GaN 器件辐照效应与LDO 电路的单粒子敏感点协同设计研究*
2024-01-17朱峻岩张优王鹏黄伟张卫邱一武周昕杰
朱峻岩,张优,王鹏,黄伟,张卫,邱一武,周昕杰
(1.复旦大学微电子学院,上海 200433;2.中科芯集成电路有限公司,江苏 无锡 214072)
0 引言
在复杂空间应用环境中,电子元器件容易被高能粒子击中,使电路发生错误甚至失效。近年来,GaN 凭借其优越的抗辐照性能,已成为最受关注的下一代航天功率半导体器件之一[1-2]。
许多国内外学者对GaN 器件、驱动集成技术及其抗辐照加固进行了研究[3],但是能够关联讨论器件辐照机理与全GaN 集成电路抗辐照的研究较少。硅基器件芯片在受到辐照时,产生的瞬时大电流会引起电路中某些关键节点的突变[4]。在数字组合电路中,这种节点的突变会被组合电路的时延展宽,可能到达时序逻辑中引起锁存器或者存储单元的逻辑错误。
GaN 基电路的驱动电流大,寄生电容小,数字单粒子瞬态(SET)脉冲在高速电路中传播能力强,传统硅基电路的SET 脉冲传播设计方法难以适合于GaN电路[5]。因此,本文从p 型栅GaN 器件的单粒子效应入手,采用计算机辅助设计技术(TCAD),获得单粒子激励电流并用于全GaN 的低压差线性稳压器(LDO)单粒子效应研究。
1 p 型栅GaN 器件的SET 效应
单粒子辐照对器件的影响是永久性烧毁或者产生SET 效应,而总剂量辐照对器件的影响主要是会导致阈值电压的迁移,从而导致电路性能的退化,比如数字电路传播延时的变化、误差放大电路中放大倍数的降低、基准电路输出的迁移等[6]。
GaN 材料比传统的Si 材料在抗辐照性能上有着明显的优势,而且GaN 基的高电子迁移率晶体管(HEMT)器件没有栅氧化层结构,不易受总剂量辐照效应的影响[7]。但由于结构的特点,GaN HEMT 具有很大的辐照敏感区域,导致在相同辐照条件下,高能粒子撞击器件的概率变大。同时敏感区电场也很大,导致辐照产生的电子空穴对更容易形成瞬态电流,影响器件的性能。关于Si 基数字电路中的SET 效应已经有了比较全面的研究,但是对于GaN 基HEMT 器件构建的全GaN 电路的SET 效应尚缺乏相关研究。
一种使用TCAD 与集成电路通用模拟程序(SPICE)仿真软件混合仿真的方式能够较好地反映出单粒子辐照效应对电路的影响。对于分立器件SET 仿真首先需要建立器件的TCAD 模型,在漏端加固定偏置,其余端均接地,设置辐照入射粒子的参数后,仿真得出器件SET 效应的相关参数。进一步利用SPICE 仿真软件可将SET 效应产生的电流视为扰动电流源,对电路中的敏感节点进行分析。传统的GaN 反相器辐照效应仿真示意图如图1(a)所示。该分析方法将器件的漏端电压固定,实际上在辐照条件下漏端电压是会受到辐照电流的影响而变化,这会造成较大的误差。基于此原因本文改进了该方法,以便能更有效地反映GaN 的SET 效应。本文以GaN 的p 型栅器件为例进行改进方法的仿真,在TCAD 中建立3D 的增强型p型栅HEMT 器件模型。与传统方法不同,改进后的方法在器件漏端耦合上负载电容和上拉电阻,以反映SET 电流对漏端偏置的影响,使得到的SET 电流更加准确,改进后的GaN 反相器辐照效应仿真示意图如图1(b)所示。首先对不同线性能传输值(LET)下的SET电流和电压进行仿真。仿真时设置的LET 值代表入射粒子使单位轨迹长度内的材料产生的电子空穴对的电量总和,在GaN 材料中,1 MeV·cm2/mg 相当于0.009 5 pC/μm。设置的LET 范围为0.01~0.90 pC/μm,p 型栅GaN HEMT 器件结构示意图如图1(c)所示,结构参数如表1 所示,其栅极宽度Wg=0.5 μm,上拉电阻等于30 kΩ。
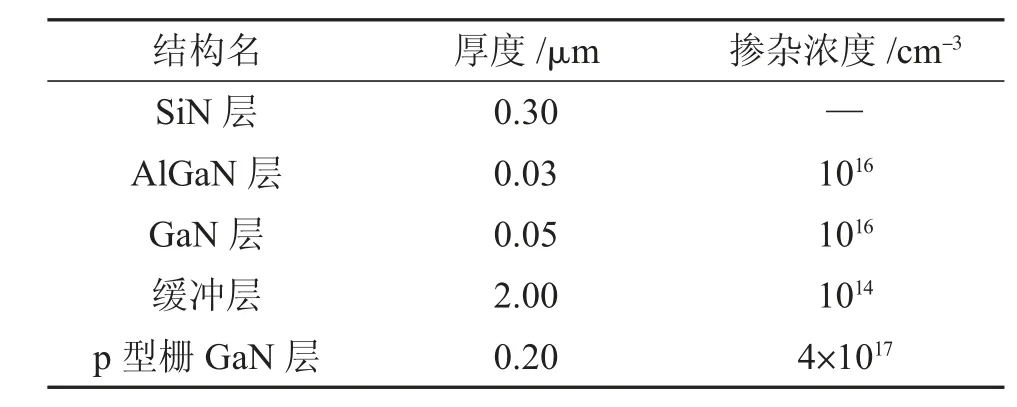
表1 p 型栅GaN HEMT 器件结构参数
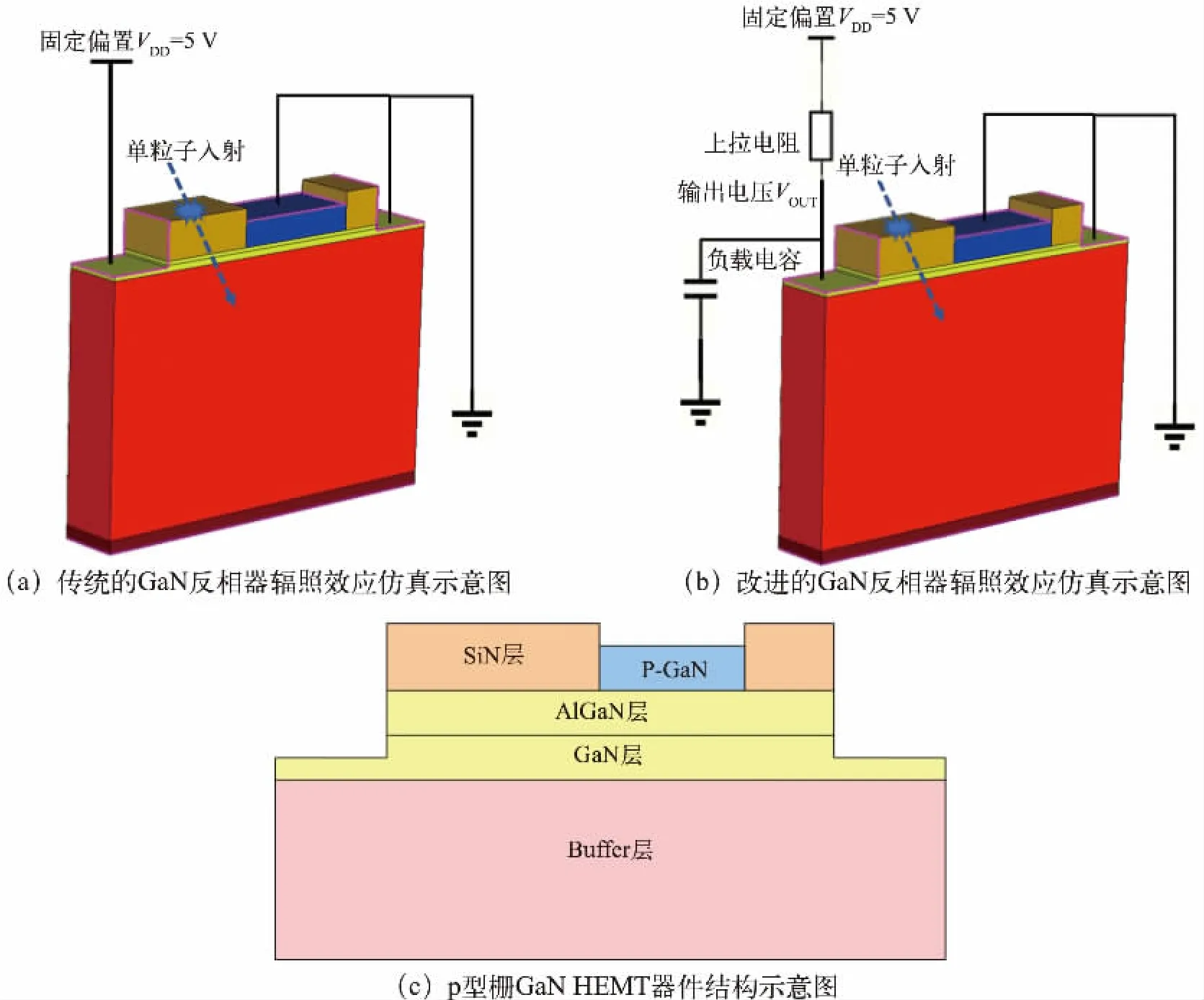
图1 GaN 反相器辐照效应仿真和p 型栅GaN HEMT 器件结构示意图
器件辐照效应测量结果如图2 所示。在不同LET的辐照条件下,器件输出节点电压经过短时间的快速下降后缓慢恢复至5 V,恢复过程中出现轻微震荡,恢复时间和电压下落幅度随着LET 值的增大而增加,但是在LET 为0.90 pC/μm 附近,增大的趋势变得饱和;p 型栅HEMT 器件的漏端电流经过短时间的快速上升后缓慢恢复至初始静态电流,恢复过程中出现轻微震荡,恢复时间和电流峰值随着LET 值的增大而增加,但是在LET 为0.90 pC/μm 附近,增大的趋势变得饱和。
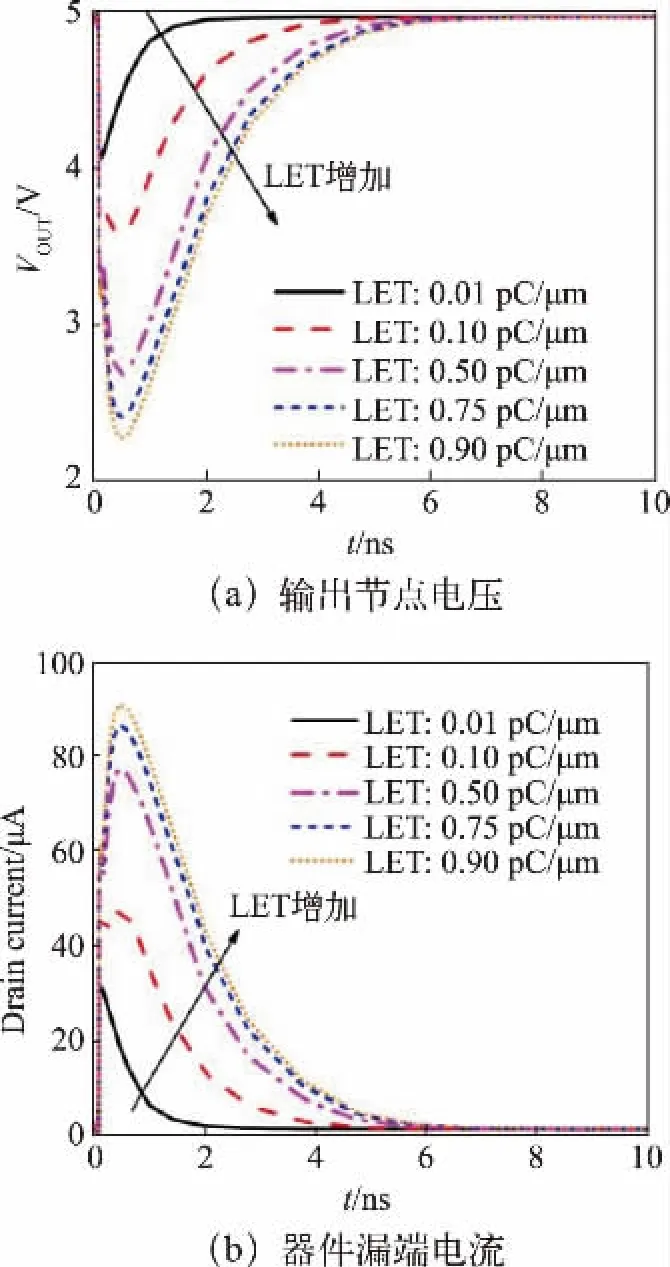
图2 器件辐照效应测量结果
2 全GaN 集成稳压电路设计
随着GaN 单片集成电路的发展,基于全GaN 技术平台设计的电路越来越完善。研究结果表明GaN HEMT 开关特性品质因数(FoM)比硅基MOSFET 更小,具有更优秀的开关特性[8]。但是GaN 基的开关电源输出纹波较大,无法满足一些对电压敏感的应用需求,因此需要设计一种能有效抑制输出波纹的线性稳压器。在传统硅基工艺下,线性稳压器中功率管有nMOS 型或pMOS 型,nMOS 相较于pMOS 的尺寸更小,可以组成具有宽环路带宽的线性稳压器,从而具有快速的瞬态响应特性。在nMOS 线性稳压器中,由于稳压器输出阻抗很低,为了控制环路的稳定性,通常将主极点设置在稳压器内部,而不是稳压器输出端[9]。
与传统的硅基nMOS 相比,相同尺寸的GaN HEMT 可以在负载较重的情况下提供更低的输出阻抗。GaN HEMT 无衬底相关寄生电容,主极点设置在稳压器内部时,即使负载较轻,输出极点也会远离主极点,从而更容易实现宽带无片外电容的稳压器。此外,基于GaN 的稳压器可以在更宽的频带范围内轻松实现优越的电源抑制(PSR)。
本文提出的GaN 单片集成线性稳压器架构如图3所示,它的结构与传统的nMOS 线性稳压器架构类似,由误差放大器、采样电阻网络和增强型GaN HEMT(MP)组成。其中VIN是输入电压,VEA,OUT为误差放大器输出电压,VF为误差放大器输入电压,VF=VOUT×β(其中β 为电压反馈因子),VREF为参考电压。误差放大器将VF与VREF进行比较,输入电压误差信号将被放大,以控制MP的栅极电压,使输出电压稳定。MP的作用类似于传统nMOS 线性稳压器中的nMOS 功率控制管,但宽长比相同时具有更低的导通电阻RDS。因此GaN HEMT 的FoM 小,误差放大器的转换速率快,单位增益频率大,从而减少了环路响应时间。

图3 GaN 单片集成线性稳压器架构
线性稳压器在重载和轻载下的环路增益与相位仿真结果如图4 所示,其中Cload为负载电容,Iload为负载电流。增强型HEMT 是一种类nMOS 的晶体管,但源极或漏极与衬底之间没有寄生p/n 结,也几乎没有体效应。由于面向的是无片外大电容的应用,而且线性稳压器的输出阻抗在重载时也非常小,所以将误差放大器的输出节点设置为环路主极点,得到其单位增益带宽(UBG)为22 MHz。当这样的系统空载时,nMOS 稳压器是最不稳定的,一般情况下,就需要在主极点处添加补偿电容而使系统稳定。然而,GaN HEMT没有体寄生二极管电容,在负载很轻的时候,输出极点还是会处于较高频位置,这使得GaN 线性稳压器的环路稳定性设计变得简易。线性稳压器电源抑制性能的仿真结果如图5 所示,它显示了轻负载和重负载下的PSR。在1 MHz 时,PSR 的绝对值大于40 dB。

图4 线性稳压器环路增益与相位仿真结果

图5 线性稳压器电源抑制性能的仿真结果
全GaN 线性稳压器的线性调整率如图6(a)所示。可以看出,在VIN=10~15 V 时,器件能够实现比较好的稳定输出。全GaN 线性稳压器负载调整率如图6(b)所示,VIN为10 V 和15 V 时,随着负载的变化,输出电压能保持稳定。

图6 全GaN 线性稳压器的线性调整率和负载调整率
负载瞬态响应仿真结果如图7 所示。在VIN=10 V和VOUT=5 V 时,负载电流在10 ns 边缘时间内在50 mA和100 mA 之间变化。当Cload=0 pF 时,下冲和过冲电压(ΔVOUT)分别为980 mV 和990 mV。对于零Cload,来自下冲和过冲的VOUT建立时间Δt 为20 ns。Iload=100 mA时的线性瞬态响应仿真结果如图8 所示。在10 ns 内,VIN在10 V 和15 V 之间变化。当Cload=10 pF 时,最大ΔVOUT为250 mV。建立时间Δt 为40 ns,线性稳压器表现出快速的瞬态响应。

图7 负载瞬态响应仿真结果

图8 线性瞬态响应仿真结果
先进的快速响应线性稳压器参数对比如表2 所示。从比较结果中可以看出,相比于CMOS 工艺,本文所提出的全GaN 工艺下的线性稳压器具有更小的建立时间、更快速的瞬态响应,同时可以承受更大的输入电压,在1 MHz 内都具有良好的PSR 性能。由此可见,在设计快速响应线性稳压器时,全GaN 工艺能够发挥出比Si 基电路更大的优势。

表2 先进的快速响应线性稳压器参数对比
3 全GaN 稳压器电路不同节点辐照敏感度
对于GaN 基电路来说,一般SET 效应对稳压器的影响主要包括对节点电压和输出节点电压变化的幅度以及持续时间等的改变[12]。对于本文设计的GaN基稳压器,每个节点都可能因SET 效应产生瞬态电流,引起节点电压的波动,并且会传播至附近相关电路,最终对稳压性能造成影响,因此有必要对每个节点进行SET 仿真,找出敏感节点,在之后的电路设计中对敏感节点进行重点加固。由于器件-电路混合仿真方法过于复杂,需要对每个节点建模。只需找出敏感节点,则可以假设所有节点的SET 电流几乎一致,判断其对输出的影响。VIN=12 V,VOUT=5 V,LET 为0.75 pC/μm,对GaN 稳压器中的4 个节点(V1,V2,VEA,OUT,VOUT)进行粒子辐照,GaN 稳压器每个节点受到的SET 效应影响示意图如图9 所示。
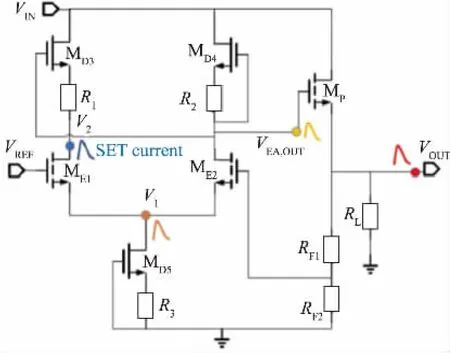
图9 GaN 稳压器每个节点受到的SET 效应影响示意图
各个节点受到SET 对电压产生的影响如图10 所示。
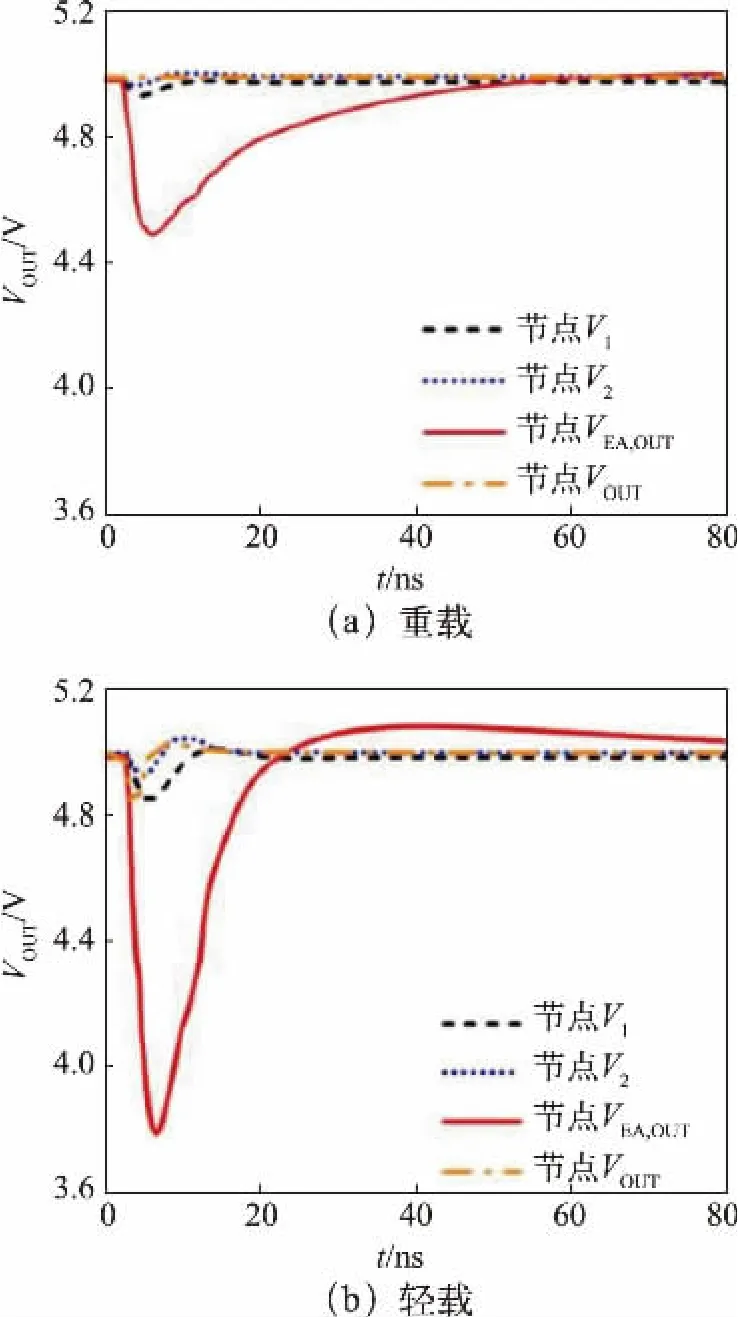
图10 各个节点受到SET 对电压产生的影响
进一步分析可知,轻载(Iload=100 μA)时,稳压器输出电压VOUT受到的影响较小,这和环路响应速度较快有关,同时也说明快速响应稳压器有利于抵抗SET 效应的影响。重载时(Iload=100 mA),VOUT本身受单粒子轰击以后输出变化是最小的,此时功率管输出电流大,SET 脉冲电流的影响几乎可以忽略。不管是在重载还是轻载条件下,当VEA,OUT受到单粒子辐照影响时,它的波动和恢复时间都是最差的。由此可以得到,VEA,OUT节点即ME2的漏端为SET 敏感节点,需要重点加固。GaN 稳压器重载和轻载时各节点SET 响应产生的输出电压变化如表3、4 所示。

表3 GaN 稳压器重载时各节点SET 响应产生的输出电压变化

表4 GaN 稳压器轻载时各节点SET 响应产生的输出电压变化
4 结论
本文讨论了基于p 型栅GaN 器件单粒子效应的全GaN 集成电路设计抗辐照新方法,明确了全GaN电路中的单粒子辐照敏感点。建立起的GaN 半导体T-CAD/SPICE 单粒子效应协同设计方法能为单片GaN 电路抗辐照研究及其加固设计提供有益的参考。
