AlGaN/GaN异质结电荷密度和内建电场强度的调控
2024-01-15庄芹芹闫金健陈佳坭
庄芹芹,林 伟,闫金健,陈佳坭
(1. 厦门理工学院光电与通信工程学院,福建 厦门 361024;2. 福建省光电技术与器件重点实验室,福建 厦门 361024;3. 厦门市先进半导体镀膜技术研发与应用重点实验室,福建 厦门 361024;4. 厦门大学物理科学与技术学院,福建 厦门 361005;5. 福建省半导体材料及应用重点实验室,福建 厦门 361005)
三族氮化物是重要的宽禁带半导体材料,适合用于制作大功率、高频率的电子器件。氮化镓(GaN)及其与氮化铝(AlN)组成的合金AlGaN 所构成的AlGaN/GaN 异质结场效应晶体管(heterostructure field-effect transistor,HFET),具有载流子饱和漂移速率高、临界击穿电场大、热导率高等优良特性,在大功率、高温电子器件领域有着广泛的应用[1-4]。因为六方纤锌矿结构的GaN 和AlN 原胞是非中心对称结构,即使没有电场也存在一定的极化,称为自发极化(spontaneous polarization,SP)。在AlGaN/GaN 异质结中,由于GaN 和AlGaN 晶格常数不匹配而在异质结界面处存在形变,使得正负离子芯发生偏移,从而产生压电极化(piezoelectric polarization,PE)。自发和压电极化使得AlGaN/GaN异质结界面处具有高达MV/cm量级的内建电场及高密度的极化电荷[5-6]。
近20 多年来,研究者们致力于探索各种有效方法来调控异质结界面的载流子浓度和内建电场,以制成高迁移率的场效应晶体管。一般认为,Al组分的增加将提高极化强度进而提高极化电荷浓度。Date 等[7]的研究表明,当Al组分从0.15增大到0.30时,极化电荷的浓度增加了1倍以上,但是,过高的Al 组分会增强合金无序散射和界面粗糙度散射,导致载流子迁移率显著减小;Douara 等[8]研究发现,增加AlGaN垒层的厚度也能提高极化诱导的自由电子浓度,但会接近一个极限值。此外,有理论和实验研究表明,GaN 层的应变及AlGaN 层的掺杂浓度同样能够对极化电荷的数量产生影响[7-9]。还有研究发现,在AlGaN/GaN 异质结中引入高温AlN 插入层[10-11]或采用双异质结结构[12]都能有效改善AlGaN/GaN 的HFET性能。在当前的一些光电应用中,由于异质界面极化场的副作用,无法使用迁移率更高的二维电子气,所以,除了电荷密度,对界面处极化电场进行调控也非常重要。然而,目前仍然缺乏同时针对AlGaN/GaN 异质结界面处电荷密度、内建电场,以及二者相互关系的研究。为此,本文采用第一性原理计算方法,通过改变AlGaN垒层的Al组分,并实施p型掺杂,对AlGaN/GaN 异质结模型进行模拟计算,并对计算结果进行比较和分析,进而获得对异质结界面处电荷密度和内建电场强度进行调控的有效方法。
1 计算方法与模型
模拟计算采用基于密度泛函理论(density functional theory,DFT)的VASP 程序包。交换关联能采用广义梯度近似(generalized gradient approximation,GGA)。电子-离子相互作用采用投影缀加波赝势法(projector-augmented wave,PAW)描述。结构优化和计算时采用平面波函数展开,截断能设为500 eV。布里渊区中积分采用Monkhorst-Pack方法,倒格子空间的网格点k取值为5×5×3。
AlxGa1-xN/GaN 模型的基本单元由4×4×16 的超晶胞组成,以x = 0.25 为例,其中包括16 个Al原子、112个Ga原子和128个N原子(见图1(a)),弛豫后的晶格常数为:a = b =0.642 nm,c =8.302 nm。掺杂的Mg原子原位替代AlxGa1-xN位于异质结界面处的一个Ga原子,x = 0.25时的超晶胞局部见图1(b)。

图1 超晶胞结构示意图Fig.1 The calculated supercell structure
2 模拟计算结果与讨论
为了解Al0.25Ga0.75N/GaN 界面附近的能态分布,以1 个三族原子和1 个氮原子为1 个单元,计算对应于晶胞模型c轴上每一个单元的电子态密度,其分布色阶见图2(a)。不同单元的电子态密度的能量分布都不相同,各单元的价带最高点和导带最低点连接起来便能得到Al0.25Ga0.75N/GaN 异质结界面附近实空间的能带结构图。由图2(a)可见,Al0.25Ga0.75N的禁带宽度比GaN更大些,界面处的能带发生了弯曲,这是由于极化强度的不连续而产生的极化电荷所形成的内建电场所导致的。图2(b)展示了各单元的静电势分布。图中拟合曲线在异质结界面处的倾斜体现了内建电场的强度,通过计算,可以估算出该电场值约为14.9 MV/cm。

图2 Al0.25Ga0.75N/GaN界面附近沿c轴的电子态密度分布和静电势分布图Fig.2 Position-dependent DOS and electrostatic potential near the interface of Al0.25Ga0.75N/GaN
由于HFET的物理性能主要取决于载流子浓度,研究AlGaN层中Al组分的变化和掺杂对异质结界面处电荷密度的的影响至关重要。计算所得,不同Al 组分(x=0.25、0.50、0.75)下AlxGa1-xN/GaN 异质结界面附近的差分电荷密度见图3(a)~图3(c),有色曲面表示7.0 e/nm3等能面,其中黄色表示电子的积聚,而蓝色表示电子的耗尽。由图3可见,本文所研究的4种模型的载流子均为电子。当Al组分从0.25 增大到0.50 时,电子密度显著增大,这是由于异质界面处能带不连续性的增大增加了界面处的极化电荷浓度,吸引了更多电子聚集到界面处,这与文献[7-8]的研究结果一致。当Al 组分继续增大到0.75 时,界面处的面电子密度比Al 组分为0.5 的却减少了。尽管Al 组分的增加将导致极化电荷浓度线性增加,但是由于异质结的晶格不匹配度也随之增大,由此引入的缺陷将影响极化电荷诱导的自由电子浓度,反而降低了HFET 的性能。所以,在实际应用中,Al 组分一般控制在0.40 以内。对于在Al0.25Ga0.75N/GaN 异质结界面处加入Mg 原子进行p 型掺杂的情况(见图3(d)),可见,由于Mg 原子引入的空穴捕获了自由电子,所以界面处的电子密度急剧减小。因此,若想提高AlGaN/GaN异质结界面附近的自由电子浓度,在一定范围内增大势垒层的Al组分是切实有效的手段。
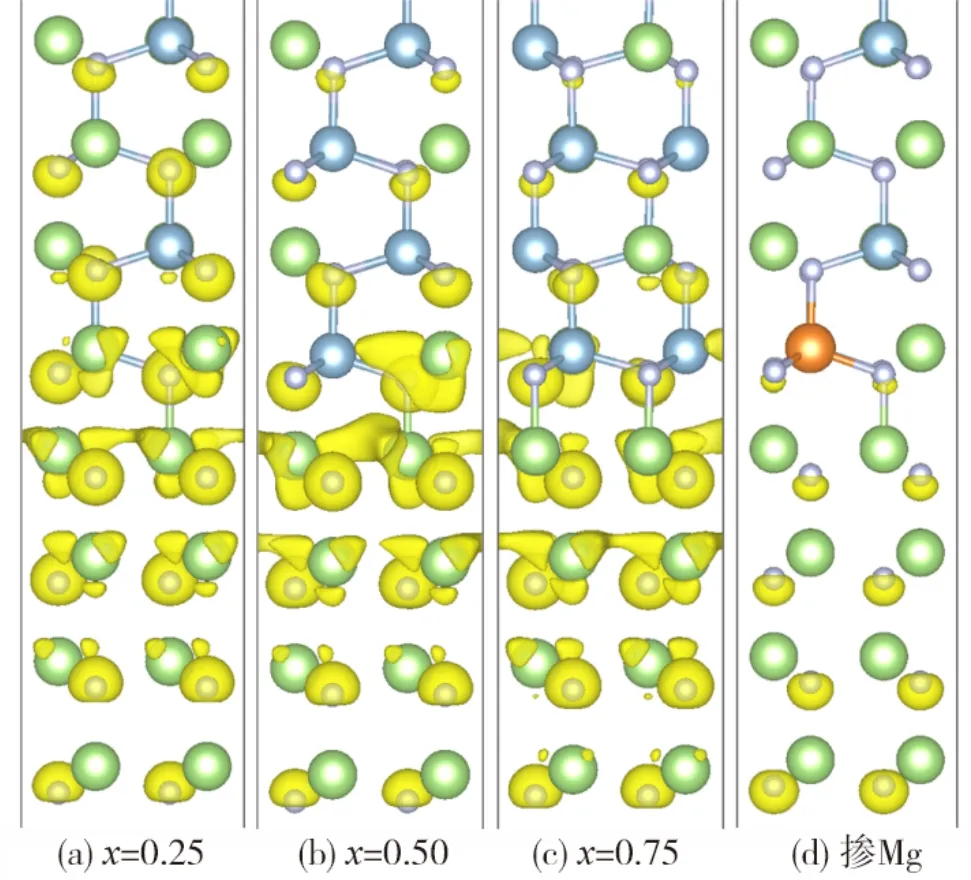
图3 不同Al组分和Mg原子掺杂下的AlxGa1-xN/GaN异质结界面附近的差分电荷密度图Fig.3 Differential charge densities(DCD)near the interface of AlxGa1-xN/GaN and Mg-doped Al0.25Ga0.75N/GaN
AlxGa1-xN/GaN 异质结界面处的内建电场强度可以通过计算异质结界面附近的静电势分布来得到。图4(a)~图4(c)展示了Al 组分从0.25 增大到0.75时的静电势分布图。拟合曲线在异质结界面处的斜率随着Al组分的增大而单调增大。当Al组分为0.50 和0.75 时,内建电场的值分别为29.7 MV/cm 和41.9 MV/cm,分别约为Al 组分为0.25 的2 倍和3 倍。这是由于,比起GaN、AlN,AlxGa1-xN 的自发极化强度,AlxGa1-xN 的自发极化强度将随x 的增大而增大。此外,x 的增大加剧了晶格失配,进而增强了AlxGa1-xN 的压电极化。于是,AlxGa1-xN 总的极化强度随着x的增大而增大,导致AlxGa1-xN/GaN 异质结界面的不连续性进一步增加,将有更多电子聚集到界面处,从而增大界面处内建电场的强度。对Al0.25Ga0.75N/GaN 进行Mg 的p 型掺杂,显著减小了异质结两侧的静电势分布的差异,内建电场也减小到5.0 MV/cm。极化电荷的积聚导致了极化电场的产生,极化电荷密度越大,极化电场越大。结合前文关于异质结界面附近电荷密度的计算结果,当Al 组分从0.25 增大到0.50 时,电荷密度有所增大,与内建电场强度的增大相对应。当使用Mg 原子原位替代Al0.25Ga0.75N 层位于交界面处的Ga 原子时,电荷密度急剧减小,该结构的内建电场强度比起未掺杂的情况也相应地减弱了约2/3。这说明,对于上述两种模型,异质结界面处的压电极化占据了主导地位。然而,对于Al 组分x=0.75 的情况,异质结界面处的电荷密度虽然比x=0.25 的略有增大,但比x=0.5 的有所减小,而内建电场强度却表现出单调增加的趋势。这一特殊现象将促进人们对AlxGa1-xN/GaN 异质结载流子密度的产生机制进行进一步探讨,也对AlxGa1-xN/GaN 基HFET 的设计提供了理论依据。

图4 不同Al组分和Mg原子掺杂下的AlxGa1-xN/GaN异质结界面附近的静电势分布图Fig.4 Electrostatic potential near the interface of AlxGa1-xN/GaN and Mg-doped Al0.25Ga0.75N/GaN
3 结论
本文采用第一性原理计算方法,研究了Al组分和Mg原子掺杂对AlGaN/GaN 异质结界面附近电荷密度和内建电场强度的调控作用。结果表明,当Al组分从0.25增加到0.50后,界面处的电荷密度明显增大,但增大到0.75 后又减小了,说明在一定范围内增大AlGaN 势垒层中的Al 组分,能够有效提高AlGaN/GaN 异质结界面附近的载流子浓度。异质结界面处的内建电场强度随着Al 组分的增大而单调增大,当x=0.50 和0.75 时,计算所得内建电场强度的值分别约为x=0.25 的2 倍和3 倍,这是由于异质界面处能带的不连续性随Al组分的增大而增大,使得压电极化强度增强所导致的。当Mg原子替代界面处的一个Ga原子进行p型掺杂后,由于自由电子被Mg原子引入的空穴捕获,故内建电场强度和电荷密度都显著减小了。本文的结果证实了Al组分和Mg原子掺杂对AlGaN/GaN 异质结中自由电子浓度和内建电场强度的调控作用,为AlGaN/GaN 基HFET的设计提供了理论依据。鉴于高Al组分下自由电子浓度下降的现象,将来需针对AlxGa1-xN/GaN异质结载流子密度的产生机制进行进一步探讨。
