兼具高电流增益和高击穿性能的电荷等离子体双极晶体管
2023-11-13金冬月贾晓雪张万荣那伟聪曹路明潘永安刘圆圆范广祥
金冬月, 贾晓雪, 张万荣, 那伟聪, 曹路明, 潘永安, 刘圆圆, 范广祥
(北京工业大学信息学部, 北京 100124)
基于绝缘体上硅(silicon-on-insulator,SOI)技术的横向双极晶体管(lateral bipolar junction transistor,LBJT)具有寄生电容小、功耗低、电学性能可调控且与成熟的互补金属氧化物半导体(complementary metal-oxide-semiconductor,CMOS)工艺相兼容等优点,已在模拟放大器和射频混合信号电路领域扮演起越来越重要的角色[1]。然而,考虑到上述LBJT中发射区、基区和集电区的掺杂往往需要采用离子注入或扩散技术来实现,将不可避免地引入掺杂波动、掺杂激活、高温热退火和热开销等问题,进而对器件的可靠性产生影响并严重制约着器件性能的有效提升[2]。
电荷等离子体双极晶体管(bipolar charge plasma transistor,BCPT),作为一种SOI基LBJT,仅需要通过选取不同功函数的金属作为电极与未掺杂的硅(Si)形成良好的金属-半导体接触,即可在Si中有效诱导产生电荷等离子体,形成n型区和p型区,于2012年由新德里理工学院Kumar等[3]首次提出,随后受到有关学者的广泛关注。2014年,韦洛尔理工学院Sahu等[4]进一步优化了Si层厚度和电极间距来提高电流增益β和特征频率fT;2017年,印度信息技术设计学院Bramhane等[5]将Si/SiGe/Si异质结构引入BCPT,fT高达1~4 THz,拓展了其在下一代模拟和射频领域的应用范围;2018年,科塔信息技术研究所Singh[6]指出,引入应变Si/SixGe1-x层虽可显著改善BCPT的β和fT,但击穿电压却相应降低。
由于BCPT中各区的载流子浓度强烈依赖于电极金属,虽可通过选取具有不同功函数的电极金属分别改变器件的β和击穿电压,但却无法实现二者的同步改善,进而限制了高功率应用及其在高速混合模电路的应用前景。
与此同时,考虑到SOI基LBJT自身的结构特点,2016年美国IBM公司Cai等[7]首次提出了一种在SOI衬底一侧引入第4个可控端口的衬底偏压技术。对于npn型晶体管,通过在器件衬底一侧引入正偏压,可以实现在靠近埋氧层一侧的发射区和基区内电子的积累,进而提高发射区的电子浓度,并降低基区的空穴浓度,此时发射结注入效率增大,器件的β得以改善。近期,本课题组也对采用衬底偏压技术改善SOI基横向SiGe HBT的高频功率性能进行了初步研究[8-9]。考虑到BCPT作为一种SOI基LBJT,如能将衬底偏压技术引入到BCPT的设计中,借助背面套刻工艺,则可实现对衬底偏压位置的合理设计,并通过对衬底一侧第4个可控端口的电压控制,实现对Si层载流子浓度的动态调节,最终可以达到电流增益和击穿电压的同步改善。
本文重点针对SOI基BCPT的β和击穿性能同步改善技术展开研究,一方面通过优化选取集电极金属提升器件的击穿特性,另一方面通过采用衬底偏压结构优化设计,在保持较高击穿特性的同时增大器件的电流增益。
1 器件建模
对于BCPT而言,为了形成npn型器件,在电极金属和Si厚度选取方面需要满足如下条件:
1) 发射极金属的功函数φmE需要满足φmE<χ(Si)+Eg/2,集电极金属的功函数φmC需要满足φmC<χ(Si)+Eg/2,基极金属的功函数φmB需要满足φmB>χ(Si)+Eg/2,其中:χ(Si)为Si的电子亲和势;Eg为Si的禁带宽度。
2) 未掺杂的Si层厚度需要小于Debye长度LD[3-4],LD为
(1)
式中:ε(Si)为Si的介电常数;uT为热电压;q为电子电荷;ni为Si层内部本征载流子浓度。
为此,本文选用功函数为4.05 eV的金属锆(Zr)作为发射极和集电极金属,用于发射区和集电区中,通过诱导产生电子等离子体形成n型发射区和集电区;选用功函数为5.65 eV的金属铂(Pt)作为基极金属,并用于基区中,通过诱导产生空穴等离子体,形成p型基区,从而形成了npn型BCPT。同时,未掺杂的Si层厚度T(Si)设为15 nm。
在此基础上,本文利用商业半导体仿真工具SILVACO TCAD的二维器件仿真器ATLAS建立了BCPT的器件模型,如图1所示。图中衬底掺杂浓度NSub为1×1013/cm3,电极间距LS为20 nm,埋氧层厚度TBox和衬底厚度TSub均为25 nm,发射极电极长度LE为50 nm,基极电极长度LB为60 nm,集电极电极长度LC为60 nm。详细的结构参数如表1所示。

表1 BCPT的结构参数
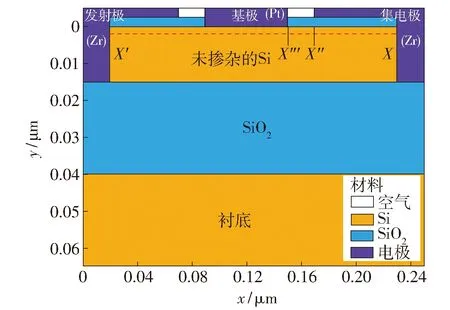
图1 BCPT的器件模型Fig.1 Device model of BCPT
进一步利用二维器件仿真器ATLAS对BCPT的电学特性进行仿真,其中,加入了俄歇复合模型、带隙变窄模型[10]、浓度相关寿命模型、迁移率受电场影响模型、浓度依赖迁移率模型、SRH(Shockley-Read-Hall)复合模型[11]、Selberherr碰撞电离模型[12]和费米狄拉克统计模型。
当BCPT工作在放大区时,电子电流密度J分布如图2所示。下面重点对BCPT的基本工作原理展开论述。当BCPT的发射结正偏、集电结反偏时,从发射区注入基区的电子在基区中只复合了极少的一部分,绝大部分还未来得及复合就已扩散到了集电结边上,被集电结势垒区的强电场拉入集电区,形成集电极电流并从集电极流出,实现放大作用。不同于发射区和集电区的电子电流靠近电极一侧,BCPT中的基区电子电流靠近埋氧层一侧,这主要归因于Si层内存在着沿y方向的电势分布。
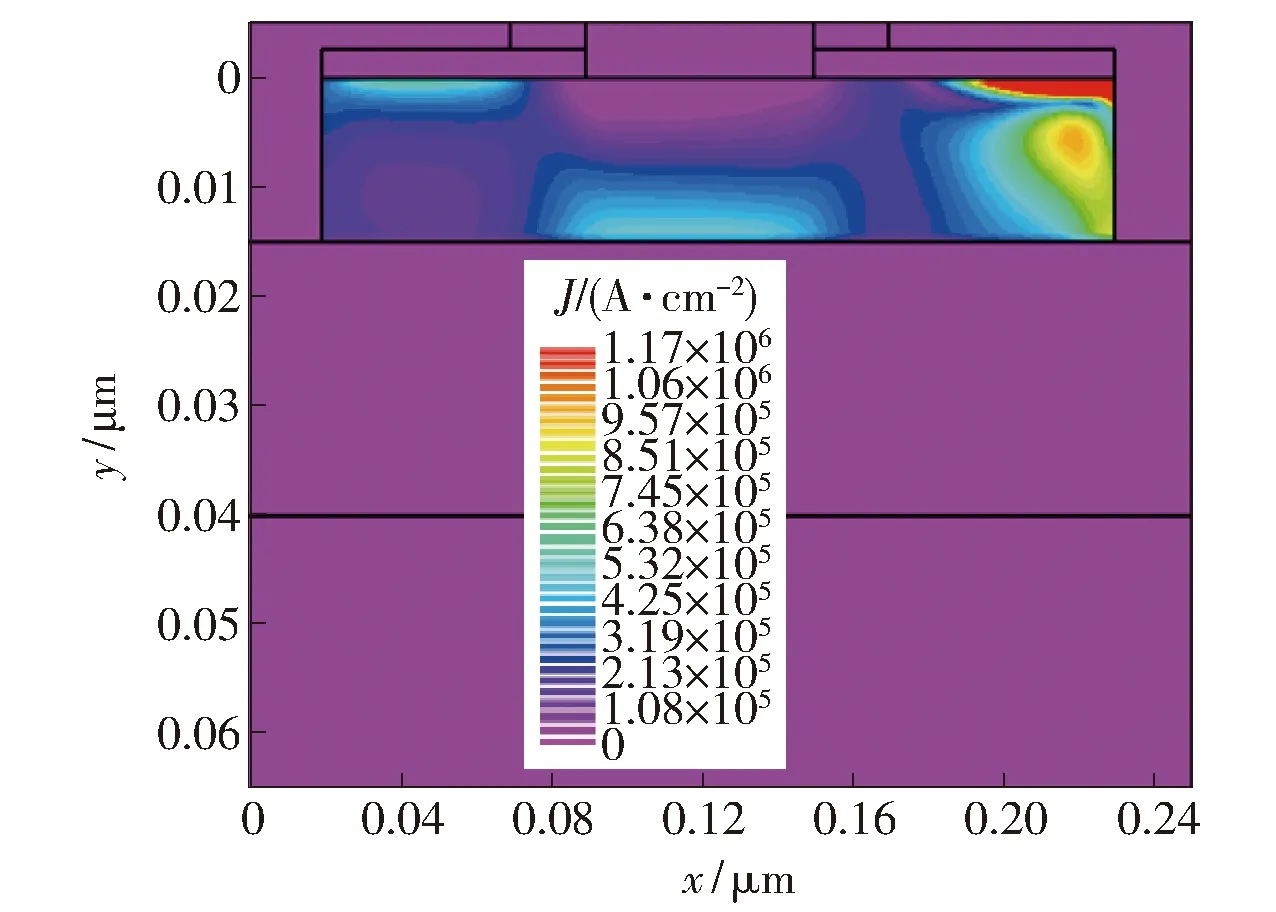
图2 BCPT的电子电流密度分布Fig.2 Electron current density distribution of BCPT
具体地,由于BCPT的Si层中载流子浓度强烈依赖于电极金属的功函数,诱导产生的电子和空穴等离子体浓度在Si层沿y方向的分布并不均匀,沿y方向的电子浓度可表示为[4]
ny=niexp (ψ(y)/uT)
(2)
式中:ψ(y)为Si层中沿y方向的电势分布;ni为未掺杂的Si层中的本征载流子浓度;uT为热电压。ψ(y)[13]可表示为

(3)
式中:φ(Si)为Si的功函数(Si,φ(Si)=4.73 eV);tox为SiO2层厚度;ε(Si)和εox分别为Si和SiO2的介电常数。可以看出,选用功函数大的集电极金属有利于降低Si层中载流子浓度。
图3给出了沿X′-X方向(图1中集电极金属-半导体接触界面向衬底方向1 nm处)的电子、空穴浓度分布。可以看出,发射极金属与Si接触界面处电子浓度较大,这主要归功于在金属-半导体接触表面处的电子积累[14],上述电子积累将会产生电场,排斥从基极注入发射极的少子空穴,使得发射区的空穴浓度梯度减小,降低基极电流IB,因此,相比较于传统的LBJT,BCPT具有更高的电流增益。

图3 BCPT的电子和空穴浓度分布Fig.3 Electron and hole concentration distribution of BCPT
图4给出了BCPT的集电极电流-电流增益(IC-β)曲线。同时为了进行对比,本文还建立了与BCPT具有相同结构参数的SOI基横向Si/SiGe/Si异质结双极型晶体管(lateral hetero junction bipolar transistor,LHBT)模型,并仿真得到IC-β曲线。其中:LHBT的Ge组分为0.24;发射区掺杂浓度为2×1018/cm3;基区掺杂浓度为2×1019/cm3,集电区掺杂浓度为2×1018/cm3。从图中可以看出,BCPT的峰值电流增益高达1 896.81,而LHBT的峰值电流增益仅为560.93,因此,BCPT具有更好的电流处理能力。

图4 BCPT和LHBT的IC-β曲线的对比Fig.4 Comparison of IC-β curves of BCPT and LHBT
2 性能改善技术研究
基于上述器件模型,分别对比研究了具有不同功函数的集电极金属对BCPT击穿特性的影响,并利用BCPT作为SOI基器件的特点,引入衬底偏压技术,通过优化设计衬底偏压结构来实现BCPT电流增益和击穿特性的同步改善。
2.1 集电极金属的影响
BCPT作为一种SOI基双极晶体管,其耐压能力和击穿特性与集电结峰值电场强度密切相关。集电结峰值电场强度[15]可表示为
(4)
式中:nCy为集电区载流子浓度;xn为集电区一侧的空间电荷区宽度;εr为相对介电常数;εo为绝对介电常数。
结合式(2)~(4)不难看出,通过合理选取集电极金属来减小集电区载流子浓度,将有利于降低集电结峰值电场强度,从而达到改善击穿电压的目的。因此,本文重点对比研究了2种集电极金属锆(Zr,φmC=4.05 eV)和铝(Al,φmC=4.28 eV)对BCPT击穿特性的影响。
图5给出了Zr和Al作为集电极金属对BCPT集电区内沿X-X″方向(图1中集电极金属-半导体接触界面向衬底方向1 nm处)电子浓度分布的影响。从图中可以看出,与Zr相比,Al作为集电极金属时在集电区中诱导的电子浓度偏低。分析其原因,当发射极、基极电极金属和Si层固定不变时,选取功函数较大的Al作为集电极电极将减小金属-半导体接触的功函数差,从而降低了集电区中诱导的电子浓度。

图5 集电极金属对BCPT集电区内沿X-X″方向电子浓度的影响Fig.5 Effect of collector metal on electron concentration along the X-X″ direction in the BCPT collector region
进一步给出了Zr和Al作为集电极金属时BCPT的二维电场强度分布,如图6所示。可以看出,电极附近的电场强度很高,与Zr相比,Al作为集电极金属时BCPT集电结附近空间电荷区内二维电场强度明显降低,其峰值电场强度减小了4.7×103V/cm。

图6 集电极金属对BCPT二维电场强度分布的影响Fig.6 Effect of collector metal on two-dimensional electric field distribution of the BCPT
发射极开路集电结的击穿电压VCBO主要取决于载流子浓度较低的一侧,公式[16]可表示为

(5)
式中:E(x)为发生击穿时的临界电场强度;ψBC为集电结的内建电势;WC为集电区宽度。当Al作为集电极金属时,集电区诱导的载流子浓度降低,靠近集电区一侧的空间电荷区展宽,有利于击穿电压的改善。
图7给出了Zr和Al作为集电极金属对BCPT的击穿电压VCBO的影响。从图中可以看出,Al作为集电极金属时,BCPT的击穿电压VCBO高达6.93 V,与Zr作为集电极金属的BCPT相比,击穿电压VCBO提高了19.48%。

图7 集电极金属对BCPT的击穿电压VCBO的影响Fig.7 Effect of collector metal on breakdown voltage VCBO of the BCPT
此外,Zr和Al作为集电极金属对BCPT集电结空间电荷区内沿X″-X‴方向(图1中集电极金属-半导体接触界面向衬底方向1 nm处)集电结空间电荷区内电子温度Tn分布的影响,如图8所示。从图中可以看出,Al作为集电极金属时,BCPT的Tn仅为3 361.31 K,与Zr作为集电极金属的BCPT相比,Tn降低了9.39%。可见选取功函数较大的集电极金属有利于降低器件的电子温度,同时,BCPT的集电结空间电荷区向集电区一侧展宽,也有利于提高击穿电压。

图8 集电极金属对BCPT集电结处电子温度的影响Fig.8 Effect of collector metal on electron temperature at the collector junction of the BCPT
根据能量平衡传输模型,电子碰撞电离率αn[17]可以表示为
(6)
式中:a、b为拟合参数;c表示电子饱和速度与其能量弛豫时间的乘积。可以看出,αn与Tn呈现出指数关系,可通过降低Tn来减小αn,进而改善器件的击穿特性。
图9给出了Zr和Al分别作为集电极金属时对BCPT的αn的影响。可以看出,Al作为集电极金属时BCPT的峰值电子碰撞电离率仅为5.66 cm-1,与Zr作为集电极金属的BCPT相比,峰值电子碰撞电离率降低了66.31%。
进一步地,Zr和Al分别作为集电极金属时对BCPT的基极开路集电极-发射极间的击穿电压VCEO的影响如图10所示。从图中可以看出,Al作为集电极金属时BCPT的击穿电压VCEO为1.68 V,与Zr作为集电极金属的BCPT相比,击穿电压VCEO提高了15.07%。
当采用φmC较大的Al作为集电极金属时,nCy随之降低会使集电结向集电区一侧展宽,从而导致集电结势垒电容CTC减小,将有利于缩短晶体管在截止区(关态)的延迟时间td。然而,集电区电子(多子)浓度的降低会使集电区少子寿命τC延长,而τC的延长将造成超量储存电荷量增大,不利于缩短晶体管在开态时处于深饱和状态的时间。因此,集电极金属及其功函数的选取对于改善器件的开态和关态特性存在着矛盾关系。
同时,图11给出了Zr和Al作为集电极金属对BCPT的IC-β曲线的影响。可以看出,Al作为集电极金属时BCPT的峰值电流增益仅为1 610.95,与Zr作为集电极金属的BCPT相比,峰值电流增益降低了14.97%。这主要是由于选取功函数较大的Al作为集电极电极将降低集电区中诱导的电子浓度,容易引起基区Kirk效应,使基区复合增大,进而导致β的大幅下降。

图11 集电极金属对BCPT的IC- β曲线的影响Fig.11 Effect of collector metal on the IC-β curves of the BCPT
从上面的分析可以看出,虽然通过选取功函数较大的Al作为集电极电极可以降低集电区中诱导的电子浓度,从而提高BCPT的击穿电压VCBO和VCEO,但也会不可避免地引起β的大幅下降。同时,考虑到能与未掺杂的Si形成良好的金属-半导体接触,并能有效诱导产生电荷等离子体的金属材料种类有限,而且上述可用金属材料的功函数呈非连续性分布,因此,仅通过优化选取电极金属来同步提升BCPT的β和击穿电压的能力有限。考虑到BCPT作为SOI基器件的一种,本文将进一步从SOI基衬底结构特点出发,引入衬底偏压技术,并通过优化设计衬底偏压结构来实现BCPT的β和击穿特性的同步改善。
2.2 具有衬底偏压结构的BCPT优化设计
为了使得BCPT在保持高击穿特性的同时提高器件的β,借助背面套刻工艺[18],本文在BCPT发射区和基区正下方的SOI基衬底一侧设计了一种衬底偏压结构,并通过施加正衬底偏压,使得埋氧层上方的发射区和基区内积累电子[14],进而可以通过调节外置的正衬底偏压实现对发射区和基区内的载流子浓度的连续调制。具有衬底偏压结构的BCPT器件模型如图12所示,其中集电极、基极和发射极金属分别为Al、Pt和Zr。

图12 具有衬底偏压结构的BCPT器件模型Fig.12 Device model of BCPT device with substrate bias structure
图13给出了在热平衡下,衬底偏压结构对BCPT器件的二维电子浓度分布和二维空穴浓度分布的影响,其中衬底偏压Vs=1.1 V。可以看出,衬底偏压的引入会使靠近埋氧层上方的发射区和基区内形成薄的电子积累层,埋氧层附近的基区被耗尽,因此,衬底偏压的引入会降低基区内有效空穴浓度。

图13 衬底偏压结构对BCPT的二维电子和空穴浓度分布的影响Fig.13 Effect of substrate bias structure on the two-dimensional electron and hole concentration distribution of BCPT
进一步地,衬底偏压结构对BCPT的Gummel曲线的影响如图14所示。其中:集电极-发射极电压为2 V;施加的衬底偏压Vs=1.1 V。可以看出,BCPT的IB对衬底偏压不敏感,衬底偏压可在较大的发射结电压变化范围(0.2~1.0 V)内增大器件的集电极电流。

图14 衬底偏压结构对BCPT的Gummel曲线的影响Fig.14 Effect of substrate bias structure on the Gummel curve of BCPT
β与发射结注入效率γ密切相关[19],可表示为
(7)
式中:β*为基区输运系数;α为共基极电流增益。γ又可以表示为
(8)
式中:DE为发射区扩散系数;DB为基区扩散系数;WB为基区宽度;WE为发射区宽度。
由式(8)可知,BCPT的β与基区和发射区有效载流子浓度nBy和nEy密切相关。衬底偏压的引入使得基区有效空穴浓度下降,而发射区有效电子浓度提高,从而增大了发射结注入效率,进而实现了β的显著提高。
进一步地,分别比较了Zr和Al作为集电极金属的BCPT以及采用衬底偏压结构且Al作为集电极金属的BCPT的IC-β曲线,如图15所示。可以看出,该BCPT具有最高的峰值电流增益,高达2 305.56,与仅采用Zr作为集电极金属的器件相比,峰值电流增益提高了21.69%。图16和图17分别比较了Zr和Al作为集电极金属的BCPT以及采用衬底偏压结构且Al作为集电极金属的BCPT的击穿电压VCBO和VCEO。分析表明,该BCPT保持了较高的击穿特性,与仅采用Zr作为集电极金属的器件相比,VCBO和VCEO分别提高了12.87%和15.07%。

图15 3种BCPT的IC-β曲线的比较Fig.15 Comparison of IC-β curves of three types of BCPT

图16 3种BCPT击穿电压VCBO的比较Fig.16 Comparison of breakdown voltage VCBO of three types of BCPT
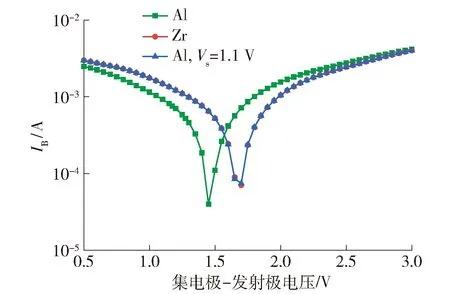
图17 3种BCPT击穿电压VCEO的比较Fig.17 Comparison of breakdown voltage VCEO of three types of BCPT
此外,BCPT还具有较高的温度敏感性[6],并且SOI结构的存在将显著削弱器件的散热性能,BCPT将面临严峻的热可靠性问题。同时,考虑到BCPT的关键制备工艺之一就是如何依靠表面处理和金属沉积方法形成有效金属-半导体结,此时由于晶格的不连续性和悬挂键的存在将会在金属-半导体接触界面上产生陷阱[3],从而严重影响BCPT的寿命及其可靠性。
3 结论
1) 为提升BCPT的高压大电流处理能力,本文利用SILVACO TCAD建立了npn型BCPT的器件模型。研究了不同集电极金属对BCPT击穿特性以及电流增益的影响。研究表明,采用Al作为集电极金属虽可减小金属-半导体接触的功函数差,从而降低诱导的集电区电子浓度,使击穿电压VCBO和VCEO分别提高了17.76%和15.07%,但也会引起基区Kirk效应,增大基区复合,降低峰值电流增益。
2) 本文提出了一种具有衬底偏压结构的BCPT,该器件在发射区和基区正下方的SOI基衬底一侧引入衬底偏压电极,通过调节外置的正衬底偏压实现对发射区和基区内的载流子浓度的连续调制。结果表明,当对该BCPT施加正衬底偏压Vs=1.1 V时,基区有效空穴浓度下降,而发射区有效电子浓度提高,从而增大了发射结注入效率,峰值电流增益增大为2 305.56,同时保持了较高的击穿电压VCBO=6.54 V和VCEO=1.68 V。本文工作对设计和制造出适用于高速混合模电路的SOI基BCPT具有一定的现实意义。
