Al2 O3/HfO2 复合薄膜的介电性能研究
2023-01-10牟舜禹李瑞江李少奎
牟舜禹,李瑞江,李少奎,熊 文,林 广
(成都宏科电子科技有限公司,四川 成都 610100)
随着硅基集成电路的集成度不断提高,MOSTET的等效栅介质层厚度须不断减小。受隧道效应的影响,栅极漏电流将随氧化层厚度的减小呈指数增长,成为微电子进一步发展的限制性因素之一。采用高介电常数栅介质材料可以保证在相同的等效厚度的前提下,增加栅介质的物理厚度,由此减小直接隧穿电流。因此寻找新型的高介电薄膜材料已经成为微电子技术的研究热点之一[1-4]。
氧化铪(HfO2)因具有宽带隙(5.7 eV)、高介电常数(理论值25)、高击穿场强(理论值600 V/μm)等优势而得到大量的研究。但HfO2具有较高的氧扩散速度,导致其在硅界面易形成一层低介电常数的界面层,从而降低了其整体介电常数;同时其结晶温度较低,结晶度较高,导致电子易沿晶粒之间的晶界传输,从而引起了较高的漏电流密度和低击穿场强[5-6];另外,氧化铝(Al2O3)薄膜因其宽带隙(8.7 eV)、高化学稳定性、高击穿场强(理论值1000 V/μm)、与硅衬底的界面处有较小的界面态和较低的电荷陷阱密度等优点也得到了大量的研究,但Al2O3薄膜介电常数理论值仅为9,在替代传统介电材料时优势不明显[7-9]。
因此,许多研究者采用复合生长Al2O3/HfO2的方式制备了Al2O3/HfO2/Al2O3层压结构薄膜[10-12]。通过利用Al2O3代替HfO2与硅接触,避免了HfO2-Si 界面层的形成,同时充分利用Al2O3击穿场强较高的优点,提高复合薄膜的整体击穿场强。在这些研究中,通常采用原子层沉积技术(Atomic Layer Deposition,ALD)进行薄膜的生长,其优势在于可进行单原子层生长,精确地控制薄膜在单原子层水平连续地沉积,并可通过控制反应循环周期精确地控制膜厚。由于生长温度较低,ALD 技术生长薄膜一般是非晶态与微晶共存,可有效降低薄膜的结晶度[13-14]。但这种层压结构的新介质薄膜材料仍然未解决HfO2薄膜的结晶问题,导致其漏电流密度较高。
因此,本论文针对上述问题,将半导体行业中的超晶格结构创新地应用于Al2O3/HfO2复合薄膜的生长,采用ALD 技术制备超晶格Al2O3/HfO2纳米叠层复合薄膜,目的是通过叠层生长,使Al2O3和HfO2在材料内部形成异质结界面,增加界面极化,从而获得高介电常数;同时,利用叠层结构抑制HfO2薄膜结晶,降低结晶度,从而提高漏电流密度和击穿场强。
实验进行了不同单层厚度和不同Al2O3∶HfO2层厚比的Al2O3/HfO2叠层薄膜生长,并测试研究了其介电性能变化规律,分析了其微观机理;使用有限元模型计算纳米叠层薄膜的介电常数理论值,采用DFT 框架内的第一性原理方法,构建Al2O3/HfO2异质结并分析界面成键情况,对纳米叠层复合薄膜材料的界面极化机理进行了理论研究。
1 实验过程及结果
在本实验中,使用三甲基铝(TMA)作为铝源,四(乙基甲基氨基铪)作为铪源,高纯水蒸气作为氧化剂,高纯N2作为载气,在高导电p 型Si(100)衬底上制备了复合薄膜,Al2O3/HfO2交替叠层生长,最终形成超晶格结构纳米叠层复合薄膜材料,结构示意图如图1。实验分别对比了不同单层厚度、不同层厚比对复合薄膜材料性能的影响,实验分组情况如表1 所示。

图1 纳米叠层薄膜结构示意图Fig.1 Schematic of the nano-laminated film
薄膜的介电性能测试采用金属-氧化物-半导体(MOS)结构平板电容器模型。在生长好薄膜的硅片表面采用磁控溅射方法溅射Ti(50 nm)/Au(1500 nm),并在正面进行光刻和刻蚀,形成上电极,上电极图形尺寸为0.38 mm×0.38 mm,通过切割制成样品。
按图2 所示方法测试样品电容量、插入损耗、击穿场强、漏电流密度,并根据容量计算薄膜介电常数。介电常数计算公式为:
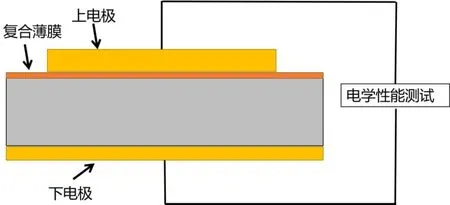
图2 测试结构示意图Fig.2 Schematic of the test structure

式中:ε为介电常数;C为电容量;d为薄膜厚度;k为常数,取0.00885;S为正对面积,取0.38 mm×0.38 mm。
采用Agilent E4980A 电容量测试仪测试薄膜样品的电容量和插入损耗,测试频率1 kHz,测试电压1 V,并根据测试结果计算得出薄膜的实际介电常数,结果如表1 所示,表中数据为20 只样品平均数据。采用高精度的Kekhley 4200-SCS 测量得出薄膜的I-V曲线,并计算其击穿场强和漏电流密度。击穿场强测试步进1 V,采用20 只样品平均值计算击穿场强,测试结果如表1 所示;漏电流密度数据步进0.2 V,测试终点为3 V,漏电流密度-电压(J-V)特性曲线如图3所示。

表1 样品分组及测试数据Tab.1 Sample grouping and test data

图3 漏电流密度-电压特性曲线。(a)不同单层厚度时;(b)不同层厚比(Al2O3 ∶HfO2)时Fig.3 J-V curves.(a) Different single layer thicknesses;(b) Different layer thickness ratios (Al2O3 ∶HfO2)
2 实验结果讨论与分析
2.1 不同单层厚度对纳米叠层复合薄膜的影响
实验对比了叠层结构中不同的单层厚度对复合薄膜介电性能的影响,实验结果显示,介电常数随着单层厚度的增加而下降,当单层厚度为0.1 nm 时,介电常数为18.33(1#),当单层厚度增加到0.6 nm 时,介电常数为13.55(4#)。这主要是由于Al-Hf 原子对电子束缚能力差异使得Al2O3/HfO2界面处束缚了一定量的电子,增加了介质材料在电场中的极化效应。薄膜总厚度保持不变,单层厚度越小,Al2O3/HfO2界面越多,界面极化效应越强,介电常数越大。
击穿场强测试结果表明,击穿场强随着单层膜厚升高而降低,当单层厚度为0.1 nm 时,复合薄膜材料的击穿场强为936 V/μm,远高于纯HfO2薄膜,接近纯Al2O3薄膜。当单层厚度为1 nm 时,击穿场强为666 V/μm。所有复合薄膜击穿场强均高于纯HfO2。这是由于随着单层厚度的降低,打破了HfO2长程有序的结晶结构,结晶度降低,抑制了电子随HfO2晶粒之间的晶界传输的可能,从而提高了击穿场强。
复合薄膜材料的漏电流密度随着单层厚度降低而降低,由图3 可知,单层厚度为0.1 nm 的复合薄膜呈现出较小的漏电流密度,当电压为3 V 时,漏电流密度仅为2.57×10-10A/cm2。所有的复合薄膜与纯Al2O3薄膜、纯HfO2薄膜对比,均显示出较低的漏电流密度。实验结果表明,纳米叠层结构能较好地提升复合薄膜的介电常数、击穿场强和漏电流密度性能。
采用透射电镜(TEM)对1#样品和5#样品的横截面介质和结晶情况进行了分析,如图4。结果显示,单层厚度为0.1 nm(1#样品)时,复合薄膜的平整性较高,薄膜内未观察到明显的微晶或者分层结构;而当单层厚度为1 nm(5#样品)时,薄膜出现了明显的畸变,平整度降低,并可以观察到明显的分层情况及局部结晶。证明降低单层厚度,可有效降低复合薄膜的结晶度,提高综合介电性能。
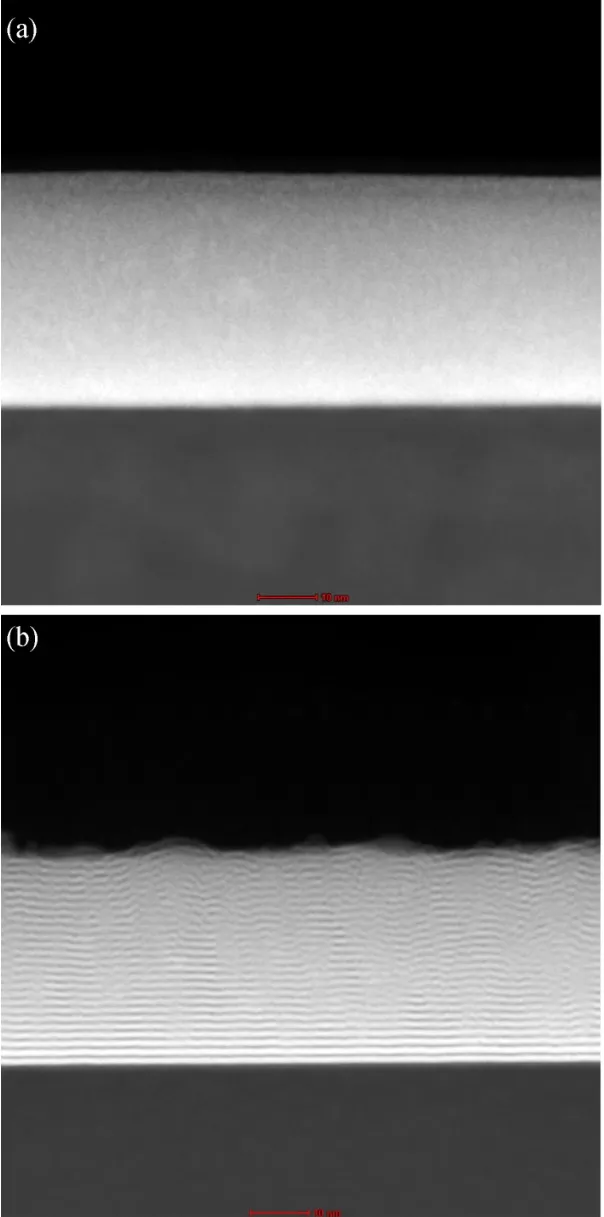
图4 透射电镜图。(a)1#样品;(b) 5#样品Fig.4 TEM images.(a) 1# sample;(b) 5# sample
2.2 Al2O3 ∶HfO2层厚比对纳米叠层复合薄膜的影响
实验对比了Al2O3∶HfO2的层厚比对复合薄膜介电性能的影响,实验结果显示,随着层厚比的下降,复合薄膜介电常数明显上升,当层厚比为3 ∶1 时,介电常数为9.65,当层厚比为1 ∶3 时,介电常数为22.87。复合薄膜的击穿场强随层厚比的下降而出现明显下降,当层厚比为3 ∶1 时,击穿场强为975 V/μm,当层厚比为1 ∶3 时,击穿场强降低至600 V/μm 以下。复合薄膜的漏电流密度随着层厚比下降而增大,但复合薄膜的漏电流密度均小于纯HfO2薄膜的。这是由于HfO2的介电常数高于Al2O3,但抗电强度和漏电流密度性能低于Al2O3,随着层厚比的下降,HfO2的含量增高,介电常数增加,漏电流密度增大。
2.3 纳米叠层复合薄膜界面极化机理探究
为了进一步探究纳米叠层结构对复合薄膜的介电性能影响的微观机理,建立理论模型对薄膜的介电常数等进行计算验证,以能更好地为后续的纳米叠层结构的性能优化和提高提供理论基础。
将薄膜材料视为电容器,电容器模型(如图5)为一标准电容器的电位势分布,两电容极板之间填满复合介质材料。坐标的选取为z轴垂直于电容板,x轴沿电容板方向,在垂直于纸面方向足够长,因此,可以简化为一个二维问题。两板之间的距离为d,板长为1。两电容板之间的电场的电位势函数φ满足拉普拉斯方程:
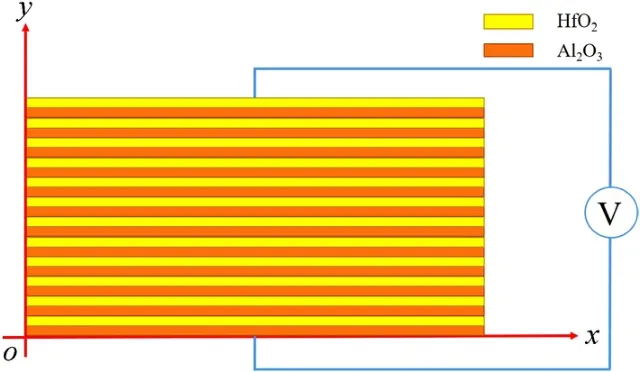
图5 复合介质材料电容器模型Fig.5 Composite dielectric material capacitor model


式中:V为加在电容器复合介质两端的电压;ε1、ε2分别为Al2O3和HfO2的介电常数,取ε1=9,ε2=25;n为复合介质材料边界的法线方向。边界条件(3)表示一个异质结底部电位势为0,则异质结顶部的电位势为V。边界条件(4)表示在复合电介质之外区域的电场强度为0。边界条件(5)表示在两种材料的交界处的电场强度相等,τ为两种材料的边界。
用有限元法求解上述边界问题,采用四节点四变形单元对分析的区域进行离散,从控制微分方程和边界条件出发,可以导出如下的有限元计算格式:

式中:φe为单元节点的电位势;e表示单元;Ke为单元刚度矩阵,可得:

其中:


式中:Ni为形函数。将各单元方程进行组集,可以得到用有限元计算的总体方程,将边界节点上的电位势代入并求解方程得到板间区域的电位势。
沿z方向的电场强度可以表示为:

储存在电容板上的电荷量为:

式中:A为电容器的面积。复合介质材料的等效介电常数εeff为:

考察Al2O3、HfO2介质材料交替叠层不同厚度、不同层厚比对复合介质材料介电常数的影响,计算结果与实验结果对比如图6 所示。结果显示,随着单层厚度降低,介电常数理论值逐渐增加,单层厚度为1 nm 时,介电常数理论值为12.81230;单层厚度为0.1 nm 时,介电常数理论值为18.15910;随着层厚比的降低,介电常数理论值逐渐增加;实验结果与理论计算结果基本一致,证明了计算结果的可靠性。

图6 理论与实验结果对比。(a)不同单层厚度时;(b)不同层厚比时(Al2O3 ∶HfO2)Fig.6 Comparison of theoretical and experimental results.(a) Different single layer thicknesses;(b) Different layer thickness ratios(Al2O3 ∶HfO2)
为了进一步分析多层复合介质材料界面结构,采用DFT 框架内的第一性原理方法,通过构建Al2O3/HfO2异质结几何结构和界面电子特性分析原子间成键情 况,利 用 VASP (Vienna Ab -Initio Simulation Package)软件结合投影缀加平面波方法对Al2O3/HfO2异质结构进行几何结构优化,将二者(110)面结合,搭建异质结,计算差分电荷密度和巴德电荷,得到在成键和成键电子耦合过程中的电荷移动以及成键极化方向等性质,判断界面的结合方式。基于VASP 软件结合投影缀加波(PAW)方法,交换和关联电势使用广义梯度近似(GGA) 下的 PBE (Perdew -Burke -Ernzerhof)函数。平面波截断能取为500 eV,结构优化被执行直到能量和力的收敛标准分别达到1×10-6eV和0.2 eV/nm,几何优化被终止。
α-Al2O3晶格常数a=b=0.47607 nm,c=1.2997 nm,六方晶系。HfO2则选择与α-Al2O3晶格常数失配率最低的立方晶系搭建模型,HfO2立方晶系晶格常数a=b=c=0.5115 nm。HfO2结构的(110)面是一个稳定的非极性表面,具有较小的表面能,利用Al2O3和HfO2的(110)表面构筑异质结构。构筑了一个八层Al2O3的结构模型,晶格常数为a=1.1612 nm,b=0.7287 nm,c=2.2000 nm 形成一个新的晶胞。以此匹配HfO2(110)面,两者之间的晶格失配率小于2.1%。为了获得更加准确的微观电子结构,对没有周期性的两个边缘原子固定后进行结构优化,得到图7 所示的异质结结构图。

图7 Al2O3/HfO2异质结结构图。O: 红;Al: 蓝;Hf: 黄Fig.7 Al2O3/HfO2 heterostructure diagram.Red: O;Blue: Al;Yellow: Hf
通过计算三维差分电荷密度分析Al2O3/HfO2异质结的结构界面间的电荷转移情况,结果如图8 所示。电子积累区用黄色显示,而电子损耗区则用青色表示。电荷密度的重新分布主要出现在Al2O3/HfO2界面附近,深入到介质膜内部的电荷密度也出现了较小程度的变化。这一现象的出现主要归因于Al2O3/HfO2界面处Al、Hf 原子通过共用O 原子形成共价键,Hf 原子半径大,对最外层电子束缚能力较弱,因此在异质结附近Hf 原子更容易失去原子,Hf 原子附近更多的电子云向O 原子偏移。而Al 原子对电子的束缚能力较强,界面处电子云无明显偏移。

图8 Al2O3/HfO2差分电荷。红: O;灰: Al;黄: Hf其中黄色和青色区域分别表示电子积累和电子损耗Fig.8 Al2O3/HfO2 differential charge.Red: O;Grey:Al;Yellow: Hf.Where the yellow and cyan regions represent electron accumulation and electron loss,respectively
进一步的,利用巴德电荷分析定量地计算了Al2O3/HfO2界面处的电荷转移和分离。结果显示在Al2O3/HfO2界面附近大约有0.2989 eV 的电子从HfO2层转移到Al2O3表面。由于Al2O3和HfO2晶体结构的差异,Hf 原子在异质结附近失去电子,且距离异质结距离越远的Hf 原子失去越多的电子数量。当电子转移达到平衡态时,异质结附近存在未配对的电子,净电荷的积累导致在Al2O3/HfO2界面处形成了一个内建电场,内建电场的方向垂直于界面并从Al2O3表面指向HfO2表面,如图9 所示。Al2O3/HfO2界面处内建电场的存在增加了介质材料在电场作用下的极化效应,从而提高了复合介质材料的介电常数。

图9 Al2O3/HfO2界面内建电场Fig.9 Electric field at Al2O3/HfO2 interface
3 结论
采用ALD 技术生长了Al2O3/HfO2纳米叠层复合薄膜,并研究了复合薄膜的单层厚度和层厚比对介电性能的影响规律。应用有限元模型模拟计算了复合薄膜的介电常数变化规律,并采用DFT 框架内的第一性原理方法,构建Al2O3/HfO2异质结几何结构和利用界面电子特性分析原子间成键情况,解释了复合薄膜介电常数变化的内在原因。
实验结果表明,相对于纯Al2O3薄膜和HfO2薄膜,复合薄膜显著提高了其综合介电性能;随着复合薄膜单层厚度的降低,其综合介电性能明显提升;复合薄膜层厚比的提高有利于其击穿强度和漏电流密度的提高,但不利于其介电常数的提高。复合薄膜击穿强度和漏电流密度变化的原因,主要是由HfO2结晶造成的,因此想要提高复合薄膜的介电性能,应尽量避免HfO2薄膜的结晶。
有限元模型模拟计算的复合薄膜介电常数的变化规律与实验实测数据基本一致,第一性原理方法计算表明,Al2O3/HfO2界面存在内建电场,增加了介质材料在电场作用下极化效应,从而提高了复合介质材料的介电常数。这也解释了复合薄膜单层厚度降低导致介电常数增加的原因,因为单层厚度降低,薄膜的异质结界面数量增加,极化效应增强,整体介电常数增加。
本文采用叠层复合生长的方式制备出全新的高介电薄膜材料,为后续器件微型化的发展创造了条件;另外,通过叠层生长不同材料形成异质结以提高综合性能的思路对后续的介质薄膜开发具有重要意义。
