光刻掩模版的低温气溶胶清洗探究
2022-09-09熊启龙
魏 晖,吕 磊,熊启龙
(1.合肥清溢光电有限公司,安徽 合肥 230011;2.中国电子科技集团公司第四十五研究所,北京 100176)
由于器件特性的收缩以及新材料新工艺的引入,集成电路器件的制造变得越来越复杂。光刻工艺一直处于制造技术进步的前沿。光刻技术的发展和需要在晶圆上印刷的特征尺寸的缩小使清洁技术成为先进掩模制造商面临的最前沿挑战。193 nm光刻技术将光学光刻技术的使用扩展到45 nm技术节点,超过此技术节点,将使用极紫外(EUV)光刻技术进行图案制作。
用于193 nm光刻的掩模版交替相移和衰减相移技术,以提高在硅片上光刻的图形质量。交替相移技术使用铬基光掩模,而衰减相移使用石英上的MoSiON层。MoSi相移层具有不同于铬二元掩膜层的化学和物理性质,使得不同类型掩模的颗粒去除具有挑战性。
传统的清洁方法是使用过氧化硫酸混合物(SPM)进行湿法清洁,以去除有机污染物,并使用标准清洁剂(SC1和SC2)去除颗粒和金属污染物。光刻掩模版上的大多数颗粒缺陷为硫酸铵和三聚氰酸,这主要是由SPM和SC1清洁剂中残留的铵离子和硫酸盐离子以及水中的CO2形成。这些缺陷也被称为渐进性缺陷,因为基于硫酸铵和三聚氰酸的缺陷会随着时间的推移而增长,从而导致十字线质量的灾难性退化。尽管这些渐进性缺陷在248 nm波长处可见,但在193 nm及以下的曝光波长处,其更为严重,此时光子被高度激发,同时过渡到300 mm晶圆需要光刻掩模版承受比200 mm更长的曝光时间。衰减型和铬基光掩模都存在这种薄膜下的缺陷。膜内空间可以捕获基于硫酸铵和三聚氰酸的分子污染物,并为它们提供反应和沉积在掩模表面的机会。
当前湿法清洗技术的另一个问题是SC1腐蚀石英表面,导致表面粗糙度增加。一些研究表明使用SPM会在相移角和透射率方面产生相对较大的变化。因此,需要从光掩模中去除纳米级关键缺陷、因长时间暴露于较短波长的光而随时间增长的渐进缺陷、使用具有各种不同物理和化学性质的膜的组合,因为需要在不影响掩模光学特性的情况下进行清洁,所以研究了替代清洁技术。
1 CO2低温气溶胶清洗机理
CO2低温清洗是一种干洗技术,其中颗粒去除主要通过动量转移进行。在5.8 MPa和25℃的压力下,使用来自钢瓶的净化液体CO2完成清洁。CO2的压力-温度相图如图1所示。液态CO2通过一个特殊设计的喷嘴膨胀到一个保持在大气压力下的清洁室中。通过喷嘴孔的膨胀和随后的焦耳-汤姆逊冷却导致CO2压力和温度降至三相点以下。CO2的相点沿着固体和蒸汽之间的边界移动,从而在高度定向和集中的气流中形成固体和气体CO2的混合物。完成表面清洁有4种机制:(1)低温颗粒的动量传递,以克服污染物颗粒对表面的粘附力;(2)气态CO2的阻力,以去除基底上脱落的颗粒;(3)由于低温颗粒升华并伴随体积膨胀而产生的局部力;(4)在低温颗粒和表面的界面处形成的液体CO2溶解有机污染物。干燥的低温清洗技术不会在清洗后腐蚀表面,导致表面粗糙。此外,由于清洁机制与膜的表面张力无关,因此它对在相移和EUV掩模中可能遇到的各种亲水和疏水膜有效。

图1 CO2压力-温度图
2 清洗机理与颗粒去除模型
2.1 低温气溶胶向掩模表面传输机理
对低温颗粒输送至污染颗粒位置的理论以及随后的污染颗粒去除机理进行了概述。在低温气溶胶清洗方法中,在清洗点的掩模版表面上形成气体边界层。由于气体流经掩模版表面上方的喷嘴,因此产生了边界层。气流中夹带的固体气溶胶颗粒必须穿过该层到达表面并去除污染物颗粒。在气体穿越边界层的过程中,由于边界层中气态CO2的阻力,低温粒子的速度降低。速度弛豫时间ξ(ps)为:

式(1)中,r为低温粒子的半径;
Pp为低温颗粒的密度;
Η为CO2气体的黏度;
Cc为坎宁安滑动连接系数:

式(2)中,P为绝对;d为低温颗粒直径
式(1)表明,如果低温粒子穿过边界层所需的时间相当于一个弛豫时间,那么它的速度将降低到初始速度的36%。该式还表明,较大的低温粒子的弛豫时间增加,这意味着它们可以以较大的初始速度穿过边界层。根据雷诺数和喷嘴速度计算了掩模版表面CO2气流产生的边界层。图2显示了低温粒子以45°角穿过50μm厚度边界层的速度分布,并表明,大于0.5μm的颗粒可以以大于初始速度36%的速度穿过边界层。

图2 低温粒子速度与穿过
掩模版表面气体CO2形成的边界层时的尺寸有关。lξ的速度松弛用14.4 m/s处的直线表示。因此,低温气溶胶清洗中的边界层起到了降低碰撞气溶胶粒子速度的作用。然而,计算结果表明,颗粒大于0.5μm的气溶胶流的很大一部分能够以大于初始速度36%的速度穿过边界层。2.2节予以说明,14.4 m/s的速度足以通过动量转移去除污染物颗粒。
2.2 低温气溶胶清洗中颗粒去除机理
空气中表面上的颗粒会经历几种不同的粘附力。这些力包括范德华力、库仑镜像力、电子双层力和毛细管力。范德瓦尔斯粘附力还包括由颗粒压力引起的变形力。在空气介质中,硅颗粒在硅衬底上粘附力的相对大小如图3所示。该图表明,对于亚微米颗粒,毛细力是迄今为止最大的力,其次是变形产生的范德华力和电子双层力。从图3中可以看出,对于亚微米颗粒粘附,库仑镜像力可以忽略。在CO2低温系统中,氮气吹扫用于将处理室保持在露点低于-40℃的低湿度。因此,对污染物颗粒的粘附力没有显著影响,在随后的CO2低温气溶胶颗粒去除分析中被忽略。因此,在这种清洁方法中,范德华力和电子双层力是主要的颗粒-基底粘附力。
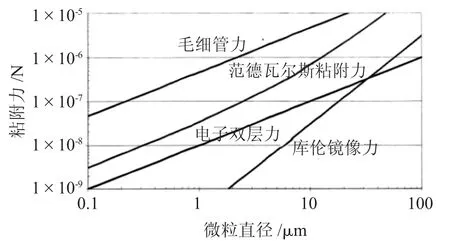
图3 硅颗粒与硅片在空气中粘附力的比较
使用颗粒粘附和去除模型进行计算,以确定去除给定直径的污染颗粒所需的低温颗粒尺寸。图4显示了计算结果,且低温粒子的初始速度为40 m/s。图4显示为了去除大于20μm的污染颗粒,需要大于2μm的低温颗粒,因为它们具有克服此类污染颗粒粘附力的动量。另一方面,亚微米颗粒需要大于0.5μm的低温颗粒才能有效去除。因此,与大颗粒相比,去除较小污染颗粒的最小气溶胶颗粒尺寸减小。这意味着去除亚微米颗粒时,气溶胶颗粒可用光谱变得更大。因此,理论上此类颗粒的去除效率应该更高。第三节对颗粒去除实验方法和结果的描述,用来验证其理论模型,以确定光掩模中不同污染物的清洗效率。

图4 去除给定尺寸的污染颗粒所需的最小低温颗粒尺寸
3 实验描述
在实验室中分别用两个实验对掩模版的清洗进行验证,研究了CO2清洁剂的除雾效果及其对掩模相位和透光率的影响。以沉积在裸硅的光刻掩模版表面的氮化硅颗粒为清洗研究对象进行实验,以验证图6中的两体碰撞模型预测。使用的光刻掩模版表面首先由KLA Tencor SP1进行扫描,以确定粒子和缺陷的初始数量,并使用小于100个大于0.12μm粒子的掩模版进行这些实验。然后用去离子水冲掩模版,并在旋转处理器中旋转干燥。SP1用于确定掩模版上的粒子数。所有的实验都是用200 mm的掩膜版完成。SP1扫描在掩模版的整个表面上进行,且排除了掩模版四周3 mm的无效区域。然后将经过上述方式前处理的光刻掩模版储存48 h,然后在Waferclean 1600TM中进行低温清洗。整个200 mm掩模版上的低温清洗时间约为1 min。使用SP1低温清洗对掩模版进行扫描。颗粒去除效率(Qpre)是根据清洁去除的颗粒数量与湿法沉积的颗粒数量之比计算得出。
在这些实验中,我们使用了透射率为6%的衰减相移掩模(att-PSM)。为了测试低温清洗的雾状物去除效率,使用湿清洗工具上的改进配方测试光刻掩模版上产生雾状物缺陷。该改良配方导致掩模版表面上残留高浓度硫酸盐离子。因此,混浊缺陷的增长速度比在普通掩模版上快得多。在烟雾缺陷生长后,在Maskclean 150中进行低温清洗。在低温清洗前和清洗后,通过KLA-星光检查系统对掩模进行扫描并记录缺陷。
在多次清洗前后,还测量了另一个掩模的相位和透射率。进行多次清洗的原因是允许累积效应,便于获得更好的灵敏度。使用Lasertec MPM-193工具作为测量工具。
4 结果与讨论
图5显示了通过CO2低温清洗对氮化硅颗粒的预处理。实验中使用的氮化硅颗粒通过第3节概述的工艺湿沉积在裸硅晶片上,由于随后的干燥,使其更难去除。清洁前后4个晶圆上的颗粒数量在每个晶圆对应的MG棒顶部的柱形图中表示。每个晶圆的Qpre绘制在x轴上。图5显示4个晶圆在0.15~30μm的尺寸范围内的平均预处理率为99.1±0.12%。图6显示了在0.15~30μm的尺寸范围内,Qpre作为氮化硅颗粒尺寸的函数。0.15~1μm颗粒的预估计算值为99.1%,在1~30μm的粒径范围内,预估计算值将降至89.2%。通过Student t检验确定两种尺寸范围内去除效率差异的显著性。统计检验的p值<0.001,表明在95%置信水平(CL)下,较低粒径范围和较高粒径范围内的去除效率之间存在统计显著差异。理论模型的结果表明(见图5),对于亚微米级污染颗粒,最小低温颗粒尺寸为0.5μm,对于最大30μm的污染颗粒,最小低温颗粒尺寸增加到2.1μm。因此,与较大尺寸的氮化硅颗粒相比,亚微米颗粒具有更高Qpre值,理论预测得到了在裸硅片上湿沉积氮化硅颗粒的实验证据的支持。

图5 裸硅片中氮化硅颗粒的去除效率

图6 氮化硅颗粒的Q pre随颗粒尺寸的变化
使用CO2低温气溶胶技术清洁掩膜版的结果如图7所示。图7中的两张AFM照片显示了石英修复过程后光掩膜的清洗前后形态。机械修复过程中石英上产生的缺陷如图7(a)所示;在Rave纳米加工修复过程中产生的颗粒似乎已被去除,且未对铬层造成任何损坏,如7(b)所示。这种使用CO2低温技术的修复后清洁应用已在光刻掩模版制造中成功商业化。

图7 掩模版清洁结果
使用Lasertec MPM-1 93工具测量清洗引起的相位和传输变化,结果如表1所示。每个传输和相位数据点是同一点上多个测量值的平均值。因此,它们中的每一个都带有一个3σ值,如表1所示。尽管我们已经累积了16个周期的清洁效果,但变化量几乎不在测量重复性水平。这表明,低温清洗对att PSM的传输和相位影响最小,即使在清洗周期明显大于从掩模版表面去除颗粒和其他渐进性缺陷所需的周期数。

表1 16次累计清洗循环前后掩模版相位和传输变化的测量结果
5 结 论
需要在不对底层薄膜、掩模版的光学特性或产生渐进性缺陷的情况下,去除高级光掩模版中的亚微米和纳米尺寸缺陷。在现有湿法清洗技术缺乏更好解决方案的情况下,行业继续研究新的清洗技术,以满足去除高级光掩模版中的亚微米和纳米尺寸缺陷要求。其中一些新技术正处于开发阶段,而另一些则更接近商业化。CO2低温清洗技术已成功商业化用于修复后清洁,并正在研究去除颗粒和渐进性缺陷。研究表明,去除渐进缺陷和亚微米颗粒是可能的,不会显著影响掩模的光学特性,如相位损失或传输。因此,清洗技术非常适合于掩模版清洗,并且应考虑用于先进的掩模版生产过程。
