微波毫米波T/R组件内键合引线熔断机理研究*
2022-07-02王越飞顾春燕张兆华
王越飞,顾春燕,张兆华
(南京电子技术研究所,江苏南京210039)
引 言
在微波毫米波多通道收发组件中,大量采用引线键合技术实现组件电学性能。键合引线承担了内部射频信号传输、大电流传输等重要任务[1-2],其可靠性将直接影响组件的电学性能,并决定了雷达装备的服役寿命。
影响键合引线可靠性的因素很多,如键合工艺参数[3]、焊盘洁净度[4]、外部力学环境因素[5]等。这些因素中,键合引线的耐电流水平至关重要,过电流如果超出引线耐受能力,将导致引线熔断、信号丢失,最终导致组件失效。因此,在组件设计之初,便要充分考虑链路的耐电流水平,如增加键合引线根数进行冗余设计、使用大直径粗引线以提高单根引线耐电流能力等。然而,现有能够为设计提供耐电流水平参考的数据主要来自引线生产厂家,通常局限于某一特定弧长引线的耐电流水平,不能够覆盖组件内部的各种引线长度需求。并且,目前的文献大都针对集成电路芯片内部金属互联线的迁移失效[6-7]以及互联凸点的迁移失效[8]开展机理研究,对引线熔断机理的分析未见报道。
因此,本文将结合雷达微波组件的实际键合需求,开展键合引线耐电流水平研究,并深入分析引线熔断机理,探讨引线熔断的微观过程,为电讯设计提供数据和理论参考。
1 试验方案
选取某型微波T/R组件产品,在组件矩形连接器与低温共烧陶瓷(Low Temperature Co-fired Ceramic,LTCC)基板之间通过楔形键合工艺完成引线。选用金带(152.4 μm(宽度)×12.7 μm(厚度)规格)/金丝(25.4 μm 直径规格)作为研究对象,纯度均为99.99%,延展率为1%~2.4%,键合设备为Westbond 7476E。通过键合设备送丝参数控制金带/金丝弧长,在矩形连接器插针和LTCC焊盘之间键合金带/金丝,对电源、电流表、负载以及组件组成的回路实现连通。通过调节电源电流水平测试不同弧长金带/金丝的耐电流能力,并分析熔断过程,开展熔断机理研究。熔断电流测试电路结构如图1所示。
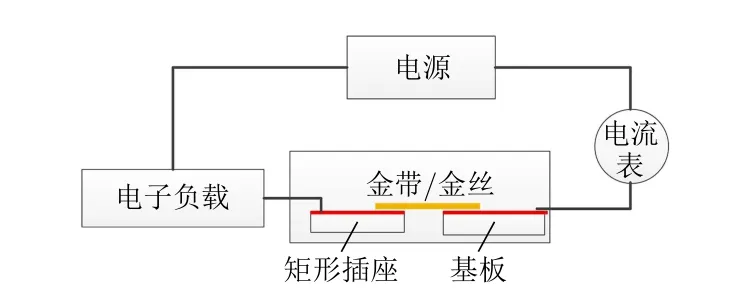
图1 熔断电流测试电路结构
2 试验结果
在光学显微镜下实时观察大电流瞬间金带的熔断过程发现,随着所施加的电流不断趋近熔断电流,金带中间部位逐渐变红,表明此处温度逐渐升高,到达熔断电流值时,温度最高部位立刻熔断。金带中间位置断裂后呈球状,如图2所示。测量不同长度金带/金丝的熔断电流水平,数据见表1。
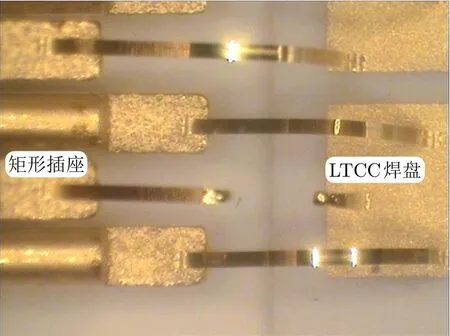
图2 金带熔断后的光学显微镜照片

表1 熔断电流数据
金带/金丝熔断电流与弧长关系曲线如图3所示。由图可见,随着弧长的增加,金带/金丝熔断电流水平逐渐降低,降低幅度逐渐减小并趋于稳定。金带长度为2.5 mm典型值时,熔断电流约为3.2 A,金丝长度为1.5 mm典型值时,熔断电流约为1.6 A。
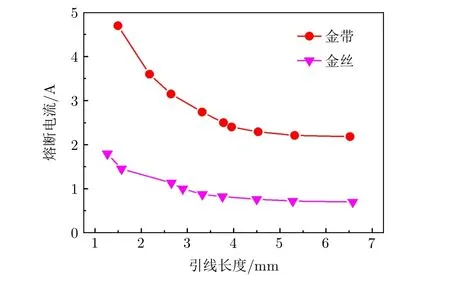
图3 金带/金丝熔断电流与弧长关系曲线
进一步观察引线在低于熔断电流的恒定电流下,表面状态随时间的变化情况。图4为金带在1.5 A恒定电流下经历6个时刻(0~290 h)的光学显微镜照片,金带尺寸为152.4 μm(宽度)×12.7 μm(厚度),金带弧长为4.0 mm。随着时间的推移,金带中间部位逐渐变得粗糙、凹凸不平,颗粒状逐渐明显,并逐渐变细,最终在约290 h时金带熔断。
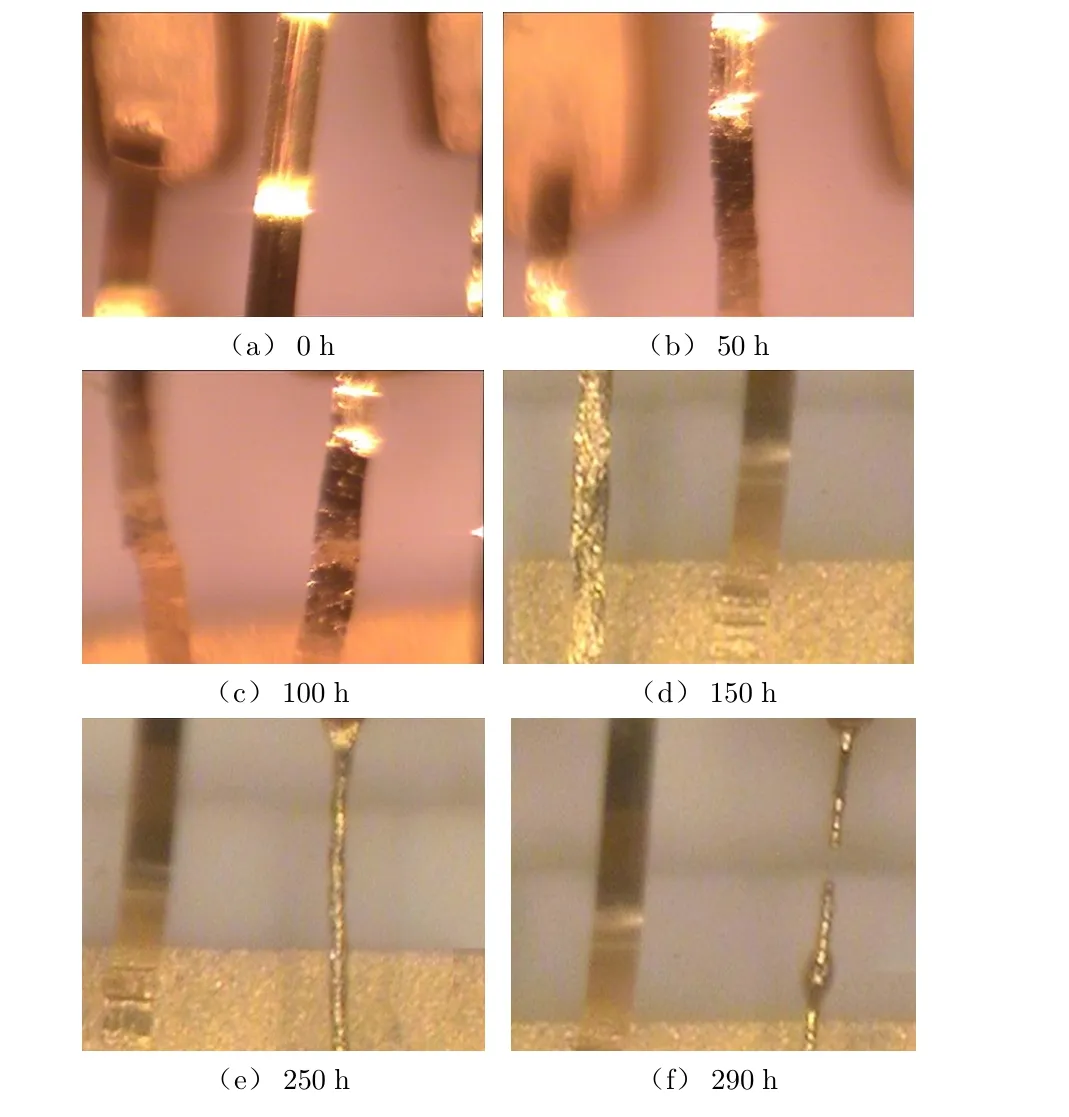
图4 恒定电流下金带表面形貌随时间的演变
3 机理分析
前人通过对集成电路芯片内部金属互联线迁移失效[6-7]以及互联凸点迁移失效[8]的机理分析,认为金属互联线在施加大电流时,内部将产生很高的电子流定向移动,在运动的过程中,电子的动能不断传递给附近的金属原子,导致金属原子沿着电子流移动的方向产生定向迁移,即原子的电迁移现象。电迁移现象通常表现为原子向同一方向移动,造成相反方向的原子数越来越少,而相同方向的原子则不断堆积。在倒装凸点焊接界面[9-10]处,该现象尤为明显,因界面处通常存在界面电阻带来的电子流堆积,造成电子流密度急剧上升,从而加快该部位的电迁移。
然而,本文金带熔断的位置均处于金带中部,界面电阻效应影响微弱,表现为金原子向两边迁移造成金带断裂,与电迁移导致的断裂现象完全不同。与此同时,中部位置的金带热量散发途径主要通过两端金带传导进入基板焊盘,因而此处在施加大电流时产生的温度最高,温度梯度从金带中部向金带两端至基板焊盘逐渐降低。温度较高部位的金原子拥有较高的动能和界面反应能[11],驱动金原子沿着温度梯度降低的方向迁移,从而产生原子的定向质量迁移,表现为金带中部的原子向两边扩散,在温度达到极值时,扩散剧烈发生,最终造成金带从中间断开。
进一步分析导致金原子热迁移的机理发现,在金带温度升高的过程中,由于金的化学性质极其稳定,不会与外界气氛发生化学反应,除了从金带两端至键合焊盘向外传导热量外,还可以通过外界气氛热传导和热辐射两种途径向外界传递热量。热辐射能够传递的热量微乎其微,外界气氛(如空气或氮气等)的热传导能力远低于两端金带和键合焊盘,所传递的热量只占很小一部分,因此散热的主要途径仍然是两端金带和键合焊盘。
本文进一步研究了外界气氛环境对金带熔断过程的影响,设计试验如下:
1)在组件壳体矩形插座位置键合若干金带,金带尺寸为152.4 μm(宽度)×12.7 μm(厚度)。设定约4.0 mm和2.5 mm两种弧长规格的金带,通过调节电源电流水平测试金带耐电流能力。
2)首先在大气气氛中,通过恒定电流源分别向两种规格金带施加电流,测得金带的熔断电流。
3)在真空腔室内进行同样的加电试验,真空腔室的真空度约为1×10-5Pa。
4)金带熔断后将其拔去并重新键合,再次进行试验,多次测量求平均值。
试验结果如图5所示。键合金带长度存在一定的涨落,对熔断电流有一定影响,图中画出了电流水平分布。分析可知:1)同样的气氛条件下,短金带的熔断电流明显高于长金带,该结论与图3结果一致;2)无论是长金带还是短金带,大气气氛下的熔断电流均略微高于真空气氛条件下。
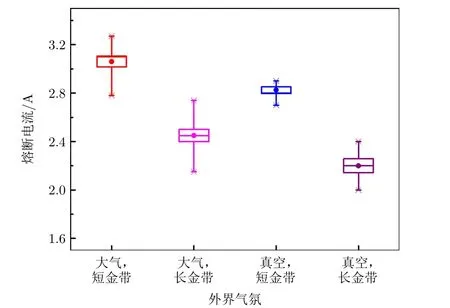
图5 金带熔断电流水平与外界气氛关系
以上两点现象表明:1)长金带中间区域离两端键合焊盘较远,热传导效率较低,金带中间部位温度上升较快,因而熔断电流减小。2)真空气氛下通过外界气氛进行热传导的途径被关闭,热传导能力有一定程度的降低,因而造成同样规格金带的熔断电流略微减小。航天产品需特别注意此问题,因在外太空环境中,当组件内部预充气氛逐渐泄露至真空时,内部引线的过电流能力降低,键合引线的使用寿命降低。
经过以上分析,可以认为在加电过程中,金带中间部位的焦耳热量不断累积,造成金原子向两端迁移,金带熔断是焦耳热造成的原子热迁移现象。
4 结束语
本文研究了在雷达微波组件中广泛应用的键合引线的熔断机理,设计了专用测试回路考察不同弧长引线的熔断电流,并深入分析了引线熔断的微观过程。
键合引线熔断电流水平与引线长度有关,随着弧长的增加,电流水平逐渐降低,并且降低幅度逐渐减小,趋于稳定。键合引线熔断电流水平与外部气氛有关,大气气氛下的熔断电流略微高于真空气氛条件下,为航天产品的设计提供重要依据。键合引线的熔断过程是焦耳热引起的原子热迁移现象。
后续将深入研究键合引线熔断机理,建立熔断加速寿命模型,考察引线在恒定电流下的特征寿命,为设计提供更加丰富的数据参考。
