激光退火硅晶圆温度场分布的数值模拟研究
2022-06-09王文武
刘 敏,郑 柳,何 志,王文武
(中国科学院微电子研究所,北京 100029)
1 引 言
激光退火(LA)工艺是采用激光作为热源对材料进行加热的一种退火方法,相比于传统退火工艺,比如管式炉退火、快速热退火(RTA)等,具有以下几点明显优势:①高温作用时间短,通常为纳秒或微秒量级,在用于注入杂质激活的时候可以大幅度减少杂质扩散,避免杂质浓度再分布问题;②加热深度浅,只有被激光照射的面近表面几微米的深度内才会被加热到退火所需要的温度,而材料内部以及另一面可以保持在常温或较低温度状态下,不会对其上的器件结构造成任何影响;③LA工艺通常采用扫描方式进行,可以进行选区或定点位置退火。基于以上特点,LA工艺被广泛应用于半导体器件的制备中,尤其是在薄膜类、薄片类以及双面结构类器件中具有不可替代的应用优势,比如薄膜晶体管(TFT)[1-2],绝缘栅场效应管(IGBT)等[3-6]。
在一些器件结构中,为了实现高性能,需要进行较深的离子注入,比如硅(Si)基IGBT器件中的场截止层,它通常由磷(P)离子注入而成。场截止层的作用是截止器件漂移区的电场,其厚度越厚,掺杂浓度就越低,其中由集电极注入其中的少子寿命就会越长,从而电导调制效应越佳,器件的导通电阻就越低。但较深的离子注入增加了激光激活杂质的难度。据了解,目前日本制钢所株式会社采用808 nm红外激光与515 nm脉冲激光结合的退火方式实现了深达~2.5 μm的深P注入激活[7-8],而本团队前期采用808 nm激光成功实现了深达6μm的深磷注入激活。但这是基于625 μm厚Si晶圆的结果,退火薄片会直接导致碎片。而目前,1200 V的Si IGBT芯片厚度可以做到120 μm一下,650 V的更是不到70 μm[9]。要想在如此轻薄的晶圆上实验深注入激活,还有待进一步优化退火条件。
由于LA工艺对Si晶圆的加热是一种瞬态过程,加热过程在纳秒和微秒量级,在LA过程中测量Si晶圆内部温度分布十分困难。而且不同波长、不同脉冲宽度的LA的系统试验往往受限于实验条件无法全面展开。因此,对于如何选择激光条件以实现薄片上的离子注入激光激活工艺,仍然没有系统清晰的准则。为了解决这个问题,本文通过仿真研究了LA工艺中波长和脉冲宽度对Si晶圆中温度场分布以及非退火面温升的影响,旨在找出激活深度在1至10 μm范围内,LA工艺的最佳波长和相应的脉冲宽度,为薄片的LA工艺提供理论参考。
2 激光退火硅晶圆的物理模型
如图1所示,当一束激光照射到Si晶圆表面时,激光的能量会被表层硅原子吸收,转化为热量,从而使晶圆的温度升高,实现退火目的。
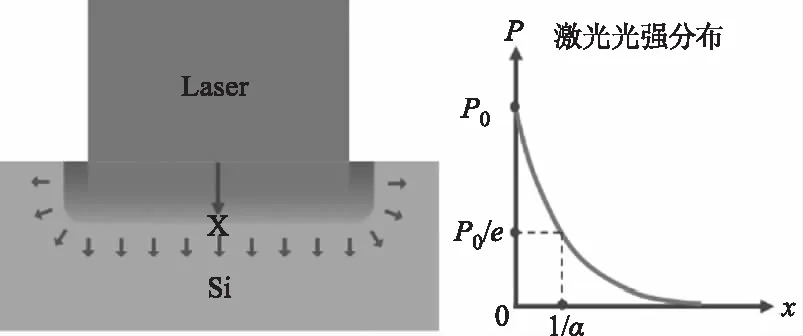
图1 激光退火硅晶圆示意图Fig.1 Schematic diagram of laser heating silicon
由于材料的吸收作用,激光光强在晶圆内部按e的负指数关系递减,具体可以表示为:
P(x,t)=P0(t)·exp(-αx)
(1)
其中,x为深度坐标,起始零点为晶圆表面,正方向沿激光传输方向指向材料内部;t为时间坐标;P(x,t)对应激光于t时刻在材料内部x深度位置的光强;P0(t)则为材料表面位置的激光光强;α是Si材料对激光的吸收系数,它的倒数1/α为穿透深度,表示激光光强下降为表面的1/e时所对应的深度。激光的波长不同,Si材料对其的吸收系数也不同。通常来讲,激光波长越长,硅材料对其的吸收系数越低,穿透深度也就越大。
由于Si材料表面对光存在反射作用,因此进入材料的激光强度相对于入射激光会有一定损失,它们满足公式:
P0(t)=P(t)·(1-R)
(2)
其中,P(t)为入射激光光强;R为Si材料表面对激光的反射率;(1-R)即表示进入材料内部的光强比例。
进入材料内部的激光会被Si晶格原子吸收从而转化成热量,热产生率可以用Q(x,t)表示,满足关系:
Q(x,t)=P(x,t)·α
(3)
联合公式(1)、(2)和(3)可得热产生率与入射激光光强的关系:
Q(x,t)=P(t)·α·(1-R)·exp(-α·x)
(4)
由此可见,热产生率在材料表面最大,在材料内部也是按照e的负指数关系递减。从而导致材料表面温度上升最快,随着深度的增加温度上升速度递减,会形成明显温度梯度。
有温度梯度就会发生热量传导,对于每一处Si材料,它的能量交换主要来自三个方面:①本身温度变化释放(吸收)的热量;②和周围材料进行热传导失去(吸收)的热量;③吸收激光的能量。这三者满足能量守恒定律,即:
(5)
其中,ρ,C和k是Si单晶材料的物理学参数:ρ表示密度;C表示热容;k(T)表示热导率,是关于温度T的函数。上式又名热流方程,等号左边项表示材料单元温度变化吸收(释放)的能量;等号右边第一项即为热传导转移的能量;最后一项为激光提供的能量。通过迭代法对热流方程(5)进行仿真运算,即可获得Si材料中温度T随时间和空间的分布情况。
当激光束的直径远大于加热深度时,热传导主要发生在垂直方向,水平方向的成分可以忽略不计。在实际应用中通常亦是如此。因此,上述所有方程只涉及了一个空间维度,本文所有的仿真计算也主要基于一维热流方程进行展开。
Si的LA工艺通常可以在空气中进行,当然也可以在惰性气体或真空中进行。由于空气的热导率较低,常温下只有0.024 W/(m·K),不及硅材料(142.2 W/(m·K))的1/1000,即使在1000 ℃的高温下,空气的热导率(0.076 W/(m·K))也只有Si材料(29.8 W/(m·K))的近1/400。因此,激光传递给材料的热量将主要在材料内部传导。本文基于一维热流方程的仿真也将采用绝热边界近似,不考虑样品表面与空气的热量交换。同时,初始温度设定为室温(27 ℃)。
LA过程在材料内部形成的温度场分布总是表面温度最高,随深度的增加递减,存在明显梯度。通过增加激光能量来提高整体材料内部的温度场分布可以使更深位置的材料加热到激活温度之上,从而有利于杂质的充分激活。但如果表面温度过高,超过了Si材料的熔点,被激光照射的区域就会融化。由于液体具有流动性,熔融表面在重新凝固后会出现明显起伏,平整度大大下降。同时液相下的杂质扩散速度远高于固相,熔融过的表面杂质浓度再分布现象十分严重,不利于器件制备。因此,将表面温度所能达到的峰值控制在Si材料熔点(1413 ℃)之下比较接近的位置最为理想。在本文的所有仿真中,将这一温度峰值设定为1410 ℃,并以此为基准拟合不同LA工艺条件下需要的脉冲能量以及对应的温度场分布情况。
根据实际使用的激光条件,仿真采用的激光束能量在空间上为均匀分布,时间上采用高斯分布近似,其中高斯分布的半高宽对应于激光脉冲的脉宽。下面就以一个波长为515 nm,脉宽为1 μs的激光脉冲辐照120 μm厚的Si晶圆为例说明其温度场随时间和深度的变化情况,分别如图2和图3所示。

图2 1 μs脉宽的515 nm激光脉冲波形以及辐照在120 μm厚Si晶圆上形成的表面温度变化Fig.2 Waveform of a 515 nm laser pulse with 1 μs pulse width and the surface temperature field induced by irradiation on a silicon wafer with a thickness of 120 μm

图3 1 μs脉宽的515 nm激光脉冲辐照120 μm厚Si晶圆形成的温度场分布Fig.3 Temperature field distribution of a 120 μm thick silicon wafer irradiated by a 515 nm laser pulse with 1 μs pulse width
基于前面声明的基准条件,要使120 μm厚的Si晶圆表面温度峰值达到1410 ℃,需要2.33 J/cm2的激光脉冲能量(Ed),对应的峰值功率密度可达2.2 MW/cm2,如图2中激光脉冲波形所示。在如此强烈的激光辐照下,Si表面温度仅需1.7 μs就可以从室温迅速上升至最大值。在峰值温度对应的时刻t0前,材料表面单位时间内吸收的激光能量大于向内部传到的热量,因此,温度迅速攀升。在t0时刻,材料表面吸收的能量与传导入内部的能量相同,温度达到最高值。而在之后的时间里,由于激光的功率迅速下降,热传导会占据主导,净能量开始减少,因此表面温度开始迅速下降。
在热传导的作用下,材料表层积累的热量向内部转移,材料表层温度逐渐下降,内部的温度会有所上升,最终温度分布曲线会趋于水平,如图3所示。晶圆背面的温度也会在温度场趋于均匀分布时达到最大值,即等于平均温度。由此可以通过数值计算平均温度的方法来获得背面的最高温度为:
(6)
其中,l为晶圆厚度,常数“27”表示室温。由此可见,背面的最高温度和施加的激光能量成正比,和晶圆的厚度成反比。考虑到在一些LA的应用中,晶圆的非退火面可能已经制备好了器件结构,比如Si IGBT的背面离子注入激活,在这种情况下,需要严格控制非退火面的温度以避免器件结构损伤。通常情况下,非退火面的温度保持的越低越好。因此,在本文的数值仿真分析中,将非退火面(本文中统称为背面)的温度作为一项重要参数来对比评估各种激光条件的退火效果。
同时,温度作为杂质激活最直接的影响因素,温度场分布曲线将是本文用来分析激光加热深度的重要依据。然而,由于LA过程是一个非稳态过程,每一瞬间的温度场分布都不相同,如图3中各时刻温度场分布曲线所示,任何时刻的温度场分布曲线都无法准确体现所有深度位置所能达到的最高温度水平。因此,为了更准确的标定加热深度,本文将提取各深度位置的最高温度合成曲线,用Tmax表示,如图3所示,基于此曲线进行对比与分析,来说明不同脉宽以及波长对激光退火对加热深度的影响。
3 不同激光条件对退火效果的影响
3.1 脉宽的影响
同样以波长515 nm的激光辐照120 μm厚的Si晶圆为例,图4给出了5个不同脉冲宽度的激光作用下的Tmax温度场分布曲线。由图可知,增加脉宽有助于实现更深的加热深度。当激光脉冲的宽设为10 ns时,加热深度仅为730 nm(@ 1000 ℃)。相比之下,当激光的脉冲脉宽拓展为100 μs时,加热深度可达近20 μm(@ 1000 ℃)。

图4 不同脉宽下的515 nm激光辐照在Si晶圆上产生的温度场分布(Tmax)Fig.4 Temperature field distribution(Tmax)in silicon formed by 515nm laser irradiation with various pulse widths
伴随着加热深度的增加,将表面加热到1410 ℃时需要的脉冲能量也会随脉宽的增加而增加。由于晶圆背面最高温度与施加的激光脉冲能量满足公式6所示的线性关系,因此,晶圆背面的最高温度也会随之上升,如图5所示。当脉冲宽度为10 ns时,需要的脉冲能量仅为0.57 J/cm2,背面最高温度只有44.9 ℃。而当脉冲宽度增加到100 μs时,需要的脉冲能量高达19.7 J/cm2,背面最高温度可达640.7 ℃。

图5 不同脉冲宽度的515nm激光将硅晶圆表面加热至1410 ℃所需的能量密度和背面的最高温度Fig.5 The energy density required to heat the surface of a silicon wafer to 1410 ℃ by 515nm laser with different pulse widths and the maximum temperature on the backside
3.2 波长的影响

图6 激光在Si中穿透深度随波长变化关系Fig.6 Laser penetration depth in silicon dependent on wavelength
越大的穿透深度意味着激光的能量分布的越深,可以直接加热的材料也就越深。图7给出了相同脉冲宽度(10 ns)的四种不同波长(515 nm,673 nm,808 nm,915 nm)激光辐照Si晶圆形成的温度场分布。如图7所示,515 nm激光的加热深度仅为730 nm(@ 1000 ℃)。相比之下,915 nm激光可以把14.9 μm厚的Si材料加热到1000 ℃以上。

图7 10 ns 脉宽下的四种不同波长激光辐照Si晶圆形成的温度场分布(Tmax)Fig.7 Temperature field distributions(Tmax)of silicon wafers irradiated by four different wavelength lasers with the same pulse width of 10 ns
随着激光波长的增加,由于加热深度增加了,因此需要的激光脉冲能量也相应增加,同时还有背面温度。当采用515 nm波长的激光进行辐照时,需要的脉冲能量仅为0.57 J/cm2,背面最高温度只有44.9 ℃。而当波长增加到915 nm时,需要的脉冲能量高达13.7 J/cm2,背面最高温度可达494.4 ℃。如图8所示。

图8 10 ns脉宽下四种不同波长激光将硅晶圆表面加热至1410 ℃所需的能量密度和背面的最高温度Fig.8 The energy density required to heat the surface of a silicon wafer to 1410 °C by four different wavelength lasers with 10 ns pulse width and the maximum temperature on the backside
3.3 特定加热深度下的最优波长与脉宽
如上所述,LA在Si晶圆中的加热深度主要由激光的脉宽和波长两个因素共同决定。这就意味着在实现同一激活深度的应用需求下,存在着多种不同脉宽和波长组合的激光条件可以利用,那它们之间是否存在最优的组合呢?接下来就从背面最高温度的角度评估各脉宽与波长组合的差异。
根据参考文献[10],1000 ℃可以认为是Si中激活掺杂剂磷的阈值温度。基于此,本文将峰值温度等于1000 ℃的深度位置定义为激活深度。以同样是120 μm厚的Si晶圆上实现3 μm的激活深度为例,图9给出了四种不同波长的激光照射在Si晶圆上产生的温度场分布,它们的曲线共同穿过(3 μm,1000 ℃)这个点,在此处相交。图10给出了相对应的脉冲宽度(PW)、能量密度(ED)和Si晶圆背面的最高温度(BT)。如图所示,脉冲宽度随波长的增加单调减小,而能量密度和Si晶圆背面温度则是先下降再上升。最低能量密度和Si晶圆背面温度出现在673 nm波长处。这表明673 nm波长和0.592 μs脉冲宽度的组合在这四种激光条件中是最优的。
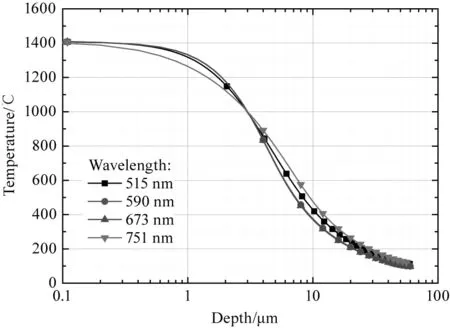
图9 四种不同波长激光实现3μm激活深度时的温度场分布(Tmax)Fig.9 The temperature field distribution(Tmax)induced by four different wavelengths of laser for 3 μm activation depth

图10 四种不同波长激光实现3μm激活深度时对应的脉宽(PW)、脉冲能量(ED)、背面最高温度(BT)Fig.10 Pulse width(PW),energy density(ED)and back maximum temperature(BT)corresponding to 3 μm activation depth by four different wavelengths laser
为了更好地理解这个现象,这里对图9所示的温度场分布进行具体分析讨论。由图可知,与其他波长的激光相比,673 nm波长激光照射在Si晶圆上产生的温度场在小于3 μm深的区域中具有最高的温度分布,而在大于3 μm深的区域温度却比较低。最理想的退火方式是只加热目标深度的材料,其他深度处以及背面保持常温状态。由此可见,673 nm波长激光在激活3 μm深的注入杂质方面更接近理想退火条件。而对于515 nm波长的短波长激光,由于穿透深度只有1.02 μm,要施加1.445 μs的长脉冲宽度才能实现3 μm的激活深度。由于脉宽较长,一部分热量被传导至3 μm以下,造成不必要的能量浪费。而对于751 nm波长的长波长激光,由于穿透深度较长(8.03 μm),激光直接可以穿透到3 μm以下,也造成了部分能量浪费。
通过对3μm激活深度的具体退火方案进行对比分析,不难看出,每个特定激活深度都会存在最适合的激光波长和脉宽使得退火需要的激光能量最少,引起的晶圆背面温升最小。为了便于计算与统计,本文不再将波长局限于实际情况中才有的值,单纯的对450~875 nm区间内按25 nm为一步长的波长进行仿真,找出激活深度从1~10 μm范围内最优波长和脉宽与之的关系。这个范围基本可以包含现有Si上离子注入激活的所有情况。
图11给出了不同激活深度下波长对晶圆背面温度的影响,晶圆厚度同样以120μm为例。

图11 不同激活深度下激光波长对背面温度的影响Fig.11 Influence of laser wavelength on backside temperature for different activation depths
由图11可知,随着激活深度的增加,最优波长也相应的增加。通过提取激活深度与最优波长的对应关系可得图12,经过拟合,最优波长λop可以表示为:
λop(nm)=122.51·ln(d)+509.97
(7)
其中,d表示激活深度,单位μm。同样的最优波长对应的脉冲宽度top(μs)可以近似拟合为:
top(μs)=0.0123·d2+0.1074·d+0.1302
(8)
需要注意的是,公式(7)和(8)是根据模拟仿真结果拟合出来的经验公式,为的是给实际退火时激光条件的选择提供一个参考依据,并没有具体的物理含义。
至此,本文充分说明了激光波长以及脉冲宽度对LA工艺在Si材料中可以加热的深度以及背面温升的影响。并通过对比不同激光方案,证明了特定激活深度会存在最佳波长和脉冲宽度组成的LA条件可以使需要的激光能量最少,Si晶圆未受激光照射的一面温升也最小。除此之外,基于本文的方法,也可以进一步推导出在特定的背面最高温度的要求下,激光的极限激活深度。比如,还是以120 μm厚的Si晶圆为例,如果要求背面最高温度不超过250 ℃,那它的极限激活深度将在10 μm附近,不会再高了(如图12中的10 μm激活深度线所示),除非将晶圆的背面与热沉接触对其进行强制降温。其他具体情况可以具体讨论,此处就不再赘述了。
4 结 论
本文基于一维热流方程,通过数值模拟仿真激光辐照在Si晶圆上产生的温度场分布,详细的分析了波长和脉冲宽度对激活深度以及背面温度的影响。结果显示,LA的激活深度由波长和脉宽共同决定,并会随着这两个参数的增加而增加。而对于特定的激活深度,存在着最优波长和脉冲宽度的组合,可以使非退火面的温升最小,从而有助于在不破坏器件结构及性能的同时实现更深的杂质注入激活深度。
