一种柔软高热导且连接界面稳定的半导体封装材料
2022-04-01刘鹏,杨诚
应用在功率模块以及高速处理器等器件上的半导体芯片具有功率密度高和芯片尺寸大等特点,对封装的散热和热应力释放都有很高的要求。两个元件之间的热膨胀系数(CTE)不匹配产生的热应力会危及相对薄弱的节点,导致芯片翘曲甚至开裂。由于热应力随着芯片工作温度和尺寸的增加而变大,对于大尺寸和大功率半导体芯片封装,热应力的威胁比传统封装严重得多。这使得开发能释放热应力、具有高热导率以及稳定连接界面的热界面(TIM)成为巨大的挑战。
清华大学杨诚教授团队首次报告了将多孔铜表面选择性分布铟(SIPC)作为一种柔软的TIM,以解决大尺寸和超高功率半导体封装热管理的核心挑战。为了使TIM具有良好的互连能力和可靠性,团队选择铟作为键合材料。通过调节电镀时间和电流密度,控制铟的沉积厚度与分布。在多孔铜表面选择性镀铟,既减少了铟的用量,又确保良好的界面焊接。
在约1 MPa下进行普通回流焊后,SIPC TIM可以牢固地连接到芯片和散热组件上。多孔铜两侧表面的选择性镀薄铟层可以在焊料回流后保证TIM与芯片和散热组件实现金属连接,极大地降低界面热阻。此外独特的薄铟层可以形成金属间化合物(IMC)Cu11In9,提高界面的熔化温度和机械强度,提供比纯铟更好的互连稳定性。SIPC的导热系数(16~117 W·m-1K-1)和杨氏模量(0.3~4.0 GPa)还可以通过改变其孔隙率和孔径来调节。
优化后的SIPC显示出高导热性(50 W·m-1K-1)与低杨氏模量(1.0 GPa),是目前能实现的金属键合同级别杨氏模量下热导率最高的热界面材料之一。将SIPC与硅芯片和铜热沉/铜板封装成Si-TIM-Cu三明治结构,模拟芯片TIM散热结构。选择经典商用银膏和纯铟作为对照样品,发现SIPC与铟具有非常接近的界面热阻、热导率以及界面剪切强度。此外,在超大尺寸芯片(1英寸×1英寸)三明治结构的高低温循环测试中,SIPC具有良好的界面稳定性,显示出优良的释放热应力的能力。
有限元研究证实,通过降低TIM的杨氏模量,可以降低整体CTE失配引起的整个夹层结构的热应力。除了较低的杨氏模量,这种多孔材料还有一个好处,可以将一个柔软的网状金属网络夹在两个刚性板之间,并在接头界面处形成不连续的IMC,将接触区域分割为小而孤立的区域。通过这种方式,整体热应力可以扩散到局部,并通过多孔铜大量的微小梁来消散,即使有裂纹也能抑制裂纹从一个接合点扩展到其他孤立的结合点,从而避免整个界面的失效(见图b)。
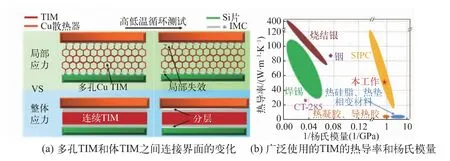
研究团队未来将聚焦使用3D打印和微加工等新技术构建更规则、更精细的三维金属连接网络,以进一步提高其柔软性和导热性。此外,用于制备骨架的材料还可以扩展到其他导热系数更高、杨氏模量更低的金属体系。(刘鹏 杨诚)
原始文献:
LIU P,LUO Y Y,LIU J M,et al.Laminar metal foam:A soft and highly thermally conductive thermal interface material with a reliable joint for semiconductor packaging [J].ACS Applied Materials&Interface,2021,13:15791-15801.
