制备非极性InGaN/GaN量子阱微米柱阵列的工艺研究
2022-03-31孙浩邓怿莹池浩林时家旭
孙浩 邓怿莹 池浩林 时家旭
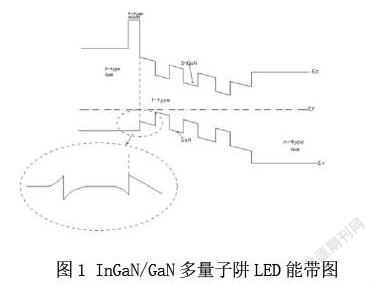
摘要:本文介绍了采用“自上而下”的方法制备InGaN/GaN微米柱阵列,可以获得均一性很好的量子阱结构;同时结合湿法刻蚀对缺陷进行定位,精确去除,可以有效地降低量子阱中的缺陷密度,从而有效地提高后续器件的光电性能。利用KOH(氢氧化钾)溶液等化学试剂对非极性InGaN/GaN样品进行湿法刻蚀,研究刻蚀条件与表面形貌之间的关系,利用表面形貌,进行金属镍掩模版的制备,接着应用等离子体刻蚀,去除掉有位错的部分,同时对样品进行相关测试,分析实验条件与纳米柱尺寸之间的关系,进一步优化条件,总结经验。
关键词:湿法刻蚀;干法刻蚀;InGaN/GaN微米柱阵列
一、引言
基于InGaN/GaN量子阱制备的发光二极管(LED)灯泡的电光转换效率可达300 lm/W,其效率是传统白炽灯的近20倍。除了高效的电光转换效率外,InGaN基LED灯泡还具有使用寿命长、环境稳定性好、维护费用低等优点。过去的近三十年,InGaN基LED研究获得了突飞猛进的发展,与此同时,如何进一步提高InGaN基LED的发光效率也变成了一个研究难点。
由于InN和GaN之间的晶格失配,沿极化方向生长的InGaN/GaN量子阱结构中,在量子阱和势垒的界面处存在因应力而形成的压电极化电荷,极化电荷在量子阱的生长方向产生内建极化电场。这一电场将电子和空穴限制在量子阱的两侧,降低它们的辐射复合概率,抑制InGaN量子阱的发光效率。2000年,Waltereit课题组首次在-LiAlO2衬底上用MBE制备出非极性面的m-GaN,沿m-方向制备的GaN/AlGaN量子阱结构消除了内建极化电场的影响。通过控制晶面生长方向,可以调控内建极化电场与量子阱之间的方向夹角,从而可以削弱甚至消除内建极化电场对载流子辐射复合效率的影响。经过国内外研究者的不断努力,时至今日,高质量的半/非极性方向氮化物材料及器件已经在氧化物、硅、碳化硅、蓝宝石等众多异质外延衬底上相继实现。相比于传统的极性方向,半/非极性方向的InGaN量子阱在降低内建极化电场,增强自发辐射效率等方面展现出显著的优势。
由于缺少合适的衬底材料,异质外延生长的半/非极性方向的GaN薄膜中含有大量的缺陷(线性位错密度109~1010 cm-2,基面堆垛层错密度104~105 cm-1)。基面堆垛层错(BSF)是某一层或多层原子发生了滑移,偏离预定位置所形成的一种缺陷。在半/非极性方向中,(0001)基面不再垂直于生长方向,BSF可以在(0001)面内沿生长方向的分量向上传播,最终贯穿InGaN/GaN量子阱区域,一直传播到样品表面,因此,不同于极性方向,在半/非极性方向的氮化物材料和器件中,BSF变成一个影响材料和器件性能表现的关键因素。众所周知,选择区域外延生长方法利用生长方向的各向异性,可以有效地降低GaN异质外延薄膜里的缺陷密度。研究发现,由于所用的图形衬底的周期性,选择区域外延生长出来的半/非极性面GaN薄膜表面的BSF也会具有周期性的分布规律。
如何制备实现氮化物纳米柱阵列结构,各国学者们采用了很多方法,如电子束曝光刻蚀、自组装纳米柱阵列、图形化衬底上垂直生长纳米柱阵列等。电子束曝光工艺复杂且成本过高。自组装纳米柱阵列成本较低,但通过该方法获得的纳米柱尺寸、分布的随机性、不均匀性为该方法的应用带来一定的限制。例如公开号为CN107424912A,公开日为2017年12月1日,发明名称为“一种氮化镓基纳米柱阵列的制备方法”的中国发明专利文献,该种技术方案中,研究者首先采用快速热退火技术在样品表面形成的自组装金属镍纳米颗粒,并以此纳米颗粒图形作为刻蚀掩膜,利用电感耦合等离子体反应离子刻蚀制备纳米柱。同时研究发现,纳米颗粒掩模版的制备和热退火的温度关系密切,等离子体的刻蚀条件的改变,使得制备的量子阱結构的纳米柱阵列的光致发光强度相比于相同的平面结构发生显著变化。通过优化刻蚀条件,可以获得发光强度显著提高的纳米柱阵列结构。
以上种种研究表明,利用刻蚀手段制备纳米柱结构去进一步降低GaN基LED中的位错,特别是非极性方向的的GaN基LED结构中的位错,是提高GaN基LED发光效率的一种有效手段。
二、实验介绍
InGaN/GaN量子阱在半导体发光二极管和短波长激光器的研制中具有其他III-V族氮化物材料不可替代的作用,对短波长发光器件的实现具有重要意义目前应用的绝大多数LED都是以其为核心结构。其结构如图1所示:
由InN和GaN形成的合金InGaN具有直接带隙,随In组分的改变其带宽从1.9eV连续改变到3.4eV,从而将半导体发光器件的波长从红光扩展到整个可见光及近紫外光范围。InN和GaN晶体的稳定结构是具有六方对称性的纤锌矿结构,而在一些特定的条件下,例如在立方衬底上外延时,GaN和InN能够形成立方对称性的闪锌矿结构。由于InN和GaN的晶格常数差达到11%,所以在形成的混合晶体中存在着较大的应力,这种应力引入了额外的势能。为了释放掉多余的能量,InGaN的晶格有一种将In 原子排挤出去的趋势,由于结构缺陷的存在,应力分布不均匀,这样在晶体内部就可能出现组分不均匀的情况,这就是相分离。
此次实验,先采用湿法刻蚀,利用KOH(氢氧化钾)溶液等化学试剂对非极性InGaN/GaN样品进行湿法刻蚀,研究刻蚀条件与表面形貌之间的关系。
在进行湿法腐蚀的过程中,熔液里的反应剂与被腐蚀薄膜的表面分子发生化学反应,生成各种反应产物。这些反应产物应该是气体,或者是能溶于腐蚀液中的物质。这样,这些反应产物就不会再沉积到被腐蚀的薄膜上。进行湿法刻蚀时,需要注意一些重要参数:腐蚀溶液的浓度、腐蚀的时间、反应温度以及溶液的搅拌方式等。由于湿法腐蚀是通过化学反应实现的,所以腐蚀液的浓度越高,或者反应温度越高,薄膜被腐蚀的速率也就越快。此外,湿法腐蚀跌反应通常会伴有放热和放气。反应放热会造成局部反应温度的升高,使反应速度加快;反应速率加快又会加剧反应放热,使腐蚀反应处于不受控制的恶性循环中,其结果将导致腐蚀的图形不能满足要求。反应放气产生的气泡会隔绝局部的薄膜与腐蚀的接触,造成局部的反应停止,形成局部的缺陷。因此,在湿法腐蚀中需要进行搅拌。此外,适当的搅拌(例如使用超声波震荡),还可以在一定程度上减轻对光刻胶下方薄膜的腐蚀。gzslib202204012242采用干法刻蚀,应用等离子体刻蚀,去除掉有位错的部分,同时对样品进行相关测试,分析实验条件与纳米柱尺寸之间的关系,进一步优化条件,总结经验。
在进行干法刻蚀的过程中,当气体以等离子体形式存在时,一方面等离子体中的这些气体化学活性比常态下时要强很多,根据被刻蚀材料的不同,选择合适的气体,就可以更快地与材料进行反应,实现刻蚀去除的目的;另一方面,还可以利用电场对等离子体进行引导和加速,使其具备一定能量,当其轰击被刻蚀物的表面时,会将被刻蚀物材料的原子击出,从而达到利用物理上的能量转移来实现刻蚀的目的。在平行电极等离子体反应腔体中,被刻蚀物是被置于面积较小的电极上,在这种情况,一个直流偏压会在等离子体和该电极间形成,并使带正電的反应气体离子加速撞击被刻蚀物质表面,这种离子轰击可大大加快表面的化学反应,及反应生成物的脱附,从而导致很高的刻蚀速率,正是由于离子轰击的存在才使得各向异性刻蚀得以实现。
三、结论
本文研究了InGaN/GaN量子阱的结构,通过湿法刻蚀手段,研究非极性InGaN/GaN材料中“有缺陷区域”和“无缺陷区域”之间的形貌对比,建立刻蚀形貌与刻蚀条件之间的相互关系。再利用传统的光刻工艺、干法刻蚀手段对湿法刻蚀后的InGaN/GaN材料进行有选择的定向刻蚀,采用此种方法制备低缺陷密度的InGaN/GaN微米柱阵列。
参考文献:
[1]王青鹏. 干法刻蚀辅助型GaN MOSFET的器件工艺及电学特性研究[D].大连理工大学,2015.
[2]杨国锋. InGaN/GaN低维量子阱结构的制备及其发光性质研究[D].南京大学,2013.
[3]王钇心. 应变对InGaN/GaN量子阱发光的影响[D].吉林大学,2015.
[4]梁明明. InGaN/GaN多量子阱中载流子的输运及复合特性研究[D].厦门大学,2014.
[5]王春伟. 湿法刻蚀均匀性的技术研究[D].复旦大学,2012.
作者简介:
孙浩(2001),男,汉族,安徽滁州人,江苏大学本科在读,光电信息科学与工程方向。
基金项目:
