国内外光刻胶发展概述
2022-03-23苏义旭马亮亮
苏义旭,马亮亮
(合肥本源量子计算科技有限责任公司,安徽 合肥 340000)
0 引言
进入21世纪,信息化产业得到了长足的发展,其中微电子技术作为核心技术对信息社会的发展奠定了基石[1]。1965年,英特尔公司创始人之一Gordon Moore对集成电路的发展进行大胆假设,历经数次修正得到广为人知的预测:“芯片上集成的元器件个数会在每18个月的时间内翻一番”[2]。摩尔定律是从经济学的角度对信息社会集成电路产业进行预测,从物理学角度出发同样有一个著名的登纳德定律。Robert Dennard在研究中发现晶体管尺寸的缩小使得电流和电压以类似的比例缩小,即在减小晶体管尺寸的同时会带来功耗降低的正影响[3]。光刻工艺作为集成电路产业的关键技术,对集成电路的小型化发展起到至关重要的作用,瑞利公式可以有效地分析光刻技术的发展。

式中:R为光刻系统可以实现的最小线宽;λ为光刻系统的曝光波长;NA为曝光系统的数值孔径;k1为跟工艺相关的常数。
从公式中(1)可以发现,通过以下3个途径可以获取更小的线宽:
(1)减小曝光波长,开发更加先进的曝光系统;
(2)提高曝光系统的数值孔径;
(3)优化工艺参数,减小k1。
上述三种途径在提高系统分辨率的同时对光刻胶的研发提出了更高的要求。后续对紫外光刻胶的种类和发展历程进行重点分析。
1 国外光刻胶研究、发展历程
光刻胶是一种对光敏感的材料,可以将需要的图案转移到基底上。光刻胶在接触一定剂量的光辐照后发生相应的化学反应,溶解性/溶解速率发生变化形成反差以达到图形转移的目的[4]。随着曝光系统中的光源波长减小,随之配套的光刻胶也经历了不同时期的发展。
1.1 酚醛树脂基光刻胶
酚醛树脂基光刻胶作为一种常见的I-线、G-线光刻胶被广泛应用,它主要包含酚醛树脂(图1)、光敏化合物(DNQ)、溶剂。在光辐照的作用下,光敏化合物分解激发光化学反应使得受光辐照的区域更加容易溶解于显影液中(相对于正胶而已,负胶情况相反),如图1所示。对聚合物的分子结构进行设计,可以得到对比度更好的光刻胶。比如将两种不同分子量的酚醛树脂进行比例混合、使用分子量分布更窄的聚合物或者选用在显影液中溶解度更小的聚合物制备光刻胶可以得到更好的结果。

图1 酚醛树脂基光刻胶受光辐照后的反应过程
1.2 tBOC基光刻胶
tBOC胶作为第一款商用的化学放大胶由IBM研发应用于248 nm工艺[5],tBOC胶包含聚4-叔丁氧基羰氧基苯乙烯树脂(PBOCST)、光致产酸剂、添加剂、溶剂。聚合物PBOCST(图2)悬挂的侧链不稳定,在酸作用下会分解脱落变成新的聚合物PHOST,使得原本疏水的聚合物变得亲水。PBOCST化学放大胶敏感度比novolac/DNQ胶高102倍,但该类型胶在曝光后应妥善放置于密闭空间中并使用空气净化器,因为环境中的胺会与曝光后产生的H+反应导致曝光区域的灵敏度降低。

图2 tBOC胶结构及受光辐照后反应过程
1.3 聚丙烯酸酯基光刻胶
随着光刻系统中曝光波长的减小,原先光刻胶体系中的聚合物已经不适应新的要求。因为聚合物中苯环在193 nm及以下有强烈的吸收,使得该类型的光刻胶不能在193 nm的波长下使用。聚丙烯酸酯基聚合物由于不含苯环结构,具有较好的性能被广泛应用[6]。该型光刻胶含有聚丙烯酸酯聚合物、光致产酸剂、碱性中和剂、功能添加剂(负胶中的交联剂、脱水剂)等。
在193 nm光刻波长下使用的化学放大胶还包括环烯烃类、乙烯基醚-马来酸酐类、环烯烃-马来酸酐类等。
1.4 单环含氟树脂型光刻胶
193 nm沉浸式曝光系统对光刻胶有更高的要求,比如更强的疏水性、较小的浸出率等。由于该类型的光刻胶为商业机密,仅有为数不多的文献可供参考[7],整理如下。单环含氟树脂结构如图3,该类型树脂由于含有氟基团因此具备更优良的疏水性,但抗刻蚀性能差。文章作者对树脂结构进行改良,在聚合物结构中加入金刚烷基团合成嵌段聚合物,新的聚合物抗刻蚀性能大大增加。
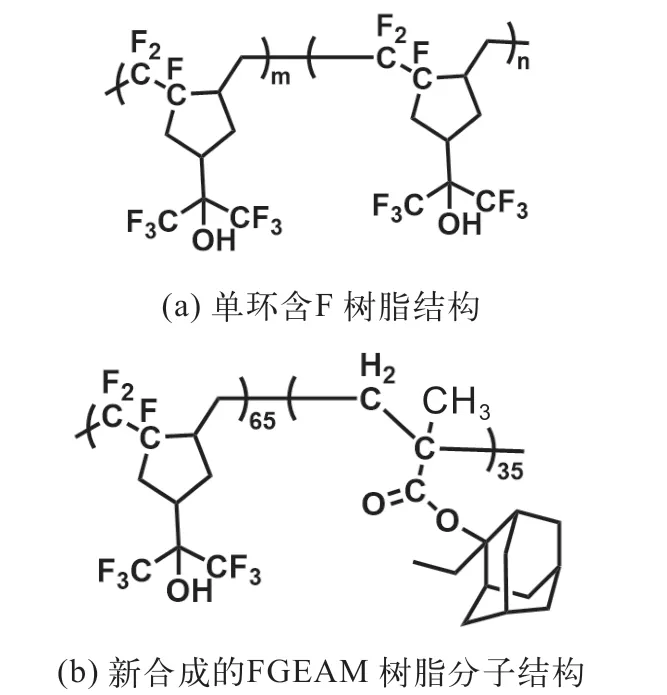
图3 193 nm沉浸式曝光系统所用光刻胶中含F聚合物结构
1.5 硅基光刻胶
为了避免显影后的线条塌陷,越细小的线宽工艺越要求薄的光刻胶厚度。但是以往的光刻胶在胶膜较薄的情况下不能有效抵抗等离子体的刻蚀。针对上述问题,研发人员开发了硅基光刻胶[8],这些含硅的光刻胶能够很好地适应薄胶工艺有效抵抗等离子的刻蚀[9]。图4介绍了一种常见的硅基光刻胶,侧链R是一种酸不稳定的基团能够在H+中解离,使光刻胶的溶解性发生较大变化从而达到图形转移的目的。

图4 一类含Si的光刻胶树脂结构
1.6 环氧树脂基光刻胶
跟以往光刻胶的设计思路不同,研发人员开发了一款新型的光刻胶:(1)利用曝光后产生的H+使光刻胶交联;(2)在光刻胶中添加热交联反应的催化剂,例如:三苯基膦、咪唑等。这类光刻胶的工作原理是光辐照后产生H+使环氧分子聚合形成环氧聚合物,然后环氧分子和酚醛反应形成交联结构,交联后的聚合物不溶于显影液,表现为负胶。
2 国内光刻胶研发进展
全球光刻胶市场萌芽于20世纪50年代,从第一款novolac/DNQ光刻胶商用开始历经60多年的发展已经进入EUV光刻胶应用阶段[10]。反观国内市场,由于工业基础薄弱、研发投入不足、市场准入门槛高等原因导致国内光刻胶研发与国际水平存在代差。
国内光刻胶研发生产龙头企业包括苏州瑞红、北京科华、深圳容大、南大光电等,在低端PCB光刻胶市场国产化替代进度较快,但高端光刻胶几乎全部依赖进口,国内产商技术积累与国外公司存在较大差异。在中端KrF光刻胶市场,北京科华实现量产,其他公司仍处于中试、研发阶段;ArF光刻胶仅仅有南大光电取得较大进展,其他公司仍处于摸索状态;极紫外光刻胶目前在国内仍处于研发阶段。为加快光刻胶国产化进程,实现自主可控,针对国内光刻胶研发、生产现状提出几点发展建议:
(1)政府主导整合上游、中游、下游相关企业,给予税收、资金等优惠政策,鼓励企业加大研发投入;政府设立半导体产业链研发中心,加速各环节卡脖子技术研发进度;政府机构简化企业技术中试审批流程,优先推广有潜力产品,做到产品在产线上使,在产线上优化。
(2)加强校企联合研发,在高校中设立奖学金奖励大学生参与光刻胶相关研发项目,调整授课内容,积极培育专门人才。
(3)提高电子化学品领域研发、生产人员工资待遇,解决人员后顾之忧做到正向积极作用。
(4)下游企业在满足生产产能的前提下,优先试用国内光刻胶产品,提供试用反馈报告。只有在实践中运用,才能真正发现问题解决问题,积极促进相关产业的高速健康发展。
3 结语
本文对国内外的光刻胶研发、生产情况进行了详细的综述。相比于常见的以光源波长为分类依据,本文以光刻胶的主要成分聚合物树脂种类为分类依据对国际上常用的光刻胶进行综述,有助于学习者、研发者更有针对性地了解光刻胶相关知识。并对国内的光刻胶研发情况进行了总结,并对促进国内光刻胶研发提出几点建议,为早日开发出具有自主知识产权的高端光刻胶材料,用于半导体器件的生产,还需要科研工作者加强相关研究。
