GaN基光栅的干法刻蚀工艺
2021-06-16郭孝浩任霄钰张立群张志军刘建平
郭孝浩, 胡 磊, 任霄钰, 吴 思, 张立群, 张志军, 杨 辉, 刘建平*
(1. 上海大学 材料科学与工程学院, 上海 200444;2. 中国科学院苏州纳米技术与纳米仿生研究所 纳米器件与应用重点实验室, 江苏 苏州 215123)
1 引 言
氮化镓(Gallium nitride,GaN)基材料及其多元合金将半导体光电子器件的发光波长拓展到可见光和紫外波段,其中激光器(Laser diode,LD)具有高纯度和高亮度特性,广泛应用于照明、显示、通信和存储等领域。GaN基激光器在可见光和海底通信及量子技术领域具有巨大的应用前景,这些应用需要窄线宽激光,因此GaN基分布式反馈(Distributed feedback,DFB)激光器近年来受到了极大的关注[1-5]。GaN基DFB激光器相对于传统激光器的研制难度更大,因为光栅作为DFB的重要结构,它的陡直度、侧壁粗糙度、均匀性以及刻蚀深度直接影响GaN基DFB激光器单纵模特性,因此得到一个陡直、侧壁光滑、均匀且刻蚀深度可控的的光栅非常重要。
光栅的特征尺寸较小,其刻蚀深度、形状尺寸、均匀性以及陡直度是很难控制的。GaN材料具有较强的化学稳定性[6],因此湿法刻蚀并不是制作光栅的最佳方案。干法刻蚀具有相对可控的刻蚀速率以及相对高的各向异性而被广泛应用在GaN基器件制作工艺中,其中包括反应离子刻蚀(Reactive ion etching,RIE)[7]、离子束刻蚀(Ion beam etching,IBE)[8-9]和电感耦合等离子体 (Inductively coupled plasma,ICP) 刻蚀[10-12]。RIE刻蚀速率低,工作压强高,离子污染大;IBE刻蚀选择比差,物理损伤大。相比于RIE和IBE刻蚀,ICP刻蚀具有相对高的刻蚀速率、选择比、各向异性以及更小的刻蚀损伤[13],更适用于GaN基DFB激光器中光栅的刻蚀。在ICP刻蚀GaN的工艺中,气体的选择很重要,目前使用比较广泛的组合为Cl2/BCl3[14]、Cl2/Ar[15]、Cl2/H2[16]、Cl2/N2/O2[17]。相比于其他气体,BCl3能有效地调节等离子体中活性氯的浓度、控制刻蚀速率,还可通过形成惰性气体BClxOy被真空泵抽走,有效去除腔室内的残余氧气,以防止形成自掩膜[18],且气体组成成分相对简单,因此本研究采用BCl3/Cl2混合气体作为刻蚀气体。刻蚀GaN的原理是通过氯自由基与GaN表面反应生成具有挥发性的氯化镓化合物,刻蚀产物挥发并由真空泵抽走[12]。除刻蚀气体外,ICP功率、射频(Radio frequency,RF)功率以及压强对GaN刻蚀结果都有较大影响。目前,国内外已经报道了不同参数对刻蚀速率和表面粗糙度的影响[11, 19-20],对于台面侧壁粗糙度和陡直度的研究很少。Rawal[18]和Tahhan[21]等刻蚀台面侧壁倾角分别为80°和82°,但是对侧壁的粗糙度并没有讨论。
本文使用BCl3/Cl2基ICP刻蚀,SiO2作为硬掩膜,研究了气体流量比以及压强对GaN台面侧壁的粗糙度、陡直度以及刻蚀速率的影响,通过调节刻蚀参数,在保证侧壁光滑的同时,提升侧壁的陡直度,最终得到了一个陡直、光滑且刻蚀深度可控的光栅。光滑且陡直的光栅对于提升氮化镓基分布式反馈激光器的器件性能及其稳定性非常重要。
2 实 验
本研究中使用的GaN样品是通过金属有机化学气相沉积(Metalorganic chemical vapor deposition,MOCVD)在c面GaN自支撑衬底上生长的外延结构,包括硅(Si)掺杂的n-AlGaN 下限制层、Si掺杂的n-InGaN 波导层、两个周期的InGaN/GaN 多量子阱(Multiple quantum well,MQW)、非故意掺杂的InGaN 波导层、镁(Mg)掺杂的p-AlGaN 电子阻挡层、Mg 掺杂的p-AlGaN/GaN超晶格上限制层和重掺杂的p-InGaN 接触层,如图1所示。

图1 GaN外延片结构示意图
实验首先通过刻蚀脊形来确定刻蚀参数,确认刻蚀参数后再进行光栅刻蚀。丙酮/乙醇超声清洗样品表面后,采用电感耦合等离子体化学气相沉积(Inductively coupled plasma chemical vapor deposition,ICPCVD)方法沉积100 nm厚的SiO2作为硬掩膜,如图2(a)所示;样品表面旋涂一层AZ5214光刻胶,MA6紫外接触式光刻机曝光出脊形图形,如图2(b)所示;然后使用RIE刻蚀将光刻胶图形转移到SiO2上,如图2(c)所示;最后采用牛津仪器ICP-180刻蚀机在不同压强和不同气体比例条件下刻蚀GaN,如图2(d)所示。刻蚀完成后,氢氟酸去除硬掩膜SiO2,扫描电子显微镜(Scanning electron microscope,SEM)Quanta 400 FEG观察脊形(或光栅)侧壁粗糙度以及倾角,台阶仪Dektak150测量刻蚀深度。
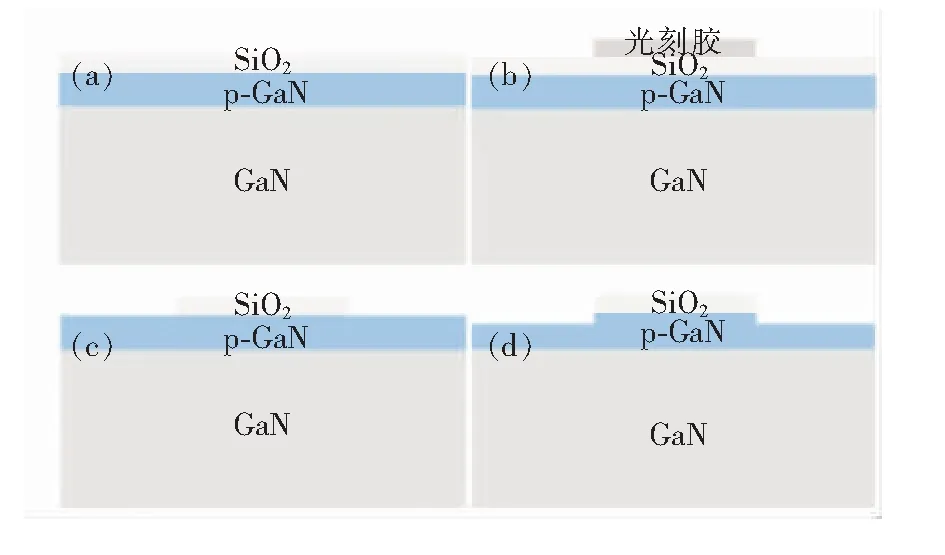
图2 ICP刻蚀实验工艺流程图
3 结果与讨论
通过两组实验分别研究了不同刻蚀气体BCl3/Cl2比例和压强对刻蚀速率、刻蚀的各向异性以及侧壁粗糙度的影响。实验的ICP功率不超过500 W,压强不低于0.798 Pa(6 mTorr),以防刻蚀过程中设备间接性中断,使实验参数偏差过大。
3.1 BCl3占比对刻蚀的影响

GaN刻蚀速率以及直流偏压与BCl3在混合气体中占比的关系如图3所示(ICP功率300 W,RF功率100 W,压强1.33 Pa(10 mTorr),BCl3/ Cl2总流量为35 mL/min)。BCl3占比为0%时,刻蚀速率最快,而当BCl3占比为100%(Cl2为0%)时,刻蚀速率从245.6 nm/min降到74.2 nm/min。随着混合气体BCl3占比的增加,电离出的Cl离子浓度降低,刻蚀速率逐渐下降。直流偏压是等离子体和样品产生的电势差,它为反应离子提供加速能量[22],先随BCl3占比增加而略微上升,当占比为50%时,直流偏压达到最大值,然后随着BCl3占比继续增加而略微下降。当BCl3占比小于50%时,Cl2作为主要刻蚀气体,化学刻蚀占主导地位,且直流偏压略微上升,所以刻蚀速率随着BCl3占比增加而缓慢下降;而当BCl3占比高于50%后,导致物理刻蚀逐渐占据主导地位,且直流偏压略微下降,所以刻蚀速率随着BCl3占比增加而迅速下降。

图3 GaN的刻蚀速率和直流偏压与BCl3占比的关系
不同BCl3/Cl2混合气体占比对GaN的刻蚀结果如表1所示,SEM测试结果如图4所示。当BCl3占比小于50%时,可以看到边缘和侧壁损伤严重,而且侵蚀明显,较为粗糙。如图4(a)、(b)所示,说明 Cl2组分通过化学反应控制了刻蚀过程,且Cl离子散射能量较大,导致边缘及侧壁损伤严重。当完全没有BCl3的物理刻蚀时,清除刻蚀残留物较为困难,使得刻蚀残留物附着在侧壁底端,如图4(a)所示。随着BCl3占比逐渐增加,边缘和侧壁损伤明显减小,表面较为光滑,如图4(c)、(d)、(e)所示,说明边缘和侧壁Cl离子散射变小。当BCl3占比大于50%时,BCl3成为主导刻蚀气体,物理刻蚀增强,使台面侧壁变得粗糙,但粗糙程度小于Cl2作为主导刻蚀气体的情况。当BCl3占比为50%时,边缘和侧壁的损伤最小,表面最光滑。
另外,我们采用侧壁倾角来表示ICP刻蚀GaN的各向异性特性。由图4(f)~(j)可以看出,当BCl3占比小于50%时,随着BCl3占比的增加,侧壁角度也随之增加;BCl3占比为50%时,侧壁角度达到最大85.3°;BCl3占比大于50%时,侧壁角度随之降低,具体表现如表1所示。在纯Cl2的条件下,刻蚀速率较快,但由于纯Cl2条件下的物理作用很小,因此台面刻蚀的各向异性较差。当刻蚀气体为纯BCl3时,化学刻蚀作用较小,刻蚀速率很慢,台面倾斜的侧壁无法得到有效的刻蚀,刻蚀的各向异性比纯Cl2条件下的更差。因此,合适的BCl3/Cl2混合气体比例才能使物理刻蚀和化学刻蚀达到一种平衡,刻蚀结果有更好的各向异性,使得台面侧壁更加陡直且光滑。

表1 GaN刻蚀速率、侧壁倾角和侧壁表面随混合气体中BCl3占比变化的结果
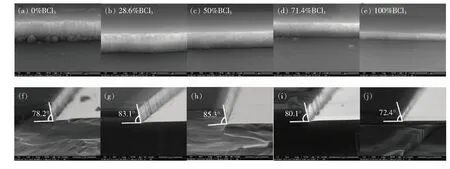
图4 BCl3占比为0%(a)、28.6%(b)、50%(c)、71.4%(d)、100%(e)条件下侧壁粗糙度以及BCl3占比为0%(f)、28.6%(g)、50%(h)、71.4%(i)、100%(j)条件下侧壁倾角SEM图像。
3.2 压强对刻蚀的影响
在ICP刻蚀GaN过程中,压强对于刻蚀速率、各向异性和侧壁粗糙度也起到关键性作用。压强越大,自由基Cl离子的平均自由程越小,离子碰撞频率增加,离子散射加剧,不利于刻蚀[12,15]。
GaN的刻蚀速率以及直流偏压与压强的关系如图5所示(ICP功率300 W,RF功率100 W,BCl3占比50%,BCl3/Cl2总流量为35 mL/min),压强从0.798 Pa(6 mTorr)到2.66 Pa(20 mTorr)变化。当压强为0.798 Pa(6 mTorr)时,刻蚀速率为280.1 nm/min,随着压强不断增大,刻蚀速率逐渐下降;当压强为2.66 Pa(20 mTorr)时,刻蚀速率降到85.2 nm/min。刻蚀速率降低主要是因为离子碰撞频率增加,离子散射加剧,导致等离子体无法有效刻蚀GaN。同时,压强升高不利于反应产物挥发,刻蚀速率下降。
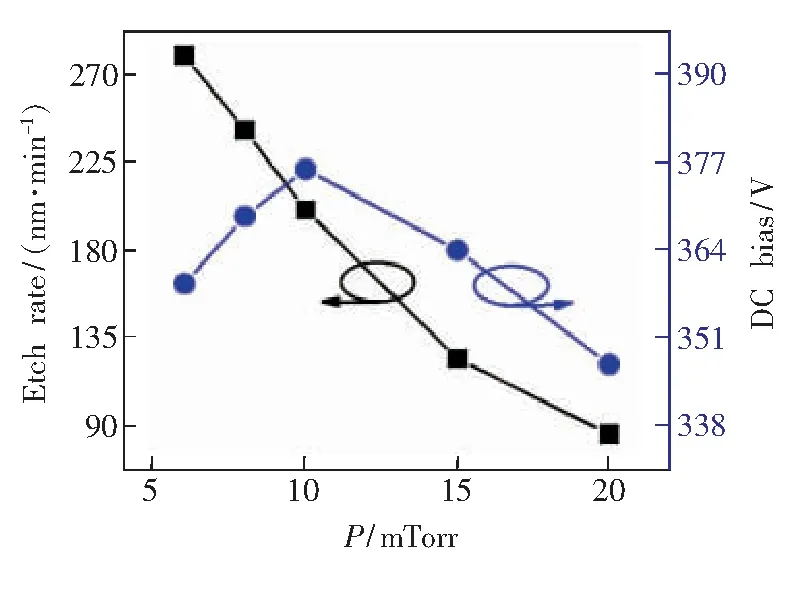
图5 GaN的刻蚀速率和直流偏压与压强的关系
不同压强条件对GaN的刻蚀结果如表2所示,SEM测试结果如图6所示。在压强为0.798 Pa(6 mTorr)时,刻蚀速率较快,但侧壁损伤严重,且比较粗糙,如图6(a)所示。主要是因为压强低,粒子平均自由程长,离子能量较高,物理和化学刻蚀效果都比较明显,从而导致图形边缘的掩膜损伤严重,导致边缘处刻蚀不均匀。且离子散射能量较大,侵蚀侧壁,导致台面侧壁粗糙。随着压强升高,离子能量降低,物理和化学刻蚀达到一种平衡,台面侧壁以及掩膜边缘变得光滑平整,如图6(b)所示。但当压强继续增大到1.995~2.66 Pa(15~20 mTorr)时,侧壁粗糙度明显增加,可能是因为在较高压强条件下,离子碰撞加剧,散射到台面侧壁。

表2 GaN刻蚀速率、侧壁倾角和侧壁表面随压强变化的结果
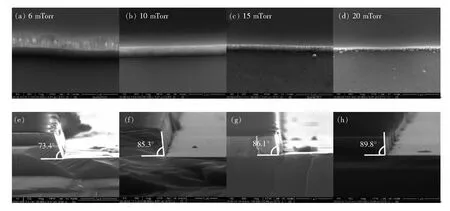
图6 压强为0.798 Pa(6 mTorr)(a)、1.33 Pa(10 mTorr)(b)、1.995 Pa(15 mTorr)(c)、2.66 Pa(20 mTorr)(d)条件下侧壁粗糙度以及压强为0.798 Pa(6 mTorr)(e)、1.33 Pa(10 mTorr)(f)、1.995 Pa(15 mTorr)(g)、2.66 Pa(20 mTorr)(h)条件下侧壁倾角SEM图像。
从图6(e)~(h)可以看出,随着压强增大,侧壁倾角从73.4°增加到89.8°,说明随着压强增大,粒子密度增加,离子碰撞加剧,离子散射较强,且尾气无法及时抽出腔室,导致各向同性刻蚀增强,选择比提高,使侧壁陡直度增加且变得粗糙。但压强大于1.995 Pa(15 mTorr)时,刻蚀表面变得粗糙,可能是压强较高条件下,离子碰撞剧烈,刻蚀均匀性变差,GaN不能得到均匀的刻蚀,使得样品表面形貌变差,如图7所示。高压强条件下,虽然陡直度高,但侧壁粗糙度大且表面形貌差。

图7 压强为1.995 Pa(15 mTorr)(a)、2.66 Pa(20 mTorr) (b) 条件下GaN表面SEM图像。
3.3 优化刻蚀条件后刻蚀光栅
保持ICP功率和RF功率分别为300 W和100 W不变,刻蚀气体BCl3占比为50%(BCl3/Cl2总流量为35 mL/min)以及压强为1.33 Pa(10 mTorr)条件下,能有效提高刻蚀的各向异性,确保光栅的陡直度,降低侧壁粗糙度,保证图形边缘光滑平整。将优化后的ICP刻蚀参数用于GaN基DFB激光器的制作中,光栅采用Raith(eLINE Plus)电子束光刻机转移图形,光刻胶为聚甲基丙烯酸甲酯(Polymethyl methacrylate,PMMA),采用SiO2硬掩膜,得到了一个平整、光滑且陡直的光栅,光栅周期1.4 μm,占空比72%,侧壁倾角为85.3°,刻蚀深度为400 nm。该工艺应用于GaN基DFB激光器中光栅的刻蚀,如图8所示。
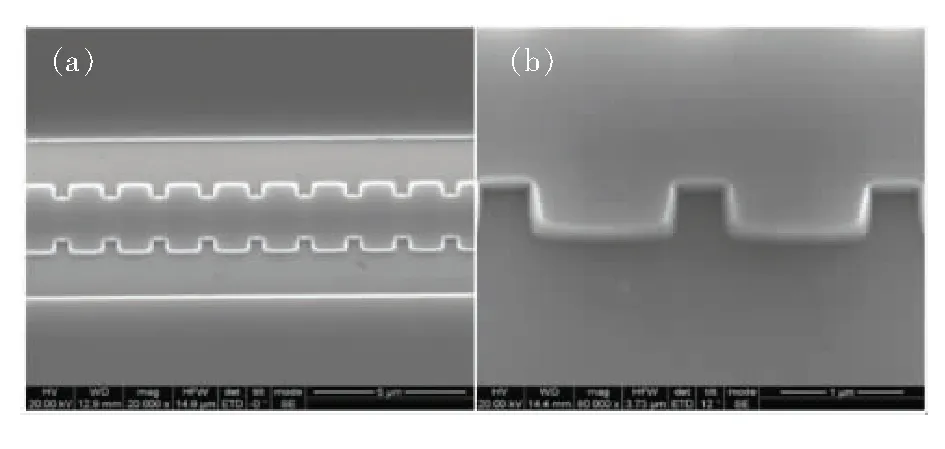
图8 优化后的刻蚀工艺刻蚀的光栅SEM图像
4 结 论
本文研究了ICP刻蚀工艺参数,包括ICP功率、RF功率、刻蚀气体比例以及压强对刻蚀GaN的影响。主要研究了刻蚀气体比例和压强对刻蚀的各向异性、台面侧壁粗糙度以及刻蚀速率的影响。最后,保持ICP功率和RF功率分别为300 W和100 W不变,在BCl3/Cl2流量比为1和1.33 Pa(10 mTorr)的压强条件下,化学刻蚀和物理刻蚀可以达到一种平衡,得到较好的各向异性且侧壁光滑的刻蚀台面。在该参数条件下,刻蚀速率为200.6 nm/min,侧壁倾角为85.3°,得到了相对陡直、光滑且深度可控的刻蚀台面。该优化工艺对于氮化镓基分布式反馈激光器中光栅的刻蚀具有重要意义,刻蚀深度可控、陡直且光滑的光栅对于提升氮化镓基分布式反馈激光器的器件性能及其稳定性非常重要。
