络合剂DTPA-5K 在集成电路阻挡层CMP中的应用及机理分析
2021-03-22霍兆晴牛新环刘玉岭杨程辉卢亚楠
霍兆晴,牛新环,刘玉岭,杨程辉,卢亚楠
(1.河北工业大学电子信息工程学院,天津 300130;2.天津市电子材料与器件重点实验室,天津 300130)
随着集成电路(IC)特征尺寸的不断降低,化学机械抛光(CMP)已经成为多层铜(Cu)布线中实现局部和全局平坦化的关键性技术,其步骤分为铜膜粗抛、铜膜精抛和阻挡层抛光,如图1所示。阻挡层CMP中涉及到多种材料(布线金属、阻挡层、介质层)的去除,最终停在Low-K 材料BD(多孔的SiOCH)上,其最主要的目标是修正铜膜抛光留下的碟形坑和腐蚀坑,它们的存在会加剧铜损失并降低器件的可靠性[1-3]。在65 nm 技术节点下,Ta作为阻挡层材料,厚度仅仅为8 nm,在机械作用下被快速去除,因此,牺牲层正硅酸乙酯(TEOS)对Cu的高速率选择性是提高平坦化性能的重要因素。一般采用增强机械作用的方法实现TEOS和Cu之间去除速率差,但较大的磨料浓度会引起表面划伤且不利于后清洗[4-5]。因此,可通过化学作用来调节速率选择性,抛光液作为抛光过程中最主要的耗材,通过调整其组分可使材料达到合适的抛光速率和表面状态[6]。一些学者研究了正价离子在CMP中对不同材料去除速率的影响:Wang等[7]加入胍离子并通过研究其与1,2,4-三氮唑(TAZ)的协同作用,将铜和钌之间的去除选择比从0.44提高到1.58。Cheng等[8]在钴插塞CMP中,加入钾离子促进表面反应,实现钴/氮化钛/TEOS的高去除速率,将钴表面粗糙度降至1.17 nm。Wang等[9]通过调节铵根离子的浓度,能够将Cu和Ru去除速率提高一个数量级。基于此,本文提出了一种高效络合剂二乙烯三胺五乙酸五钾(DTPA-5K),它具有五个钾离子,可通过减少TEOS表面的静电斥力而提高去除速率,其分子结构如图2所示。
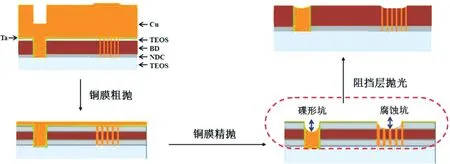
图1 Cu互连CMP过程示意图Fig.1 CMP process diagram for Cu interconnection
本文研究了DTPA-5K对Cu和TEOS去除速率的影响,详细地分析了相关的去除机理。另外,引入抑制剂TAZ提高TEOS对Cu的选择性。最后,用优化后的抛光液对图形片进行抛光,检测碟形坑和腐蚀坑的修正能力以及抛后表面状态。研究结果对工业生产以及后续更小技术节点下CMP有参考意义。

图2 DTPA-5K的分子式Fig.2 Molecular structure of DTPA-5K
1 实验
实验准备:所有实验均在超净实验室完成,室温为25℃,抛光液由磨料硅溶胶(SiO2,p H 约9.6,粒径约62 nm,武汉金伟)、氧化剂双氧水(H2O2,质量分数为30%,上海风船)、络合剂二乙烯三胺五乙酸五钾(DTPA-5K,质量分数40%,麦克林)和抑制剂1,2,4-三氮唑(TAZ,分析级,麦克林)组成。固定基础抛光液为质量分数10%SiO2和0.15%H2O2,后续抛光实验在此基础上加入试剂。
抛光实验:分别对3英寸Cu靶材和TEOS介质片进行抛光,实验设备为法国产E460抛光机,实验参数列于表1。采用电子分析天平(Mettler Toledo AB204-N)称量抛光前后铜靶材质量,铜的去除速率(R)可采用公式(1)进行计算。通过介质膜厚测量仪F50(Filmetrics,Inc.)测量抛光前后介质片厚度,利用厚度差来获得TEOS的去除速率。每次测量重复三次并取平均值。

式中:Δm 为CMP前后铜靶材质量差;r为铜靶材半径;ρ=8.9 g/cm3;t=180 s。

表1 实验参数的设定Tab.1 Experimental setting parameters
XPS测试:为了更直观地阐明反应机理,将1 cm×1 cm铜镀膜片浸泡在不同溶液中6 min,去离子水冲洗并氮气吹干。采用X 射线光电子能谱(XPS,Thermo Scientific,ESCALAB 250Xi)检测浸泡后的铜表面化学成分,利用Casa XPS软件拟合峰获得表面物质的结合能,并与公共数据库中的数值比对确定成分。
性能测试:碟形坑和腐蚀坑是评估抛光液平坦化性能的重要指标,采用台阶仪(XP-300,AMBIOS)测量CMP前后图形片坑深。图3显示了共聚焦显微镜(OLYMPUS,OLS5000-LAF)在放大倍数为500倍的情况下65 nm图形片的测试位置,每个测试点线宽为75μm×75μm。粗糙度(Sq)是表征表面质量的参数,采用原子力显微镜(Agilen,5600SL)在10μm×10μm区域测量抛光前后铜表面的表面形貌。

图3 65 nm 图形片上碟形坑和腐蚀坑的测试点Fig.3 Dishing and erosion test pads on 65 nm pattern wafer
2 结果与讨论
2.1 DTPA-5K对Cu和TEOS去除速率的影响
在基础抛光液中加入不同浓度的DTPA-5K,Cu和TEOS的去除速率如图4所示,随着DTPA-5K 浓度由质量分数0%增加到0.4%,Cu和TEOS去除速率分别由37.6 nm/min和44.1 nm/min迅速增大到105.5 nm/min和108.4 nm/min,继续增大DTPA-5K浓度,Cu和TEOS去除速率趋于平缓。
为了更直观地确认DTPA-5K 与Cu表面的反应,在铜离子溶液(质量分数1.5%)中加入不同浓度DTPA-5K后出现的现象如图5所示。可以看到,在向#0中加入少量DTPA-5K,溶液颜色急剧变化,这表明了DTPA-5K与Cu2+可以发生络合反应。并且,也可以看出无论颜色怎么变化,溶液都始终保持透明,说明反应产物是水溶性物质。此外,在#2溶液之后,颜色不再变化,进一步说明在DTPA-5K 浓度为质量分数0.4%时,反应达到饱和,与上述抛光实验结果相符合。
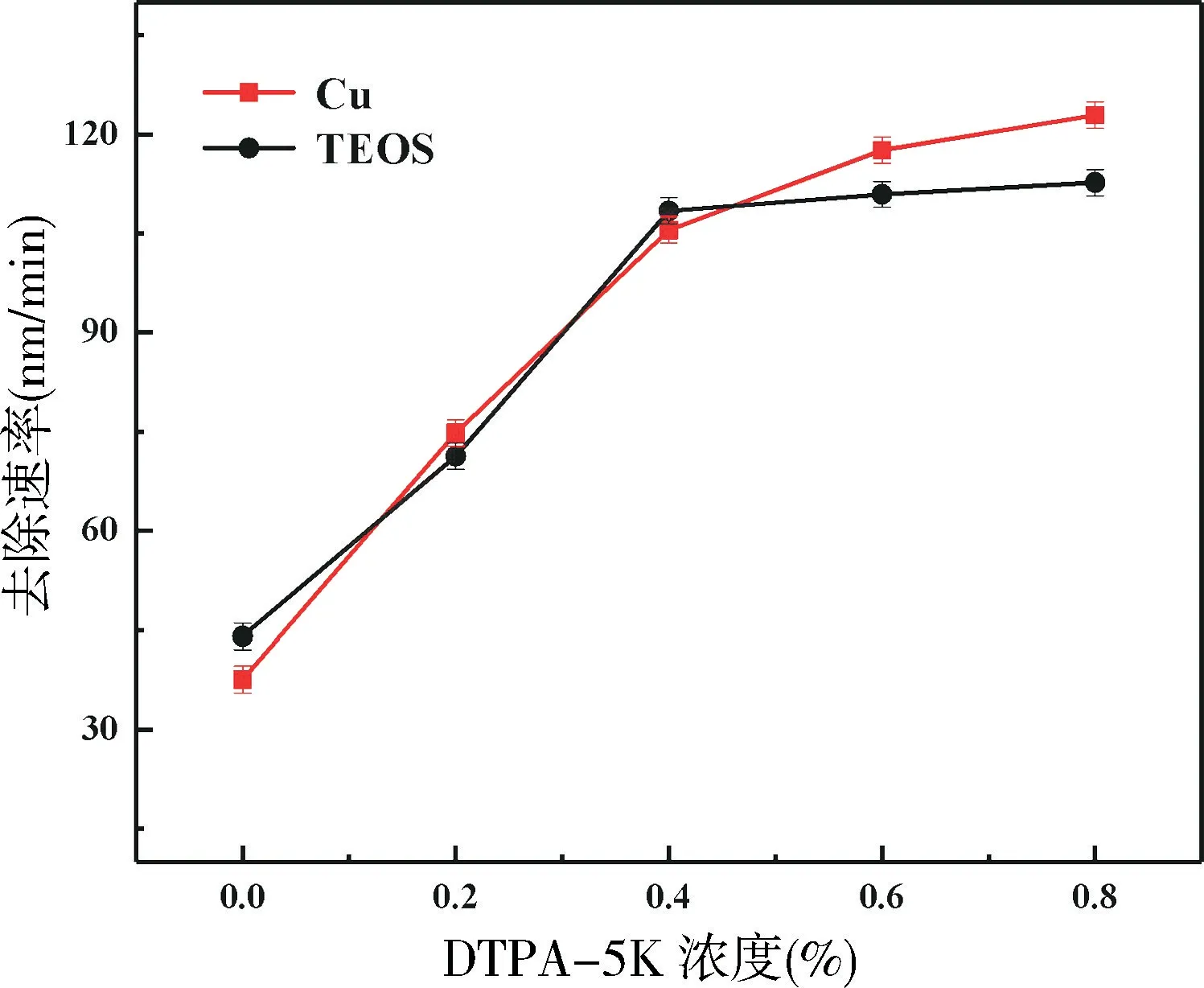
图4 DTPA-5K浓度对Cu和TEOS去除速率的影响Fig.4 The removal rates of Cu and TEOS with different concentrations of DTPA-5K

图5 在1.5%Cu2+(Cu(SO4)2)溶液中加入不同浓度DTPA-5K(从左到右依次为0%,0.2%,0.4%,0.6%,0.8%)后的现象Fig.5 The appearance phenomenon of 1.5%Cu2+solution(Cu(SO4)2)after adding different concentrations of DTPA-5K(from left to right,the concentration of DTPA-5K is 0%,0.2%,0.4%,0.6%,0.8%)
2.2 DTPA-5K对铜和TEOS去除机理分析
为了深入分析DTPA-5K 与Cu之间的反应机理,将铜镀膜片分别浸泡在(Ⅰ)0.15%H2O2和(Ⅱ)0.15%H2O2+0.4%DTPA-5K溶液中,采用XPS检测Cu表面成分组成。其结果如图6所示,可以看出:在引入DTPA-5K后,可以看到Cu 2p峰强度值显著增加,表明DTPA-5K可能络合了更多的Cu2+,从而使更多的Cu表面裸露出来。该循环过程有效地促进了Cu的去除。对于浸泡在仅有H2O2的试样,处理后的表面被CuO和Cu2O 钝化覆盖,因此检测到的铜元素相对较少。
进一步分析Cu表面具体成分组成,试样(Ⅰ)、(Ⅱ)拟合后的Cu 2p3/2光谱分别如图7(a)、(b)所示,试样(Ⅰ)中检测到两个峰,峰值分别为932.4 eV 和933.6 eV,以及在试样(Ⅱ)中,两峰峰值分别为932.3 eV和933.4 eV。这些结果与开放资源库中现有的Cu/Cu2O(932.5 e V)和CuO(933.6 e V)结合能数值相吻合[10]。但是,与图7(a)相比,图7(b)出现了新的峰,峰值为931.5 e V,在数据库中没有相应的物质,可以合理推测是少量反应产物Cu-DTPA-5K吸附在Cu表面,反应过程如式(2)所示[11-12],这进一步说明DTPA-5K可以络合铜离子。

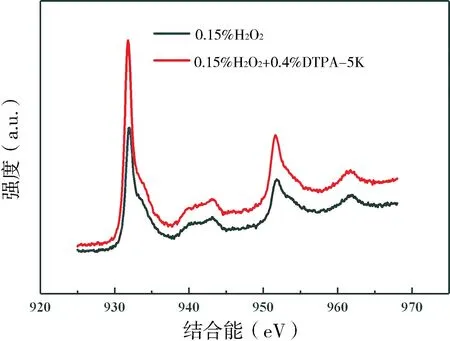
图6 分别浸泡在(Ⅰ)0.15%H2 O2,(Ⅱ)0.15%H2 O2+0.4%DTPA-5K溶液的铜镀膜片表面Cu 2p光谱Fig.6 The whole Cu 2p spectra of Cu blanket wafer after soaking in(Ⅰ)0.15%H2 O2,(Ⅱ)0.15%H2 O2+0.4%DTPA-5K
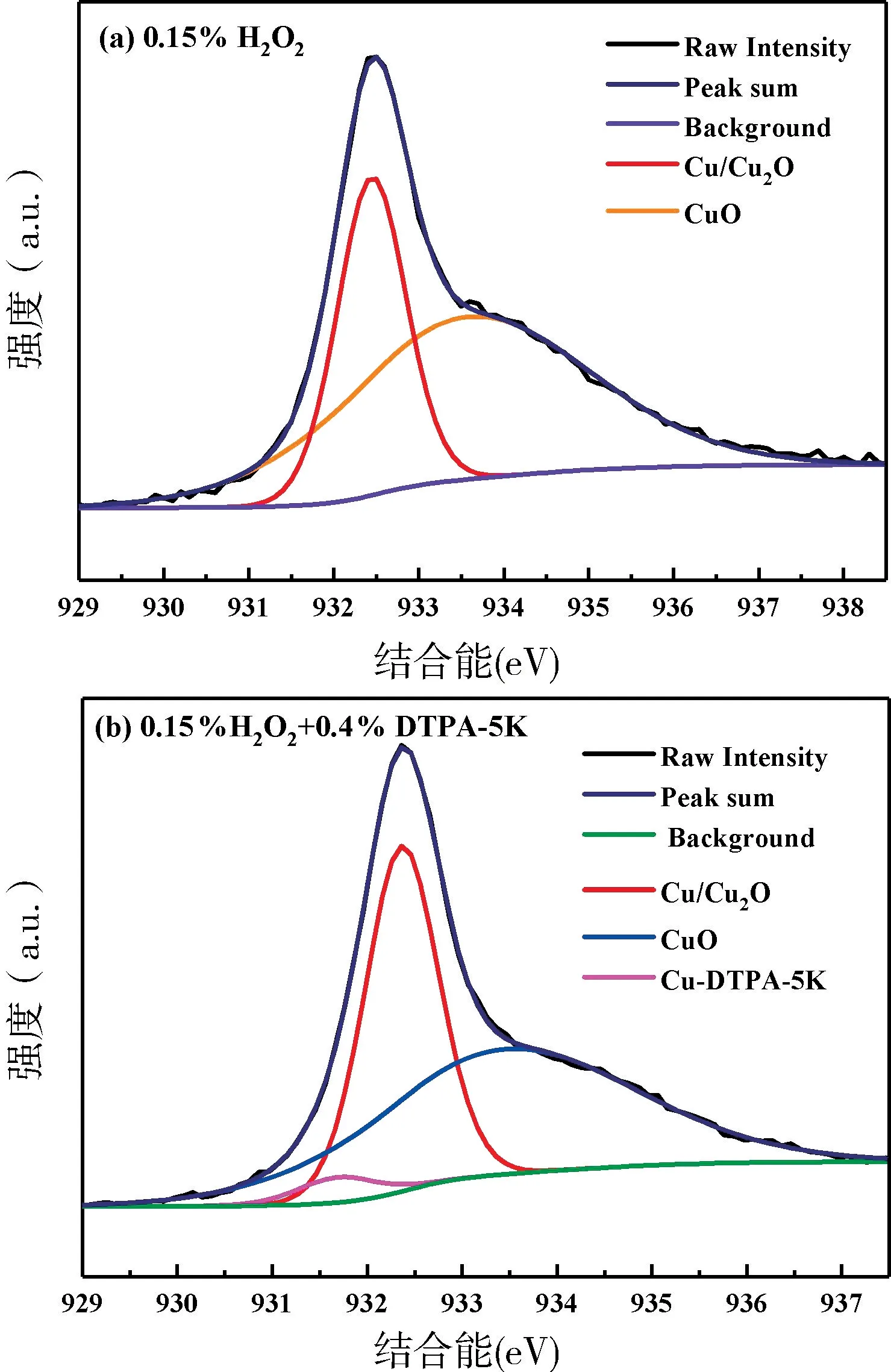
图7 分别浸泡在(a)(Ⅰ)0.15%H2 O2,(b)(Ⅱ)0.15%H2 O2+0.4%DTPA-5K溶液的铜镀膜片表面Cu 2p3/2光谱Fig.7 The peak fitted Cu 2p3/2 spectra from Cu blanket wafer surfaces after soaking in:(a)(Ⅰ)0.15%H2 O2,(b)(Ⅱ)0.15%H2 O2+0.4%DTPA-5K
因此,根据上述讨论,可以得出:在基于H2O2的抛光液中,一系列的氧化反应将在Cu表面发生,从而形成CuO、Cu(OH)2和Cu2O等氧化物,Cu(OH)2可以水解电离生成Cu2+。相关方程式在(3)-(6)中示出。DTPA-5K可以络合Cu2+生成Cu-DTPA-5K 的配合物,而Cu2+的消耗促进了式(6)向正向进行,进而加速了式(3)-(5)的反应,因此加速铜的去除。

DTPA-5K的引入还大大提高了TEOS的去除速率,TEOS是一种掺杂SiO2的薄膜,抛光过程中,水进入其表面层会发生水化反应,导致O-Si-O 键断裂并形成Si-OH,然后生成软质层,随机械作用力迅速去除,反应过程如式(7)所示。同时,表面SiO2与碱性溶液中的OH-形成SiO32-,加入DTPA-5K后,钾离子可以与硅酸根离子反应形成可溶性硅酸钾,这也提高了去除速率,相关反应如式(8)-(9)所示。
碱性条件下,TEOS表面和硅溶胶颗粒表面均呈电负性,添加相反电荷的K+可以降低静电斥力,压缩双电子层[14],增强磨料和TEOS表面之间的机械相互作用,从而提高TEOS去除速率,如图8所示。而K+破坏介质表面结构或是粘附在SiO2表面,都增大了磨损,而促进水分子进入表面,进一步加速水解[15]。

图8 K+在CMP过程中对TEOS作用机理分析Fig.8 Schematic diagram of TEOS removal in CMP process with potassium ion

2.3 TEOS/Cu速率选择比的优化
从2.1节可以看出,虽然DTPA-5K 可以有效地提高Cu和TEOS的去除速率,但由于Cu去除速率较高,TEOS对Cu的速率选择比不能满足要求。因此,引入了绿色无害的抑制剂TAZ来进一步优化,其分子结构与常用的苯并三唑(BTA)相似,但与BTA 相比,Cu-TAZ吸附膜较薄且易于去除,清洗后会留下亲水性的Cu表面[16]。图9(a)所示为在基础抛光液和0.4%DTPA-5K中加入不同浓度TAZ的Cu和TEOS的去除速率。随着TAZ浓度从0 g/L增加到5 g/L,Cu去除速率从105.5 nm/min显著降低到41.7 nm/min。TEOS去除速率在误差范围略有波动,影响可忽略。图9(b)为TEOS对Cu的选择比与TAZ浓度的关系。可以看出,选择比与TAZ浓度成正相关。为了满足选择比1.5~2的工业要求[13],将TAZ的浓度选择为3 g/L,此时选择比为1.96,Cu和TEOS的去除速率分别达到107.4 nm/min和54.9 nm/min。
TAZ的加入有效抑制了Cu的去除,这主要是由于Cu表面形成了阻碍化学反应的双层吸附抑制层[17],如图10(a)所示。Cu表面的铜离子通过与1,2,4-TA-三唑环中的氮原子共享电子形成Cu-TAZ 钝化膜(图10(b))。其次,溶液中游离铜离子形成的Cu-TAZ络合物再沉积,进一步抑制了材料的去除。将铜镀膜片试样浸泡在0.15% H2O2,0.4% DTPA-5K和3 g/L TAZ溶液中,采用XPS检测分析其表面成分,结果如图11所示。其中,图11(a)为N1s光谱,并与2.2节中不添加TAZ 的试样(Ⅱ)对比,图11(b)为Cu 2p3/2光谱图。结果显示,加入TAZ后,N1s的数量明显增加,说明TAZ吸附在Cu表面,对Cu的腐蚀有一定的保护作用。将图11(b)与图7(b)相比,除了Cu/Cu2O,CuO,Cu-DTPA-5K 外,在结合能934.86 e V处出现了一个新的峰,开放资源库中没有对应的物质,但在Zhou等[18-19]文献中也检测到类似峰,可合理认为是Cu-TAZ的复合物。由此推测Cu-TAZ吸附在Cu表面,再次证实了抑制机理。
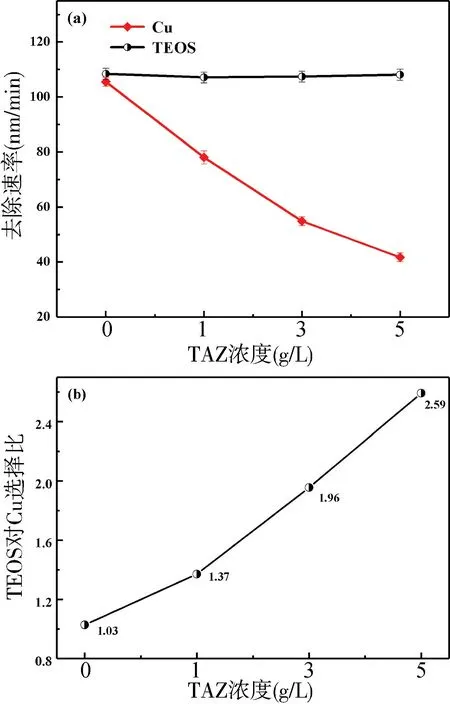
图9 不同TAZ浓度时(a)Cu和TEOS去除速率;(b)TEOS对Cu速率选择比Fig.9 (a)The removal rates of Cu and TEOSand(b)the removal rates selectivity for TEOSto Cu by using different concentrations of TAZ
2.4 平坦化性能检测
根据以上结果,优化后的抛光液组分为10%SiO2,0.15%H2O2,0.4%DTPA-5K和3 g/L TAZ,对65 nm Cu图形片抛光45 s,抛光前后碟形坑腐蚀坑检测结果如图12所示。由图可知,碟形坑均值由112.9 nm下降到55.8 nm,同时腐蚀坑均值由55.6 nm 下降到19.7 nm。结果表明,该抛光液在高速率选择比下体现出较强的修正作用。同样,表面状态也是检测平坦化性能的重要参数,测试CMP前后的表面粗糙度(Sq),结果如图13所示,对铜镀膜片抛光45 s后,Sq由3.35 nm降低到1.08 nm,表现出良好的表面状态。

图10 (a)TAZ在Cu表面的吸附类型;(b)Cu-TAZ 配位过程Fig.10 (a)The adsorption type of TAZ on Cu surface;(b)Cu-TAZ permutation formation process

图12 抛光45 s前后碟形坑(a)和腐蚀坑(b)的值Fig.12 The dishing(a)and erosion(b)values before and after polishing 45 s

图13 抛光前(a)和抛光45 s后(b)的表面粗糙度Fig.13 The roughness value before(a)and after(b)polishing 45 s
3 结论
研究了钾盐络合剂DTPA-5K在阻挡层CMP中对铜和介质材料作用效果的影响。结果表明:可溶性Cu-DTPA-5K络合物的生成是促进Cu去除速率的主要原因,而DTPA-5K 中游离的钾离子增强与磨料间机械研磨,极大地促进了TEOS的去除速率。其次,为了进一步优化TEOS对铜的速率选择比,引入抑制剂TAZ,它对铜表面形成双吸附层降低了铜的去除速率,实现了理想的选择比1.96,最后对图形片抛光45 s,结果显示碟形坑和腐蚀坑得到了明显修正,并且表面状态良好。其结果验证了钾盐络合剂一剂两用,在阻挡层CMP中提高了平坦化性能,并且对后续更小技术节点CMP中添加剂的选择有参考意义。
