氮化镓的干法刻蚀工艺研究
2020-08-25李攀,卢宏
李 攀, 卢 宏
(华中科技大学武汉光电国家研究中心,武汉430074)
0 引 言
人类社会的进步越来越离不开电力,电力的使用过程不可避免地要进行直流交流转换,在该过程中会产生损耗,而环保问题日益突出。直流交流转换需要功率器件,而第一代硅功率器件正逐渐被更加节能、环保的,以GaN为代表的第3代半导体材料所替代[1]。Ⅲ-Ⅴ族化合物半导体以其特殊的材料特性广泛应用于HEMT[2]、激光器[3-6]、调制器[7]、探测器[8-9]、LED[10-11]等各种光电子器件中。感应耦合等离子(ICP)干法刻蚀具有比反应离子刻蚀更高的等离子密度、更低的损伤,还具有更好的侧壁形貌、更高的刻蚀速率和选择比[12],可以进行各向异性刻蚀。
Shul等[14]采用ICP 通入Cl2、H2、Ar刻蚀GaN,得到了光滑的形貌和光滑陡直的侧壁。Han等[15]采用Cl2、BCl3、Ar等气体对GaN/AlGaN 进行刻蚀,提高了ICP刻蚀效果,得到了比刻蚀前更加光滑的刻蚀表面。
本文探索GaN等Ⅲ-Ⅴ族化合物半导体的刻蚀方法,分析刻蚀速率及刻蚀形貌。研究不同掩膜的刻蚀选择比,为这些半导体材料的干法刻蚀提供参考。
1 GaN系材料的干法刻蚀
ICP干法刻蚀原理如图1所示。本文采用英国Oxford公司的Plasmalab System 100(ICP 180)刻蚀机对GaN材料的刻蚀工艺进行探索,采用美国KLA公司KLA TENCOR P16+台阶仪测试刻蚀深度,采用荷兰FEI公司的SIRION 200场发射扫描电镜观察刻蚀形貌。通常刻蚀采用的掩膜有光刻胶(Photo Resist,PR)、SiO2、金属等,本文对PR和SiO2等掩膜分别进行刻蚀,并观察形貌。
2 SiO2掩膜刻蚀GaN工艺
刻蚀参数见表1。表中:tPre指气流稳定吹扫时间;t是刻蚀时间;PICP是电感射频功率;PRF指下电极偏置射频功率;Temp为腔体温度;UDC,BIAS为自偏压;vER为刻蚀速率;选择比指材料刻蚀速率与掩膜刻蚀速率的比值。

图1 ICP体刻蚀原理图[13]
使用直径约5 cm小圆片放在石英盘上刻蚀,刻蚀SiO2掩膜厚度约480 nm,刻蚀后的GaN截面SEM形貌如图2所示。由图2可知,刻蚀效果较好,刻蚀侧壁较垂直。根据测量结果,刻蚀速率约1 μm/min,选择比为1∶7.8。

表1 ICP刻蚀SiO2掩膜GaN的主要参数

图2 SiO2掩膜刻蚀GaN的截面形貌
3 PR掩膜刻蚀GaN
PR掩膜的刻蚀做了两个试验(PR厚度3 μm左右),使用PR为AZ6130,匀胶两次,刻蚀参数见表2。

表2 ICP刻蚀PR掩膜GaN的主要参数
使用PR掩膜时,为了解决刻蚀时温度过高,PR易碳化的问题,需要尽可能地降低刻蚀的ICP功率,而增大RF功率,即增大物理刻蚀的效果。其刻蚀效果见图3。

图3 PR掩膜刻蚀GaN的截面形貌
由图3可见,使用PR掩膜时,刻蚀侧壁较垂直,但是随着刻蚀ICP功率的增大,两层光刻胶由于烘干时间不足,产生了分层,导致刻蚀有台阶。因此使用PR掩膜进行刻蚀时,需要将光刻胶彻底烘干,且最好一次匀胶,保证光刻胶的均匀性。
4 GaN侧边倾斜角较大的刻蚀
有时需要刻蚀的侧壁有一定的倾斜度,其刻蚀工艺见表3。为了得到刻蚀效果为侧壁较倾斜,需要增大BCl3的比例,减小直流BIAS偏压,使BCl3的侧壁保护效果得到加强,其效果见图4。

表3 ICP刻蚀倾斜侧壁GaN的主要参数

图4 倾斜侧壁GaN的刻蚀截面形貌
由图4可知,使用该程序可以达到要求,但是在刻蚀的时候会降低刻蚀的速率及刻蚀的选择比。
5 刻蚀的均匀性及重复性
5.1 刻蚀均匀性
均匀性采用在相对极差的一半前面加上“±”来表示。刻蚀的均匀性的测试,晶圆片的测试是选择两个小片,放在直径约10 cm晶圆托盘上刻蚀,然后测试两片之间的均匀性。对于小片之间的均匀性,主要采取在4个位置每个位置放置1个小片,然后进行刻蚀,再测试其均匀性。其试验工艺参数见表4。其中№8刻蚀目的是为了测试片内的均匀性,共放置片子为2个小片,刻蚀效果见图5,均匀性测试结果数据见表5。

表4 ICP刻蚀GaN的主要参数
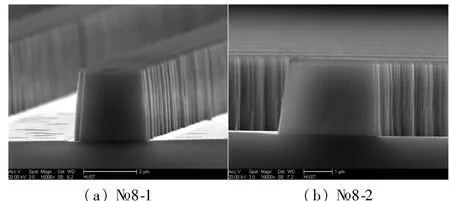
图5 GaN的刻蚀截面形貌

表5 ICP刻蚀GaN的均匀性测试结果
№9刻蚀目的是为了测试4个小片之间的均匀性,共放置4个小片,均匀性测试数据见表6。刻蚀效果见图6。

表6 ICP刻蚀GaN的均匀性测试结果

图6 刻蚀均匀性测试截面形貌
5.2 刻蚀重复性测试
重复性采用在相对极差的一半前面加上“±”来表示[16]。重复性是短时间内由同一程序连续刻蚀后进行对比。由上面的试验№8和№9的数据可以计算出两次刻蚀的重复性为±2.51%。
6 结 语
研究了GaN刻蚀的刻蚀速率、选择比、形貌,分别对金属掩膜、SiO2掩膜和PR掩膜刻蚀形貌进行了对比。研究了工艺气体对刻蚀形貌、刻蚀速率、选择比的影响。实验结果表明,采用Cl基气体可以对GaN材料进行刻蚀,刻蚀侧壁及底部形貌光滑。增大BCl3的比例可以获得倾斜侧壁的GaN刻蚀形貌。
