LTCC基板化学镀镍镀钯浸金工艺研究
2020-07-18王颖麟
王颖麟 李 俊
(中国电子科技集团公司第二研究所,山西 太原 030024)
0 引言
低温共烧陶瓷(Low Temperature Co-fired Ceramic,简称LTCC)技术是20世纪80年代发展起来的实现高密度多层基板互连的技术。由于其三维布线灵活度高,信号传输速度快,高频特性好,集成密度高,可靠性好等一系列优点被广泛应用于微波通信、航空航天和军事电子等领域。在LTCC技术中,一般使用金或者银作为导体材料。由于其电导率更高,电路损耗低,使用频率可高达几十GHz,但同时金等贵金属的使用也使得LTCC成本更高,成为限制LTCC技术发展和推广的一个重要制约因素。根据统计,LTCC全金基板金浆料成本占整个基板材料成本的60%甚至更高。
全银LTCC基板化学镀工艺是指在全银LTCC基板表层、背面层以及腔体内露出层的银导体上化学镀镍/钯/金(ENEPIG)层,既能解决银导体易氧化和银离子迁移的问题,又能大量减少金等贵金属的使用,大幅度降低LTCC基板制造成本,并实现键合、焊接等互联需求。全银LTCC基板化学镀工艺具有以下优点:
(1)镀层均匀性好,镀层晶粒细,无孔,耐腐蚀性好,化学稳定性好,接触电阻低,导电性能好,易于焊接。
(2)化学镀工艺设备简单,无需电源和电极。
(3)化学镀不受基板复杂程度影响,与电镀相比,可镀表面具有大量孤岛焊盘的复杂布线基板,避免电镀工艺中的工艺线将孤岛焊盘互联,大大简化了表面镀覆工艺流程,成为LTCC/HTCC(高温共烧陶瓷)高密度布线基板的优选方案。
(4)与全金LTCC基板相比,极大减少了金、铂、钯等贵金属的使用量,从而降低了成本,仅有全金LTCC基板成本的30%~40%左右,为微波LTCC多层基板的低成本生产提供了一条有效的技术途径。
(5)ENEPIG镀层能够满足多种封装工艺的需求,例如表面组装工艺、金属丝键合工艺、倒装芯片焊接工艺等,具有万能镀层的美誉。
(6)由于在镍层和金层之间加入一层钯层作为阻挡层,降低了镍金原子之间扩散,避免了焊盘黑化引起的焊盘失效问题,同时也改善了金丝键合能力,提高了产品的可靠性。
1 原理和工艺流程
1.1 原理
化学镀是指在没有电流通过的情况下,利用化学方法使溶液中的还原剂被氧化而释放自由电子,把金属离子还原为金属原子并沉积在基体表面,形成镀层的一种表面加工方法。全银LTCC基板化学镀工艺是指在全银LTCC基板表层、背面层以及腔体内露出层的银导体上ENEPIG,LTCC基板化学镀镍钯金镀层结构(见图1)。
LTCC基板ENEPIG工艺表面镀层的生长分为3步,分别化学镀镍、化学镀钯、化学浸金,化学镀镍是以次磷酸盐作为还原剂而进行自催化氧化还原反应,进而在银面上沉积上一层均匀致密Ni-P层,反应如下:
H2PO2-+H2O→HPO32-+H++2H
Ni2++2H→Ni↓+2H+
2H2PO2-+H→HPO32-+H2O+P+H2↑
化学镀钯的反应机理和化学镀镍的机理相同,通常采用次磷酸钠+盐酸体系进行氧化还原反应生成致密的Pd-P层,反应示意图如图1,钯层会直接沉积在Ni-P层上,钯层比镍层更为致密,可有效阻止镍腐蚀的发生。反应方程式如下:
H2PO2-+H2O→HPO32-+H++2H
Pd2++2H→Pd↓+2H+
22H2PO2-+H→HPO32-+H2O+P+H2↑
化学浸金属于置换反应,金与镍置换或者金与钯置换,反应方程式如下:
2Au++Pd→2Au+Pd2+
或2Au++Ni→2Au+Ni2+
其中,当钯层较厚时,则钯层排列致密,只发生金与钯置换的反应;若钯层较薄,则金液会透过钯层晶格间隙与镍层接触,金即与钯置换也与镍置换,会造成钯层与镍层剥离的风险,因此,钯层须有一定的厚度。
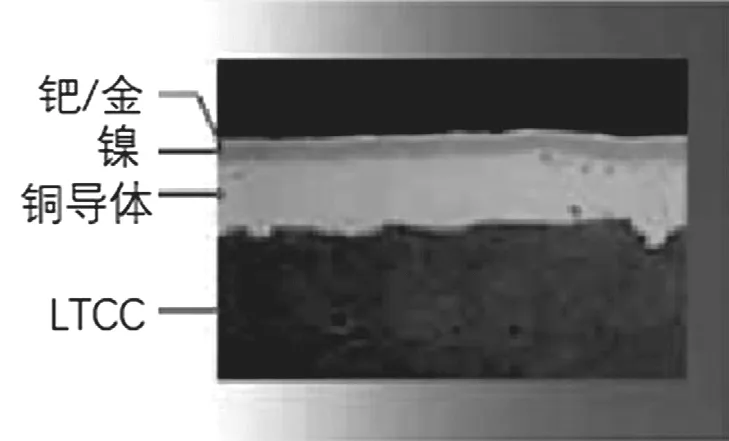
图1 LTCC基板化学镀镍钯金镀层结构
1.2 工艺流程
LTCC基板化学镀与常规的PCB在结构上有很大的不同,首先,LTCC基板表面银导体中含有较多的玻璃相,活化难度较大;其次LTCC材料密度低,耐酸碱腐蚀性差,易受到镀液腐蚀;另外,LTCC基板大多具有复杂的腔体结构,腔体内银层镀液流动性差,不易清洗和刻蚀、活化,易产生渗镀漏镀等质量问题。所以LTCC基板化学镀工艺必须通过多次试验验证,优化工艺和参数,保证基板的质量。
LTCC基板ENEPIG流程为:
除油→清洗→蚀刻→中和→活化→化镀镍→化镀钯→化镀金
1.2.1 除油工序
由于LTCC基板不耐酸性和碱性溶液腐蚀,相对而言,耐酸性更差一些,所以采用弱碱性除油剂进行基板表面的除油工序,除油工序温度为50 ℃,除油时间为5 min。除油后进行热水洗和等离子水清洗,清除残留的除油剂有机成分。
1.2.2 蚀刻
LTCC基板表面银导体中含有较多的玻璃成分,可镀性差,需要对基板表面银导体进行玻璃相刻蚀,改善银导体表面状态,从而改善化学镀层质量。蚀刻溶液的选择主要从两个方面考虑:第一,能达到较好的蚀刻效果,改善LTCC基板银导体表面状态,增强导体层的可镀性;第二,对陶瓷基板没有腐蚀。通过对不同种类刻蚀溶液刻蚀效果的试验和比较,选用40 g/L的氢氧化钠溶液进行银导体表面的玻璃相刻蚀。
1.2.3 活化
活化处理是将刻蚀后的基板浸如含有催化活性的贵金属化合物溶液中,使基板表面金属导体上生成一层具有催化活性的贵金属层,这些具有催化活性的金属微粒是化学镀的结晶中心。本文中LTCC基板采用的离子型活化液一般是氯化钯型活化液,氯化钯活化液价格比较高,但稳定性好,使用寿命长。活化是LTCC基板化学镀的重要工序,活化工艺的好坏直接影响到后续镀层质量,活化工序的主要参数包括活化液钯离子浓度、活化温度和活化时间,钯离子浓度过低,容易导致漏镀;钯离子浓度过高,容易导致渗镀。活化采用钯浓度50 mg/L的中性活化液,化镀后基板无渗镀,漏镀现象发生,可以得到外观良好的镀层。活化温度对镀层外观质量有明显的影响,活化温度过高,容易产生渗镀,活化温度过低,容易产生漏镀。活化时间对渗镀漏镀有一定影响,活化时间过短,容易产生漏镀。
1.2.4 化学镀镍
镍层的作用主要有两方面:一是作为阻挡层,防止LTCC基板银层和镀金层的相互扩散;二是在焊接时与Sn形成良性介面合金共化物Ni3Sn4,保证良好的装配焊接性能。陶瓷基板化学镀镍一般采用化学镀镍-磷合金或者化学镀镍-硼合金,本文中LTCC基板化学镀镍采用化学镀镍-磷合金,化学镀镍-磷合金是在Pd催化表面的作用下,采用NaH2PO2作为还原剂,通过氧化还原反应沉积Ni层;镍层中含磷量5%左右。当Ni层完全覆盖Pd催化层后,单质Ni又作为化学镀镍的催化剂,促使Ni沉积过程继续进行。LTCC基板化学镀镍层厚度一般为4~6 μm。
1.2.5 化学镀钯
钯层作为阻挡层,阻止了Au沉积过程中溶液对Ni层的腐蚀,也阻挡了Ni向Au层扩散;同时,致密的Pd层也可作为抗氧化层、抗腐蚀层,提高可焊性。化学镀钯的反应机理与化学镀镍相似,也采用NaH2PO2作为还原剂,通过氧化还原反应沉积Pd层。
1.2.6 化学浸金
ENIG工艺中金层具有低接触电阻、不易被氧化、强度高耐摩擦的特点,可以满足电路导电性要求,保护Ag层和Ni层不被氧化,从而保证Ni层的可焊性。化学浸金是通过置换反应在Ni层表面生成Au层;置换反应将在生成的Au层完全覆盖Ni层后终止,因此,Au层厚度较薄。
2 实验过程
2.1 LTCC基板材料选择
与PCB、氧化铝等基板相比,LTCC基板从材料和化镀工艺方面都有很多不同之处,LTCC基板化学镀工艺主要难点有以下几点。
根据LTCC基板化学镀工艺的特点,LTCC基板材料的选择一般应满足以下要求:
(1)陶瓷烧结后致密性好,耐酸碱腐蚀,对化镀镀液不产生污染;
(2)基板表面银导体致密性好,孔隙率小,玻璃含量较少;
(3)基板表面银导体层粗糙度适中,可镀性好,镀层附着力好。
实验选用杜邦9k7全银材料体系的LTCC基板进行化学镀,并对化镀结果进行测试。
2.2 化学镀工艺参数选择
(1)LTCC基板表面银导体中含有较多的玻璃相,活化难度较大。
(2)LTCC基板表面布线密度大,线宽/线间距较小,容易产生渗镀,导致短路。
(3)LTCC基板大多具有复杂的腔体结构,腔体内银层镀液流动性差,不易清洗和刻蚀、活化,易产生渗镀漏镀等质量问题。
(4)LTCC材料密度低,耐酸碱腐蚀性差,易受到镀液腐蚀。
另外,化学镀液稳定性较差,易造成工艺不稳定,容易造成渗镀、漏镀、焊盘腐蚀、陶瓷腐蚀等质量缺陷(见表1)。
3 结果与讨论
3.1 镀层基本性能
镍钯金化学镀LTCC基板样品如图2所示,无色差、漏镀、渗镀,陶瓷基板无腐蚀。图3为化学镀镍钯金LTCC基板SEM(扫描电子显微镜)图和EDS(能散X线光谱仪)分析结果,可以看出基板镀层致密,镀层无污染。

表1 化学镀工艺参数
3.2 镀层厚度
ENEPIG在LTCC基板实际应用中表面镀层需要满足锡铅焊或者金锡焊、金丝键合等组装要求,组装工艺一般为先进行锡铅或者金锡焊接,再进行金丝键合,如果镀金层厚度太薄,在焊接后金层会发白,影响键合可靠性,为了解决金层焊接后发白的问题,对化学镀工艺进行调整和优化,主要调整两个方面:(1)通过增加镀钯时间,增加钯层厚度;(2)使用还原性质的镀金液对金层进行加厚。
使用X射线衍射镀层膜厚测试仪对调整优化ENEPIG工艺前后的镀层厚度进行测试,测试结果(见表2)。
将调整工艺后的LTCC基板进行300℃高温烘烤试验,无金层发白现象。由此可见增加钯层和金层厚度可以有效防止焊接后金层发白现象,有效提高焊接后金丝键合可靠性。
3.3 镀层可焊性
对化学镀镍钯金LTCC基板可焊性进行测试,膜层上锡良好,缺陷面积小于5%,可焊性合格。
3.4 镀层键合强度测试
用金丝键合机在测试样品表面键合20根25 μm金丝,然后使用拉力测试仪进行拉力测试,测试结果(见图4)。
4 结束语
全银材料体系LTCC基板化学镀基板工艺与传统LTCC技术相比,具有成本低,可焊性好,可同时满足金锡焊、锡铅焊、金丝键合等多种组装工艺等优势,与电镀工艺相比,避免了金属辅助线电连接,对于复杂布线结构、孤单焊盘多的LTCC基板具有良好的应用前景。通过优化LTCC基板镍钯金化学镀工艺,解决了高温焊接后金层颜色发白,键合可靠性差的难题,通过对镀层厚度、镀层可焊性、金丝键合拉力等性能进行测试,均满足产品应用需求。

表2 ENEPIG的镀层厚度

图4 键合强度测试
