一种新型大尺寸多晶硅片晶向的光学扫描方法
2020-06-09付少永李云珠张映斌
熊 震,付少永,李云珠,殷 丽,张映斌
(天合光能股份有限公司光伏科学与技术国家重点实验室, 常州 213031)
0 引言
在多晶硅铸锭时,由于温度梯度和坩埚限制会引入大量应力,从而造成多晶硅锭缺陷密度随着晶体生长高度的增加而增长。过去几年,多晶硅行业对控制多晶硅锭缺陷增殖进行了大量研究,有研究表明,应力可以通过控制晶向和晶界来释放。FUJIWARA 等[1]报道了一种枝状晶体生长技术,该技术在晶体生长前期采用<112>和<110>晶向做籽晶来控制其微结构。XIONG 等[2]的研究表明,类单晶硅太阳电池的短路电流与其所采用的硅片的晶向有明显相关性。为降低多晶硅片缺陷密度,提高多晶硅太阳电池的质量,检测、监控及扫描多晶硅片晶向被多次提及,但目前行业仍缺乏一种适合于生产中应用的快速检测方法。
目前已经存在多种硅片晶向分析方法,其中X 射线衍射[3]、中子衍射[4]和电子衍射[5]是最成熟的方案,但这些技术较适用于单点测试,对于硅片这种面积较大的样品不太适合。电子背散射衍射技术(EBSD)[5-6]可适用于硅片的整面扫描,但该方法通常适用于面积较小(1~2 cm2)的硅片;且其对制样的要求较高,需要精密抛光;测试时间也较长,典型的测试时间为60 min。因此,该方法仍不太适合于批量的大尺寸硅片的晶向检测。20 世纪末,WANG 等[7]提出了基于硅片表面SEM 形貌的晶向分析方法,但该方法仅限于定性分析且耗时也较长。
上述测试方法都由于某些原因而无法对大尺寸硅片进行准确扫描,直到近几年,德国的Franhofer 研究所推出了一种劳厄扫描仪[8],才实现了对大尺寸多晶硅片晶向的扫描,但该方法的测试时间较长,需要1~2 h。基于此,本文提出了一种简单易行,可以快速、低成本地实现大尺寸多晶硅片晶向的光学扫描方法。
1 理论预测
在一块多晶硅片上,肉眼可见多个晶粒,从不同角度去观察这些晶粒,会发现晶粒的对比度发生了变化;当对硅片进行一些预处理(如碱制绒)后,可以发现晶粒的对比度增强了。这种对比度来源于晶体表面的微观形貌,而微观形貌取决于晶体表面的晶向。晶体硅是典型金刚石结构,其原子密排面是<111>面,在机械加工或碱制绒时能量最低的密排面更倾向于保留下来。不同晶向指数的晶体表面,由于其与<111>面夹角不同,会保留特定的微观形貌。以单晶硅片为例,晶体表面是晶向<100>,其平面与<111>晶面的夹角均为57.3°,围成了一个正金字塔结构。对于多晶硅片而言,晶粒的晶向除了<100>,还有很多其他种类,硅片表面形貌也大不一样,这主要取决于实际晶向与<111>晶向夹角。其表面的精确形貌可以通过解析几何计算得到,方法就是在实际晶体表面所在平面去截一个正八面体,分析所切割的部分。
假定一块晶体硅在三维空间内无限延伸。图1 为晶体硅任意晶向的晶面制绒后的3D 形貌及其2D 投影。如图1a 所示,8 个<111>晶面在oxyz笛卡尔坐标系里围成了一个正八面体;假设图1b~图1d 中的橙色面是硅片表面,则<111>晶面的法向量在硅片表面的投影会随切割面角度的变化而变化。在切割面上定义一个xoy坐标系,可以计算出这些法向量在xoy坐标系内的2D投影。由此可知,当相机处于法向量投影方向时,可观测到最强的反射信号。

图1 晶体硅任意晶向的晶面制绒后的3D 形貌及其2D 投影Fig. 1 3D morphorlogy and its 2D projection on textured crystal silicon surface with a random orientation
上述2D 投影向量可以由反射曲线的峰值检测到,而且从<111>晶面的3D法向量的定义出发,2D 投影向量也可以被还原成空间的3D 形式。
假设v1

将相关参数代入式(1)可以得到6 个等式,但需要求解的未知数只有z1~z4这4 个,这是一个超定方程组,可采用数值分析的方法求解。
晶粒的晶向指数可以由特征谱线的峰值计算得出,也就是将各单位法向量求和。
为了便于确定和区别晶体中不同的晶向,国际上采用晶向指数来标定晶向。
由于晶体结构的对称性,只要得到3 个或4个3D 向量,其余的第4 个或第5 个向量都能推断出来。从理论上来看,利用反射谱线峰值能够检测出晶粒的晶向,下文将通过实验进行验证。
2 实验
2.1 实验和装置的设计
选取1 块面积为100×100 mm2的多晶硅片作为实验硅片,经过10 min的标准碱制绒工艺后,硅片获得了更加明显地晶粒对比度。图2 为实验硅片碱制绒后晶粒的外观图,其中,晶粒a~晶粒d 为不同对比度的典型晶粒。

图2 实验硅片碱制绒后晶粒的外观图Fig. 2 Appearance of grains after experimental silicon wafer alkaline texturing
用电子扫描显微镜(SEM)观察了图2 中晶粒a~晶粒d 的表面微形貌,如图3 所示。从图中可看出,不同对比度的晶粒,其微观形貌区别也较大。

图3 不同晶粒的表面微形貌SEM 图Fig. 3 SEM images for the surface morphology of different grains
无论是否采用制绒工艺,从不同角度去观察一块多晶硅片,其表面的晶粒对比度都会发生变化。由此可知,这种各向异性是由微观形貌造成的。
本文设计了一种实验装置来记录实验硅片上晶粒对比度的变化,该装置由1 个光学旋转台、1 个漫反射LED 屏和2 部相机组成,其结构示意图如图4 所示。以光学旋转台表面的旋转中心为圆心,建立3D 的笛卡尔坐标系,z轴垂直于旋转台表面,x轴正半轴指向并垂直于漫反射LED屏,xy所在平面与实验硅片表面重合。
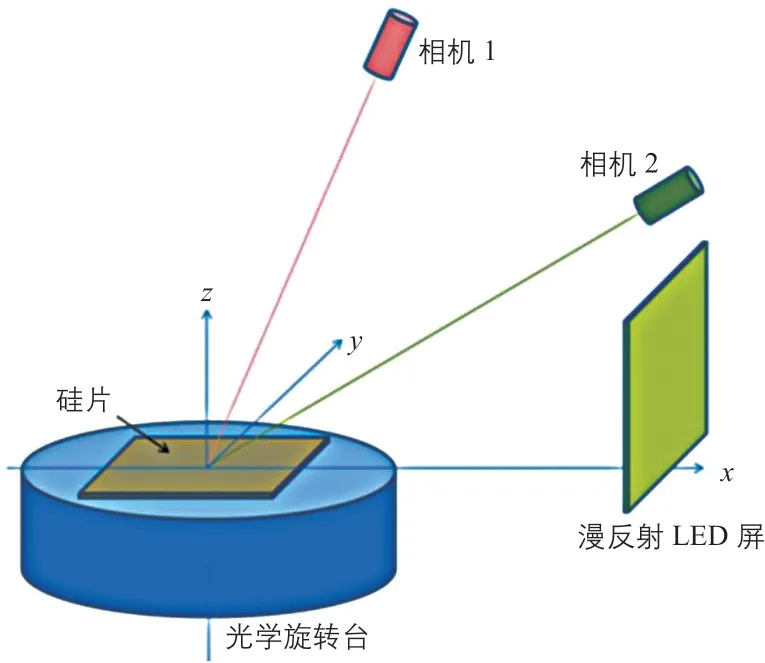
图4 实验装置的结构示意图Fig. 4 Schematic diagram of the experimental device
2.2 图像处理及数据分析
对光学旋转台上的硅片拍照,将1 部相机任意角度采集得到原始图像(见图5a),根据文献[9]中的投影变换方法,可变换得到初始角度(0°)时的图像(见图5b),然后将投影变换过程中生产的0°~359°的图像排成一列(见图5c)。由于是2 部相机,所以可得到2 列这样的序列。


图5 不同情况下的图像Fig. 5 Images in different situations
取出同一像素时0°~359°投影变换得到的所有图像中的亮度值,并在极坐标中生成角度-亮度散点图,可以得到非常有特征的反射图谱,如图6 所示,其中红色和蓝色谱线分别代表2个相机拍摄到的反射谱线。从每个晶粒上都能得到若干个亮度极值,图6 的反射谱线中一般包含3~4 个亮度峰值。


图6 晶粒a~d 的反射图谱Fig. 6 Reflection intensity pattern of grains a~d
2.3 大尺寸样品的数据校正
测试大尺寸硅片时,绝大多数晶粒并不能处于光学旋转台的正中心,因此检测的反射谱线峰值与<111>晶面的法向量会有一定偏差。
假设图7 中一个任意晶粒g 处于向量V0位置,晶粒g 存在一个<111>晶面的法向量V1。实际测试过程中,假设在向量Vc1方向观察到了亮度峰值,那么可以通过式(2)计算出V1。

图7 的模型解释了这种偏差的来源,并提出了校准方法。在模型中,所有元器件都被投影到xoy平面内,并以硅片为参照物,相机和光源在绕原点公转。

图7 大尺寸硅片峰值偏差解释模型和校准方法Fig. 7 A model to explain and calibrate the vector deviation on large silicon wafer
校正过程十分必要,尤其是相机1 的Vc1的模要小于相机2 的Vc1的模。
3 结果与讨论
基于上述分析和校准方法,图3 中4 个晶粒的晶向指数的计算结果为:晶粒a<0.469,0.569, 0.085>、晶粒b<0.977, 0.100, 0.000>、晶粒c<0.579, 0.564, 0.588>、晶粒d<0.923, 0.168,0.021>。
为了检验本文所提出方法的精确性,通过激光切割,选取了2 个面积为1 cm2的样本,分别采用本文所设计的光学扫描方法与X 射线衍射(XRD)进行晶向检测,并将检测结果进行对比,结果如表1 所示。

表1 光学检测与XRD 检测结果对比
XRD 是一种较为精确的晶向检测方法,其精度一般高于0.5°。由表1 可知,本文所设计的光学扫描方法与XRD 检测结果的最大差异是0.84°,因此本文所设计的检测方法的检测精度小于1.34°。
本文所设计的光学扫描方法可适用于所有晶粒晶向的精确检测。由于硅片中的晶粒较多(多达数千),为方便显示,按角度差异将晶向归为<100>、<110>、<111>、<124>、<205>、<113>和<122>这7 类。按此分类,实验所用的面积为100×100 mm2多晶硅片的晶向光学扫描结果如图8所示,面积为100×100 mm2的硅片的测试时间小于10 min。本方法可用于多晶硅铸锭的优化和高效多晶硅片的研发。

图8 100×100 mm2 多晶硅片晶向的光学扫描结果Fig. 8 Orientation mapping of 100×100 mm2 polysilicon wafer
4 结论
本文提出了一种大尺寸多晶硅片晶向的光学扫描方法,经测试对比,该方法与XRD 检测结果的差异在1°以内,面积为100×100 mm2硅片的测试时间小于10 min,大约可以实现1000 多个晶粒的识别和晶向计算,并可按角度差异将晶向归为7 类显示在晶向扫描图中。该方法可用于多晶硅铸锭的优化及高效多晶硅片的研发。
