AlGaN/GaN高电子迁移率器件外部边缘电容的物理模型*
2020-04-30刘乃漳张雪冰姚若河
刘乃漳 张雪冰 姚若河
(华南理工大学电子与信息学院, 广州 510640)
AlGaN/GaN HEMT外部边缘电容Cofd是由栅极垂直侧壁与二维电子气水平壁之间的电场构成的等效电容.本文基于保角映射法对Cofd进行物理建模, 考虑沟道长度调制效应, 研究外部偏置、阈值电压漂移和温度变化对Cofd的影响: 随着漏源偏压从零开始增加, Cofd先保持不变再开始衰减, 其衰减速率随栅源偏压的增加而减缓; AlGaN势垒层中施主杂质浓度的减小和Al组分的减小都可引起阈值电压的正向漂移, 正向阈值漂移会加强沟道长度调制效应对Cofd的影响, 导致Cofd呈线性衰减.在大漏极偏压工作情况下, Cofd对器件工作温度的变化更加敏感.
1 引 言
AlGaN/GaN高电子迁移率晶体管(high electron mobility transistor, HEMT)具有良好的高频和高功率特性, 在射频领域得到了广泛的关注[1,2].GaN HEMT的C-V特性是器件的一个重要参数.其栅极电容可以分为本征电容和二维电子气 (two-dimensional electron gas, 2DEG)电极边缘电容两部分, 而边缘电容在总的栅极电容中占有相当大的比例, 器件正常工作状态下占10%以上,在弱反型或截止区时甚至达到90%[3].边缘电容包括内部边缘电容Cifs/d和外部边缘电容Cofs/d, 其中Cofs/d会受到外部偏置的影响, 特别是漏端一侧的外部边缘电容Cofd所受的影响尤为明显.
Pregaldiny等[4]曾指出LDD MOSFET内部边缘电容Cifs/d与器件所施加的栅极电压密切相关, 建立了 Cifs/d对应的物理模型.Bansal等[5]利用保角映射法对DGMOS的外部边缘电容Cofs/d进行了物理建模, 该Cofs/d模型中的变量由工艺参数决定, 未考虑外加偏压对Cofs/d的影响.之后,Zhang等[3]推导了GaN HEMT包含边缘电容Cifs/d和Cofs/d的电容模型, 认为边缘电容对GaN HEMT器件开关特性有着重要的影响.最近, Li等[6]建立了适用于GaN HEMT边缘电容的电荷模型, 指出外部边缘电容与施加的漏极偏压相关, 之后Jia等[7]对GaN HEMT边缘电容模型进行了改进, 在传统Cofs/d模型前添加指数修正函数来表述Cofd随外加偏压的变化情况.到目前为止, 由于利用保角映射法推导得到的Cofd模型只与工艺参数相关,常被当作固定值处理.而实验发现它会受到外加偏置电压的影响, 但目前已报道的研究文献尚未给出Cofd关于外加偏压的理论解释及相应的物理模型, Cofd关于外加偏压的物理模型有待确立.
本文通过分析外部边缘电容的形成机理, 推导出新的Cofd的核心模型, 同时利用沟道长度调制效应确定漏端沟道长度, 研究了外加偏压、温度变化及阈值电压漂移对Cofd的影响, 建立了相应的Cofd物理模型.
2 物理模型推导
GaN HEMT的沟道长度与器件工作状态相关.以耗尽型 GaN HEMT 为例, 其关断 (OFF)与开启(ON)状态示意图如图1所示.当Vg低于阈值电压(Vth)时, 器件处于关断状态, 此时Vg太小不足以在AlGaN/GaN形成能供2DEG运动的势阱, 在栅极下方形成一小区域的耗尽区[7], 2DEG沟道被耗尽区隔开为漏端沟道和源端沟道.同时,在栅极与漏极之间, 靠近栅极的AlGaN类施主表面陷阱起着“虚栅”的作用[8], 这个能够俘获电子的虚栅使栅极和漏极之间的等效电位(VGD)降低, 把栅极靠近漏端下方的2DEG也耗尽[9], 导致耗尽区向漏端延伸, 漏端沟道长度(Ld)减小; 当Vg足够大且稳定时, HEMT处于开启状态, 栅极下方的耗尽区消失, 同时类施主表面陷阱释放电子, 由虚栅引起的耗尽区也连同消失, 这时漏或源端沟道长度都达到最大值.

图1 GaN HEMT 不同工作状态下外部边缘电容示意图(a)处于关断状态; (b)处于开启状态Fig.1.Schematic of GaN HEMT outer fringing capacitances in different state: (a) In the OFF-state; (b) in the ON-state.
Cofs/d是由栅极垂直侧壁与漏(源)2DEG水平壁之间的电场构成的等效电容, 该电容与沟道长度密切相关.而由于Ld同时受沟道长度调制效应和表面陷阱变化的影响, Cofd随外部偏压变化情况比Cofs更复杂.
2.1 Cofd核心模型
图2是与Cofd相关电场的示意图, Tg是栅极的厚度, TAlGaN是 AlGaN 势垒层的厚度, Ldep_d是类施主表面陷阱对2DEG的耗尽长度, Ld是不考虑沟道长度调制效应时的漏端沟道长度.

图2 栅极侧壁与 2DEG 之间的电场示意图Fig.2.Schematic of normal electric field between the side wall of the gate and the 2DEG.
求解Cofd需要先将电场转换成共焦电场, 以最里面的电场线作为参考, 它的焦点是

假设其外部的共焦电场表达式为

结合(1)式可以求出外部电场与内部电场共焦时Tcg应当满足的条件:

共焦后的电场示意图如图3(a)所示, 令Lcd=Ld后电场示意图如图3(b)所示.
求出共焦电场后利用转换函数将共焦电场转换成平板电容模型, 转换函数如下:


图3 (a)共焦后的电场示意图; (b) Lcd = Ld 时的共焦电场Fig.3.(a) Electric field lines after transforming the nonconfocal elliptical system to the confocal system; (b) the confocal system with Lcd = Ld.

其中, x和y都是X-Y坐标系对f归一化后的数值, u 表示电势, v 表示电场.把 v1和 v2与 Y 轴的交点 ( 0, TAlGaN/f)和(0, (TAlGaN+ Tcg)/f) 分别代入(4a)式可以求出v1与v2,

同时把(3)式代入到v2中可以得到v2关于Lcd的表达式,

同理, 也把两个交点代入(4b)中可以求得u1和 u2的表达式: u1= 0, u2= π/2.然后利用平板电容的公式,

把 v1, v2, u1, u2全部代入到 (6)式中可以计算出共焦电场的等效边缘电容Cofd,

其中: ex是介于钝化层SiNx与AlGaN势垒层之间的等效介电常数[3], 这是因为电场线同时穿过钝化层SiNx和AlGaN势垒层; W表示器件宽度.
如图4所示, 因为在计算共焦电场时, 作出了Lcd= Ld的假设, 所以得出的外部共焦电场其实比原本的最外部的电场大, 需要在Lcd前添加修正函数h, 最终得到的Cofd表达式如下,

t, a, b, c 为拟合参数.

图4 Lcd = Ld 所引入的误差Fig.4.Error in the confocal system with Lcd = Ld.
2.2 沟道长度调制效应
当Vds较大时漏端沟道长度因为沟道长度调制效应而减小, 假设沟道长度变化量为DL, 漏端实际沟道长度Lcd为:


其中, p, m 为拟合参数, Esat为饱和电场, Vdse为渐变沟道末端的电位, Vdsat为夹断点电势.(11)式中Vdsat可以通过以下方式确定.
当势垒层AlGaN中的载流子被完全耗尽后,2DEG沟道内电子浓度ns表达式可以写成[10],

其中, d 是 AlGaN 层的厚度 (d = TAlGaN), φs表示表面势, Vc表示不同沟道位置处的电势.由于位于漏端附近的沟道受到栅极电压的控制相对较弱, 因此当Vd升高时, 靠近漏端的势阱先消失形成耗尽区.耗尽区内电子很少, 与2DEG沟道内的电子浓度相比可以忽略, 假设沟道和耗尽区交界的夹断点处 ns= 0, 此时 Vc就是夹断点电势 Vdsat, 稍作修正后表达式为

其中, x1和 x2是拟合参数; Ef为费米能级, 是一个与器件工作状态相关的物理量.Ef–ns的经验表达式为[11]:

本文提出的 Cofd模型中, Ef以及阈值电压Vth都与温度相关[12], 而由于 Ef随温度变化对Cofd的贡献相对于Vth来说要小得多, 在300—500 K条件下由Ef引起Cofd的变化比由Vth引起的变化少3个数量级, 因此对Cofd进行温度仿真时可以近似认为Ef与温度无关.阈值电压关于温度的关系表达式为[13]

其中, Vtemp是 Vth的温度依赖系数, TNOM表示器件的温标, 可由实验数据拟合得到.
阈值电压Vth与AlGaN/GaN HEMT内部参数相关, 经典Vth表达式为[14]:

其中: x 表示 AlxGa1–xN 中 Al的组分, ND是 AlGaN势垒层的施主杂质的掺杂浓度, dd表示AlGaN势垒层的厚度, di表示本征隔离层的厚度, d = dd+di, jb是AlGaN表面肖特基接触势垒高度, 它关于x的表达式为[15]

sAlGaN表示AlxGa1–xN极化感生电荷密度,a是AlxGa1–xN晶格常数, e31和e31表示压电常数,c13和 c31表示弹性常数, Psp表示 AlxGa1–xN 自发极化强度[16],

其 中 , a = (–0.077x + 3.189) × 10–10, Psp=–0.052x – 0.029, e31= –0.11x – 0.49, e33= 0.73x +0.73, c13= 5x + 103, c33= –32x + 405.
∆Ec是AlGaN/GaN异质结界面的导带阶, 它关于x的表达式为[17]:

3 模型仿真与分析
为了验证所推导的模型, 采用表1的器件参数进行仿真验证.
3.1 Cofd核心模型验证
GaN HEMT从关态转变为开态并处于稳定时, Ldep_d会逐步转变为零.对 Cofd的核心公式(8)式进行仿真, Ldep_d扫描范围设置为0到0.6 µm,同时把仿真结果与文献[7]的实验数据进行对比,结果如图5所示, 仿真结果与实验数据有较好的拟合度, 而相比以往的Cofd模型, 本文提出的模型包含了Lcd项, 可进一步研究外加偏压对Cofd的影响.

表1 模型仿真的器件参数值Table 1.Model parameters in this paper.

图5 2DEG沟道被类施主表面陷阱耗尽的长度对Cofd的影响关系图Fig.5.Cofd versus the extended depletion length induced by donor-like surface traps.
3.2 偏置条件对Cofd的影响
3.2.1 Vdsat与 Vg的关系
由(15)式和(16)式得到的 Ef-ns与Vg关系如图6 所示, 由图可得当 Vg= –3 V 时, 已经存在浓度高达 1011cm–2的 2DEG, 这些电子主要来源于类施主表面陷阱和AlGaN/GaN的极化效应[15];当Vg处于Ⅰ区时, HEMT工作在中反型区[18],Vg增大使势阱加深, 此时由AlGaN/GaN极化效应产生的极化电场EAlGaN较强, 该电场把AlGaN层被表面陷阱俘获的电子和内部杂质电离的价电子扫向势阱[19], 势阱内的电子浓度急剧增加导致Ef往远离导带底部的方向移动, Ef迅速增加; 当Vg处于Ⅱ区时, HEMT工作在强反型区, 此时由AlGaN层扫向势阱的电子已经相对较多, 这些电子与留在AlGaN层的电离施主杂质和表面陷阱共同形成电场E2DEG, 该电场与极化电场EAlGaN方向相反, 抑制2DEG浓度ns的继续增加, 并且随着ns的增加其抑制作用逐渐增强, 导致ns的增量减缓, Ef趋向线性变化.
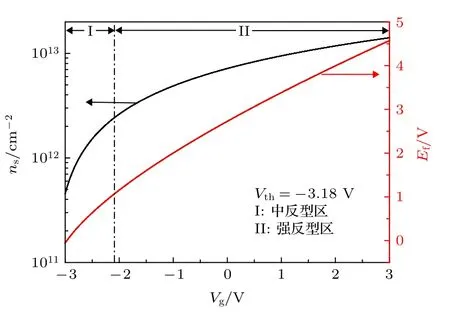
图6 Vg 与 2DEG 浓度 ns和 Ef的关系曲线Fig.6.The curve of the density ns of 2DEG and Ef versus Vg.
基于该Ef模型得到的Vdsat与Vg关系如图7所示, 结果与实验数据进行对比, 实验数据来源于文献[20].分析图7发现, 新Vdsat模型与实测数据拟合度较高, Vdsat与Vg呈微弱的非线性关系, 这是由 Ef随Vg的非线性变化引起的, 而准确的Vdsat是分析HEMT沟道调制效应的关键.
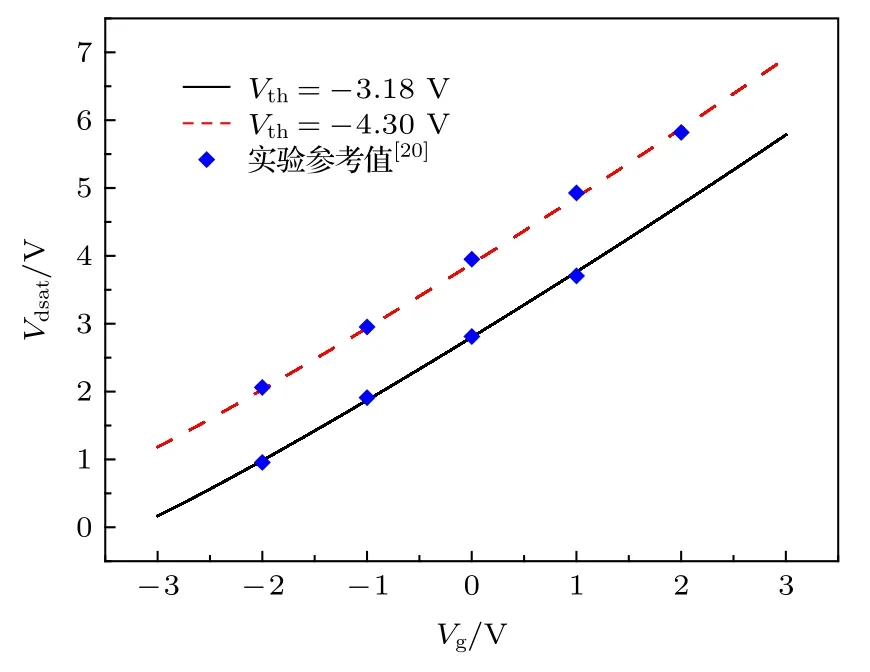
图7 Vg 与 Vdsat的关系曲线Fig.7.The curve of Vdsat versus Vg.
3.2.2 沟道长度调制效应对 Cofd的影响
给栅极施加足够大的偏压使HEMT工作在开启状态, Vds变化范围设置为 0 到 60 V, 图8 是Cofd与 Vds的关系图, 上 3条曲线是本文 Cofd-Vds的仿真结果, 下3条曲线是在Cofd传统模型前添加修正函数后的仿真结果, 对比模型来源于文献[7]中给出的Cofd-Vds模型.由新Cofd模型曲线可知: 当 Vds< Vdsat时, 由于不存在沟道长度调制效应, Lcd保持在最大值, 此时 Cofd不受 Vds变化的影响, 对 Vg的变化也不敏感; 当 Vds≥ Vdsat且Vds不断增加时, 沟道长度调制效应作用增强, 夹断点不断往源端移动, Cofd因为Lcd的减小而衰减;当Vg升高时Cofd曲线衰减速率减慢, 这是因为Vg与Vdsat呈非线性正相关关系, Vg的升高会导致Vdsat相应增加, 更高的Vdsat意味着Lcd受沟道长度调制效应调制作用所消耗的Vds变大, Cofd衰减起点被延后, 曲线整体衰减速率减缓.

图8 传统模型和本文模型得到的Vds与Cofd的关系曲线Fig.8.The curve of Cofd versus Vds obtained from the traditional model and the model in this paper.
从图8下面3条曲线可以看出传统Cofd模型随Vds的变化呈指数级衰减, 衰减速率最大的地方在 Vds= 0 处, 而且在 Vds= 0 时 Cofd因为 Vg的改变表现出不稳定的问题.然而从前面分析可知,Cofd在 Vds< Vdsat期间基本不变, 对 Vg的变化也不敏感, 这是传统Cofd模型存在的问题.导致新旧模型变化趋势不一样的原因在于: 本文提出的新模型是从器件内部针对外加偏置的物理建模, 而传统模型忽略了外加偏置对Cofd的影响, 只是添加指数函数作为修正项, 然而单纯添加修正函数未能准确地预测Cofd随Vg或Vds的变化趋势.
3.2.3 阈值电压漂移对 Cofd的影响
由于保角映射法是数学几何的建模方法, 建模过程在2DEG沟道到栅极之间进行, 因此它考虑到的工艺参数仅限于从栅极到AlGaN势垒层的外部几何参数, 未能进一步研究AlGaN/GaN内部参数对Cofd的影响, 包括AlGaN势垒层的掺杂浓度ND和Al的组分x.在本文提出的新模型中,HEMT的内部参数可以利用Vth进行表征, Vth与ND和x的关系如图9的内插图所示, Al组分x的减小会引起AlGaN势垒层自发极化和压电极化减弱, 更弱的极化效应使势垒层底部的感生极化电荷密度减小, 减弱了电子在GaN的积累作用[15],2DEG浓度减小, 阈值电压发生正向漂移.AlGaN势垒层掺杂浓度的变化也会对Vth产生影响, 但是相对x对Vth的影响来说要小得多.由AlGaN内部参数变化引起的阈值电压漂移可以对Cofd产生影响.假设 Vth从–4 到 0 变化, 固定 Vg= 0 保证器件处于开启状态, 得到的仿真结果如图9所示.当 Vds= 0 时, 不存在沟道长度调制效应, Vth的变化不能影响 Lcd, Cofd保持不变; 当 Vds大于Vdsat后, Vth的正向漂移使势阱内的 ns减少, 此时要产生相同强度的沟道长度调制效应所需要的Vds减小.如果器件工作在固定的Vds, 那么沟道长度调制效应对沟道的调制作用会随着ns的减小不断加强, 更强的沟道长度调制效应使Lcd被耗尽得更快, Cofd呈线性衰减.由图9 还可以发现, 虽然Vds对 Cofd的影响比 Vth更加显著, 但是随着Vds的增加, Cofd对Vth的变化越来越敏感.

图9 Vth 对 Cofd 的影响关系曲线 (插图为 Vth 与 Al组分x和掺杂浓度ND的关系曲线)Fig.9.The curve ofCofd versus Vth(The illustration show the curve of Vth with Al component and doped concentration).
图10 是 Cofd在 Vds= 50—54 V 偏置条件下关于温度的仿真结果, 由图10可知, 在较大的漏极偏压条件下Cofd会因为器件工作温度波动而发生变化, 这是由温度变化引起器件阈值电压漂移造成的.在众多受温度影响的参数变量中, 肖特基势垒对阈值电压的贡献最显著[21], 当温度升高时, 肖特基势垒高度增大引起Vth发生正向漂移, 当器件工作在大的Vds情况下Cofd对阈值电压的漂移会更加敏感, 这时温度的变化会引起Cofd发生偏移,而且这种现象会随着Vds的增加而增强.
为了进一步研究不同Vds偏压下Cofd对温度的敏感程度, 我们将Cofd对温度求导得到ai, 表征Cofd对温度的敏感程度:


图10 温度 T 对 Cofd 的影响关系曲线Fig.10.The curve of Cofd versus T.
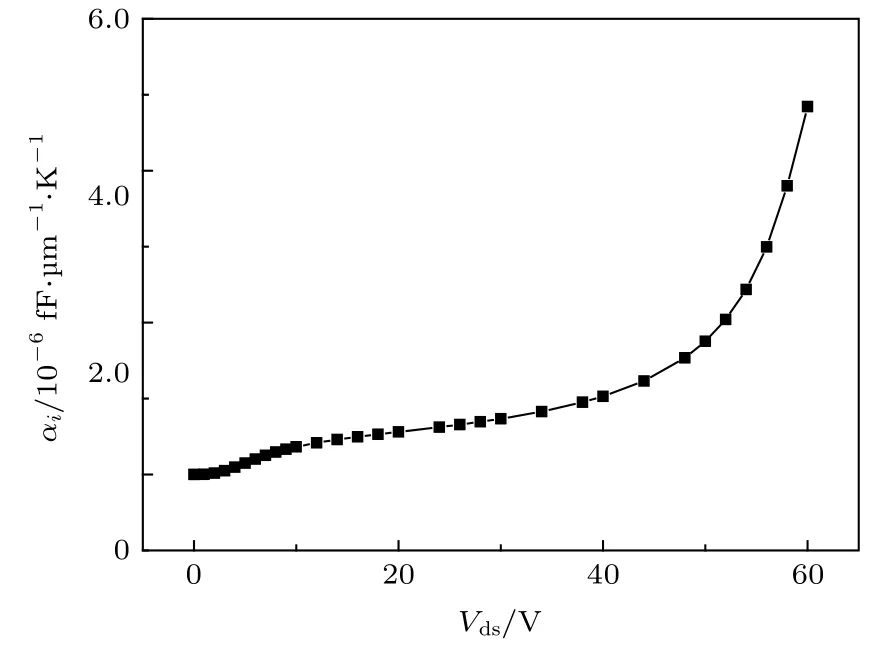
图11 不同漏极偏压下Cofd对温度敏感程度的关系曲线Fig.11.The curve oftemperature sensitivity of Cofd under different drain bias.
不同Vds偏置条件对应的ai如图11所示, 从图中可以发现在Vds< 40 V的情况下Cofd对温度的变化不敏感, 然而随着Vds继续增加, ai呈现出指数增长的趋势, 这时由器件工作温度波动而引起的Cofd偏移会进一步增强.实际上, 器件在高温工作情况下还存在着组分变化和杂质再分布等问题, 这些都会加强温度波动所造成的阈值电压漂移, 使Cofd受温度变化影响进一步加强, 因此在现实应用中, 当器件需要施加大的Vds时, 由温度变化对Cofd影响就更加不能被忽视.
4 结 论
本文基于保角映射法同时考虑沟道长度调制效应, 对Cofd进行了物理建模, 新模型考虑了Vg、Vds和Vth变化对Cofd的影响, 具有较高的精度.分析研究发现: 当 Vds< Vdsat时, 不存在沟道长度调制效应, 这时 Cofd不受 Vds和 Vg的影响; 当 Vds≥Vdsat后, Vds的增大会使沟道长度减小引起Cofd的衰减, 而衰减速率随Vg的增加而减缓; AlGaN势垒层中掺杂浓度的减小和Al组分的减小都可以引起阈值电压的正向漂移, 正向阈值漂移使得势阱内二维电子气浓度减小, 导致器件沟道所受到的调制作用增强, 实际的沟道长度变得更小, Cofd随Vth的正向增加呈线性衰减.且在大Vds工作状态下, Cofd对阈值电压漂移会更加敏感, 这时器件工作温度的升高会加强阈值电压的漂移现象, 使Cofd因为温度的变化出现偏移.并且随着漏极偏压的上升, Cofd受温度变化波动的也越来越敏感, 在实际大电压应用中这些问题需加以关注.
