一种基于低温共烧陶的无引线键合封装
2020-03-12焦静静石云波赵永祺赵思晗米振国
焦静静,石云波,赵永祺,赵思晗,张 婕,米振国,康 强
(1.中北大学 电子测试技术重点实验室,山西 太原 030051;2.中国兵器工业实验测试研究院,陕西 华阴 714200)
0 引言
微机电系统(MEMS)加速度计因高集成度和低功耗等优点在工业和国防等领域发挥着极大的作用[1-2]。传感器的封装对于传感器的可靠性有重要的影响[3]。在高冲击环境下加速度传感器的主要失效模式包括键合引线的脱落、微梁断裂等[4]。通过长期试验表明,在冲击载荷环境下引线易疲劳断裂,同时金线和芯片上的铝键合点发生固相反应,形成“紫斑”。传感器铝焊盘表面的氧化膜也会阻碍金丝键合,从而易导致键合质量差或引线脱落[5]。金丝键合的键合质量及抗冲击性在实验过程中影响极大。因此,有效的封装是影响传感器可靠性的一个重要因素。
低温共烧陶瓷(LTCC)技术结合厚膜技术和高温共烧陶瓷技术的优点,与其他微电子封装工艺相比,其工艺难度较低,且具有较好的温度特性和高机械品质[6]。在LTCC材料中可集成无源组件,有利于实现结构的动员化和小型化[7]。越来越多的人开始采用LTCC材料进行封装,实现传感器的异构集成[8-9]。2016年,Fraunhofer实验室提出在与硅阳极键合过程中,含有Na+的LTCC基板的电子迁移率会高于高硼硅玻璃中的电子迁移率[10]。2017年,Andrea将LTCC射频MEMS技术应用于重构空间子系统中并进行了设计、制造和测试,测试结果表明,LTCC与MEMS技术适用于极端条件[11]。
为提高MEMS加速度计的可靠性,减小因为引线键合导致传感器失效。本文提出了一种基于LTCC的无引线晶圆级封装。通过LTCC基板实现无引线封装和电路转接功能,极大地减小了传感器的封装体积,为实现MEMS传感器的异构集成提供可能。
1 结构设计
1.1 传感器结构
本文设计针对高量程加速度传感器,采用四悬臂梁粗梁结构[12](见图1),通过离子掺杂形成电阻,芯片表面溅射铝线形成惠斯通电桥。依靠压阻效应将加速度信号转化成电压信号。

图1 传感器实物图
1.2 LTCC三层封装设计
现有高量程加速度传感器封装均采用金丝键合将敏感结构与印刷电路板(PCB)相连,而后输出电线钎焊在PCB板上,如图2所示。由于金丝键合和PCB板的存在,增大了封装后的体积,同时降低了传感器在高冲击条件下的可靠性。LTCC实现电路转接比用普通PCB电路基板具有更优良的热传导性和更好的温度特性。由于LTCC较小的热膨胀系数和介电常数温度系数,其与硅芯片阳极键合过程中产生的残余应力较小。无引线键合封装结构如图3所示。当采用含Na+的熟瓷片与敏感结构阳极键合,同时在熟瓷片内印刷电路,从而实现电路转接功能。该结构可简化敏感结构到传输线之间的步骤,减小由于金丝键合和PCB板造成的噪声,提高传感器整体的可靠性;同时保证了加速度传感器整体封装后的面积与敏感结构相同。在高度提高时,仍能有效地保护敏感结构。
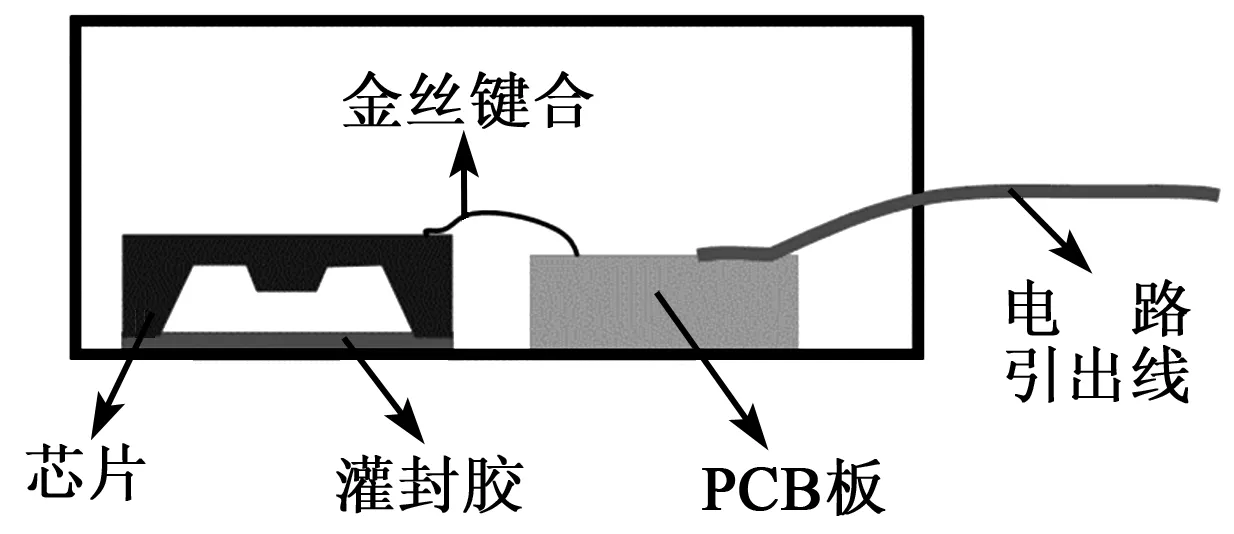
图2 常规封装示意图

图3 整体封装结构示意图
1.3 设计参数
本传感器敏感结构为对称四悬臂梁结构,因此可简化为中心有一质量为m2的质量块的简支梁模型。梁的长、宽、厚分别为a1,a2和h1。
悬臂梁的挠度曲线近似方程为
(1)
式中:M(x)为梁弯矩;E为杨氏模量;I为惯性矩。
弯矩方程为
EIy″=Fx-M0
(2)
式中:F为两端固支面的支持力;x为梁上位置;M0为梁边缘的约束弯矩。
通过边界条件:
(3)
当结构受加速度a的作用时,可解得结构挠度方程:
(3a1x2-2x3) 0≤x≤a1
(4)
式中:υ为泊松比;m1为梁质量。
当x=a1时为形变最大值点,即
(5)
通过式(5)计算可得在满量程条件下质量块的最大位移为5.6 μm,故第一层生瓷片空腔高度应大于6 μm。
2 性能仿真
利用ANSYS workbench有限元仿真软件对封装结构和整体封装的振动模态进行分析,相关材料参数如表1所示。图4为裸片第一阶模态。由图可知,未封装传感器的z轴振动模态为285 kHz。图5为无引线封装后的第一阶固有频率为567 kHz。由此可见,无引线键合封装对整体传感器的固有频率有较大的提升。当采用不锈钢金属管壳为封装外壳,灌封胶灌封对芯片进行系统级封装后的整体固有频率为103 kHz,如图6所示。对封装体进行冲击仿真,冲击载荷200 000g(g=9.8 m/s2),加载时间60 μs,底边固定。图7为200 000g冲击下的无线封装后的敏感结构应力等效图。由图可知,无引线键合封装最大应力为50.81 MPa,最大应力位置为梁根部。梁根部的最大应力小于硅的许用应力,该结构满足设计要求。

表1 参数性能

图4 裸片第一阶模态
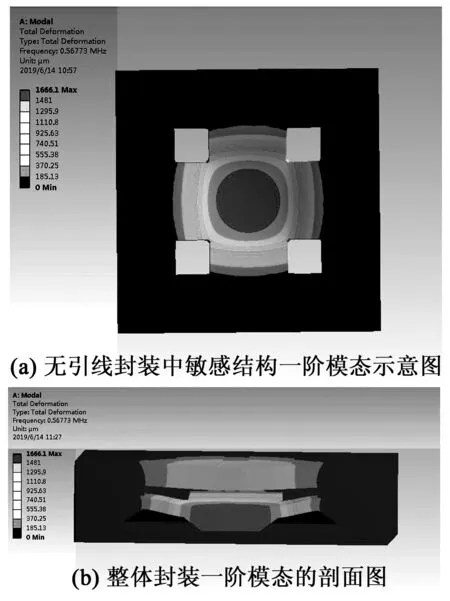
图5 无引线键合封装第一阶模态及剖面图
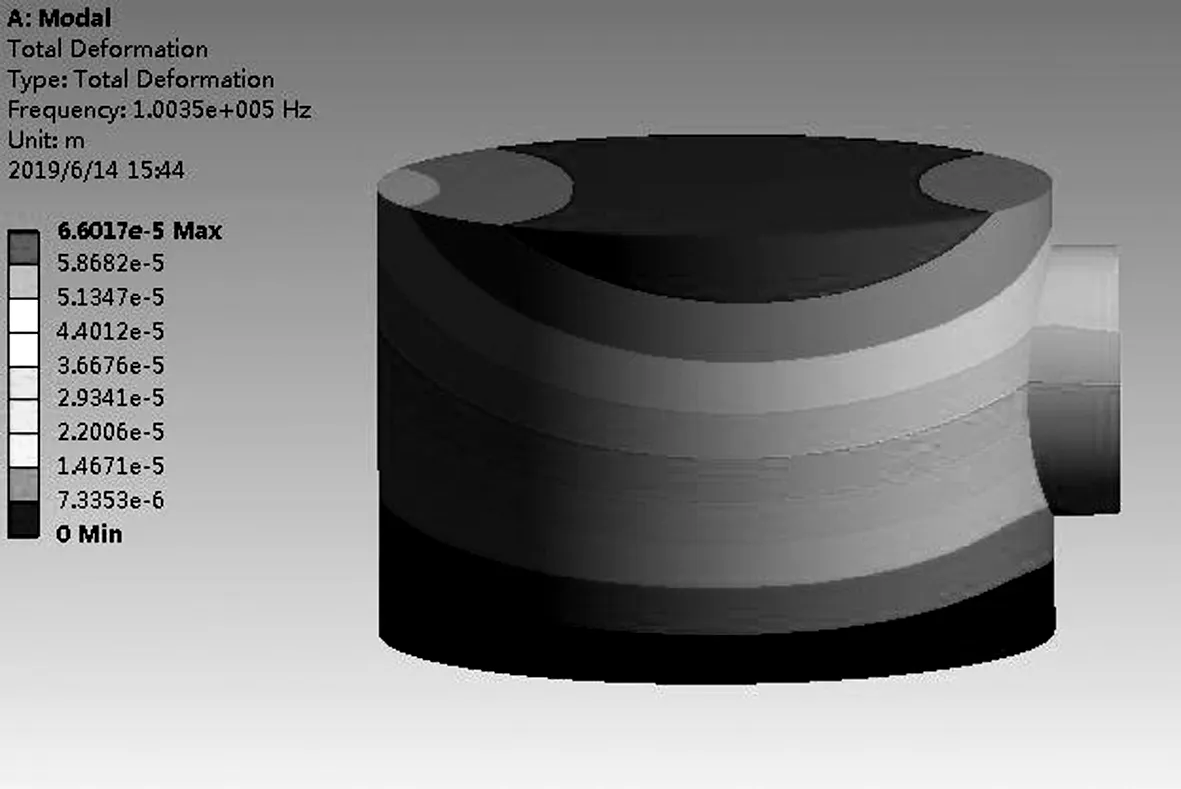
图6 灌封封装后的第一阶模态

图7 无引线封装后的敏感结构应力等效图
3 封装工艺制备
图8为LTCC基板的制备图。通过阳极键合技术将敏感结构和底层生瓷片连接。第1层生瓷片上通过激光打孔技术打上和敏感结构硅片上的引脚焊盘(PAD)点大小、位置一致的通孔,同时在和敏感结构接触面刻出与敏感结构表面溅射同大小导线的凹槽。第2层生瓷片打孔位置与第1层生瓷片一样,采用浆料填孔实现敏感结构与转接电路垂直连接。在第2层生瓷片表面上印刷转接电路,第3层生瓷片在第2层生瓷片转接电路结束处相应位置激光冲孔。在第3层(顶层)生瓷片上印刷可钎焊浆料形成与电线焊接的焊盘。上面三层生瓷片整体通过叠层、压片、在850 ℃熔炉中烧结形成一个紧凑的整体模块,将这个整体与已键合底面熟瓷片的敏感结构通过阳极键合连接。最后,封装后的整体通过贴片胶粘接,实现三层封装结构与管壳的连接。

图8 低温共烧陶瓷基板的制备
4 结束语
本文设计了一种无引线键合的封装结构,该结构采用含Na+的陶瓷板通过阳极键合与传感器相连。陶瓷基板内含有金属连接通孔,同时将电路转接功能也制作在陶瓷基板内。基板上表面含有可焊锡浆料,可直接钎焊金属导线,从而实现无引线键合的封装。这种结构减小了由于金丝键合和灌封胶对传感器的影响。通过仿真可知,该结构在不影响传感器输出性能的同时,可减小传感器的封装体积和质量,提高传感器的稳定性和可靠性。
