光器件应用改性Ge的能带结构模型∗
2018-11-03杨雯宋建军任远张鹤鸣
杨雯 宋建军 任远 张鹤鸣
(西安电子科技大学微电子学院,宽禁带半导体材料与器件重点实验室,西安 710071)
(2018年6月12日收到;2018年7月24日收到修改稿)
1 引 言
Ge为间接带隙半导体,通过改性技术可以转换为准直接或者直接带隙半导体.与间接带隙的Ge相比,准/直接带隙改性Ge半导体载流子辐射复合效率高,应用于光器件发光效率高;同时,准/直接带隙改性Ge半导体载流子迁移率显著高于Si半导体载流子迁移率,应用于电子器件工作速度快、频率特性好.鉴于改性Ge半导体在光器件和电器件两方面的应用优势,其具备了单片同层光电集成的应用潜力,已成为该领域内研究的热点和重点[1−6].
目前实现Ge改性的技术主要有两种:一种是施加双轴张应力使得Ge发生应变从而实现改性;另外一种就是掺Sn通过合金化的方法来实现改性[7−9].是否还有别的方法来实现Ge改性?为了解决这一问题,本文在研究改性Ge材料应变张量模型的基础上,揭示不同改性条件下Ge带隙类型转化的规律,拟建立准/直接带隙改性Ge带隙类型转化模型,完善间接转直接带隙Ge实现方法的相关理论.
准/直接带隙改性Ge具备单片同层光电集成的应用潜力,且其工艺与Si兼容,为高速器件与电路提供了新的技术发展途径.能带结构是准/直接带隙改性Ge材料实现单片同层光电集成的理论基础之一,但据我们所知,目前该方面的工作仍存在不足.有鉴于此,我们在建立准/直接带隙改性半导体应变张量和形变势模型的基础上,采用kp微扰法,拟建立准直接带隙改性Ge能带E-k模型以及直接带隙弛豫Ge1−xSnx合金8带kp模型,据此所获相关结论可为发光二极管(LED)、激光器件仿真模型提供关键参数.
Ge与GeSn做光电器件已具有很大的竞争优势[7−10],但是目前为止尚未做出成熟的Ge基同层单片光电集成.实现Ge基光互连要求其中发光管、探测器、波导有源层材料的禁带宽度必须满足:Eg,波导>Eg,发光管>Eg,探测器. 因此,为实现同层单片光电集成,必须对器件各部分有源层材料的能带结构进行调制.但遗憾的是缺乏该方面的文献报道.有鉴于此,本文基于固体能带理论,研究不同改性条件下Ge半导体在单轴应力作用下禁带宽度的变化规律,提出改性Ge单轴应力禁带宽度调制方案,为准/直接带隙改性Ge单片同层光电集成的实现提供理论参考.
本文的研究结果量化,可为准/直接带隙改性Ge材料物理的理解以及Ge基光互连中发光器件有源层研究设计提供重要理论依据.
2 改性Ge带隙类型转化的规律
本节以改性Ge为研究对象,基于广义胡克定律、形变势原理,考虑各种改性致Ge带隙类型转化的情况,全面揭示改性Ge带隙类型转化的规律,建立准/直接带隙改性Ge带隙类型转化模型,完善间接转直接带隙Ge实现方法的相关理论.
2.1 应变张量与形变势模型
计算、分析Ge半导体间接转直接带隙,首先需要计算Ge及其合金半导体以应力为自变量的应变张量模型[11].基于广义胡克定律,(001)衬底、(101)衬底和(111)衬底双轴应变张量结果如(1)式所示,单轴应变张量结果如(2)式所示.


式中c11,c12,c44为弹性劲度系数;εxx,εyy,εzz,εxy,εxz,εyz,εxx为应变张量;T为应力.式中参数的具体数值见文献[11].为了直观地描述应力施加方式,我们给出(001)衬底、(101)衬底和(111)衬底单轴应力示意图,如图1所示,{x′,y′,z′}为辅助坐标系,{x,y,z}为原胞坐标系,θ为x与x′间夹角.
Ge半导体在应力作用下导带各能级变化可由形变势模型给出,合金化作用可由Sn和Ge相关参量的线性插值表征[12,13].(001),(101),(111)双轴应变Ge导带各能级变化公式如下(式中各参量物理意义和数值详见表1):

图1 单轴应力示意图Fig.1.Diagram of uniaxial stress.


表1 IV族半导体导带形变势参数(所有物理量单位均为eV)[12,13]Table 1.Deformation potential parameters of IV semiconductors(all units of physical quantities are eV)[12,13].
2.2 带隙类型转化规律模型
Ge为间接带隙半导体,通过改性技术可以转换为准直接或者直接带隙半导体.改性是指通过一定的方法与技术,调制Ge布里渊区中心的导带底和决定其禁带宽度处于布里渊区边界[111]方向的导带底能级相对位置,使其由间接带隙材料变为直接带隙材料.
2.2.1 应力致Ge带隙类型转化
在应力作用下,Ge半导体导带L能谷能级与Γ能级之间相对位置会发生变化,进而引起Ge带隙类型的转变[14−17],Γ能谷能级与L能谷能级交叉处即为带隙转化交叉点.本节首先讨论(001),(101),(111)双轴张/压应变Ge导带各能级随应力的变化关系,如图2(a)—(c)所示.由图可知,(001)双轴张应变作用下,Ge半导体可实现间接转直接带隙.图2(d)和图2(e)给出了(001)单轴0◦-[100]晶向、(001)单轴45◦-[110]晶向张/压应变导带各能级随应力的变化关系.由图可知,(001)单轴0◦张应变可实现带隙类型转化,说明除双轴张应力外,单轴张应力也可实现带隙类型的转化.由图2(f)可知,“较低强度”单轴力+“较低强度”双轴力的复合应力模式下,也可实现带隙类型转化,这为我们实现Ge改性提供了新的方向.

图2 张/压应变Ge导带各能级随应力的变化关系 (a)(001)双轴;(b)(101)双轴;(c)(111)双轴;(d)(001)单轴0◦-[100]晶面;(e)(001) 单轴45◦-[110]晶面;(f)(001)单轴0◦+双轴Fig.2.The relationship between conduction band energy levels of the tensile/compressive strained-Ge and stress intensity:(a)(001)biaxial strain;(b)(101)biaxial strain;(c)(111)biaxial strain;(d)(001)uniaxial strain 0◦-[100]crystal surface;(e)(001)uniaxial strain 45◦-[110]crystal surface;(f)(001)uniaxial strain 0◦ +biaxial strain.

图3 (001)单轴0◦+双轴张应变Ge导带能级随应力的变化 (a)单轴;(b)双轴;(c)二维等能图Fig.3.The relationship between conduction band energy levels of the(001)uniaxial 0◦+biaxial tensile strained-Ge and stress intensity:(a)Uniaxial strain;(b)biaxial strain;(c)two-dimensional equal energy graph.
值得注意的是,图2(f)采用的是(001)单轴0◦+双轴张应变的复合应力模式,并不是复合应力施加的最优模式,下面对该问题做进一步探讨.图3(a)和图3(b)分别为(001)单轴0◦+双轴复合应变Ge Γ能谷能级与L能谷能级随单轴、双轴应力变化的关系.由于变化率不同,Γ能谷能级与L能谷能级在带隙转化时将发生交叉,交叉处各单轴与双轴应力点的组合均可实现Ge带隙类型转化,更为直观的结果可参阅复合应力下Ge带隙类型转化等能图(图3(c)).
2.2.2 Sn合金化致Ge带隙类型转化
本小节将给出Sn合金化致Ge带隙类型转化的量化结论. 图4(a)为弛豫Ge1−xSnx(Sn组分0—0.2)导带各能级合金化作用条件下的变化情况.由图可见,合金化约8%左右,Ge半导体可实现带隙类型转化,该结论与目前报道的结果基本一致.图4(b)为(001)双轴张应变Ge1−xSnx合金导带各能级变化情况,图中Γ能谷能级与L能谷能级交叉处即为带隙转化交叉点.由图可见,合金化与张应力共同作用情况下,Ge半导体也可实现带隙类型转化,这为我们实现带隙类型转化提供了又一新的思路.

图4 Ge1−xSnx致Ge带隙类型转化示意图 (a)弛豫Ge1−xSnx导带各能级随合金化变化;(b)张应变Ge1−xSnx带隙转化情况Fig.4.Diagram of bandgap conversion of Ge1−xSnx:(a)The relationship between conduction band energy levels of the relaxation Ge1−xSnxand alloying;(b)the bandgap conversion of tensile strained-Ge1−xSnx.
综合2.2.1及2.2.2小节的相关讨论,我们得出结论:除了传统的施加双轴张应力或掺Sn合金化的方法来实现Ge改性之外,还可以通过单轴张应力、单双轴复合应力、合金化与张应力共同作用来实现Ge改性.本节所获结论为我们实现Ge带隙转化提供了新的途径,比如单轴应力可以通过微加工技术在(100)GOI薄膜上引入;再比如应力与合金化共同作用实现的改性Ge由于特殊的能带结构,其禁带宽度可通过控制Sn组分来改变,且GeSn合金的光吸收系数高,可满足Ge材料探测器件整个通信波段的要求.
3 准/直接带隙改性Ge的能带结构
能带结构是光互连各分立器件以及光互连整体兼容设计的理论基础,而要获得改性Ge材料的能带结构,重点是研究建立改性Ge材料能带结构的E-k关系.本节在前节准/直接带隙改性半导体应变张量和形变势模型的基础上,采用kp微扰法,建立准直接带隙改性Ge能带的E-k模型以及直接带隙弛豫Ge1−xSnx合金8带kp模型,据此所获相关结论可为LED、激光器件仿真模型提供关键参数.
3.1 准直接带隙改性Ge的能带结构
准直接带隙改性Ge导带、价带E-k关系解析模型分别如(4)和(5)式所示,相关参数见文献[14—17].

图5给出了低强度双轴张应变Ge导带、价带各能级随应力变化的物理模型.由5(a)可知,低强度张应变Ge半导体导带Γ能谷能级与L能谷能级之间带差减小.图5(b)为导带Γ与L能谷能级之差随应力强度变化的关系,当应力强度达到0.3%时,二者之间的带隙差减小约17%.由图5(c)可知,双轴低强度张应变Ge材料的带边(“重空穴带”)和亚带边(“轻空穴带”)发生分裂;同时随着应力的增大,双轴低强度张应变Ge的带边、亚带边、次带边Γ点处的能级均随之增加.图5(d)为禁带宽度随应力强度的变化规律,当应力强度达到0.3%时,低强度双轴张应变Ge材料禁带宽度减小约0.714 eV.
图6为弛豫Ge价带,0.1%,0.2%和0.3%双轴张应变Ge价带结构.由图6(a)可见,弛豫Ge价带顶两个最高的带(重空穴带和轻空穴带)在Γ点处4◦简并,第三支带(旋轨劈裂带)为2◦简并.弛豫Ge重空穴带、轻空穴带等能面虽为扭曲面,但同一晶向族内各晶向价带结构相同.由图6(b)—(d)可见,低强度双轴张应变Ge材料在应力的作用下价带顶简并消除,且其劈裂能随着应变的增加而逐渐增大.与k矢相关的“重空穴带”和“轻空穴带”价带结构也发生了变化,同一晶向族内沿[001]和[100]两个晶向的价带结构在应力的作用下不再对称,相应的空穴有效质量亦不相同,各向异性显著.

图5 双轴低强度张应变能带结构 (a)各个导带能级随应变的变化关系;(b)导带Γ能谷与L能谷能级之差;(c)价带Γ点能级随应力的变化关系;(d)禁带宽度随应力的变化关系Fig.5.The band structure of biaxial tensile strain with low strength:(a)The relationship between conduction band energy levels and stress intensity;(b)the difference between the conduction band Γ and L energy valley;(c)the relationship between valence band point Γ energy level and stress intensity;(d)the relationship between the bandgap width and the stress intensity.

图6 双轴低强度张应变Ge价带结构 (a)弛豫;(b)0.1%应变;(c)0.2%应变;(d)0.3%应变Fig.6.The valence band structure of biaxial tensile strained-Ge with low strength:(a)Relaxation;(b)0.1%strain;(c)0.2%train;(d)0.3%train.

图7 双轴低强度张应变Ge导带Γ能谷与L能谷电子有效质量等能图Fig.7.Equal energy graph of the conduction band Γ and L energy valley electron effective mass of biaxial tensile strained-Ge with low strength.
低强度张应变Ge导带电子有效质量、价带空穴有效质量是后续光器件与电子器件仿真需要的重要物理参量,等能面可以直观地反映其各向异性.图7(a)和图(b)分别为低强度张应变Ge导带L能谷与Γ能谷电子有效质量等能图.由图可知,L能谷电子有效质量等能图仍为椭球型,其有效质量由横、纵有效质量两个指标表征;Γ能谷电子有效质量等能图仍为球形,其有效质量为各向同性.图8(a)—(c)分别给出了不同应力强度下双轴张应变Ge材料带边、亚带边、次带边40 meV的二维、三维等能图,其形状直观地反映了低强度双轴张应变Ge材料带边、亚带边、次带边空穴各向异性有效质量.
3.2 弛豫GeSn合金能带结构

Sn合金化是实现Ge带隙类型转化的另一种重要改性手段,且通过控制Sn组分还可以调节改性Ge的带隙宽度.当Sn组分>0.08时,Ge1−xSnx合金可形成直接带隙改性Ge半导体,将其应用于光器件,发光效率将显著提升;同时,Ge1−xSnx合金载流子迁移率高,应用于电子器件,可有效提高器件的工作速度与频率特性.本节重点研究建立直接带隙Ge1−xSnx合金(Sn组分>0.08)能带结构模型,包括导带、价带各能级以及禁带宽度随应力变化的物理模型.
直接带隙Ge1−xSnx合金能带kp本征值模型需同时包括导带和价带两个部分,本征值矩阵维数至少为8[14−17](如(7)式).

其中

上式中Luttinger参数γ,γ,γ对应6带kp模型参数;EΓg为Ge半导体Γ点导带底与价带顶能级差;∆为Ge半导体旋轨分裂能;mc为Ge半导体导带Γ点电子有效质量;kx,ky,kz为倒易空间波矢量,分别对应[001],[010],[100]晶向.

图8 双轴低强度张应变Ge价带40 meV E等能图 (a)带边;(b)亚带边;(c)次带边Fig.8.Equal energy graph of the valence band 40 meV Eof biaxial tensile strained-Ge with low strength:(a)The edge;(b)subband edge;(c)subband edge.

图9 直接带隙Ge1−xSnx合金导带结构(a)(x>0.08)导带各能级随Sn组分x的变化关系;禁带宽度与Sn组分x的关系Fig.9.The conduction band structure of direct bandgap Ge1−xSnxalloy:(a)Relationship between(x>0.08)conduction band energy levels and x;(b)relationship between the bandgap width and x.
导带方面,图9(a)为直接带隙Ge1−xSnx合金(Sn组分>0.08)导带结构随Sn组分x的变化关系.由图可知,随着Sn组分x的增加,直接带隙Ge1−xSnx合金Γ能谷能级与L能谷能级均随之减小,Γ能谷能级与L能谷能级之间的带差随之增加;图9(b)为禁带宽度随应力强度的变化规律,随着Sn组分的不断增大,直接带隙GeSn合金禁带宽度随之减小.价带方面,图10(a)—(d)分别为直接带隙Ge0.92Sn0.08,Ge0.91Sn0.09,Ge0.90Sn0.10和Ge0.89Sn0.11合金价带结构随Sn组分x的变化关系,由图可见,价带带边和亚带边在Γ点处简并,沿[001]和[100]两个晶向的价带结构对称,同一晶向族内沿各晶向的空穴有效质量相同.
图11为直接带隙Ge0.92Sn0.08,Ge0.91Sn0.09,Ge0.90Sn0.10和Ge0.89Sn0.11合金Γ能谷电子有效质量40 meV二维、三维等能图.由图可知,直接带隙Ge1−xSnx合金(Sn组分>0.08)导带Γ能谷电子有效质量等能图仍为球形,有效质量为各向同性.图12(a)—(c)分别给出了直接带隙Ge1−xSnx合金(Sn组分>0.08)带边、亚带边、次带边40 meV的二维、三维等能图.由图可知,直接带隙Ge1−xSnx合金(Sn组分>0.08)价带40 meV等能面为扭曲等能图,有效质量表现为各向异性.
本节主要解决LED、激光器件仿真模型等关键参数缺乏问题.通过建立准直接带隙改性Ge能带E-k模型以及直接带隙弛豫Ge1−xSnx合金8带kp模型,我们提供了改性Ge单片同层光电集成各种器件的参数,包括导带、价带各能级随应力的变化关系、导带Γ能谷能级与L能谷能级之差、禁带宽度、导带电子有效质量、价带空穴有效质量等,其具体结果见图5—图12.

图10 不同Sn组分下直接带隙Ge1−xSnx合金价带结构 (a)Sn组分0.08;(b)Sn组分0.09;(c)Sn组分0.10;(d)Sn组分0.11Fig.10.The valence band structure of direct bandgap Ge1−xSnxalloy with different Sn component:(a)Sn component 0.08;(b)Sn component 0.09;(c)Sn component 0.10;(d)Sn component 0.11.

图11 不同Sn组分下直接带隙Ge1−xSnx合金40 meV导带等能图Fig.11.Equal energy graph of the 40 meV conduction band of direct bandgap Ge1−xSnxalloy with different Sn component.
4 准/直接带隙改性Ge带隙调制模型
实现Ge基光互连,要求Ge基光互连中发光管、探测器、波导有源层材料的禁带宽度必须满足:Eg,波导>Eg,发光管>Eg,探测器. 尤其对于同层单片光电集成方式而言,各器件的有源层采用同一种半导体材料,所对应的禁带宽度一致.因此,为实现同层单片光电集成,必须对器件各部分有源层材料的能带结构进行调制[16−20].本节基于固体能带理论,研究不同改性条件下Ge半导体在单轴应力作用下禁带宽度的变化规律,提出改性Ge单轴应力禁带宽度调制方案,旨在为准/直接带隙改性Ge单片同层光电集成的实现提供理论参考.
4.1 准直接带隙改性Ge禁带宽度调制
本节建立了准直接带隙改性Ge导带、价带Γ点各能级与单轴应力之间的物理模型.图13(a),图13(b)和图13(c),图13(d)分别为准直接带隙改性Ge半导体0◦和45◦单轴应力作用下导带、价带Γ点各能级的变化情况.
为了更清晰地观察单轴应力作用下准直接带隙改性Ge半导体导带、价带Γ点各能级的变化情况,以双轴应变张量0.2%时准直接带隙改性Ge半导体为例,绘制了其导带、价带Γ点各能级与0◦,45◦单轴应力的函数关系.由图14(a)可知,0◦单轴张应力作用下,L能谷能级减小,且价带带边能级随之明显增加;由图14(c)可知,由于45◦单轴应力作用下准直接带隙改性Ge半导体导带L能谷分裂,导带最低能级显著降低.图14(b)和图14(d)为0.2%双轴张/压应变准直接带隙改性Ge半导体单轴应力禁带调制量化模型.由图14(b)可知,0◦单轴张应力作用下准直接带隙改性Ge半导体禁带窄变,而在0◦单轴压应力作用下禁带变宽;由图14(d)可知,45◦单轴应力作用下准直接带隙改性Ge半导体禁带仅会出现窄变一种情况.

图13 准直接带隙改性Ge导带、价带Γ点各能级与应力T的关系 (a)0◦单轴应力下的导带;(b)0◦单轴应力下的价带;(c)45◦单轴应力下的导带;(d)45◦单轴应力下的价带Fig.13.The relationship between conduction band,valence band point Γ energy level of quasi direct bandgap modified Ge and stress intensity T:(a)Conduction band under 0◦ uniaxial strain;(b)valence band under 0◦uniaxial strain;(c)conduction band under 45◦ uniaxial strain;(d)valence band under 45◦ uniaxial strain.

图14 (a),(c)0.2%双轴应变准直接带隙改性Ge导带、价带Γ点各能级与0◦,45◦单轴应力T的关系;(b),(d)禁带宽度与0◦,45◦单轴应力T的关系Fig.14.(a),(c)The relationship between conduction band,valence band point Γ energy level of quasi direct bandgap modified Ge under 2%uniaxial strain and 0◦,45◦ uniaxial stress intensity T;(b),(d)relationship between the bandgap width and 0◦,45◦ uniaxial stress intensity T.
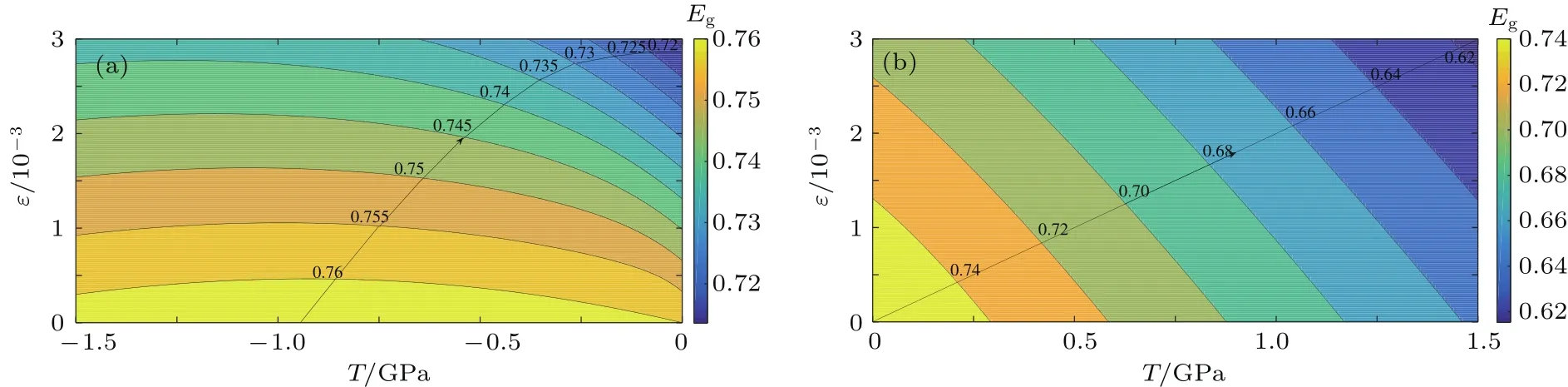
图15 准直接带隙改性Ge禁带宽度0◦单轴应力调制图 (a)压应力;(b)张应力Fig.15.0◦uniaxial strain bandgap modulation diagram of quasi direct bandgap modified Ge:(a)Tensile stress;(b)compression stress.
此外,本文还给出了不同双轴张应变情况下准直接带隙改性Ge半导体的0◦单轴应力禁带调制等能图,见图15.
4.2 直接带隙Ge1−xSnx合金禁带宽度调制
本节进一步建立直接带隙Ge1−xSnx合金导带、价带Γ点各能级与单轴应力之间的物理模型.图16(a),图16(b)和图16(c),图16(d)分别为直接带隙Ge1−xSnx合金0◦和45◦单轴应力作用下导带、价带Γ点各能级的变化情况.

图16 直接带隙Ge1−xSnx合金导带、价带Γ点各能级与应力T的关系 (a)0◦单轴应力下的导带;(b)0◦单轴应力下的价带;(c)45◦单轴应力下的导带;(d)45◦单轴应力下的价带Fig.16.The relationship between conduction band,valence band point Γ energy levels of direct bandgap Ge1−xSnx alloy and stress intensity T:(a)Conduction band under 0◦ uniaxial strain;(b)valence band under 0◦ uniaxial strain;(c)conduction band under 45◦ uniaxial strain;(d)valence band under 45◦ uniaxial strain.

图17 (a),(c)直接带隙Ge0.92Sn0.08导带、价带Γ点各能级与0◦及45◦单轴应力T的关系;(b),(d)禁带宽度与0◦及45◦单轴应力T的关系Fig.17.(a),(c)The relationship between conduction band,valence band pointΓ energy level of direct bandgap Ge1−xSnx alloy and 0◦,45◦ uniaxial stress intensity T;(b),(d)relationship between the bandgap width and 0◦,45◦ uniaxial stress intensity T.

图18 直接带隙Ge1−xSnx合金禁带宽度0◦单轴应力调制图 (a)压应力;(b)张应力Fig.18.0◦ uniaxial strain bandgap modulation diagram of direct bandgap Ge1−xSnxalloy:(a)Tensile stress;(b)compression stress.
同样,我们以Sn组分x为0.08为例,绘制了直接带隙Ge1−xSnx合金导带、价带Γ点各能级与0◦及45◦单轴应力的函数关系.由图17(a)可知,单轴张应力作用下Ge0.92Sn0.08合金仍为直接带隙半导体,而单轴压应力作用下Ge0.92Sn0.08合金却转变为间接带隙半导体;由图17(c)可知,45◦单轴应力作用下直接带隙Ge0.92Sn0.08合金由直接带隙半导体退变为间接带隙半导体.图17(b)和图17(d)为.2%双轴张/压应变直接带隙Ge0.92Sn0.08合金单轴应力禁带调制量化模型.由图17(b)可知,0◦单轴张应力作用下直接带隙Ge0.92Sn0.08合金禁带变窄,而在0◦单轴压应力作用下禁带变宽;由图17(d)可知,45◦单轴应力作用下直接带隙Ge0.92Sn0.08合金禁带宽度仅会出现变窄一种情况.
若对同层单片光电集成各器件进行能带调制,单轴压应力可应用于Ge0.92Sn0.08合金波导的带隙调制,单轴张应力则不仅可应用于探测器的带隙调制,还可应用于发光器件的带隙调制.此外,本文还给出了不同Sn组分情况下直接带隙Ge1−xSnx合金0◦单轴应力禁带调制等能图,见图18.
能带调制结果将为改性Ge单片光电集成器件设计、制备提供有益的指导.实现Ge基光互连,要求Ge基光互连中发光管、探测器、波导有源层材料的禁带宽度必须满足:Eg,波导>Eg,发光管>Eg,探测器, 因此必须对器件各部分有源层材料的能带结构进行调制.例如n+-Ge/i-GeSn/p+-Ge/p+-Si单片光电集成器件制备,使用II型DR-Ge1−xSnx光源,波导及探测器部分可以采用淀积氮化硅薄膜施加外力的方法实现能带调制;再例如n+-Ge/i-Ge1−xSnx/p+-Ge/p+-Si单片光电集成器件制备,使用II型DR-Ge1−xSnx光源,波导及探测器部分采用Sn组分区域变化的方法实现能带调制.
5 结 论
Ge为间接带隙半导体,通过改性技术可以转换为准直接或者直接带隙半导体,准/直接带隙改性Ge具备单片同层光电集成的应用潜力.能带结构是准/直接带隙改性Ge材料实现单片同层光电集成的理论基础之一,本文针对该问题开展了三方面的工作:1)以改性Ge为研究对象,基于广义胡克定律、形变势原理,揭示了不同改性条件下Ge材料带隙类型转化的规律,完善了间接转直接带隙Ge实现方法的相关理论;2)在建立准/直接带隙改性半导体应变张量和形变势模型的基础上,采用kp微扰法,建立了准直接带隙改性Ge能带E-k模型以及直接带隙弛豫Ge1−xSnx合金8带kp模型,据此所获相关结论可为LED、激光器件仿真模型提供关键参数;3)基于固体能带理论,研究了不同改性条件下Ge半导体在单轴应力作用下禁带宽度的变化规律,提出改性Ge单轴应力禁带宽度调制方案,为准/直接带隙改性Ge单片同层光电集成的实现提供了理论参考.
本文的研究结果量化,可为准/直接带隙改性Ge材料物理的理解以及Ge基光互连中发光器件有源层研究设计提供重要理论依据.
