Si3N4钝化层对横向PNP双极晶∗体管电离辐射损伤的影响机理
2018-09-11杨剑群董磊刘超铭李兴冀徐鹏飞
杨剑群 董磊 刘超铭 李兴冀 徐鹏飞
(哈尔滨工业大学材料科学与工程学院,哈尔滨 150001)
1 引 言
空间辐射环境中的带电粒子及各种射线是造成航天器内部的电子器件损伤的主要原因[1−6],其中以电离辐射效应为主.双极晶体管作为双极电路中的基本单元,具有诸多优良特性,广泛应用于航天电子系统,但对电离辐射效应具有较高的敏感性[7−9].电离辐射损伤会在双极晶体管的内部形成两种类型的缺陷:氧化物俘获电荷和界面态[10−12].由于电离辐射损伤使晶体管内部产生大量的电子-空穴对,处于氧化层中的自由电子比空穴的迁移速率大得多,可以迅速逸出SiO2/Si界面.空穴的迁移速率小,留下的空穴易于被形成具有氧空位的缺陷俘获,形成氧化物俘获正电荷.其中,含氢的氧空位释放出质子,质子传递到界面处与Si-H发生反应,形成界面态陷阱电荷.这两种缺陷的产生会使表面复合速率增加,引起复合电流增大,电流增益下降,最终导致双极晶体管的电学性能发生退化.
研究表明,电子器件的电离辐射敏感性与其结构密切相关[13,14].Shaneyfelt等[15]针对有/无Si3N4钝化层结构的LM111和LM139两种器件的研究表明,在相同辐照条件下,具有钝化层结构的器件,输入偏置电流随电离总剂量的变化更明显,说明钝化层结构对器件受到电离辐射的损伤程度有密切的关系.马武英等[14]探究了有/无Si3N4钝化层结构对栅控横向PNP双极晶体管辐射响应的影响.基于栅扫描技术发现,有钝化器件的基极电流随着栅压变化出现展宽现象.由此得出推论,有钝化层的器件可能是由于制备钝化层过程中引入了氢分子,导致界面电荷的增加并使得界面态能级分散.然而,上述研究无法排除栅极工艺的影响.上述研究表明,双极晶体管的辐射特性具有很强的工艺相关性.然而,迄今无法直接证明钝化层对电离辐射损伤的影响机理.
为了解决上述问题,本文选取60Co源作为辐照源,针对横向PNP(LPNP)双极晶体管,采用电性能测试及深能级缺陷分析等两种研究手段相结合,深入研究了有/无Si3N4钝化层处理双极晶体管的电离辐射微观缺陷及损伤机理.通过综合运用电性能测试和微观缺陷分析两种手段,可以更好地揭示器件宏观性能退化与微观缺陷演化的对应关系,阐明钝化层材料和结构对双极器件电离辐射损伤程度的影响机理.
2 试验器件与试验方法
本实验选用国产双极电路中广泛采用的LPNP双极晶体管作为研究对象,采用两种钝化处理方式.第一种LPNP晶体管仅有SiO2钝化层;第二种LPNP晶体管在SiO2钝化层上进行了Si3N4钝化.两种晶体管的SiO2钝化层厚度相同,约为900 nm;Si3N4钝化层厚度约为1200 nm,如图1所示.本文选取60Co γ射线辐照源进行辐照试验,辐照剂量率为100 rad(Si)/s,总剂量为100 krad(Si),室温大气下进行辐照.辐照过程中器件所有管脚均为接地状态.
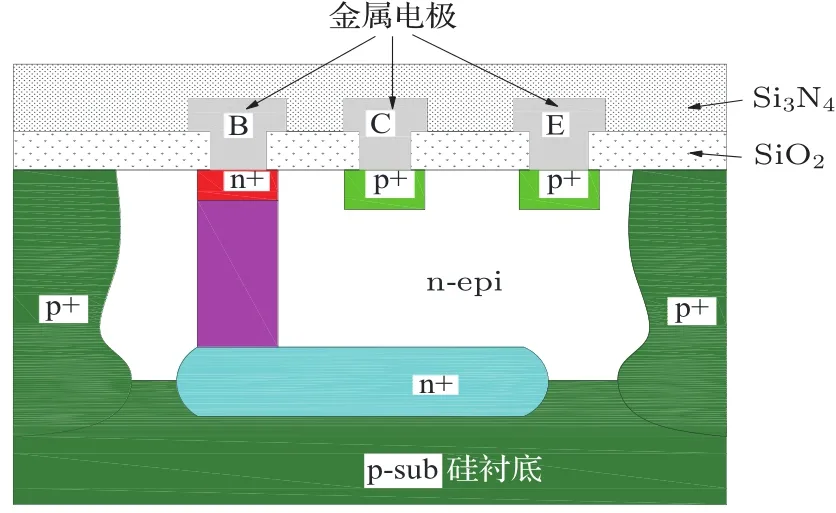
图1 有/无Si3N4钝化层的LPNP双极晶体管结构图Fig.1.Structure of lateral PNP(LPNP)bipolar junction transistor with/without nitride passivation layer.
辐照试验前后,针对LPNP晶体管进行Gummel曲线测试.Gummel曲线的测试条件为:发射极接扫描电压,以0.01 V的步长从0.2 V扫描至0.8 V,即VEB=0.2—0.8 V;基极和集电极均接地,即VB=VC=VBC=0.由Gummel特性曲线,可以得到LPNP晶体管的电流增益β及其倒数随吸收剂量的变化规律.此外,通过晶体管基极电流IB和集电极电流IC在辐照前后的变化量可以定性表征电离缺陷的变化规律,用于和深能级瞬态谱的比较.
深能级瞬态谱(DLTS)是检测半导体材料和器件中深能级缺陷最有效的方法.对辐照前后双极晶体管进行DLTS测试分析,可以定量表征微观缺陷的演化特征.为了深入分析LPNP晶体管电离辐照损伤微观机理,本文利用深能级瞬态谱测试系统对辐照前后LPNP晶体管内部的微观缺陷状态进行了测试分析.
在电离辐射条件下,双极晶体管中所产生的DLTS信号峰本质上是氧化层俘获正电荷和界面态对Si体材料中载流子迁移行为影响的外在表现.对于双极晶体管,DLTS测试时将给定的高频电压加到PN结上,电压值在反向偏压UR和填充脉冲电压UP之间往返(UR>UP).通过结电容的变化,可以获得深能级缺陷信息.测试是在给定温度范围内进行的,扫描得到的∆C-T测试曲线便是深能级瞬态谱.选取PNP双极晶体管中掺杂浓度较低的集电区进行深能级瞬态谱测试,测试过程中PNP双极晶体管的基极接高电位,集电极接低电位.DLTS测试过程中设定的主要参数为:反向偏压VR=5 V,脉冲电压VP=0.1 V,测试周期TW=4 s,脉冲宽度TP=0.01 s,扫描温度从150 K到330 K.
3 实验结果与分析
3.1 电性能测试分析
图2为在剂量率100 rad(Si)/s的60Co γ射线辐照条件下,有/无Si3N4钝化层的LPNP双极晶体管Gummel特性曲线.由图2(a)可知,随着吸收剂量的增加,无论有氮化层还是无氮化层的LPNP晶体管基极电流(IB)均逐渐增加.并且,当发射结电压VEB较小时,IB增加量较大;当发射结电压VEB较大时,IB增加量减小.从图中可以看出,有氮化层的LPNP晶体管IB增加量明显大于无氮化层的LPNP晶体管.图2(b)示出了有/无Si3N4钝化层的LPNP晶体管的集电极电流(IC)随发射结电压VEB的变化情况.由图可知,随着吸收剂量的增加,无氮化层的LPNP晶体管IC几乎未发生变化.有氮化层的LPNP晶体管的IC随辐照剂量的增加略有降低,辐照后二者IC的变化差别不是很明显.这表明辐照后有/无氮化层对LPNP晶体管电学性能的影响主要表现在IB的差别上.

图2 相同辐照条件下,有/无Si3N4钝化层的LPNP双极型晶体管在辐照前后(a)基极电流IB和(b)集电极电流IC随VEB的变化Fig.2.Variations of(a)base current;(b)collector current with base-emitter for the PNP bipolar transistorswith/without nitride passivation layer under the same irradiation conditions.
辐照前后双极晶体管基极电流的变化量称为过剩基极电流.通过研究双极晶体管中过剩基极电流(∆IB)与发射极-基极电压(VEB)的变化关系,可以深入分析氧化物电荷和界面态对双极晶体管辐射损伤的影响规律,进而揭示有/无Si3N4钝化层对双极晶体管电离辐射损伤的影响机理.过剩基极电流为∆IB=IB−IB-pre,式中,IB为辐照后晶体管的基极电流,IB-pre为辐照前的基极电流.针对双极晶体管的电离辐射损伤效应,引入理想因子n,过剩基极电流为∆IB正比于exp(VEB/n·VT),其中,VEB为发射极-基极结的偏压,VT为硅中载流子的热电压,n为理想因子.根据文献[16,17]可知,∆IB来自于表面复合电流和体复合电流.理想情况下,在辐照过程中,如果过剩基极电流是以空间电荷区的复合电流为主,理想因子n=2;如果过剩基极电流来源于空间电荷区及中性基区的复合电流,则理想因子n<2.在60Co γ射线辐照条件下,双极晶体管主要受到电离辐射的影响,而电离辐射损伤主要在双极晶体管内部产生两种类型的辐射缺陷,包括氧化物俘获正电荷和界面态.氧化物俘获正电荷和界面态均会影响表面复合电流和体复合电流.

图3 在相同辐照条件下,有/无Si3N4钝化层的PNP双极型晶体管的∆IB随VEB的变化Fig.3.Variations of excess base current(∆IB)with base-emitter voltage(VEB)for the PNP transistors with/without nitride passivation layer under the same irradiation conditions.
图3示出了在相同剂量率辐照条件下,有/无Si3N4钝化层的LPNP双极晶体管辐照过程中∆IB随发射结电压VEB的变化关系.由图可知,对于这两种类型的LPNP晶体管来说,随着电离吸收剂量的增加,∆IB均明显增加;两种类型的LPNP晶体管∆IB的理想因子n随VEB变化曲线斜率为n<2.因此,有/无Si3N4钝化层的LPNP晶体管的∆IB是由空间电荷区和中性基区的复合电流共同作用引起的.此外,在相同辐照条件下,与无氮化层的LPNP晶体管相比,有氮化层的LPNP晶体管∆IB增加幅度更大,这进一步说明有氮化层的LPNP晶体管受到的辐射损伤程度大.这是由于在辐照过程中,会产生大量的界面态,使空间电荷区和中性基区的表面复合电流增加,进而产生过剩基极电流.而PNP双极晶体管中,位于基区上方氧化层中的氧化物正电荷的累积会导致Si/SiO2界面附近少子浓度降低,使少子和多子浓度的差值增大,降低了表面复合率,抑制了基极电流的增加.基于以上分析,过剩基极电流主要是由界面态造成的.此外,与无氮化层的LPNP晶体管相比,辐照过程中有氮化层的LPNP晶体管产生的过剩基极电流大,由此可知,有氮化层的LPNP晶体管辐照诱导的界面态加快表面复合速率,促使复合电流的增加更为显著,导致少子寿命及电流增益的降低,进而使器件的电性能退化程度加剧.
3.2 深能级缺陷分析
根据上述分析可知,LPNP晶体管电性能退化的微观机理主要受界面态的影响.现对上述试验结果进行微观缺陷分析.
图4为相同辐照条件下,有/无Si3N4钝化层的LPNP双极晶体管深能级瞬态谱的比较结果.图中信号峰对应的横坐标温度反映类深能级缺陷的能级位置,而纵坐标高度对应于类深能级缺陷的浓度.由图4可见,在60Co γ射线辐照后,有/无Si3N4钝化层的LPNP晶体管的深能级瞬态谱中均出现了明显的特征信号峰,DLTS信号为正值,表明60Co γ射线在LPNP晶体管集电区中所产生的缺陷信号为多子陷阱中心,且缺陷信号峰所在的温度范围为250—320 K.与无氮化层晶体管相比,有氮化层的晶体管辐照后DLTS特征峰向左移动,将其分别命名为H(310)缺陷和H(300)缺陷.针对所出现的信号峰,基于DLTS测试系统中阿伦尼乌斯方程进行拟合,计算得出辐射缺陷对应的能级,如图5所示.由图5可知,无氮化层的LPNP晶体管中的类深能级缺陷能级为Ec=0.716 eV;有氮化层的LPNP晶体管中的类深能级缺陷能级为Ec=0.630 eV.已有大量研究表明,针对硅基双极晶体管,类深能级缺陷能级位于0.6—0.8 eV之间的信号为界面态陷阱[18−20].基于上述分析可知,对于LPNP晶体管,钝化层会影响电离辐射损伤产生的类深能级缺陷能级位置,有氮化层的LPNP晶体管中引入的缺陷能级位置变浅,更接近Si禁带中心(Ec=0.55 eV).从图4中还发现,无Si3N4钝化层LPNP晶体管的DLTS特征峰的高度大于有Si3N4钝化层的,这说明无Si3N4钝化层的晶体管辐射产生的类深能级缺陷浓度大于有Si3N4钝化层的.根据肖克莱-里德-霍尔模型[21]可知,能级越接近禁带中心的缺陷复合效率越高,对器件造成的损伤越大.在缺陷能级相同的情况下,缺陷浓度越高,损伤越大.因此,基于上述分析可知,有/无Si3N4钝化层LPNP晶体管辐射损伤的程度由缺陷能级和缺陷浓度综合作用的效果而定,既不单独取决于缺陷能级,也不单独取决于缺陷浓度,其中缺陷能级占主导作用,显著影响晶体管的电性能的退化程度.Si3N4钝化层的存在促使LPNP器件电离辐射损伤缺陷的能级位置发生改变,能级位置更接近禁带中心,从而加剧了LPNP晶体管的辐射损伤.

图4 60Co γ射线辐照条件下,有/无Si3N4钝化层的LPNP双极型晶体管深能级瞬态谱图Fig.4.DLTS spectra of the PNP transistors with/without nitride passivation layer irradiated by60Co source.

图5 阿伦尼乌斯方程拟合曲线Fig.5.Arrhenius equation fitting curve.
根据上述分析,现通过LPNP双极晶体管电流增益∆β及其电流增益倒数∆(1/β)随电离吸收剂量的关系,直观地反映电性能变化规律,以证明钝化层对电离辐射损伤的影响机理,从而揭示器件宏观性能退化与微观缺陷演化的对应关系.晶体管的电流增益β可由Gummel特性曲线计算获得.对于LPNP双极晶体管,当VEB=0.65 V时,集电极电流与基极电流的比值(β=IC/IB)定义为电流增益.电流增益的变化量取为∆β=β−β0,电流增益倒数的变化量为∆(1/β)=1/β − 1/β0,式中β0和β分别代表晶体管辐照前和辐照后的电流增益值.
图6和图7为在剂量率为100 rad(Si)/s的60Co γ射线辐照条件下,LPNP晶体管的∆β和∆(1/β)随电离吸收剂量的变化结果.由图可以看出,有/无Si3N4钝化层的LPNP晶体管的∆β均随电离吸收剂量的增加而降低,∆(1/β)则先逐渐增加,然后趋于饱和.上述结果表明,在剂量率为100 rad(Si)/s的60Co γ射线辐照条件下,有/无Si3N4钝化层的LPNP晶体管发生明显的辐射损伤.并且,在相同吸收剂量条件下,与无钝化层的LPNP晶体管相比,有氮化层的晶体管电流增益的退化程度更大.与上述钝化层对电离辐射损伤影响的微观机理讨论结果相符合.

图6 在相同辐照条件下,有/无氮化层处理的LPNP双极型晶体管的电流增益随电离吸收剂量的变化Fig.6.The current gain as a function of total dosefor the LPNP transistors with/without nitride passivation layer under the same irradiation conditions.
综合上述分析可知,与无氮化层的LPNP晶体管相比,有氮化层的LPNP晶体管电性能损伤严重,并且产生了大量的能级接近禁带中心位置的界面态.这主要是由于在进行氮化层制备过程中引入了大量的氢导致,这一现象已被文献[15]证实.文献中利用弹性反冲探测技术检测有/无氮化层的LM139电压比较器中氢元素的浓度.研究发现,与无氮化层的样品相比,有Si3N4钝化层的LM139样品内部引入了大量的氢元素,使其性能发生严重退化.器件内部氢的存在对其电离辐射效应产生显著影响,是导致器件Si/SiO2界面处产生界面态的主要因素[22−24],从而加剧了晶体管性能退化.此外,文献[25]研究表明,制备钝化层过程中引入的机械应力也会提高器件的抗辐射能力.然而,本文研究表明,与无氮化层的LPNP晶体管相比,具有氮化层的晶体管对电离辐射效应敏感.由此,可以认为具有氮化层的晶体管抗辐射能力差主要是由于制备钝化层过程中引入的氢,而不是机械应力导致.

图7 在相同辐照条件下,有/无氮化层处理的LPNP双极型晶体管的电流增益倒数随电离吸收剂量的变化Fig.7.The reciprocal of current gain as a function of total dose for the LPNP transistors with/without nitride passivation layer under the same irradiation conditions.
4 结 论
通过对比研究在60Co γ射线辐照过程中有/无Si3N4钝化层的LPNP双极晶体管的电性能及电离辐射缺陷的演化规律,揭示了氮化层的存在对LPNP双极晶体管电离辐射损伤的影响机理,得到以下结论.
1)在60Co γ射线辐照过程中,有/无Si3N4钝化层的LPNP晶体管的电性能参数呈现出类似的变化趋势,IB随电离吸收剂量的增加而增大,并且有氮化层的LPNP晶体管IB退化程度较大;有/无Si3N4钝化层的LPNP晶体管电流增益均随电离吸收剂量的增加发生明显的退化,其中有氮化层的LPNP晶体管的电流增益退化程度较大.
2)基于过剩基极电流的变化及DLTS分析表明,随着电离吸收剂量的增加,有/无Si3N4钝化层的LPNP晶体管的过剩基极电流由空间电荷区和中性基区复合电流共同作用.电离辐射导致有/无Si3N4钝化层的LPNP晶体管内部产生大量的界面态.与无氮化层的LPNP晶体管相比,有氮化层的LPNP晶体管产生的界面态缺陷能级更接近禁带中心位置.这主要是由于在制备氮化层过程中引入了大量的氢所导致.氢的存在促进了能级更接近禁带中心位置的界面态形成,从而加剧了晶体管性能的退化.
