AlGaN/GaN HEMT材料的高温MOCVD生长研究
2018-08-17陈峰武巩小亮罗才旺程文进
陈峰武,巩小亮,罗才旺,程文进,魏 唯,鲍 苹
(中国电子科技集团公司第四十八研究所,湖南 长沙 410111)
第三代半导体材料GaN由于其禁带宽度大、耐高压、耐高温、抗辐射、电子迁移速率高、易于形成异质结构等,是制造高温、高频、高效、大功率、抗辐射微波电子器件和电路的理想材料。高频大功率GaN基高电子迁移率晶体管在相控阵雷达、电子对抗、5G通讯、汽车电子等领域具有广泛的应用前景,已成为目前国际学术界和产业界关注的焦点[1-3]。
目前,AlGaN/GaN HEMT的研究和应用取得了很多突破性的进展,但仍然面临着不少难题,例如外延材料的缺陷和杂质问题、欧姆接触问题、表面钝化问题、器件的稳定性和可靠性问题等[4]。其中外延材料的缺陷和杂质问题主要是由于缺乏同质衬底。为了弥补同质衬底的缺失,目前Al-GaN/GaN HEMT结构材料的生长一般在异质衬底上进行。常用的异质衬底有蓝宝石、碳化硅和硅。蓝宝石衬底由于生产技术成熟、机械强度高、热稳定性好等优点,已成为目前最常用的衬底材料,但其也存在导热性能差、与GaN的晶格失配和热失配大(分别为14%和35%)的问题;硅衬底具有成本低廉、尺寸大、导电性能好的优点,是未来低成本器件制造的一种重要候选衬底,但是同样存在与GaN的晶格失配和热失配过大(分别为17%和56%)导致外延层翘曲和开裂等问题。碳化硅衬底由于具备与GaN最小的晶格失配和热失配度(分别为3.5%和18%),导热性能优异等特点,是目前高频大功率AlGaN/GaN HEMT器件最合适的衬底材料[5]。
高电子迁移率AlGaN/GaN HEMT的研制一直是AlGaN/GaN基射频微波器件的发展方向。要提高二维电子气的迁移率,需要制备高质量的GaN沟道层和AlGaN势垒层。其中AlGaN势垒层中Al组分的含量、势垒层厚度、是否调制掺杂、晶体质量等对HEMT结构材料和器件性能的影响很大。增加AlGaN中Al含量提高了势垒高度因此提供对高密度二维电子气更好的限制。此外更宽的带隙还使击穿电场增加,这对高功率操作是必不可少的。然而由于在生长表面的Al难以移动,使得高质量的AlGaN生长困难并且使界面质量下降[6]。高温MOCVD技术能够改善AlGaN的晶体质量和表面质量,将对提高AlGaN/GaN HEMT的性能起到有益的作用。
本文采用中国电子科技集团公司第四十八研究所自主研制的高温MOCVD设备,在SiC衬底进行AlGaN/GaN HEMT结构材料的生长。高温MOCVD有着比普通MOCVD更高的晶片加热温度以及更低的工作气压和Ⅴ/Ⅲ比,因而更有利于高质量AlGaN材料的制备。本文通过高温MOCVD外延生长技术改善了AlGaN势垒层、AlN插入层的晶体质量和表面质量,从而获得了较高二维电子气迁移率的AlGaN/GaN HEMT结构材料。
1 试验
本文采用在中国电子科技集团公司第四十八研究所自主研制的高温MOCVD设备上生长Al-GaN/GaN HEMT结构材料。该高温MOCVD设备是针对高Al组分AlGaN材料、AlN材料及器件发展需求而研发出的一款设备,具有加热温度高、控温精度好、反应室压力和V/Ⅲ比调控范围宽、颗粒物少等优点。高温MOCVD每次能生长6片75 mm(或4片100 mm),反应室配备了高温原位监测系统,可实时监测和分析外延生长速率、衬底表面温度、反射率等。实验中,以三甲基铝(TMAl)、三甲基镓(TMGa)和氨气(NH3)分别为Al源、Ga源和N源,利用氢气和氮气的混合气体作为载气。
采用的AlGaN/GaN HEMT外延生长结构如图1所示。衬底为75 mm 4H半绝缘SiC衬底。在生长工艺上,首先在半绝缘SiC衬底上生长50 nm的AlN形核层,然后生长2 μm厚的非故意掺杂高阻GaN缓冲层,接着生长2 μm厚的非故意掺杂高迁移率GaN沟道层,最后高温外延生长1.5 nm厚的AlN插入层和20 nm厚的非故意掺杂Al-GaN势垒层。采用三步生长法来进行GaN沟道层的外延生长,可以实现GaN沟道层的二维层状生长,从而可获得高表面平整度和晶体质量的GaN沟道层;采用高温外延生长工艺(高生长温度、低生长气压和低Ⅴ/Ⅲ比)提高Al原子的表面迁移率,降低Al源与N源之间的气相预反应,提高AlGaN势垒层、AlN插入层的晶体质量和表面质量;通过TMA流量和TMA/TMG流量比控制Al-GaN材料中Al组分。

图1 SiC衬底AlGaN/GaN HEMT外延生长结构
外延片晶体质量和Al组分含量采用高分辨X射线衍射仪(Bruker D8 Discover)测量,使用的射线源为 Cu Kα1(λ=0.154 06 nm);外延片的室温二维电子迁移率和浓度、方阻不均匀性采用Hall效应测试仪(Nanometrics HL5500PC)进行测量;样品的表面微观形貌和表面粗糙度采用扫描探针显微镜(NT-MDT Solver-Pro)进行测量。
2 结果及分析
2.1 晶体质量及Al组分含量分析
采用高分辨X射线衍射仪对AlGaN/AlN/GaN HEMT结构材料进行2θ-ω扫描,扫描曲线如图2所示。扫描曲线显示材料结晶完整,GaN(002)、AlGaN(002)以及 SiC(006)3 个衍射峰从左向右依次出现在图中。X射线衍射摇摆曲线半高宽是表征材料结晶质量的重要参数,图2给出了SiC衬底AlGaN/GaNHEMT外延结构材料的ω扫描摇摆曲线测试结果,从图2中可以看出,SiC衬底上GaN材料的(002)面摇摆曲线半高宽为160.9弧秒,(102)面摇摆曲线半高宽为224.3弧秒,均优于在蓝宝石衬底上的生长结果。这表明采用晶格更加匹配的SiC衬底,结合三步法外延生长工艺,可显著提高AlGaN/GaN HEMT外延结构中GaN沟道层的晶体质量。
此外,利用德国布鲁克D8 DISCOVER高分辨衍射仪的组分分析功能,对图2中的2θ-ω扫描曲线进行拟合分析,可得出拟合曲线如图3所示。由拟合结果得出,AlGaN材料Al组分含量为22.7%,AlGaN层的厚度为19.4 nm,与设计值相符合。为了测试AlGaN外延薄膜Al组分不均匀性,选取了AlGaN/GaN HEMT外延片中心及边缘区域5个位置进行了测量,测量结果分别为:24.05%、23.69%、22.73%、23.51%、22.87%,经计算,AlGaN外延薄膜Al组分不均匀性为2.39%。
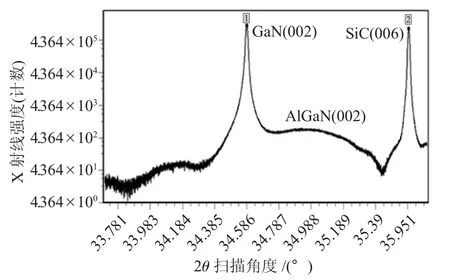
图 2 SiC衬底AlGaN/GaN HEMT外延材料材2θ-ω扫描曲线
2.2 电学性能分析
图3给出了半绝缘4H-SiC衬底AlGaN/GaN HEMT结构霍尔测量的典型结果。从图中可以看出,室温二维电子迁移率和载流子浓度分别为2 040 cm2/V·s和 6.15×1012cm-2,每方块电阻值为497 Ω,表明基于高温MOCVD设备制备的Al-GaN/GaN HEMT结构材料具有优异的二维电子气输运性能。
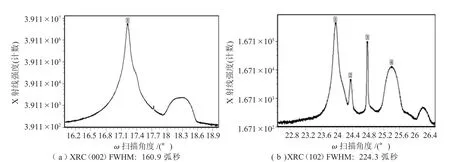
图3 AlGaN/GaN HEMT外延材料材中GaN的晶体质量测试结果

图4 AlGaN/GaN HEMT外延材料材中AlGaN材料的Al组分拟合分析
进一步,对AlGaN/GaN HEMT外延片方块电阻的片内及片间均匀性进行了Hall测试,选取了同一炉的4片外延片,每片外延片测试5个点,选点规则与测试AlGaN材料Al组分不均匀性一样,测试结果如表1所示。经计算,Al-GaN/GaN HEMT外延片方块电阻的片内不均匀性最大值为2.82%,方块电阻的片间不均匀性为3.92%。
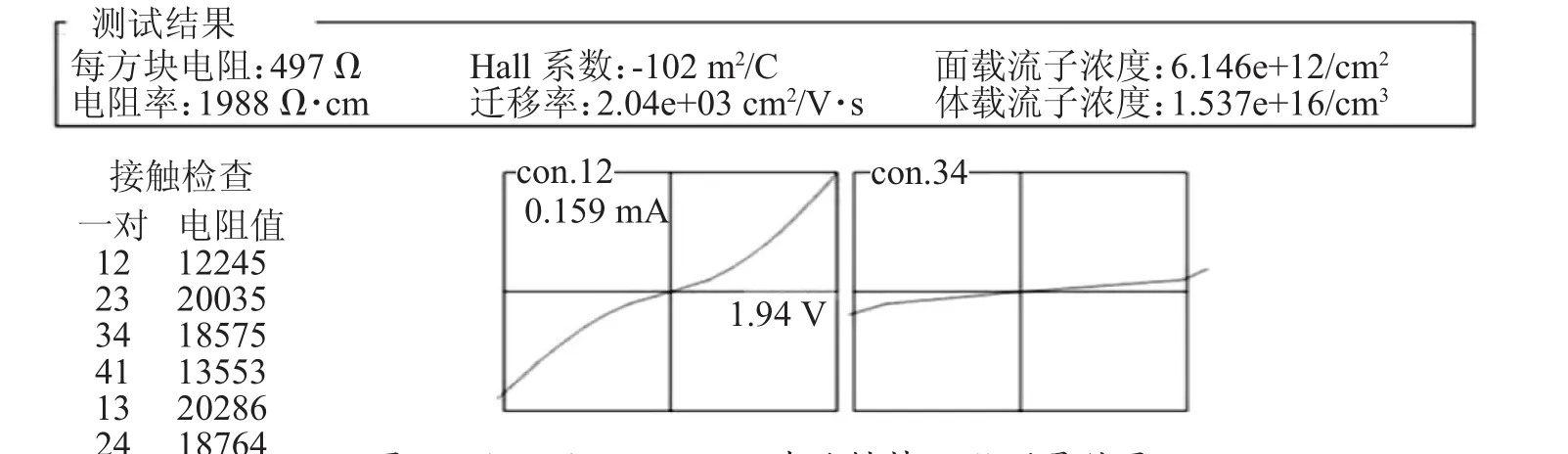
图4 AlGaN/GaN HEMT外延材料Hall测量结果

表1 AlGaN/GaN HEMT外延片方块电阻的片内及片间均匀性测试
2.3 表面形貌分析
采用AFM技术对AlGaN/GaN HEMT结构材料的表面形貌进行了测试,扫描面积为5 μm×5 μm,结果如图6所示。从图6中可以看出,Al-GaN/GaN HEMT结构材料表面呈现出台阶流生长模式,表面均方根粗糙度值为0.95 nm。

图6 AlGaN/GaN HEMT外延片表面的AFM形貌图
3 结 论
本文采用自主研制的高温MOCVD设备进行了AlGaN/GaN HEMT结构材料的生长。采用三步法进行了非掺杂GaN沟道层的生长,其高分辨X射线(002)和(102)面摇摆曲线半高宽分别为160.9弧秒和224.3弧秒,说明GaN沟道层具有较高的晶体质量。采用高温外延生长工艺进行了AlGaN势垒层和AlN插入层的生长,测试结果表明,AlGaN的Al组分和厚度分别为22.7%和19.4 nm,达到了设计要求;AlGaN材料表面呈现出台阶流生长模式,表面粗糙度为0.95 nm;异质结室温二维电子迁移率和浓度分别为2 040 cm2/V·s和6.15×1012cm-2,说明 Al-GaN/GaN异质结具有较高的二维电子气输运性能。AlGaN材料的Al组分不均匀性为2.39%,外延片方阻不均匀性最大值为2.82%,说明高温MOCVD设备具备良好的均匀性控制能力。研究结果表明,采用国产高温MOCVD设备能够制备出晶体质量、均匀性较好的AlGaN/GaN HEMT结构材料,可为我国高电子迁移率AlGaN/GaN HEMT的科研生产发挥积极作用。
