插指型SiO2电流阻挡层对大功率LED外量子效率的影响
2017-06-19刘梦玲高艺霖胡红坡刘星童吕家将郑晨居丁星火周圣军
刘梦玲, 高艺霖, 胡红坡, 刘星童, 吕家将, 郑晨居, 丁星火, 周圣军
(武汉大学 动力与机械学院, 湖北 武汉 430072)
插指型SiO2电流阻挡层对大功率LED外量子效率的影响
刘梦玲, 高艺霖, 胡红坡, 刘星童, 吕家将, 郑晨居, 丁星火, 周圣军*
(武汉大学 动力与机械学院, 湖北 武汉 430072)
为了改善蓝光大功率LED芯片p电极处的电流拥挤现象,提高大功率LED芯片的外量子效率,在ITO透明导电层与p-GaN间沉积插指型SiO2电流阻挡层。采用等离子体增强化学气相沉积的方法沉积SiO2薄膜,再经过光刻和BOE湿法刻蚀技术制备插指型SiO2电流阻挡层。采用SimuLED仿真软件分析插指型SiO2电流阻挡层对大功率LED芯片电流扩展性能的影响,研究插指型SiO2电流阻挡层对大功率LED芯片外量子效率的影响。结果发现,插指型SiO2电流阻挡层结构可以有效改善p电极附近的电流拥挤现象。与没有沉积插指型SiO2电流阻挡层的大功率LED芯片相比,光输出功率得到显著的提高。在350 mA的输入电流下,沉积插指型SiO2电流阻挡层后的大功率LED芯片的外量子效率提高了18.7%。
大功率LED; 插指型SiO2电流阻挡层; 电流拥挤; 外量子效率
1 引 言
发光二极管(Light-emitting diodes,LEDs)作为第四代光源,从20世纪60年代发展至今,由于具有节能环保、光电转换效率高、寿命长以及响应快等优点,被广泛应用于照明和显示等领域。LED芯片的外量子效率取决于芯片的内量子效率和芯片的出光效率。为了提高LED芯片的外量子效率,芯片结构被不断改善[1-5]。另外,为了获得更高光输出功率的LED芯片,以及提高LED芯片对电流的承受能力,芯片的面积逐渐增大,大功率LED芯片得到快速发展。
GaN半导体具有宽禁带、耐高温、高热导率、性质稳定等特点,使其成为应用最广泛的高性能电子器件的主流材料。目前市场上的GaN基半导体主要是在蓝宝石衬底上生长的,但是蓝宝石衬底与GaN之间存在较大的晶格失配,使得蓝宝石上生长的GaN外延材料具有较高的位错密度。图形化蓝宝石衬底技术不仅可以减少GaN外延层的位错密度,提高LED芯片的内量子效率,而且可以对LED芯片有源区发射的光的传播方向进行调制,从而提高LED芯片的出光效率[6-10]。此外,在LED芯片的侧面引入空气间隙结构可以进一步提高芯片的出光效率[11]。采用微结构技术[12]、表面粗化技术[13]、光子晶体技术[14]、图形化ITO技术[11]以及底部反射镜结构[15]等均可以有效提高芯片的出光效率。但是对于大功率LED芯片而言,由于输入电流增大,电流拥挤现象更加严重,从而影响了大功率LED芯片的外量子效率和芯片的可靠性[16-21]。通过在LED芯片的电极和p-GaN之间蒸镀一层ITO透明导电层可以改善电流的扩展性[22],但是由于ITO透明导电层的方块电阻大于n-GaN层的方块电阻,使得电流在p电极附近的拥挤现象仍然十分明显。LED芯片p电极附近的电流拥挤现象会导致芯片有源区光辐射功率分布不均匀,从而减小芯片的内量子效率,同时造成芯片局部热量集中,影响芯片的可靠性。在ITO透明导电层和p-GaN间沉积SiO2电流阻挡层可以缓解电流在p电极附近的拥挤现象,改善LED芯片有源区电流密度分布情况,从而提高LED芯片的外量子效率和整体性能[23-25]。
本文设计了一种插指型SiO2电流阻挡层,该阻挡层位于大功率LED的p电极的正下方,且图形与p电极的图形保持一致。采用实验与仿真相结合的方法,详细分析了该插指型SiO2电流阻挡层对大功率LED芯片电流扩展性能与外量子效率的影响。
2 实 验
采用金属有机化学气相沉积(MOCVD)设备在图形化蓝宝石衬底上生长GaN基LED外延结构。三甲基镓(TMGa)、三甲基铟(TMIn)、三甲基铝(TMAl)和氨气(NH3)分别为外延生长过程中的Ga源、In源、Al源和N源。硅烷(SiH4)和二茂镁(Cp2Mg)分别为n-GaN和p-GaN的掺杂材料。
将c面图形化蓝宝石衬底放入反应腔内,先经过1 034 ℃的高温清洗去除图形化蓝宝石衬底上的杂质,再经过525 ℃的低温成核过程形成30 nm的GaN缓冲层;将温度升高至1 010 ℃生长2.2 μm的u-GaN;然后将生长温度降到960 ℃生长120 nm的n-AlGaN;在1 010 ℃的温度下生长2.5 μm的n-GaN,其中Si的掺杂浓度为1×1019;接着生长InGaN/GaN超晶格应力释放层,该InGaN/GaN超晶格结构由12个周期的厚度分别为9 nm和2 nm的 InGaN/GaN组成, 其中InGaN和GaN的生长温度分别为750 ℃和800 ℃;然后生长225 nm的多量子阱(multiple quantum wells, MQWs)结构,该多量子阱由15个周期的厚度分别为12 nm和3 nm的GaN势垒层和InGaN势阱层组成,其中InGaN和GaN的生长温度分别为730 ℃和820 ℃;接着生长6个周期p-AlGaN/GaN超晶格电子阻挡层,其中p-AlGaN和GaN的厚度均为1.5 nm,生长温度均为900 ℃;然后在905 ℃的生长温度下生长10 nm厚的p-InGaN;在945 ℃的生长温度下生长110 nm的p-GaN,其中Mg的掺杂浓度为1×1020;然后在650 ℃的温度下生长5 nm厚的p-InGaN,最后采用炉外退火,在N2气氛中750 ℃下退火20 min。GaN基LED外延结构如图1所示。
大功率LED芯片的制造工艺如下:首先,将LED外延片分别放入小王水(HCL∶HNO3∶H2O)和稀盐酸刻蚀液(H2O∶HCL)中浸泡清洗,冲水甩干后,采用电感耦合等离子体(ICP)刻蚀的方法刻蚀出MESA图形,ICP的刻蚀深度为1.2 μm,直至暴露出n-GaN层。然后,采用PECVD在p-GaN上沉积厚度为190 nm 的SiO2薄膜,再经过光刻和BOE湿法刻蚀技术制备插指型SiO2电流阻挡层结构。接着,在60 ℃的温度下分别用511溶液(V(H2O)∶V(H2O2)∶V(H2SO4)=1∶1∶5)和稀盐酸溶液浸泡清洗。冲水甩干后,采用电子束蒸镀的方法沉积180 nm厚的ITO透明导电层,并制备p电极和n电极,电极材料为Cr/Pt/Au(50 nm/50 nm/2.1 μm)。通过机械减薄和研磨将LED外延片的厚度减薄至150 μm。最后,采用激光切割LED外延片制备大功率LED芯片,芯片尺寸为1.14 mm×1.14 mm(45 mil×45 mil)。

图1 GaN基LED外延结构示意图
采用聚焦离子束(FIB)技术制备透射电子显微镜(TEM)样品,并用TEM观察LED外延结构。采用405 nm的半导体激光器对LED外延片进行光致发光(Photoluminsecence,PL)测试。运用SimuLED仿真软件分析大功率LED芯片有源区电流密度分布情况,采用快速光谱仪测量芯片的光输出功率-电流-电压(L-I-V)曲线。
3 结果与讨论
3.1 LED外延结构
图2(a)为LED外延结构的透射扫描电镜(TEM)图。由图可知,位于图形化蓝宝石衬底上方的Ⅰ区位错密度明显小于没有图形结构的Ⅱ区。这是因为图形化蓝宝石衬底可使外延材料横向生长,从而减小位错密度。图2(b)展示了外延结构中的InGaN/GaN超晶格、InGaN/GaN多量子阱和p-AlGaN/GaN超晶格结构。可以看出,InGaN/GaN超晶格结构、InGaN/GaN多量子阱和p-AlGaN/GaN超晶格结构分别为12个周期、15个
周期和6个周期。图2(c)为12个周期的InGaN/GaN超晶格结构示意图。由图可知,InGaN/GaN超晶格结构中InGaN的厚度约为2 nm,GaN的厚度约为9 nm。图2(d)为6个周期的p-AlGaN/GaN超晶格结构示意图。由图可知,p-AlGaN/GaN超晶格结构中p-AlGaN和GaN的厚度均为1.5 nm左右。

图2 GaN基LED外延结构的透射扫描电镜图。(a)外延片整体结构图;(b)InGaN/GaN超晶格、InGaN/GaN多量子阱和p-AlGaN/GaN超晶格;(c)InGaN/GaN超晶格结构;(d)p-AlGaN/GaN超晶格结构。
Fig.2 TEM images of GaN-based LED epitaxial structure. (a) Overall structure of the wafer. (b) TEM image of InGaN/GaN superlattice, InGaN/GaN multiple quantum wells and p-AlGaN/GaN superlattice. (c) TEM image of InGaN/GaN superlattice. (d) TEM image of p-AlGaN/GaN superlattice.
图3显示了LED外延片的PL光谱。图3(a)为LED外延片的峰值波长分布图,由图可以看出,该外延片光致发光波长分布在450.5~456.5 nm,位于蓝光波段,最大波长与最小波长相差仅6 nm,从边缘到中心处,波长逐渐减小,且除外延片边缘部分外,发光波长分布较均匀;图3(b)为LED外延片的发光强度分布图,由图可知,与边缘部分相比外延片中间部分发光强度较大,但除去边缘部分,该外延片发光强度分布较均匀。可知该外延片发光波长位于蓝光波段且外延片的发光分布较均匀。

图3 LED外延片的光致发光分布图:(a)峰值波长;(b)发光强度。
Fig.3 Photoluminescence distribution of LED wafer. (a) Peak wavelength. (b) Light emission intensity.
3.2 插指型SiO2电流阻挡层对芯片电流扩展性能的影响
注入电流在大功率LED芯片有源区横向扩展的过程中,芯片内部某点处的电流密度为J(x)。根据电流扩展理论,由于p型接触电阻的降低以及p型掺杂浓度的提高使得水平结构大功率LED芯片的垂直串联电阻(Rv)可忽略不计,也即Rv上的电压降小于kT/q(26 mV,当T=300 K时),此时大功率LED芯片有源区电流密度分布可用下式表示[25-27]:
(1)
(2)
其中,J0为p电极边缘处最大电流密度,x为该点到p电极边缘的距离,Ls为电流扩展长度,k、T和q分别为玻尔兹曼常数、温度和电荷,ρs,ITO和ρs,n-GaN分别为ITO和n-GaN的方块电阻,nideal为GaN基LED的理想因子。在350 mA的输入电流下,当温度为300 K时计算得理想因子为1.7[28]。
由式(2)可知,电流扩展长度Ls与ITO和n-GaN的方块电阻有关。当ITO的厚度为180 nm时,经测量其方块电阻为40 Ω/□;当n-GaN的厚度为2.5 μm,电子浓度为1019/cm3,电子迁移率为175 cm2/(V·s)时,经测量n-GaN的方块电阻为15 Ω/□。当J0为28.7 A/cm2,ITO和n-GaN的方块电阻分别为40 Ω/□和15 Ω/□时,根据式(2)计算得电流的扩展长度为89.1 μm。
图4(a)为MESA和插指型SiO2电流阻挡层示意图,其宽度分别为24 μm和15 μm。n焊盘和p焊盘处的直径分别为134 μm和110 μm。由于电流扩展长度Ls为89 μm,因此我们设计插指型SiO2电流阻挡层图形时,使SiO2电流阻挡层的插指与MESA边缘的距离为89 μm。图4(b)为p电极和n电极形状示意图,其中p电极和n电极的宽度分别为5 μm和6 μm。图4(c)为p电极(Cr/Pt/Au)、位于p电极下厚度为180 nm的ITO透明导电层以及位于ITO透明导电层下厚度为190 nm的SiO2电流阻挡层的TEM图。该插指型SiO2电流阻挡层的形状与大功率LED的p电极的形状相同,且位于p电极的正下方。

图4 SiO2电流阻挡层形状示意图。(a)MESA和CBL图形示意图;(b)p电极和n电极示意图;(c)p电极、ITO透明导电层和SiO2电流阻挡层的TEM图。
Fig.4 Demonstration ofinterdigitated SiO2CBL. (a) Schematic diagram of MESA and CBL. (b) Schematic diagram of p-electrode and n-electrode. (c) TEM image of the deposited multilayer thin films including Cr/Pt/Au, ITO and SiO2CBL, respectively.
运用SimuLED仿真软件,仿真分析在350 mA输入电流下的插指型SiO2电流阻挡层对大功率LED芯片有源区电流密度分布的影响,其结果如图5所示。由图5(a)可知,没有沉积插指型SiO2电流阻挡层时,电流在p电极附近拥挤现象十分明显;对比图5(b)发现,插指型SiO2电流阻挡层结构可以有效改善p电极附近的电流拥挤现象,使大功率LED芯片有源区电流密度分布更均匀。
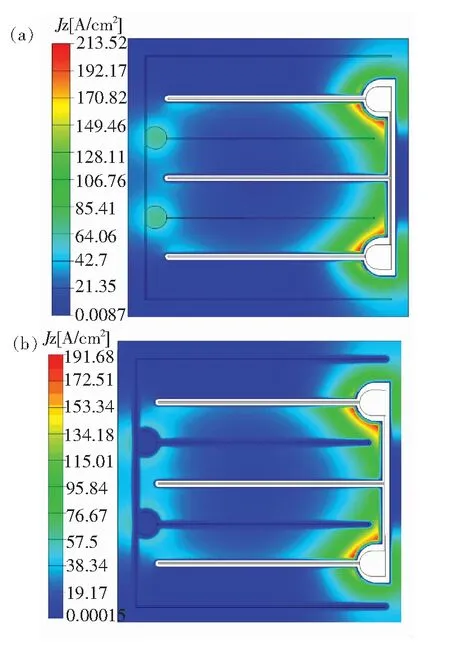
图5 无(a)、有(b)插指型SiO2电流阻挡层的大功率LED芯片有源区电流密度的SimuLED仿真分布图。
Fig.5 SimuLED simulation results of the current density distribution of high power LED in InGaN/GaN MQWs active region without (a) and with (b) interdigitated SiO2CBL
LEDⅠ和LEDⅡ分别表示没有和有插指型SiO2电流阻挡层的大功率LED芯片。采用快速光谱仪测量大功率LED芯片在不同输入电流下的光输出功率,得到LEDⅠ和LEDⅡ的光输出功率-电流(L-I)曲线,如图6(a)所示。在相同的输入电流下,LEDⅡ的光输出功率明显高于LEDⅠ。当输入电流为350 mA时,LEDⅠ和LEDⅡ的光输出功率分别为409.7 mW和486.4 mW,可知沉积插指型SiO2电流阻挡层后,芯片的光输出功率提高了18.7%。通过L-I曲线可计算 LED芯片的外量子效率(EQE):
(3)
其中,P为LED芯片的光输出功率(mW),I为输入电流(mA),λ为光波长(nm),将e(电子电荷量)、h(普朗克常量)和c(光速)的数值代入式(3)后可得:
(4)
将大功率LED芯片的光输出功率和发光波长带入公式(4)可得,在350 mA的输入电流下,LED Ⅰ和LED Ⅱ的外量子效率分别为42.7%和50.7%,可知沉积插指型SiO2电流阻挡层后,大功率LED芯片的外量子效率提高了18.7%。

图6 不同结构大功率LED芯片的L-I-V曲线。(a)L-I;(b)I-V。
Fig.6L-I-Vcharacteristics of high power LED with and without interdigitated SiO2CBL. (a)L-I. (b)I-V.
图6(b)为LEDⅠ和LEDⅡ 的电流-电压(I-V)曲线,根据I-V曲线可得电流传输路径中的动态电阻r:
(5)
其中Rsh为与p-n结的并联电阻,Rs为串联电阻。由式(5)可知,当电流I增大到一定值时,串联电阻Rs约等于动态电阻值r。根据图6(b)的I-V曲线可得,LEDⅠ和LEDⅡ的串联电阻分别为1 Ω和1.1 Ω。在350 mA的输入电流下,LEDⅠ和LEDⅡ的正向电压分别为3.19 V和3.22 V。由于沉积插指型SiO2电流阻挡层之后,ITO与p-GaN之间的欧姆接触面积减小,导致电流传输路径中的串联电阻增大了0.1 Ω,从而使大功率LED芯片的电压增大了0.03 V。
4 结 论
本文介绍了蓝光大功率LED芯片的外延生长工艺以及芯片制造工艺,采用Simu LED仿真软件分析了插指型SiO2电流阻挡层对大功率LED芯片电流扩展性能的影响。仿真结果表明,插指型SiO2电流阻挡层可以有效改善大功率LED芯片p电极处的电流拥挤现象,使大功率LED芯片有源区的电流密度分布更加均匀。与没有沉积插指型SiO2电流阻挡层的大功率LED芯片相比,LED芯片的光输出功率明显提高。在350 mA的输入电流下,沉积插指型SiO2电流阻挡层使大功率LED芯片的外量子效率提高了18.7%。
[1] NAKAMURA S. GaN growth using GaN buffer layer [J].Jpn.J.Appl.Phys., 1991, 30(10A):L1705-L1707.
[2] 江风益, 刘军林, 王立, 等. 硅衬底高光效GaN基蓝色发光二极管 [J]. 中国科学: 物理学 力学 天文学, 2015, 45(6):067302-1-18. JIANG F Y, LIU J L, WANG L,etal.. High optical efficiency GaN based blue LED on silicon substrate [J].SciSinicaPhys.Mech.Astron., 2015, 45(6):067302-1-18. (in Chinese)
[3] 张连, 魏学成, 路坤熠, 等. 能带调控提高GaN/InGaN多量子阱蓝光LED效率研究 [J]. 中国科学: 物理学 力学 天文学, 2015, 45(6):067305-1-6. ZHANG L, WEI X C, LU K Y,etal.. Investigation of the GaN-based light-emitting diodes with engineered energy band in InGaN multiple quantum wells [J].Sci.SinicaPhys.Mech.Astron., 2015, 45(6):067305-1-6. (in Chinese)
[4] 谢世勇, 郑有炓, 陈鹏, 等. GaN材料p型掺杂 [J]. 固体电子学研究与进展, 2001, 21(2):204-210. XIE S Y, ZHENG Y D, CHEN P,etal. p-type doping of GaN [J].Res.Prog.SSE, 2001, 21(2):204-210. (in Chinese)
[5] 徐现刚, 崔得良, 唐喆, 等. InGaAs/InP异质结界面层的应变研究 [J]. 中国科学(A辑), 2001, 31(9):817-822. XU X G, CUI D L, TANG Z,etal.. Investigation of interface strain in InGaAs/InP heterojunctions [J].Sci.ChinaSer. A, 2001, 31(9):817-822. (in Chinese)
[6] WANG W K, WUU D S, LIN S H,etal.. Efficiency improvement of near-ultraviolet InGaN LEDs using patterned sapphire substrates [J].IEEEJ.QuantumElectron., 2005, 41(11):1403-1409.
[7] LEE J H, LEE D Y, OH B W,etal.. Comparison of InGaN-based LEDs grown on conventional sapphire and cone-shape-patterned sapphire substrate [J].IEEETrans.ElectronDevices, 2010, 57(1):157-163.
[8] MURAMOTO Y, KIMURA M, NOUDA S. Development and future of ultraviolet light-emitting diodes: UV-LED will replace the UV lamp [J].Semicond.Sci.Technol., 2014, 29(8):084004-1-8.
[9] 付星星, 刘扬, 张国义. PSS侧壁弧度优化及对GaN基LED出光效率的影响 [J]. 微纳电子技术, 2016, 53(5):321-325. FU XX, LIU Y, ZHANG G Y. Radian optimization of the side-wall of the PSS pattern and its influence on the light extraction efficiency of GaN-based LEDs [J].Micronanoelect.Technol., 2016, 53(5):321-325. (in Chinese)
[10] ZHOU S Z, WANG H Y, LIN Z T,etal.. Study of defects in LED epitaxial layers grown on the optimized hemispherical patterned sapphire substrates [J].Jpn.J.Appl.Phys., 2014, 53(2):025503.
[11] ZHOU S J, YUAN S, LIU S,etal.. Improved light output power of LEDs with embedded air voids structure and SiO2current blocking layer [J].Appl.Surf.Sci., 2014, 305:252-258.
[12] GUO S, ZHOU S X, LI H J,etal.. Light diffusing films fabricated by strawberry-like PMMA/SiO2composite microspheres for LED application [J].J.ColloidInterf.Sci., 2015, 448:123-129.
[13] FUJII T, GAO Y, SHARMA R,etal. Increase in the extraction efficiency of GaN-based light-emitting diodes via surface roughening [J].Appl.Phys.Lett., 2004, 84(6):855-857.
[14] WIERER JJ, KRAMES M R, EPLER J E,etal.. InGaN/GaN quantum-well heterostructure light-emitting diodes employing photonic crystal structures [J].Appl.Phys.Lett., 2004, 84(19):3885-3887.
[15] HUANG H M, HU J Y, WANG H. GaN-based light-emitting diodes with hybrid micro/nano-textured indium-tin-oxide layer [J].J.Semicond., 2014, 35(8):084006-1-5.
[16] ZHOU S J, CAO B, YUAN S,etal.. Enhanced luminous efficiency of phosphor-converted LEDs by using back reflector to increase reflectivity for yellow light [J].Appl.Opt., 2014, 53(34):8104-8110.
[17] KIM H, LEE S N. Theoretical considerations on current spreading in GaN-based light emitting diodes fabricated with top-emission geometry [J].J.Electrochem.Soc., 2010, 157(5):H562-H564.
[18] 邹水平, 吴柏禧, 万珍平, 等. 电-热应力对GaN基白光LED可靠性的影响 [J]. 发光学报, 2016, 37(1): 124-129. ZOU S P, WU B X, WAN Z P,etal.. Effect of current-temperature stress on the reliability of GaN LED [J].Chin.J.Lumin., 2016, 37(1): 124-129. (in Chinese)
[19] LI Q, LI Y F, ZHANG M Y,etal.. Current spreading in GaN-based light-emitting diodes [J].Chin.Phys. B, 2016, 25(11):117102-1-6.
[20] 费翔, 钱可元, 罗毅. 大功率LED结温测量及发光特性研究 [J]. 光电子·激光, 2008, 19(3):289-292, 299. FEI X, QIAN K Y, LUO Y. Junction temperature measurement and luminous properties research of high-power LED [J].J.Optoelectron.·Laser, 2008, 19(3):289-292, 299. (in Chinese)
[21] JEONG T, PARK H J, JU J W,etal.. High efficiency InGaN blue light-emitting diode with >4-W output power at 3 A [J].IEEEPhoton.Technol.Lett., 2014, 26(7):649-652.
[22] LAI W C, LIN C N, LAI Y C,etal.. GaN-based light-emitting diodes with graphene/indium tin oxide transparent layer [J].Opt.Express, 2014, 22(S2):A396-A401.
[23] ZHOU S J, LIU S, DING H. Enhancement in light extraction of LEDs with SiO2current blocking layer deposited on naturally textured p-GaN surface [J].Opt.LaserTechnol., 2013, 47:127-130.
[24] 郭伟玲, 俞鑫, 刘建朋,等. 具有电流阻挡层的不同GaN基LED的光电特性 [J]. 发光学报, 2013,34(7):918-923. GUO W L, YU X, LIU J P,etal.. Electrical and optical characteristics of different GaN-based light emitting diodes with current blocking layer [J].Chin.J.Lumin., 2013, 34(7):918-923.
[25] GUO X, SCHUBERT E F. Current crowding and optical saturation effects in GaInN/GaN light-emitting diodes grown on insulating substrates [J].Appl.Phys.Lett., 2001, 78(21):3337-3339.
[26] SCHUBERT E F, GESSMANN T, KIM J K.LightEmittingDiodes[M]. New York: John Wiley & Sons, Inc., 2005.
[27] LV JJ, ZHENG C J, CHEN Q,etal.. High power InGaN/GaN flip-chip LEDs with via-hole-based two-level metallization electrodes [J].Phys.Stat.Sol. (a), 2016, 213(12):3150-3156.
[28] SHAH J M, LI Y L, GESSMANN T,etal.. Experimental analysis and theoretical model for anomalously high ideality factors (n≫2.0) in AlGaN/GaN p-n junction diodes [J].J.Appl.Phys., 2003, 94(4):2627-2630.

刘梦玲(1993-),女,湖北黄石人,硕士研究生,2016年于南昌大学获得学士学位,主要从事GaN基LED芯片和先进电子制造等方面的研究。

E-mail: lml0305@whu.edu.cn周圣军(1983-),男,湖北天门人,博士,副教授,硕士生导师,2011年于上海交通大学获得博士学位,主要从事GaN基LED芯片和先进电子制造方面的研究。
Email: zhousj@whu.edu.cn
Effect of Interdigitated SiO2Current Blocking Layer on External Quantum Efficiency of High Power LEDs
LIU Meng-ling, GAO Yi-lin, HU Hong-po, LIU Xing-tong, LYU Jia-jiang,ZHENG Chen-ju, DING Xing-huo, ZHOU Sheng-jun*
(WuhanUniversity,SchoolofPowerandMechanicalEngineering,Wuhan430072,China)
In order to alleviate current crowding around p-electrode of high power blue light-emitting diodes (LEDs) and improve its external quantum efficiency (EQE), a SiO2current blocking layer (CBL) was deposited between ITO transparent conductive layer and p-GaN by plasma enhanced chemical vapor deposition (PECVD). An interdigitated SiO2CBL pattern was then fabricated by photolithography and BOE wet etching process. The effect of interdigitated SiO2CBL on the current spreading performance of high power LED was analyzed using commercial SimuLED package. It is found that the current crowding around the p-electrode is effectively alleviated by employing the interdigitated SiO2CBL. Comparing with the high power LED without interdigitated SiO2CBL, the light output power is significantly improved. At 350 mA injection current, the external quantum efficiency of the high power LED with interdigitated SiO2CBL is 18.7% higher than that of LED without interdigitated SiO2CBL.
high power LED; interdigitated SiO2CBL; current crowding; external quantum efficiency
1000-7032(2017)06-0786-07
2016-12-05;
2017-02-03
国家自然科学基金(51675386, 51305266); “863” 国家高技术研究发展计划重大项目(2015AA03A101)资助 Supported by National Natural Science Foundation of China(51675386, 51305266); Major Project of “863” National High Technology Research and Development Program(2015AA03A101)
TN383
A
10.3788/fgxb20173806.0786
*CorrespondingAuthor,E-mail:zhousj@whu.edu.cn
