背照式EMCCD背端处理技术研究
2016-12-10周福虎丁继洪朱小燕
周福虎,丁继洪,朱小燕
(北方通用电子集团有限公司,安徽蚌埠233042)
背照式EMCCD背端处理技术研究
周福虎,丁继洪,朱小燕
(北方通用电子集团有限公司,安徽蚌埠233042)
为了消除EMCCD芯片背面平坦抛光光敏区的物理机械缺陷、可动电荷、硅表面界面不连续等产生的电荷态,降低器件暗电流和光电转换效率。采用带介质低能硼注入及激光退火工艺技术,建立一个由P_指向P+的内建场;成功的将硼杂质激活,且结深小于0.1μm,形成了P+/P-型光敏区自建电场,满足BE背端处理的要求。
激光退火;自建电场;结深;金属引线完整性;参考芯片
一、引言
英国的E2V公司在前期的产品开发中,采用前照式工作模式,倍增电压高、内部增益高、像元尺寸较大、制作工艺相对简单、成本低,但受器件正面半透明多晶硅电极的反射与吸收影响,器件量子效率较低,特别是对较短波长的探测如400 nm以下的光[1]。E2V公司在高性能的产品中,开发了背照结构的EMCCD,入射光从器件的背面照射光敏区,在增加了抗反射膜层及背端自建电场技术等处理后,器件量子效率得到了极大提高,背照式EMCCD的量子效率是当前EMCCD中最高的[2]。背照EMCCD性能优于前照结构,但芯片衬底减薄与抛光后的背端P_层将形成耗尽层,成为光电子的势阱,极大影响器件的量子效率和暗电流[3],所以对背端的处理,是研究背照式EMCCD器件的关键技术之一。采用低能硼注入及激光退火工艺术,建立一个由P_指向P+的内建电场;成功的将硼杂质激活,结深小于0.1μm,且能够使金属线条能够保证完整。
二、工艺实验方案设计
通过低能硼注入及激光退火,在芯片背端外延层P_区引入约300-600埃,杂质浓度高达1E20的P+区,形成P+/P_结构,建立一个由P_指向P+的内建电场。退火工序位于多层金属布线工艺之后,进行杂质激活的同时必须保证金属引线的完整性,同时EMCCD器件工艺属于典型浅结工艺,避免浅结推进,要求杂质扩散结深小于0.1μm。
工艺实验方案有两种,一种为验证芯片,另一种为参考芯片;通过对验证芯片、参考芯片的方块电阻、杂质激活后形成的结深数据对比验证,以及对验证芯片背端金属线条的完整性检验,确定背照式EMCCD背端处理工艺技术方案的可行性。由于工艺设备限制,无超低能离子注入机,因此验证芯片以及参考芯片均采取带介质注入。验证芯片是在N<111〉衬底以及P<111〉衬底硅片的背面进行铝金属溅射以及光刻刻蚀,芯片的正面淀积1300埃左右PE二氧化硅,之后进行P型杂质注入、激活,杂质激活工艺采用激光退火;参考芯片是在N<111〉衬底以及P<111〉衬底硅片上淀积1300埃左右的PE二氧化硅,带介质进行P型杂质注入,最后进行炉管退火(850℃,20minN2)。
三、工艺实验过程
(一)参考芯片实验方案:炉管退火
1.实验片工艺流程剖面图:
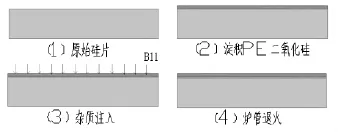
2.工艺实现的主要步骤:
(1)选择N<111〉的原始硅片做衬底,原始硅片电阻率为5.5Ω.cm~6.5Ω.cm。厚度为525μm,直径为100mm;
(2)在原始硅片上淀积1300埃左右的PE二氧化硅;
(3)P型杂质注入,剂量为1.5E15,能量为30Kev;
(4)杂质激活,采用炉管退火将杂质激活;退火条件为:850℃,20minN2;
“一份椰香鸡焗饭,一杯摩卡咖啡,咖啡后上啊,谢谢!”声音从背后传来,敦礼吃了一惊,自己光顾着胡乱猜想,人来了都不知道。他心虚似的,猛地端起咖啡喝了一大口,接着又朝周边看了看,坐直身子,很绅士地呷了一小口,然后放下咖啡,点了香酥鸡块和黑椒牛柳炒意面。
(5)进行方块电阻测试;
(6)磨结染色测试结深。
(二)验证芯片实验方案:激光退火
1.实验片工艺流程剖面图
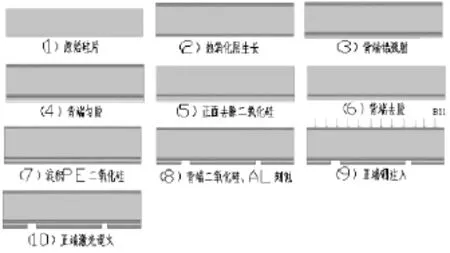
2.工艺实现的主要步骤:
(1)选择N<111〉的原始硅片做衬底,原始硅片电阻率为5.5Ω.cm~6.5Ω.cm。厚度为525μm,直径为100mm;
(2)在原始硅片上生长5500埃左右的一层热氧化层;
(4)芯片背端以及侧端匀胶保护,胶膜厚度约3.0μm;
(5)去除芯片正面热氧化层,采取干法加湿法工艺;
(6)芯片背端光刻胶去除;
(7)淀积1300埃左右的PE二氧化硅;
(8)背端二氧化硅、铝刻蚀,刻蚀出清晰的图形线条,CD尺寸为4μm;

表1 参考芯片以及原始硅片方块电阻测试对比

表2 验证芯片以及原始硅片方块电阻测试对比
(9)芯片正面P型杂质注入,剂量为1.5E15,能量为30Kev;
(10)芯片正面激光退火,杂质激活;
(11)测试方块电阻;
(12)磨结染色测试结深。
四、结果分析
(一)炉管退火后参考芯片以及原始硅片方块电阻对比
(二)激光退火后参考芯片以及原始硅片方块电阻对比
通过表1、表2数据对比分析,激光退火的验证芯片与炉管退火的参考芯片表面的杂质均已被激活,参考芯片N<111〉衬底的杂质方块电阻分布在465.4Ω/□~523Ω/□,P<111〉衬底的杂质方块电阻分布在125.3Ω/□~153.6Ω/□,验证芯片N<111〉衬底的杂质方块电阻为458.0Ω/□~698.8Ω/□,P<111〉衬底的杂质方块电阻分布在125.3Ω/□~153.6Ω/□;但是明显激光退火均匀性明显比炉管退火均匀性好,具体数据分析结果见表3。

表3 激光退火与炉管退火均匀性误差值对比

图3 参考芯片炉管退火后结深

图4 激光退火后结深
图3是参考芯片磨结染色后的结深,经测试检验,该区域为P型区域,结深大约为0.16μm。图4是验证芯片磨结染色后的结深,经测试检验,该区域为P型区域,但是由于设备精度能力原因,无法精确测量小于0.1μm的结深。但确定该区域为P型区域,且结深小于0.1μm。
五、结论
经过参考芯片与验证芯片对比分析,杂质方块电阻值几乎相等,说明激光退火将杂质激活,但是参考芯片方块电阻的均匀性明显较验证芯片均匀性好。参考芯片的结深控制在0.16μm左右,为P型区域;验证芯片的结深无法精确测量,无明显结深,由于设备精度能力原因,无法精确测量小于0.1μm的结深。但确定的是该区域为P型区域,且结深小于0.1μm。验证芯片激光退火后经过镜检,背面铝金属线条清洗可见,无明显变化。可以实现P+/P-型光敏区自建电场,满足BE自建电场的要求。
[1]戴丽英,刘德林,等.B电荷耦合器件的研制[J].光电子技术.2005,(3).
[2]周蓓蓓.电子倍增CCD的工作模式及其光子计数成像研究[N].南京理工大学硕士学位论文.2010.
[3]张鑫.基于BCCD的微弱目标成像系统设计[D].中国科学院长春光学精密机械与物理研究所.2011.
(责任编辑:袁媛)
Research on Back End Processing Technology of Back Illuminated EMCCD
ZHOU Fu-hu,DING Ji-hong,ZHU Xiao-yan
(North General Electronics Group Co.,Ltd.,Bengbu 233042,China)
In order to eliminate the physical and mechanical defects on the EMCCD chip surface,the movable charges and the charges generated by the discontinuous silicon surface,the dark currents and the photoelectric conversion efficiency of the device are reduced.The technology with medium low energy boron implantation and laser annealing is adopted to build an internal field from a P_to P+,which successfully activates the boron impurity.The junction depth is less than 0.1μm,and a P+/P-type photosensitive self-built electric field is created to meet the processing requirements of BE back end.
laser annealing;self-built electric field;junction depth;metal lead integrity;reference chip
TP393
B
2016-08-16
周福虎(1986-),男,安徽天长人,助理工程师,研究方向:微光成像器件的工艺开发。.E-mail:hfutz2008@126.com.
1671-802X(2016)05-0015-03
