垂直式MOCVD中生长参数对Ga N材料生长的影响
2016-11-23冯兰胜过润秋张进成
冯兰胜,过润秋,张进成
(1.西安电子科技大学机电工程学院,陕西西安 710071; 2.西安电子科技大学微电子学院,陕西西安 710071)
垂直式MOCVD中生长参数对Ga N材料生长的影响
冯兰胜1,过润秋1,张进成2
(1.西安电子科技大学机电工程学院,陕西西安 710071; 2.西安电子科技大学微电子学院,陕西西安 710071)
为了更好地研究GaN材料生长过程,笔者对一种垂直喷淋式金属有机物化学气相淀积系统生长GaN材料过程中反应物的传递和反应过程进行了模拟.模拟结果表明,反应室压力和进入反应室的气流速度对Ga N的生长速率和厚度均匀性均有影响.随着反应气体进入反应室的速度升高,反应室内预反应会增强,GaN生长速率升高,同时GaN厚度的不均匀性也会升高;在同样的进气速率下,反应室压强减小,可在一定范围内提高GaN生长速率,但同时增加衬底中央区域厚度,导致厚度不均匀增加.
GaN;金属有机物化学气相淀积;生长速率;反应动力学
Ga N是重要的宽带隙半导体材料,在光电器件、高功率器件等众多领域有着广泛的应用.金属有机物化学气相淀积(Metal Organic Chemical Vapor Deposition,MOCVD)方法是制备GaN材料的主要手段之一.为了提高GaN的材料质量,国内外很多学者针对MOCVD生长GaN材料的生长动力学过程做了大量研究.文献[1-2]使用fluent软件对垂直喷淋式MOCVD中生长GaN的气体流动、表面反应过程、衬底温度分布以及生长速率进行了模拟.文献[3-5]使用分子动力学方法、离散傅里叶变换(Discrete Fourier Transform,DFT)等方法在分子运动层面分析了GaN生长过程.文献[6-9]对GaN生长过程中的化学反应路径和反应过程进行了分析.目前,对于GaN生长过程的模拟主要分为宏观参数模拟和微观分子运动模拟两大类.宏观参数模拟主要用来模拟反应过程中反应物的气体流动、化学反应浓度分布等过程;微观分子运动模拟主要用来模拟分子在衬底表面的吸附、扩散、脱附等过程.笔者通过对垂直喷淋式MOCVD系统生长Ga N的生长过程进行模拟,分析对比不同的反应物流速以及不同的反应室压力对于Ga N生长化学反应过程和生长速率的影响.其主要目的是为优化GaN生长条件、提高GaN生长质量提供参考.
1 化学生长模型与反应室模型
Ga N生长过程中的实际化学反应过程非常复杂,目前很难通过实验确定其详细的化学反应过程及相关参数.总体上说,GaN生长涉及的化学反应过程可以分为加合反应和热解反应.两类反应的反应条件不同.在气相传输过程中由于环境温度相对较低,多发生加合反应.随着反应物接近衬底,温度逐渐升高,加合反应转变为热解反应.文中所涉及的MOCVD系统由于其反应室结构特点,在GaN材料生长过程中,反应气体在到达衬底之前会充分地进行混合,然后混合气体逐渐接近衬底,再通过化学反应生成Ga N材料.因此,在气相传输中和衬底表面均发生明显的化学反应.为了全面地分析GaN材料生长过程,笔者分别模拟了反应物在气相传输过程中和到达衬底后在衬底表面发生的化学反应,其中既有加合反应,也有热解反应.其化学模型如表1和表2所示.
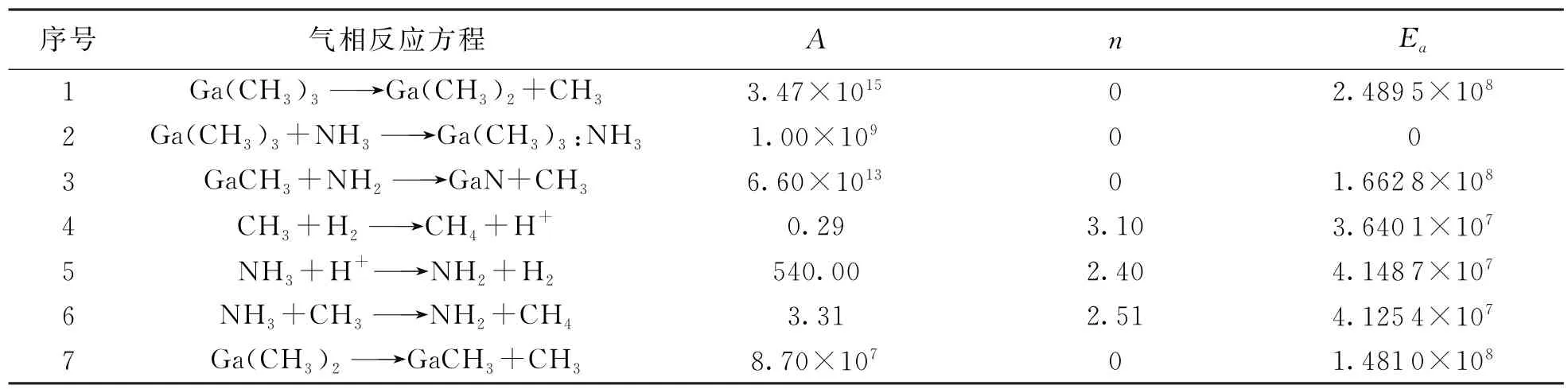
表1 GaN气相化学反应

表2 GaN表面化学反应
表1中每种化学反应的反应速率k均遵循Arrhenius公式:k=ATnex( p-Ea/(RT)).指前系数A的单位为cm3/(mol·s).n为温度指数.Ea为反应发生所需要的活化能,单位为J/(kg·mol),R为理想气体常数.
文中所涉及的MOCVD设备为西安电子科技大学自行研制的120型MOCVD.该反应室为垂直喷淋式,其模型如图1(a)所示.对应其内部结构,建立模拟所使用的模型如图1(b)所示.模型包括反应室进气口、侧壁、石墨上表面(衬底)以及石墨侧面的气流出口.

图1 120型MOCVD反应室结构图以及模型图
2 模拟结果及讨论
笔者在模拟中使用的主要反应条件包括:衬底温度为1 000℃,衬底旋转速度为60 r/m,V/Ⅲ为2 000,衬底半径为25 mm,气体入口半径为25 mm,入口至衬底高度为225 mm,反应气体为TMGa、NH3,载气为H2.
2.1入口气体流速对GaN生长速率及厚度均匀性的影响
在上述条件下,反应室压力为40torr(1torr≈133.322 Pa)时,模拟了不同的入口气体流速下,Ga N的生长过程.图2所示为入口气体流速分别为0.01 m/s,0.10 m/s,0.30 m/s,0.50 m/s,0.70 m/s,0.9 m/s时,Ga N沿衬底表面方向的生长速率分布.
根据图2的模拟结果,随着入口气体流速的升高,GaN生长速率因单位时间内反应物增加而升高,但是其生长速率并未与入口气体流速成比例的升高,同时在衬底表面的分布逐渐趋向不均匀.中心部位和边缘生长速率相对较低,而且速率增长缓慢,其余区域沿半径逐渐升高.为了分析原因,笔者对比了不同情况下的GaN表面反应过程.在衬底表面生成Ga N的化学反应过程主要为热解反应,热解反应的反应物主要是MMGa(单甲基镓GaCH3),根据化学反应模型,这是生成GaN材料最主要的物质.MMGa的浓度和分布直接决定了Ga N的生长速率以及厚度分布.不同气体进口速度所对应的MMGa在衬底表面的分布规律如图3所示.通过对比发现,MMGa只分布在衬底表面高温区域中,说明只有在这个高温区域内发生热解反应.同时,随着入口气体流速的升高,反应物MMGa的分布区域逐渐向边缘地带移动,从而引起生长速率分布的变化.
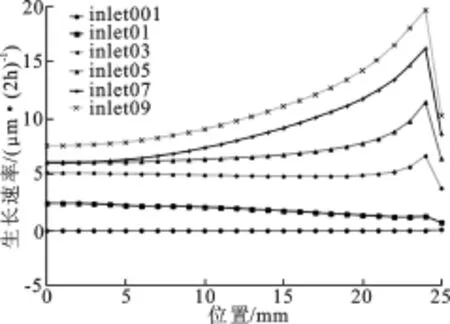
图2 GaN在不同入口速率下生长速率分布
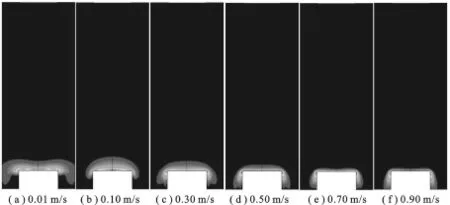
图3 不同入口气流速度下MMGa沿衬底表面的分布
此外,通过对图3的对比发现,在流速过低或者过高的情况下,进入反应室的反应物质所生成的MMGa都不能很好地分布在衬底表面,从而进一步生成Ga N.笔者对比了不同进口速度下,反应室内的流场分布,其结果如图4所示.
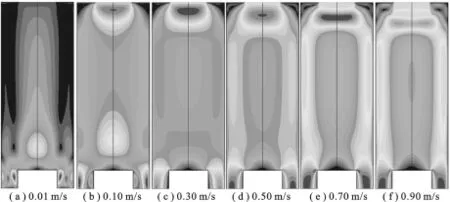
图4 不同入口气流速度下反应室内的流场速度分布图
通过图4的流场分布对比图发现,流速过低时,反应气体到达衬底表面的难度增加,大部分会在气体传输中发生预反应.流速较高时,根据流场分布图,反应物会更多地经过衬底边缘,同样使得到达中央区域的反应物质减少.因此,适当的气体入口速度不仅对于材料厚度的均匀性有影响,同时影响反应物的利用率.在Ga N生长中,应该合理调整入口气体速度,从而获得更好的GaN材料厚度均匀性,同时提高反应物的利用率.根据实际实验数据,文中针对的MOCVD系统采用进口气体速度在0.1~0.3 m/s之间,生长速率在2μm/h左右.同时,其表面厚度分布大致为中心厚度较小,沿半径方向厚度升高,边缘地带又有所降低.特征基本与模拟结果吻合.
2.2入口气体流速对预反应的影响
图5为不同的入口气体流速下,沿反应室高度方向反应物质TMGa∶NH3的分布情况.横轴代表反应室垂直方向中心线.通过模拟结果发现,反应气体进入到反应室后,在接近衬底并不断混合的过程中,逐渐生成TMGa∶NH3,该物质是主要的预反应生成物之一.模拟结果表明,随着气流速度的升高,反应产生的TMGa∶NH3增多,从而使得预反应增强,这一方面会降低原材料的利用率,另一方面也会影响材料的质量.从这个角度出发,也应该限制反应过程中的入口气体流速.
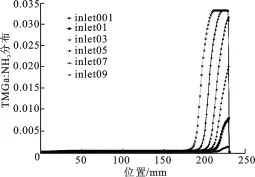
图5 不同入口气体速率下的TMGa∶NH3分布

图6 不同反应室压力下GaN生长速率
2.3反应室压力对GaN生长速率的影响
确定了反应室的进口气体流速后,笔者还通过改变反应室的压力来对比不同压力对反应过程的影响.在其他模拟条件不变的情况下,将入口流速设置为0.3 m/s.将反应室压力分别设置为10,20,40,60,80,单位为torr,对Ga N反应过程进行模拟.根据模拟结果得到不同反应室压力下Ga N生长速率沿衬底表面的分布曲线如图6所示.通过曲线可以看出,在不同压力下,生长速率的分布规律基本相同,均为沿半径先有增加的趋势,然后到边缘部分再降低.但是不同压力下也有所不同.在低压下,衬底中央区域的反应速率相对较高,这是由于在压力低的情况下,反应室内压力较低,反应物更容易抵达衬底表面中心区域.而在压力升高时,反应室内气体密度大,反应物到达衬底表面的区域逐渐外移.因此,适当地设置生长过程中反应室的压力,既有利于生长速率的提高,又有利于材料厚度的一致性.
3 结 论
笔者针对一种垂直喷淋式MOCVD系统建立了化学反应模型和仿真结构模型.模拟在不同反应条件下,Ga N生长时在传输过程中发生的气相化学反应过程和在衬底表面生成Ga N的表面反应过程.在此基础上,分别对不同的反应室进口气体流速和反应室压力进行了模拟仿真.模拟结果表明,反应室压力和进入反应室的气流速度对GaN的生长速率和厚度均匀性均有影响.随着反应气体进入反应室的速度升高,反应室内预反应会增强,GaN生长速率升高,同时Ga N厚度的不均匀性也会升高;在同样的进气速率下,反应室压强减小,可在一定范围内提高Ga N生长速率,但同时增加衬底中央区域厚度,导致厚度不均匀增加.模拟结果与实际实验得到的Ga N材料特征相符合,进一步验证了模拟的准确性,是优化Ga N生长条件、提高GaN生长质量的有效方法.
[1]TSENG C F,TSAI T Y,HUANG Y H,et al.Transport Phenomena and the Effects of Reactor Geometry for Epitaxial GaN Growth in a Vertical MOCVD Reactor[J].Journal of Crystal Growth,2015,432:54-63.
[2]ZHANG Z,FANG H S,YAN H,et al.Influencing Factors of GaN Growth Uniformity through Orthogonal Test Analysis[J].Applied Thermal Engineering,2015,91:53-61.
[3]ZHOU A,XIU X Q,ZHANG R,et al.Effect of Lattice Defects on the Property of GaN Crystal:a Molecular Dynamics Simulation Study[J].Superlattices and Microstructures,2015,88:679-684.
[4]KEMPISTY P,STRAK P,SAKOWSKI K,et al.DFT Study of Ammonia Desorption from the GaN(0001)Surface Covered with NH3/NH2 Mixture[J].Journal of Crystal Growth,2014,403:105-109.
[5]TOKOI H,OHTAKE A,TAGO K,et al.Development of GaN Growth Reaction Model Using Ab Initio Molecular Orbital Calculation and Computational Fluid Dynamics of Metalorganic Vapor-phase Epitaxy[J].Journal of the Electrochemical Society,2012,159(5):270-275.
[6]于海群.GaN沉积的化学反应动力学进展[J].材料导报,2012,26(17):21-24. YU Haiqun.The Progress of Chemical Reaction Kinetics with Ga N Deposition[J].Materials Review,2012,26(17): 21-24.
[7]王国斌,张永红,王怀兵.氮化镓生长反应模型与数值模拟研究[J].人工晶体学报,2010,139(增刊):160-163. WANG Guobin,ZHANG Yonghong,WANG Huaibing.Reaction Model and Numerical Simulation of Gallium Nitride Growth[J].Journal of Synthetic Crystal,2010,139(S1):160-163.
[8]PARIKH R P,ADOMAITIS R A.An Overview of Gallium Nitride Growth Chemistry and Its Effect on Reactor Design: Application to a Planetary Radial-flow CVD System[J].Journal of Crystal Growth,2006,286:259-278.
[9]FU K,FU Y,HAN P,et al.Kinetic Monte Carlo Study of Metal Organic Chemical Vapor Deposition Growth Dynamics of Ga N Thin Film at Microscopic Level[J].Journal of Applied Physics,2008,103(10):103524.
[10]许晟瑞,段涣涛,郝跃,等.(11-02)r面蓝宝石生成长(112-0)a面氮化镓研究[J].西安电子科技大学学报,2009,36 (6):1049-1052. XU Shengrui,DUAN Huantao,HAO Yue,et al.Study of(112-0)Non Polar a-plane Ga N on the(11-02)r-plane Sapphire[J].Journal of Xidian University,2009,36(6):1049-1052.
(编辑:李恩科)
Effect of growth parameters on GaN in a vertical MOCVD reactor
FENG Lansheng1,GUO Runqiu1,ZHANG Jincheng2
(1.School of Mechano-electronic Engineering,Xidian Univ.,Xi’an 710071,China; 2.School of Microelectronics,Xidian Univ.,Xi’an 710071,China)
A simulation of reactants in the transfer and reaction process during the GaN growth in a vertical MOCVD reactor is presented.The results show that the Ga N growth rate and thickness uniformity are all affected by the chamber pressure and the velocity of reactants into the chamber.With the increasing velocity of reactants into the chamber,pre-reaction will be enhanced,Ga N growth rate will be increased and thickness uniformity decreased.With the inlet velocity remaining the same and chamber pressure decreasing,the growth rate is improved within a certain scope,but the thickness uniformity may be increased at the same time with the thickness of the central region of the substrate increased.
GaN;MOCVD;GaN growth rate;reaction kinetics
TN204
A
1001-2400(2016)05-0178-05
10.3969/j.issn.1001-2400.2016.05.031
2016-01-22
国家自然科学基金资助项目(61334002);国家重大科技专项资助项目(2011ZX01002-001)
冯兰胜(1978-),讲师,西安电子科技大学博士研究生,E-mail:fenglansheng001@163.com.
