高压P-i-N二极管关断瞬态综合失效机理分析
2016-11-17罗皓泽李武华何湘宁
罗皓泽 李武华 何湘宁
高压P-i-N二极管关断瞬态综合失效机理分析
罗皓泽 李武华 何湘宁
(浙江大学电气工程学院 杭州 310027)
针对商用高电压大功率多芯片P-i-N二极管在钳位型电感负载电路中,在额定电气参数下发生的瞬态失效现象,分别从电路布局和器件机理层面讨论了各因素对二极管芯片失效的作用影响。首先,通过考察二极管模块内部失效芯片的位置和故障波形,得出整个电力电子装置的可靠性是由失效风险最高的局部芯片决定而非由功率模块的坚固性决定。其次,根据二极管芯片在深度动态雪崩情况下所产生丝状电流的现象,得出由芯片电流密度不均所引发的结温-电流密度正反馈机制是导致多芯片功率模块失效的最终原因。最后,根据失效表征与测试条件,提出了由综合失效诱因导致的多芯片模块动态失效新模式。结论表明本文讨论的大功率多芯片模块所发生的失效现象,是多失效诱因综合作用所引发的,而非单一因素超限的结果。
大功率电力电子器件 电流密度不均 瞬态热失控 雪崩击穿 综合失效机理
0 引言
以绝缘栅双极型晶体管(IGBT)为代表的全控型器件因其开关速度高、导通损耗低以及过电流能力强等优点被广泛应用于机车牵引、风力发电和柔性直流输电等高电压大功率电力变换应用场合[1,2]。据调研表明,工业应用中功率器件的失效率在失效元器件里面占有率最高,占总失效率的31%[3]。因此功率模块的可靠性也成为了制约电力电子装备安全运行的瓶颈之一。在现有的电力电子装备运行中,IGBT的性能发挥往往被其反并联续流二极管性能所限制。高压二极管(1 700V及以上)通常采用P-i-N结构,该结构与普通低压PN结二极管相比,在反向恢复时期,需要更多的时间来抽出或者复合其基区的过剩载流子[4,5]。所以P-i-N结构的高压二极管关断时间更长且反向恢复损耗更大。相应地,反向恢复电流不仅限制了IGBT的开关速度,还增加了IGBT的电流应力,并进一步增加IGBT的开关损耗,同时在杂散电感上感应的电压过冲还增加了功率器件的过电压失效风险。因此研究高压二极管在运行工况下的失效模式,对大功率电力电子装置可靠性的提升具有重要的作用。国内外学者在大功率器件失效分析的研究中,主要集中在IGBT等有源开关器件[6-8]。而针对高压大容量二极管的失效分析较少,且主要集中在以下三个方面:①专注于功率芯片物理层面的失效机理[9-11];②制造工艺环节的不良设计[12];③非典型工况下的极限测试[13]。
在众多的功率P-i-N二极管失效分析的文献讨论中,较少计及开关动态的失效分析,且大多缺乏失效瞬态过程的电气应力波形分析。而失效后的最终损坏结果又不利于探讨器件的真实失效原因。其次失效结果与失效原因之间的讨论缺乏系统性关联。本文以3 300V/800A高电压大功率P-i-N二极管在额定电压、额定电流以及最高结温限制的范围内,其关断瞬态发生的失效现象为研究对象,以失效瞬态的电气暂态波形为分析基础,将功率电路布局、多芯片功率模块的结构特点、P-i-N二极管技术特征、功率芯片高温特性、雪崩击穿的不良影响等重要因素纳入失效模式的分析中,通过对高压P-i-N二极管的失效表征与对应的失效模式进行讨论,提出了由综合因素作用触发功率芯片内部的结温正反馈机制,是导致高压P-i-N二极管可靠性降低,最终引发装置失效的主要原因。
1 测试条件及失效现象
1.1 大功率模块开关特性测试装置
高电压大功率模块的开关特性测试,是大功率变流器的设计基础。采用离线测试手段并辅以等效试验法,通过改变运行环境参数,驱动参数和线路参数,可以获得大功率模块在不同温度、寄生参数、电压和电流下的动态开关特性,进而模拟功率模块在典型应用工况及极限应力下的动态特征表现[14]。图1显示了带电感负载的两电平半桥拓扑测试电路及其测试方法时序图[15],待测器件为某款3 300V/ 800A高压IGBT模块(简称为“模块”)。由图1a可知,两只相同的模块安装在加热板上,其中模块1(S1和S2)作为开关器件,模块2中的反并联二极管(VD1和VD2)作为续流二极管。从模块的外部端子来看,每个模块可看成是两只功率器件并联运行,且共用一个驱动。测试方法采用双脉冲测试法[15]。图1b显示了双脉冲测试方法的时序图及关键波形。第一个脉冲为集电极电流c的建立过程。当模块1的c达到期望测试电流点时,关断模块1从而获得模块1的关断特性。随后负载电流L在负载电感及其换流二极管内续流。此后第二个脉冲再次开通待测模块1,此时可捕获模块1的开通特性及其换流二极管(VD1和VD2)的关断特性。

(a)大功率IGBT模块及开关特性测试电路
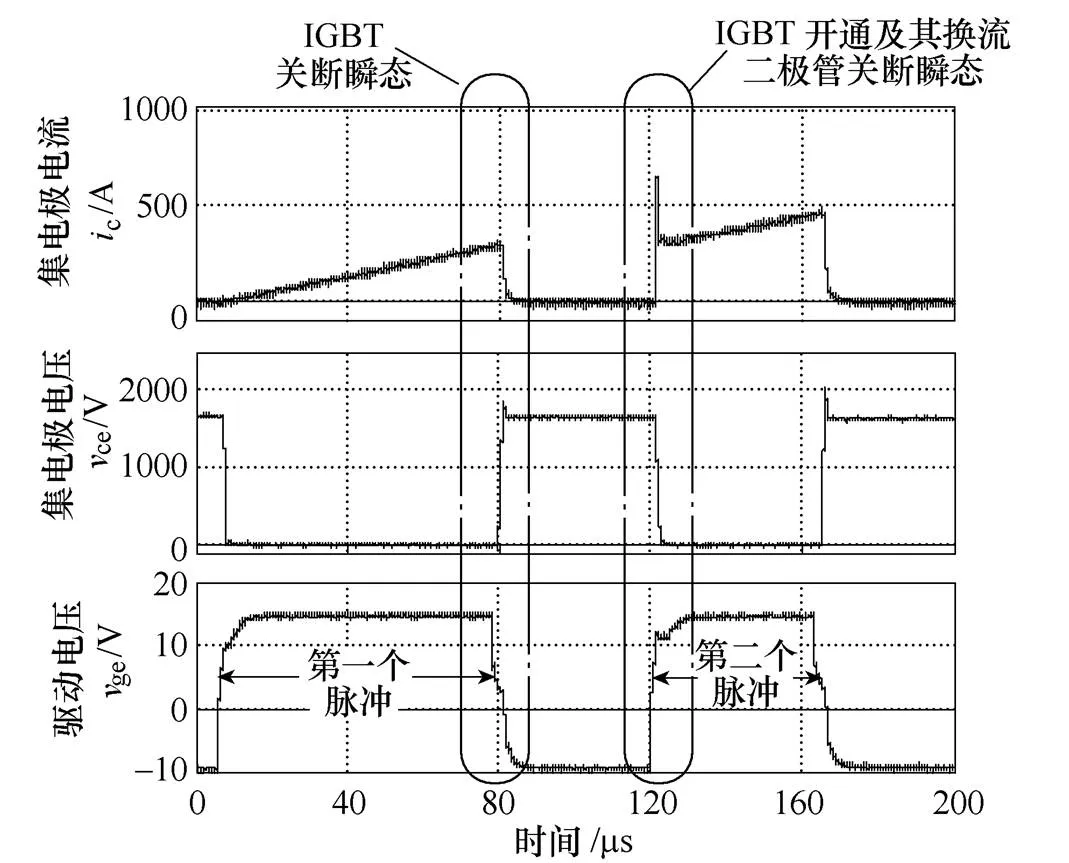
(b)双脉冲测试法测试时序及关键波形
图1 大功率IGBT模块动态特性测试平台及测试时序图
Fig.1 Diagrams of dynamic test platform with high power IGBT module and test sequence
1.2 多芯片大功率模块失效现象
图2显示了开关特性测试电路的布局结构及某额定测试条件下,失效芯片的位置。失效发生时刻为负载电流从模块2的续流二极管换流至下桥臂模块1的IGBT时刻。在待测模块内部,4只IGBT芯片与2只二极管芯片组成一个DBC衬底,4个DBC衬底共用一块基板。整个IGBT模块一共包含有16个IGBT芯片,8个二极管芯片,且二极管芯片依次排布在两组IGBT芯片的中间。图2还显示了模块内部失效芯片的具体位置,失效芯片的位置出现在靠近换流内层回路。作为IGBT的模块只损坏了一只IGBT芯片,其余芯片完好;作为续流二极管的模块,只损坏了1只二极管芯片,其余芯片完好。

图2 半桥测试电路母线排布局及模块失效芯片位置
图3显示了失效芯片的表征情况,待测的高压二极管芯片表面是阳极,阴极在芯片底部,无法直接观察。

(a)失效前完好芯片 (b)失效损坏芯片
图3 二极管芯片失效前后对比
Fig.3 Comparison of undamaged chip and failure chip
本文仅分析高压P-i-N二极管的关断失效机制。根据二极管芯片失效位置以及失效前后征状对比,失效的外在表征如下:①靠近母线换流回路内层的二极管损坏;②约一半面积的芯片受损,绑定线炸断,巨大能量从芯片底部的阴极释放出来;③位于芯片底部的边缘(即终端处)损坏情况最严重,破损口很深,且处于阴极部位。下面逐步分析讨论上述三方面失效现象的原因。
2 失效瞬态电气参数分析
2.1 开通瞬态失效波形分析
图4显示了动态测试平台捕获的大功率模块1中IGBT在开通时刻的瞬态失效波形。失效发生时刻的测试条件如下:功率模块的芯片结温为75℃,dc=2 000V,L=600A。图4中ce为下管IGBT的集电极-发射极的电压波形,c为流过同轴电阻上的电流波形,VD为二极管的电压波形。根据图4失效波形,将分为以下8个阶段进行分析。

图4 大功率IGBT模块1开通失效波形
阶段1(0~1):0时刻下管IGBT处于关断状态,并承受2 000V母线电压;续流二极管流经全部负载电流L,此时二极管压降为通态压降。
阶段2(1~2):当门极电压达到阈值电压时,下管IGBT开始导通。同时集电极电压ce开始下降,续流二极管电流VD也开始下降,电流下降速度近似常数dVDd=dc/s,其中s为换流回路杂散电感总和。相应地c也以同一速率上升,且dcd在s上会使ce电压产生一个瞬态下跌。当c上升至负载电流时,二极管开始进入反向恢复过程,反向恢复电流是由基区中等离子区的抽取来维持的。当P+n-结附近的等离子区消失时,耗尽层开始形成;此时二极管开始承受反压。当等离子区缩减到某一程度时,剩余的载流子浓度不足以维持以之前速度增长的反向电流,随即通过调整减小dVDd来实现剩余载流子浓度与电流变化率的平衡。当二极管电流变化率dVDd=0时,反向恢复电流rr达到峰值700A,此时有

在2时刻二极管的反向恢复电流达到峰值rr后,开始减小。
阶段3(2~3):当等离子区中剩余载流子的浓度不能继续维持反向电流时,随即反向恢复电流开始下降,此时的下降速率dVDd由二极管本身的特性决定。且其在杂散电感上感应的电压将在3时刻使得d达到最大值。
阶段4(3~4):反向恢复电流继续下降,其下降速率要低于阶段3。因而可推断在阶段3的末尾,P+n-结附近发生了轻微动态雪崩。雪崩产生的电子和空穴对在电场的作用下分别向阴极和阳极漂移,产生相应的电子电流和空穴电流来减缓了反向恢复电流的下降速度。即此阶段内存在额外部分的电流来抑制反向恢复电流的下降。较低的dVDd使杂散电感上的电压过冲降低,VD电压开始下降。
阶段5(4~5):VD进一步向阻断电压恢复。由雪崩效应产生的电子电流和空穴电流抑制了反向恢复电流的迅速减小,形成一个电流拖尾现象。此外雪崩产生的空穴漂向P+n-结,提高了P+n-结附近空间电荷区的电场强度,从而使反向VD电压升高。
阶段6(5~6):从5时刻开始,二极管电压从1 800V开始骤跌,由于电路中杂散电感与下管IGBT的影响,c没有开始突变。当二极管电压降至600V左右时,c开始飙升。此时IGBT还处于有源区,可以承受一定的短路电流,因此在这一阶段IGBT的压降没有显著变化。
阶段7(6~7):从6时刻开始,c从800A飙升至2 000A,并在7时刻后超出示波器量程。此刻二极管反向电流VD也直线上升,c=VD+L。而其电压VD与IGBT的端电压ce保持不变,这一阶段持续约200ns。可以推断出IGBT还未进入饱和区,仍旧在放大区,并且c还未升至IGBT的短路电流极限值。由于二极管电压探头两端之间不仅包含二极管芯片,还含有模块内部的杂散电感sd。因而该阶段中VD并不是二极管芯片的实际压降。假设二极管芯片电压为dp,则有

因此,在本阶段内失效芯片的实际电压dp远远小于测试结果。
阶段8(7~8):图5所示为第8阶段二极管电压测试图。在7时刻,短路电流超出示波器量程。IGBT在承受极限短路电流的情况下,开始由放大区进入到饱和区,其特征是c电压开始逐渐升高。其次反向雪崩电流上升率逐渐减小,其在杂散电感上感应电压也逐渐减小。可以推断在8时刻,短路电流变化率为零,母线电压dc=ce+VD。二极管电
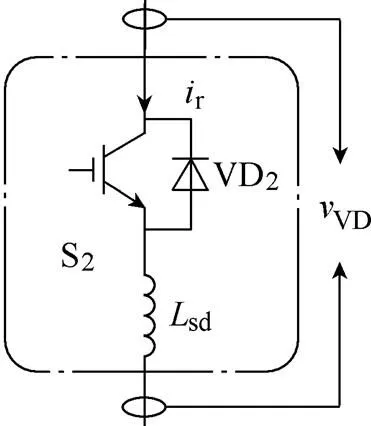
图5 第8阶段二极管电压测试图
压仍旧维持约200V水平,此时IGBT并没有损坏迹象。图6显示了失效瞬态时,二极管故障功耗波形rVD,故障电压波形VD,故障电流波形c和正常电流波形ca。其中,a时刻为二极管峰值功率出现时刻,为2 200kW,P-i-N二极管芯片的峰值功率密度约为260kW/cm2,b时刻为二极管失效时刻。根据失效波形,可得初步的结果分析:

图6 集电极电流ic失效前后的对比情况和二极管耗散功率
(1)反并联二极管首先损坏,二极管的失效现象首先是阻断电压先骤跌,失去反向阻断能力,随即反向电流开始飙升。
(2)下管IGBT在开通瞬态还未出现失效。从二极管失效到IGBT开始进入饱和区大概有约300ns时间,进入饱和区标志是IGBT的端电压开始上升。
(3)在二极管失效时刻,并不是承受峰值功率的时刻,而是在反向恢复末尾阶段。其次二极管所承受的峰值电压与峰值电流并未超出额定限制值,且还有很足的裕量。
上述失效波形的测量,均是对功率模块外部端子的测试。其获得的电气参数是模块内部多支功率芯片并联运行的总结果。虽然模块总体上没有直接表现出过电压和过电流现象,但是对于多芯片大功率模块而言,内部的芯片可能出现功率分配不均,从而导致模块失效情况发生[16]。
3 电路级失效诱因分析
图7显示了半桥拓扑二极管关断换流时刻的等效电路。dc为母线电容组,p1与p2为正母线杂散电感;n1与n2为负母线杂散电感;h1、h2、s1与s2为IGBT模块内部芯片与外部功率端子连接的寄生电感总和;com为母线公共电感。


图7 含杂散电感的多芯片IGBT模块开通换流等效电路
当下管IGBT模块开通时,负载电流从二极管VD1和VD2换至开关管S1和S2。在整个换流过程中,由基尔霍夫定律可知



将式(4)~式(6)联立可得

假设环路电感h2+p2+s2+n2>h1+s2,且假设二极管VD1与VD2反向恢复特性一致,开关管S1与S2开通特性一致,则有

可知在IGBT模块1开通的换流过程中,由于换流回路中的杂散电感总和不一致,导致了换流回路1和回路2的dcd不一致,即动态电流分配不均匀。即使在开通换流过程结束后,支路电流c1=c2,由于动态电流分配不均,开关管S1与S2在开通时刻的峰值功率将有所不同。承受较高峰值功率的芯片将存在较高的失效风险。此外,假设换流回路完全对称时,即h2+p2+s2+n2=h1+s2时,可得

式(5)可以改写为
假设存在个开关管并联运行且同时动作时,其支路1的二极管瞬态电压表达式为

由式(11)可知,由于公共电感com的存在,即便是各支路上芯片换流速度一致,额定分配的dcd仍旧会在杂散电感上产生过电压施加在内部芯片[17],其实际的运行功率将大于其额定分配功率。综上分析可得模块内部多芯片存在动态功率分配不均的原因为:其一是换流回路的不对称和功率器件换流速度不一致性,将致使芯片之间的动态功率分配不均。其二是公共电感过大,导致多芯片模块中部分芯片的动态功率超出其自身额定分配功率。
图8显示了测试点为1 600V/400A/125℃时,图7中二极管VD1和VD2在反向恢复时期的功率分配不均的情况。不对称的换流回路导致了瞬态功率分配不均的现象。然而换流回路不均是电路级失效因素的表征,只能确定失效风险最高的芯片区域位置,功率器件的失效机理还仍需从芯片级的角度分析。

图8 换流二极管动态功率分配不均图
4 芯片级失效诱因分析
根据上述电路级分析以及失效表征对比,P-i-N二极管并未直接因过电压或过电流等因素而失效。根据图4与图6波形,二极管未在峰值功耗附近发生失效,进而初步排除瞬态过热失效。结合失效前后对比发现,图3中二极管的阴极与边缘处的损坏情况最为严重。因此本实例根据多芯片大功率模块的特点,从并联芯片瞬态的动态电流密度不均的角度出发,重新讨论动态雪崩击穿失效机理。
研究表明当硅基功率二极管的功率密度达到250kW/cm2时,即可触发硅基功率器件的动态雪崩击穿[18]。根据图6显示的峰值功率,可以进一步推断二极管芯片在第三阶段内可能就已发生了动态雪崩。由于功率器件在经历动态雪崩期间,基区剩余载流子的运动情况非常复杂,文献[19]依据空间电荷区的电离程度不一,将动态雪崩现象细划分成三种层次。在第一层次的雪崩击穿情况下,空间电荷区电离出的电子电荷向N+极移动的过程中,会复合一部分空穴,进而削弱峰值场强,抑制雪崩过程的扩大。随着反向电流密度的增大,二极管发生第二层次的雪崩击穿。其特点是碰撞电离发生在P+n-区域,且伴随负微分电阻效应。负微分电阻区的特征容易诱发芯片局部电流集中,即:“丝状电流(filament current)”的出现。然而有两个重要的因素会限制负微分电阻效应导致灾难性后果,其一碰撞电离率具有负温度系数;其二是大电流密度下形成的丝状电流会不断的移动,难以在某一固定位置持续发热[20]。因此,第一和第二层次的雪崩击穿是一个自限制过程,且失效风险最高的区域在二极管的阳极附近。当发生第三层次的雪崩击穿时,其形成原理如图9所示[21]。图9中,半岛体的物理参数用和表示。表示空穴,表示电子。在反向恢复阶段开始后,空间电荷区首先会在P+n-结处形成,等离子层内剩余的空穴将穿越已经形成的空间电荷区到达阳极。雪崩击穿首先发生在二极管的阳极附近,碰撞电离出的多余电荷av与av分别向阳极与阴极方向移动。此时阳极附近耗尽层内的有效正电荷密度eff将由掺杂浓度和穿越的载流子浓度共同决定,即

式中,D为基区掺杂浓度;h为空穴浓度,其计算
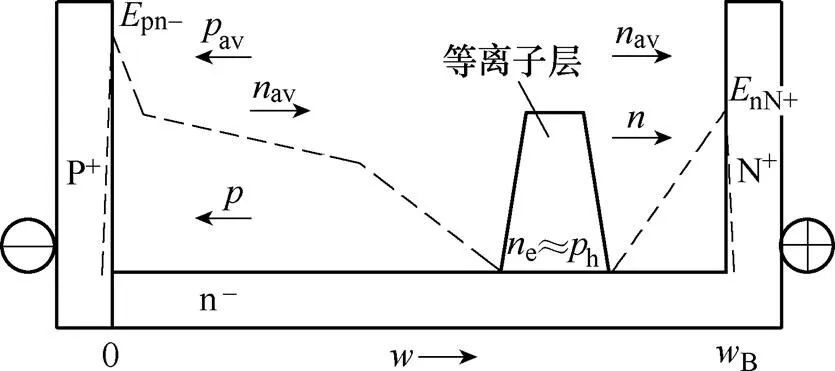
图9 简化的双边动态雪崩示意图
式为

式中,p为空穴电流密度;sat为空穴饱和迁移率;为电子常数。当电离出的电子av与等离子体抽出的电子e大于n-N+结附近耗尽层的掺杂浓度时,这个区域的电场分布为

当阴极附近的电场强度过高时,将会引发阴极侧的雪崩击穿现象。那么雪崩击穿现象同时出现在P+n-结以及n-N+结处。n-N+结处碰撞电离产生的空穴在向阳极移动的过程中,又会增加P+n-结的该处的动态雪崩。第三层次的动态雪崩会在阳极和阴极出同时出现丝状电流。由于阳极丝状电流会不断的移动来避免热聚集效应;而阴极产生的丝状电流位置基本固定不变,仅能通过碰撞电离率的负温度系数效应缓慢的移动。因此,阴极处n-N+结发生动态雪崩现象极易形成固定位置的丝状电流,局部芯片温度在短时间内急剧上升,从而引发热击穿失效机理。由上述三种动态雪崩的分析可知,避免二极管由轻度动态雪崩恶化至第三层次的双边动态雪崩是保护P-i-N二极管的关键。以硅基P-i-N高压二极管为例,其动态雪崩击穿电压cirt表达式为[22]

在式(15)中,反向电流密度是平均值概念,然而多芯片大功率模块内部的部分芯片,在动态换流过程中,其瞬态电流密度是会超过平均电流密度的。又因为载流子饱和速率sat都受结温影响,且随温度的升高而下降[23]。因此,图4中二极管反向恢复期间内仅承受1 800V电压时就出现因动态雪崩而引发阴极侧的失效现象。可以得出本例失效机理是典型的局部芯片由于动态雪崩击穿引发的“丝状电流”现象,其表现为热正反馈击穿的失效机制,最终导致整只大功率模块失效。
5 综合失效机理模式分析
通过对上述二极管动态失效机理的分析,并结合本例中二极管芯片的最终失效表现。从而提出了一种P-i-N二极管的综合失效模式,图10显示了该综合失效因素的关系图。方框内表示电路级的外部因素,圆框内表示芯片级的失效诱因。由于大功率多芯片模块与功率回路的不对称,导致了靠近功率回路的芯片承担最高的失效风险。这一现象可以确定图2中部分受损芯片的位置情况。

图10 本实例二极管综合失效模式
随着测试电压与电流的增加,二极管在反向恢复过程中的平均峰值功率也逐步逼近雪崩击穿阈值。根据受损芯片在阴极和边缘处损坏最严重的现象,可以推断出n-N+结发生严重的动态雪崩。n-N+结发生第三层动态雪崩的特征是在阴极处形成位置基本不动的丝状电流。丝状电流造成局部芯片的温度骤升,当结温超过硅基芯片的本征温度时,由雪崩维持的丝状电流进而转为由器件的热激发维持。随后进一步增加了电流丝的密度以及芯片的温度,如此形成电流密度不断增加导致局部温升不断增加的正反馈机制。根据图4中阶段5的分析,二极管发生了严重的动态雪崩,芯片局部过热严重,导致热击穿失效。由于阴极部位芯片温度要高于其余部位芯片,首先发生失效后导致能量在阴极部位聚集,热失控现象出现后,母线能量倾泻至失效支路,二极管芯片严重损坏。图11显示了考虑不同电流密度、与结温对空穴饱和迁移率等影响因素,根据式(15)得到的雪崩击穿电压关系示意图。由图11可知,随着反向电流密度与芯片结温的增加,雪崩击穿阈值电压都会下降,然而反向电流密度对阈值

图11 雪崩击穿电压与j和Tj的关系示意图
电压的下降影响要高于芯片结温。
综上分析,本文P-i-N二极管的失效触发机制来源于峰值功率。过高的峰值功率提供触发了雪崩击穿所必要的热积累,并增加了过电压击穿失效的危害。当二极管发生严重的动态雪崩时,高电流密度的“丝状电流”效应触发了器件内部的“电流密度-温度正反馈”机制,从而导致了部分芯片发生热击穿的失效模式。通过对本失效实例的综合失效模式分析图可知,P-i-N二极管模块的坚固性可从以下四方面来提高。
(1)完善结构布局和优化驱动参数配置,确保模块内部芯片的动态功率分配尽量均匀。
(2)优化大功率器件模块内部的杂散电感分布,从而降低模块内部芯片的关断电压应力,缓解动态功率分配不均。
(3)采用提高n-N+结雪崩击穿耐量的新型高压二极管,如CIHB结构高压二极管[21]。
(4)增加散热设计裕量,并同时对模块内部二极管芯片的平均运行结温进行在线检测与控制[24]。
6 结论
本文以商用高压P-i-N二极管在额定参数下发生的失效实例为研究对象,从瞬态失效波形和芯片失效表征入手,对电路级影响因素和半导体物理机理进行了分析和讨论。在大功率模块的失效分析中,提出了由综合失效诱因所导致的多芯片模块失效新模式。该综合失效模式有助于分析大功率多芯片模块的动态失效机制。同时得出了电力电子装置的可靠性并非由单一功率模块的坚固性决定,而是由失效风险最高芯片的坚固性而决定的结论。论文最后总结了提高大功率多芯片P-i-N二极管模块坚固性的措施和方法。
参考文献:
[1] 蒋冠前, 李志勇, 杨慧霞, 等. 柔性直流输电系统拓扑结构研究综述[J]. 电力系统保护与控制, 2015, 43(15): 145-153.
Jiang Guanqian, Li Zhiyong, Yang Huixia, et al. Research review on topological structure of flexible HVDC system[J]. Power System Protection and Control, 2015, 43(15): 145-153.
[2] 汪璐, 邵如平, 王雅璐. 基于海上大型风电场VSC-HVDC系统电网侧控制器的设计[J]. 电力系统保护与控制, 2015, 43(17): 107-112.
Wang Lu, Shao Ruping, Wang Yalu. Grid side controller design of VSC-HVDC system based on large offshore wind farm[J]. Power System Protection and Control, 2015, 43(17): 107-112.
[3] Yang S, Bryant A, Mawby P, et al. An industry-based survey of reliability in power electronic converters[J]. IEEE Transactions on Industry Applications, 2011, 47(3): 1441-1451.
[4] 方春恩, 李威, 李先敏, 等. PIN型功率二极管动态特性物理模型参数提取[J]. 电工技术学报, 2015, 30(6): 208-215.
Fang Chunen, Li Wei, Li Xianmin, et al. PIN power diode dynamic behavior and physics-based model parameter extraction method[J]. Transactions of China Electrotechnical Society, 2015, 30(6): 208-215.
[5] 陈思哲, 盛况. 4700V碳化硅PiN整流二极管[J]. 电工技术学报, 2015, 30(22): 57-61.
Chen Sizhe, Sheng Kuang. 4700V SiC PiN rectifier[J]. Transactions of China Electrotechnical Society, 2015, 30(22): 57-61.
[6] 沈刚, 周雒维, 杜雄, 等. 基于小波奇异熵理论的IGBT模块键合线脱落故障特征分析[J]. 电工技术学报, 2013, 28(6): 165-171.
Shen Gang, Zhou Luowei, Du Xiong, et al. Characteristics analysis of IGBT module with bond wire lift-off based on wavelet singular entropy theory[J]. Transactions of China Electrotechnical Society, 2013, 28(6): 165-171.
[7] 陈民铀, 高兵, 杨帆, 等. 基于电-热-机械应力多物理场的IGBT 焊料层健康状态研究[J]. 电工技术学报, 2015, 30(20): 252-260.
Chen Minyou, Gao Bing, Yang Fan, et al. Healthy evaluation on IGBT solder based on electro- thermal-mechanical analysis[J]. Transactions of China Electrotechnical Society, 2015, 30(20): 252- 260.
[8] 李学生, 张新闻, 常玉峰, 等. 基于半导体功率损耗的小型风电变换器可靠性研究[J]. 电力系统保护与控制, 2015, 43(19): 15-21.
Li Xuesheng, Zhang Xinwen, Chang Yufeng, et al. Small wind power converter reliability research based on semiconductor power loss[J]. Power System Protection and Control, 2015, 43(19): 15-21.
[9] Huang A Q, Temple V, Liu Y, et al. Analysis of the turn-off failure mechanism of silicon power diode[J]. Solid-State Electron, 2003, 47(4): 727-739.
[10] Rahimo M T, Shammas N Y A. Freewheeling diode reverse-recovery failure modes in IGBT appli- cations[J]. IEEE Transactions on Industry Appli- cations, 2001, 37(2): 661-670.
[11] Wu R, Blaabjer F G, Wang H, et al. Overview of catastrophic failures of freewheeling diodes in power electronic circuits[J]. Microelectronics Reliability, 2013, 53(9-11): 1788-1792.
[12] Perpina X, Cortés I, Urresti-Ibanez J, et al. Edge termination impact on clamped inductive turn-off failure in high-voltage IGBTs under overcurrent conditions[C]//23rd IEEE International Symposium on Power Semiconductor Devices and ICs, San Diego, CA, 2011: 112-115.
[13] 孟庆云, 马伟明, 孙驰, 等. 考虑二极管非理想特性的中点钳位三电平电路的分析[J]. 电工技术学报, 2010, 25(6): 40-46.
Meng Qingyun, Ma Weiming, Sun Chi, et al. The NPC three-level circuit considering nonideal characteristic of diode[J]. Transactions of China Electrotechnical Society, 2010, 25(6): 40-46.
[14] 贺之渊, 汤广福, 李宁, 等. 大功率电力电子装置试验方法论[J]. 电工技术学报, 2007, 22(1): 67-73.
He Zhiyuan, Tang Guangfu, Li Ning, et al. Study of high power electronic equipment test methodology[J]. Transactions of China Electrotechnical Society, 2007, 22(1): 67-73.
[15] 陈娜. 中高压功率IGBT模块开关特性测试及建模[D]. 杭州: 浙江大学, 2011.
[16] Hermann R, Bernet S, Suh Y, et al. Parallel connection of integrated gate commutated thyristors (IGCTs) and diodes[J]. IEEE Transactions on Power Electronics, 2009, 24(9): 2159-2170.
[17] Bakran M M, Eckel H G, Helsper M, et al. Next generation of IGBT-modules applied to high power traction[C]//European Conference on Power Elec- tronics and Applications, Aalborg, 2007: 1-9.
[18] Domeij M, Lutz J, Silber D. On the destruction limit of Si power diodes during reverse recovery with dynamic avalanche[J]. IEEE Transactions on Electron Devices, 2003, 50(2): 486-493.
[19] Josef Lutz, Schloangenotto Heimrich, Scheuerrmann Uwe, et al. Semiconductor power devices: physics, characteristics, reliability[M]. Berlin: Springer, 2011.
[20] Baburske R, Niedernostheide F, Lutz J, et al. Cathode-side current filaments in high-voltage power diodes beyond the SOA limit[J]. IEEE Transactions on Electron Devices, 2013, 60(7): 2308-2317.
[21] Lutz J, Baburske R, Chen M, et al. The nn-junction as the key to improved ruggedness and soft recovery of power diodes[J]. IEEE Transactions on Electron Devices, 2009, 56(11): 2825-2832.
[22] Stefan Linder. 功率半导体器件与应用[M]. 肖曦, 李虹, 等译. 北京: 机械工业出版社, 2009.
[23] Palmer P R, Santi E, Hudgins J L, et al. Circuit simulator models for the diode and IGBT with full temperature dependent features[J]. IEEE Transa- ctions on Power Electronics, 2003, 18(5): 1220-1229.
[24] Luo H, Li W, He X. Online high-power P-i-N diode chip temperature extraction and prediction method with maximum recovery current d/d[J]. IEEE Transactions on Power Electronics, 2015, 30(5): 2395-2404.
Comprehensive Failure Mechanisms in High Voltage P-i-N Diode During Turn-off Transient
(School of Electrical Engineering Zhejiang University Hangzhou 310027 China)
In this paper, the turn-off transient failure of commercial high voltage multi-chip P-i-N diode under the rated parameters in clamped circuit is discussed from the circuit layout aspect and semiconductor mechanism aspect. Firstly, through the failure chips and failure waveforms, it is proved that the riskiest chip instead of the modules determines the reliability of power converter system. Besides, according to the filament current phenomenon of P-i-N diode under the deepest dynamic avalanche, the impact of local over temperature induced by the unbalanced current distribution is discussed. It is concluded that the failure mechanism of P-i-N is the positive feedback of thermoelectric coupling mechanism. Finally, based on the failure results and test conditions, the comprehensive failure mechanisms of power device are proposed. It is shown that the failure mechanisms are not induced by one single factor but the combined effects of all related factors.
High power modules, non-uniform current distribution, transient hot runaway, avalanche, comprehensive failure mechanism
TN312+.4
罗皓泽 男,1986年生,博士,研究方向为电力电子器件可靠性。
E-mail: luohaoze@163.com(通信作者)
李武华 男,1979年生,博士,教授,研究方向为电力电子变流技术与可再生能源接入。
E-mail: woohualee@zju.edu.cn
2015-09-19 改稿日期 2015-12-21
国家重点基础研究发展计划(973计划)资助项目(2014CB247400)。
