SiC MOSFET体二极管反向恢复特性研究
2016-11-12彭咏龙李亚斌
史 孟,彭咏龙,李亚斌,江 涛
(华北电力大学 电气与电子工程学院,河北保定071003)
SiC MOSFET体二极管反向恢复特性研究
史 孟,彭咏龙,李亚斌,江 涛
(华北电力大学 电气与电子工程学院,河北保定071003)
详细分析了新型功率器件SiC MOSFET的结构特点及其寄生体二极管的反向恢复机理,推导了反向恢复过程的电压与电流计算;同时,搭建了双脉冲实验测试平台,通过实验和仿真的方法,测试了不同关断电压、正向导通电流和串联寄生电感这些最常见的外部因素对SiC MOSFET寄生体二极管反向恢复特性的影响;此外,对比测试了同电压等级的SiC MOSFET、Si MOSFET寄生体二极管和快恢复二极管的反向恢复性能。相关结果表明SiC MOSFET寄生体二极管可以作为变换器中的续流通道而不必额外再单独反并联快恢复二极管,对实际工程应用有一定的借鉴意义。
碳化硅MOSFET;体二极管;反向恢复
0 引 言
近年来,碳化硅(Silicon carbride,SiC)宽禁带半导体器件因其高击穿场强、高饱和漂移速度和高热导率等优点,可提高电力电子变换器的性能,成为了国内外研究学者争相关注的对象。SiC MOSFET因其比导通电阻低、工作频率高和高温条件下工作稳定等优点,已被广泛应用于高压、高频、高效的变换器中[1]。
在软开关变换器中,MOSFET内部寄生体二极管在零电压开关(ZVS)模式下实现续流,几乎没有反向恢复电流产生[2,3]。但是,在一些硬开关变换器中,如半桥、全桥和LLC的电源系统,续流二极管需要在非零电压开关(Non-ZVS)模式下完成续流,传统Si MOSFET内部寄生的体二极管因反向恢复特性较差,在这一过程会产生相当大的电流尖峰和关断浪涌电压,严重时会损坏半导体器件[4]。因此,工程上通常采用在MOSFET漏极串联二极管来阻止寄生体二极管导通,然后在漏源极两端额外反并联快恢复二极管来提供新的续流通路[5,6]。显然,这种方极大地增加了电路设计的复杂性和成本费用。如果新兴的SiC MOSFET的寄生体二极管能够表现出优良的反向恢复特性,那么这一弊端问题将得以解决。
然而,目前没有几篇文献对SiC MOSFET寄生体二极管的动态特性进行研究。文献[6]比较了SiC MOSFET和Si MOSFET寄生体二极管的性能,但是该文侧重于分析二者在正向导通性能上的差异,仅比较了不同正向导通电流条件下的反向恢复特性差异。文献[7]提到影响SiC MOSFET寄生二极管反向恢复特性的因素可分为器件内部参数和外部运行条件两类,外部因素除了正向导通电流外还包括关断电压、换流斜率(di/dt)和结温。文献[8]探究了SiC MOSFET寄生体二极管在不同温度下的相关特性,并探讨了相关的功率损耗和可靠性问题。因此,SiC MOSFET寄生体二极管的反向恢复性能如何,能否替代反并联快恢复二极管直接作为续流通道,仍没有得到系统的评估。
本文在此基础上,首先详细分析了SiC MOSFET的结构特点及寄生体二极管的反向恢复机理,然后通过双脉冲实验平台和仿真分析,研究了不同正向导通电流和串联寄生电感对SiC MOSFET寄生体二极管反向恢复性能的影响;此外,还进一步对比测试了同电压等级的SiC MOSFET、Si MOSFET寄生体二极管和快恢复二极管的反向恢复性能。
1 SiC MOSFET的结构及反向恢复机理
图1为SiC MOSFET的结构单元截面图,其主要由栅极(G)、漏极(D)、源极(S)和N沟道组成,垂直结构。由图1所示的结构可以看到,P基区和N+层形成了一个PN结,即SiC MOSFET的寄生体二极管[8]。
当寄生体二极管外加正向电压VF时,PN结的内电场被削弱,漂移和扩散的动态平衡遭到破坏,扩散运动强于漂移运动,如图1中箭头所示,P区的多子(空穴)流向N区,N区的多子(电子)流向P区,进入N区的空穴和进入P区的电子就会成为该区的少子。这些多出来的少子依靠积累时浓度差在P区和N区之间进行扩散,被称为非平衡少子。在扩散过程中,空穴同N区中的多子电子发生复合,与PN结边界相距越远,发生复合的空穴也就越多。正向导通时非平衡少子积累的这一现象通常被叫做电荷存储效应。

图1 SiC MOSFET内部结构图
此时,若在寄生体二极管外突然加反向电压,PN结内漂移运动就会强于扩散运动,上述P区存储的电子和N区存储的空穴并不会立刻消失,而是通过以下两种途径逐渐减少:(1)与多数载流子发生复合;(2)在反向电场的作用下,P区存储的电子逐步回到N区,N区存储的空穴逐步回到P区,由此产生反向漂移电流。
整个反向恢复过程可以细分为4个阶段,如图2所示[8]。

图2 体二极管反向恢复特性曲线
(1)t0~t1阶段。体二极管仍处于续流阶段,PN结处于正向偏置,结电阻很小,势垒区很窄,流过体二极管的正向电流开始以一固定的di/dt减小,di/dt的大小由外电路参数决定。
(2)t1~t2阶段。在反向电压的作用下,体二极管之前存储的电荷开始扫出,由于P N结处耗尽层尚未形成,扫出的过量电荷继续维持着反向电流;电流开始以di/dt的速率反向增大,体二极管尚未承受反向电压。
(3)t2~t3阶段。PN结处等离子浓度已经衰减为0,形成耗尽层,体二极管开始承受反向电压。由于反向电压急剧增大,反向恢复电流反向增大的速度di/dt开始逐渐减小;在t3时刻,反向电压达到VDC,反向恢复电流的di/dt降为0,恢复电流达到反向最大值,即IRM。
(4)t3~t4阶段。扩散到耗尽层的载流子开始继续维持反向电流,因为等离子一直在耗散,导致空间电荷区边缘的过量电荷浓度梯度在逐渐降低,所以反向电流自t3后以负di/dt的速率逐渐减小;同时,体二极管所承受的反向电压也将继续增长,并在反向电流降为0的时候达到峰值VPM。t4之后,电路进入RLC自由振荡阶段,电流和电压振荡衰减至稳定值(图2中有省略)。
2 实验原理及分析
2.1 双脉冲实验平台介绍
双脉冲实验平台虽然设计简单,却能准确获取MOSFE在开关过程中的主要参数,包括寄生体二极管的反向恢复性能[10]。电路原理图如图3所示,在上端MOSFET(M1)的栅极加上5 V的负压,以保证其关断,只有寄生体二极管起续流作用;在下端MOSFET(M2)的栅极加上双脉冲信号,以此来控制M1体二极管的续流。
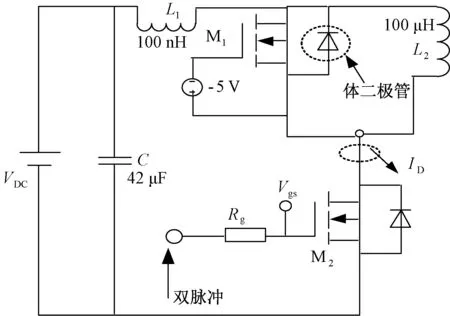
图3 双脉冲实验原理图
因为不能直接测得体二极管的反向恢复电流波形,所以采用在M2的漏极处测量电流ID的替代方法,相关波形如图4所示。

图4 测试点电流波形

2.2 反向恢复过程的电压与电流计算
根据第1小节中分析,整个反向恢复过程分为4个阶段。
在t0~t1,t1~t2两个阶段,体二极管从正向导通电流ID开始以一恒定的di/dt下降,因为M1体二极管的反向导通电阻很小,忽略不计,由回路KVL方程可得[8]:
(1)
由式(1)可知,该di/dt主要由电路外部参数决定,分别是电动势VDC,下端M2的漏源间电压Vds,和回路寄生电感L1,又因为M2开通速度很快,Vds的影响很微弱。
t2~t3阶段,反向恢复电流继续反向增大至IRM,速率di/dt与之前相比有所减小,且主要由器件本身特性所决定,而不取决于外围电路参数。
t3~t4阶段,体二极管进入反向阻断状态,反向恢复电流开始减小,与之相并联的寄生电容Cds开始被充电,且与串联寄生电感L1发生谐振,相关方程组如下[10]:
(2)
(3)
且 iL(0)=IRM,Vc(0)=0;Roff为体二极管等效电阻;
将(3)式代入(2)式,可得:
(4)
对二阶常系数非齐次线性微分方程(4)求解,可得体二极管两端的Vc和这一阶段的反向恢复电流iL:
(5)
(6)
其中:
(7)
(8)
(9)
(10)
条件是:
(11)
一般情况下Roff都很大,因此都能满足这一条件。由(5)、(6)两式可知,t3~t4阶段及往后,体二极管的电压与电流波形高频振荡,呈指数衰减,同时产生很高的反向电压尖峰,可能会危及MOSFET器件本身的安全。t3~t4这段时间的长短与体二极管Roff、Cds的大小相关,相同条件下该段时间越短,反向电压尖峰就越大。
2.3 改变正向导通电流
SiC MOSFET寄生体二极管的反向恢复特性取决于器件内部参数和外部操作条件。器件内部参数由器件厂商决定,因此外部因素是需要研究的重点,而不同的关断电压和正向导通电流是器件最常见的外部因素[6,7]。在接下来的测试中,通过调节调压器来改变SiC MOSFET关断电压,由2.1节可知,进而会改变寄生体二极管的正向导通电流,观测寄生体二极管的反向恢复电流,波形如图5所示。
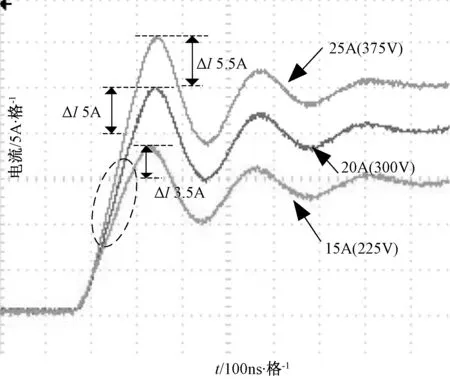
图5 不同正向导通电流下的反向恢复波形对比
对比图5的电流波形发现:当体二极管承受的关断电压Vdc由225 V增大到375 V时,正向导通电流IF的下降速度di/dt也随之由550 A/μs增大到710 A/μs,这符合公式(1)的分析。同时,由图5可以看出反向恢复电流随着正向导通电流增大而有所增大,这是因为扫出来的电荷量与正向导通电流几乎成正比;但其对峰值电流IRM的影响很微弱,正向导通电流从15 A增大到25 A,而反向恢复电流峰值仅增加2 A,最大反向峰值电流5.5 A,这也在一定程度上表明了SiC MOSFET寄生体二极管的优良性能。另外,虽然反向恢复电流的峰值不同,但振荡的趋势却相近似,由公式(6)~(8)可知,影响振荡的ω并未改变,只是初始角度ψ和幅值VA有所变化。
2.4 改变寄生电感
线路的寄生电感也是现实应用中不得不考虑的重要外部因素之一[9]。因为实验条件限制,不方便轻易有效的改变线路的寄生电感,所以采用仿真的方法来观测不同串联寄生电感条件下SiC MOSFET寄生体二极管的反向恢复电流。在OrCad Capture 16.3中按图3搭建仿真电路,其中SiC MOSFET(IXFN50N120SiC)器件模型由厂家提供的Spice程序构建,串联寄生电感L1分别取100 nH、150 nH和200 nH,体二极管的反向恢复电流如图6所示(仿真可以直接测得该电流)。

图6 不同寄生电感下的反向恢复波形对比
由图6的仿真结果图可以看到,寄生电感值越小,正向导通电流IF的下降速度di/dt就越大,这符合公式(1)的分析,对应的反向恢复电流的峰值IRM的值就越大,但差别很微弱。然而,由公式(6)~(8)可知,寄生电感值越大,影响振荡的ω值就越小,导致相对应的反向恢复电流的振荡就越严重,达到稳定状态耗时就越长,这与仿真波形是相吻合的。因此,综合考虑应尽可能的减小线路的寄生电感。
2.5 体二极管反向恢复特性对比
为了更好的测试SiC MOSFET体二极管的反向恢复性能,特意选择和同电压等级的Si MOSFET以及快恢复二极管做对比,三种器件的参数如表1所示。可调直流电压源统一设定为300 V,保证正向导通时电流都为20 A。分别测量各自二极管两端的电压和流过下端M2的电流,相关波形如图7所示。

表1 三种二极管的主要参数对比
对比图7波形可以发现:SiC MOSFET寄生体二极管性能和快恢复二极管相当,远好于Si MOSFET,甚至在反向电压浪涌方面还优于快恢复二极管。SiC MOSFET寄生体二极管和快恢复二极管的反向恢复速度极快,约70~80 ns,而Si MOSFET则为300 ns,远高于前二者;SiC MOSFET寄生体二极管的反向恢复电流峰值最小,为3.5 A,快恢复二极管次之,为5 A,Si MOSFET寄生体二极管表现最差,高达18 A;同时,SiC MOSFET寄生体二极管反向恢复过程引起的电压浪涌是最小的,约为电源电压的1.7倍,而Si MOSFET寄生体二极管和快恢复二极管在反向过程中引起的电压浪涌分别达到了原电源电压的2.3~2.5倍,对器件安全构成很大的威胁;由公式(5)~(8)可知,反向恢复电压、电流波形的振荡与器件的寄生电感和电容有关,结合表1,Si MOSFET的寄生电容最大,因而振荡最为严重。

图7 三种二极管的反向恢复波形对比
3 结论
本文在详细分析了新型功率器件SiC MOSFET的结构特点及体二极管反向恢复机理的基础上,推导了反向恢复过程的电压与电流计算。搭建了双脉冲实验平台,探究了不同正向导通电流和串联寄生电感对SiC MOSFET寄生体二极管反向恢复性能的影响,结果表明即使是在较大正向导通电流下,体二极管的反向恢复电流也在可接受的范围内,而较大的寄生电感会引起反向恢复电流的剧烈振荡。同时,还进一步对比测试了同电压等级的SiC MOSFET、Si MOSFET寄生体二极管和快恢复二极管的反向恢复性能,结果表明SiC MOSFET寄生体二极管的性能远优于Si MOSFET的寄生体二极管,和快恢复二极管的性能相当。因此,SiC MOSFET寄生体二极管可以作为变换器中的续流通道而不必再额外的单独反并联快恢复二极管,但在应用过程中应注意通过合理的布线来减小线路寄生电感带来的不利影响。
[1]李荣荣. 基于SiC MOSFET的高频感应加热电源关键技术研究[D]. 保定:华北电力大学, 2015.
[2]王艺翰, 凌志斌, 李睿, 等. 一种新颖的零电压开关全桥逆变器 [J]. 电工电能新技术, 2014, 33(5): 12-16.
[3]李建文, 刘教民, 王震洲,等. 高频逆变电源新型软开关调功策略的研究[J]. 华北电力大学学报(自然科学版), 2010, 37(3):33-37.
[4]杨志华. 开关电源中二极管反向恢复的电压浪涌与损耗 [J]. 通信电源技术, 1998(4):5-8.
[5]BOLOTNIKOV A, GLASER J, NASADOSKI J, et al. Utilization of SiC MOSFET body diode in hard switching applications[C]//Materials Science Forum. 2014, (778): 947-950.
[6]JORDAN J, ESTEVE V, SANCHIS-KILDERS E, et al. A comparative performance study of a 1200 V Si and SiC MOSFET intrinsic diode on an induction heating inverter[J]. Power Electronics, IEEE Transactions on, 2014, 29(5): 2550-2562.
[7]SARNAGO H, LUCIA O, BURDIO J M. A comparative evaluation of SiC power devices for high-performance domestic induction heating[J]. Industrial Electronics, IEEE Transactions on, 2015, 62(8): 4795-4804.
[8]FUNAKI T. A study on performance degradation of SiC MOSFET for burn-in test of body diode[C]// IEEE International Symposium on Power Electronics for Distributed Generation Systems. 2013:675-676.
[9]葛小荣, 刘松. 理解功率MOSFET体二极管反向恢复特性 [J]. 今日电子, 2012(11):36-37.
[10]洪峰, 单任仲, 王慧贞,等. 一种逆变器损耗分析与计算的新方法 [J]. 中国电机工程学报, 2008, 28(15):72-78.
SHI Meng,PENG Yonglong,LI Yabin,JIANG Tao(School of Electrical and Electronic Engineering,North China Electric Power University, Baoding 071003, China)
Research on Reverse Recovery Behavior of the Body Diode of SiC MOSFET
The structure characteristics of the new power device SiC MOSFET and the mechanism of the reverse recovery of the body diode are analyzed in detail, and the calculation process of the voltage and current of the reverse recovery process is derived. At the same time, a double pulse test platform is built, and the effects of the most common external factors, such as varied turn-off voltage, forward current and series parasitic inductance, on the reverse recovery behavior of the body diode of SiC MOSFET is analyzed by the methods of experiment and simulation. In addition, the reverse recovery performances of the body diode of SiC MOSFET, Si MOSFET and fast recovery diode are compared at the same voltage level. Related research results show that the body diode of SiC MOSFET can be used as a continuous flow channel in the converter without anti-paralleling a fast recovery diode, which has a certain reference value for practical engineering applications.
SiC MOSFET;body diode;reverse recovery
2016-06-20。
史孟(1990-),男,硕士研究生,研究方向为电力电子技术在电力系统中的应用,E-mail:shimengdy@126.com。
TM20
A DOI:10.3969/j.issn.1672-0792.2016.09.007
