焊料Sn3.5Ag4Ti(Ce,Ga)与SiO2基板低温活性焊接机理*
2016-10-31成兰仙李国元
成兰仙 李国元
(华南理工大学 电子与信息学院, 广东 广州 510640)
焊料Sn3.5Ag4Ti(Ce,Ga)与SiO2基板低温活性焊接机理*
成兰仙 李国元
(华南理工大学 电子与信息学院, 广东 广州 510640)
采用扫描电镜、能谱仪和透射电镜研究了Sn3.5Ag4Ti(Ce,Ga)低温活性焊接SiO2基板界面的微观形貌和焊接机理,并根据反应热力学和活性元素的吸附理论分析了Sn3.5Ag4Ti(Ce,Ga)与SiO2基板的焊接机理及焊接动力学过程.实验结果表明,焊接界面由TiSi和TiO2形成.理论分析与实验结果一致表明:Ti元素在SiO2基板表面的化学吸附可能是实现焊接润湿的主要原因,在焊接的初始阶段发挥重要的作用;Ti与SiO2之间的界面反应并形成界面产物是实现Sn3.5Ag4Ti(Ce,Ga)与SiO2基板焊接的主要机理.
低温;活性焊接;界面产物;活性元素
晶片键合在新型的SiP封装、三维(3D)封装及微电子机械系统(MEMS)的加工中有着重要的应用[1-4].目前主要的键合方式有直接键合、中间层键合、阳极键合、表面活化键合等,大部分的晶片键合技术通常需要在高温条件下进行,由此导致的热应力问题会造成器件工作不稳定和可靠性降低,过高的温度还会使晶片材料中的功能成分再度扩散,致使电学特性恶化.低温焊接技术在这方面有着明显的优势,可以有效地减小器件在封装过程中的损坏.近几年来,焊料作为一种中间层键合材料,非常频繁地被当作胶水在芯片级键合中使用.相比于其他键合技术,焊接可以容忍更大程度的表面粗糙度,并且只需要较低的温度就可以实现真空密封和局部加热[5].

文中主要研究Sn3.5Ag4Ti(Ce,Ga)与SiO2基板在低温活性焊接过程中Ti的作用和影响,分析焊接界面形成的固-液反应产物及形成机理,以及SiO2基板与Sn3.5Ag4Ti(Ce,Ga)实现低温活性焊接的动力学过程.
1 实验材料与方法

实验设置了4种焊接时间(1、15、30、60 min),以观察焊接过程中焊接时间对焊接界面微观形貌的影响.按照金相样品的制作方法准备好实验样品的焊接横截面,采用扫描电子显微镜(SEM,HITACHI S-3700)、能谱仪(EDS)观察焊接界面的微观组织和分析化学成分,采用场发射透射电子显微镜(TEM,JEM-2100)对焊接界面的微观结构和界面产物进行分析,确定焊接界面形成的反应物质.
2 结果与分析
2.1焊接界面微观结构
SiO2/Sn3.5Ag4Ti(Ce,Ga)/SiO2在不同焊接时间(1、15、30、60 min)下的焊接横截面扫描电镜图如图1所示.可以发现,虽然焊接时间不同,但两片SiO2都实现了良好的结合.从扫描电镜结果看,焊接时间对焊接界面微观结构的影响不明显.仔细观察SiO2/活性焊料的焊接界面,有一层物质明显地连接在SiO2的表面上.为了初步获取焊接界面的物质成分,对在SiO2表面上形成的物质进行EDS分析.
图2是对图1(c)中A1、A2处进行EDS分析的结果,可以发现:A1处Ti元素的含量是11.49%,明显高于活性焊料中Ti的含量;A2处Ti的含量是5.83%,也是高于活性焊料中Ti的含量.可以推测,Ti元素可能在界面处富集或者形成富含Ti的物质.虽然A1和A2区域所选的只是一个点,但在进行EDS检测过程中,由于仪器检测的物理精度原因,A1和A2附近的焊料和SiO2基板中相关元素的含量也会在EDS中表征出来,因而图2中包括了Sn、Ag、Si和O元素.为了明确界面产物和分析焊接机理,有必要采用较高精度的透射电镜对焊接界面的物质形成进行更深入的检测和分析.
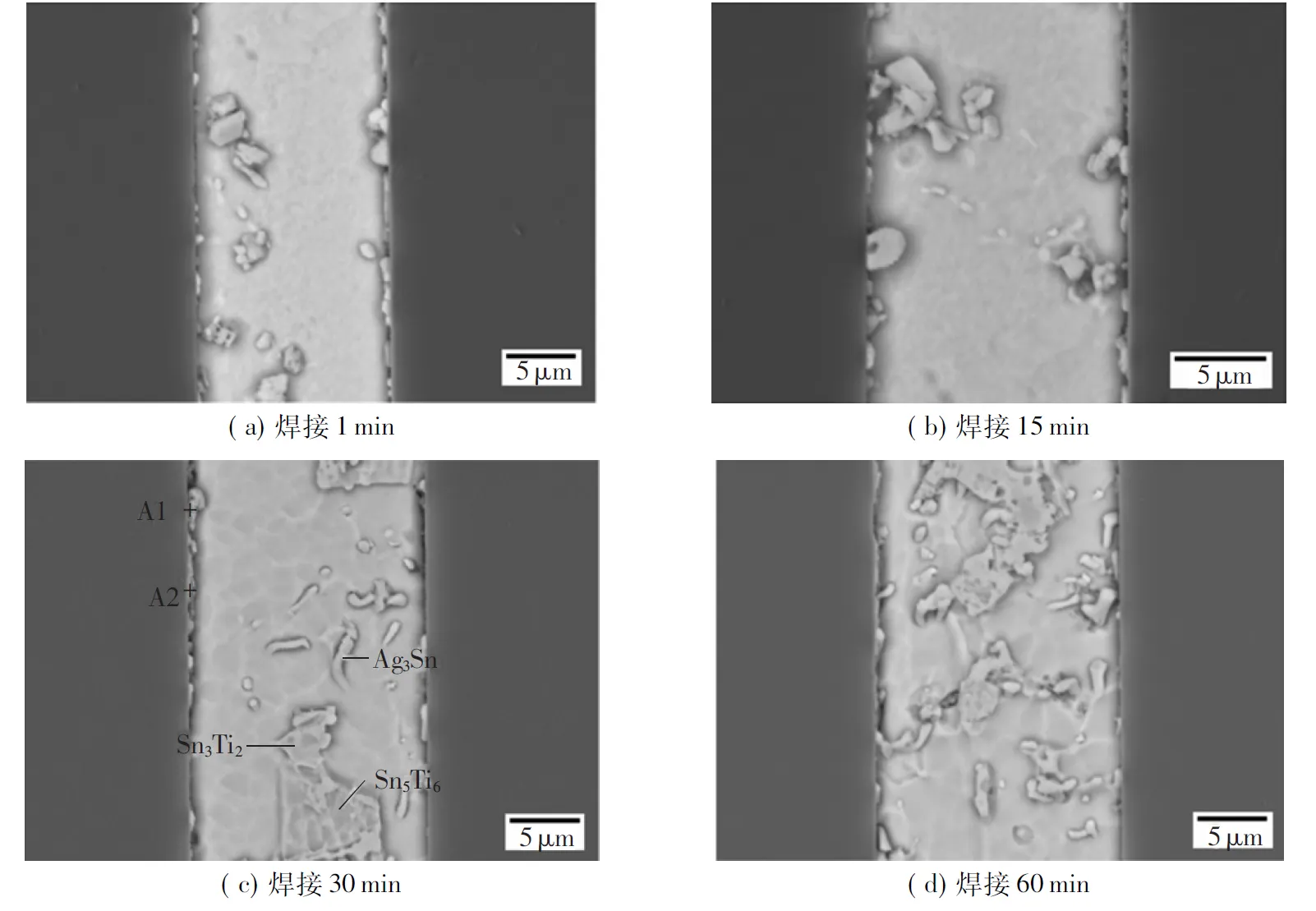
图1不同焊接时间的SiO2/Sn3.5Ag4Ti(Ce,Ga)/SiO2焊接横截面扫描电镜图
Fig.1SEM micrographs of cross-sectional view of SiO2/Sn3.5Ag4Ti(Ce,Ga)/SiO2solder joints with different soldering time

(a)A1处

(b)A2处
2.2焊接界面反应物的观察和分析


(a)界面反应层的微观结构图
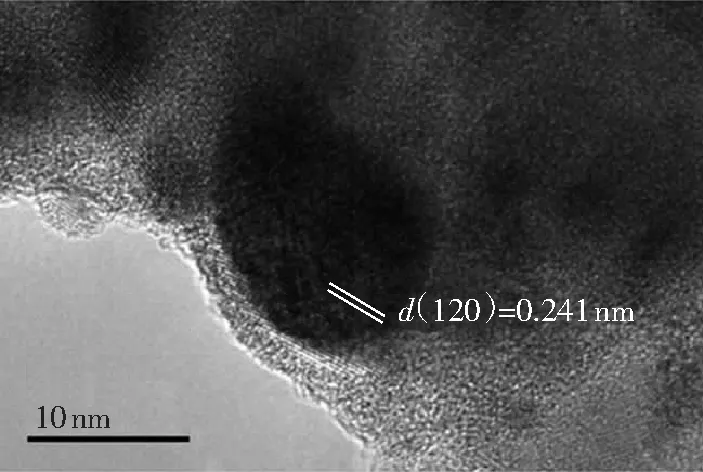
(b)B1处的高分辨透射电镜图

(c)B2处的高分辨透射电镜图

(d)B1处的衍射花样

(e)B2处的衍射花样
图3焊接时间为30 min的SiO2/Sn3.5Ag4Ti(Ce,Ga)焊接横截面的透射电镜图
Fig.3TEM micrographs of cross-sectional view ofSiO2/Sn3.5Ag4Ti(Ce,Ga) solder joints with soldering time of 30 min
综合SiO2/Sn3.5Ag4Ti(Ce,Ga)焊接界面微观形貌、界面反应层的高分辨透射图和衍射花样分析,一致推断在SiO2/Sn3.5Ag4Ti(Ce,Ga)焊接界面形成了TiSi和TiO2相.
2.3界面反应热力学分析
在焊接界面的检测结果中,未发现有Ga或Ce的化合物形成,也未发现Ga或Ce元素在焊接界面偏聚.Chang等[10-12]曾提出添加的稀土元素Ga和Ce可以有效地保护活性元素Ti防止氧化.仅从文中实验结果很难对稀土元素在实现低温焊接中的作用进行讨论,因此文中主要分析活性元素Ti在实现SiO2基板低温活性焊接中的作用和影响.
为了分析低温活性焊接过程中界面反应物质的形成机理,有必要从热力学角度进行分析和研究.实验中,活性焊料Sn3.5Ag4Ti(Ce,Ga)中的活性元素Ti最有可能与SiO2基板发生化学反应,从而形成界面反应生成物[13]:
SiO2(s)+Ti(l)=TiSi(s)+TiO2(s)
(1)



T/KΦ'TiSiΦ'TiO2∑Φ'T(生成物)Φ'TiΦ'SiO2∑Φ'T(反应物)ΔΦ'TTΔΦ'TΔGθT/J50054.38157.015111.39633.55847.14080.69830.69815349.0-178943.060058.50062.124120.62435.75551.65787.41233.21219927.2-183521.2
2.4界面Ti元素的活性吸附
SiO2/Sn3.5Ag4Ti(Ce,Ga)焊接界面微观形貌分析表明,界面上有连续的反应生成物TiSi和TiO2形成.根据前期关于Al2O3的低温活性焊接中Ti的扩散动力学过程分析[15],可以推测焊接过程中Ti原子由于活性焊料液体内部原子之间的排斥力而往基板界面和液体表面扩散,Ti与SiO2基板之间可能存在活性吸附能,从而使钛原子吸附在焊接界面并与基板发生界面反应.因此很有必要估算一下Ti原子与SiO2基板之间的吸附能大小.
根据Li[16]对界面吸附能的计算,吸附能W可以表示为
W=SWnws
(2)
式中:SW为吸附能的斜率参数,它是指定基板与不同金属接触时一个稳定的界面吸附强度;nws为金属Wigner-Seitz胞边界的电子密度.SiO2的SW约为188 mJ/(m2·du),Ti的nws为3.51 du[17],1 du=6×1022cm-3.因此,Ti在SiO2界面的吸附能为
W=188 mJ/(m2·du)×3.51 du=659.8 8 mJ/m2.
由此表明,SiO2表面与Ti原子之间存在一定强度的吸附能.可能是由于SiO2表面对Ti有吸附作用,才会在焊接过程中吸引Ti原子往界面扩散,并停留在固液界面上.这可能是Sn3.5Ag4Ti(Ce,Ga)与SiO2基板在低温下实现润湿的主要原因,在焊接的初始阶段发挥重要的作用.
综合上述界面反应热力学分析和界面Ti元素的活性吸附分析,Sn3.5Ag4Ti(Ce,Ga)在低温焊接SiO2基板的焊接动力学过程可以分成3个步骤:
(1)活性焊料液体内部原子之间的相互排斥力促使一部分活性原子扩散到液体表面和焊接界面;
(2)由于SiO2和Ti之间有着一定强度的活性吸附能,扩散到SiO2/活性焊料界面的Ti原子吸附在界面处;
(3)Ti元素与SiO2基板接触后发生界面化学反应,形成一层连续的反应层.由于活性焊料与SiO2能自发地发生化学反应,因此界面处的Ti原子被消耗掉而形成一层反应物质.
3 结论
文中研究了Sn3.5Ag4Ti(Ce,Ga)活性焊料在SiO2基板上的低温活性焊接机理,分析了焊接界面微观形貌和形成的反应生成物,探讨了低温下实现Sn3.5Ag4Ti(Ce,Ga)与SiO2基板的焊接动力学过程,得出如下结论:
(1)在焊接温度为250 ℃、焊接时间为30 min的Sn3.5Ag4Ti(Ce,Ga)/SiO2焊接界面上有明显的生成物TiSi和TiO2.
(2)低温下实现Sn3.5Ag4Ti(Ce,Ga)活性焊料在SiO2基板的焊接,Ti元素与SiO2之间存在一定强度的吸附能可能是实现润湿的主要原因,促进活性原子往界面扩散;其次,Ti与SiO2之间的界面反应,促使形成界面反应物,是实现低温活性焊接的主要机理.
(3)实验结果和理论分析表明,活性焊料液体内部原子之间的相互排斥力促使一部分活性原子扩散到液体表面和固-液界面,由于Ti元素与SiO2之间存在一定强度的吸附能,扩散到SiO2/活性焊料界面的Ti原子吸附在界面上,在Ti元素与SiO2基板接触后发生界面化学反应,形成连续的界面反应化合物.
[1]LIU Y T,SUN L N.Laser-heating wire bonding on MEMS packaging [J].AIP Advances,2014,4(3):31312.
[2]MARAUSKA S,CLAUS M,LISEC T,et al.Low temperature transient liquid phase bonding of Au/Sn and Cu/Sn electroplated material systems for MEMS wafer-level pa-ckaging [J].Microsystem Technologies,2013,19(8):1119-1130.
[3]GARNIER A,BAILLIN X,HODAJ F.Solidification and interfacial interactions in gold-tin system during eutectic or thermo-compression bonding for 200 mm MEMS wafer level hermetic packaging [J].Journal of Materials Science:Materials in Electronics,2013,24(12):5000-5013.
[4]BRAEUER J,BESSER J,WIEMER M,et al.A novel technique for MEMS packaging:reactive bonding with integrated material systems [J].Sensors and Actuators A:Physical,2012,188:212-219.
[5]MIKI N.Wafer bonding techniques for MEMS [J].Sensor Letters,2005,3(4):263-273.
[6]TSAO L C.Microstructural characterization and mechanical properties of microplasma oxidized TiO2/Ti joints soldered using Sn3.5Ag4Ti(Ce) active filler [J].Journal of Materials Science:Materials in Electronics,2014,25(1):233-243.
[7]TSAO L C.Interfacial structure and fracture behavior of 6061 Al and MAO-6061 Al direct active soldered with Sn-Ag-Ti active solder [J].Materials & Design,2014,56:318-324.
[8]TSAO L C.Direct active soldering of micro-arc oxidized Ti/Ti joints in air using Sn3.5Ag0.5Cu4Ti(RE) filler [J].Materials Science and Engineering:A,2013,565:63-71.
[9]WANG W L,TSAI Y C.Microstructural characterization and mechanical property of active soldering anodized 6061 Al alloy using Sn-3.5Ag-xTi active solders [J].Materials Characterization,2012,68:42-48.
[10]CHANG S Y,CHUANG T H,TSAO L C,et al.Active soldering of ZnS-SiO2sputtering targets to copper ba-cking plates using an Sn3.5Ag4Ti(Ce,Ga) filler metal [J].Journal of Materials Processing Technology,2008,202(1/2/3):22-26.
[11]CHANG S Y,CHUANG T H,YANG C L.Low temperature bonding of alumina/alumina and alumina/copper in air using Sn3.5Ag4Ti(Ce,Ga) filler [J].Journal of Electronic Materials,2007,36(9):1193-1198.
[12]CHANG S Y,TSAO L C,CHIANG M J,et al.Active soldering of indium tin oxide (ITO) with Cu in air using an Sn3.5Ag4Ti(Ce,Ga) filler [J].Journal of Materials Engineering and Performance,2003,12(4):383-389.
[13]TING C Y,WITTMER M,IYER S S,et al.Interaction between Ti and SiO2[J].Solid-State Science and Technology,1984,131(12):2934-2938.
[14]叶大伦,胡建华.实用无机物热力学数据手册 [M].2版.北京:冶金工业出版社,2002:9-20.
[15]CHENG L X,LI G Y,LI Z L,et al.Effects of titanium on active bonding between Sn3.5Ag4Ti(Ce,Ga) alloy filler and alumina [J].Journal of Materials Science:Materials in Electronics,2015,26(8):6004-6012.
[16]LI J G.Energetics of metal/ceramic interfaces,metal-semiconductor Schottky contacts,and their relationship [J].Materials Chemistry and Physics,1997,47(2):126-145.
[17]张邦维,胡望宇,舒小林.嵌入原子方法理论及其在材料科学中的应用 [M].长沙:湖南大学出版社,2003:7-9.
Supported by the Science and Technology Planning Project of Guangdong Province(2013B010403003)
Active Bonding Mechanism Between Sn3.5Ag4Ti(Ce,Ga) and SiO2Substrate at Low Temperature
CHENGLan-xianLIGuo-yuan
(School of Electronic and Information Engineering, South China University of Technology, Guangzhou 510640, Guangdong, China)
The interfacial microstructure and soldering mechanism of the low-temperature active bonding SiO2substrate with Sn3.5Ag4Ti(Ce, Ga) alloy filler were investigated by means of SEM, EDX and TEM, and the mechanism and dynamic process of the active bonding between Sn3.5Ag4Ti(Ce, Ga) and SiO2substrate were analyzed on the basis of the active adsorption and reaction thermodynamics theories. Experiment results show that TiSi and TiO2phases form along the interface. Both theoretical results and experimental results indicate that the chemical adsorption of Ti on SiO2substrate interface may be the main reason for wetting and plays an important role in the initial bonding stage, and that the main bonding mechanism of Sn3.5Ag4Ti(Ce, Ga) and SiO2substrate can be described as the interfacial reaction between Ti and SiO2and the forming of correspondent reactants.
low temperature; active bonding; interfacial product; active element
1000-565X(2016)09-0067-06
2015-11-20
广东省科技计划项目(2013B010403003)
成兰仙(1981-),女,博士生,高级工程师,主要从事先进微电子封装材料研究.E-mail:cheng.lx@mail.scut.edu.cn
TG 425
10.3969/j.issn.1000-565X.2016.09.010
