SiO2-Si3N4-SiO2复合梁谐振式压力传感器结构设计与分析
2015-06-07李春风
李 新,薛 阳,李春风
(1.沈阳工业大学,辽宁沈阳 110870;2.沈阳通美电器有限公司,辽宁沈阳 110000)
SiO2-Si3N4-SiO2复合梁谐振式压力传感器结构设计与分析
李 新1,薛 阳1,李春风2
(1.沈阳工业大学,辽宁沈阳 110870;2.沈阳通美电器有限公司,辽宁沈阳 110000)
提出了一种采用SiO2-Si3N4-SiO2复合谐振梁结构的谐振式压力传感器。采用有限元分析技术分别对谐振梁和传感器芯片结构进行了电热分析、模态分析以及谐响应分析,最后对SiO2-Si3N4-SiO2复合梁谐振式压力传感器的工艺进行了探讨,表明通过多晶硅牺牲层技术能更好地得到SiO2-Si3N4-SiO2复合谐振梁,具有良好的选频特性。
有限元;SiO2-Si3N4-SiO2复合梁;压力传感器
0 引言
在工业实践中压力传感器广泛应用于航空航天、医疗卫生、工业检测等众多行业。传统的压力传感器是输出为模拟信号的压阻式压力传感器,其抗干扰性较差,而谐振式压力传感器输出的频率信号可与数字接口相连,克服了抗干扰性较差的缺点。
文中设计了一种基于电热激励压阻拾振方式的SiO2-Si3N4-SiO2复合梁谐振式压力传感器,采用多晶硅牺牲层技术,其制作工艺简单,避免了硅-硅键合带来的体应力。结合ANSYS有限元分析软件,全面分析了压力、温度等对谐振式压力传感器谐振频率的影响规律,为谐振器的结构设计分析提供依据。
1 谐振式压力传感器原理
SiO2-Si3N4-SiO2复合梁谐振式压力传感器结构如图1所示。

图1 氮化硅梁谐振式压力传感器结构示意图
SiO2-Si3N4-SiO2复合谐振梁位于硅感压膜的上方,梁下方是为梁提供振动空间的凹槽,多晶硅激励电阻位于SiO2-Si3N4-SiO2复合谐振梁的中间,梁的端部为多晶硅拾振电阻。硅膜的另一侧接待测压力源,芯片底膜四周粘接在管座上,谐振梁封装在玻璃真空当中。当外界压力作用在感压膜时,感压膜会发生机械形变,谐振梁也会发生相应的变形,进而改变了谐振梁的固有谐振频率,通过给激励电阻一个周期性变化的激励电压,使激励电阻对梁进行周期性的加热,谐振梁上就会产生周期性的驱动力,梁在驱动力的作用下产生振动。当激励电压的频率与谐振梁固有频率一致时,此时的梁的振动幅度最大,梁端部拾振电阻的拾振信号也最强,通过确定最强的拾振信号,进而确定梁的固有谐振频率,最终确定外界压力的大小[1]。
根据弹性理论,谐振梁在无应力(σ=0)时的固有频率
(1)
式中:E为材料的杨氏模量;h为梁的宽度;l为梁的长度;ρ为材料密度。
当考虑轴向应力(σ≠0)时,谐振梁的固有频率
(2)

取硅感压膜为2a×2a×t,谐振梁上的应力可近似表示为
(3)
式中μ为材料泊松比。
所以,临界外加压力PC可表示为
(4)
当待测压力为临界外加压力的20%以下时,可近似为[2]
(5)
灵敏度为
(6)
谐振式压力传感器比较重要的参数为梁的长度和宽度,膜的尺寸和厚度。
2 传感器结构有限元分析
由于理论分析只能对简单的模型进行数学解析,而对于较复杂的模型,有限元仿真分析是比较好的方法,为了得到最好的分析结果,提高传感器的性能,在ANSYS有限元仿真软件中进行建模仿真。
建立谐振梁模型,通过对谐振梁各个参数的仿真,得到谐振梁的谐振频率与各个参数关系如图2和图3所示,说明梁的频率与梁长度倒数平方和梁的宽度有非常好的线性关系。
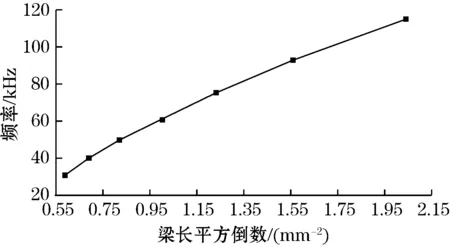
图2 梁频率与梁长倒数平方关系曲线
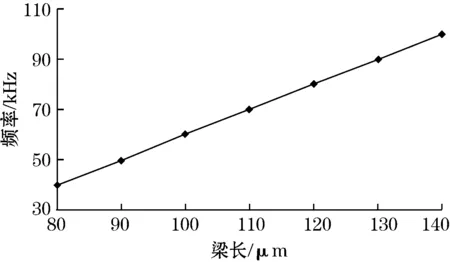
图3 梁频率与梁宽关系曲线
通过理论分析和仿真结果分析,以及多晶硅薄膜激励电阻的尺寸,再结合工艺条件,确定模型尺寸参数:传感器芯片4 000 μm×4 000 μm×200 μm,SiO2-Si3N4-SiO2复合谐振梁1 000 μm×100 μm×0.9 μm,凹槽1 000 μm×400 μm×0.5 μm,背部C型硅杯深度100 μm。随着微电子工艺的发展,多晶硅薄膜在合适的掺杂和热处理后能够获得线性度更好的温度特性,所以激励电阻和拾振电阻采用多晶硅薄膜电阻,多晶硅方块电阻大小为20 Ω。在电热激励分析中施加2 V激励电压Vex,得到在激励电压下梁的温度与位移的分布如图4所示,由图可知谐振梁中部的温度与位移变化最大。
由于整个压力传感器结构具有XZ两个方向的对称性,所以只建立1/4模型对其进行模态分析和谐响应分析。对感压膜施加100 kPa,150 kPa,200 kPa,250 kPa,300 kPa,350 kPa,400 kPa,450 kPa,500 kPa的压力,通过有限元分析得到谐振梁谐振频率变化如图5所示,在没有外界压力的情况下,谐振梁的固有谐振频率为60.608 kPa,外界压力与谐振梁的谐振频率有非常好的线性关系,线性度达到了0.99,灵敏度达到了104 Hz/kPa。在感压膜上施加100 kPa的压力,得到压力传感器结构的一阶模态如图6所示。谐振梁的固有谐振频率为60.608 kPa,在激励点施加100 N的正弦激振力,通过有限元的谐响应分析,得到拾振点振幅与激励频率的关系如图7所示。


图4 激励电压2 V下的复合梁温度与位移
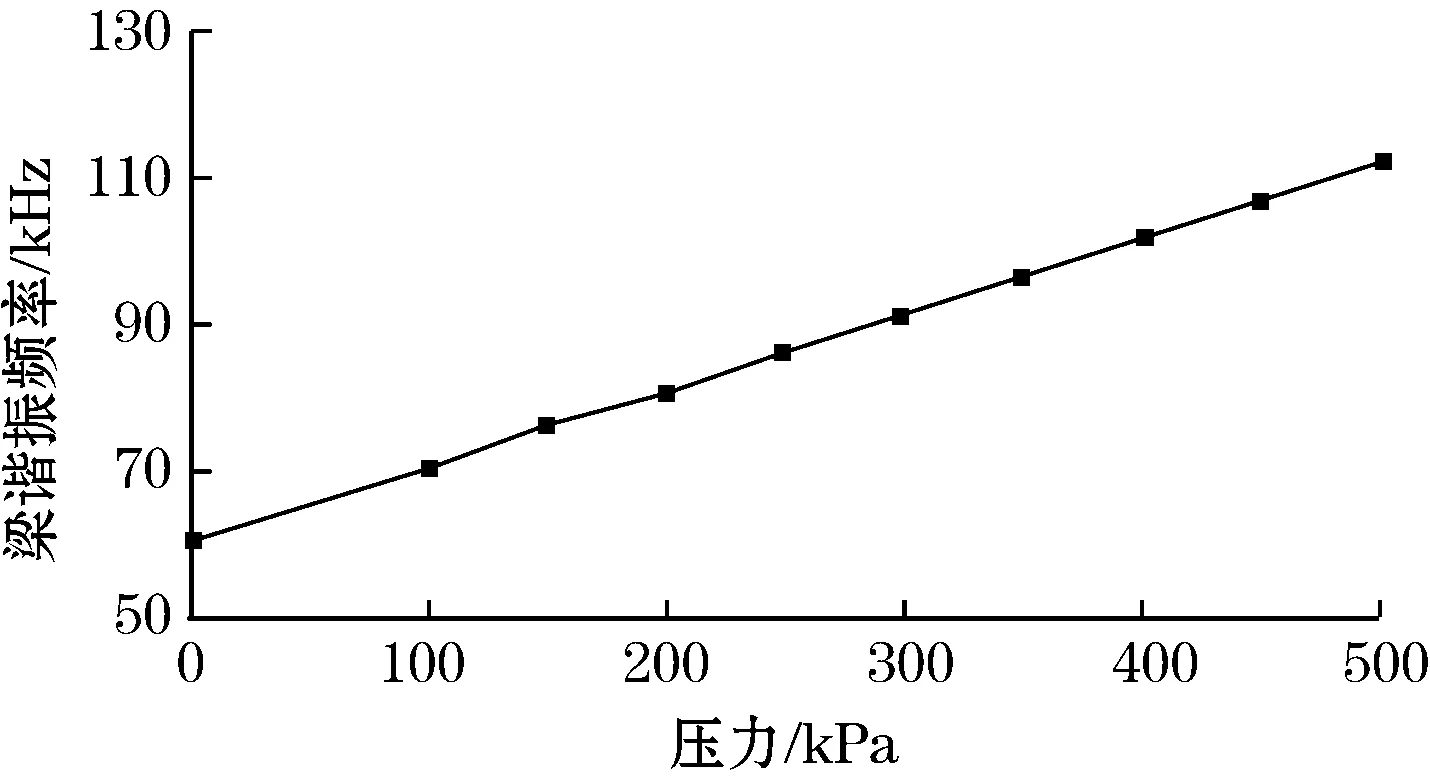
图5 不同压力下梁的谐振频率

图6 100 kPa压力下的模态
由图6和图7可知第一阶模态对应梁的一阶谐振,梁中央振幅最大,谐振梁在固有频率附近具有较大的振幅,而以固有频率为中心,随着扫频频率偏离中心固有频率,谐振梁的振幅迅速下降,由此可见该谐振式压力传感器中的谐振结构具有很好的选频特性。

图7 谐振结构幅频特性曲线
3 工艺设计
工艺流程图如图8所示。(a)硅片热氧化,将4in(1in=2.54 cm)N型(100)硅片,厚度约为200 μm,用清洗液清洗后,放入氧化炉生长0.65 μm二氧化硅,避免牺牲层腐蚀时硅衬底也被腐蚀液腐蚀;(b)淀积刻蚀LPCVD多晶硅牺牲层,厚度约为0.5 μm,曝光显影,用氯气进行刻蚀;(c)平坦化处理[3],淀积0.8 μm二氧化硅,涂胶、平烘后用干法刻蚀光刻胶与二氧化硅直至牺牲层顶部氧化层厚度约0.1 μm,湿法去胶;(d)淀积SiO2-Si3N4-SiO2复合层,用离子淀积设备先后淀积0.3 μmPECVD二氧化硅、0.5 μmPECVE氮化硅、0.1 μm PECVD二氧化硅,再将硅片放入氮气扩散炉中退火30 min,使介质薄膜致密化;(e)制备多晶硅电阻,淀积掺磷多晶硅,控制掺杂浓度,使方块电阻大小为20 Ω;(f)淀积二氧化硅隔离层,厚度约为0.3 μm,再将硅片放入气氛为氮气扩散炉中退火30 min,使介质薄膜致密化;(g)刻蚀接触孔,制备铝电极;(h)淀积0.6 μm二氧化硅作为钝化层,防止污染,提高器件可靠性;(i)刻蚀腐蚀窗口,TMAH溶液腐蚀牺牲层[4];(j)背部腐蚀出感压膜。
4 结论
提出了一种电热激励压阻拾振SiO2-Si3N4-SiO2复合梁谐振式压力传感器的结构,通过多晶硅牺牲层技术释放复合谐振梁,并采用有限元分析的方法对芯片进行了电热、应力、模态以及谐响应分析,结果表明该谐振结构具有良好的选频特性。
[1] 王喆垚.微系统设计与制造.北京:清华大学出版社,2008.
[2] ZHU Z,LIU C.Micromachining process simulation using a continuous cellular automata method.IEEE/ASME Journal of,Microelectro mechanical Systems (JMEMS),2000,9(2):252- 261.
[3] HUBBARD T J,ANTONSSON E K.Emergent faces in crystal etching.Journal of,Microelectro mechanical Systems,1994,3(1):19-28.
[4] WILLIAMSILLIAMS K R.Etch rates for micromachining processing-Part II.Journal of.Micro-electromechanical Systems,2003,12(6):761-778.
Design and Analysis of SiO2-Si3N4-SiO2Composite Resonant Beam Pressure Sensor
LI Xin1,XUE Yang1,LI Chun-feng2
(1.Shenyang University of Technology,Shenyang 110870,China;2.Shenyang Tongmei Electric Appliance Co.,Ltd.,Shenyang 110000,China)
The resonant pressure sensor with SiO2-Si3N4-SiO2composite beam structure was proposed in this paper.Finite elemet method was adopted to analyze electrothermal analysis,modal analysis and harmonic response analysis of the resonance beam and sensor chip architecture.The SiO2-Si3N4-SiO2composite beam resonant pressure sensor fabrication process were discussed in this paper.SiO2-Si3N4-SiO2composite resonant beam was fabricated with polysilicon sacrificial layer technology,which has characteristic of good selection frequency.
finite element;SiO2-Si3N4-SiO2composite beam;pressure sensor

(a)热氧化

(b)淀积牺牲层

(c)平坦化处理

(d)淀积复合层

(e)制备电阻

(f)淀积隔离层

(g)制备电极

(h)淀积钝化层

(i)腐蚀牺牲层

(j)腐蚀感压膜
辽宁省自然基金资助项目(20102162)
2014-10-26 收修改稿日期:2015-03-01
TP212
A
1002-1841(2015)08-0013-03
李新(1974—),副教授,博士后,主要从事微电子技术研究。E-mail:lixin97@163.com
