PET衬底上ITO薄膜的制备及光电性能
2014-12-01胡志强徐书林王海权刘贵山姜妍彦张海涛
杨 坤,胡志强,徐书林,王海权,于 洋,刘贵山,姜妍彦,张海涛
(1大连工业大学 新能源材料研究所,辽宁 大连116034;2锦州新世纪石英(集团)有限公司,辽宁 锦州121000)
铟锡氧化物(ITO)薄膜是一种混合掺杂的n型半导体薄膜,具有复杂的立方铁锰矿结构。其不仅有高可见光透过率和高电导率,还有高紫外吸收率、高红外反射率、便于刻蚀等优良性能[1],被广泛应用于各种平板显示器、OLED、触摸屏面板以及太阳能电池等领域[2]。
目前制备ITO薄膜的主要方法有喷雾热解法[3]、电子束蒸发法[4]、溶胶-凝胶法[5]、激光沉积法[6]以及溅射法中的射频磁控溅射法[7]、直流磁控溅射法[8]、脉冲磁控溅射法[9]。这些方法中,脉冲磁控溅射法不仅能克服等离子体不稳定、电弧放电、高沉积温度的缺点,还可以在低温下较好的溅射于柔性衬底上[2]。
与硬质的玻璃、陶瓷、单晶基片等相比[10],柔性衬底不仅质轻、超薄、易弯曲,而且柔韧性好。近年来众多学者对ITO薄膜进行了很多研究,并取得了一定的成果。Lin等[9]通过脉冲磁控溅射法在PET衬底上,获得了电阻率为4.5×10-4Ω·cm、可见光透射率在85%以上的ITO薄膜;辛荣生等[11]用直流磁控溅射法在PET衬底上制备了电阻率小于5×10-4Ω·cm、可见光透过率大于80%的ITO薄膜;王军等[12]用同样的方法在玻璃基底上制备了方阻为22Ω/□、可见光区域平均透过率为85%的ITO薄膜。
本实验采用PET作为衬底材料,利用脉冲磁控溅射技术对薄膜的光电性能进行了探讨,旨在低温下寻求高透过率与低方块电阻的最佳平衡点,制备出光电性能优良的ITO透明导电膜。
1 实验
1.1 设备与靶材
实验采用JCP-200型高真空磁控溅射蒸发镀膜机在PET衬底上制备了ITO透明导电膜,所用电源为TABP-Z20-Ⅲ双击脉冲电源。溅射选用ITO陶瓷靶材,参数为:In3O2与SnO2的质量分数之比为90∶10,纯度为99.99%,靶材尺寸为φ53mm×4mm。
1.2 方法与表征
PET衬底未溅射之前按顺序进行以下清理:在去离子水、0.05mol/L的NaOH溶液、丙酮溶液、无水乙醇中分别超声15min,然后烘箱烘干。将衬底装入溅射室内,靶距65mm,旋转速率10r/min,背低真空5×10-3Pa,通入高纯氩气,将功率调至45W,每次预溅射5min除去靶材表面的氧化物,然后开始溅射。镀膜的溅射气压为0.5~1.1Pa,溅射时间为15~45min,衬底温度为25(室温)~150℃。
薄膜的表征:采用 D/max-3B型 X射线衍射(XRD)仪测定薄膜的晶体结构;通过JSM-6460LV型扫描电镜观察薄膜的表面形貌及断面;用SX1934型数字式四探针测试仪测定薄膜的方块电阻;用UVVis分光光度计Lambda35型测定薄膜在300~1200nm光谱范围内的透射率。
2 结果与讨论
2.1 薄膜物相结构分析
图1所示XRD曲线为柔性衬底PET自身的衍射峰和不同衍射时间的ITO薄膜的衍射图谱。
由ITO薄膜中主要成分In2O3的PDF卡(01-0929)标 准 谱 图 得 出 2θ 位 置 为 30.698°,35.597°,51.283°的特征衍射峰分别对应于薄膜中晶体的(222),(400),(440)晶面。
与柔性衬底的空白衍射峰相比,除ITO薄膜的特征衍射峰外,在图1中并未发现Sn或Sn氧化物(SnO,SnO2)的特征衍射峰,说明离子半径较小的Sn4+(0.069nm)已完全替换了离子半径较大的In3+(0.079nm),掺杂到了In2O3的结构当中,In3+和Sn4+保持在一种单一平衡的化学键状态,形成了置换固溶体。由于Sn4+半径比In3+半径小,形成的固溶体晶格体积与In2O3的相比略小,故衍射峰的位置与标准谱图相比稍有偏离。

图1 不同溅射时间的ITO薄膜XRD图谱Fig.1 XRD patterns of ITO thin films sputtering at different time
由图1可知随着溅射时间的延长,(222)晶面衍射峰强度逐渐增强,θ角的位置右移,说明(222)面上存在强烈的择优取向;(400)和(440)晶面衍射峰在溅射35min时增强而45min时减弱;PET衬底的衍射峰随着时间延长,逐渐减弱并被ITO薄膜的特征衍射峰掩盖。
根据Scherrer公式:

由(222)晶面衍射峰的半高宽和衍射角可计算出ITO薄膜的平均晶粒尺寸;通过布拉格方程:

以及立方晶系中晶格常数与晶面间距的关系式:

可得(222)面的晶格常数a与晶面间距dhkl成正比关系,与衍射峰位2θ成反比关系[13]。
表1表示的是在PET衬底,溅射压强为0.5Pa,溅射时间分别为25,35,45min和溅射压强为0.7Pa,溅射时间为35min的ITO薄膜的(222)面的晶体结构参数。

表1 不同溅射时间的ITO薄膜的晶体结构参数Table 1 Crystal structure parameters of ITO thin films under different sputtering time
由表1(222)晶面的参数可得出:随着溅射时间延长,衍射角先减小后增大,薄膜的平均晶粒尺寸及晶格常数均先增大后减小。这可能是因为:薄膜生长的初期,衬底表面的吸附能和扩散能较大,有利于晶核的形成生长并迅速扩散到衬底表面;随着膜厚的增加,衬底的吸附能和扩散能降低,膜受残余气体分子或沉积过程中引入杂质的污染、表面粗糙度的增加以及产生的各种缺陷等不利因素影响抑制了薄膜晶核的生长,使晶格常数变小[3]。
图2所示为功率、压强、时间一定,衬底温度为25~150℃的衍射图谱。

图2 不同衬底温度的ITO薄膜XRD图谱Fig.2 XRD patterns of ITO thin films at different substrate temperatures
由图2可知薄膜(222)晶面衍射峰随衬底温度升高,峰强逐渐增加,晶粒尺寸增大[14]。图2中除单一的(222)晶面峰外,其余均为PET衬底自身的衍射峰,说明薄膜中非晶与多晶的掺杂结构较多或衬底本身较强的衍射峰掩盖了ITO薄膜其他较弱的特征衍射峰。由图2中不同衬底温度的ITO薄膜(222)晶面衍射角,利用公式(1)可以得出ITO薄膜的平均晶粒尺寸D以及通过公式(2)、(3)可以得出晶格常数a。
表2表示的是功率、压强、时间一定,衬底温度为25~150℃的(222)面的晶体结构参数。

表2 不同衬底温度的ITO薄膜的晶体结构参数Table 2 Crystal structure parameters of ITO thin films at different substrate temperatures
由表2中(222)面的晶体结构参数得出:随着衬底温度升高,衍射角向左偏移变小,薄膜的平均晶粒尺寸逐渐增大,结晶化程度变好,晶格常数逐渐增大,晶面间距变大,说明在25~150℃的衬底温度内,有利于薄膜晶核的生长,容易结晶化。
2.2 薄膜表面形貌分析
图3所示为功率、压强、衬底温度一定,不同溅射时间ITO薄膜SEM图。

图3 室温下不同溅射时间的ITO薄膜SEM 图 (a)15min;(b)25min;(c)35min;(d)45minFig.3 SEM images of ITO thin films of different sputtering time at room temperature (a)15min;(b)25min;(c)35min;(d)45min
由图3可看出,随着时间延长,薄膜表面平均晶粒尺寸增大,粗糙度增大,缺陷增多,形貌不规则;至溅射时间为45min时,图3(d)相比图3(c)膜表面粗糙度要低一些,平均晶粒尺寸要小[15]。这与图1中XRD衍射图谱的分析结果一致。
图4所示为最佳工艺参数下ITO薄膜的表面和截面SEM图。由表面图4(a)可知薄膜由微小晶粒紧密堆积而成,且均匀性好、致密度高[16];由截面图4(b)可知溅射35min的ITO薄膜厚度为300nm,其电阻率为4×10-4Ω·cm。
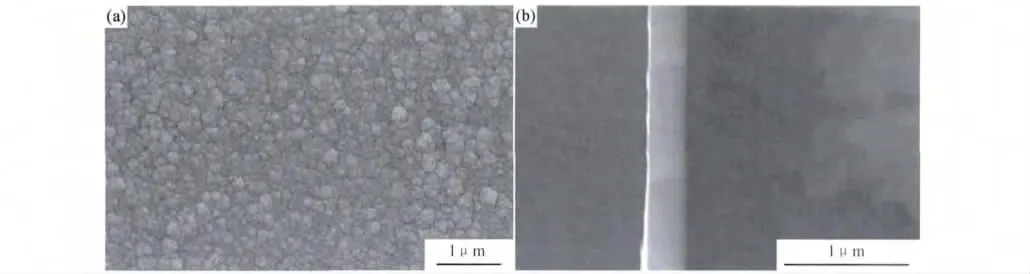
图4 150℃下ITO薄膜的表面(a)和截面(b)SEM图Fig.4 SEM images of ITO thin films at 150℃ (a)film surface;(b)film thickness section
图4(a)与图3(c)相比,可以明显看出衬底温度高的薄膜表面平整、均匀,平均晶粒尺寸大,晶格排列整齐。温度高使得吸附在衬底表面的残余气体排除,增加了衬底表面分子与溅射粒子之间的结合力;促使膜层物理吸附向化学吸附转化,增强了分子之间相互作用力,使膜层更加紧密,提高了机械强度[17]。
2.3 薄膜光电性能分析
2.3.1 溅射气压对薄膜光电性能的影响
图5所示为功率一定,不同溅射气压下的ITO薄膜的UV-Vis透射光谱图。
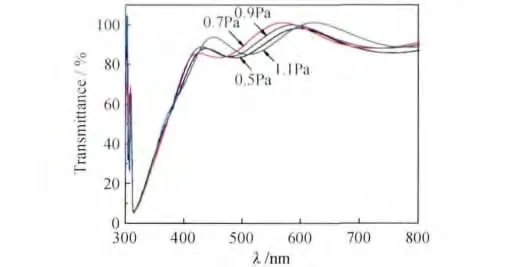
图5 溅射气压不同的ITO薄膜UV-Vis透射光谱Fig.5 UV-Vis transmission spectrum of ITO thin films deposited at different working pressure
由图5可知,在溅射过程中,高纯氩气的流量影响了溅射室内的气体压力,在低于0.4Pa的气压下,不会产生辉光放电,很难制膜,所以薄膜气压均在0.4Pa以上。由图5知光谱曲线震荡幅度小,说明薄膜的厚度较小,膜表面平整、均匀;在蓝光的长波方向,光透过率较高,均在80%以上;在紫外光区,向着短波方向的移动,薄膜的透过率都逐渐减小。图6所示,气压对薄膜的电学性能也有一定影响。薄膜的方块电阻在气压0.5Pa开始先是降低,直至气压降至0.7Pa,得最小值31Ω/□,然后随着气压增大而逐渐增大。
图6所示为功率、溅射时间一定,不同溅射气压下的ITO薄膜的方块电阻值。

图6 溅射气压不同的ITO薄膜方块电阻Fig.6 Sheet resistance of ITO thin films deposited at different working pressure
由图6可知,气压较小时,靶材被溅射出粒子除自身碰撞外,受到连续不断的Ar原子冲击以及其他粒子的散射较弱,能均匀地溅射到衬底上,靶材中的Sn4+可以较好地掺杂到In2O3结构中,其掺杂量之比接近10%,载流子密度大,故此时气压下具有较高透光率和较低的电导率。随着气压的增加,靶材被溅射出粒子受到冲击和散射较强,溅射到衬底上的薄膜缺陷增多、结晶性较差,所以透光率下降,方块电阻增大。
2.3.2 溅射时间对薄膜光电性能的影响
图7所示为功率、溅射压强一定,不同溅射时间下的ITO薄膜的UV-Vis透射光谱图。
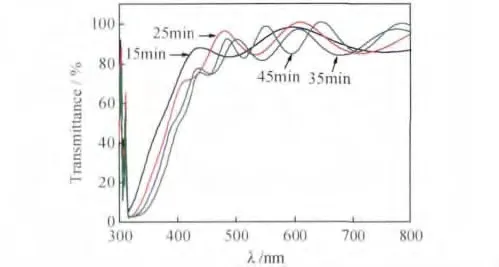
图7 溅射时间不同的ITO薄膜UV-Vis透射光谱Fig.7 UV-Vis transmission spectrum of ITO thin films deposited at different working time
由图7可知光谱曲线的振动幅度较大,说明薄膜厚度大,表面粗糙。在可见光蓝光(450nm)的长波方向,薄膜的透过率均在80%以上,蓝光的短波方向,透过率逐渐降低;随着膜厚的增加,光吸收波长逐渐红移,薄膜的禁带宽度逐渐变窄,透光率下降[18]。图8所示,随着溅射时间延长,膜厚增加,方块电阻起初降低明显,后降低缓慢,最小值为15Ω/□。
图8所示为功率、溅射气压一定,不同溅射时间下的ITO薄膜的方块电阻值。

图8 溅射时间不同的ITO薄膜的方块电阻Fig.8 Sheet resistance of ITO thin films deposited at different working time
由图8可知,溅射初期薄膜表面颗粒细而密,光散射小,透过率高,In2O3结构中氧空位少,载流子密度低,方块电阻较大;随着膜厚增加,膜表面粗糙度增大,缺陷增多,形貌不规则,致使光散射增强,透光率降低,但掺杂的Sn4+增多,氧空位增多,载流子密度增大,方块电阻减小。
2.3.3 衬底温度对薄膜光电性能的影响
图9所示为功率、压强、溅射时间一定,不同衬底温度下的ITO薄膜的UV-Vis透射光谱图。
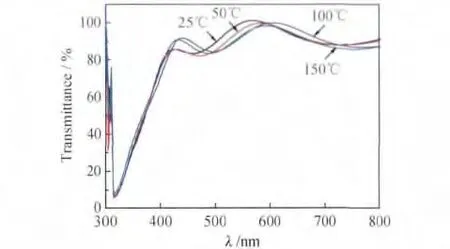
图9 衬底温度不同的ITO薄膜UV-Vis透射光谱Fig.9 UV-Vis transmission spectrum of ITO thin films deposited at different substrate temperatures
由图9可知随着衬底温度升高,薄膜的透光率逐渐增大,光谱曲线的振幅较为平缓,说明高温致使膜表面晶化程度提高,更平整、致密;在蓝光长波方向,薄膜的透过率均在80%以上;在紫外光处,薄膜的短波吸收边没有移动。
图10所示功率、气压、溅射时间一定,不同衬底温度下的ITO薄膜的方块电阻值。

图10 衬底温度不同的ITO薄膜的方块电阻Fig.10 The sheet resistance of ITO thin films deposited at different substrate temperatures
由图10可知,随着衬底温度升高,薄膜方块电阻逐渐降低,后趋于平缓,最小值为22.5Ω/□。当衬底温度较低时,膜中缺陷以及残余气体较多,薄膜未完全晶化,O-4含量较少,Sn4+不稳定,易变价形成Sn2+,使得定量掺杂10%的Sn4+含量降低,致使方块电阻变大;而低价锡氧化物呈黑色,也影响了薄膜的透过率[12]。当温度较高时,有利于溅射粒子与衬底间的相互扩散,除去膜中残余气体,减少缺陷。但过高的温度,一方面造成薄膜晶粒粗大,与衬底之间热膨胀系数差异变大,热应力增高,劣化薄膜性能[17];另一方面柔性衬底耐热性差,无法在高温下完成溅射,150℃接近衬底承受的极限温度,所得薄膜光电性能最佳。
3 结论
(1)方块电阻随溅射气压的增加先减小后增大,随溅射时间延长、衬底温度升高均减小;可见光透过率随溅射时间的延长而降低,衬底温度的升高而增大,不受溅射气压变化的影响。
(2)最佳工艺参数下,柔性ITO薄膜的电阻率为4×10-4Ω·cm,可见光透过率为85%。
[1]王树林,夏冬林.ITO薄膜的制备工艺及进展[J].玻璃与搪瓷,2004,32(5):51-54.WANG S L,XIA D L.Fabrication techniques and development of ITO film [J].Glass & Enamel,2004,32(5):51-54.
[2]LIN Y C,LI J Y,YEN W T.Low temperature ITO thin film deposition on PES substrate using pulse magnetron sputtering[J].Applied Surface Science,2008,254(11):3262-3268.
[3]HICHOU A EI,KACHOUANE A,BUBENDORFF J L,etal.Effect of substrate temperature on electrical,structural,optical and cathodoluminescent properties of In2O3-Sn thin films prepared by spray pyrolysis[J].Thin Solid Films,2004,458(1-2):263-268.
[4]GEORGE J,MENON C S.Electrical and optical properties of electron beam evaporated ITO thin films[J].Surface and Coatings Technology,2000,132(1):45-48.
[5]ALAM M J,CAMERON D C.Optical and electrical properties of transparent conductive ITO thin films deposited by sol-gel process[J].Thin Solid Films,2000,377-378:455-459.
[6]KIM H,HORWITZ J S,KUSHTO G P,etal.Indium tin oxide thin films grown on flexible plastic substrates by pulsed-laser deposition for organic light-emitting diodes[J].Applied Physics Letters,2001,79(3):284-286.
[7]KIM Y S,PARK Y C,ANSARI S G,etal.Influence of O2admixture and sputtering pressure on the properties of ITO thin films deposited on PET substrate using RF reactive magnetron sputtering[J].Surface and Coatings Technology,2003,173(2-3):299-308.
[8]赵佳明,边继明,孙景昌,等.柔性聚酰亚胺(PI)衬底上ITO薄膜的生长及其透明导电性能影响机制研究[J].功能材料,2011,42:644-647.ZHAO J M,BIAN J M,SUN J C,etal.Growth and transparent conductive properties of ITO films on flexible polyimide(PI)substrates[J].Journal of Functional Materials,2011,42:644-647.
[9]LIN Y C,SHI W Q,CHEN Z Z.Effect of deflection on the mechanical and optoelectronic properties of indium tin oxide films deposited on polyethylene terephthalate substrates by pulse magnetron sputtering[J].Thin Solid Film,2009,517(5):1701-1705.
[10]肖定全,朱建国,朱基亮,等.薄膜物理与器件[M].北京:国防工业出版社,2010.
[11]辛荣生,林钰,贾晓林.工艺条件对柔性衬底ITO薄膜光电性能的影响[J].电子元件与材料,2009,28(6):43-45.XIN R S,LIN Y,JIA X L.Effect of technological conditions on the electrical and optical properties of flexible ITO films[J].E-lectronic Components and Materials,2009,28(6):43-45.
[12]王军,成建波,饶海波,等.磁控溅射低阻ITO薄膜的气体参数优化[J].压电与声光,2007,29(1):115-117.WANG J,CHENG J B,RAO H B,etal.Optimizing gas parameters of low-resistance ITO films prepared by DC magnetron sputtering[J].Piezoelectectrics & Acoustooptics,2007,29(1):115-117.
[13]余焜.材料结构分析基础[M].北京:科学出版社,2010.
[14]袁红梅,林祖伦,陈文彬,等.溶胶-凝胶法制备ITO薄膜及光电性能的研究[J].电子器件,2010,33(1):5-9.YUAN H M,LIN Z L,CHEN W B,etal.Electrical and optical properties of ITO films prepared by the sol-gel method[J].Chinese Journal of Electronic Devices,2010,33(1):5-9.
[15]罗飞,王锦鹏,陶春虎,等.化学液相沉积制备PbSe薄膜生长过程及其性能研究[J].航空材料学报,2011,31(2):33-36.LUO F,WANG J P,TAO C H,etal.Study of deposition process and properties of PbSe films grown by chemical liquid deposition[J].Journal of Aeronautical Materials,2011,31(2):33-36.
[16]祁洪飞,刘大博.薄膜生长工艺对TiO2基紫外探测器光电性能的影响[J].航空材料学报,2011,31(5):47-50.QI H F,LIU D B.Effect of growth technology of TiO2film on photoelectronic properties of TiO2UV detector[J].Journal of Aeronautical Materials,2011,31(5):47-50.
[17]梁继然,胡明,阚强,等.晶粒尺寸对氧化钒薄膜电学与光学相变特性的影响[J].材料工程,2011,(4):58-63.LIANG J R,HU M,KAN Q,etal.Effects of grain size on resistance and transmittance transition of vanadium oxide thin film[J].Journal of Materials Engineering,2011,(4):58-63.
[18]卢进军,刘卫国.光学薄膜技术[M].西安:西北工业大学出版社,2005.
