锑基二类超晶格中波红外焦平面探测器技术
2014-06-12马文全张燕华邢伟荣
巩 锋,马文全,谭 振,刘 铭,王 亮,张燕华,邢伟荣
(1.华北光电技术研究所,北京100015;2.中国科学院半导体研究所,北京100083)
锑基二类超晶格中波红外焦平面探测器技术
巩 锋1,马文全2,谭 振1,刘 铭1,王 亮1,张燕华2,邢伟荣1
(1.华北光电技术研究所,北京100015;2.中国科学院半导体研究所,北京100083)
InAs/GaSbⅡ类超晶格以其特有的量子效率高、暗电流小、能带结构可调等材料性能和器件优势,成为第三代红外探测器技术的最佳选择之一。本文报道了中波InAs/GaSbⅡ类超晶格材料的设计、生长、器件工艺技术,制备出了高性能的128×128中波InAs/GaSbⅡ类超晶格红外焦平面探测器,像元暗电流密度降到1.8×10-7A/cm2,量子效率达36.64%。
InAs/GaSbⅡ类超晶格;128×128;像元暗电流密度;量子效率
1 引 言
三代红外焦平面器件向着大规模高性能、双多色探测、低成本方向发展。目前主流的碲镉汞红外探测器[1]由于Hg-Te键较弱,易形成Hg空位;隧穿电流大、俄歇复合速率高;用于甚长波红外探测的高Hg组分HgCdTe材料生长大面积成分控制困难、均匀性差,限制了其在更大规模高性能、双多色探测、低成本焦平面方向的快速发展和应用。
锑基Ⅱ类超晶格红外探测材料具有独特的“破带隙”能带结构,使得Ⅱ类超晶格材料具有以下优点[2-3]:量子效率高,带间跃迁,可以吸收正入射,缩短了焦平面探测器的积分时间,响应时间快;暗电流小,通过调节应变及其能带结构,使轻重空穴分离大,降低了俄歇复合及相关的暗电流;电子有效质量大,是碲镉汞的三倍,隧穿电流小,尤其在甚长波可获得高的探测率(如图1);带隙可调,响应波长从3μm到30μm可调;双色Ⅱ类超晶格器件全部外延层的厚度不到双色碲镉汞器件的三分之一,这给材料生长和器件工艺带来许多便利,具有更好的光谱调节能力和像元均匀性;基于Ⅲ-Ⅴ族材料生长技术,大面积材料均匀性好、成本低。因此,美国西北大学的M.Razeghi以及波兰军事科学院的A.Rogalski等预言InAs/GaSb II型超晶格材料将是下一代红外探测器的首选材料[4-5]。
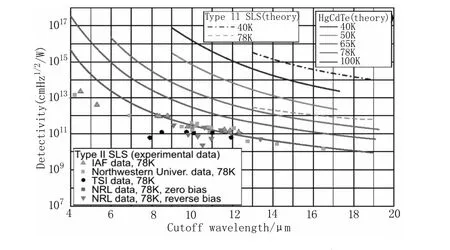
图1 TypeⅡ和P-on-n型HgCdTe理论探测率对比
2 实 验
采用中科院半导体所设计、生长的中波PIN型Ⅱ类超晶格材料,突破了InAs/GaSbⅡ类超晶格表面钝化、低损伤刻蚀、欧姆电极制备和GaSb衬底的减薄去除等关键工艺技术,制备出性能较好的128× 128中波InAs/GaSbⅡ类超晶格红外焦平面探测器。
3 关键技术分析与讨论
3.1 中波InAs/GaSbⅡ类超晶格材料制备
基于量子力学的薛定谔方程和包络函数方法的理论基础,通过使用传输矩阵算法(TMM)和八带KP算法进行Ⅱ类超晶格材料响应波长和吸收效率的模拟仿真;通过改变超晶格各层厚度、超晶格周期数及增加GaInSb中的In组分,增大电子-空穴波函数的交叠,设计中波Ⅱ类超晶格红外探测器的材料结构。材料结构与带隙和晶格失配的关系:图2(a)为GaSb层从6单分子层到20单分子层;InAs层从4单分子层到20单分子层变化的相应带隙结果。图2(b)为相应结构的晶格失配情况,在模拟计算中均假设使用两个相同的InSb界面。

图2 计算得到的能带结构与应力分析结果
以GaSb为衬底材料,采用分子束外延技术进行中波Ⅱ类超晶格材料生长,工艺核心是生长温度、V/III束流比及InAs/GaSb超晶格GaAs型界面与InSb型界面的选择控制,严格控制各源快门的打开顺序及V族源的所谓soak时间。图3、4为中波Ⅱ类超晶格材料透射电镜层界面图及X射线双晶衍射图,材料质量较高。
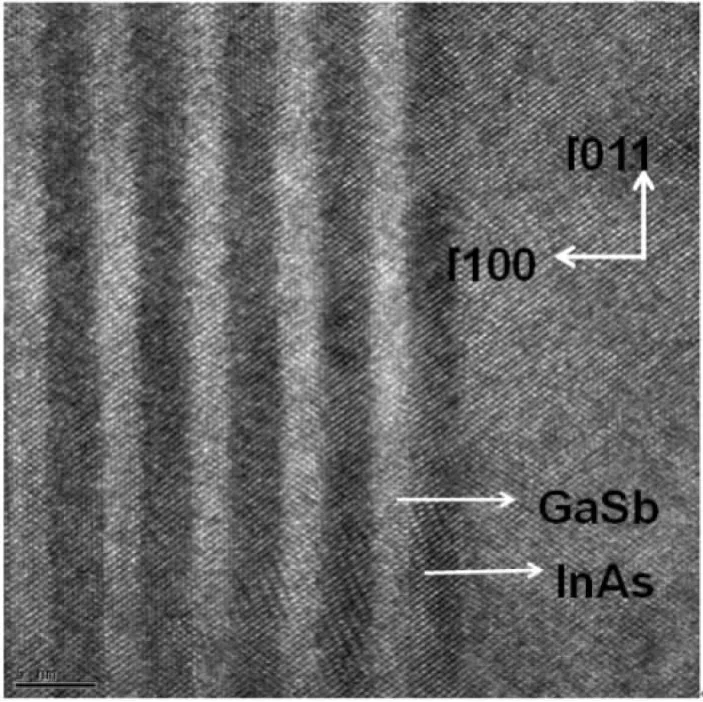
图3 中波Ⅱ类超晶格材料高分辨率TEM

图4 中波Ⅱ类超晶格材料结构XRD曲线
3.2 表面钝化
表面漏电流是暗电流的主要来源。引起表面泄漏电流增大的原因如下:
制作台面过程中,侧壁是暴露在空气中的,从而形成自然氧化物,比如氧化铟、氧化镓、氧化锑等,而氧化镓是很好的导体材料,从而形成了表面泄漏电流通道;空气中的一些离子可能被吸附到表面,形成氧化物。这些氧化物在表面产生表面能级,使得表面能带弯曲,从而形成泄漏电流;自由表面的存在使其周期性在表面出发生中断,引起了附加能级即表面态。表面的缺陷也将产生表面能级。表面的中断,断键在表面产生陷阱。这些陷阱在半导体的禁带里形成能级,使得费米能级钉扎在禁带中央。
表面泄漏电流增大,导致了总体的暗电流的增加,其表现为微分电阻与面积乘积(R0A)的减少。随着探测带隙减少,特别当器件尺寸变小时,表面泄漏电流成为限制探测器性能的一个最主要的因素。
根据超晶格器件表面漏电流产生机理,采用SiON材料进行器件表面钝化来抑制表面漏电流,效果良好,可将R0A提高大约13倍。
3.3 低损伤刻蚀
为了获得高均匀性、低图形失真以及低损伤、底部光滑、化学成分稳定的Ⅱ类超晶格刻蚀表面,刻蚀工艺中需要解决高均匀性、刻蚀形貌及刻蚀损伤控制问题。采用干湿结合的方法进行InAs/GaSbⅡ类超晶格面阵探测器芯片台面刻蚀。
先采用干法刻蚀刻出台面,再使用湿法腐蚀去除干法刻蚀损伤,辅以扫描电子显微镜(SEM)、台阶仪和原子力显微镜的方法对各种腐蚀液或刻蚀方法所能得到的表面形貌进行研究,优化干法刻蚀工艺参数,改进腐蚀液配比和浓度,获得了表面光亮、平整,侧壁起伏较小的刻蚀台面。
3.4 欧姆电极制备
欧姆接触工艺使用传输线模型研究P型GaSb、N型InAs以及P型N型超晶格的欧姆接触电极体系选择与制备工艺。采用Ti/Au、Ti/Pt/Au体系作为重掺接触层的电极体系,Au/Ge/Ni及相关金属体系作为非重掺接触层的电极体系。优化热蒸发沉积工艺、各层厚度以及合适的热处理方法获得较低的接触电阻,实现良好的欧姆接触,如图5所示。

图5 128×128中波Ⅱ类超晶格探测器像元SEM图
3.5 GaSb衬底的减薄去除
由于GaSb衬底对探测波段的红外光有较强吸收,且GaSb材料与Si的热膨胀系数差异等问题,因此为了提高器件量子效率,需在倒装互连后进行底部填充及衬底减薄去除。项目组将底部填充后的探测器混成芯片首先进行机械磨抛将衬底减薄至100 μm左右;然后利用化学机械磨抛的方法将衬底减薄至20μm左右,最后通过湿法腐蚀的方法把衬底完全去除(如图6所示),提高探测器量子效率。

图6 互连后底部填充及衬底去除工艺示意图
4 探测器性能
采用上述材料结构和器件工艺制备了50μm中心距128×128中波InAs/GaSbⅡ类超晶格焦平面探测器,峰值波长为4.18μm,量子效率达到36.64%,像元暗电流密度为1.8×10-7A/cm2,并初步进行了成像演示验证,如图7所示。

图7 中波128×128 InAs/GaSb二类超晶格红外探测器光谱曲线及成像照片
5 结 论
采用中科院半导体所设计、生长的中波PIN型Ⅱ类超晶格材料,通过对表面钝化、低损伤刻蚀、欧姆电极制备和GaSb衬底的减薄去除等关键工艺技术的研究,制备出性能较好的128×128中波InAs/GaSbⅡ类超晶格红外焦平面探测器。像元暗电流密度、量子效率与目前国际先进水平相当,并初步经成像演示验证,性能良好。
[1] Rogalski A.Infrared detector:an overview[J].Infrared Physics&Technology,2002,43:187-210.
[2] Shi Yanli.Type-ⅡInAs/GaInSb superlattices infrared detectors-one of the best choices as the third generation infrared dtectors[J].Infrared Technology,2011,33(11):621-638.(in Chinese)史衍丽.锑基Ⅱ类超晶格红外探测器—第三代红外探测器的最佳选择[J].红外技术,2011,33(11):621-638.
[3] Xu Zhicheng,Chen Jianxin,He Li.Background concentration measurement of GaSb-based InAs/GaSb type-Ⅱsuperlattice[J].Laser&Infrared,2012,42(1):45-50.(in Chinese)徐志成,陈建新,何力.GaSb基的InAs/GaSbⅡ类超晶格背景载流子浓度的测量[J].激光与红外,2012,42(1):45-50.
[4] M Razeghi,E K-w Huang,B-M Nguyen,et al.Type-Ⅱantimonide-based superlattices for the third generation infrared focal plane arrays[C].Proceedings of the SPIE,2010,7660:76601F.
[5] Rogalski A,Antoszewski J,Faraone L.Third-generation infrared photodetector arrays[J].JAppl Phys,2009,105(091101):1-44.
Research on Sb-based type-Ⅱsuperlattice MW infrared focus plane array
GONG Feng1,MAWen-quan2,TAN Zhen1,LIU Ming1,WANG Liang1,ZHANG Yan-hua2,XINGWei-rong1
(1.North China Research Institute of Electro-Optics,Beijing 100015,China;2.Institute of Semiconductors,Chinese Academy of Sciences,Beijing 100083,China)
Owing to the excellentmaterial performance and device advantage of InAs/GaSb Type-Ⅱsuperlattice such as high quantum efficiency,low dark current and adjustable energy band structure,it has been one of the best choice for the third-generation infrared focal plane arrays detector.Material design,material growth and device technology of MW InAs/GaSb Type-Ⅱsuperlattice are reported.High performance 128×128 MW focal plane arrays were fabricated.Dark current density is 1.8×10-7A/cm2and quantum efficiency reaches 36.64%.
InAs/GaSb type-Ⅱsuperlattice;128×128;pixel dark current density; quantum efficiency
TN214
A
10.3969/j.issn.1001-5078.2014.03.07
1001-5078(2014)03-0258-03
巩 锋(1978-),男,高级工程师,硕士,主要从事HgCdTe及InSb材料的研究。E-mail:wuxiang2005@aliyun.com
2013-08-06;
2013-08-31
