具有多MO 喷嘴垂直MOCVD 反应腔外延层厚度均匀性的优化理论及应用*
2024-03-19李建军崔屿峥付聪乐秦晓伟李雨畅邓军
李建军 崔屿峥 付聪乐 秦晓伟 李雨畅 邓军
(北京工业大学,光电子技术教育部重点实验室,北京 100124)
金属有机物化学气相淀积(metal organic chemical vapor deposition,MOCVD)作为异质结半导体材料外延的关键手段,其外延层厚度均匀性会直接影响产品的良率.本文将理论与实验相结合,针对3 个MO 源喷嘴的垂直反应腔MOCVD,将各MO 源喷嘴等效为蒸发面源,并引入一等效高度来涵盖MOCVD 的相关外延参数,建立外延层厚度与各MO 源喷嘴流量间的定量关系,设计并利用EMCORE D125 MOCVD 系统外延生长了AlGaAs 谐振腔结构,根据实验测得的外延层厚度分布结果,利用最小二乘法对模型参数进行了拟合提取,基于提取的模型参数,给出了优化外延层厚度均匀性的方法.4 in (1 in=2.54 cm)外延片mapping 反射谱的统计结果为,腔模的平均波长为651.89 nm,标准偏差为1.03 nm,厚度均匀性达到0.16%.同时外延生长了GaInP 量子阱结构,4 in 外延片mapping 荧光光谱的统计结果为,峰值波长平均值为653.3 nm,标准偏差仅为0.46 nm,厚度均匀性达到0.07%.本文提出的调整外延层厚度均匀性的方法具有简单、有效、快捷的特点,且可以进一步推广至具有4 个MO 喷嘴以上的垂直反应腔MOCVD 系统.
1 引言
20 世纪60 年代Manasevit[1]提出了金属有机物化学气相淀积(metal organic chemical vapor deposition,MOCVD)外延技术,他在蓝宝石衬底上进行了不同III-V 族材料的异质结外延生长,但当时的外延层质量远远低于液相外延(liquid phase epitaxy,LPE)和氯化物气相外延(Cl-vapor phase epitaxy,Cl-VPE)技术生长的外延层质量[2].随着MOCVD 的原材料纯度的提高、生长工艺的改进,逐渐引起人们的兴趣并进行了广泛的研究,如今MOCVD 技术已成为异质结晶体管(heterojunction bipolar transistor,HBT)、发光二极管(light emitting diodes,LED)、激光二极管(laser diodes,LD)、光探测器(photon detectors,PD)和太阳能电池等异质结半导体器件制备的关键性技术[3–7].近年来,由于半导体器件向着微型化、集成化发展,对于大面积生长的外延层质量有着更高的要求.2021年,Wang 等[8]对化学气相沉积反应的过程进行分析,并总结了制备大面积二维材料的调控方法;2022年,Liu 等[9]对二维单晶材料表面纳米级调控进行了归纳总结.所以,对于异质结半导体器件,其外延层厚度的精确控制至关重要.例如:1) 对于以量子阱(quantum well,QW)为有源区的LD 来说,QW 的阱区厚度会影响阱中子能级的位置[10],进而改变子能级间的跃迁波长,即LD 的激射波长;2) 对于垂直腔面发射激光器(vertical cavity surface emitting laser,VCSEL)外延层厚度不但会影响QW 有源区的波长,还会决定其腔模波长及分布式布拉格反射镜(DBR)的峰值反射波长,这三个波长如不能很好地匹配,器件的性能不仅会降低甚至可能不激射[11];3) 对于HBT 来说,基区的厚度会影响器件的增益特性和频率特性[12].因此,不论是研发阶段对样品结果一致性的要求,还是规模化生产中对高成品率、低成本的要求,都希望外延片的厚度均匀性越高越好,以保证同批次各分立器件的性能一致.
为提高外延层厚度均匀性,两大主流MOCVD设备厂商都对系统的核心反应腔部分进行了独特设计.德国AIXTRON 公司采用的是行星卫星式衬底托盘的水平反应腔结构[4,13],在外延过程中,各衬底片不但在子托盘上自转,各子托盘还在整个大盘上进行公转,从而使外延片的均匀性大为提高.美国VEECO(前EMCORE)公司采用的则是垂直反应腔结构[14,15],通过多个MO 源喷嘴的流量匹配及高速旋转的衬底托盘,实现沿托盘径向的外延层厚度调控.
相比而言,VEECO 公司的MOCVD 系统的生产效率高、后序维护成本低.之前,我们曾利用Fluent 流体动力学软件对垂直反应腔内部的气流场和温度场进行了模拟[16,17],结果表明,该方法在宏观层面上对于优化温度、气流量、衬底转速和压强等条件的匹配是有效的.然而,实际的MOCVD外延是一个复杂的过程,理论模拟只能给出一个优化的趋势,当需要在微观层面上精确到纳米量级调控厚度均匀性时,该方法是无能为力的.另外,利用Fluent 软件模拟的另一个问题是计算工作量大,特别是涉及精确的三维模拟时,计算量更大.更进一步,对于具有多个MO 喷嘴的垂直反应腔,虽然设备商提供了通过调节各MO 喷嘴流量来提高厚度均匀性的手段,然而到目前为止,对于如何具体调整各MO 源喷嘴流量来提高外延层厚度的均匀性,相关的理论和实验方法都未见专门的报道.
本文针对多MO 喷嘴垂直MOCVD 反应腔的外延层厚度均匀性问题,结合Holland 和Steckelmacher 的真空蒸镀沉积理论[18],将各MO 喷嘴等效为一蒸发面源,首先建立了各MO 喷嘴流量与外延层厚度的理论模型,并将理论与实验相结合,利用最小二乘法提取相关模型参数,之后针对厚度均匀性给出了优化各MO 喷嘴流量的方法.该方法简单、高效且易于实施.
2 理论模型
为了从理论上得到外延层厚度与MO 源流量间的关系,建立了具有多个III 族MO 源喷嘴的垂直MOCVD 反应腔简化模型,如图1 所示.主载气H2,V 族氢化物和III 族MO 源从顶部的法兰注入反应室,在主载气的推送及下游真空泵抽取的作用下,V 族和III 族源被输运到位于加热托盘的衬底上方发生化学反应,进而在衬底上实现材料的外延生长.为了对外延材料的厚度均匀性进行控制,MO 源在顶部法兰处沿径向被分配给3 个喷嘴,距法兰中心O'的距离分别为yin,ymid和yout,流经各喷嘴的气体流量(包括MO 源和载气H2)分别为Min,Mmid和Mout.另外,衬底托盘绕OO'轴高速旋转.针对图1 所示反应腔模型,在材料外延过程中做如下假设:
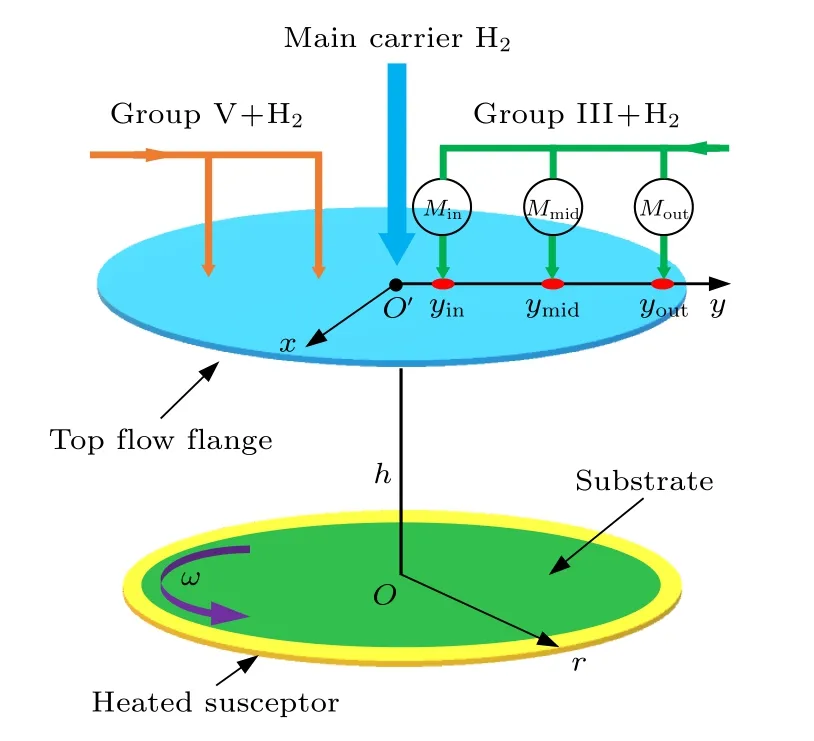
图1 一种多个Ⅲ族MO 喷嘴垂直MOCVD 反应腔的简化模型Fig.1.Simplified chamber model of the vertical MOCVD reactor with multiple group III MO injectors.
1) 所有外延参数(衬底温度、反应室压力、主载气流量、V 族源流量、III 族源流量、衬底托盘转速等)保持不变;
2) 衬底温度控制在质量流量控制区,即外延层的生长速率受控于输运到衬底的反应剂的量;
3) 通过主载气流量、反应室压力及衬底托盘转速的合理匹配,反应室中的气流场为线流形式,不存在涡流,即V 族源和III 族源的反应只发生在衬底表面;
4) V/III 比足够高,外延速率只决定于III 族MO 源的流量;
5) 对于流经各MO 喷嘴在衬底托盘上的MO 源分布,可用一蒸发面源来等效各MO 喷嘴,即MO 源在衬底表面服从余弦分布[18,19].
由于衬底托盘高速旋转,衬底上外延层的厚度t仅与径向半径r有关.根据假设2)—4),t的大小仅决定于III 族MO 源在衬底表面的分布,进一步根据假设5),当MO 源仅流经第i(i=in,mid,out)个MO 喷嘴,而其他MO 喷嘴的流量为零时,衬底表面外延层的归一化厚度为
式中,ti(r) 是由流经第i个喷嘴的MO 源在r点产生的外延层厚度;h是顶部法兰到衬底表面的高度.需要说明的是,是一归一化的无量纲量,仅决定于反应腔的结构参数h和yi.当r=0时,=1.
实际上,图1 所示的MOCVD 反应腔比蒸发系统的腔体要复杂得多,体现为: MOCVD 的衬底温度、反应室压力以及托盘旋转速度更高,高速旋转的托盘会产生泵吸效应[20],且MOCVD 还有V 族源、分载气以及大量主载气流入反应室,另外从各喷嘴注入的MO 源对反应室内的气流场也会产生扰动.为此,对(1)式的常规蒸发模型进行修正,将h用一等效高度heff进行替换,修正后的(1)式改写为
需要强调的是,heff隐含了所有MOCVD 外延参数的作用,如衬底温度、反应室压力、衬底转速、V/III比,主载气流量等,任何参数的改变都会引起heff的改变.根据假设(1),在外延过程中,由于所有外延参数保持不变,因此heff是一常数.
以典型的EMCORE D125 MOCVD 系统为例,衬底托盘的直径为125 mm,表1 给出了(2)式中其他的反应腔结构参数.当heff=27 mm时,图2 给出了各曲线,r的最大值为50 mm,相应于4 in 衬底的半径.可以看出,流经喷嘴in 的MO源主要分布在托盘的中心处,流经喷嘴out 的MO 源主要分布在托盘边缘处,而由喷嘴mid 注入的MO 源则分布在峰值r=27.5 mm 的附近.不管怎么说,流经任一喷嘴的MO 源对托盘上任何位置r处的外延层厚度都会产生影响,因此,外延片上各点的外延层厚度受控于各个MO 源喷嘴流量的相对大小.

表1 EMCORE D125 MOCVD 腔室的结构参数Table 1.Structure parameters of the EMCORE D125 MOCVD chamber.
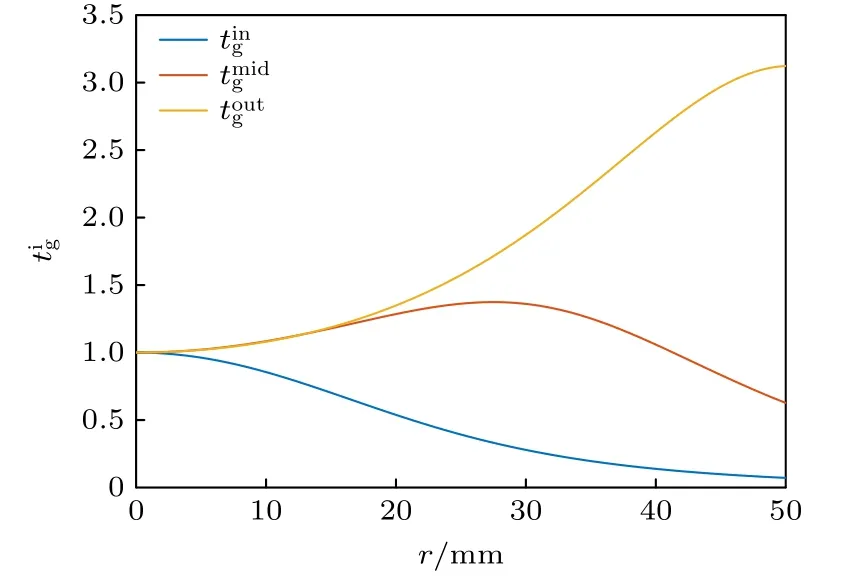
图2 对应于每个MO 喷嘴的相对外延层厚度Fig.2.Relative epitaxial layer thickness corresponding to each MO injector.
在实际外延过程中,MO 源将会流经三个MO 源喷嘴,因此外延层的总厚度t表示为
其中,ti是流经第i个喷嘴的MO 源对外延层厚度的贡献;Mi是流经第i个MO 源喷嘴的气流量,单位是sccm;αi是对于第i个喷嘴,气体单位流量产生的r=0 处的外延层厚度,单位是nm/sccm.αi与MO 源转化为外延层的效率有关,并与外延时间成正比.
根据(2)式和(3)式,决定外延层厚度的参数可分为三类: 1) 反应腔结构参数yin,ymid和yout.对于已制备好的反应腔,这些参数是不能改变的.2) 外延过程关联参数αin,αmid,αout和heff.外延条件(温度、压力、V/III 比、衬底转速、主载气流量、生长时间等)确定后,这些参数也是基本不变的.3) 工艺参数Min,Mmid和Mout.通过调整这些参数的相对大小,可实现外延层厚度均匀性的控制.当上述三类参数都确定后,即可由(3)式求得外延片上各点的外延层厚度.
3 提取模型参数
根据(2)式和(3)式,反应腔结构参数(yin,ymid和yout)固定后,对于设定的工艺参数Min,Mmid和Mout,如果希望得到外延层的厚度,就必须知道过程关联参数αin,αmid,αout和heff.本节根据实验测得的外延层厚度结果,利用最小二乘法拟合来提取这些关联参数,并给出应用示例.
3.1 通过最小二乘法提取模型参数
外延过程结束后,沿衬底托盘的径向,分别测试N个点rj处的外延层厚度T(rj) (j=1,2,···,N),简记为Tj.根据最小二乘法[21],拟合参数αin,αmid,αout和heff应满足下式:
式中,MIN 表示对于选取的拟合参数αin,αmid,αout和heff,应使得Q的取值为最小.需要注意的是,(4)式中的t(rj) 隐含了拟合参数αin,αmid,αout和heff.
求(4)式中Q的极小值问题可转化为以下四个方程组的求解,
将(4)式代入上述各式,可以很容易地写出各式的具体形式,即
方程组(6a)—(6d)共有4 个方程,且有4 个未知量,因此解是可以确定的.由于(6a)—(6d)式是关于αin,αmid,αout和heff的非线性方程,不容易直接求解,为此,可以将其转化为线性化方程,通过牛顿迭代法进行求解.首先,设定待求解量的初值X0=(注: 上标T 表示矩阵的转置),接着将方程组(6a)—(6d)在X0处进行泰勒级数展开,并忽略二阶以上高次项,得
式中,下标“0”表示各矩阵元应代入相应的初值X0.
根据(8)式求得ΔX=A–1B后,对初值进行如下修正,
式中,箭头表示将左边的量赋予右边的量,箭头右边的X0是新的初值.通过反复求解∆X并利用(10)式对初值进行修正,直到∆X小于规定的精度,最后得到的X0即为方程组(6a)—(6d)的解.
3.2 应用示例
根据3.1 节理论,为了拟合求解αin,αmid,αout和heff,需要知道外延层厚度的精确实验值,为此设计了表2 所列的谐振腔外延结构.该结构由10 对Al0.95G0.05As/ Al0.5G0.5As 下DBR,10.5对Al0.5G0.5As/ Al0.95G0.05As 上DBR,以及夹在二者之间的Al0.95G0.05As 谐振腔组成.DBR 每层的厚度为1/4 波长光程,谐振腔的厚度为1 个波长光程.整个结构外延在GaAs 衬底上.外延生长结束后,通过测试外延片的mapping 反射谱,可以精确测得片内不同位置rj处腔模对应的波长λcj,再用λcj除以腔材料的折射率nc,即可得到外延片上不同位置处 Al0.95Ga0.05As 谐振腔层的厚度Tj.事实上,由于我们关心的是外延层厚度均匀性的问题,因此可以直接将λcj代替Tj带入方程组(6a)—(6d)中,结果只不过是αin,αmid和αout都乘了一个相同的系数nc,对均匀性的拟合结果并不会产生影响.

表2 用于确定外延层厚度的谐振腔结构Table 2.Resonant cavity structure to determine the epitaxial layer thickness.
针对表2 所列结构,利用EMCORE D125 MOCVD 进行了材料的外延生长.由于衬底托盘的直径为12.5 cm,因此选用了4 in 衬底(直径约10.1 cm),并将衬底置于托盘的中心.外延中所用的载气是经钯管纯化后的高纯H2,V 族源是高纯AsH3,III 族源是TMGa 和TMAl.表3 列出了典型的外延参数,sccm 表示每分钟标准毫升.

表3 典型的外延参数Table 3.Typical epitaxial parameters.
在标准状况下,Min,Mmid和Mout分别等于275.5,123.2 和1101.3 mL/min时,外延生长了Bragg cavity#20-2.外延结束后,利 用Philip PLM100 白光光源对外延片进行了反射谱的测试.图3(a)是片子中心点的单点测试结果,由图中测试曲线可以精确得到腔模波长为653.5 nm.进一步对整个外延片进行反射谱的mapping 测试,mapping 的空间步长为2.5 mm,得到外延片上各点的腔模波长,结果显示在图3(b)对应的各点上,由于mapping 点太小,图中数字太小而显示不清楚,为此图3(c)给出了片上各点腔模波长的统计结果,统计过程中,考虑到边缘效应,扣除了外延片边缘附近5 mm 的数据.为明显起见,将图3 中的具体数据列在了表4中,是各点腔模波长的平均值,等于657.9 nm,σ 是λc的标准偏差,等于3.7 nm.σ 越小,λc的均匀性越好,表征均匀性的参数越小,表中值为0.6%.λc(10%)表示所有测试点中有10%的腔模波长小于λc(10%),而λc(90%)表示所有测试点中有90%的腔模波长小于λc(90%).λc(90%)—λc(10%)越小,说明λc的均匀一致性越好.

表4 典型的外延参数Table 4.Typical epitaxial parameters.

图3 Bragg cavity#20-2 样品的反射谱结果(a) 外延片中心点的反射光谱;(b) 腔模波长的mapping 结果;(c) 整个外延片腔模波长的统计结果Fig.3.Reflective spectrum results of Bragg cavity#20-2: (a) Reflective spectrum at wafer center point;(b) mapping results of the cavity wavelength;(c) statistic results of the cavity wavelength for the whole wafer.
根据图3 的mapping 测试结果,沿图3(b)箭头所示径向,从外延片的中心点O开始,逐点读取腔模的波长,并将其等效为外延层厚度的测试值Tj代入方程组(6a)—(6c),拟合求解的结果如图4 所示.实验测试数据与理论拟合值t符合得很好,图中同时给出了相应于各MO 源喷嘴对外延层厚度的贡献.拟合参数αin,αmid,αout和heff的具体数值列在了表4中,通过表中数据可知,流经喷嘴mid 的MO 源的利用效率最高,而流经喷嘴out 的MO 源的利用效率最低.需要强调说明的是,实际反应室的MO 源喷嘴距衬底托盘的距离约为70 mm,而用蒸发面源模型拟合得到的等效高度heff仅为30.45 mm.这是由于heff含概了所有与MOCVD 相关的外延参数的影响,如温度、压力、托盘转速、V/III比,以及载气流量等.

图4 Bragg cavty#20-2 样品的厚度拟合结果Fig.4.Thickness fitting results of Bragg cavty#20-2.
4 优化厚度均匀性
根据表4,Bragg cavity#20-2 的厚度均匀性达到了0.6%,对于普通的边发射LD 或LED 来说,这样的均匀性条件是足够满足的.但是,其λc(90%)与λc(10%)的差为10 nm,这对于VCSEL或RCLED 这样的垂直谐振腔器件来说是不能接受的.因为垂直谐振腔器件的发光波长主要决定于谐振腔的层厚,该层厚度的不均匀将使成品率降低,生产成本提高.为此,本节给出优化外延层厚度均匀性的方法.
4.1 优化理论
根据第3节方法拟合求得αin,αmid,αout和heff之后,为使外延层的厚度尽可能均匀,希望通过调节Min,Mmid和Mout,使片上各点的层厚与平均厚度的偏差越小越好,即
式中,MIN 表示Min,Mmid和Mout的取值应使得F的值最小,tj=t(rj)是rj处外延层的厚度(j=1,2,···,N,N是外延片上的离散点总数),是外延层的平均厚度,结合(3a)式可得
在调整Min,Mmid和Mout的过程中,可固定三个喷嘴的总流量不变,即
其中总流量MT是一常数.将Min和Mmid作为调节量,则Mout=MT-Min-Mmid.因此,(11)式等价为以下方程组的求解:
将(11)式代入(15)式,经过推导化简,可进一步写出关于Min和Mmid的线性化方程组:
式中,各矩阵元为
将拟合参数αin,αmid,αout和heff代入方 程(17a)—(17f)式,再求解(16)式,即可得到优化的三个MO 源喷嘴的流量Min,Mmid和Mout.
4.2 应用示例
基于Bragg cavity#20-2 的拟合参数αin,αmid,αout和heff,将三个MO 源喷嘴的总流量固定为1500 sccm,根据4.1 节的优化理论,得到对应于Min,Mmid和Mout优化值分别为281.3,125.8 和1092.9 sccm,并外延生长了与Bragg cavity#20-2结构相同的Bragg cavity#22,反射谱的mapping测试结果如图5 所示.腔模波长的统计数据也列在了表4中,与Bragg cavity#20-2 比较得到,Bragg cavity#22 的平均 腔模波长由657.9 nm 增加到681.9 nm,这与in 和mid 喷嘴的MO 源利用率高且这两个喷嘴的流量增加有关.让我们振奋的结果是,标准偏差由3.7 nm 降为1.52 nm,均匀性值从0.6%降为0.22%,且λc(90%)—λc(10%)的值由10 nm 降为2 nm.可以说,Bragg cavity#22 的厚度均匀性是完全满足VCSEL 和RCLED 等垂直腔型器件的需求的.拟合参数αin,αmid,αout和heff的变化可能是由于各MO 源喷嘴流量的变化对反应腔内气流场的扰动引起的.

图5 Bragg cavity#22 样品的反射谱结果(a) 腔模波长的mapping 结果;(b) 整个外延片腔模波长的统计结果Fig.5.Reflective spectrum results of Bragg cavity#22: (a) Mapping results of the cavity wavelength;(b) statistic results of the cavity wavelength for the whole wafer.
为了进一步得到用于650 nm RCLED 的DBR的外延条件,将Bragg cavity#22 各层的时间简单乘以650/681.9倍,保持其他条件不变生长了Bragg cavity#23,反射谱的mapping 测试结果如图6 所示,相关统计数据也列在了表5 中.Bragg cavity#23 的平均 腔模波长为651.89 nm,标 准偏差为1.03 nm,厚度均匀性为0.16%,λc(90%)为653 nm,λc(10%)为651 nm,相差2 nm,可以完全满足面向POF 的RCLED 的DBR 外延结构的需求.相比Bragg cavity#22,Bragg cavity#23的heff的变化不大,αin,αmid和αout的减小是由于外延层的时间减小造成的.

表5 650 nm 量子阱外延结构Table 5.Epitaxial structure of 650 nm QW.

图6 Bragg cavity#23 样品的反射谱结果(a) 腔模波长的mapping 结果;(b) 整个外延片腔模波长的统计结果Fig.6.Reflective spectrum results of Bragg cavity#23: (a) Mapping results of the cavity wavelength;(b) statistic results of the cavity wavelength for the whole wafer.
基于优化后的MO 喷嘴流量,生长了表5 所列的650 nm QW 外延结构RCLED QW#69,并利 用PHILIPS PLM100 的532 nm 激光源测试外延片的室温PL 谱.图7 是外延片中心点的PL谱测试结果,峰值波长λp为653 nm,半高宽为20.5 nm.图8 是外延片峰值波长的mapping 结果,统计表明,峰值波长的平均值为653.3 nm,标准偏差仅为0.46 nm,均匀性达到了0.46/653.3=0.07%.λp(90%)和λp(10%)分别为654 和653 nm,二者相差仅1 nm.
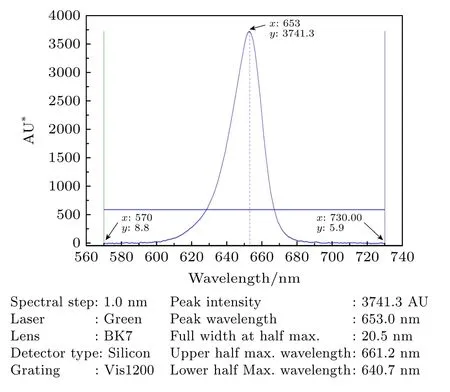
图7 650 nm 量子阱外延片中心点的PL 谱Fig.7.PL spectrum of 650 nm QW at wafer center point.
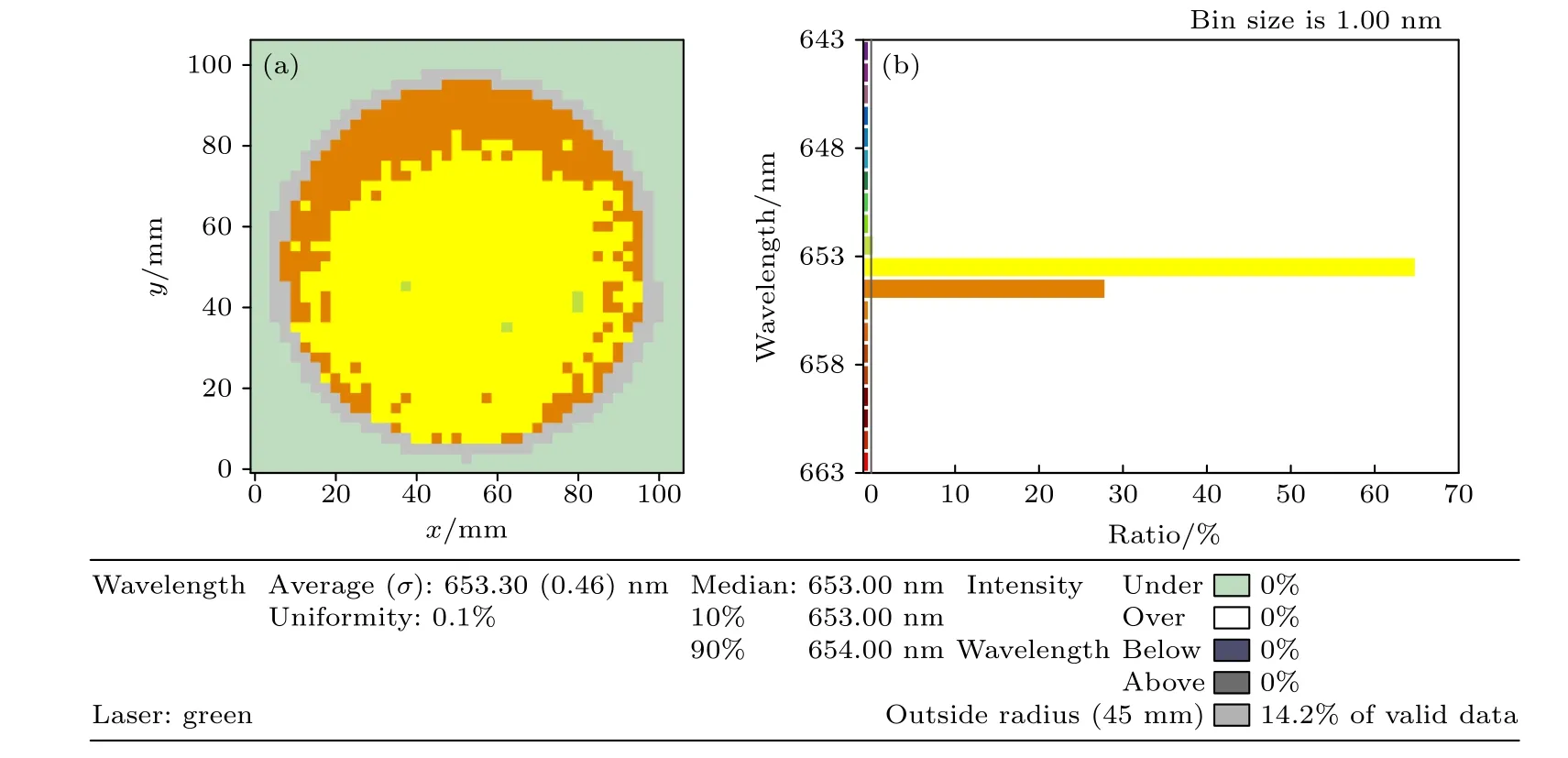
图8 RCLED QW#69 样品的PL 谱(a)峰值波长的mapping 结果;(b) 整个外延片峰值波长的统计结果Fig.8.PL spectrum results of RCLED QW#69: (a) Mapping results of the peak wavelength;(b) statistic results of the peak wavelength for the whole wafer.
需要强调说明的是,设备厂商一般担保的均匀性验收指标中,不论是外延层厚度还是QW 峰值波长,通常只有2%,而利用本文的方法将均匀性指标提高了1 个量级以上.
5 结论
外延层的厚度均匀性是MOCVD 在规模化生产中的一个至关重要的参数.本文针对多MO 源喷嘴垂直MOCVD 反应腔,提出了提高外延层厚度均匀性的有效方法.该方法的关键点包括: 1) 将MO 源喷嘴等效为蒸发系统的余弦型面源,并引入一等效高度来涵盖所有相关的MOCVD 外延参数;2) 与实验相结合,采用最小二乘法对模型参数进行了有效提取;3) 根据提取的模型参数,给出了提高外延层厚度均匀性的有效方法.应用结果表明,4 in 外延片的厚度均匀性达到0.16%,650 nm QW 的PL 峰值波长均匀性达到0.07%.这些结果比设备厂家的验收标准提高了1 个量级.虽然本文中MO 源喷嘴的数目为3个,但是我们相信该模型可以进一步推广至4 个甚至更多个MO 源喷嘴的情形,这有益于规模化生产中良率的提高和生产成本的降低.特别是对于VCSEL 和RCLED 等垂直谐振腔型器件的MOCVD 量产外延,本文的模型方法应为不可或缺.
