SiGe BiCMOS 低噪声放大器激光单粒子效应研究*
2024-03-19李培董志勇郭红霞张凤祁郭亚鑫彭治钢贺朝会
李培 董志勇 郭红霞 张凤祁 郭亚鑫 彭治钢 贺朝会
1) (西安交通大学核科学与技术学院,西安 710049)
2) (西北核技术研究院,强脉冲辐射环境模拟与效应国家重点实验室,西安 710024)
随着CMOS 工艺的日益成熟和SiGe 外延技术水平的不断提高,SiGe BiCMOS 低噪声放大器(LNA)广泛应用于空间射频收发系统的第一级模块.SiGe HBT 作为SiGe BiCMOS LNA 的核心器件,天然具有优异的低温特性、抗总剂量效应和抗位移损伤效应的能力,然而,其瞬态电荷收集引起的空间单粒子效应是制约其空间应用的瓶颈问题.本文基于SiGe BiCMOS 工艺低噪声放大器开展了单粒子效应激光微束实验,并定位了激光单粒子效应敏感区域.实验结果表明,SiGe HBT 瞬态电荷收集是引起 SiGe BiCMOS LNA 单粒子效应的主要原因.TCAD 模拟表明,离子在CMOS 区域入射时,电离径迹会越过深沟槽隔离结构,进入SiGe HBT 区域产生电子空穴对并引起瞬态电荷收集.ADS 电路模拟分析表明,单粒子脉冲瞬态电压在越过第1 级与第2 级之间的电容时,瞬态电压峰值骤降,这表明电容在传递单粒子效应产生的瞬态脉冲过程中起着重要作用.本文实验和模拟工作为SiGe BiCMOS LNA 单粒子效应抗辐射设计加固提供了技术支持.
1 引言
随着光纤通讯、无线和卫星通讯的发展,SiGe BiCMOS 工艺集成电路在卫星通信、GPS 定位导航、军事雷达以及无线局域网和全球卫星定位系统等领域得到广泛应用,在空间无线通讯领域扮演着越来越重要的角色[1–4].SiGe BiCMOS 电路兼容SiGe 和体硅CMOS 的工艺[2,5],因其优异的线性特性和高频低噪声性能广泛应用于空间射频电路系统[6–11].研究表明,SiGe HBT 作为SiGe BiCMOS 低噪声放大器(LNA)的核心器件,通过调节其基区 Ge 组分梯度能够有效降低因载流子冻结而出现“Freeze-out”现象的温度阈值,实现器件大跨度的工作温度范围[12–16].此外,SiGe HBT器件还天然具有优异的抗总剂量和位移损伤效应的能力[17–21],这些优势使得SiGe BiCMOS LNA电路有可能不再需要体硅电子学系统沉重的保温装置,直接应用于航天器的壳体外部,从而降低发射成本并扩展远程控制功能[22,23].然而研究表明,SiGe BiCMOS 电路对空间单粒子效应非常敏感,表现出不同于体硅工艺的复杂电荷收集机制[24–27].本文针对SiGe BiCMOS LNA 芯片开展了单粒子效应的TCAD 数值模拟,ADS 电路模拟与激光微束实验,实验结果表明,SiGe HBT 是SiGe BiCMOS LNA 电路中单粒子效应的敏感区域,在直流和交流条件下,低噪声放大器对单粒子效应非常敏感,表现出不同于单个SiGe HBT 器件的复杂电荷收集机制.TCAD 数值模拟结果表明,SiGe BiCMOS结构中,单粒子在CMOS 区域呈角度入射时会引起SiGe HBT 集电极的电荷收集现象.ADS 电路模拟表明,在单粒子效应导致的瞬态电压越过第1 级与第2 级之间的电容时,瞬态电压峰值骤降,表明电容在传递单粒子效应产生的瞬态脉冲过程中起着重要作用.
2 单粒子效应数值模拟
2.1 器件级数值模拟
基于TCAD 模拟软件Sentaurus Sprocess 对低噪声放大器进行工艺建模.如图1 所示,器件结构从左至右分别是SiGe HBT,NMOS,PMOS,模型底部为衬底电极.BAG 工艺被采用,SiGe HBT与CMOS 器件的掺杂、离子注入、退火等工艺参数参考TCAD 例程中的相关数据.SiGe HBT 发射极尺寸约为0.26 μm,CMOS 栅长为0.18 μm.SiGe HBT 与CMOS 之间深槽底部距表面为8 μm,起到隔离衬底噪声耦合的作用[28–30].通过Sdevice 与Svisual 模块对HBT 的Gummel 特性以及CMOS的输入输出特性进行了验证.SiGe HBT 单粒子效应研究表明,集电极/衬底结(C/S 结)反偏是最劣偏置条件,因此设置衬底反偏(Substrate=–3 V,其余电极为0 V)作为偏置条件[31–33].Sdevice 模块可提供Heavy Ion 模型,可用于仿真单粒子效应的过剩载流子产生.该模型计算沿离子轨道轴分布的电子-空穴对生成率,通过求解载流子连续性方程和泊松方程,开展重离子入射半导体器件的数值模拟[34–37].(1)式表示电离径迹与入射点距离为l(l小于电离径迹总长度lmax) 的位置的电子空穴对产生率:

图1 TCAD 建立的2D 模型Fig.1.2D model by TCAD.
式中,GLET(l) 是线性能量传递(LET)的生成密度(单位为pairs·cm–3),其值在Sdevice 中通过关键词LET_f 的设置以及文件中相关默认参数计算得出;R(w,l)和T(t) 分别是载流子生成率随空间和时间变化的函数.在文中,载流子随空间的分布既可遵循指数函数也可遵循高斯函数,本文选用高斯分布;载流子随时间的分布T(t) 也遵循高斯分布[37–40].
当离子在不同位置呈不同角度入射时,电离径迹也会相应地发生变化.在TCAD 模拟中,集电极瞬态电流呈正值,衬底呈负值,基极与发射极一般情况下在0 值上下波动.本文统计了集电极瞬态电流峰值,数据如图2(a)所示.离子在SiGe HBT 区域垂直入射时,由“漏斗效应”产生的电子空穴对在偏置电压的作用下向电极迅速漂移,空穴向衬底输运,电子则被扫向集电区域,导致集电极瞬态电流较大.离子在SiGe HBT 区域垂直入射时,深沟槽隔离结构对载流子输运的抑制作用减小了对SiGe HBT 集电极电荷收集的影响,因此峰值远低于在HBT 区域入射.当离子呈角度入射时,如图1 所示,在CMOS 区域入射时电离径迹穿过深沟槽隔离结构,在SiGe HBT 区域产生的电子空穴对,这部分电子空穴对会引起集电极的瞬态电流,最大值约为0.26 mA;在SiGe HBT 发射极呈角度入射时,引发的集电极瞬态电流峰值依旧最大,约为0.83 mA.当离子在CMOS 区域呈角度入射时,最右侧PMOS 漏极区域电流值较大,故在此处改变入射角度并在5°—85°内进行模拟.如图2(b)所示,随着入射角逐渐增大,集电极瞬态电流峰值先增大后减小.入射角为5°时,由于电离径迹经过SiGe HBT 有源区,单粒子效应产生的电子易于被集电极收集,导致集电极瞬态电流峰值较高,约为0.348 mA.其余入射角中,40°时集电极瞬态电流峰值最高,约为0.265 mA.除入射角为5°以外,集电极瞬态电流峰值的变化与电离径迹在SiGe HBT区域的变化一致.入射角大于60°时,电离径迹在SiGe HBT 区域基本无分布,瞬态电流峰值也几乎为零.

图2 SiGe HBT 集电极瞬态电流(a) 垂直与45°;(b) 5°—85°Fig.2.SiGe HBT transient collector currents: (a) Vertical and 45°;(b) 5°–85°.
通过在不同位置进行重离子辐照模拟,分别呈垂直和角度入射,并统计入射瞬间集电极的瞬态电流数据.数据均表明在SiGe HBT 区域入射时,集电极瞬态电流峰值较大,表现出敏感的单粒子效应.相比之下,从CMOS 区域入射引起的集电极瞬态电流在垂直入射时较小,而呈角度入射时集电极瞬态电流峰值有所提高.除5°入射角外,随着入射角的增大,集电极瞬态电流峰值先增加后减小.其中在PMOS 漏极最右侧呈40°入射时表现出较高的单粒子瞬态电流.
2.2 SiGe BiCMOS LNA 电路模拟
基于ADS (Advanced Design System)软件模拟SiGe BiCMOS LNA 电路.该电路采用cascode结构,并在M1 和M4 的源极处添加电感作为负反馈.为了模拟SiGe HBT 在不同位置产生单粒子效应对电路各节点电压的影响,将Sentaurus TCAD仿真得到的瞬态电流时域信号以电流源的形式加载到ADS 仿真电路中,并记录各节点的电压情况进行分析.如图3 所示,正极性信号经过M1 进行反向放大以及MOS 管的源极跟随在输出支路产生负极性信号.另外一支路中,通过M4 进行反向放大,在输出端同样产生负极性信号.最终,有用信号为这两个效应的相互叠加[41].这种设计可以实现信号的放大和反相输出,是常见的LNA(低噪声放大器)电路结构.通过模拟和分析SiGe HBT在不同位置产生单粒子效应对电路各节点电压的影响,评估并改进电路的性能和稳定性.

图3 SiGe BiCMOS LNA 仿真电路图Fig.3.Simulation schematic of SiGe BiCMOS LNA.
SiGe BiCMOS LNA 仿真电路的S参数如图4(a)所示,在频率点1.55 GHz,S11与S22最低可降低至–40 dB 以下,S21为20.14 dB.噪声系数见图4(b),在1.4—1.7 GHz 频率内均低于2 dB.

图4 S 参数与噪声系数仿真结果(a) S 参数 ;(b)输出端噪声系数Fig.4.Simulated results of S-parameters and noise figure:(a) S-parameters;(b) noise figure of output.
在仿真中,将瞬态电流作为电流源添加到图3所示的①—④号位置,模拟了SiGe HBT 在M1—M4 管发生单粒子效应时集电极的瞬态电流,并记录和分析了单管和多管产生单粒子效应时各节点电压的变化.然而,不同的LNA 电路结构、不同的SiGe HBT 入射条件以及LNA 输入信号振幅大小都会对结果产生影响.因此,这里仅对当前数据进行定性分析.仿真结果显示,在脉冲电压通过第一级与第二级之间的电容Cc时,瞬态电压峰值显著降低.而当通过输出匹配电路中的电容Cout时,瞬态电压峰值有所增大.共射管产生的单粒子效应比共基管更显著,而且瞬态电压持续时间更长.当4 个位置同时添加单粒子效应时,输出端的瞬态电压峰值最高,但瞬态电压持续时间明显缩短.此外,在晶体管添加单粒子效应时,输入支路也会产生瞬态电压,从而影响到输入端口.综上所述,仿真结果表明,在SiGe BiCMOS LNA 电路中,电容在传递单粒子效应产生的瞬态脉冲上起着重要作用,特别是第1 级与第2 级之间的电容两端,其瞬态电压变化明显.
3 实 验
3.1 实验样品
实验样品采用西南集成研制的SiGe BiCMOS工艺低噪声放大器XND1108IE,这款芯片是广泛用于GNSS 导航领域的高性价比LNA[42].实验前需通过化学腐蚀方法去除被测器件正面封装使管芯裸露,然后利用直径为1.4 μm 的微束光斑在器件版图中沿着金属布线间隙均匀入射,以确保脉冲激光能够照射到器件灵敏区域内并实现减少脉冲激光能量衰减.图5(a)为芯片开盖后的概貌图,芯片采用DFN6 L 封装并引出6 个引脚,红框内的区域为SiGe HBT 器件的有源区域,采用叉指工艺引出SiGe HBT 电极与其他器件的接触.该芯片适用于1170—1620 MHz 频段的信号接收,工作电压范围为1.5—3.6 V,工作电流为4.7 mA.在高频网络中,等效电压和电流以及相关的阻抗和导纳参数难以测量,矢量网络分析仪则能够测量单端口或双端口射频网络的幅值和相位,并通过相应的计算获得端口反射波和入射波的特征.测试所用矢量网络分析仪(创远仪器T5260C)频率范围为300 kHz—8.5 GHz,最大输出功率范围为–50—10 dBm,可以达到XND1108IE 的测试条件.图5(b)为XND 1108IE 低噪声放大器的S参数测试结果,该结果与器件手册所示的S参数较为一致,说明化学腐蚀正面封装不影响LNA 样品的电学特性.
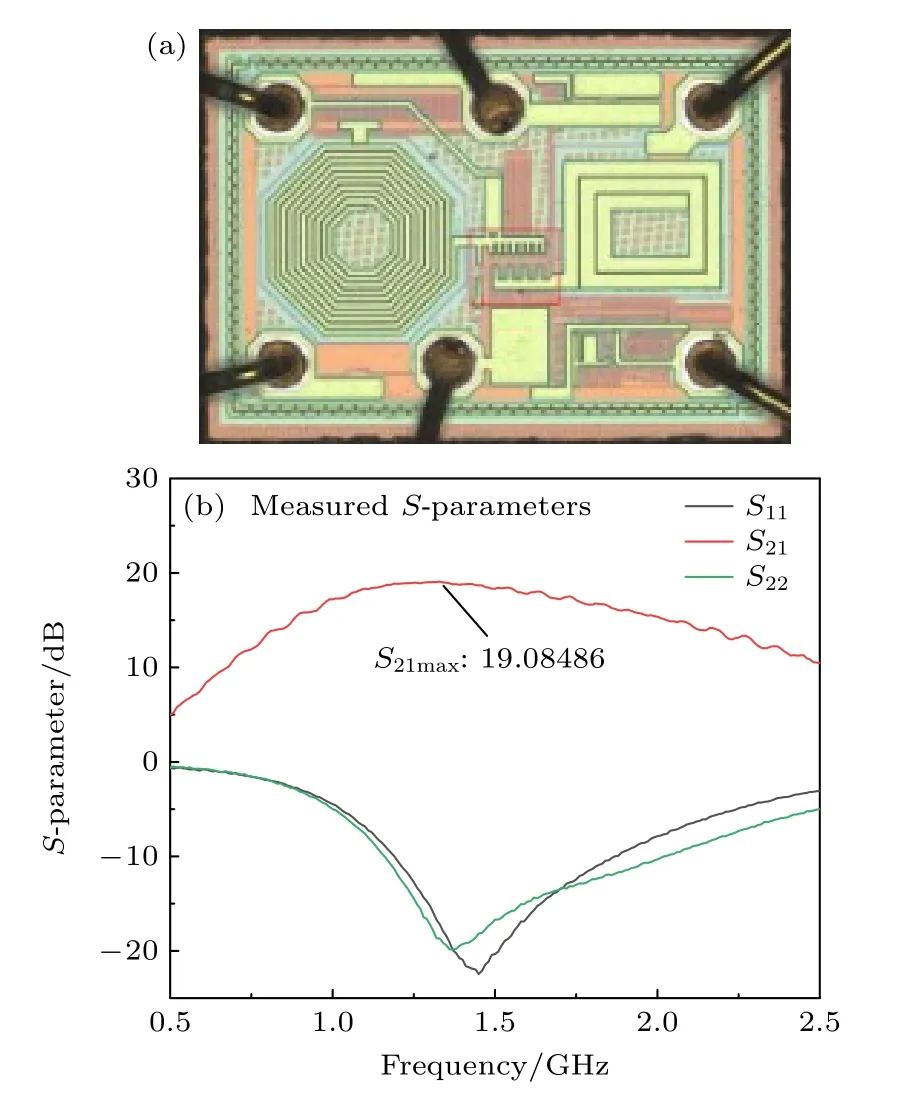
图5 XND1108IE(a)概貌图;(b) S 参数测试结果Fig.5.XND1108IE: (a) Micrograph;(b) measured S-parameters.
为保障高频信号的稳定传输,实验采用与XND1108IE LNA 配套的评估板开展激光单粒子辐照实验,测试板输入输出均为SMA 接口.图6(a)为激光实验的测试电路实物图,该电路由核心器件SiGe HBT、匹配电路和偏置电路组成.图6(b)为测试电路图,当EN ABLE 端口默认悬空上拉到电源电压时,电路工作,接地则关断.C1 为退耦电容,退耦电容由1 μF 与100 pF 并联使用;L1 为匹配电感,9.5 nH 配置适用于1.17—1.62 G 宽带应用,9.1 nH 配置适用于L1 频段窄带应用.PIN1为RFGND,应用时应尽可能地减小PIN1 PCB版上寄生电阻和电感.

图6 评估板与原理图(a) XND1108IE 评估板;(b)评估板原理图Fig.6.Evaluation board and schematic: (a) Evaluation board of XND1108IE;(b) schematic of the evaluation board.
3.2 实验结果与讨论
实验在西北核技术研究所脉冲激光单粒子效应实验平台进行,激光装置主要由Nd:YAG皮秒激光器(PL2210)、聚焦定位系统、控制计算机、机械隔振光学平台等组成,激光波长可选择1064/532 nm.本次采用1064 nm 波长的脉冲激光,使用100 倍放大倍数的聚焦单元物镜,光斑直径为1.4 μm[43].辐照过程中,DC 条件VCC 设置为1.8 V,GND 接地,RF_IN 无输入.当激光垂直入射样品芯片时,从较小的能量(1 nJ)开始辐照芯片,当激光能量达到3 nJ时,在示波器中观测到了LNA 输出信号的瞬态电压.之后采用5 nJ 的激光能量均匀入射样品器件,确定了敏感区域大致范围,并在DC 条件下对一敏感点以不同能量的激光入射,以及敏感区域的密集入射.对于AC 条件下的激光模拟实验,VCC 设置为1.8 V,GND 接地,RF_IN 使用信号发生器接入1200 MHz,–30 dB 的正弦信号.与直流偏置条件下的激光辐照步骤一致,分别进行了不同能量的单发激光脉冲辐照.为了顺利捕捉瞬态电压信号,实验采用高速示波器(Tektronix DPO 71604)通过50 Ω 的同轴电缆与输出端RF_OUT 信号相连进行捕捉,示波器采样频率为50 GHz,阻抗匹配为50 Ω.
电压信号被高速示波器捕捉到后,通过除以50 Ω 的阻抗得到电流信号.如图7(a)所示,在DC 条件下,对样品的同一位置进行不同能量的激光入射,得到RF_OUT 端瞬态电流随时间的变化.激光入射器件后产生电子空穴对,因电子的迁移率普遍高于空穴,故电子率先到达RF_OUT端,产生一个负向的峰,脉冲宽度约为0.3 ns;接着空穴到达,产生正向峰;当激光能量增大时,产生的电子空穴对数量增加,两个峰的电流绝对值随之升高,瞬态电流逐渐恢复正常所需时间也随之增长.

图7 不同能量激光入射时RF_OUT 端时域瞬态电流(a) DC 条件;(b) AC 条件Fig.7.RF_OUT time-domain transient currents with different laser energy: (a) DC conditions;(b) AC conditions.
如图8 概貌图所示,SiGe HBT 有源区域采用叉指工艺,将SiGe HBT 电极与电感等器件接触.脉冲激光通过缝隙入射到SiGe HBT 表面,从而在电路中产生单粒子效应.在直流工作条件下,首先在不同位置使用5 nJ 激光进行入射,观察到当激光脉冲通过缝隙达到SiGe HBT 叉指电极结构区域时,器件表现出显著的单粒子电荷收集效应.
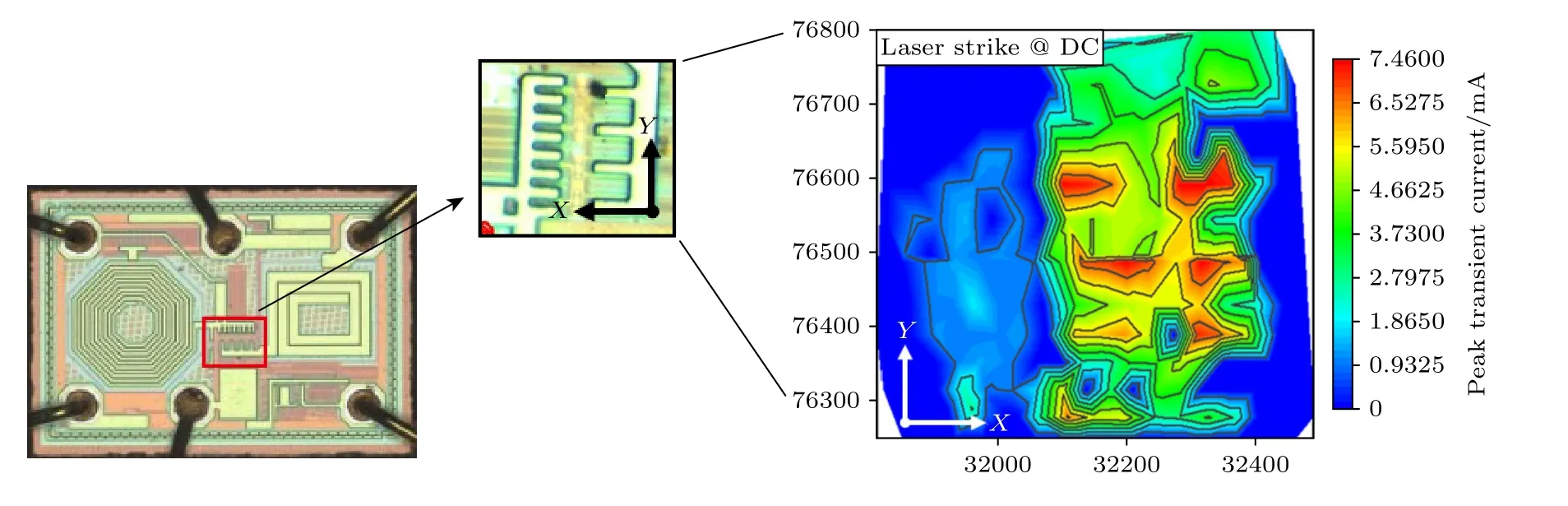
图8 密集入射区域以及该区域瞬态电流峰值分布图Fig.8.Area of dense incidence and the distribution of transient current peaks in the dense incident area.
如图7(b)所示,低噪声放大器工作在交流条件下时,激光单粒子瞬态电流表现出一个下降峰紧跟着一个上升峰,且电流绝对值同样随着能量的增加而升高,之后信号逐渐恢复正常.相较于直流条件,AC 条件下的单粒子效应脉冲电流触发时间与脉冲宽度更加一致,下降的脉冲宽度大约为0.2 ns,能量越高,恢复时间越长.通过比较DC 与AC 条件下入射能量相同时瞬态电流峰值的差值,可以得到AC 条件下激光单粒子效应更加敏感.如图9 所示,大部能量点分表现出AC 条件下瞬态电流峰值更大.

图9 激光能量相同时两种工作条件下峰值的比较Fig.9.Comparison of peak transient current under two operating conditions with the same laser energy.
入射能量在75 nJ 及以上时,如图10 所示,交流条件下的激光单粒子实验还观察到一个值得关注的现象.当激光能量较高时,输出端口信号出现瞬态波形并恢复后会出现信号逐渐衰减的现象,其衰减程度随着激光能量的增大而减弱.对交流条件下的数据进行快速傅里叶变换,通过将时域的数据转化为频域的数据得到了功率谱密度,如图11 所示.可以看出,在1.2 GHz 频率处观察到峰值,能量较低时峰值均约为–120 dB.当能量再升高时,与图10 中的现象相呼应,功率谱密度峰值有所减弱,减弱程度也有所不同.在后续测试中,芯片仍正常工作.这种现象可能是由瞬态电流经过内部电路器件的分压造成,使得非输出路径的分压增大,输出电压降低.
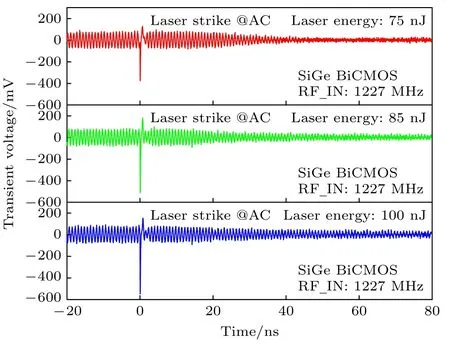
图10 AC 条件下激光能量较高时的瞬态电压随时间的变化Fig.10.Transient voltage with time at high laser energies under AC conditions.

图11 AC 条件下不同能量激光入射时功率谱密度随频率的变化Fig.11.Variation of power spectral density with frequency of laser incident with different energies under AC conditions.
本文针对SiGe BiCMOS 工艺低噪声放大器开展了其单粒子效应的激光微束实验以及器件、电路级模拟,后续将进一步开展SiGe BiCMOS 工艺低噪声放大器的抗辐射加固技术研究.在抗辐射加固技术中,通常采用性价比较高的抗辐射设计加固方法.目前已有研究针对分立SiGe HBT 进行了抗辐射加固设计研究,其中器件级加固方法包括C-B-E SiGe HBT 结构以及反模级联SiGe HBT结构[24,26,44].版图级加固方法则在P 衬底和N+保护环之间增加一反向偏置的PN 结来进行单粒子效应加固[45,46].低噪声放大器是模拟电路,更便于进行器件级与版图级抗辐射加固设计,但SiGe BiCMOS 电路的单粒子效应机理以及加固设计研究相对较少.本文后续将基于已有研究基础,进一步探索SiGe BiCMOS LNA 的抗辐射设计加固方法.
4 结论
针对SiGe BiCMOS 低噪声放大器开展单粒子效应激光微束实验,进行SiGe BiCMOS 电路单元的TCAD 数值模拟仿真以及SiGe BiCMOS LNA电路的ADS 电路模拟仿真,探讨SiGe BiCMOS LNA 电路及其SiGe HBT 器件的空间单粒子效应机理.实验结果表明,低噪声放大器的单粒子效应敏感区域在SiGe HBT 区域,输出端瞬态电流峰值随着激光能量的增加而增大.同时,在交流条件下,低噪声放大器单粒子效应更加敏感,在激光能量较高时出现了输出信号在恢复后减弱甚至消失的现象,该现象可能由瞬态电流经过内部电路器件的分压造成,使得非输出路径的分压增大,输出电压降低.相比于SiGe HBT 分立器件,SiGe BiCMOS电路的单粒子效应电荷收集机制更为复杂.本文SiGe BiCMOS 低噪声放大器单粒子效应激光微束实验以及器件和电路级模拟,为进一步开展其抗辐射加固设计提供了技术支持.
感谢西北核技术研究院给予的激光辐照实验指导和帮助.
