热处理Hastelloy合金基带对生长 NiO 薄膜的影响*
2024-01-27赵新霞吴振宇金艳营黄玉琴谢清连
赵新霞,吴振宇,金艳营,韩 徐,黄玉琴,谢清连
(南宁师范大学 a.物理与电子学院;b.广西高校新型电功能材料重点实验室,广西 南宁 530100)
自发现超导现象以来,高温超导体就因其独特的物理性质和潜在的应用价值成为近几十年来众多科研人员重点关注的一个前沿方向[1].为适应工程应用的需要,超导薄膜需要制作在柔性的金属基带上[2].目前的金属基带主要以 Ni 和 Ni 基合金为主[3],而 Ni 与超导薄膜之间的相容性较差,在 Ni 基带上不能直接制备出性能良好的超导薄膜,因此需要在基带与超导薄膜之间生长兼容性较好的缓冲层来提高超导薄膜的性能[4].本文基于高温超导材料的应用,探究如何在Hastelloy合金基带(无织构的镍基合金)上生长出高温超导薄膜所需要的NiO缓冲层.
Hastelloy合金基带是目前应用最广泛的耐蚀合金材料之一,适用于氧化性、还原性介质中的应用[5].在Ni-Cr-Mo三元材料的基础上添加适量的W、Fe等元素,可以得到一种面心立方结构的合金材料,Hastelloy合金基带便是由这种合金材料加工而成[6,7].目前Hastelloy合金基带主要分为B、C、G三个系列,本文使用的基带是由C-276C系合金材料加工而成,它具有良好的韧性、较高的高温强度、优越的抗腐蚀和抗氧化能力,已在化工、石油和核工业等领域得到了广泛的应用[8].为解决Hastelloy合金基带表面粗糙度大、与超导薄膜之间存在晶格不匹配的问题,本文将基带进行适当的退火处理[9],加速基带表面的氧化,使其表面形成一层连续的NiO薄膜,之后利用射频磁控溅射法在其表面同质外延生长一层NiO缓冲层,该缓冲层可阻挡衬底材料原子在退火结晶过程中与超导薄膜发生化学反应或原子间相互扩散[10],且为超导薄膜的取向生长提供模板.
1 实验
Hastelloy合金基带在生产过程中会受到水蒸气、有机物和灰尘的污染,这些污染物会降低基带表面的脱附能Qdes,从而降低薄膜与基带之间的结合力.因此必须在薄膜制备之前对基带进行预处理.本研究的预处理过程如下:依次用丙酮和无水乙醇对C-276型合金基带进行超声波震荡清洗20min,然后将基带放在烘干箱内烘干.
把清洗后的部分基带放置在快速升温烧结炉中,在流氧的环境中快速退火.退火条件为:退火温度650℃~950℃,退火时间20min,升温速率30℃/s.
采用射频磁控溅射方法在未退火与退火后的基带上生长 NiO 缓冲层.NiO溅射靶为河北玖越新材料科技有限公司生产的纯度为99.9%、直径为2英寸、厚度为3mm的NiO靶材.沉积参数如下:溅射功率为90W,溅射气压为2Pa,衬底温度为350℃,溅射时间为3min,溅射气体为高纯氩.
采用DX-2700B型X射线衍射仪(XRD)的θ-2θ扫描图谱和摇摆曲线分别分析退火前后衬底各个衍射峰的变化以及NiO薄膜的结晶质量.采用NanoWizard 4 BioScience型原子力显微镜(AFM)测试样品的表面形貌.
2 结果与讨论
2.1 在未退火的基带上生长NiO
首先研究在未退火的Hastelloy基带上以不同的衬底温度生长NiO薄膜的结构情况.在薄膜的制备中采用溅射气压为2Pa、溅射功率为90W、溅射时间3min、衬底温度为350℃~750℃等沉积参数,样品的XRD扫描结果如图1所示.由图1可知,衬底温度由350℃增加到750℃的过程中,NiO(002)衍射峰的强度均较弱,说明薄膜尽管均呈现出纯C轴取向,但是其生长质量并没有随着衬底温度的提高而出现明显的改善.此外,在保持衬底温度350℃下分别改变溅射功率和溅射气压来沉积NiO薄膜,其XRD的扫描结果与上述样品类似.

为了找出其原因,我们对未退火的基带进行ω扫描,结果如图2所示.可以看出未退火的基带在43.25°处衬底峰半高宽大(大于15°)且强度弱,摇摆曲线的对称性较差,而且由摇摆曲线图可以看出未退火的基带有众多细小尖锐的峰.说明基带表面存在着细小的NiO晶粒,其粒径尺寸不均匀,这不利于随后沉积粒子的同质外延生长.
2.2 退火处理对基带的结构和表面形貌的影响
为了改善基带表层的结晶质量和表面形貌,本文对基带进行高温退火处理.图3是未退火基带及基带在650℃~950℃退火20min的XRD图.由图3的a、b可以看出,基带经过650℃退火20min后,在43.25°处的基片峰强度有所提高,这说明在650℃条件下退火,基带表层的Ni原子部分氧化成NiO晶粒.图3c样品表明,基带在经过850℃退火20min后NiO(002)衍射峰的强度比未退火样品增大了近7倍.把一新基带在850℃退火30min后,其XRD图的NiO(002)衍射峰强度与退火20min的几乎相同,这说明基带在850℃退火20min后,其表面形成了一层连续的NiO薄膜,阻挡了内部Ni原子的氧化.此外由图3还可观测到样品出现了(021)取向生长的 MoO3,但是它的衍射峰强度极弱,对NiO薄膜生长的影响可以忽略不计.图 4为基带经过850℃退火20min后基带(002)衍射峰的ω扫描图.样品显示,NiO(002)衍射峰的ω扫描图的半高宽比未退火样品小很多,只有9.58°;摇摆曲线的对称性好,线条流畅、平滑.图3d样品显示,当退火温度继续提高到950℃时,衬底峰的强度反而减弱,这是由于过高的温度使得基带产生形变,导致基片峰强度减弱;同时当温度过高接近基带固溶温度时,元素Cr在高温下会挥发,产生空穴,使基带表面晶粒的取向一致性变差.实验证实在适当的温度下退火,一方面基带表层形成新的 NiO晶粒;另一方面,基片表面粒子获得能量后迁移到能量较低的位置,从而促进了晶粒长大,使得基片表面晶粒排列密集且一致性变好,表面粗糙度降低.

图3 在未退火及不同退火温度下Hastelloy空基带的XRD图

图4 850℃退火20min后基带ω扫描图
为证实43.25°的基带峰为NiO的衍射峰,我们对850℃退火20min的基带进行XPS测量.图5为退火与未退火基带的Ni2p的XPS图谱.测试结果表明,相较于未退火的基片,基片表面其他金属离子含量变化不大,但退火后的基带表面Ni离子的含量明显增加.又因为本文采用的基带含有大量的Ni元素,所以基带在O2环境中快速退火的过程中,Ni原子在高温下与O2反应生成(002)取向的NiO晶粒.这也刚好证实了为什么43.25°处(图3c、d样品)基带(002)衍射峰明显增强.在退火过的基带上生长NiO薄膜,属于同质外延生长,不存在晶格失配现象,所以由此推断在退火后的基带上更容易生长C轴取向的NiO薄膜.
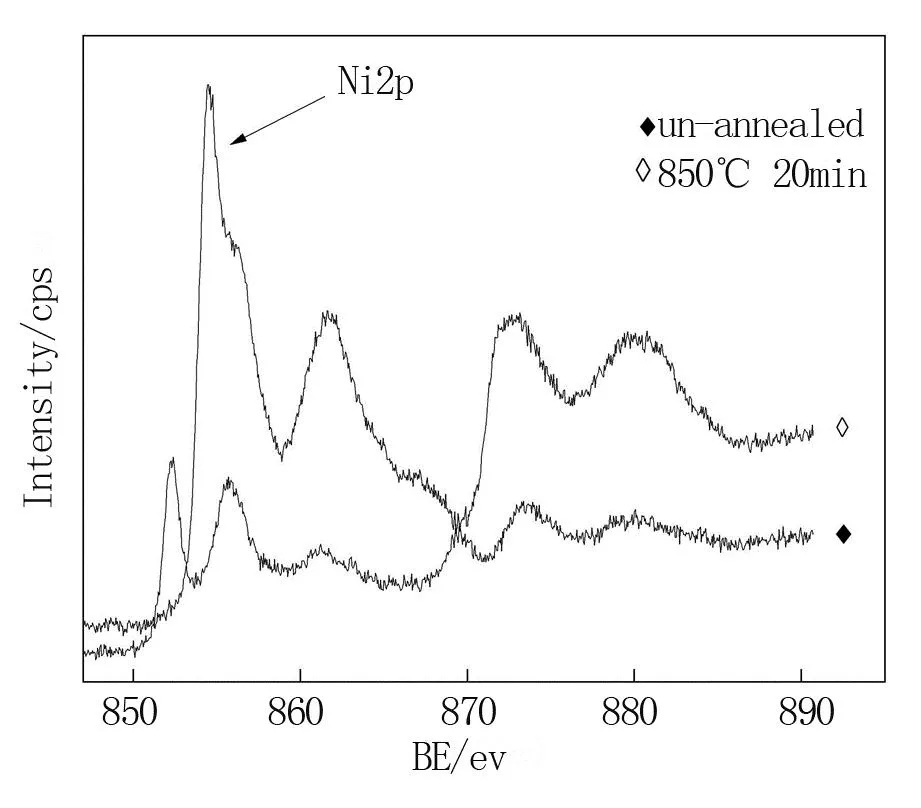
图5 退火与未退火基带的Ni2p的XPS图
采用原子力显微镜对退火前后的基带进行3um×3um的扫描,结果如图6所示.由图6(a)可知,未退火的基带表面有许多在生产过程中由机器造成的轧压痕迹,表面呈阶梯状结构;由局部位置的高度分布曲线可以看到这时NiO峰多而尖锐,说明基带表面NiO晶粒较小,其均方根粗糙度(rms)为50.24nm,峰-谷距离为6.92nm.基带经过650℃退火后,基片表面Ni原子与O2开始发生氧化反应,晶粒较未退火时有所长大,其表面的均方根粗糙度降到47.76nm,峰-谷距离为5.38nm.当退火温度达到850℃时,晶粒继续长大,均方根粗糙度降到38.32nm.说明NiO晶粒获得充足的能量进行生长,使氧化层变厚;并且表面能较高的顶层晶粒获得了足够能量后,迁移到较低的位置,使表面变得更加平坦,表面能降低.但是由于退火温度较高,处于较高位置的NiO晶粒继续生长,峰-谷距离达到5.62nm,造成个别晶粒生长过大,不利于先驱膜的后续生长,所以还可以对退火时间作进一步探索.此外,三个样品的表面均存在大小不一的沟痕,这是基带在生产过程中出现的固有缺陷,与退火条件无关.

图6 基带在不同温度下退火20min后的AFM形貌图
2.3 退火温度对同质外延生长NiO缓冲层的影响
在以上退火过的基带上进行同质外延生长NiO缓冲层,沉积参数如下:溅射气压为2Pa,溅射功率为90W,溅射时间为3min,衬底温度为350℃.
图7给出了各样品的XRD扫描图谱.图7(a)样品显示,在650℃下退火的基带生长的NiO薄膜衍射峰较弱,其衍射峰强度与未退火的衍射峰(图1a样品)强度接近.这是由于退火温度过低,基带表面原子没有得到足够的能量迁移,表面受损伤痕迹还未得到修复,不能诱导溅射下来的NiO粒子的取向生长,薄膜结晶质量差.图7(b)样品显示,基带退火750℃后生长的NiO薄膜衍射峰强度有所提高,但是衍射峰高度还是较弱.说明这时候部分Ni原子在O2中氧化成NiO,但基带表面平整度还是不够,薄膜结晶质量还是较差.图7(c)样品显示,在退火温度为850℃时,生长的NiO(002)衍射峰达到最大值,其强度超过基片峰.当退火温度达到950℃时,如图 7(d)样品所示,生长的NiO薄膜(002)的衍射峰高度有所降低,这是由于过高的退火温度使基带表面晶粒的取向一致性变差,不利于NiO薄膜的同质外延生长.总之基片在相同的退火时间下,退火温度过高或过低都不利于NiO薄膜的取向生长.
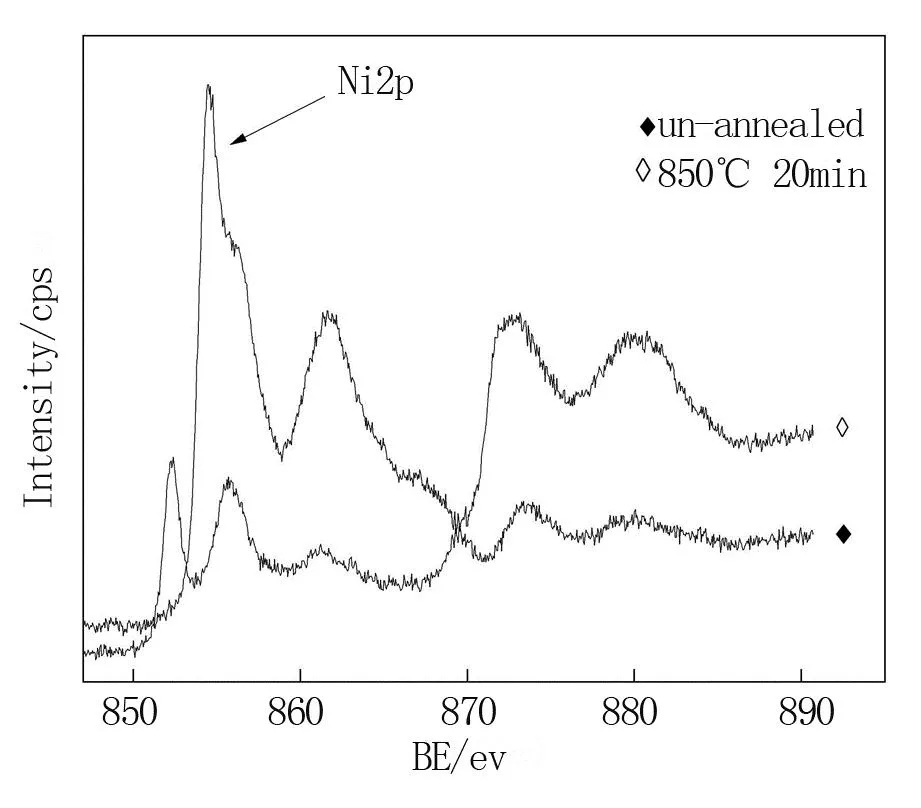
图7 在不同退火温度的基带上生长NiO薄膜的XRD图谱
为探究基带退火温度对生长的NiO缓冲层的影响,本文对NiO薄膜进行AFM扫描,结果如图 8所示.图8(a)样品表明,未退火的基带上生长的NiO晶粒细小,呈层状生长模式;得到的薄膜平均粗糙度(Ra)较大,为16.93nm.3D图显示,沉积下来的薄膜晶粒较小,大部分粒径小于0.1nm.在经过650℃退火后的基带上生长NiO薄膜,如图8(b)所示.可明显看到晶粒呈现岛状生长,生长的薄膜晶粒变大,晶粒尺寸约为0.1nm.但是表面平整性趋于凹凸不平,平均粗糙度也随着变大,变为22.68nm.图8(c)表明,在经过850℃退火后的基带上沉积NiO薄膜,同样呈现岛状生长,其晶粒尺寸约为0.4nm.薄膜表面粗糙度明显改善,平均粗糙度降为11.06 nm,表面平整.说明此退火温度可以提高基带表面平整度,可以很好地诱导溅射下来的NiO粒子生长.同时可以看到,此时生长的NiO薄膜表面由大、小晶粒混合组成,晶粒尺度分布不均匀,因此还需要对沉积参数开展进一步的研究.

图8 基带在不同温度下退火20min后生长NiO薄膜的AFM形貌图
3 结论
实验结果表明,直接在Hastelloy合金基带上生长NiO薄膜较为困难,且生长的NiO薄膜结晶质量差.本研究通过对Hastelloy合金基带进行高温退火处理,从而有效地促进基带晶粒的粒子迁移,可以很好地改善基片表面的损伤层,改善基片表面的平整性和粗糙度,使基带能够生长出强度高且呈纯C轴取向的NiO薄膜.该薄膜可以为后续实验制备的高温超导薄膜提供良好的生长环境.
