GaAs 插入层对InGaAs/AlGaAs 量子阱发光性质的影响
2023-12-04于海鑫王海珠郎天宇吕明辉徐睿良邹永刚
于海鑫,王海珠*,郎天宇,吕明辉,徐睿良,范 杰,邹永刚
(1.长春理工大学 重庆研究院,重庆 401135;2.长春理工大学 高功率半导体激光国家重点实验室,吉林 长春 130022)
1 引言
InGaAs/GaAs 多量子阱作为有源区,已经在激光二极管、光电探测器等各种光电器件中得到了广泛应用[1-5]。但是,在940 nm 波段的InGaAs/GaAs 量子阱外延生长过程中,还存在GaAs 势垒层不能良好限制载流子、可能会使载流子发生逃逸的问题[6-9]。因此,开展针对InGaAs/AlGaAs 多量子阱的研究是十分必要的。使用AlGaAs 材料代替传统的GaAs 势垒层是个不错的选择。首先,AlGaAs 的晶格常数和GaAs 相近,但是AlGaAs 的禁带宽度要远高于GaAs,对于在900 nm 左右发光的量子阱,可以起到很好的限制载流子的作用。从制备方法上来说,近年来主要使用金属有机物化学气相沉积(Metal-organic chemical vapor deposition,MOCVD)和分子束外延(Molecular beam epitaxy,MBE)的方法生长良好的InGaAs/AlGaAs 多量子阱[10-12]。最近,Zhang 等通过优化砷化镓的厚度,研究了砷化镓插入层对InGaAs/AlGaAs QWs光学特性的影响[13]。但是,对于MOCVD 生长的InGaAs/AlGaAs 多量子阱仍有许多问题没有解决。InGaAs 量子阱材料的热稳定性差,需要在低温下进行沉积,但对于AlGaAs 材料则需要升温生长以保证Al 原子的正常迁移,这会导致量子阱在生长时候有一个温度差[14],温度越高,In 原子越有可能发生偏析[15-16]。并且,在InGaAs 和AlGaAs 的界面处可能会生成InAlGaAs 四元合金,影响量子阱的质量和发光效果。为了减少这两种因素可能带来的不利影响,我们在InGaAs/AlGaAs 的界面处引入插入层阻止高温生长过程中的In 偏析,阻止InAlGaAs 四元合金的形成。对于插入层材料的选择,基于晶格常数、禁带宽度[17],我们选择GaAs 作为插入层材料,这是因为GaAs 和衬底材料匹配,不会带来额外的晶格失配;其次,GaAs 材料的发光波长在860 nm 附近,对于940 nm 左右的波段是透明的,并不会对阱层产生影响。
本文利用MOCVD 技术在GaAs 衬底上生长了InGaAs/AlGaAs 多量子阱材料,并在量子阱中引入GaAs 插入层阻挡升温过程的In 偏析和In-GaAlAs 四元合金的形成,并且减小失配,改善量子阱的生长质量和发光质量。通过变温光致发光(Photoluminescence,PL)和变功率PL、X 射线衍射(X-ray diffraction,XRD)、原子力显微镜(Atomic force microscope,AFM)测试,验证引入GaAs 插入层的InGaAs/AlGaAs 多量子阱发光特性变化和生长质量的改善。本文对研究InGaAs/AlGaAs 多量子阱的发光性能及辐射复合机制具有重要意义。
2 实 验
实验采用德国Aixtron 公司200/4 型MOCVD设备进行InGaAs/AlGaAs 多量子阱的外延生长制备。以三甲基镓(TMGa)和三甲基铟(TMIn)及三甲基铝(TMAl)作为Ⅲ族源,砷烷(AsH3)作为Ⅴ族源,高纯氢气(H2)作为Ⅲ族源的载气。生长时反应腔室压力维持在10 kPa(100 mbar),且在富Ⅴ族气体的氛围下进行。
图1 给出了带GaAs 插入层和不带GaAs 插入层的InGaAs/AlGaAs 多量子阱的生长结构示意图,从图中可以看出,InGaAs/AlGaAs 多量子阱结构生长在N 型无偏角的GaAs(100)衬底和缓冲层上。在生长前,对衬底在650 ℃的温度下进行5 min 的退火处理,以去除表面氧化物。之后生长300 nm 厚的GaAs 缓冲层,随后将温度升高到680 ℃生长AlGaAs 势垒层,然后将温度降低到600 ℃生长InGaAs 势阱层,再升高温度到680 ℃生长AlGaAs 势垒层,生长三个周期的量子阱结构。其中,每个量子阱结构包括6 nm 厚的In0.17Ga0.83As 量子阱层和8 nm 厚的Al0.3Ga0.7As 势垒层,两者的生长速率分别为0.507 µm/h 和0.58µm/h。最后,生长120 nm 厚的GaAs 盖层以保护量子阱,此为A 样品。作为对比,设计生长6 nm的GaAs 插入层,在生长完AlGaAs 势垒层之后生长6 nm 的GaAs 插入层,然后降温到600 ℃生长InGaAs 阱层和GaAs 插入层,最后升温生长8 nm AlGaAs 势垒层和GaAs 插入层。生长三个周期量子阱,并生长120 nm 的GaAs 盖层,作为样品B。生长结束后在AsH3气体的保护下,将反应室温度降至室温,以便后续测试表征。
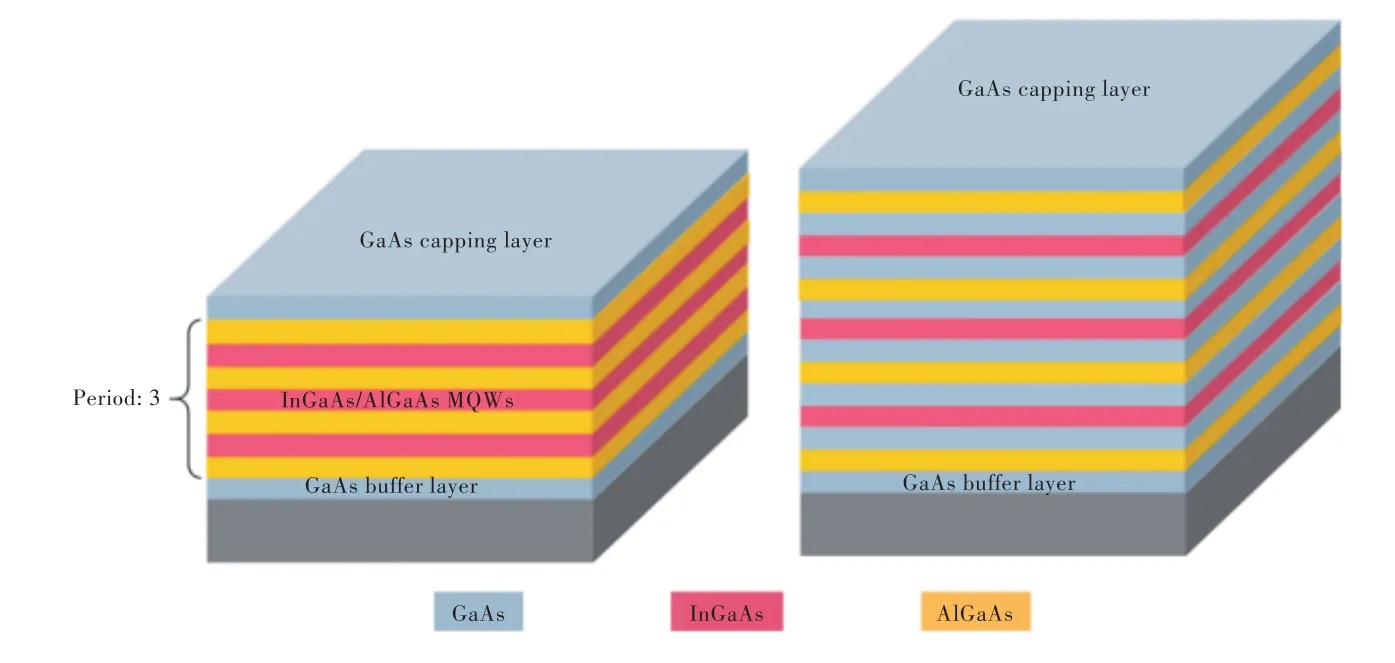
图1 InGaAs/AlGaAs 多量子阱结构示意图Fig.1 Schematic structure of InGaAs/AlGaAs MQWs
本文生长获得的量子阱材料的变温及变功率PL 由HORIBA iHR550 光谱仪完成,选用InGaAs探测器,激发光源是波长为447 nm 连续输出的半导体激光器,光斑直径为0.4 cm。样品放置在液氦制冷台上,用带有CaF2窗口镜片的真空罩保护。变温PL 测试的温度调节范围为20~300 K,功率密度维持在150 mW/cm2;变功率PL 测试的功率密度调节范围为10~70 mW/cm2,温度维持在20 K。
3 结果与讨论
首先,我们先对没有GaAs 插入层的样品A 进行光致发光测试,结果发现A 样品在室温下不发光,如图2 所示。而样品A 变温PL 测试显示,其在低温下发光,并随着温度升高,样品发光质量变差,直到完全消失,如图3 所示。为了探究样品A在低温下的发光性质,对我们A 样品进行低温20 K 条件下变功率测试,功率密度为10~70 mW/cm2,并对测试结果进行了拟合曲线分析,结果如图4 和图5 所示。

图2 A 和B 样品的室温PL 测试Fig.2 PL spectra of two samples at room temperature
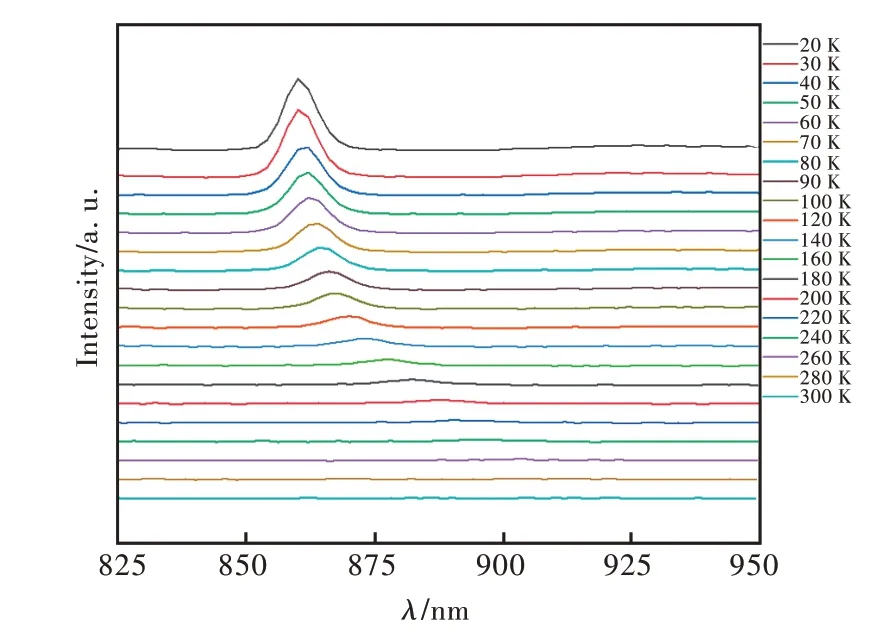
图3 样品A 的变温PL 测试结果Fig.3 Temperature-dependent PL results of sample A

图4 A 样品的变功率PL 测试图Fig.4 Excitation power-dependent PL results of sample A
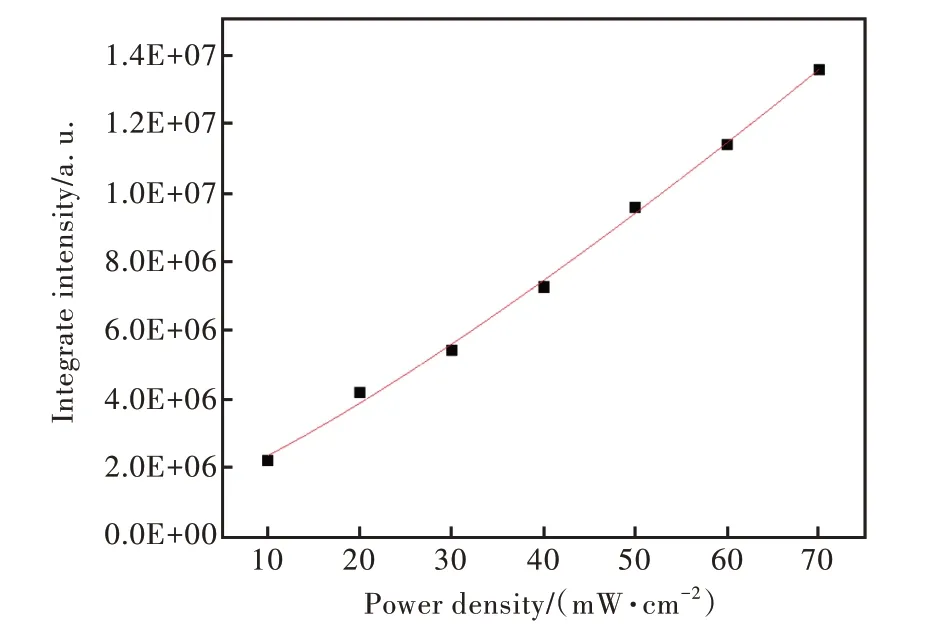
图5 样品A 在不同激发功率下的积分强度Fig.5 The integral strength of sample A under different excitation power
针对变功率PL 的积分强度与功率密度建立对应关系,积分强度与激发功率的关系如下所示:
其中I为PL 积分强度,β为辐射效率,I0为激发功率密度,a为特征值。经过拟合得出样品A 在20 K 温度下的a=1.22(a>1),推断为自由激子辐射复合发光。对于样品A,在低温下的发光机制为自由激子复合发光,但是随着温度升高发光质量变差直到光强完全消失。随着温度降低发光强度增大的原因是低温下能够抑制非辐射通道的散射,导致了更多的能量被转移到辐射通道中,增强了辐射复合的发生,增加了发光效率。随着温度的升高发光强度减小直到消失的原因是载流子发生了热逃逸,随着温度进一步升高,环境温度能量大于激子结合能,使自由激子解离,抑制了辐射复合的产生,这也导致自由激子复合峰的强度降低,直至完全消失。
接下来,我们又对样品B 进行室温PL 测试,结果如图2 所示。随着GaAs 插入层的引入,In-GaAs/AlGaAs 多量子阱发光有了明显改善。对于GaAs 插入层的引入改善了InGaAs/AlGaAs 多量子阱的发光情况,可能有以下几点原因:(1)GaAs 插入层的引入分离了阱层InGaAs 和垒层AlGaAs,减少了阱层和垒层界面处InAlGaAs 四元化合物的形成,减少了非辐射复合的形成,进而改善了PL的发光质量。(2)抑制阱层InGaAs 的偏析:在样品A 升温到680 ℃生长AlGaAs 势垒层时,升温表面为InGaAs 层,从600 ℃升温到680 ℃需要几分钟,会使表面的InGaAs 发生In 的偏析,从而降低InGaAs 的生长质量,进而导致样品发光不理想。而加入GaAs 插入层的样品B 在生长AlGaAs 时升温表面是GaAs 层,抑制了阱层InGaAs 的偏析,并起到限制与保护阱层In 原子的作用,提高了阱层InGaAs 的生长质量,从而改善了量子阱的发光质量。(3)改善载流子输运:加入GaAs 插入层可以改善载流子的输运过程。这是因为GaAs 和Al-GaAs 具有相似的晶格常数和晶体结构,插入层可以缩小应变差异并平滑材料界面,从而减少载流子的散射和复合。这将提高载流子的迁移率和激子寿命,从而增强PL 强度。(4)调整能带结构:插入层可以调整InGaAs/AlGaAs 多量子阱的能带结构。由于InGaAs 和AlGaAs 的晶格常数不同,多量子阱内部也存在应变,从而使能带位置发生变化。引入插入层可以缓解这种应变,进而影响载流子的能级分布和激子能级位置,从而改变PL峰的峰位和强度。(5)减少缺陷密度:加入GaAs插入层可以减少材料中的缺陷密度。多量子阱的界面和结构是材料中缺陷的主要来源之一。我们认为起主导作用的原因是插入层可以平滑多量子阱,从而减少位错和其他缺陷,提高量子阱生长质量,进而提高载流子的寿命并增强PL 强度。
为了继续探究GaAs 插入层的引入对量子阱界面生长质量的影响,我们对两个样品进行了XRD 测试分析,结果如图6 所示。生长的两个样品的衍射图均表现出明显的周期性衍射峰,表明其周期性结构和高结晶质量。对比引入GaAs 插入层的B 样品和没有引入GaAs 插入层的样品A,XRD 测试结果的卫星峰有明显的增加,表明在引入GaAs 插入层之后,量子阱的生长质量有明显改善[18-20]。这充分说明拥有GaAs 插入层的样品B 的结晶质量要远远好于样品A,也可以进一步说明引入GaAs 插入层改善了InGaAs/AlGaAs 多量子阱的生长质量,从而改善了发光情况。

图6 样品A 和B 的XRD 测试结果Fig.6 XRD results of A and B samples
为了继续探究GaAs 插入层的引入对量子阱生长质量的影响,我们对两个样品进行了AFM 测试分析,样品的表面粗糙度(Roughness measurement of the surface,RMS)结果如图7 所示。样品A的RMS=0.467 nm,样品B 的RMS=0.269 nm,说明GaAs 插入层的引入可以降低样品表面粗糙度,进一步表明GaAs 插入层的引入可以提高多量子阱的生长质量,进而影响量子阱发光性能。
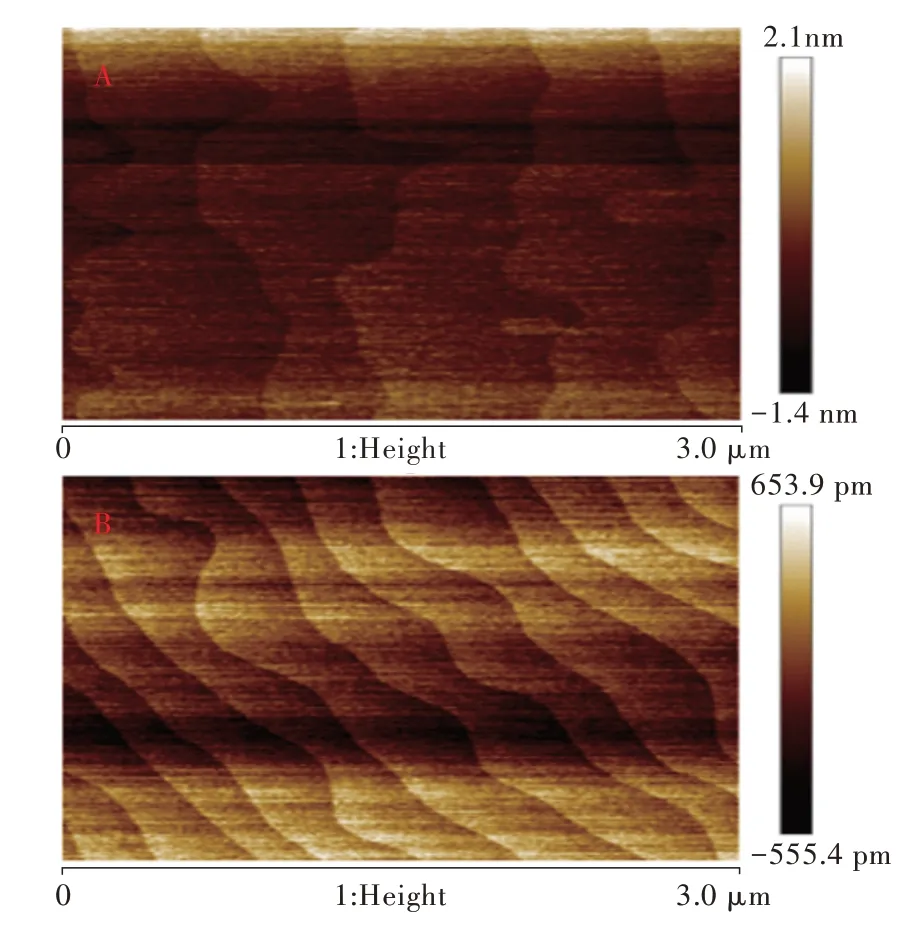
图7 样品A 和B 的AFM 测试结果Fig.7 AFM results of A and B samples
为了进一步探究GaAs 插入层的引入对发光性能的影响,我们又对样品B 进行了变温PL 测试,测试结果如图8 所示。可以发现在低温下随着温度升高,样品B 的发光波长有些异常变化。为了更加直观地看到随着温度升高波长的变化情况,我们又做了温度与波长和半峰宽(Full wave at half maximum,FWHM)的关系图,如图9 所示。从图中可以看到,随着温度从20 K 升高到60 K,波长出现先红移再蓝移的现象,推测出现这种“S”型变化可能是InGaAs/AlGaAs 多量子阱内部“局域态”发光导致。为了验证样品B 中可能出现“局域态”的猜想,我们又对样品B 在低温20 K 下进行了变功率实验,功率密度仍然为10~70 mW/cm2,结果如图10 所示。利用图9 中的数据,我们进行了拟合分析,曲线如图11 所示。结果发现拟合曲线得到a=0.88(a<1),进而得出样品B 在低温下为缺陷导致发光,由此推测低温状态下的异常’S’型波长变化为“局域态”导致的发光[21-22]。
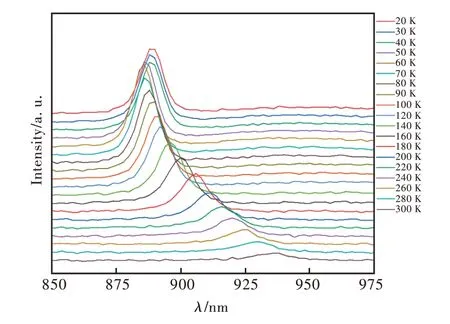
图8 样品B 的变温PL 测试结果Fig.8 Temperature-dependent PL results of sample B
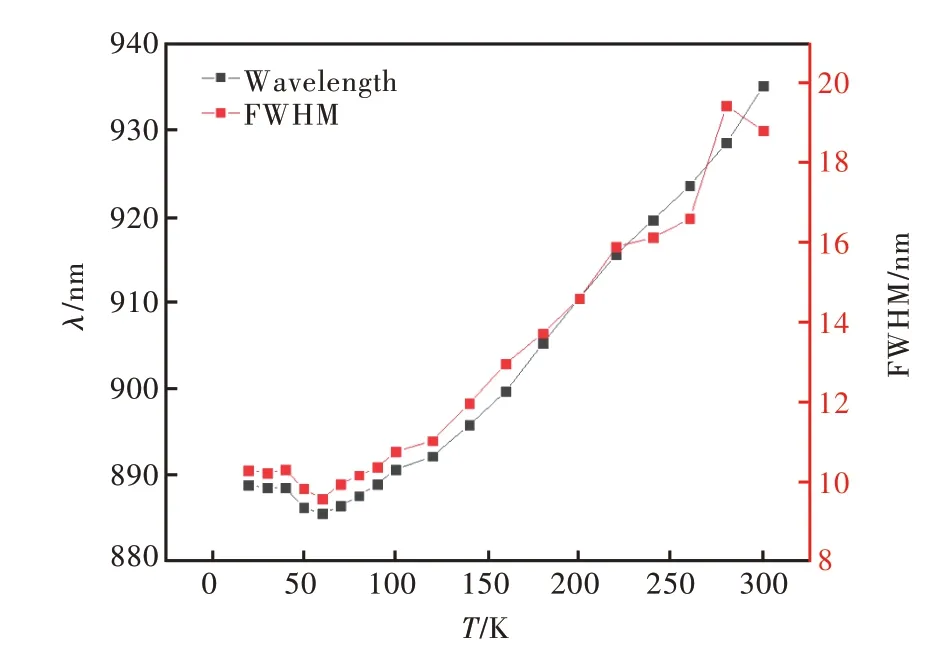
图9 样品B 温度相关的峰值位置和温度相关的FWHMFig.9 Sample B temperature-dependent peak position and temperature dependent FWHM

图10 B 样品的变功率PL 测试图Fig.10 Excitation power-dependent PL results of sample B
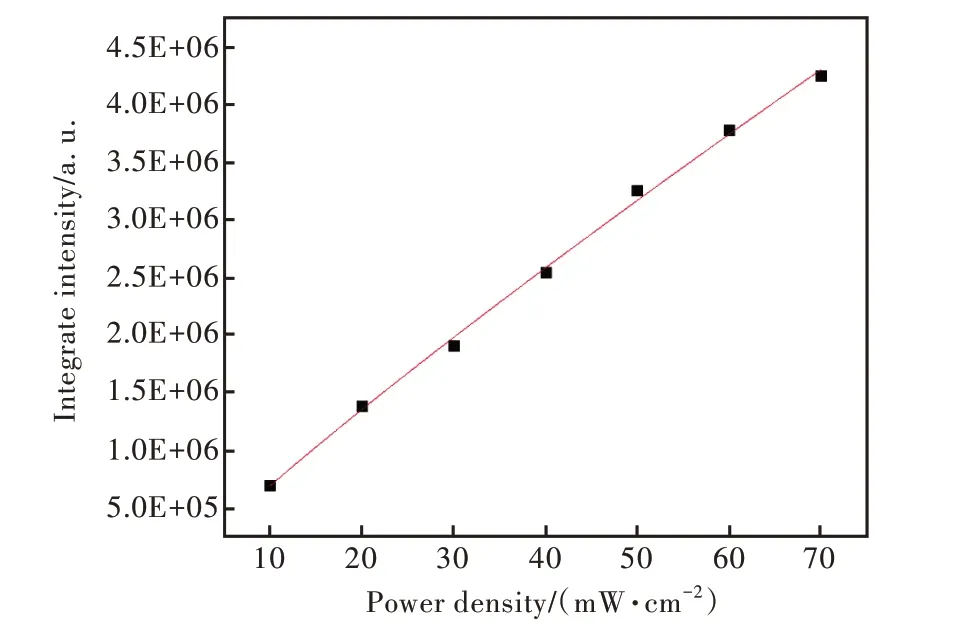
图11 样品B 在不同激发功率下的积分强度Fig.11 The integral strength of sample B under different excitation power
对于引入了GaAs 插入层的样品B 出现“局域态”的现象,我们推测是因为与阱层InGaAs 接触的AlGaAs 层,相较于GaAs 层,更不容易与In 原子互换,也就是说InGaAs 的In 原子更容易偏析进入GaAs 层,从而导致局部In 原子的数量下降,故而加入了GaAs 插入层的样品B 会出现“局域态”现象。
4 结论
本文通过MOCVD 设备生长了三周期的In-GaAs/AlGaAs 多量子阱材料。首先通过室温PL和变温PL 测试发现,没有加入GaAs 插入层的样品在室温下不发光,在低温下发光正常并且a>1,为自由激子发光。推测是低温下能够抑制非辐射复合的产生,随着温度升高,载流子发生了热逃逸,发光质量逐渐变差。而引入GaAs 插入层的样品在低温和室温下都正常发光,但是在低温时随着温度升高,波长有“S”型变化,并且低温20 K 时变功率测试a<1,推测为引入GaAs 层的样品量子阱内部出现“局域态”,是因为In 原子更容易偏析进入GaAs 层之中,进而导致了阱层In-GaAs 形成In 原子密度不同的区域。后续又进行XRD 和AFM 测试,发现引入GaAs 插入层的样品衍射峰的数量明显多于没有插入层的样品,并且样品表面粗糙度也有明显的下降,表明GaAs 插入层的引入改善了多量子阱的结晶质量,导致样品B 发光质量好于样品A;但是同时也会引入“局域态”,给量子阱的发光性质带来变化。本研究可以加深对InGaAs/AlGaAs 多量子阱辐射复合机制的理解,对引入GaAs 插入层的InGaAs/AlGaAs多量子阱发光性质的研究具有重要意义。
本文专家审稿意见及作者回复内容的下载地址:http://cjl.lightpublishing.cn/thesisDetails#10.37188/CJL.20230202.
