多场环结构对GaN基JBS击穿电压和正向工作电流的影响
2023-05-30陈宏佑王志忠黄福平楚春双张勇辉张紫辉
陈宏佑 王志忠 黄福平 楚春双 张勇辉 张紫辉

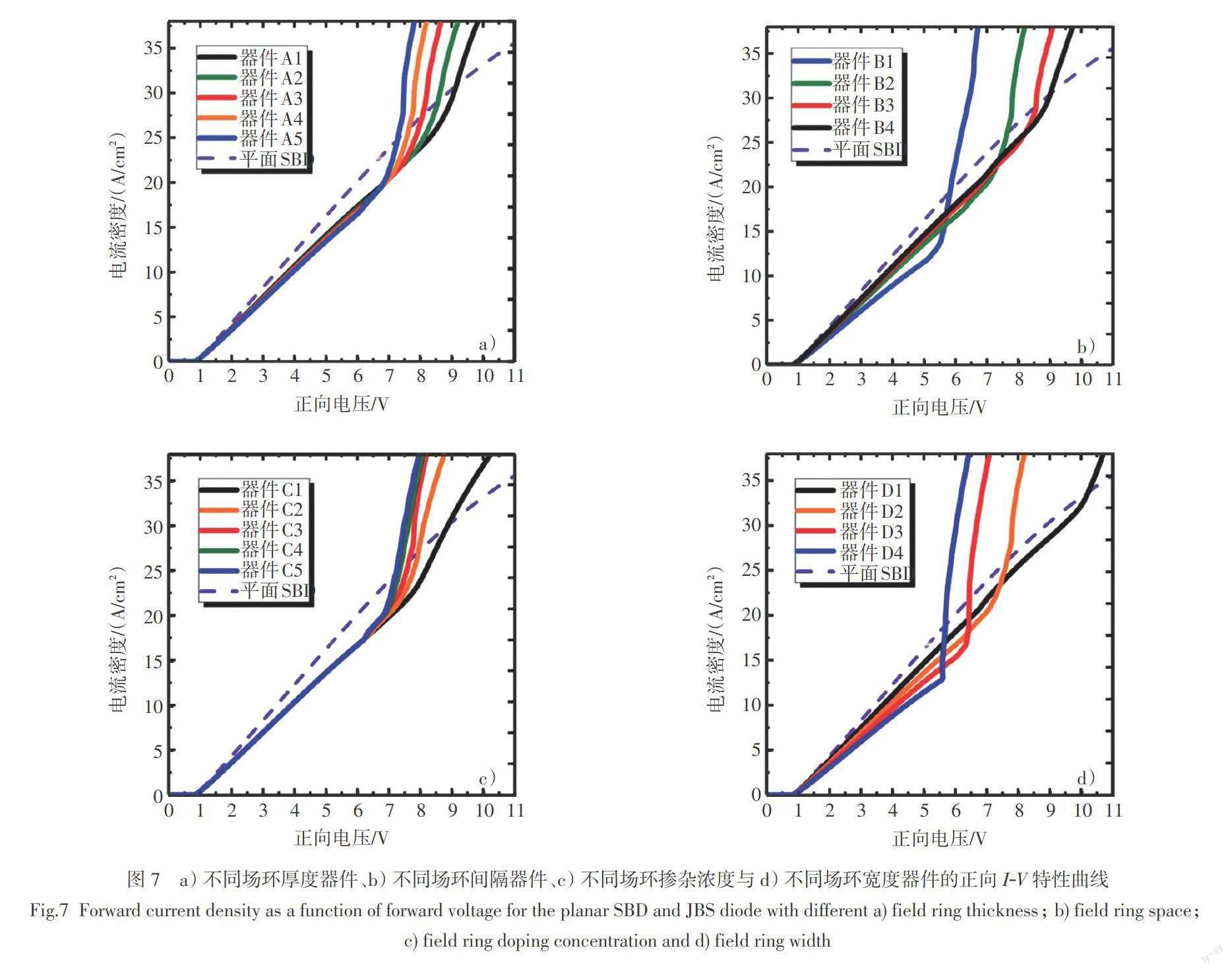
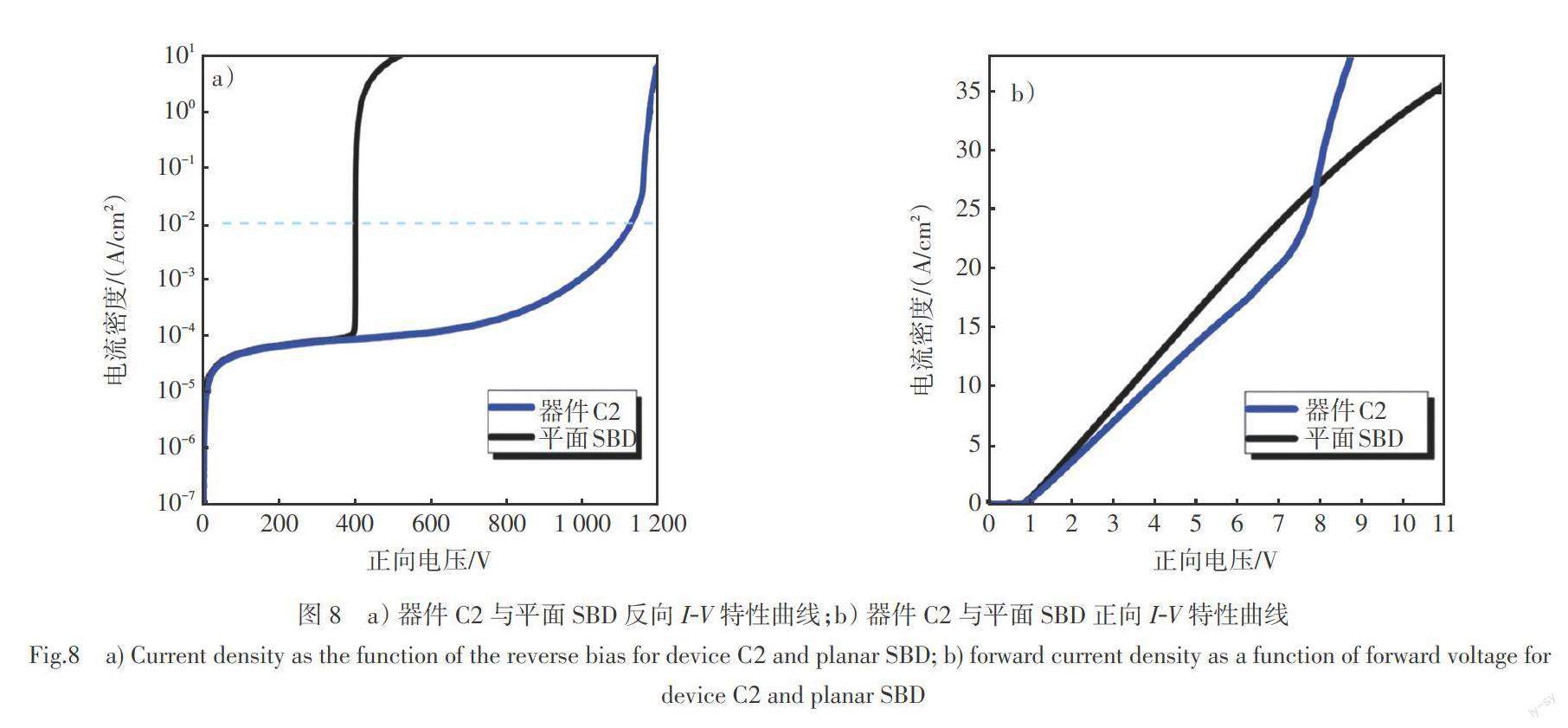
摘要 通过TCAD仿真模拟计算,系统地研究了不同结构参数对GaN基结势垒肖特基二极管(Junction Barrier Schottky Diode)电学特性的影响。JBS二极管在肖特基接触下方以若干个p型场环取代N?-GaN漂移区,通过电荷耦合效应降低肖特基接触位置的电场强度,减弱镜像力的影响以达到减小反向漏电和提高击穿电压的效果。研究表明,P-GaN场环的厚度、掺杂浓度及场环的间隔均对器件的反向击穿电压有明显影响。例如,采用适当厚度的场环可以显著降低反偏状态下肖特基接触位置下方的电场强度,同时不会产生过大的pn结漏电,最优厚度300 nm的场环可以实现1 120 V的击穿电压。同时,由于阳极金属分别与N--GaN和P-GaN形成肖特基接触和欧姆接触,JBS二极管可以实现低开启电压。当pn开启后,P-GaN内空穴注入漂移区产生电导调制效应,有助于提高正向电流密度。
关 键 词 击穿电压;漏电流;结势垒肖特基(JBS)二极管;电荷耦合;器件优化
中图分类号 TN312.8 文献标志码 A
Effects of multi field ring edge termination on the breakdown voltage and forward current for GaN- based junction barrier Schottky diode
CHEN Hongyou1, WANG Zhizhong1, HUANG Fuping1, CHU Chunshuang1,
ZHANG Yonghui1,2, ZHANG Zi-Hui1,2
(1. School of Electronics and Information Engineering, Hebei University of Technology, Tianjin 300401, China; 2. Key Laboratory of Electronic Materials and Devices of Tianjin, Tianjin 300401, China)
Abstract We systematically investigate the impact of different structural parameters on the electrical characteristic for GaN-based junction barrier schottky (JBS) diode with the help of TCAD simulation tools. The N?-GaN drift region under the Schottky contact is partly replaced by several p-type GaN field rings, so the electric field magnitude at/near the Schottky contact interface can be markedly reduced by using the charge-coupling effect. The charge-coupling effect results in the weakened image force, and thus the decreased leakage current and increased breakdown voltage (BV) can be obtained. According to our results, the thickness, p-type doping concentration, and the spacing of the P-GaN field ring have a significant impact on the reverse blocking characteristics for the studied devices. In the reverse bias state, the electric field magnitude at the Schottky contact interface can be reduced by using a field ring with an optimized thickness, e.g., the BV can reach ~1 120 V when the field ring with the 300 nm thickness is used. At the same time, the leakage current at p-n junction will not be greatly increased. Meanwhile, the JBS diode can achieve a low turn-on voltage (VON) when the anode metal forms the Schottky contact and ohmic contact on the N?-GaN and P-GaN, respectively. When the p-n junction is turned on, the hole injection into the drift region produces an enhanced conductance modulation effect, then the forward current density can be increased.
Key words breakdown voltage; leakage current; junction barrier Schottky (JBS) diode; charge-coupling effect; device optimization
0 引言
GaN作为第三代半导体材料,因其具有临界电场大,电子饱和漂移速度和热导率高等优点,成为了当下电力电子器件研究的热门方向并已在多个领域得到广泛应用[1-2];肖特基势垒二极管(SBD)为单极性器件,具有开启电压低,开关速度快等优点。目前,GaN基SBD器件主要分为两类,一类为生长在异质衬底,如Si、SiC上的水平结构异质结SBD,另一类为生长在GaN自支撑衬底上的垂直结构SBD。得益于Ⅲ族氮化物具有自发极化和压电极化的特性,无需故意掺杂即可在GaN/AlGaN异质结处形成一层高密度的二维电子气(2DEG),可实现低导通电阻和快速开关[3-4]。但异质结SBD大多生长在异质衬底上,材料生长时的晶格失配现象会导致反向漏电流增加[5-6];同时,表面态的存在会导致电流崩塌现象和动态电阻上升[7-9]。垂直结构SBD的漂移区可以很好地承担电压,形成耗尽区,并且由于电流在器件内纵向流动,所以受表面态的影响较小。
尽管SBD拥有低开启电压和快速开关等优点,但其较低的击穿电压已不能满足当前电子行业发展的需要。结势垒肖特基(JBS)二极管在拥有SBD优点[10-11]的基础上,在肖特基接触下方设置若干个高掺杂的P-GaN场环,如图1a)所示。当对器件加反向偏压时,耗尽区随着电压的增大不断扩大,进而联结在一起,使强电场不出现在肖特基电极附近[12]。对于金半接触位置的漂移区,两侧的P-GaN可以对N?-GaN漂移区形成二维耗尽,通过电荷耦合效应屏蔽强电场,避免镜像力导致的肖特基势垒降低现象[13-15]。肖特基电极下方的P-GaN与N?-GaN漂移区形成了若干个pn结,在反向偏置时,pn结会产生漏电。P-GaN场环各项参数,如场环的厚度、掺杂浓度则对电荷耦合和pn结漏电有很大的影响,器件设计时选择适当的参数便尤为重要。本文详细研究了JBS二极管P-GaN场环的厚度、间隔、掺杂浓度以及场环宽度对器件反向击穿电压,反向漏电,电场分布及正向特性的影响。
1 器件结构及参数
本文所研究的JBS二极管结构如图1a)所示,参考器件为平面肖特基势垒二极管,如图1b)所示。器件直径为66 μm;漂移区厚度为9 μm,非故意n型掺杂浓度为2×1016 /cm3;GaN衬底的Si掺杂浓度为5×1018 /cm3,阴极金属与衬底形成欧姆接触。P-GaN场环的宽度,厚度,间隔分别用[Qp,Tp,Wn]来表示。器件上方金属与N?-GaN漂移区形成肖特基接触。我们采用半导体器件模拟软件(APSYS)进行仿真计算,考虑的物理模型包括连续性方程,泊松方程,漂移扩散模型和碰撞电离模型等。本论文所考虑的物理模型已经过实验校准,实验结果和仿真结果具有高的一致性[16]。GaN材料的电子和空穴的碰撞电离系数[(αn和αp)]用Chynoweth方程式表示,如方程式(1)和(2)所示[17]:
式中E为漂移区内的电场强度。GaN材料的临界电场设置为3 MV/cm[18]。碰撞电离系数定义了每单位距离上由单个电子或空穴产生的电子-空穴对的数量。为了方便下文表述,我们将所研究器件的结构信息列在表1。图1c)为场环厚度为500 nm,宽度为2 μm,间隔为2 μm,P-GaN掺杂浓度为5×1017/cm3的JBS二极管与平面SBD的反向电流-电压(I-V)特性曲线,证明了JBS二极管可有效提高SBD的击穿电压。
2 结果与讨论
2.1 P-GaN场环厚度对GaN基JBS二極管反向击穿特性的影响
为了研究P-GaN场环厚度与器件反向击穿电压的关系,设计了器件A1~A5,场环厚度为200 nm到600 nm,其结构的详细参数见表1。不同P-GaN场环厚度的器件的反向击穿特性曲线如图2a)所示,可以发现当场环厚度大于300 nm后,击穿电压随着P-GaN场环厚度的增加而减小。图2b)展示了器件A1~A5沿场环间隔中线的电场分布,虚线所示的是平面SBD垂直方向的电场分布。在电场分布图中可以看到,场环厚度为Tp=200 nm的器件A1在肖特基接触位置下方的电场强度仅略低于同位置平面SBD的电场强度。由于P-GaN场环的厚度不足,N?-GaN漂移区无法在二维空间内有效耗尽,使耗尽区域的尺寸明显缩小,因此会在肖特基接触下方有最强电场。在图2b)的插图中,选择性展示了场环厚度为300 nm与600 nm的器件A1和A5 的N?-GaN漂移区电势分布,可以发现器件A5的电场耦合效应更加显著,因此如图2b)所示,当P-GaN场环厚度逐渐增加时,电荷耦合效应增强,肖特基接触下方电场强度逐渐减小。图2c)为肖特基接触下方水平方向电场强度分布图,同样证实了这一结论。然而,本文所提出的不同场环厚度的JBS二极管的反向击穿电压并没有随着场环厚度的增加、电荷耦合的增强而提高。图2d)展示了器件A1~A5水平方向肖特基接触下方反向漏电流的分布,如图所示,在电荷耦合效应的作用下,N?-GaN漂移区的漏电流随着场环厚度的增加而减小;而随着场环厚度的增加,pn结的面积增大,导致P-GaN位置漏电流增大。在器件A1~A5中,以反向漏电达到0.01 A/cm2定义为器件击穿判断标准,击穿电压最理想的是场环厚度Tp = 300 nm的器件A2,为1 120 V。
2.2 P-GaN场环间隔对GaN基JBS二极管反向击穿特性的影响
在本节,研究了场环的间隔对JBS二极管的电场分布、漏电流、耗尽区及击穿电压的影响。图3a)显示了不同P-GaN场环间隔的器件的反向I-V特性曲线。P-GaN场环间隔变化从1 μm到4 μm,即表1中的器件B1~B4。研究发现,随着场环间距的减小,击穿电压增大。图3b)展示了器件B1~B4沿场环间隔中线的一维电场分布和平面SBD沿垂直方向的电场分布。随着场环间隔的减小,肖特基接触下方电场强度逐渐降低。电场强度的降低应归因于漂移区良好的二维耗尽效应;P-GaN场环间隔为4 μm的器件B4在肖特基接触下的电场强度仅略低于平面SBD在同位置的电场强度,这意味着由于场环间的间隔距离过大,拥有4 μm场环间隔的器件N?-GaN漂移区未能实现有效的二维耗尽,几乎没有产生电荷耦合效应。当器件的场环间隔缩小到3 μm时,肖特基接触下方电场强度开始降低,直到间隔为1 μm时,电场强度降低到最小。图3b)的插图选择性地展示了器件B2和B4的电势分布图,这进一步说明了当场环间隔减小时,N?-GaN漂移区具有良好的二维耗尽。图3c)显示了器件B1、B2、B4在肖特基接触下方水平方向电场分布,从中也可看出,当P-GaN场环间隔增大时,电荷耦合效应变弱,肖特基接触下的强电场不能被有效屏蔽,这与上述结论一致。图3d)显示了器件B1、B2、B4肖特基接触水平方向反向漏电流分布,当场环间隔较小时,更强的电荷耦合效应将将电场推向更靠下的N?-GaN漂移区内,使P-GaN拐角处电势线分布更均匀,故在此位置的局部电场强度更小,漏电流更小。综上,器件B1~B4的反向击穿电压随场环间距的减小而提高,击穿电压最高的器件为场环间距为1 μm 的器件B1,为1 115 V。
2.3 P-GaN场环掺杂浓度对GaN基JBS二极管反向击穿特性的影响
接下来,研究了p型GaN场环的掺杂浓度对JBS二极管的反向击穿电压的影响。我们设计了器件C1~C5,其p掺杂浓度的范围从1×1017/cm3到1×1018/cm3,在表1中分别为C1~C5。图4a)显示了不同P-GaN场环掺杂浓度对器件反向击穿特性的影响。p型GaN是由Mg+掺杂形成的,Mg+重掺杂使P-GaN形成一个等势体,以此可以二维耗尽N?-GaN漂移区。研究发现击穿电压不随场环的掺杂浓度线性变化,并且器件C2的击穿电压最高。如图4b)所示,器件C1~C5沿场环间隔中线的电场强度随着场环p掺杂浓度提高而下降,证明N?-GaN电荷耦合和二维耗尽效应随场环掺杂浓度提高更明显。P-GaN掺杂浓度为1×1017/cm3的器件C1在肖特基接触位置下方的电场强度仅略低于同位置平面SBD的电场强度,证明了低掺杂浓度的场环不足以形成足够宽的耗尽区。图4b)内插图所示为p掺杂浓度为3×1017/cm3和1×1018/cm3的器件C2、C5的局部电势分布,可见场环掺杂浓度高的器件可以更好地对N-GaN实现二维耗尽。同时由图4c)可以观察到,器件C1在P-GaN内的电场强度也要高于另外3个器件,这是由于掺杂p型浓度低,场环无法形成等势体,在内部产生了电压降导致的。当场环掺杂浓度足够高时,器件C2~C5的P-GaN内不再有强电场,且漂移区电场强度也在电荷耦合效应的作用下显著降低。场环和漂移区内均有较大的电场强度也导致了器件C1的提前击穿。场环掺杂浓度更高的器件C2~C5的反向击穿电压并非随着掺杂浓度的提高而升高。如图4d)所示,当P-GaN掺杂浓度提高时,虽然更好的二维耗尽效应使漂移区漏电流显著降低,但pn结反偏时的漏电流会有提高。当P-GaN场环掺杂浓度为3×1017/cm3时,反向击穿电压最为理想,为1 133 V。
2.4 P-GaN场环宽度对GaN基JBS二极管反向击穿特性的影响
器件D1~D4的P-GaN场环宽度为1~4 μm,场环的厚度、间隔和掺杂浓度均相等且保持不变。由图5a)所示,器件D1~D4的反向击穿电压并没有明显差别。由上文分析可得,N?-GaN漂移区的二维耗尽效应决定了电荷耦合的强度,改变P-GaN场环宽度并不会对二维耗尽区宽度造成影响。如图5b)和图5c)所示,器件D1~D4肖特基接触位置下方的电场强度也几乎相等,这也证明了这个结论。图5d)展示了器件D1~D4的二维漏电流示意图,场环宽度较大的器件P-GaN漏电流却较小,这由于器件处于反向偏置时,器件内部的最强电场出现在P-GaN场环的拐角处,场环宽度不足时,左右两处拐角的电场在较大反向偏压会更容易耦合到一起,形成局部强电场,从而使漏电流增大。P-GaN场环宽度较大时,pn结漏电面积则更大,最终导致不同场环宽度的器件反向漏电流相当。
2.5 P-GaN场环对GaN基JBS二极管正向特性的影响
由于JBS二极管P-GaN场环会与N?-GaN漂移区形成pn结,当对器件加正向偏压时,pn结将会在达到一定电压时开启。图6a)展示了器件A2与平面SBD的正向I-V曲线。在正向偏压较小时,由于有P-GaN场环的存在,仅N-GaN参与导电,JBS二极管的电流密度要低于平面SBD。当继续加正向偏压至7 V时,pn结开始导通,空穴注入导致的电导调制效应使电阻率降低,电流密度增大。图6b)与图6c)分别展示了器件A2在Vf=6 V和Vf=8 V时的电流分布图。图7a)所示为器件A1~A5的正向I-V曲线图,不同场环厚度对pn结开启前的电流密度几乎没有影响。较厚的场环可以提供的更多的空穴注入,使pn结越早开启且开启后电流密度越大。拥有不同P-GaN场环间隔的器件B1~B5的正向I-V曲线如图7b)所示,由于器件总尺寸不变,故场环间隔越小,N-GaN区域的占比则越小,则在pn結开启前参与导电的区域越小,所以电流密度也就越低。图7d)为不同P-GaN场环宽度的JBS二极管正向I-V特性曲线。与不同场环间隔的器件类似,场环宽度的增大导致N-GaN占器件总尺寸减小,pn结开启前电流密度越小。P-GaN占比越大,开启越早且正向电流密度越大。不同P-GaN场环掺杂浓度的JBS正向I-V特性曲线如图7c)所示。器件正偏时,P-GaN掺杂浓度越高,则可以提供更多的空穴注入,pn结开启的电压也越低。
2.6 器件参数优化
在选择制备器件所用参数时,需权衡考虑反向特性与正向特性。更小的P-GaN场环间隔虽然可以提高击穿电压,但在器件正偏且pn结未开启时,电流密度较低;场环宽度较大时同样表现出这样的特性,故场环宽度和间隔选择2 μm最合适。场环的p型掺杂浓度对反向击穿电压的影响较大,而当掺杂浓度大于等于3×1017/cm3时,对器件正向特性的影响并不大。场环厚度较厚的器件会对反向特性有不利影响,但影响程度比掺杂浓度对击穿电压的影响小;而较厚的场环正向时可以实现pn结更早开启。综上所述,选择场环宽度,间隔均为2 μm,场环掺杂浓度为3×1017/cm3,场环厚度为500 nm的器件C2可实现对器件正向与反向特性的折中考虑。图8所示为经优化后的器件C2的反向与正向I-V曲线。
3 结论
本文详细研究了GaN基JBS二极管P-GaN场环各参数对器件反向击穿电压和正向导通特性的影响。P-GaN场环的厚度、掺杂浓度和场环之间的间隔均会影响器件的反向漏电,并对击穿电压产生影响。可以通过适当减小场环间隔,选择合适的掺杂浓度和场环厚度增强电荷耦合效应,减小N?-GaN漂移区漏电强度,提高击穿电压。器件正偏时,P-GaN场环内空穴注入N?-GaN漂移区产生的电导调制效应可增大正向电流密度,因此场环厚度、掺杂浓度、间隔和宽度均会对影响pn结开启的电压。经优化的JBS二极管权衡了反向击穿电压和正向电流密度,为JBS二极管的设计与制备提供重要参考。
參考文献:
[1] CHEN K J,HABERLEN O,LIDOW A,et al. GaN-on-Si power technology:devices and applications [J]. IEEE Transactions on Electron Devices,2017,64(3):779-95.
[2] ROCCAFORTE F,FIORENZA P,GRECO G,et al. Emerging trends in wide band gap semiconductors (SiC and GaN) technology for power devices [J]. Microelectronic Engineering,2018,187-188:66-77.
[3] MILLAN J,GODIGNON P,PERPINA X,et al. A survey of wide bandgap power semiconductor devices [J]. IEEE Transactions on Power Electronics,2014,29(5):2155-63.
[4] LENCI S,DE JAEGER B,CARBONELL L,et al. Au-free AlGaN/GaN power diode on 8-in Si substrate with gated edge termination [J]. IEEE Electron Device Letters,2013,34(8):1035-7.
[5] LI Y,WANG M,YIN R,et al. Quasi-vertical GaN Schottky barrier diode on silicon substrate with 1010 high on/off current ratio and low specific on-resistance [J]. IEEE Electron Device Letters,2020,41(3):329-32.
[6] BIAN Z,ZHANG J,ZHAO S,et al. 1. 48 MV?cm?1/0. 2 mΩ?cm2 GaN quasi-vertical Schottky diode via oxygen plasma termination [J]. IEEE Electron Device Letters,2020,41(10):1476-9.
[7] HAN S,YANG S,LI R,et al. Current-collapse-free and fast reverse recovery performance in vertical GaN-on-GaN Schottky barrier diode [J]. IEEE Transactions on Power Electronics,2019,34(6):5012-8.
[8] LIN W,WANG M,SUN H,et al. Suppressing buffer-induced current collapse in GaN HEMTs with a source-connected p-GaN (SCPG):a simulation study [J]. Electronics,2021,10(8).
[9] ZHANG T,LV Y,LI R,et al. Current-collapse suppression of high-performance lateral AlGaN/GaN Schottky barrier diodes by a thick GaN cap layer [J]. IEEE Electron Device Letters,2021,42(4):477-80.
[10] ZHOU F,XU W,REN F,et al. Demonstration of avalanche and surge current robustness in GaN junction barrier Schottky diode With 600-V/10-A switching capability [J]. IEEE Transactions on Power Electronics,2021,36(11):12163-7.
[11] ZHOU F,XU W,REN F,et al. High-voltage quasi-vertical gan junction barrier Schottky diode with fast switching characteristics [J]. IEEE Electron Device Letters,2021,42(7):974-7.
[12] BALIGA B J. Advanced Power Rectifier Concepts [M]. New York,NY,USA:Springer,2009.
[13] BALIGA B J. The pinch rectifier:a low-forward-drop highspeed power diode [J]. IEEE Electron Device Letters,1984,5:194-6.
[14] BALIGA B J. Analysis of junction-barrier-controlled Schottky (JBS) rectifier characteristics [J]. Solid-State Electron,28:1089-93.
[15] KOEHLER A D,ANDERSON T J,TADJER M J,et al. Vertical GaN junction barrier Schottky diodes [J]. ECS Journal of Solid State Science and Technology,2016,6(1):Q10-Q2.
[16] HUANG F,CHU C,ZHANG Y,et al. GaN-based quasi-vertical Schottky barrier diodes with the sidewall field plate termination for obtaining low leakage current and high breakdown voltage [Z]. 2021 IEEE 1st International Power Electronics and Application Symposium (PEAS). 2021:1-4. 10. 1109/peas53589. 2021. 9628512
[17] CHYNOWETH A G. Ionization rates for electrons and holes in silicon [J]. Physical Review,1958,109(5):1537-40.
[18] XIA L,HANSON A,BOLES T,et al. On reverse gate leakage current of GaN high electron mobility transistors on silicon substrate [J]. Applied Physics Letters,2013,102(11).
