宽禁带半导体碳化硅IGBT器件研究进展与前瞻*
2023-02-09张峰张国良
张峰,张国良
(厦门大学物理科学与技术学院,厦门 361005)
1 引言
功率半导体技术作为微电子器件领域的重要分支,在绿色能源、航天、交通运输和电力传输等方面有着广泛的应用,并对人们的生产生活方式产生了十分深刻的影响。目前,功率半导体技术水平的高低已成为一个国家科技发展水平和综合实力的重要体现,因此当今世界各国特别是发达国家都把该技术作为科技发展的重中之重。半导体器件自身性能与其所使用的材料密切相关。在半导体材料的发展历程中,人们习惯于把硅(Si)、锗(Ge)等材料称为传统半导体材料,将砷化镓(GaAs)和磷化铟(InP)等称为窄禁带半导体材料,将碳化硅(SiC)、氮化镓(GaN)和氮化铝(AlN)等称为宽禁带半导体材料[1-4]。与传统半导体材料Si和窄禁带半导体材料GaAs相比,SiC材料具有带隙宽(是Si的2.9倍)、临界击穿电场高(是Si的10倍)、热导率高(是Si的3.3倍)、载流子饱和漂移速度高(是Si的1.9倍)以及化学稳定性和热稳定性极佳等特点,是制造新一代高温、大功率电力电子和光电子器件的理想材料。在具备相同击穿电压的情况下,SiC基功率器件的导通电阻只有Si器件的1/200,极大地降低了变换器的导通损耗,这使得SiC材料在功率半导体领域有着巨大的应用潜力[5]。另外,SiC器件的散热效率高,能大幅降低器件外围冷却设施的体积和重量,因此,SiC功率器件也被称为绿色能源革命中的核心器件。经过三十多年的发展,SiC在材料生长与器件制备等方面都取得了长足的进展,其商品化水平不断提高。进一步推动SiC产业化发展进程、扩大SiC功率器件市场份额已成为宽禁带半导体材料与器件领域的重要研究课题。
绝缘栅双极型晶体管(IGBT)作为功率半导体全控型器件,集功率MOSFET的高速性能与双极型器件的高增益于一体,具有输入阻抗高、电压控制功耗低、控制电路简单、驱动功率小、通态电阻低等特性,广泛应用在新能源汽车、轨道交通、智能电网、绿色能源等领域。SiC基IGBT较Si基IGBT具有高耐压、高功率的特点,然而其在发展过程中也遇到较大的挑战,如导通特性较差、电导调制不强、关断速度较慢等。为解决以上问题,新型结构的SiC基IGBT结构应运而生。
本文概述了SiC IGBT的发展历程,梳理了P沟道SiC IGBT和N沟道SiC IGBT的经典器件,总结了SiC IGBT的发展现状和发展趋势。
2 SiC IGBT发展历程
通常来讲,全控型半导体器件可以依照其导通状态下的载流子类型分为单极型半导体器件和双极型半导体器件,在每一类中又可以分为电流控制型和电压控制型[6]。
在较低阻断电压的应用中,大多使用单极型半导体器件。最常用的单极型半导体器件是金属-氧化物-半导体场效应晶体管(MOSFET),目前利用SiC材料制备沟槽栅MOSFET(UMOSFET)或者双注入MOSFET(DMOSFET或DiMOSFET)已经有大量的报道。虽然使用SiC材料可以使临界电场增加,但随着阻断电压的提高,单极型半导体器件的漂移区电阻不可避免地迅速增加,导通压降也随之增加。因此在更高电压的应用中,单极型半导体器件往往难以胜任。
双极型半导体器件同样具有厚的漂移区,与单极型半导体器件不同,对于双极型半导体器件,如IGBT、栅控晶闸管(GTO)和电力晶体管(GTR),在导通状态下,少数载流子会注入到漂移区中,形成漂移区的电导调制现象,提高了漂移区的导电能力,降低了器件的导通压降。然而这些少数载流子在关断过程中需要被去除,又导致了大的关断损耗,因此GTO等器件只适用于对开关频率要求不高的高阻断电压应用中。目前SiC GTO和SiC GTR也有相当多的报道。
GTO和BJT的开启和关断依赖栅极或基极的控制,这一弱点使电路设计者需要为其设计复杂的控制系统。为了解决这一问题,Baliga提出了IGBT的概念,其兼有MOSFET的高输入阻抗和GTR的低导通压降两方面的优点,并逐步发展出了多种IGBT结构。近年来,由于各项工艺的进步,越来越多的研究小组参与到SiC IGBT的研究中。
SiC IGBT的发展历程较短,国内外SiC IGBT部分发展历程如图1所示,1996年,RAMUNGUL等人制作出了第一个沟槽结构的6H-SiC IGBT,通过该器件验证出在相同的漂移层厚度下,SiC IGBT的最大电流密度比SiC MOSFET高十倍左右[7]。1999年,SINGH等人制作出了第一个4H-SiC P沟道沟槽型IGBT,在室温下其导通电阻为32Ω·cm2,该器件设计阻断电压为790 V,但由于没有解决寄生NPN晶体管的高增益问题,其在85 V时便被击穿[8]。之后的SiC IGBT基本使用4H-SiC制作,因为相比于其他晶型的SiC,4H-SiC拥有较高的热导率,而且其电子迁移率各向异性弱,迁移率更高。同时从单晶衬底角度看,4H-SiC的施主杂质浓度更高,这意味着器件的电阻率也更低。2005年,ZHANG等人首次制作出10 kV N沟道沟槽型IGBT,其在室温下比导通电阻为17 mΩ·cm2。在SiC IGBT器件研究历程的前期,研究多是集中在P沟道的SiC IGBT,原因是相比于N型的衬底,P型衬底的电阻率更低且缺陷更多[9]。随着研究的不断深入,SiC IGBT的性能也逐步提升,导通电阻更是呈现不断进步的趋势,2007年,ZHANG等人引入电荷存储层(CSL),在消除JFET效应的同时增强电导调制效应,使制作出的器件导通电阻进一步降低,该器件阻断电压为7.5 kV,在室温下其比导通电阻约为26 mΩ·cm2[10]。2010年,WANG等人在独立4H-SiC外延片上使用翻转工艺在Si面上生长P型集电区,制作出了N沟道平面型IGBT,该器件的漂移区厚度为180μm,其阻断电压为20 kV,在300 W/cm2的功率密度下,电流密度可达到27.3 A/cm2[11]。2013年,YONEZAWA等人在翻转工艺的基础上采用翻转注入外延的方法制作出了带有CSL的N沟道平面型IGBT,该器件阻断电压可达16 kV,电流密度为100 A/cm2时,正向导通电压为5 V[12]。2014年,HINOJOSA等人利用N型衬底制备出了阻断电压为20 kV的N沟道平面型IGBT,该器件的比导通电阻为28 mΩ·cm2[13]。2018年,YANG等人研制出国内首个12 kV N沟道平面型IGBT,该器件在集电极电压为12 kV时,漏电流小于10μA,当正向导通电流密度为24 A/cm2时,比导通电阻为140 mΩ·cm2[14]。2019年,WEN等人研制出国内首枚10 kV P沟道平面型IGBT,该器件采用六角形元胞设计并使用阶梯空间调制型结终端拓展(SSM-JTE)终端结构,在300 W/cm2的功率密度下,其比导通电阻为56.92 mΩ·cm2,同时在集电极电压为-10 kV时,其漏电流仅为50 nA[15]。2020年,国家电网研制了国内首枚18 kV/12.5 A N沟道SiC IGBT。2022年,杨晓磊等人在N型SiC衬底上制备了国内首枚超20 kV SiC N沟道IGBT器件,该器件阻断电压为20.08 kV时,漏电流仅为50μA,当栅电极施加20 V电压、集电极电流为20 A时,器件的导通电压为6.0 V,此时器件的微分比导通电阻为27 mΩ·cm2[16]。自此,国产SiC IGBT的研究开始紧跟国际步伐。

图1 国内外SiC IGBT部分发展历程
3 SiC IGBT的结构与特性发展
IGBT器件具有P沟道和N沟道两种类型。P沟道IGBT可以看作P沟道MOSFET和NPN型双极型晶体管的混合,N沟道IGBT可以看作N沟道MOSFET和PNP型晶体管的混合。P沟道与N沟道IGBT结构如图2所示[6]。可以看出,N沟道IGBT基本结构与P沟道IGBT相同,掺杂类型与P沟道IGBT反型。
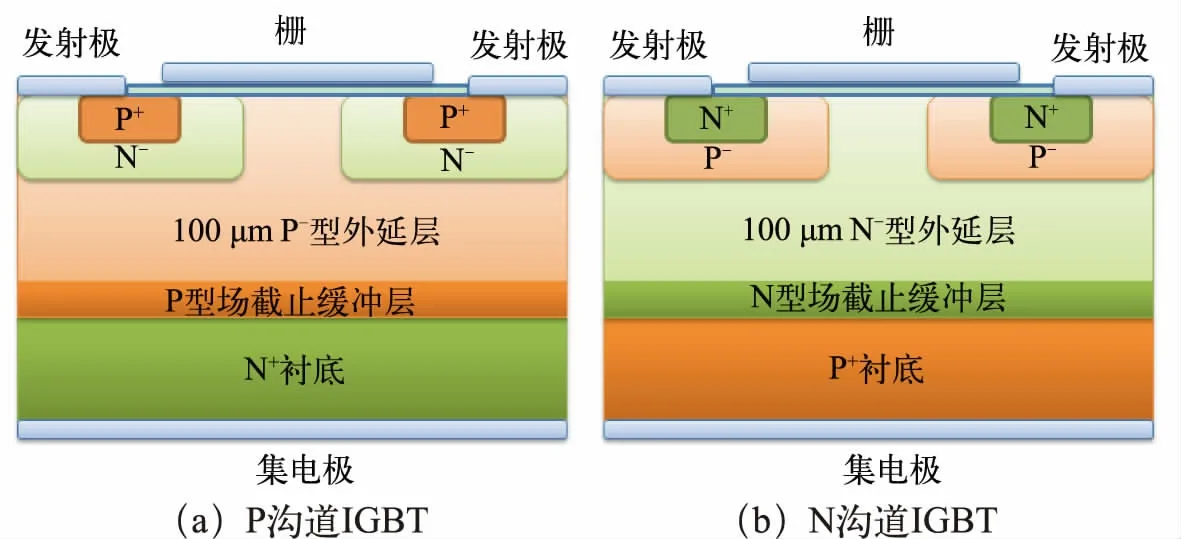
图2 P沟道与N沟道IGBT结构
3.1 P沟道SiC IGBT器件结构与特性
P沟道SiC IGBT的率先发展源于高质量N型掺杂SiC衬底的成熟应用。因此,早期SiC IGBT器件研究重点为P沟道IGBT器件。由于早期高温离子注入的工艺不成熟,P沟道IGBT多采用沟槽栅结构。SINGH等人[17]于2003年制备出了最早的P沟道槽栅4H-SiC及6H-SiC IGBT,P沟道沟槽栅IGBT基本结构如图3所示。
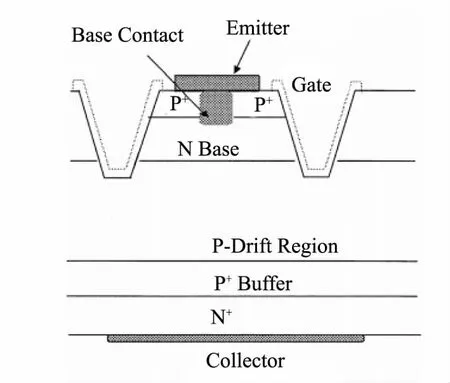
图3 P沟道沟槽栅IGBT基本结构[17]
SINGH对器件在不同温度下的性能进行了测试,在室温下(300 K),该器件阈值电压约为-28 V,栅击穿电压约为-40 V,导通电压约为-7.1 V,导通电流为20 mA时,导通压降约为-11.25 V,器件的漏-源击穿电压约为-85 V。较低的击穿电压预示着需要增加P+缓冲层的厚度或者P+缓冲层的掺杂。当器件栅压偏置在-32 V时,室温下其微分比导通电阻为32.68Ω·cm2;当温度上升至350℃时,微分比导通电阻为0.226Ω·cm2。当器件栅压偏置在-34 V时,在室温下其微分比导通电阻为66.7Ω·cm2;温度升高到400℃时,器件表现出了较好的输出特性,导通电流密度大幅上升,微分比导通电阻仅为0.297Ω·cm2。
随着温度的增加,器件具有更好的输出特性,可能源于以下原因:①欧姆接触电阻随着温度的增加而减小;②器件栅氧化层界面态密度随着温度的增加而降低;③漂移区载流子寿命随着温度的增加而增加;④PN结内建电场随着温度的增加而减小;⑤杂质的激活率随着温度的增加而增加。在研究器件栅漏电的测试中发现,当温度超过100℃时,器件出现了栅极漏电,该漏电会随着发射极-集电极偏压的增加而降低,这预示着在高温下,槽栅结构IGBT器件在槽栅底部边角处可能会存在漏电路径。器件在不同温度下的输出特性曲线及栅极漏电情况如图4所示。

图4 器件在不同温度下的输出特性曲线及栅极漏电情况[17]
SINGH还比较了400℃下沟道位于不同晶面上的器件的性能,结果显示,在(1120)晶面上制备的器件的集电极电流大约比(1100)晶面上制备的器件高两个数量级。对这一现象的解释是SiC-SiO2表面的碳簇会影响表面质量,进而造成界面态密度的增加,导致沟道载流子迁移率的下降,(1120)表面碳原子相比于(1100)面上更少,也许是导致高迁移率的原因。SINGH的工作没有使用有效的终端技术,导致阻断电压(85 V)远低于理论值(约3600 V)。栅氧化层退火工作的缺失也导致沟道载流子迁移率的低下,进而导致器件沟道电阻的增加。P发射极欧姆接触特性也有待提高,质量较低的欧姆接触导致了较高的正向压降,但槽栅结构以及(1120)沟槽晶面的选择为后续沟槽栅IGBT器件的研究提供了思路。然而沟槽栅IGBT的栅氧化层击穿等问题导致器件的可靠性较低,随着高温离子注入技术的解决,研究的重点转移到了平面栅IGBT上。
2006年,ZHANG等人[18]第一次制备了平面栅P沟道IGBT。采用JFET区注入制备的SiC P沟道IGBT如图5所示,器件元胞大小为29μm,使用高质量的N型衬底,外延生长2μm的P型缓冲层,掺杂浓度为1×1017~2×1017cm-3,之后生长50μm掺杂浓度为2×1014~6×1014cm-3的P型外延层。N阱和P型发射极分别使用氮(N)和铝(Al)离子注入形成,相邻N阱之间的JFET区利用离子注入降低了JFET电阻,注入浓度为1×1016~2×1016cm-3,器件使用离子注入形成的场环作为终端保护,离子注入激活温度约为1700℃。使用等离子体增强化学气相沉积(PECVD)厚度约为1μm的场氧化层,栅介质层通过热氧化形成,厚度为40~60 nm,经过湿氧再氧化后,再在一氧化氮(NO)环境下退火,保证栅氧化层质量。器件的N型欧姆接触使用Al/Ni作为接触金属,P型欧姆接触使用Ni作为接触金属,Ti/Au作为背金属,整个器件有源区面积约为4.5 mm2。

图5 采用JFET区注入制备的SiC P沟道IGBT[18]
平面栅IGBT阻断特性曲线如图6(a)所示,在栅压为0 V时,阻断电压约为5.8 kV,此时漏电流密度小于0.02 mA/cm2。栅压为-30 V时,25℃下,微分比导通电阻约为570 mΩ·cm2,没有表现出良好的输出特性。不同温度下器件输出特性曲线如图6(b)所示,可以看到,当温度为300℃时,比导通电阻下降为118 mΩ·cm2。比导通电阻随温度的增加而减小的主要原因是载流子寿命的增加,测试结果显示,室温下双极型载流子寿命约为370 ns,导致器件的电导调制效率很低,导通电阻较大。温度提高后,漂移区双极型载流子寿命增加,使导通电阻大大减小。类似结构的PMOSFET器件载流子迁移率测试结果显示,沟道载流子迁移率峰值为2.35 cm2/(V·s)。迁移率低的原因一是通过离子注入形成的P型沟道的低迁移率特性,二是SiO2/SiC表面的固定电荷。该器件的阈值电压仅为-12 V,满足了工业界-20 V以内阈值电压的要求。
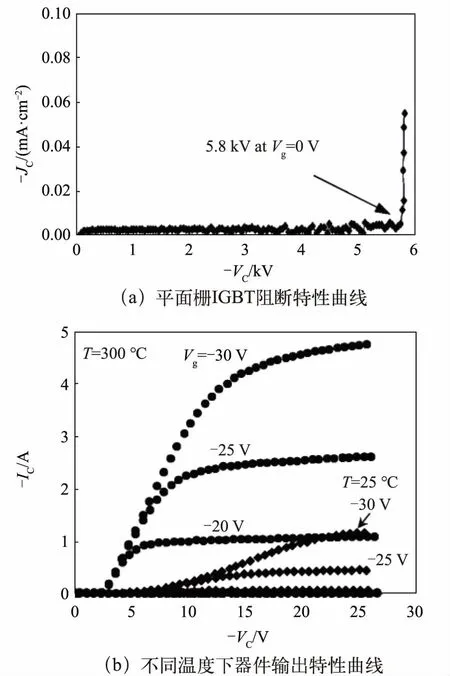
图6 平面栅IGBT阻断特性曲线与不同温度下器件输出特性曲线[18]
ZHANG还对器件的动态特性进行了测试。导通状态下,栅压偏置为-27 V时,集电极电流为0.75 A,集电极电压偏置为-400 V,将器件关断用时约为750 ns;当温度上升至130℃时,器件的双极型载流子寿命由370 ns上升至约1.1μs,关断用时大大增加。开关特性测试结果显示,器件的开启时间要远高于关断时间,这是由于器件具有高的密勒电容。ZHANG指出,将JFET区双极型载流子寿命提高到2μs以上、沟道迁移率提高到10 cm2/(V·s)以上时,可以获得较低的比导通电阻。该工作是对P沟道平面栅IGBT的首次探索,其使用离子注入的方法制作出N阱和P发射区,并实现了平面栅IGBT的制作,同时利用离子注入降低JFET区域的电阻,并指出了双极型载流子寿命对器件输出特性的重要性,分析了沟道迁移率较低的原因,为之后的平面栅IGBT的制作提供了参考。
2013年,KATAKAMI等人[19]制备了高沟道载流子迁移率的P沟道IGBT,最大载流子迁移率达到了13.5 cm2/(V·s)。P沟道SiC IGBT器件结构如图7所示。器件以N型掺杂作为衬底,器件外延层包括一个76μm厚、掺杂浓度为1.2×1014cm-3的P型漂移层和一个2.5μm厚、掺杂浓度为1.8×1017cm-3的P型缓冲层,用以阻断12 kV的电压。器件漂移区载流子寿命为0.8~1.6μs,使用2个注入集成方案的JTE作为终端保护。器件单元长度、沟道长度和JFET区长度分别是15μm、1.5μm和3μm。
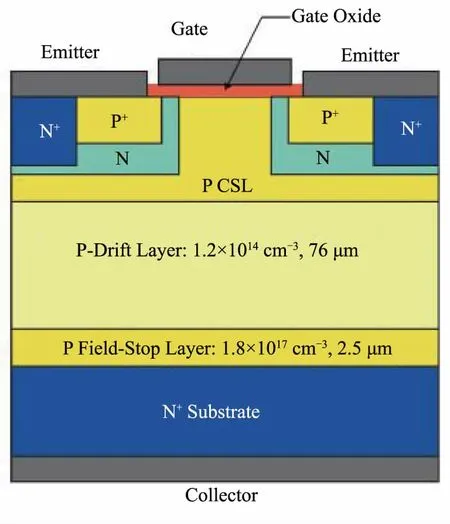
图7 P沟道SiC IGBT器件结构[19]
为了探寻最合适的栅氧化层形成方法,KATAKAMI比较了采用不同栅氧化层退火方法的器件的特性。作者制备了3个MOSFET器件,经过1200℃干氧氧化形成栅氧化层,之后在950℃或1100℃下进行湿氧二次氧化(样品1、2),或者在1200℃下进行一氧化二氮(N2O)退火(样品3)。结果显示,在相同的栅压下,采用1100℃湿氧再氧化的方法制成栅氧化层的器件(样品2)具有最高的沟道迁移率,为14.7 cm2/(V·s),同时拥有最大的沟道电流,其在25℃下阻断电压大约为10.2 kV,漏电电流密度为1μA/cm2,器件的微分比导通电阻为24 mΩ·cm2。1100℃下进行湿氧再氧化退火的器件比在950℃进行湿氧再氧化退火的器件导通特性更好。采用N2O对栅氧化层进行退火的器件具有较低的载流子迁移率和沟道电流。
KATAKAMI还比较了工作在不同温度下、通过1100℃湿氧二次氧化栅进行退火的器件的一些特性,SiC P沟道MOSFET器件输出特性曲线如图8(a)所示,阈值电压及沟道载流子迁移率与温度的关系如图8(b)所示,随着温度的提高,阈值电压的绝对值发生轻微的下降,沟道载流子迁移率随温度先轻微上升,之后下降。KATAKAMI的工作主要针对器件的沟道迁移率,作者分析了不同的栅氧化层形成方法,且分析了器件阈值电压和沟道载流子迁移率随温度变化的关系,为后续沟道迁移率的提升提供了有效渠道。
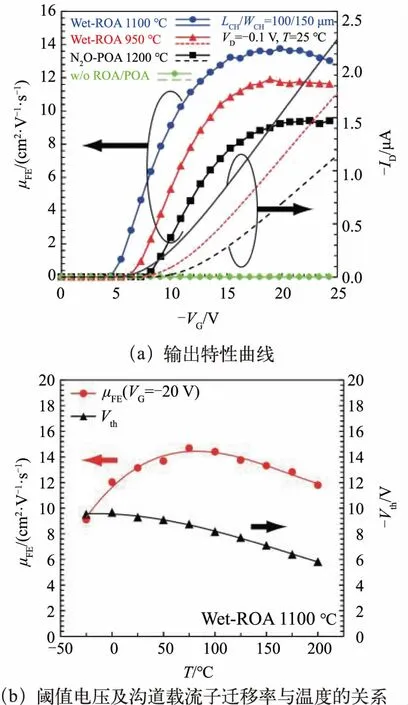
图8 SiC P沟道MOSFET器件输出特性曲线和阈值电压及沟道载流子迁移率与温度的关系[19]
2019年,WEN等人[15]制作出10 kV P沟道IGBT,该器件使用六角形元胞设计和SSM-JTE终端结构,10 kV P沟道IGBT器件结构如图9(a)所示,SSM-JTE结构如图9(b)所示。由于平面型器件制作工艺较为简单且可以保证较高的栅氧化层可靠性,因此该器件使用平面栅结构。整个器件的外延生长都是在一个晶轴偏4°角、350μm厚的4英寸4H-SiC衬底片上。首先生长一层2μm厚、掺杂浓度为2×1017cm-3的P型缓冲层,之后继续生长100μm厚、掺杂浓度为2×1014cm-3的P型漂移区。漂移区的载流子少子寿命为1.2μs。为保证栅氧化层的可靠性,同时尽可能地提升器件的通态特性,在条形元胞中JFET区域的宽度设计为10μm,六角形元胞中JFET区域的宽度设计为8μm。这样可以保证在阻断电压为10 kV的情况下,两种元胞的栅氧化层电场强度均小于4.5 MV/cm。考虑到器件制作过程中掺杂的激活率问题,器件的SSM-JTE的宽度设计为530μm,这样可以保证足够宽的工艺窗口。同时,为降低器件开启时的电阻,该器件使用自对准技术制作沟道,所制作出来的器件有源区为2.25 mm2,整个器件为3 mm×3 mm。
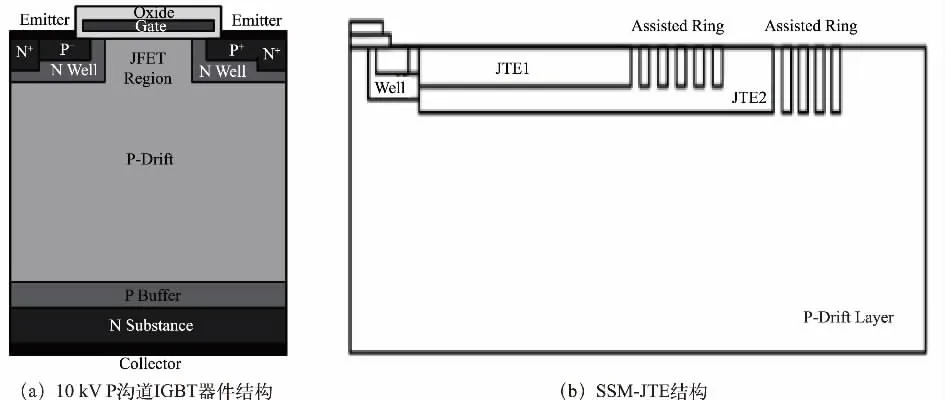
图9 10 kV P沟道IGBT与SSM-JTE结构[15]
使用不同终端结构的六角形元胞器件阻断特性曲线如图10所示,在阻断电压为-10 kV的情况下,宽度为200μm的双JTE结构和宽度为500μm的双JTE结构漏电流分别为970 nA和590 nA,而SSM-JTE结构的漏电流仅为50 nA,原因为SSM-JTE结构内部的环可以消除电场拥挤现象,从而降低漏电流。

图10 使用不同终端结构的六角形元胞器件阻断特性曲线[15]
使用条形元胞设计和六角形元胞设计的器件输出特性曲线如图11所示。可以看出,与仿真数据相比,实际制作出来的器件导通电阻偏大,其主要原因为以下3点:(1)在界面处,表面复合降低了双极型载流子的寿命;(2)源区的欧姆接触电阻较高,因而产生了较高的压降;(3)缓冲层和发射层所形成的PN结注入效率较低。根据输出曲线可知,条形元胞和六角形元胞设计的器件,在300 W/cm2的条件下,输出电流分别为34.2 A/cm2和38.9 A/cm2。六角形元胞设计的器件性能优于条形设计,其原因为六角形结构的宽长比为4.1×105,而条形结构的宽长比为2.9×105。该工作比较了条形结构设计与六角形结构设计的输出特性,为以后的器件元胞结构设计提供了参考;同时,在终端中使用的SSM-JTE结构也在阻断状态下大幅降低了器件的漏电流,这表明与双JTE结构相比,SSM-JTE更适用于高压器件之中。
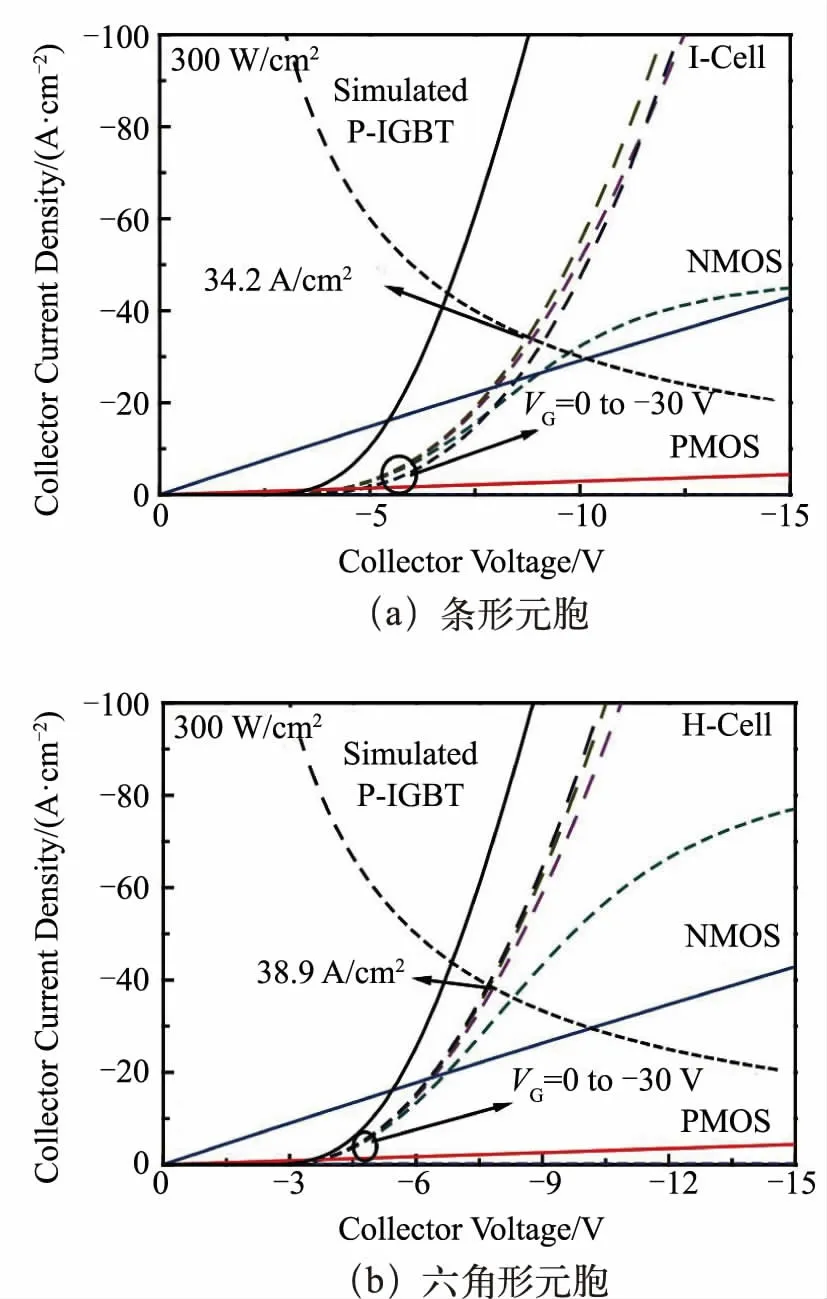
图11 条形元胞与六角形元胞设计的IGBT输出特性曲线[15]
自2002年SINGH等人制作出第一个P沟道SiC槽栅IGBT以来,科研人员对于P沟道SiC IGBT的研究已走过二十个年头,器件结构的研究重点也由沟槽栅逐渐转换为平面栅,这是工艺的逐步成熟与器件性能需要的共同选择(高温离子注入技术问题得到了解决,同时平面栅结构的栅氧化层可靠性更高),针对平面栅IGBT的结构特点,科研人员做出了以下优化:引入自对准源区注入方法,在器件中实现了窄沟道,使器件表现出较好的导通特性和高温稳定性;针对平面栅SiC IGBT中难以产生电导调制的JFET区域,采用CSL结构代替JFET区的离子注入,在降低JFET电阻的同时避免了离子注入的不利影响,还通过抑制NPN晶体管提高了P+发射极的注入效率。其他一些因素对器件特性的影响同样重要,如少数载流子的寿命、沟道迁移率、器件元胞结构设计与终端设计等,作者认为,相关的研究对以后的器件制备将产生深远的影响。在对P沟道SiC IGBT进行探索的过程中,科研人员还发现相比于N沟道SiC IGBT,P沟道SiC IGBT拥有更好的阻断特性,且在高温下导通特性更好。相信未来P沟道SiC IGBT将在相应的领域发挥巨大的作用。
3.2 N沟道SiC IGBT的研究、制备
由于N沟道IGBT需要高质量的P型衬底,P型衬底这些年来一直发展较慢,在一定程度上延缓了SiC N沟道IGBT器件的发展。然而,由于电子相对空穴具有较高的迁移率,能够带来更低的导通压降,同时N沟道IGBT具有与现有电力电子系统兼容的特性,因此N沟道IGBT器件的研究具有很高的现实意义。
2008年,DAS等人[20]制备了第一个13 kV N沟道IGBT,其结构如图12所示,器件在使用高质量p型衬底的基础上制备,JFET区进行N注入实现更高的掺杂,离子注入退火温度为1600℃以上,使用Si压抑制表面重构和Si原子蒸发,场氧厚度为0.8μm,栅氧化层厚度为50 nm,使用热氧化的方式生长,在NO环境下退火。经测试显示,该器件的开启电压大约为3 V,微分比导通电阻约为22 mΩ·cm2,器件阻断电压达到了13 kV,不同温度下器件的输出特性如图13(a)所示,随着温度的上升,器件的导通特性下降,跨导降低。器件的开启电压随温度的上升而略微增加,不同温度下器件的阻断特性如图13(b)所示,阻断电压随温度的上升而略有下降,但在200℃的温度下依然能够阻断超过10 kV的电压。该器件表现出了良好的导通特性,但动态特性稍有不足,电压上升的时延较长,这表明该器件栅极结构设计存在问题,需进一步完善相关结构。
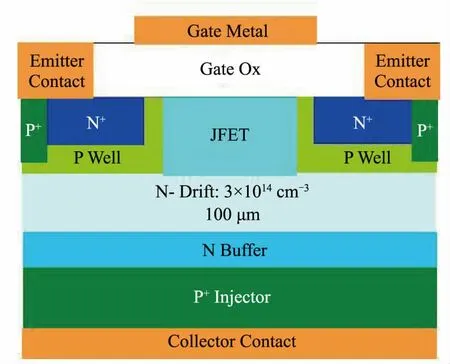
图12 13 kV N沟道SiC IGBT结构[20]

图13 不同温度下13 kV N沟道SiC IGBT的输出特性和阻断特性[20]
2014年,YONEZAW等人[12]制备了翻转型注入外延N沟道SiC IGBT,其基本结构如图14所示。器件使用N型衬底,在(0001)面上依次生长N型缓冲层,150μm厚的N型漂移区,N+缓冲层,P+集电极区;翻转器件后去除N型衬底和N型缓冲层,并生长N型CSL层。离子注入形成P阱底部后进行P型外延生长,注入形成N型JFET区、P+基区以及N+源区。器件的终端由两个box的JTE形成,总长度为750μm。栅氧化层经过干氧氧化后在富N环境下退火形成。器件元胞大小为14.8μm,器件尺寸为8 mm×8 mm,器件有源区面积大小为0.37 cm2。测试结果显示,在栅压为0 V时,器件达到了16 kV的阻断电压,导通电流分别为20 A和60 A时,正向压降分别为4.8 V和7.2 V,微分比导通电阻为23 mΩ·cm2,器件开启电压约为4.8 V。在可靠性方面,器件的阈值电压稳定性如图15(a)所示,器件在栅压分别为-30 V和30 V两种情况下,经过1000 s的老化测试,阈值电压依然保持稳定,最大阈值电压偏移在0.1 V以内。不同温度下器件的输出特性如图15(b)所示,结果显示器件的输出特性具有良好的温度稳定性。
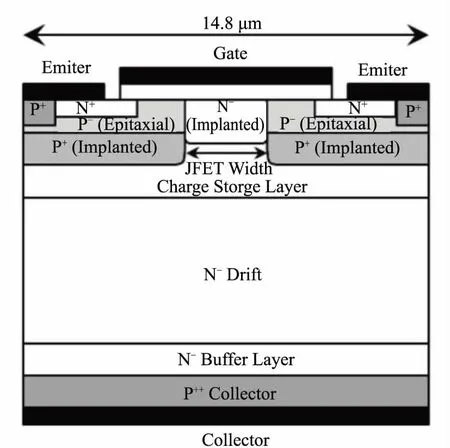
图14 翻转型注入外延N沟道SiC IGBT基本结构[12]

图15 翻转型注入外延N沟道SiC IGBT阈值电压稳定性与不同温度下器件的输出特性[12]
YONEZAW很好地制备出16 kV N沟道IGBT,但其方法十分复杂,所需外延及离子注入工序极多,有很大的制备难度。目前有关N-IGBT成功制备的报道并不是很多,主要是因为高质量的P+衬底难以获得,而采用翻转外延生长的方式又会因为晶面选择和外延层质量等因素存在影响器件性能的问题。
2022年,杨晓磊等人制备出了一种耐压超过20 kV的超高压SiC N沟道IGBT[16],其基本结构和制备方案分别如图16、17所示。该团队通过在N型4H-SiC衬底上生长所需的关键外延层,包括N-漂移层、N+缓冲层以及P+集电极层,采用SiO2作为各区域的注入掩模,使用多次离子注入形成P阱、P+区域和N+区域;同时对JFET区域进行单独的N型离子注入,所有注入完成后在1650℃的Ar环境下退火以激活注入离子。退火后,通过牺牲氧化去除表面碳层,湿法表面清洗后放入高温氧化炉中进行干氧氧化,形成栅氧化层。采用NO高温退火技术,有效降低栅氧界面陷阱密度,最终将氧化层厚度控制在50 nm左右。在栅氧工艺完成后,通过在栅氧化层上沉积多晶Si实现栅电极的制作。采用氧化硅/氮化硅(SiO2/SiN)介质实现栅极和发射极的隔离以及表面钝化。发射极的欧姆接触由金属Ni实现,介质孔刻蚀后通过加厚Al层完成发射极单胞之间的互联。器件正面结构完成后通过减薄/背面研磨的方法去除N型衬底,保留部分P+层,接着蒸发背面欧姆金属,并使用激光退火完成背面的欧姆接触。
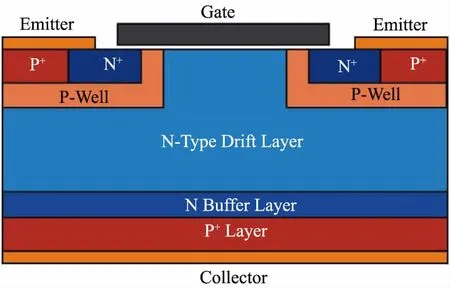
图16 超高压SiC N沟道IGBT器件元胞的基本结构[16]
超高压SiC N沟道IGBT阻断特性如图18(a)所示,该器件击穿电压可以达到20 kV,当集电极电压为20.08 kV时,漏电流为50μA。超高压SiC N沟道IGBT输出特性如图18(b)所示,该器件在栅压为20 V、集电极电流为20 A时,其微分比导通电阻为27 mΩ·cm2。
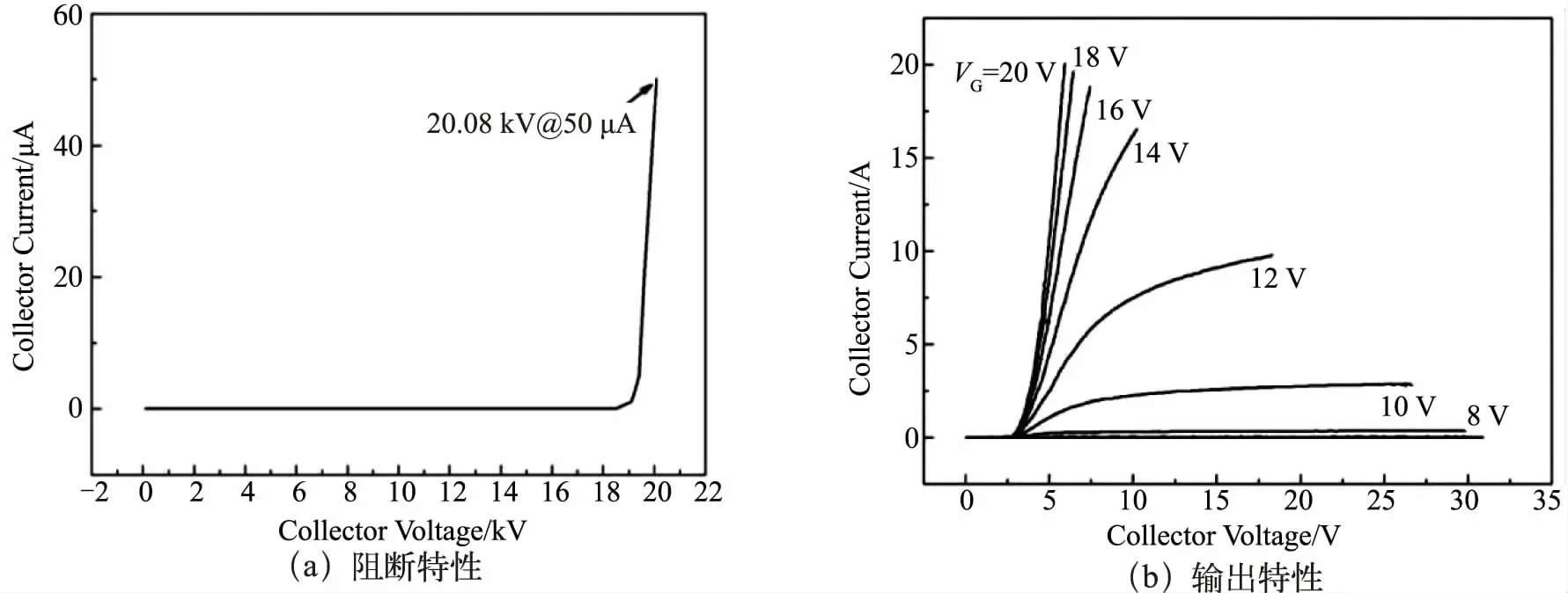
图18 超高压SiC N沟道IGBT的阻断特性和输出特性[16]
该团队还使用了长时间的高温氧化工艺对器件进行少子寿命的提升,通过高温热氧化过程,使得部分碳原子扩散到体区并填补碳空位,消除Z1/2缺陷中心。高温热氧化处理前后超高压SiC N沟道IGBT的输出特性如图19所示,芯片A引入了载流子寿命提升工艺,芯片B未引入载流子寿命提升工艺。观察发现,芯片B在栅极电压为20 V、集电极电流密度为70 A/cm2的条件下,器件导通压降为16.2 V,引入载流子寿命提升工艺后,芯片B在同等测试条件下,其导通压降降至6.5 V,这一结果也恰好验证了载流子寿命的提升能有效提高SiC N沟道IGBT器件的导通能力。
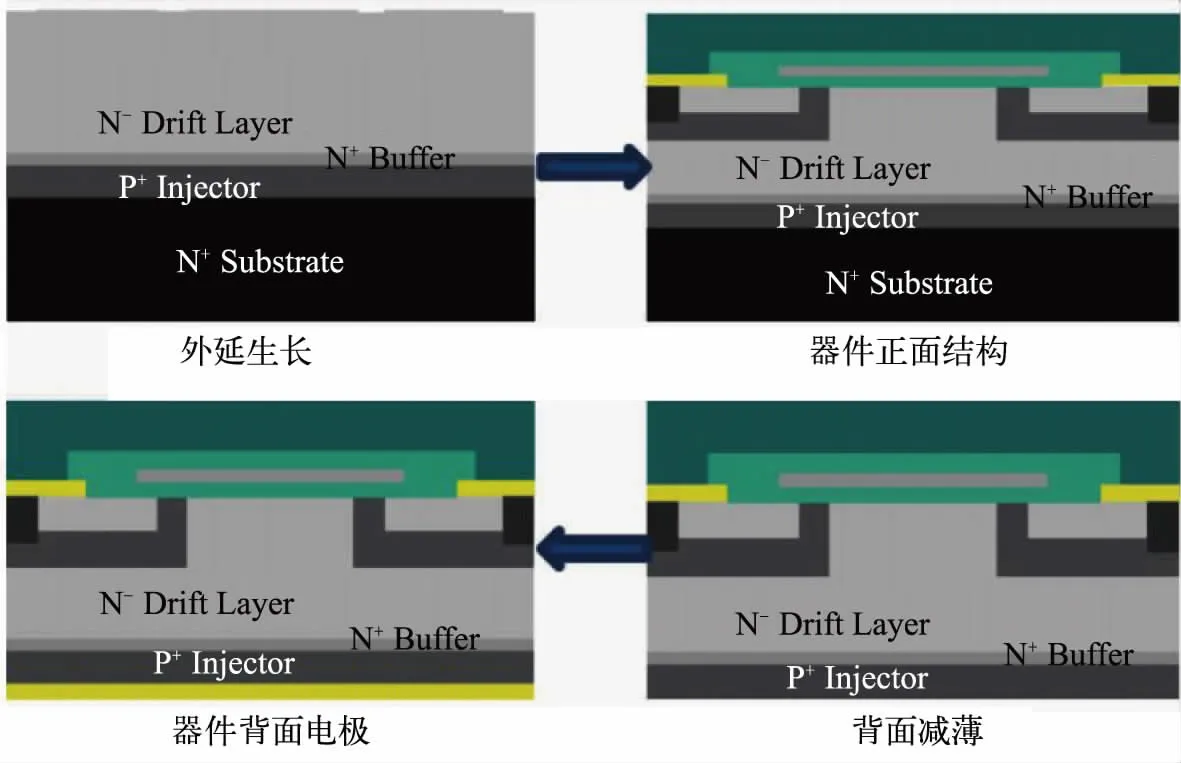
图17 超高压SiC N沟道IGBT制备方案[16]

图19 高温热氧化处理前后超高压SiC N沟道IGBT的输出特性[16]
该超高压SiC N沟道IGBT器件在制备过程中通过引入高温热氧化的载流子寿命提升技术,有效提高了其电导调制效应。且该器件在栅压为20 V、集电极电流为20 A时,其微分比导通电阻为27 mΩ·cm2,进一步缩小了与国际先进器件之间的差距。
2022年,WATANABE等人[21]对SiC IGBT引入了盒式元胞布局,该布局在传统的条形元胞布局的基础上进行了优化,增强了器件的电导调制,降低了器件的通态损耗,小幅增加了器件的关断损耗,N沟道IGBT器件结构如图20所示,条形元胞布局与盒式元胞布局如图21所示。该器件基于N型的SiC衬底,生长95μm厚的N型漂移层,用来承受10 kV的阻断电压,再生长一层N型的缓冲层,由于没有可用的P型衬底,之后需要在缓冲层的下面外延生长一层高掺的P型层作为器件的空穴注入层。接着将器件的N型衬底去除,在器件漂移区的顶部制作表面结构。
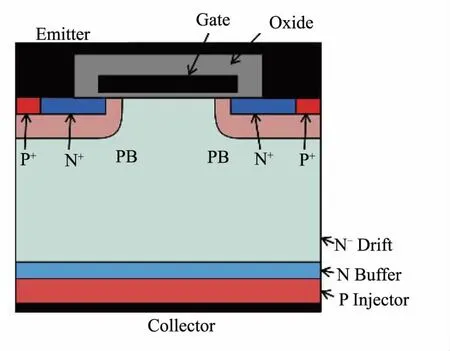
图20 N沟道IGBT器件结构[21]

图21 条形元胞布局与盒式元胞布局[21]
接着,WATANABE讨论了器件的静态特性,盒式元胞布局的IGBT器件相比条形元胞布局在同样的面积下具有更大的沟道宽度,这会增强器件源区的电子注入。另外,盒式元胞布局的IGBT器件的顶部P+区域面积更小,这将抑制发射极的空穴泄漏,同时可以增强器件的电导调制。条形元胞布局和盒式元胞布局的IGBT器件的输出特性对比如图22所示,对于200 A/cm2的电流密度,盒式元胞布局的IGBT器件和条形元胞布局的IGBT器件导通电压分别为6.5 V和7.4 V,盒式元胞布局使导通电压得到了降低。另外,盒式元胞布局的IGBT器件的特征微分比导通电阻为13 mΩ·cm2,该值比条形元胞布局的IGBT器件低了35%。
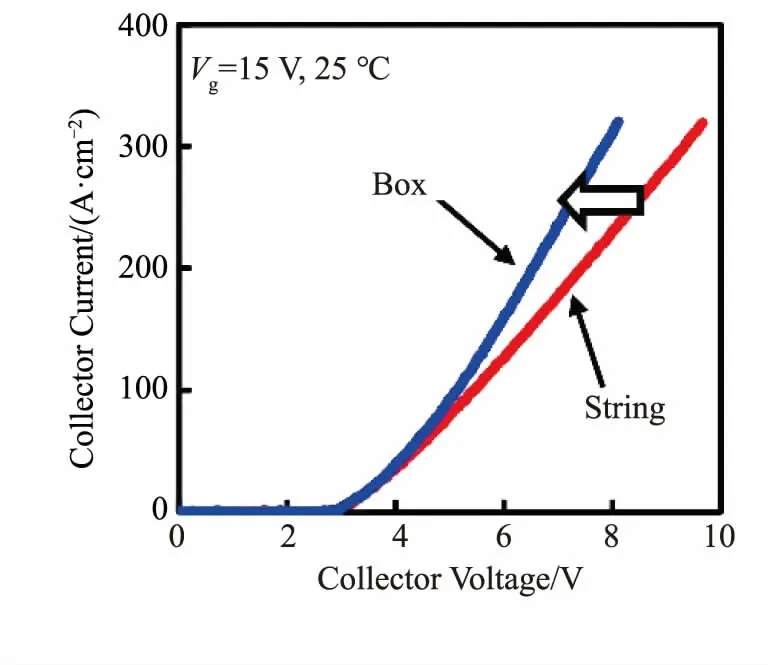
图22 条形元胞布局和盒式元胞布局的IGBT器件的输出特性对比[21]
随后,WATANABE分析了器件的动态特性,盒式元胞布局的IGBT器件的关断速度会比同样条件下的条形元胞布局的IGBT器件略慢,并且关断损耗会有轻微的增加。3.6 kV和125 A/cm2的转换条件下两种元胞布局的IGBT器件结构对应的关断曲线如图23(a)所示,相比条形元胞布局的IGBT器件,盒式元胞布局的IGBT器件关断速度从13.8 kV/μs降低到了12.5 kV/μs,关断损耗从53.1 mJ/cm2增加到了55.9 mJ/cm2。不同集电极电流下两种元胞布局的IGBT器件结构对应的关断损耗如图23(b)所示,即使在电流为300 A/cm2的转换条件下,盒式元胞布局的IGBT器件相比条形元胞布局的IGBT器件关断损耗也只增加了7%。盒式元胞布局提高了IGBT器件靠近发射极的漂移区载流子浓度,这部分载流子的抽取造成了器件的关断速度降低和关断损耗增加。

图23 两种元胞布局的IGBT器件的关断曲线与关断损耗[21]
最后,WATANABE讨论了盒式元胞布局对IGBT器件闩锁效应的影响。相比于传统的条形元胞布局,盒式元胞布局的IGBT器件P型体区和发射极电极的接触面积更小,从而具有更大的接触电阻,使得IGBT器件更加不易发生闩锁。300 A/cm2的状态下盒式元胞布局的IGBT器件结构对应的关断曲线如图24所示,器件在300 A/cm2的状态下也没有发生闩锁效应。

图24 300 A/cm2的状态下盒式元胞布局的IGBT器件的关断曲线[21]
盒式元胞结构与六角形元胞结构设计思路相同,相比于条形元胞分布,盒式元胞分布的沟道宽度更大,且该布局更易产生电导调制,因此盒式元胞布局的导通特性更好,该布局提升了器件靠近发射极的漂移区载流子浓度,故关断时间更长,盒式元胞布局因其具有发射极更大的接触电阻,同样可以提升抗闩锁能力。
相比于P沟道SiC IGBT,N沟道SiC IGBT发展较晚,这是由于SiC有低电阻率以及低缺陷密度的N型衬底而缺少高质量的P型衬底,在这些高电阻率和缺陷密度的P型SiC衬底上直接生长出来的N型SiC IGBT质量很差。但是因为SiC材料电子的迁移率比空穴的迁移率高,理论上来说,N沟道SiC IGBT将比P沟道SiC IGBT具有更好的导通特性,所以科研工作者一直致力于高质量N沟道SiC IGBT的研发。由于对N沟道SiC IGBT的研究较晚,P沟道SiC IGBT中已摸索的工艺如反向外延生长和自对准技术可直接使用到N沟道SiC IGBT中。但是对于N沟道SiC IGBT的动态特性仍需要进一步研究,无论是栅极与栅极驱动的优化设计,还是关断时电场的平缓度,都是未来器件设计与应用中需重点关注的内容。
4 结束语
本文从P沟道SiC IGBT和N沟道SiC IGBT发展历史中的经典器件入手,介绍了各种SiC IGBT器件的制作过程与相关性能,并就SiC IGBT的工艺优化与结构优化进行了报道,对比了P沟道SiC IGBT和N沟道SiC IGBT的优缺点。P沟道SiC IGBT在阻断能力与高温下的导通能力具有明显优势,而N沟道SiC IGBT在常温下的导通能力更具优势。SiC IGBT的结构由沟槽型逐步变为平面型,这与相关工艺的进步与平面型器件与生俱来的优势有关。平面型器件的JFET区电阻较高,因此CSL应运而生,其在降低JFET电阻的同时避免了离子注入的不利影响。除了传统的元胞结构外,六角形元胞结构与盒式元胞结构因其更高的宽长比更易获得更好的导通能力。对于SiC IGBT,终端结构同样重要,优秀的终端结构可以减缓电场的拥挤效应,进一步降低漏电流。
过去,对SiC IGBT的研究主要集中在美国和日本,国内起步较晚,但是在高压大功率输电、轨道交通等领域的大量应用驱动以及国家能源转型和碳达峰等政策的指导下,近几年中国的SiC IGBT研制取得了较好的成果和进展。目前SiC IGBT的相关工作还是以器件结构设计与仿真为主,解决器件制造的相关问题,制备出性能优异的SiC IGBT器件将是未来该领域重要的发展方向。在结构设计方面,业界针对器件集电区和发射极的结构改进已经做了很多工作,但超结SiC IGBT的设计相对较少,还有很大的研发空间;另外将Si IGBT的结构借鉴到SiC IGBT也是SiC IGBT研发的重要思路,但是在借鉴的过程中要重点注意Si材料和SiC材料特性的差别,这对异质结、肖特基结等结构与SiC IGBT的结合会产生重大影响。除此之外,能否引入新的物理机制以优化SiC IGBT器件的性能也是值得进一步深入研究的课题。在实现能源转型、推进碳达峰与碳中和以及建立新型电力系统的重要应用背景下,SiC IGBT器件的研究前景十分光明,其研制与应用一定会为社会和人类带来更加节能与清洁的美丽世界。
