用于手机非均匀分布热点的热电冷却系统设计
2022-10-20张锦扬曹丽莉
张锦扬 曹丽莉 缪 旻
(北京信息科技大学信息与通信工程学院 光电测量技术与仪器教育部重点实验室 北京 100101)
随着科技的发展,手机已经成为人们日常生活中不可或缺的一部分。然而,高功率、高算力的芯片所产生的非均匀分布热点将导致电子器件的热衰竭,并严重影响其效率、稳定、安全运行和使用寿命[1-2]。当手机芯片满负荷工作时,如果芯片的温度不能有效降低,芯片就必须采取降频策略来降低芯片的温度,以防止芯片损坏[3-5]。据报道[5-6],降低芯片频率的策略会使手机运行速度变慢约3倍。为了调控芯片温度,手机需要配套的制冷系统,且该制冷系统须满足高集成度和高散热量的特点[7-8]。大多数手机散热技术[9-12]如石墨烯散热技术、真空腔均热板散热技术(VC液冷),均为被动散热技术。石墨烯散热技术是依靠石墨烯良好的导热性将热量及时导出。VC液冷是一个内壁具有微细结构的真空腔体,通常由铜制成。当热量由热源传导至VC腔体时,腔体里的冷却液受热后开始产生气化现象,液体汽化吸热,当气相工质接触到较冷的区域时便会产生凝结的现象,借由凝结释放出之前吸收的热量。凝结后的冷却液会借由微结构的毛细管道再回到蒸发热源处,该过程将在腔体内周而复始进行。VC液冷原理上类似于热管,散热效果提升有限,且散热能力受环境温度影响较大。热电制冷器(thermoelectric cooler, TEC)是一种体积小、制冷量高的主动制冷器件,在手机制冷方面具有很高的应用前景[13-15]。
TEC是一种主动制冷装置,在电流的驱动下可以将热量从制冷器的冷端传递至热端。然而,随着热量在TEC热端迅速积累,热端温度升高,TEC的制冷效率将会下降。因此,在应用TEC时,应在其热端增加散热设计[13-15]。H. S. Huang等[16]采用循环水冷系统作为TEC热端散热装置,该制冷系统比传统水冷系统的制冷效率更高。Wang Jing等[17]提出一种将TEC和电晕风冷系统耦合的制冷装置。S. Al-Shehri 等[18]开发了一种应用于计算机芯片的热管理系统。在该系统中,TEC热端温度由热沉和风扇的组合进行调控。但该制冷系统体积较大,难以应用于手机制冷系统。此外,在上述研究中,热源均以恒定发热体替代,且大多为温度分布均匀的热源。因此,有必要根据实际芯片的热点分布设计热电制冷系统。通常,研究者使用TEC时,会将其冷端直接附着在热源表面[13-18],这种直接连接的方式并不能充分发挥热电制冷器的制冷效率,反而会增加设备的功耗。因此,设计热源与冷端之间的导热层是提高热电制冷系统制冷效率的最有效途径。利用TEC解决微芯片散热问题的研究逐渐受到关注,但目前对于非均匀分布热点问题的研究还很少[1-3,13-20]。微尺寸(约1 mm)的TEC虽然可以针对性地解决该问题,但其设计和制造过程较为复杂、造价十分昂贵,短期内还不能用于手机芯片制冷[21-22]。因此,本文将采用小尺寸(12.1 mm×11.2 mm)TEC构建热管理系统。
为增强TEC在小空间中的制冷效果,本文基于有限元仿真,对热电制冷系统中各向异性导热层和热端热沉进行设计。根据仿真结果,建立了基于TEC的热管理系统,并采用周期性供电系统来降低热沉温度和功耗。为了保证实验的真实性,以手机芯片作为热源并搭建相应的测试环境,采用开源程序使手机满载运行并实时监控其芯片利用率。
1 实验
1.1 基于Peltier效应的热电制冷器
构建了如图1所示的芯片模型[23-24],该模型参考一般芯片的微结构,由不同材料堆叠而成的多层组合。各层模型的尺寸如表1所示,模型中的所有材料参数均为实际材料的平均属性,如表2所示。该模型用于研究芯片满载时的温度场。此外,还构建了适用于该芯片模型的小型TEC模型,通过多物理场耦合和有限元数值分析的方法进行实体建模和单因素分析,以指导TEC在手机芯片制冷中的应用。

图1 芯片模型及网格划分Fig.1 Structure and mesh of chip model

表1 芯片模型尺寸Tab.1 Size of chip model
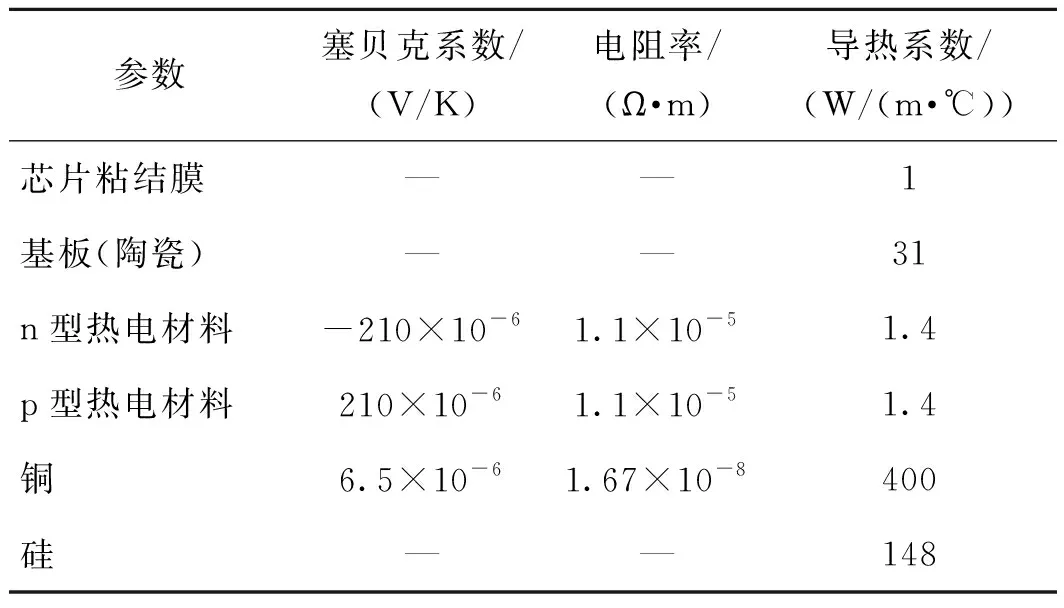
表2 模型材料参数Tab.2 Material parameters of model
1.2 热管理系统
手机满负荷工作时,温度迅速升高。为解决手机芯片散热问题,设计了基于仿真结果的热管理系统。该系统由TEC、控制器、热沉和电源组成。TEC的冷端与芯片通过导热层相连,热端与铜制热沉相连。电源和控制器为TEC提供可控能源。通过测量芯片的温度及芯片利用率来检验热管理系统对手机芯片的散热效果。
2 结果与讨论
2.1 芯片温度场
为研究芯片满载时的温度场分布,建立了芯片仿真模型。芯片的基板和填充物的网格尺寸为0.5 mm,其余结构的网格尺寸为0.2 mm。在本仿真中,环境温度设置为25 ℃,对流传热系数设置为300 W/(m2·℃);外部硅层A的光谱辐射力设置为2.5 W/mm3,外部硅层B的光谱辐射力设置为0.05~3 W/mm3,非均匀分布[5-6]。TEC模型及芯片模型温度场如图2所示。由温度场模拟结果(图2(a))可知,硅层的温度最高,最高温度达到102.8 ℃,这将破坏手机的大部分电子器件。为降低芯片温度,采用TEC对芯片进行制冷。基于现有工艺,设计了尺寸为12.1 mm×11.2 mm×1.95 mm的块状热电器件(图2(b))。由图2(c)可知,当环境温度为25 ℃时,TEC输入电流设置为300 mA,芯片的最高温度降至72.5 ℃,TEC成功地将芯片的热转移至热端。但如图2(c)中截面图所示,芯片温度呈现非均匀分布,TEC的冷端温度也呈现相同的分布。因此,本文将探索一种解决非均匀分布热点的方法,以提高制冷效率。
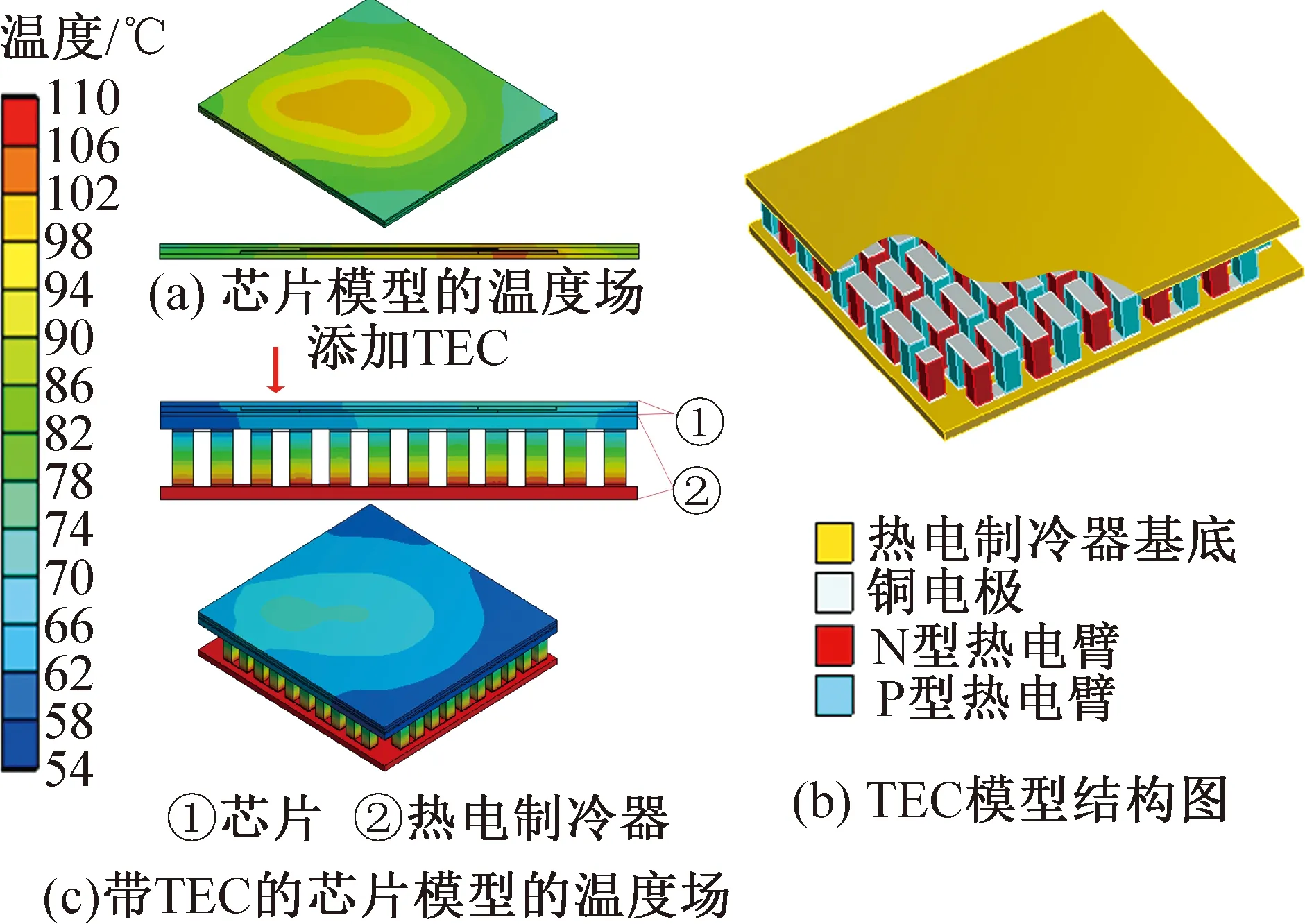
图2 TEC模型及芯片模型温度场Fig.2 Thermoelectric cooler model and temperature field of chip model
2.2 导热层设计
上述结果表明,TEC的引入降低了芯片的温度,但还未能解决热点分布不均匀的问题。为了提高制冷系统的效率并改善芯片温度场分布,本文探索了导热层的设计。添加导热层后芯片模型的温度场如图3所示。如图3(a)所示,导热层是一片厚度为0.1 mm,导热系数为1 W/(m·℃)的薄片,导热层的加入进一步降低了芯片的温度,但热分布的均匀性并未得到很大的改善。因此,改变了导热层的面外与面内导热系数,试图影响热传导的过程,从而改善芯片的热分布。

图3 添加导热层后芯片模型的温度场Fig.3 Temperature field of chip model after adding thermal conductive layer
图3(b)所示为面内与面外导热系数的比值对芯片温度的影响。当该比值大于1时,芯片温度降幅较大,且在相同比例下,随着面外导热系数的增大,降温幅度也在增大。当面外导热系数从1 W/(m·℃)增至5 W/(m·℃)时,芯片温度显著下降,但进一步增加面外导热系数并不会使芯片温度发生太大变化。当数值超过5 W/(m·℃)时,面内导热系数的增加对制冷效果的影响比面外导热系数更显著。
由图3(c)可知,当面外导热系数为60 W/(m·℃)时,芯片温度随面内面外导热系数比值的增加而降低。此外,芯片的热点集中在光谱辐射力数值较大的区域,热点的尺寸随着比值的增加而减小,特别是当比值大于1时,温度分布基本是均匀的,有效缓解了热点分布不均匀的问题。提高导热系数可使芯片温度分布更均匀,有效缓解了分布式热点问题,并使芯片温度保持在较低的水平,且在实际应用中,由于面内导热系数的增加对制冷效果的影响比面外导热系数更显著,应重点寻找面内导热系数大的导热层材料。
2.3 热沉设计
由2.2节的仿真结果可知,虽然芯片温度降低了,但TEC的热端温度非常高(约100 ℃),这对TEC是不利的,会降低TEC的效率。因此,设计了一种小尺寸的热沉以降低热端温度。图4所示为添加热沉后的温度分布,热沉为导热系数为400 W/(m·℃)的矩形块体,此外,2.2节设计的导热层面外导热系数为60 W/(m·℃)、面内导热系数为1 800 W/(m·℃)。与图3中的温度场对比可知,增加了热沉后TEC热端温度得到降低,芯片温度随热端温度的降低而进一步降低。结果表明,热沉对热电制冷系统的制冷效果非常重要。为进一步优化制冷效果,对不同尺寸的热沉进行了研究。

图4 带TEC、导热层和热沉模型温度场Fig.4 Temperature field of model with thermoelectric cooler, thermal conductive
图5所示为改变热沉厚度及其底面面积后芯片和热沉温度的变化,可知,温度随热沉厚度和面积的增加而降低。考虑到热管理系统的应用基础是小型电子设备,仿真中热沉厚度的变化范围较小。在相同底面面积下,热沉厚度从0.5 mm增至1.5 mm,芯片温度的下降不超过1 ℃,热沉温度下降不超过2 ℃。而在厚度相同的情况下,当热沉底面面积从98 mm2增至1 800 mm2时,芯片温度下降超过18 ℃,热沉温度下降超过45 ℃。结果表明,在小型电子设备中,增加热沉面积可以进一步提高TEC的制冷效率。

图5 热沉厚度和底面面积对制冷效果的影响Fig.5 Influence of heat sink thickness and lower surface area on refrigeration effect
2.4 热管理系统的验证
基于仿真结果,设计了一种高效的TEC,并应用于热管理系统以检验热管理系统的制冷效果。热管理系统及测试系统如图6所示,TEC与仿真模型同尺寸,且拥有65对热电对,最大制冷量为6.3 W,相关参数如表3所示。在实验中,热管理系统由带有导热层的TEC、热沉和控制器(Arduino UNO开发板及其外围电路)组成。TEC的冷端以导热硅胶与导热层连接,再贴合在手机芯片上,最后,将热沉附在TEC的热侧。导热层采用石墨烯复合膜,该产品具有胶面,便于直接贴附在手机芯片表面并且可以起到联接TEC的作用;根据出厂参数可知,导热层面内导热系数为1 500 W/(m·℃),面外导热系数为60 W/(m·℃)。此外,热沉采用边长为45 mm的矩形薄铜片。控制器用于调节TEC的工作状态。在测试系统中,采用直流稳压电源为控制器供电,采用多路温度计监控芯片和热沉的温度。

图6 热管理系统及测试系统Fig.6 Thermal management system and test system

表3 TEC参数Tab.3 Parameters of thermoelectric cooler
在测试中,利用应用程序使芯片满负荷工作,并通过TEC系统调控芯片的温度。由于芯片的自主保护策略[3-5],芯片的利用率在较高的温度下会受到限制以防止芯片热衰竭,随着芯片温度的下降限制将逐渐解除。此外,对采用被动散热的芯片进行了温度测量。测试结果如图7所示。由图7(a)可知,被动散热的芯片保持在约40 ℃。当使用TEC时,芯片温度随着电流的增加而迅速下降,当TEC通入的电流达到300 mA时,芯片温度降至30 ℃。但随着时间的推移,芯片的温度逐渐升高。此外,如图7(c)中紫色线条结果所示,热沉的温度急剧上升,这表明热沉在快速积累热量,即TEC热端温度快速上升,导致制冷效率的下降和芯片温度的上升。为了解决热积累问题,为TEC设计了周期性的供电策略,测量芯片和热沉在不同占空比下的温度。如图7(b)所示,芯片的温度迅速下降,然后在一个小范围内波动。随着供电周期占空比的减小,芯片温度在达到最低温度后趋于稳定。但当占空比小于50%时,芯片温度超过38 ℃,散热效率较差。如图7(c)所示,在TEC不工作的情况下,热沉温度为36.9 ℃。在TEC开始工作后,热沉温度迅速上升,导致TEC冷却效果逐渐下降,芯片温度升高。温升速率随占空比的减小而减小,说明减小占空比可以优化TEC的应用效果。由于手机是手持设备,热沉的温度需要控制到一定程度,否则会影响使用体验。

图7 实测结果Fig.7 Measured results
通过手机应用监控芯片利用率,结果如图7(d)所示。在连续输入300 mA电流的情况下,芯片的利用率先快速增加后持续下降。而采用周期性供电策略时,虽然降低了芯片的最大利用率,但提高了芯片的稳定性。此外,综合考虑散热效果和热沉的温度,采用占空比为75%的周期电源是制冷效果最为良好且稳定的策略。结果表明,采用基于TEC的热管理系统降低了芯片温度,提高了芯片利用率,提高了手机的流畅性。
TEC是一种主动制冷装置,通过调控输入电流,制冷量会随之改变,为精确调控目标温度奠定了基础。本文中采用的器件,其制冷量可达到6.3 W,是被动制冷无法企及的。但在带来可观制冷量的同时,该器件需要通入1.2 A、9.6 V的直流电流,这对于小型移动设备是较大的负荷,因此,采用周期性供电策略,一方面减少了TEC热端热量的积累,另一方面减少了约25%电功耗。
3 结论
本文通过有限元分析方法讨论了导热层和热沉对TEC制冷效率的影响,基于仿真设计开发了用于手机芯片的热电型热管理系统,得到如下结论:
1)在TEC与热点的接触面中添加导热层可以降低芯片温度,且导热层的面内导热系数越大,芯片的温度分布越均匀。
2)在TEC热端添加热沉可以有效降低TEC热端的温度,从而提高TEC的制冷效果;热沉面积越大,制冷效果提升越大,但在0.5~1.5 mm范围内热沉厚度的变化对制冷效果影响较小。
3)室温条件下,使用周期性供电策略,可以在不降低TEC响应速率的前提下有效降低TEC热端的热积累速率。
4)该热管理系统能使手机芯片的温度降至34 ℃,成功解决了手机芯片的散热问题。与传统的手机散热方案相比,基于TEC的热管理系统散热效率高,可控性好,还可以用于解决各种小芯片散热问题。
TEC是一种无活动性部件、体积小的主动制冷装置,为高度集成提供了可能性。另一方面,TEC制冷量十分可观,但对于手机这类需要不断充电的移动设备,TEC制的功耗较大,在今后的工作中需要深入探索,进一步优化制冷系统的能耗,在能耗和高效制冷之间寻求最佳平衡。
本文受北京新星项目多学科合作项目(Z191100001119013),北京市教委科研计划项目(KM202111232015),北京信息科技大学师资补充扶持项目(2019—2021)(5029011103)资助。(The project was supported by the Beijing Nova Programme Interdisciplinary Cooperation Project (No.Z191100001119013), the Scientific Research Project of Beijing Educational Committee (No.KM202111232015), the Supplementary and Supportive Project for Teachers at Beijing Information Science and Technology University (2019—2021) (No.5029011103).)
