GeS/MoS2异质结电子结构及光学性能的第一性原理研究
2022-04-14梁志华谭秋红王前进刘应开
梁志华,谭秋红,2,王前进,2,刘应开,2
(1.云南师范大学物理与电子信息学院,昆明 650500;2.云南省光电信息技术重点实验室,昆明 650500)
0 引 言
自2004年石墨烯被成功制备以来[1],六方氮化硼[2-3]、g-C3N4[4]、过渡金属硫化物[5-6]、黑磷[7]、Ⅳ单硫族化合物[8-9]等二维层状材料由于其特殊的结构以及新颖的电子性能而吸引越来越多研究者的关注。电子器件的小型化及多功能化的发展趋势使得人们对材料性能的要求越来越高,单一的二维材料难以更好地满足人们的应用需求,将不同的二维材料堆叠在一起形成范德瓦耳斯异质结,不仅可以保留单一材料优良性能,而且可以发挥二者的协同功能,使其展现出新的功能,因此得到越来越多研究者的广泛研究[10-15]。例如,异质结界面区域形成的内建电场能更好实现电子和空穴对的分离进而抑制两者的复合,使电子或空穴更顺利进行还原或氧化反应[12-14]。此外,二维范德瓦耳斯异质结的电子结构等性能还可以通过界面间距、应变、或者外加电场等手段[16-19]来调节。Wang等[18]研究了双轴应变对ZnO/GeC异质结的影响,结果表明双轴应变能明显调节ZnO/GeC异质结的带隙和带边排列,且所有应变异质结构都具有适合可见光吸收的带隙。Zhang等[19]研究了界面间距、电场对SnS2/polyphenylene异质结的影响,带隙随着间距的增加先增大后减小,在无电场影响时异质结为Ⅱ型异质结,当正向电场加到2 V/nm时转为Ⅰ型异质结,加到5 V/nm时转为Ⅲ型异质结,施加负向电场为-1.5 V/nm时转变为Ⅲ型异质结。
近年来,Ⅳ单硫族化合物与MoS2组成的异质结表现出优异的光电性能,其在光电器件方面极具潜力,因此受到了人们的青睐。Diao等[20]用化学气相沉积法制备了SnS/MoS2异质结,发现Ⅱ型带排列的SnS/MoS2异质结能有效地分离电荷,促使MoS2的光致发光熄灭,与孤立MoS2和SnS元件相比,SnS/MoS2异质结表现出明显增强的非线性光学特性。GeSe/MoS2异质结[21]在500 nm光照下光响应达到3.5×104AW-1;SnSe/MoS2异质结[22]属于Ⅱ型异质结,表现出具有超快光响应的自供能光电流 (<10 ms),以及高的开关电流比 (105); Xin等[23]报道了一种新颖的基于GeSe/MoS2p-n异质结的极化敏感自供电光电探测器,这归功于Ⅱ型异质结和内建电场的形成使异质结表现出增强的自供电光响应特性以及具有优越的偏振敏感特性;这些研究结果极大地激起了研究人员对该类异质结的研究兴趣。GeS是Ⅳ单硫族化合物中的一员,不仅具有地球含量丰富、毒性小、环境相容性好、化学稳定性好等优点[24],并且具有高的迁移率 (3 680 cm2·V-1·s-1)[25]和高的光响应 (173 AW-1)[26]等优异性能而被广泛研究和应用于光电[27]、压电[28]和锂电池[29]等领域。截至目前,单层GeS和MoS2形成的异质结在实验和理论上还未见报道,对该异质结的电子结构进行详细的理论研究可以为制备该异质结的研究者们提供理论支持和指导。
1 计算方法
本文采用基于密度泛函理论 (density functional theory, DFT) 的第一性原理计算方法,利用商业软件包QuantumATK (R-2020.09-SP1) 进行模拟计算。所有计算均采用原子轨道线性组合 (LCAO) 基组和PseudoDojo赝势,自洽标准均设置为10-4eV。优化计算中均使用Perdew-Burke-Ernzerhof (PBE) 泛函,其中异质结构具有范德瓦耳斯相互作用,因此Grimme DFT-D2修正项被添加在泛函中,力的收敛标准均设置为0.1 eV/nm。此外,PBE泛函经常低估带隙值[30],而Heyd-Scuseria-Ernzerhof (HSE06) 杂化泛函能够给出与实验结果更相近的带隙值[14,31],因此在计算电子结构 (能带、投影能带) 和光吸收谱时HSE06泛函被采用,而计算体系总能和电子密度时PBE泛函被采用,同样对异质结构Grimme DFT-D2修正项被添加在泛函中。对于单胞GeS和GeS/MoS2体系,截断能取值为85 Hartree,而单胞MoS2截断能取值为55 Hartree。对于GeS、MoS2单胞和GeS/MoS2异质结A模型 (B模型),Monkhorst Pack Grid K点取值分别为6×7×1、10×10×1和2×3×1(3×3×1),并且在z方向 (垂直异质结平面方向) 施加了3 nm的真空层以消除体系周期性结构的相互作用。
2 结果与讨论
2.1 GeS/MoS2异质结的构建及电子结构
优化后GeS单胞晶格常数为a=0.421 nm、b=0.378 nm,这与Li等[25]的计算结果(a=0.433 nm、b=0.367 nm)和Dimitri等[32]报道的GeS实验结果(a=0.430 nm、b=0.365 nm) 接近;而MoS2单胞晶格常数为a=b=0.319 nm,这与Zhang等[33]和Wilson等[34]的报道的结果(a=b=0.316 nm) 非常吻合。如图1为单层4×4×1 GeS和4×4×1 MoS2超胞结构图。图2是采用HSE06杂化泛函计算得到的GeS和MoS2单胞能带图,从图中可以看出GeS是带隙为2.22 eV的间接带隙半导体。值得注意的是GeS直接带隙为2.37 eV,其与间接带隙值相差仅为0.15 eV,因此GeS也被称为准直接带隙半导体[35]。MoS2是带隙为2.14 eV的直接带隙半导体,导带底和价带顶均处在K点位置。本文对GeS和MoS2带隙大小的计算结果与之前研究人员[36-37]用HSE06杂化泛函计算的结果基本一致。这也证实了计算结果的可靠性,为计算GeS/MoS2异质结的电子结构提供了可靠的保障。

图1 单层GeS和MoS2结构图Fig.1 Structure of monolayer GeS and MoS2
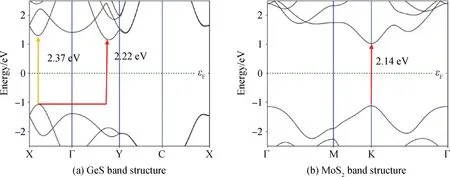
图2 GeS和MoS2能带图Fig.2 Band structure of GeS and MoS2
对于GeS/MoS2异质结,有两种不同类型的堆叠模型被构建,分别称为A模型 (A_model)和B模型 (B_model)。A模型为3×3×1 GeS超胞与4×2√3×1 MoS2超胞堆叠形成,而B模型使用√13×√5×1 GeS超胞与√21×√7×1 MoS2超胞堆叠而成。这样构建的A模型和B模型异质结的晶格失配率低分别为1.23%和1.35%。考虑到原子个数和失配率的原因,本文仅研究这两种模型。在A模型中,MoS2同侧两两相邻的S原子连成的直线有一条与GeS的Armchair方向平行,而在B模型中MoS2表面两相邻的S原子连成的三条直线均与GeS的Armchair方向不平行,其中有一条与GeS 的Armchair方向成42° 角,如图3所示。对构建的异质结模型进行结构优化后, A、B模型界面间距分别为0.300 nm和0.298 nm。异质结结合能的大小是评估异质结稳定性的一个参数。结合能定义为:
Ef=[EGeS/MoS2-EGeS-EMoS2]/N
(1)
式中:EGeS/MoS2、EGeS和EMoS2分别是GeS/MoS2异质结、单层GeS和单层MoS2的总能量;N为异质结总原子个数。经计算A、B模型的结合能分别是-47 meV/atom和-51 meV/atom,两模型结合能均小于0,说明两模型均能稳定存在。

图3 A、B模型结构和投影能带图Fig.3 A, B model structure and projected band structure
图3(c)、(f)分别为A、B模型投影能带图,从图中看出A、B模型中GeS的导带底 (conduction band minimum, CBM) 和价带顶(valence band minimum, VBM) 都高于MoS2的导带底和价带顶,所以A、B模型都是Ⅱ型异质结,即一个材料的导带底和价带顶分别高于另一材料的导带底和价带顶。这样的能带排列有利于电子从高导带底转移到低导带底、空穴从低价带顶转移到高价带顶。Ⅱ型异质结非常有利于光生电子空穴对的分离,减少复合。尤其是A、B型都有着大的导带带阶(conduction band offset, CBO) 和价带带阶(valence band offset, VBO),大的带阶可以提供一个强的电子空穴转移驱动力。由于形成交错的Ⅱ型能带排列使得异质结带隙远小于各层材料带隙,A、B模型带隙分别为0.88 eV、1.27 eV。这些数据说明GeS/MoS2异质结在光电器件、太阳能电池和光催化等领域有着潜在的应用。光吸收系数α(ω)是光电材料的重要参数,其计算公式为:
(2)
式中:ε1(ω)、ε2(ω)分别为介电函数的实部和虚部。根据上述公式,得到异质结的吸收光谱,如图4(a)所示。两种材料形成异质结,界面间必然发生电荷转移。为了研究GeS和MoS2间的电荷转移情况,异质结的差分电荷密度Δρ用如下公式计算:
Δρ=ρGeS/MoS2-ρGeS-ρMoS2
(3)
式中:ρGeS/MoS2、ρGeS、ρMoS2分别是GeS/MoS2异质结、GeS、MoS2单层电荷密度。图4(b)、(c)分别为A、B模型差分电荷密度图,从图中可知GeS表面失去电子;MoS2表面既有得电子区域也有失电子区域,其得电子区域主要是面中与Ge原子相对的区域。这很好地说明了S原子绝对电负性 (6.22 eV)[38]大于Ge原子绝对电负性 (4.6 eV)[38],导致电子更倾向向S原子附近偏移[39]。图4(d)、(e)分别为A、B模型平面平均差分电荷密度图,大于0的值为得到电子,小于0的值为失去电子,从图中看出MoS2表面电子密度小于0,说明了MoS2表面失电子数大于得电子数。

图4 (a)A、B模型异质结光吸收系数图;(b)、(c)分别代表A、B模型异质结空间差分电荷密度图,等值面为2.4 e·nm-3;(d)、(e) 分别代表A、B模型异质结平面平均差分电荷密度图,各图中左右竖直虚线分别代表GeS和MoS2的内表面Fig.4 (a) Absorption coefficient diagram of A, B model heterojunctions. Charge density difference of (b) A and (c) B model,with an isosurface value of 2.4 e·nm-3. The plane-averaged charge density difference for (d) A and (e) B model, the left and right vertical dotted lines in each figure represent the inner surfaces of GeS and MoS2 respectively
2.2 界面间距对GeS/MoS2异质结能带结构及光学性能的影响
异质结的形成会产生界面相互作用,调节异质结的界面间距会影响这种相互作用从而影响电子结构、电子转移等。图5中展示了不同界面间距下A模型异质结随界面间距变化的投影能带图。两种模型在整个界面间距研究范围内依然保持着原来的Ⅱ型能带排列。图6说明了两种模型异质结带隙都随着界面间距的增加而减小,B模型变化相对明显。不同界面间距下的光吸收系数,如图7(a)所示。界面间距越小光吸收系数在可见光范围略有提升,这是因为界面间距越小两种材料界面相互作用越大,由此产生的界面态就越多。这些GeS界面态一定程度上利于GeS在可见光范围对光的吸收,从而提升异质结在可见光范围的光吸收系数。图7(b) 是A模型异质结在不同界面间距下电子转移情况。从图中看出随着界面间距的减小,界面间的电子转移越明显,在面间距为0.26 nm时转移最为明显。这是因为S原子的绝对电负性大于Ge原子的绝对电负性,距离越近S原子对Ge原子的影响越大,S对Ge的影响起主要作用。随着距离的加大S原子对Ge原子的影响减小,两材料的绝对电负性大小起主要作用。材料的电负性可由如下公式计算[40]:
(4)
式中:χAaBb、χA、χB分别是AaBb化合物和A、B原子的绝对电负性。根据先前的研究结果Ge、S、Mo原子绝对电负性分别为4.6 eV、6.22 eV、3.9 eV[38],得到GeS、MoS2的绝对电负性分别为5.35 eV和5.32 eV。由于两种材料的绝对电负性相差不大 (0.03 eV),说明两种材料对电子的吸引能力相当。这导致在一定范围内界面间距越大中间的电子相对越多。

图5 不同界面间距下A模型异质结投影能带图Fig.5 A model projected band structure at different interlayer distance
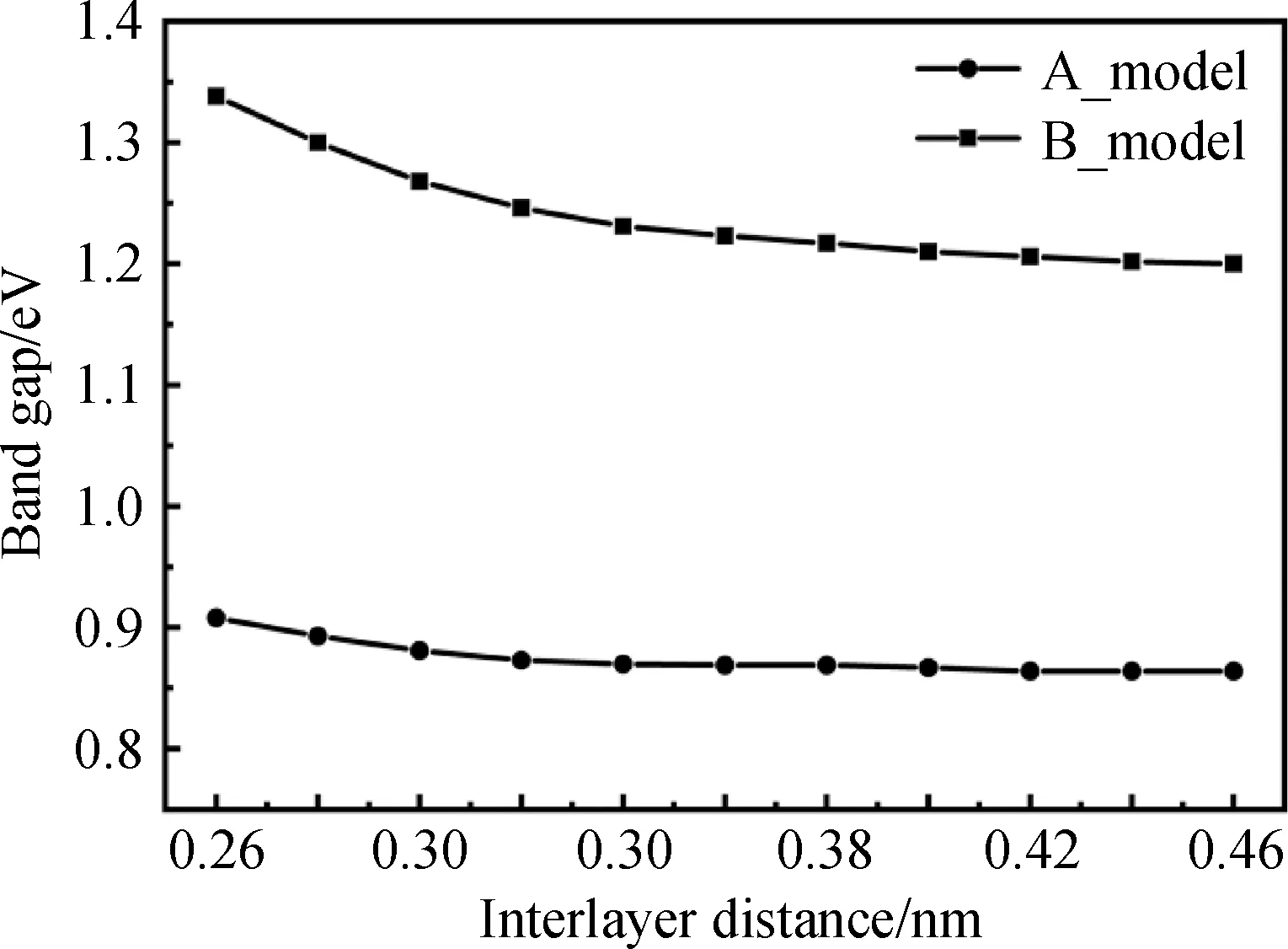
图6 A、B模型带隙随界面间距变化趋势Fig.6 Variation trend of band gap of A and B model with interlayer distance

图7 不同界面间距下A模型 (a)光吸收系数图和(b)平面平均差分电荷密度图,图中竖直虚线从左到右依次为GeS内表面和界面间距为0.26 nm、0.30 nm、0.34 nm、0.38 nm的MoS2内表面Fig.7 A_model (a) absorption coefficient diagram and (b) the plane-averaged charge density difference at different interlayer distance, the vertical dotted lines in the figure represent the inner surface of GeS and the inner surface of MoS2 with interlayer distance of 0.26 nm, 0.30 nm, 0.34 nm and 0.38 nm from left to right
2.3 应变对GeS/MoS2异质结电子结构及光学性能的影响
应变主要改变各材料面内的相互作用,从而影响异质结性能。应变又有单轴应变和双轴应变,单轴应变为对异质结的两个基矢方向 (除垂直异质结方向) 中的某一方向进行压缩或拉伸;双轴应变为同时对异质结构的两个基矢方向进行压缩或拉伸。应变量表示为:
(5)
式中:l0、l分别为晶格常数(a或b)应变前后的值。在本文中所建立的异质结模型中Armchair和Zigzag方向分别与x和y轴平行,因此只采用Armchair和Zigzag方向描述异质结的单轴应变。本文研究了应变量从-6%到6%下应变对异质结电子结构及光学性能的影响。图8中展示了A模型异质结在不同应变下的投影能带图,图9则展示了两种堆叠模型在不同应变下各材料的导带底和价带顶变化图。在整个应变研究范围内GeS/MoS2异质结均为Ⅱ型异质结。但是各材料的导带底和价带顶在异质结投影能带中的位置有所不同。双轴和Zigzag轴应变对GeS的导带底影响明显,随应变从-6%到6%而上升,因此GeS带隙在增大。而MoS2有所不同,所有应变下,MoS2价带顶相比于导带底变化大,随应变从-6%到6%而上升,所以MoS2带隙在减小。MoS2和GeS形成异质结后两材料仍然保留着孤立GeS[41]和MoS2[42-43]随着应变的变化规律:GeS随着结构拉伸带隙增大,而MoS2随着结构拉伸带隙减小。如图10(a)、(b)分别是A、B模型在单、双轴应变下的带隙变化曲线。在双轴应变下两模型的异质结带隙都随着结构的拉伸而减小,随着结构的压缩而带隙先变大后减小。A模型异质结的带隙随着单轴应变从-6%到6%而减小,Armchair轴的变化大于Zigzag轴的变化;B模型异质结在单轴应变上略有不同,相较于A模型应变量在-6%到-4%处出现反常 (带隙增大),随后应变量从-4%到6%过程中Armchair方向应变带隙逐渐减小,而Zigzag方向带隙变化平缓。由于应变对各材料的带隙变化影响明显,而异质结的光吸收主要取决于各材料的电子跃迁,因此应变对异质结光吸收系数有着明显的影响。如图10(c)所示,为A模型在不同双轴应变下的光吸收系数。随着拉伸应变量增大光吸收系数有着明显的红移现象,这使得异质结的光吸收系数在可见光内有大的提高。这是因为MoS2的光吸收系数高于GeS,异质结的光吸收系数受MoS2的影响更大。随着应变的加大MoS2带隙减小,光吸收谱发生红移。图10(d) 给出的平面平均差分电荷密度图,与界面间距相比,电荷密度转移改变不大,因为应变主要影响面内电荷密度,对界面间电荷密度改变较小。

图8 不同应变下A模型投影能带图Fig.8 A model projected band structure at different strain

图9 A、B模型中GeS和MoS2导带底和价带顶随应变变化图Fig.9 CBM and VBM of GeS and MoS2 in A, B model change with strain

图10 (a)A和(b)B模型异质结带隙随应变的变化图;A模型在不同双轴应变下(c)光吸收系数图和(d)差分电荷密度图,图中左右竖直虚线分别为GeS和MoS2的内表面Fig.10 (a) A, (b) B model heterojunctions band gap vary with strain; A model (c) absorption coefficient and (d) the plane-averaged charge density difference under different biaxial strains, the left and right vertical dotted lines in the figure represent the inner surfaces of GeS and MoS2 respectively
2.4 电场对GeS/MoS2异质结电子结构及光学性能的影响
电场也是调节异质结电子结构的主要手段,相比于应变调控,实验上电场调控更容易实现。规定电场正方向与z轴方向相同,即从GeS指向MoS2的方向为正方向。研究了电场强度从-12 V/nm到12 V/nm范围内异质结电子结构和光学性质的变化结果,结果表明两种堆叠模型有着相同的变化规律:随着电场从-12 V/nm到12 V/nm变化,GeS的导带底和价带顶分别向下移动,而MoS2的导带底和价带顶分别向上移动,如图11和图12(a)、(b)所示。当正向电场达到一定大小时异质结转为导带底和价带顶分别由MoS2和GeS贡献的Ⅱ型异质结,异质结带隙由此开始减小,如图12(c) 所示。当电场强度为-10 V/nm时,A型异质结实现从Ⅱ型异质结到Ⅲ型异质结的转变。Ⅲ型异质结中GeS价带顶高出MoS2导带底,使得电子很容易从GeS层的价带顶直接隧穿到MoS2层的导带底,这是隧道场效应晶体管非常理想的能带排列。这说明GeS/MoS2异质结在隧道场效应晶体管方面有着潜在的应用。由于构成异质结的各组分材料的带隙并没有明显变化,因此异质结的光吸收谱并未发生大的变化,如图13(a) 所示。

图11 不同电场下A模型投影能带图Fig.11 A model projected band structure at different electric field
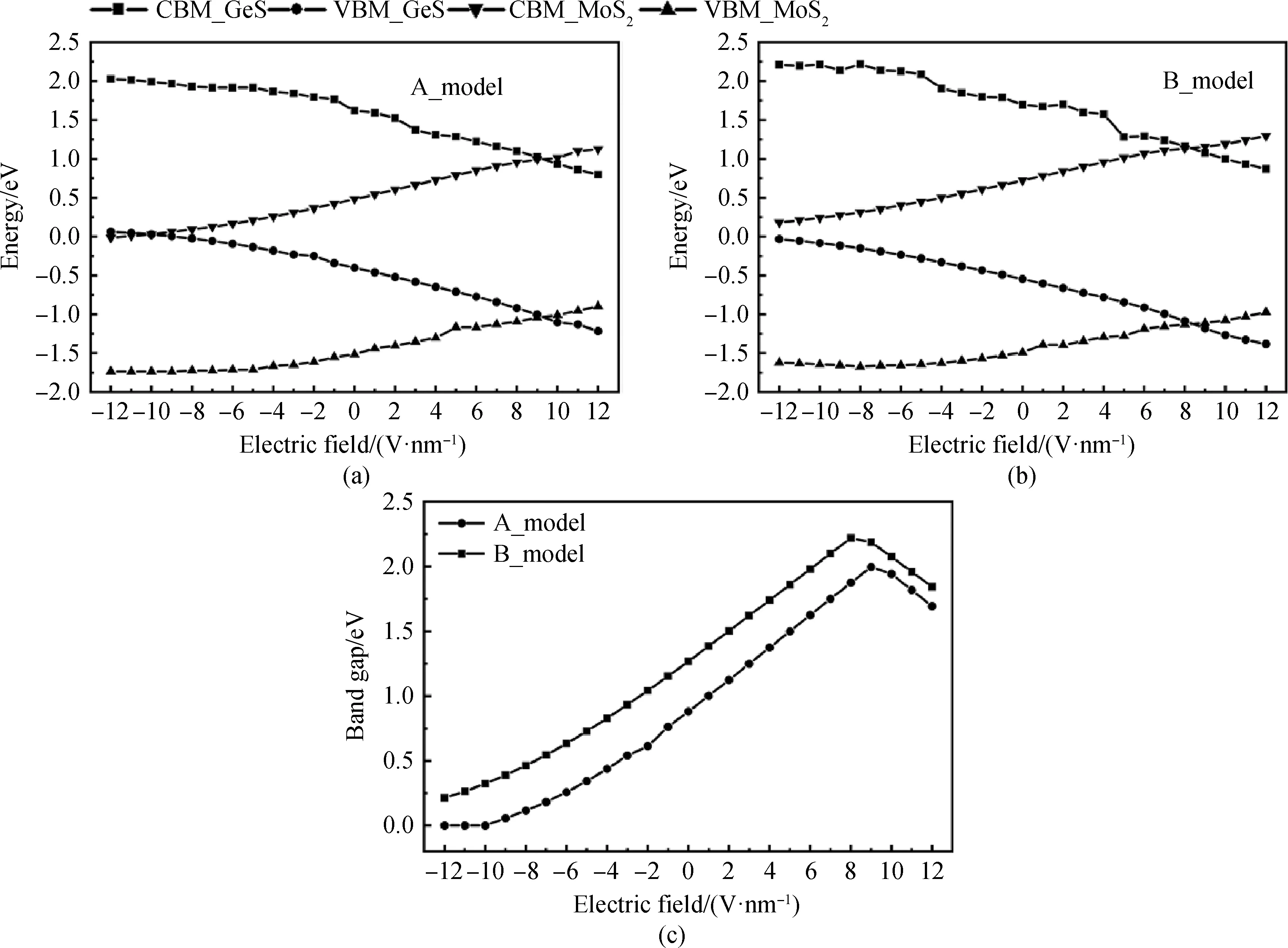
图12 (a)A和(b)B模型异质结中GeS和MoS2的导带底和价带顶分别随电场变化图;(c)A、B模型异质结带隙随电场变化图Fig.12 Variation of CBM and VBM of GeS and MoS2 with electric field in (a) A and (b) B model; (c) variation of band gap of A and B model with electric field
当有外电场存在时,异质结界面处的电子转移必受电场影响。值得说明的是计算电场作用下差分电荷密度时,公式(3) 中ρGeS/MoS2的数值为在电场下的数值,ρGeS、ρMoS2的数值为无电场的数值[44]。当施加正电场时,电场驱动GeS内表面电子向外表面偏移,驱动MoS2外表面电子向内表面偏移,让GeS和MoS2内表面分别聚集空穴和电子在异质结内部形成GeS指向MoS2(方向与外电场一致) 的内部电场。当加负电场时,情况相反,如图13(b)所示。

图13 不同电场下A模型的(a)光吸收系数图和 (b)平面平均差分电荷密度图,图中竖直虚线从左到右分别代表GeS外、内表面和MoS2内、外表面Fig.13 A model (a) absorption coefficient diagram and (b) the plane-averaged charge density difference, the vertical dotted lines in the figure represent the outer and inner surfaces of GeS and the inner and outer surfaces of MoS2 from left to right
3 结 论
本文基于密度泛函理论,采用商业模拟软件包QuantumATK对GeS/MoS2异质结的电子结构及光学性质进行了研究。研究表明,GeS/MoS2异质结是导带底和价带顶分别由MoS2和GeS贡献的Ⅱ型异质结。此外,本文还研究了界面间距、应变以及电场对异质结电子结构及光学性能的影响。GeS/MoS2异质结电子结构在不同界面间距和应变下仍然保持着原来的Ⅱ型异质结。界面间距主要影响异质结界面间的电子转移,界面间距越小,S原子对Ge原子的影响越大,越有利于电子向MoS2一侧转移。应变对光吸收谱的改变非常大,随着拉伸应变的加大,光吸收谱发生红移现象。A模型异质结在外电场为-10 V/nm时,异质结带隙为零,从半导体性转为金属性的Ⅲ型异质结,扩展了其在光电器件中的应用。当正向电场到达一定值时,异质结变成导带底和价带顶分别由GeS和MoS2贡献的Ⅱ型异质结。不仅如此,电场还可以改变电子的转移方向。这些结果表明GeS/MoS2异质结在光催化、光电器件等领域具有潜在应用,可以为设计与GeS/MoS2相关的光电器件提供理论指导。
