溅射功率和溅射时间对Mg2Si纳米晶薄膜结构和电阻率的影响
2021-11-03廖杨芳
廖杨芳,谢 泉
(1.贵州师范大学物理与电子科学学院,贵阳 550001; 2.贵州大学大数据与信息工程学院,贵阳 550025)
0 引 言
金属硅化物即金属与硅化合而成的物质,由于其电阻率比多晶硅低,且其与硅基体的界面能形成原子级的洁净界面,相容性很好,因而在微电子领域如作为肖特基势垒和互联材料得到广泛应用,但其能否集成到微纳电子器件中,主要依赖于能否精确控制其合成过程。因此,金属硅化物的生长在过去的几年中得到了广泛的研究,其主要目标是与衬底达到低接触电阻[1]、高热稳定性[2]和纳米尺度薄膜的厚度控制[3]。
硅化镁(Mg2Si)薄膜作为一种有前景的半导体,被广泛应用于电子[4]、机械[5]和红外光电子领域[6-7]。在硅[8]、玻璃[9]、Al2O3[10]、MgO[11]、CaF2[12]等衬底上形成的Mg2Si薄膜在热电和硅基器件方面都显示出了巨大的潜力。但这些Mg2Si薄膜采用的溅射源一般为单质Mg及单质Si,其厚度一般为1 μm左右,且薄膜的表面不够平整,导致样品中缺陷密度大,这些高密度缺陷将强烈地影响其性质。为了制备厚度薄、表面平整、缺陷密度小的Mg2Si薄膜,采用Mg2Si烧结靶作为溅射源是理想的选择。但传统的熔融凝固法制备Mg2Si靶存在以下困难:Mg和Si的熔点相差较大、Mg的饱和蒸汽压高且Mg与坩埚容易发生腐蚀性反应。如今放电等离子烧结(spark plasma sintering, SPS)方法可以较好地克服这些困难,使得烧结Mg2Si靶变得容易。
为了制备出结晶良好的高质量Mg2Si薄膜,首先需要确定溅射参数如溅射功率和溅射时间对薄膜的影响。
1 实 验
采用射频磁控溅射方法在蓝宝石衬底上沉积Mg2Si薄膜。溅射靶材为商用Mg2Si烧结靶,纯度(质量分数)为99.9%,规格为φ60 mm×5 mm。衬底为20 mm×20 mm的蓝宝石。溅射室背底真空为 5×10-5Pa。溅射功率分别为90 W、100 W、110 W、120 W、130 W和140 W。
样品分为三组:第一组研究溅射功率对溅射速率的影响。溅射时间均为10 min,未退火。第二组研究溅射功率对样品结构的影响。溅射时间均为40 min,退火温度为350 ℃,退火时间为1 h。第三组研究溅射时间对样品结构的影响。溅射功率均为100 W,溅射时间分别为10 min、20 min、30 min、40 min、50 min和60 min,退火温度为350 ℃,退火时间为1 h。
采用Alpha-Step IQ型台阶仪测量样品的沉积速率,则薄膜厚度为沉积速率与沉积时间的乘积。采用锐影(Empyrean)X射线衍射仪测试样品的晶体结构,所用的Cu-KαX射线波长为0.154 nm,掠入射角为0.5°,加速电压为45 kV,加速电流为40 mA,扫描步长为0.02°,扫描范围为20°~80°。采用LabRAM HR Evolution型共焦显微拉曼光谱仪测试样品的拉曼光谱,激发光波长为532 nm。采用直线型数字式四探针测试仪器(RTS-8)测试样品的电阻率。
2 结果与讨论
2.1 溅射功率对Mg2Si薄膜沉积速率的影响
在溅射参数(溅射功率、溅射气压、氩气流量、溅射时间等)中,溅射功率是影响薄膜沉积速率的重要因素之一。首先研究溅射功率对Mg2Si薄膜沉积速率的影响。
图1为射频溅射功率分别为 90 W、100 W、110 W、120 W、130 W和140 W时,薄膜的沉积速率随溅射功率的变化关系。从图中可以看出,溅射功率越大,沉积速率越大,主要是由于溅射功率越大,相应的氩离子通量及其轰击靶材的平均动能越大。与Chan等[13]报道的靶材溅射速率与溅射功率有相似的依赖关系。

图1 不同溅射功率时Mg2Si靶的沉积速率Fig.1 Deposition rate of Mg2Si target at different sputtering powers
2.2 物相分析
图2为溅射功率分别为 90 W、100 W、110 W、120 W、130 W和140 W,溅射时间为40 min,退火温度为350 ℃,退火时间为1 h的Mg2Si薄膜的XRD图谱。从图中可以看出,所有样品均呈现出尖锐的Mg2Si衍射峰,其中Mg2Si (220)峰最强。当溅射功率为100 W时,样品的衍射峰明显强于溅射功率为90 W的样品;但是,当功率超过100 W,样品中出现了偏析出来的单质Mg,且随着功率增加,单质Mg对应的衍射峰越来越强。这是因为溅射功率增加,氩离子所具有的能量增加,而靶材中的不同种类的原子具有不同的束缚能,从而造成不同原子溅射的速率不同而出现偏析现象。Li等[14]也报道了由溅射功率增加导致金属相析出的现象。因此,该条件下Mg2Si靶的最优溅射功率为100 W。图3为蓝宝石衬底上Mg2Si靶的溅射时间为10~60 min时薄膜的XRD图谱。溅射功率均为100 W,退火温度为350 ℃,退火时间为1 h。从图中可以看出,所有样品的衍射峰均为Mg2Si晶体的衍射峰,其中最强峰为(220)峰。溅射时间为10~40 min时,随着溅射时间增加,样品的XRD强度逐渐增强;继续增加溅射时间,样品的衍射峰强度开始减弱,且在约42°处出现微弱的MgO衍射峰。薄膜的溅射时间太长,即使退火处理也无法完全释放应力,因此薄膜的结晶质量变差,衍射峰变弱,且晶界处容易出现氧化现象。

图2 蓝宝石衬底上Mg2Si靶不同溅射功率时薄膜的XRD图谱Fig.2 XRD patterns of Mg2Si thin films on sapphire substrate at different sputtering powers using Mg2Si target
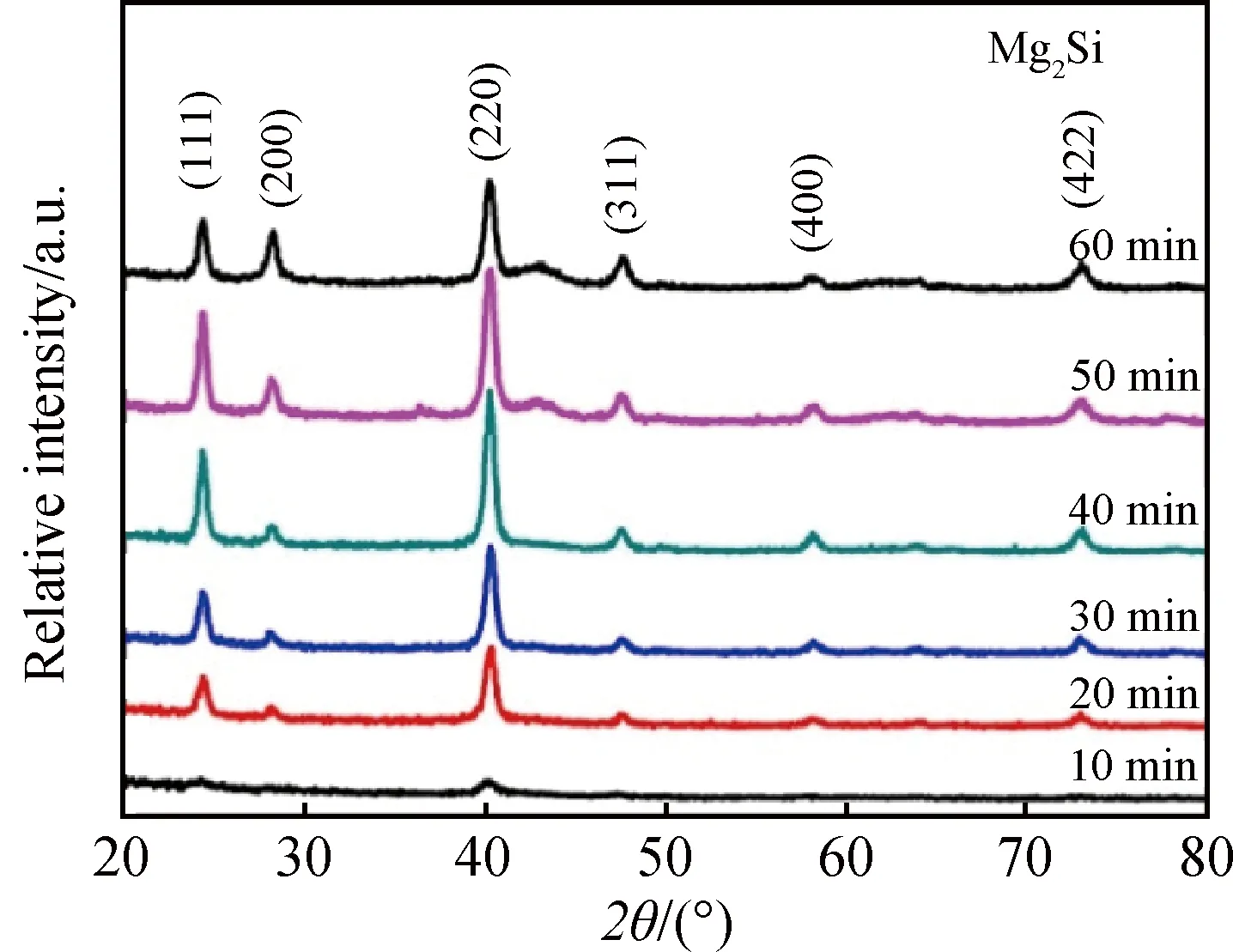
图3 蓝宝石衬底上Mg2Si靶不同溅射时间时薄膜的XRD图谱Fig.3 XRD patterns of Mg2Si thin films on sapphire substrate for different sputtering time using Mg2Si target
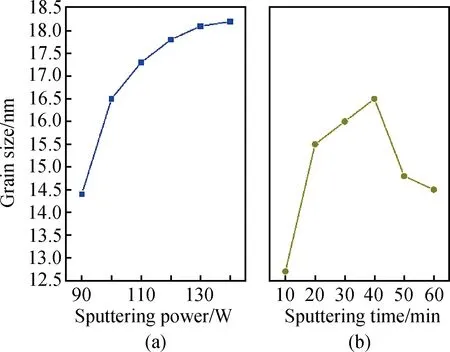
图4 晶粒尺寸随溅射功率(a)和溅射时间(b)的变化关系Fig.4 Variation of grain size with sputtering power (a) and sputtering time (b)
2.3 拉曼光谱分析
图5为蓝宝石衬底上不同溅射功率条件下Mg2Si薄膜的拉曼光谱图。从图中可以看出,所有样品均展现出Mg2Si晶体的特征拉曼峰,即256 cm-1处的F2g模及347 cm-1附近的F1u(LO) 声子振动模,说明该条件下得到了结晶良好的Mg2Si薄膜[6,18]。从图2可知,当溅射功率大于100 W时,样品中有Mg偏析出来,但由于Mg为金属,没有拉曼模[16],因此这些样品中未出现金属Mg相关的振动模。
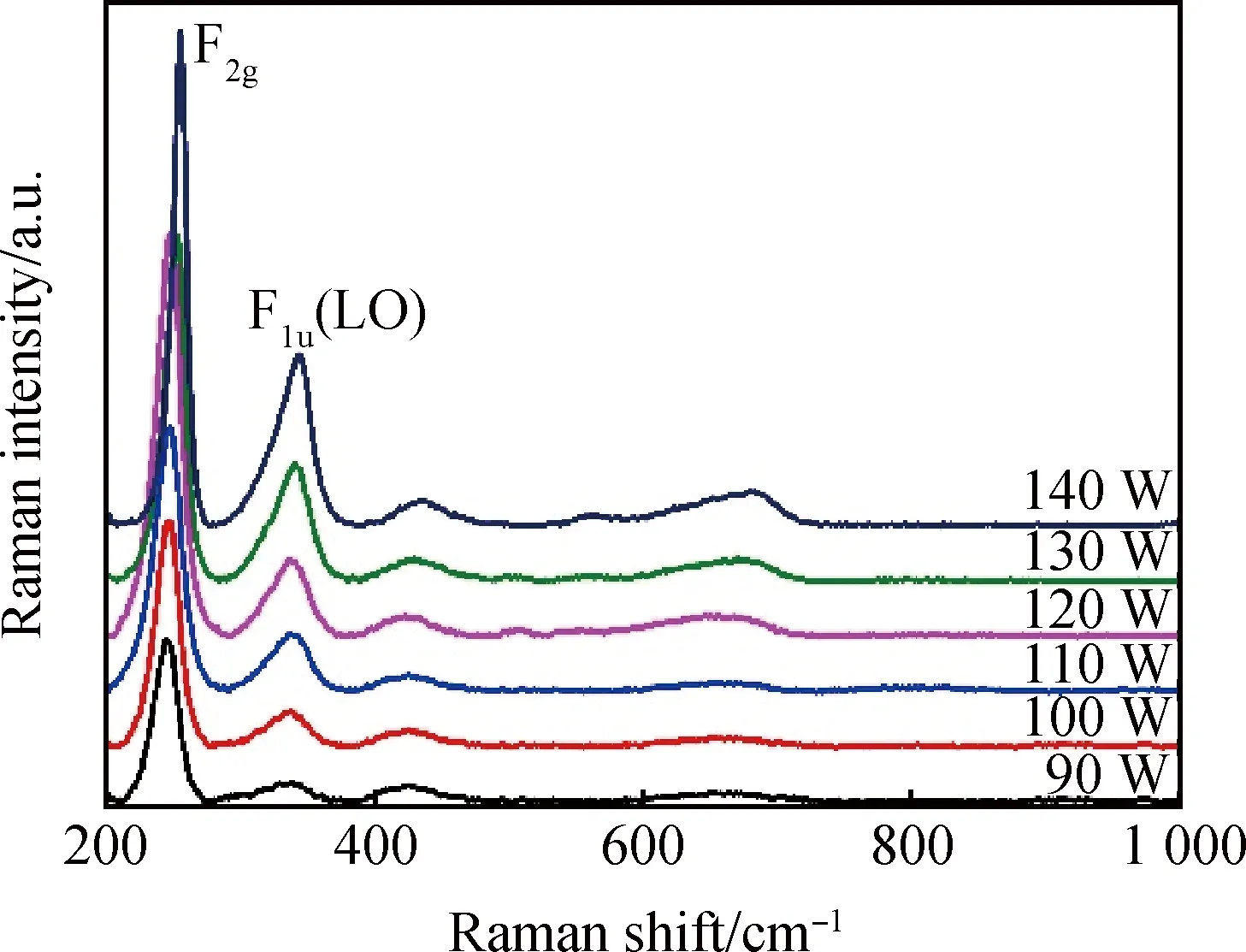
图5 蓝宝石衬底上Mg2Si靶不同溅射功率时Mg2Si薄膜的拉曼光谱Fig.5 Raman spectra of Mg2Si thin films on sapphire substrate at different sputtering powers using Mg2Si target
图6为蓝宝石衬底上Mg2Si溅射时间为10~60 min样品的拉曼光谱。从图中可以看出,所有样品均展现出Mg2Si晶体的特征拉曼峰,即256 cm-1处的F2g模及347 cm-1附近的F1u(LO)声子振动模,说明该条件下得到了结晶良好的Mg2Si薄膜。随着溅射时间增加,拉曼峰逐渐增强。当溅射时间为50~60 min时,样品在500 cm-1处出现明显的MgO峰,与XRD结果一致。

图6 蓝宝石衬底上Mg2Si靶不同溅射时间时Mg2Si薄膜的拉曼光谱Fig.6 Raman spectra of Mg2Si thin films on sapphire substrate for different sputtering time using Mg2Si target
结合XRD与拉曼光谱可得,该条件下Mg2Si靶的最优溅射时间为40 min。
2.4 薄膜的电阻率
蓝宝石衬底上Mg2Si薄膜的电阻率随溅射功率的变化关系如图7(a)所示。从图中可以看出,随着溅射功率增大,电阻率逐渐减小,主要原因是:(1)溅射功率增大,样品的晶粒尺寸变大,晶界散射作用减小。(2)当溅射功率大于100 W时,样品中出现了析出的金属Mg,金属Mg含量越多,样品的电阻率越低。
Mg2Si薄膜的电阻率随溅射时间的变化关系如图7(b)所示。从图中可以看出,随着溅射时间增加,薄膜的电阻率先减小后增大,当溅射时间为40 min时,电阻率达到最小值。这是由于溅射时间为10~40 min时,样品的晶粒尺寸随着溅射时间增加而增加,晶界散射作用减小;溅射时间为50 min或60 min时,样品中出现了少量的MgO,MgO是离子晶体,自由载流子非常少,导致样品的电阻率增大。根据Tellier有效平均自由程模型[19],薄膜的电阻率ρ可以表示为:
(1)
式中:ρB为块体电阻率;l0为块体电子平均自由程;d为薄膜厚度;p为镜面反射因子,对于纳米晶薄膜,镜面散射因子p=0,因此公式(1)变形为:
(2)

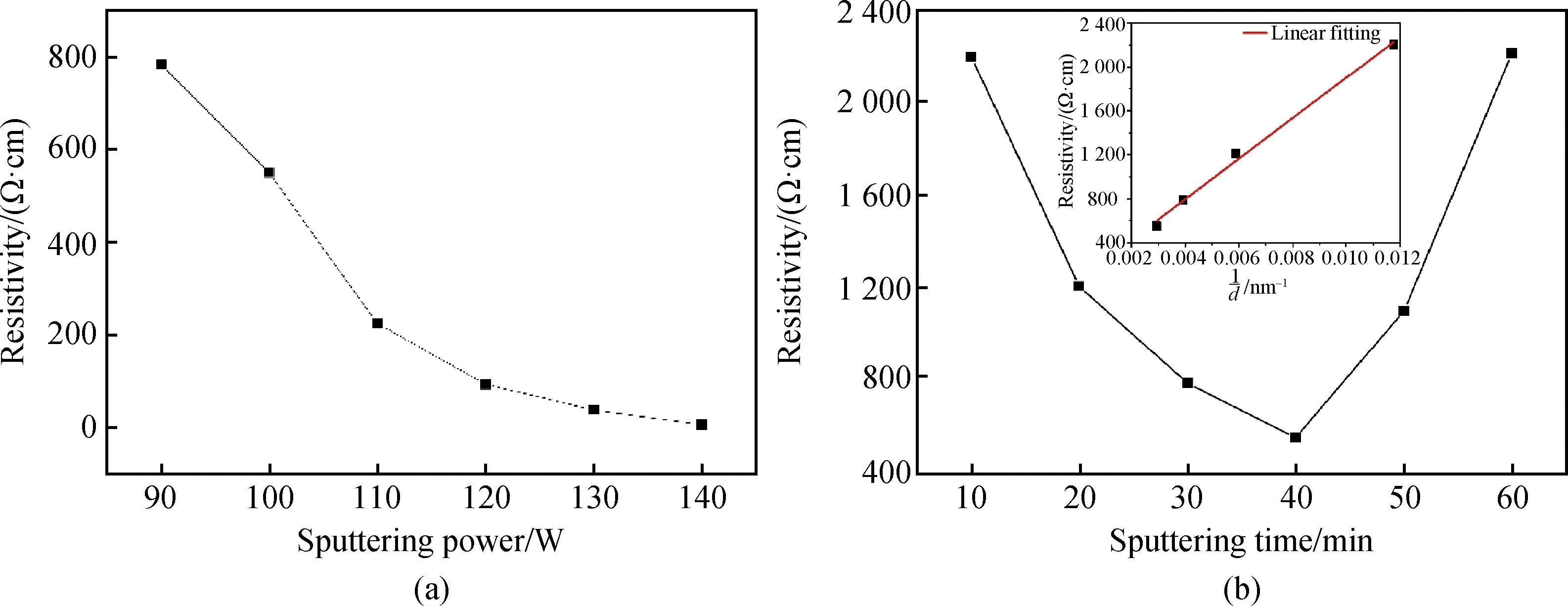
图7 Mg2Si薄膜的电阻率随溅射功率(a)和溅射时间(b)的变化关系,图(b)内的插图为电阻率与薄膜厚度倒数的函数图(溅射时间为10~40 min)Fig.7 Variation of resistivity for the Mg2Si thin films as a function of sputtering power (a) and sputtering time (b), the inset of (b) is the variation of ρ versus inverse thickness (sputtering time is in range of 10 min to 40 min)
3 结 论
采用射频磁控溅射Mg2Si烧结靶方法在蓝宝石衬底上制备了Mg2Si薄膜,研究了溅射功率及溅射时间对Mg2Si薄膜的沉积速率、结构和电阻率的影响。结果表明:(1)溅射功率越大,沉积速率越大。(2)随着溅射功率增加,样品的XRD衍射峰逐渐增强,但当功率超过100 W,样品中出现了偏析出来的单质Mg,且随着功率增加,单质Mg对应的衍射峰越来越强。(3)随着溅射时间增加,样品的XRD强度先增强后减弱,溅射时间为40 min时,样品的XRD衍射峰最强。继续增加溅射时间,样品中出现微弱的MgO衍射峰。(4)所有样品均展现出Mg2Si晶体的特征拉曼峰,即256 cm-1处的F2g模及347 cm-1附近的F1u(LO)声子振动模。但当溅射时间大于40 min时,样品中出现少量的MgO峰。因此,采用Mg2Si烧结靶作为溅射靶材时,溅射功率100 W,溅射时间40 min是最优的溅射参数。(5)薄膜的电阻率随着溅射功率增大而减小。随溅射时间的增大,电阻率先减小后增大,溅射时间为40 min时,样品的电阻率最小。
