Nano-LED半极性面InGaN/GaN单量子阱结构极化和光谱仿真分析
2021-01-12王鑫炜刘宏伟张赞允李晓云宁平凡王笃祥牛萍娟
王鑫炜, 刘宏伟*, 高 克, 张赞允, 李晓云, 宁平凡, 王笃祥, 牛萍娟
(1. 天津工业大学 电子与信息工程学院, 天津 300387;2. 天津市光电检测与系统重点实验室, 天津 300387; 3. 天津三安光电有限公司, 天津 300384)
1 引 言
GaN纳米发光二极管(Nano-LED)是基于纳米尺度GaN三维结构的发光二极管,得益于其纳米尺度、高响应速度和高光效等特性,其在微纳显示、高速可见光通信、环境监测和光学传感等多种领域具有广阔的应用前景[1-4]。Nano-LED为亚微米级三维核壳结构[5-8]。Nano-LED由非极性面生长的侧壁及半极性面生长的顶端组成,其中非极性面生长的侧壁不受材料极化影响,而半极性面生长的顶端量子阱将会受到自发极化电场和压电极化电场的影响[6],导致Nano-LED整体的发光光谱及发光强度变化[9]。在Nano-LED单色高效发光器件的制备过程中,提高Nano-LED器件中的纳米柱高度、利用Nano-LED高比表面积增加侧壁非极性面发光面积、减小顶部半极性面的影响是目前的研究热点[9-11],但过高的纳米柱高度为后续Nano-LED 非极性面侧壁材料生长带来一定的困难[12]。以高度5 mm、直径1 mm的Nano-LED器件为例,半极性面和非极性面面积比为4.33%,对于高度为1 mm、直径为1 mm的器件,半极性面和非极性面面积比增加为21.6%[13]。因此,在Nano-LED整体结构中,顶部半极性面仍会占有一部分发光面积,其对器件整体性能的影响不能忽略。
Nano-LED为纳米尺度,半极性面量子阱边缘位置应力释放作用明显[14],边缘应力释放作用导致压电极化的改变,对半极性面InGaN/GaN单量子阱发光特性影响较大,导致Nano-LED的整体器件光谱中出现双峰值现象,该现象将为基于Nano-LED多波长的可见光通信提供波分复用的基础[15]。相比普通发光二极管,半极性面Nano-LED的尺寸效应导致半极性面量子阱中受边缘应力释放影响的比例增多,增大了半极性面边缘应变释放所导致的光谱偏移程度,对Nano-LED整体器件发光光谱的影响随之增大。因此,需要深入研究Nano-LED半极性面上生长的量子阱的边缘应变极化对Nano-LED量子阱整体发光光谱的影响规律。
本文利用最基本的Nano-LED InGaN/GaN单量子阱有限元模型来分析半极性面Nano-LED InGaN/GaN单量子阱应变变化,利用COMSOL仿真软件计算出量子阱在距离边缘不同位置的应变,推导出其压电极化分布。然后,采用Silvaco仿真软件计算不同压电极化条件下半极性面Nano-LED InGaN/GaN单量子阱的发光光谱及Nano-LED 整体结构的发光光谱。本文工作为Nano-LED结构设计及光谱调制设计提供了理论依据。
2 数值模型的建立及仿真结果分析
2.1 基于有限元的InGaN/GaN单量子阱应变仿真分析

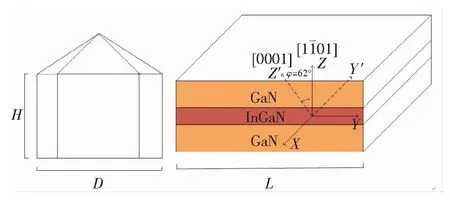
图1 Nano-LED InGaN/GaN单量子阱应变分析模型
InGaN/GaN单量子阱中是由两种不同晶格常数的材料组成的异质结,晶格常数的差异随In组分变化,晶格常数随In的增多其差异性将随之增大,晶格差异性将会产生弹性应变。量子阱内部初始应变可以由下式计算得到[16]:
(1)

(2)
其中a、c为对应纤锌矿结构[1000]和[0001] 晶向晶格常数,abot、atop、cbot、ctop为量子阱中材料InGaN、GaN的晶格常数。φ为量子阱的生长方向与GaNc轴的夹角。应变εx′x′、εy′y′、εz′z′、εy′z′可以通过下列公式得到[16]:
εx′x′=εm1,εy′y′=εm2,
(3)
(4)
(5)
其中由材料生长角度不同导致的过程参数A31、A32、A41、A42、B31、B41、B32、B42可以由以下公式得到:
A31=C11sin4φ+(0.5C13+C44)sin22φ+C33cos4φ,
(6)
A32=
[C11sin2φ+(C13+2C44)cos2φ-C33cos2φ]sin2φ,
(7)
A41=0.5[(C11-C13)cos2φ+2C44cos2φ+
(C13-C33)cos2φ]sin2φ,
(8)
A42=[0.5(C11+C13)-C13]sin22φ+2C44cos22φ,
(9)
B31=C12sin2φ+C13cos2φ,
(10)
B41=0.5(C12+C13)sin2φ,
(11)
B32=C13(cos4φ+cos4φ)+
[0.25(C11+C33)-C44]sin22φ,
(12)
B42=0.5[C11cos2φ-
(C13+2C44)cos2φ-C33sin2φ]sin2φ,
(13)
其中C11、C12、C13、C33、C44为InGaN/GaN单量子阱结构中GaN势垒层和InGaN势阱层材料的弹性常数。其中表1为GaN/InN量子阱材料晶格常数,表2为GaN/InN量子阱材料的弹性常数。本文中不同In组分的InGaN晶格常数、弹性常数参量可以通过表1、表2并结合维加德定理[3-4]计算得到。

表1 GaN/InN量子阱材料的晶格常数[16-17]

表2 GaN/InN量子阱材料的弹性常数[18-20]


图2 长度为320 nm的Nano-LED InGaN/GaN单量子阱应变分布。(a)εx′x′;(b)εy′y′;(c)εz′z′;(d)εy′z′。
2.2 InGaN/GaN单量子阱压电极化计算
对于InGaN/GaN单量子阱结构,z轴极化场可以由下式得到[21]:
PZ=PSP+PPZ,
(14)
其中PSP为自发极化场,PPZ为压电极化场。
Nano-LED量子阱自发极化场为:
(15)

PSP(InxGa1-xN)=x·PSP(InN)-(1-x)·
PSP(GaN)+bAB·x·(1-x),
(16)
其中Bowing参数bAB可以用下式得到[23]:
bAB=2PSP(InN)+2PSP(GaN)-
4PSP(In0.5Ga0.5N),
(17)
对于压电极化场PPZ,依据上一节内容中的应变分布,计算压电极化场强如下:
PPZ=εx′x′(e31cosφ)+
εy′z′[(e31-e33)cosφsin2φ+e15sinφcos2φ)],
(18)
压电张量系数e31、e15、e33见表3[21,24-25]。

表3 InGaN量子阱材料的压电张量参数
利用上节仿真得到的应变参数εx′x′、εy′y′、εz′z′、εy′z′,代入公式(18),即可得到半极性面Nano-LED InGaN/GaN单量子阱压电极化分布,如图3所示。结果表明,分析压电极化的位置逐渐靠近边缘,压电极化随应变的减小而减小,半极性面Nano-LED InGaN/GaN单量子阱压电极化变化范围约为100 nm,当距离边缘位置大于100 nm时,压电极化将会明显减弱。利用计算得到的压电极化,设置Nano-LED InGaN/GaN单量子阱的边界条件,通过计算得到对应的距边缘不同距离的发光光谱及发光强度。

图3 长度为320 nm的InGaN/GaN单量子阱压电极化分布
2.3 InGaN/GaN单量子阱光电特性分析
利用推导得到的半极性面Nano-LED InGaN/GaN单量子阱压电极化公式,设置不同极化条件下的量子阱能带,通过Silvaco光电耦合计算和载流子复合有限元分析的方法得到不同应力位置下InGaN/GaN单量子阱的发光光谱。改变Nano-LED直径,利用发光光谱和半极性面、非极性面的比例关系得到对应的不同直径(D)Nano-LED的发光光谱,分别如图4和图5所示。
图4(a)光谱计算结果表明,半极性面Nano-LED InGaN/GaN单量子阱发光光谱功率呈高斯分布。与量子阱中心位置(160 nm)相比,边缘位置(0 nm)发光光谱出现光谱偏移的现象,且整体辐射效率较高。在60 mA注入电流条件下,距离量子阱边缘位置100 nm处光辐射峰值波长为464 nm,在量子阱边缘位置(0 nm)发光光谱的峰值波长为443 nm,向蓝光方向移动了21 nm(如图4(b)所示)。产生这种结果的原因是InGaN/GaN单量子阱内部在压电极化的作用下,量子阱的导带和价带所形成的能带模型由无极化的方形势阱变为三角形势阱,量子阱内电子和空穴在极化场的作用下将会出现空间分离的现象,进而导致电子空穴复合几率的下降,使量子阱发光效率降低。同时,由于量子阱相对宽度变窄,导致发光波长变长。而量子阱边缘位置产生的应力释放可以减弱压电极化影响,进而使半极性面生长的InGaN/GaN单量子阱发光光谱蓝移,在量子阱内部应力释放作用逐渐减弱(如图2所示),压电极化趋于稳定。
图5所示的Nano-LED非极性面和半极性面整体发光光谱表明,随着Nano-LED的直径增大,Nano-LED发光面积随之增大,导致Nano-LED发光强度增大。Nano-LED半极性面因受边缘应力释放作用的影响,半极性面的光谱将会出现偏移。在固定Nano-LED高度的条件下,半极性面所占Nano-LED整体结构比例随直径的增大而增多。随半极性面所占Nano-LED整体面积比例的增多,边缘应力释放作用所导致半极性面Nano-LED InGaN/GaN量子阱光谱偏移的影响增大,导致Nano-LED整体结构的发光光谱在440 nm及470 nm处出现双峰值现象。
3 结 论
本文利用COMSOL软件分析了半极性面Nano-LED InGaN/GaN单量子阱距离边缘不同位置的应变,并推导出量子阱的压电极化分布,通过光电耦合和有限元分析软件Silvaco仿真计算得到不同应变位置InGaN/GaN单量子阱的发光光谱及Nano-LED整体结构的发光光谱。结果表明,在量子阱边缘位置(0 nm)和量子阱中心位置(160 nm),发光光谱的峰值波长蓝移21 nm,这一结果体现了应力释放对InGaN/GaN单量子阱发光的调制作用。这一光谱差异在进行波分复用的可见光通信系统中可以加以利用,拓展系统的通信带宽。针对Nano-LED整体结构的发光光谱在440 nm以及470 nm处出现的双峰值现象,对于在同一衬底材料上生长不同直径的Nano-LED器件结构,其顶部半极性面将受到材料组分和极化电场的双重调制,其光谱变化范围将会更大,这为单衬底多波长发光器件的应用提供了行之有效的解决方案。在Nano-LED器件设计过程中,通过控制Nano-LED的高度和直径,同时设计Nano-LED侧壁非极性面和顶端半极性面量子阱比例,可以得到更大的光谱调制范围。这些结果对Nano-LED结构设计及光谱调制设计提供了理论依据。
