氮气载气MOCVD外延生长GaN成核层研究
2020-04-01刘磊宿星亮王申
刘磊,宿星亮,王申
(山西大学 物理电子工程学院,山西 太原 030006)
0 引 言
氮化镓(GaN)基半导体材料具有禁带宽度宽、热导率高、电子迁移率高等一系列的优点[1-2]。1969年,Maryska等人[3]就利用氢化物气相外延的方法,成功地在蓝宝石衬底[4]上生长了GaN单晶,其载流子浓度和载流子迁移率分别达到了1×1019~5×1019cm-3和125~150 cm2/vs。1993年,Nakamura等人[5]研制出了第一支GaN基发光二极管(Light Emitting Diode,LED)。之后GaN基半导体外延生长成了产业界的重要问题。受制于成本,目前生产中主要使用异质外延生长[6],这导致了外延层较大的晶格失配和热失配,是GaN外延生长中所面临的主要问题[7-9]。目前获得GaN薄膜的方法主要是在氢气气氛下利用金属有机物化学气相沉积(Metal-Organic Chemical Vaper Deposition,MOCVD)方法进行两步法异质结外延生长,先在衬底表面低温生长GaN成核层,在成核层基础上外延生长GaN薄膜,薄膜质量在很大程度上取决于成核层的质量,因此成核层的生长是人们关注的重要问题。另一方面,氢气作为载气存在着安全性差、成本昂贵等缺点。我们的工作聚焦于使用相对安全廉价的氮气代替氢气作为载气,利用工业生产设备Thomas swan 2英寸19片机生长GaN成核层,通过改变生长时间、生长温度、镓源流量以及氮化基底等方式生长成核层,成核层的形貌通过原子力显微镜(Atomic Force Microscope,AFM)表征,以期找到在氮气作为载气生长GaN成核层的最佳参数。
1 实验

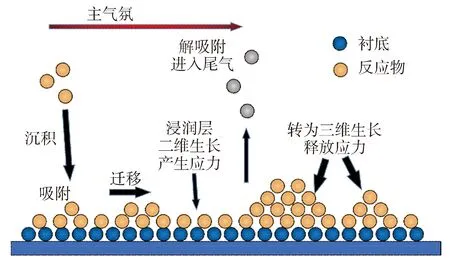
图1 MOCVD生长过程原理图Fig.1 Schematic diagram of MOCVD growth process
使用Thomas Swan 2英寸19片MOCVD工业级生长设备在蓝宝石衬底上生长GaN成核层,生长系统主要由反应腔、源供给、自动控制和尾气处理四部分组成,反应前驱物由紧耦合喷淋头[13-14]进入反应腔,喷淋头与衬底间的距离在10-20 mm可调[12-13],这一结构可以减小涡流影响。三甲基镓和氨气分别作为反应的金属有机化合物(Metal-Organic,MO)源和氮(N)源,生长基片选取c面蓝宝石衬底。我们首先对蓝宝石衬底进行清洗,将蓝宝石置于反应腔石墨盘上在氢气气氛中1 195℃烘烤5 min,以去除蓝宝石表面的杂质和污染物。之后降低温度并通入氮气准备生长。反应腔中的生长压强为66.66 kPa,NH3流量为6 000 mL/min。
2 实验结果
在Ga源流量6.25 mL/min,生长温度650℃,氮气气氛下生长了A1、B1、C1、D1四块样品,生长时间分别为0.5 min、1 min、2 min和3 min,四组样品AFM扫描的表面形貌如图2所示。由图中可以看出,成核层中GaN成核岛分布均匀,样品A1、B1、C1、D1最大高度分别为11.84 nm、11.92 nm、27.10 nm、28.24 nm,均方根值(Root Mean Square, RMS)分别为1.067 nm、1.662 nm、4.032 nm、4.253 nm。当生长时间达到2 min时,开始出现较大的岛屿。同时,成核层的最大高度在1~2 min之内发生了阶跃式的变化,最大高度增长了约2.3倍,之后2~3 min的生长对表面形貌高度的影响约为5%,如图3a中所示。同时,图3b表明成核层的RMS在2 min之前随时间趋于线性增长,在2 min之后趋于饱和。这说明成核层中的量子点生长过程在1 min内主要为密度增加,1~2 min内趋向于颗粒体积增大,2 min后趋于饱和,因此我们认为成核层的生长时间应控制在2 min内,以保证成核层为单层生长,并保证之后外延薄膜的质量。
在Ga源流量6.25 mL/min,控制生长时间1 min,氮气气氛下生长了B2、C2、D2三组样品并与B1进行比较,生长温度分别为700℃、750℃和800℃,四组样品AFM扫描的表面形貌如图4所示。样品B1、B2、C2、D2的最大高度分别为11.92 nm、19.70 nm、21.35 nm、53.46 nm,RMS分别为1.662 nm、2.833 nm、3.071 nm和11.29 nm。从图中可以看出,温度在650℃~750℃范围内表面成核岛分布较均匀,但是在800℃下生长时,样品表面形貌发生了剧烈的变化,形成了亚微米级的点状结构。在650℃~750℃温度下生长的样品,其最大高度以及表面RMS趋于较缓慢的线性增长,但800℃下生长的样品最大高度和RMS分别急剧增长了3.5倍和3.7倍,如图5所示。从保证之后外延层质量的角度来说,成核层生长的温度应控制在750℃以下。

图3 样品A1~D1(a)成核层最大高度随生长时间变化关系;(b)样品表面RMS随生长时间变化关系Fig.3 Sample A1~D1 (a) Diagram of the maximum height of the nucleating layer with the growth time;(b) Diagram of the variation of the surface RMS with the growth time
在氮气气氛下生长了B3、C3两块样品,与D2进行比较,三组样品AFM扫描的表面形貌如图6所示。生长温度为800℃,生长时间为1 min,Ga源流量为6.25 mL/min、12.5 mL/min、25 mL/min。样品D2、B3、C3的最大高度分别为53.46 nm、121.27 nm、355.89 nm,表面RMS分别为11.29 nm、28.98 nm和52.97 nm。从图6中可以看出,当Ga源流量为6.25 mL/min时,成核岛密度很低,而随着Ga源流量的提升成核岛密度持续增加。由图7可以看出,样品表面最大高度和RMS随Ga源流量基本表现为线性增加,说明可以通过控制Ga源的流量来调控成核层的生长速率。之所以选择在800℃下生长样品对比Ga源流量与生长速率的关系,是因为在750℃以下的样品在Ga源流量为12.5 mL/min时已经转为多层生长,其最大高度和RMS已不能表征其生长速率的信息。

图4 B1和B2~D2分别对应生长温度650℃、700℃、750℃和800℃,生长时间均为60 s的AFM图像(图像尺寸为10 μm×10 μm,右侧为样品高度尺)Fig.4 B1, B2~D2 corresponding growth temperature at 650℃, 700℃, 750℃ and 800℃, the growth time for 60 s of the AFM images (image size to 10 μm×10 μm,the sample is on the right height feet)

图6 D2、B3、C3分别对应Ga源流量6.25 mL/min、12.5 mL/min和25 mL/min,生长温度均为800℃的AFM图像(图像尺寸为10 μm×10 μm,右侧为样品高度尺)Fig.6 D2, B3, C3 corresponding to Ga source flow rate 6.25 mL/min, and 12.5 mL/min and 25 mL/min,growth temperature is 800℃ of AFM images (image size to 10 μm×10 μm, the sample is on the right height feet)

图7 样品D2、B3、C3(a)成核层最大高度随Ga源流量变化图;(b)样品表面RMS随Ga源流量变化图Fig.7 Sample D2, B3, C3 (a) Diagram of the variation of themaximum height of the nucleating layer with Ga rate of flow;(b) Diagram of the variation of the RMS on sample surface with Ga rate of flow.
3 结论
Sengupta和Hirako[15]曾提出GaN生长的反应途径模型,其反应速率由速率常数k(T)=ATnexp(-Ea/RT)决定,其中A为指数前因子,Ea为活化能。在气相反应过程中,三甲基镓(TMGa)分解成为二甲基镓(DMGa)和甲基镓(MMGa),而反应过程中向衬底沉积GaN的过程主要有以下3种:
(GaNH2)3(环)→3H2+3GaN ,
(Ga(CH3)NH2)3(环)→6CH4+3GaN ,
TMGa+NH3→TMGa:NH3→GaN+3CH4。
H的作用是降低TMGa和DMGa分解过程中的活化能,从反应中可以看出,对GaN生长起主要作用的是H和NH2,而由于NH3的分解需要较高的活化能,在无催化剂的情况下,其气相分解活化能约为376 kJ/mol[16],因此氨气分解对反应过程带来的影响可以忽略不计,而且与氮气气氛相比,在氢气气氛下可以获得更多的H和NH2,生长速度也随之变快,这也是在此之前通常在氢气气氛下进行GaN外延层生长的原因。
本文采用MOCVD方法在氮气气氛下外延生长GaN成核层,利用AFM对样品表面形貌进行了表征。研究了生长参数对成核层的影响,结果表明,成核层的生长时间应控制在2 min以内,生长温度在750℃以内。Ga源流量与生长速率之间为线性增加关系,可以通过控制Ga源流量实现对成核层生长速率的调控。
