基于X荧光方法的Inconel材料镀层厚度检测
2019-12-26葛腾张小刚郭梦雅田梓萌丛林
葛腾 张小刚 郭梦雅 田梓萌 丛林

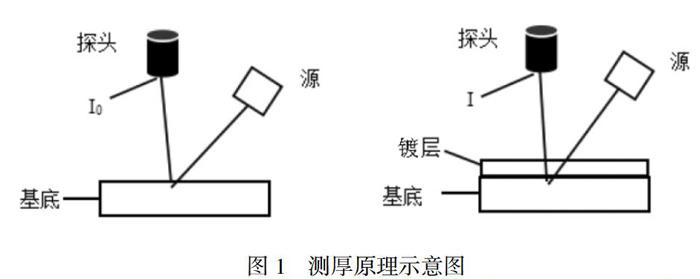

【摘 要】本文采用便携式X荧光测量仪,对Inconel材料上Ni镀层厚度进行测量。通过不同厚度镀层试验样品的制作,在元素分析模式下对检测可行性进行确认,通过标准曲线的建立和金相解剖结果的验证,对检测结果的准确性进行验证。通过本实验,X-MET8000 Optimum型便携式X射线荧光光谱仪用于Inconel材料上Ni镀层厚度在3μm~15μm时检测精小于1μm。
【关键词】X荧光;Ni镀层厚度检测;Inconel材料
一、引言
对于镀层厚度的检测,目前已经成熟应用的无损检测方法有涡流法、磁性测厚法、超声测厚法、X荧光测厚法等;已经成熟应用的破损法有金相解剖法、库伦电解法等。对于无损检测方法的验证通常采用金相解剖法。X荧光测厚法是一种仪器分析方法,其特点是成本低、速度快、人为因素小、不需取样的无损(非破坏)检测。
本文使用X-MET8000 Optimum型便携式X射线荧光光谱仪,对Inconel材料上Ni镀层厚度在3μm~15μm的Ni镀层开展X荧光法测厚实验。
二、X荧光测厚原理
当射线照射在Inconel基底上时,会激发出金属的特征X射线,即X荧光;X荧光通过镀层时主要进行康普顿散射,光电效应。X荧光的强度将减弱,射线减弱将遵循以下规律[7]:
式中I0为没有穿过镀层时射线的强度,I是射线穿过镀层后的强度,见图1;μm为质量吸收系数,dm为质量厚度。将(1)式变形得:
在实际测量过程中需测量没有穿过镀层的X荧光强度I0的值,再测量穿过已知标准厚度的射线强度I值,最后得到如下曲线,这条曲线是运用最小二乘法的方法拟合得到的:
将a、b值作为初始数据。根据公式(3),利用检测出透过涂层后进入探测器的射线强度,就可以得到被测涂层的厚度值。
由以上可以看到,通过镀层的吸收率对信号的影响来测量被测物质的厚度。所以已知某物质吸收系数的情况下,只要测定I0和相应的I的强度,根据最小二乘法拟合公式就可以精确计算出被测物质的厚度。
三、实验装置
本实验选用X-MET8000 Optimum型便携式X射线荧光光谱仪(英国牛津仪器公司)测量铀及铀合金表面的Ni锌双镀层。该仪器配置50KV铑阳极靶X射线管和大面积硅漂移探测器(SDD)。配置3mm微焦点功能,可视频精确定位样品测试点。对金属元素可有效激发和测量,分析元素范围从元素周期表镁元素到铀元素。在总厚度不超过50μm的情况下,最多可同时分析5层镀层的厚度。
X射线荧光光谱法(EDXRF)作为镀层厚度测量方法,对基材的种类、镀层的种类适应性强,适用范围宽。工作时无损不接触样品。测量时间一般在30秒钟。手持便携式X荧光检测仪对产品的长度、高度等尺寸适应性强,一般情况下无需专门另外制样。
实验样品共制作了长150mm,宽60mm的Inconel条带8块,在条带镀Ni工艺上制作3min镀Ni样品1块,6min镀Ni样品1块,10min镀Ni样品2块,13min镀Ni样品1块,16min镀Ni样品1块,20min镀Ni样品1块,剩余一块留作空白实验。
四、元素分析法測试
现用镀Ni工艺中,电镀时间为10min,为证明X荧光方法能够区分不同厚度的镀层样品,利用X-MET8000 Optimum型手持式X射线荧光光谱仪进行的测试图谱。测试电压为40kV,电流为8μA,滤波片为Filter6,测量持续时间为30s。不同样品所得的Ni元素特征谱线如图2所示,样品中的Ni和Fe含量如表1所示。
图2可以看出,对不同电镀时间的实验样品进行元素分析,Ni元素随着电镀时间的增长,Ni元素含量呈阶梯增长,相邻两样品间的增长幅度在1.18%~3.64%范围; 同时Ni元素的Kа谱线峰值也呈阶梯增长。因此,理论上可以使用X荧光法进行该产品的镀层厚度检测,但由于材料本身含有近53%的Ni元素,因此需开展后续实验消除基体材料对Ni镀层厚度测量结果的影响。
五、镀层厚度测量
实验中对1#~7#实验样品,使用测试电压为40KV,电流为8μA,滤波片为Filter6条件下使用设备中Fe基体Ni镀层厚度测量标准曲线模式下进行厚度测量,测量持续时间为30s,测量结果如表2所示。
表2 Fe基体Ni镀层厚度模式测量结果 单位:μm
从表2可以看出,在Fe基体Ni镀层测厚模式下,未镀样品也有一定的厚度,且镀层厚度随着电镀时间的增长而增大。实验中进一步将未镀样品的测量值定位本底值,重新对实验样品在相同模式下进行测量,测量后镀层厚度仍随电镀时间的增长而增大,如表2所示。为验证该模式下解剖结果的可靠性,实验中对测量位置进行金相解剖,解剖结果如表2所示。
通过对不同样品上Ni镀层厚度的金相解剖可以得出,金相解剖结果随着电镀时间的增长,镀层厚度的增大值比Fe基体上Ni镀层的X荧光测量结果大很多。在10min的电镀样品上两种样品的厚度值差.70μm,因此直接使用软件中的Fe基体上的Ni镀层测厚标准曲线不能对Inconel材料上的Ni镀层进行测量。
为避免Inconel基体中的Ni干扰,直接使用上述1#~7#样品的金相解剖值作为标称厚度值,用上述样品作为标准厚度样品制作测量用标准曲线,制作后线性系数大0.995。然后对上述样品重新进行测量,测量结果如表3所示。
由表3可知,使用Inconel基体上Ni镀层测量标准曲线进行镀层厚度测量,测量结果与金相解剖结果基本一致,最大误差达0.71mm。
为进一步验证检测结果的准确性,实验中对另外一块电镀10min中的样品(8#样品)在该标准曲线上进行多次测量,测量结果如表4所示。测量后对该样品金相解剖,解剖结果如表4所示。
由表4可以看出,使用Inconel基体上Ni镀层测量标准曲线的制作,测量结果与金相解剖结果一致,两种方法测量误差小于1μm。因此X荧光方法可以作为Inconel基体上镀层厚度检测的无损检测方法。
六、结论
本实验验证了使用X荧光方法时,AP1000条带Inconel基体对Ni镀层的测量存在干扰,使用常规Fe基体Ni镀层厚度测量标准曲线,测量结果偏小,使用与待测样品工艺相同的材料制作标准曲线后检测精度小于1μm。
【参考文献】
[1]卢淑芳.涂层厚度的探讨[J].专论与综述,2013,16(7):26-28.
