退火气氛对ZnO薄膜晶体管电学稳定性的影响
2019-12-06张文通高晓红
张文通,高晓红
吉林建筑大学 电气与计算机学院,长春 130118
由于薄膜晶体管(Thin Film Transistor,英文缩写为TFT)在有源矩阵液晶显示器(Active matrix liquid crystal display,英文缩写为AM-LCD)、射频识别标签、大面积传感器和计算机等电子市场上的广泛应用,人们对TFT进行了大量的研究工作[1-2].与非晶硅和多晶硅薄膜晶体管相比,金属氧化物半导体具有低成本、高透明、高迁移率和大面积均匀性等优点[3-4],这使金属氧化半导体成为最有前途的薄膜晶体管沟道层材料之一.
目前,未进行掺杂的纯ZnO薄膜晶体管无法得到应用的原因常常是由于器件的电学性能不够好或是器件稳定性还不满足要求.研究发现TFT的转移曲线出现顺时针滞回现象的主要原因之一是在栅压正向扫描时界面陷阱电荷俘获载流子,在栅压负向扫描时由于陷阱占用部分载流子,使得达到同样大的源漏电流IDS需要更高的栅压[5],导致了阈值电压正向偏移.研究者发现,通过对薄膜退火可降低其界面陷阱密度,改善薄膜质量[6-7].
本文拟通过使用射频磁控溅射沉积ZnO沟道层材料制备成TFT,并进行退火,改变不同的退火气氛,摸索提高ZnO薄膜晶体管电学性能的方法,并提高器件转移曲线的滞回稳定性.利用X射线衍射(X-ray diffraction,英文缩写为XRD)、光致发光(Photoluminescence,英文缩写为PL)光谱对ZnO薄膜进行表征,使用场发射(Field emission,英文缩写为FE)扫描电子显微镜(Scanning electron microscope,英文缩写为SEM)、原子力显微镜(Atomic force microscopy,英文缩写为AFM)观察薄膜表面形貌.
1 实验
实验采用美国kurtJ.Lesker的PVD 75型磁控溅射设备在具有100 nm SiO2介电层的Si(004)衬底上沉积40 nm厚的ZnO薄膜,氩氧比为95∶5,溅射气压为8 mTorr,溅射功率为100 W,衬底温度为90 ℃.然后对薄膜进行湿法光刻并蒸镀Pt电极,制备成TFT器件.将器件进行15 min的退火,退火气氛分别为N2,O2和空气.
图1为TFT器件的结构示意图和光学显微镜下照片,沟道长度60 μm、宽度300 μm.对4个器件使用keysight B1500A半导体参数测试仪测试电学性能,用布鲁克公司的高分辨X射线衍射仪(D8 DISCOVER)分析ZnO薄膜的结晶情况,X射线源为Cu靶Kα,波长λ = 1.541 8 Å;采用HORIBA公司的光致发光/拉曼光谱仪测试ZnO薄膜的发光特性;采用日本电子株式会社的场发射扫描电子显微镜(JSM-7610F)和牛津公司的原子力显微镜(MFP-3D)观察ZnO薄膜表面形貌.

(a) (b)图1 (a)TFT结构示意图和(b)光学显微镜下的TFT照片Fig.1 (a)TFT schematic diagram and (b)TFT photos under optical microscopy
2 结果与讨论
2.1 TFT器件分析
图2为不同退火气氛下TFT的转移特性曲线和滞回曲线.

(a)

(b)

(c)

(d)
由图(a)可见,N2气氛下退火的器件出现了较好的电学性能,电流开关比Ion/Ioff为5.88×107,亚阈值摆幅SS为0.97 V/decade;
O2气氛下退火的器件由于O原子会填补一部分的氧空位,氧空位的减少使沟道层中的载流子浓度下降,器件的开态电流降低了近1个数量级;
空气气氛下退火的器件开态电流略有下降,关态电流提高了1个数量级;
未退火的器件由于存在较多晶体缺陷,各项电学性能都较差,开关比仅为103.
器件的各项电学性能见表1.

表1 TFT的电学性能Table 1 Electrical performance of TFT
由图2(b)~图2(d)可分析出N2下退火的器件滞回稳定性最高,阈值电压偏移ΔVTH仅为0.2 V,在O2和空气下退火的器件均出现了较大的阈值电压偏移,分别为5.8 V和6 V.这是由于N2退火降低了界面陷阱电荷密度[8],在O2和空气下没有达到同样的效果.从器件的亚阈值摆幅SS可计算得出栅介电层与沟道层之间的界面态密度DIT,由式(1)可得[2]:

(1)
式中,SS为亚阈值摆幅,V/decade;e为自然常数;Cox为单位面积电容,mF/cm2;k为玻尔兹曼常数,J/K;T为绝对温度,K;q为单位电荷量,C.计算得出在N2下退火时的界面态密度DIT最低,为3.34×10121/(cm2·eV).
2.2 光致发光分析
图3为不同退火氛围下ZnO薄膜的PL光谱,激发光源为325 nm,在室温下进行测试.在380 nm附近的峰为ZnO的本征发光峰,峰位基本保持一致,表明退火气氛没有改变ZnO薄膜的禁带宽度.
处于可见光范围的发光峰为ZnO的缺陷发光峰[9],O2下退火的ZnO薄膜缺陷发光最弱,O2填补了一部分磁控溅射沉积ZnO薄膜时产生的氧空位,N2和空气下退火的ZnO薄膜的缺陷峰比未退火的薄膜低,这是因为退火使晶体中原子迁移,减少了位错、层错和晶格应力等晶体缺陷.
而未退火的ZnO薄膜缺陷发光强度很高,大量的晶体缺陷不利于载流子传输,使得未退火的ZnO器件性能很差.

图3 不同退火气氛下ZnO薄膜的PL光谱Fig.3 PL spectra of ZnO thin films in different annealing atmospheres

图4 不同退火气氛下ZnO薄膜的XRD光谱Fig.4 XRD spectra of ZnO thin films in different rapid annealing atmospheres
2.3 XRD分析
图4为不同退火气氛下ZnO薄膜的XRD光谱,所有薄膜均出现了ZnO六方纤锌矿的(002)衍射峰[10],晶体垂直于界面生长,未出现其他晶向.
未退火的ZnO薄膜2θ角为34.08°,退火后的ZnO薄膜2θ角均为34.4°,未退火薄膜的衍射峰向小角度偏移是由于在磁控溅射沉积时在薄膜中存在残余拉应力导致晶格畸变造成的,这种应力可通过退火消除,这也是造成未退火的ZnO TFT电学性能不良的原因之一.
2.4 表面形貌分析
图5(a)~图5(d)为不同退火气氛下ZnO薄膜的SEM照片.所有薄膜晶粒均致密均匀,未出现孔隙或团簇现象.

(a) N2

(b) O2

(c) 空气 (c) Air

(d) 未退火 (d) As deposited
图6(a)~图6(d)为不同退火气氛下ZnO薄膜的AFM照片,N2,O2和空气以及未退火的ZnO薄膜粗糙度RMS分别为3.661 nm,3.708 nm,3.412 nm和3.476 nm.不同的退火气氛并未对ZnO薄膜的粗糙度和表面形貌造成明显的改变.

(a) N2

(b) O2

(c) 空气 (c) Air
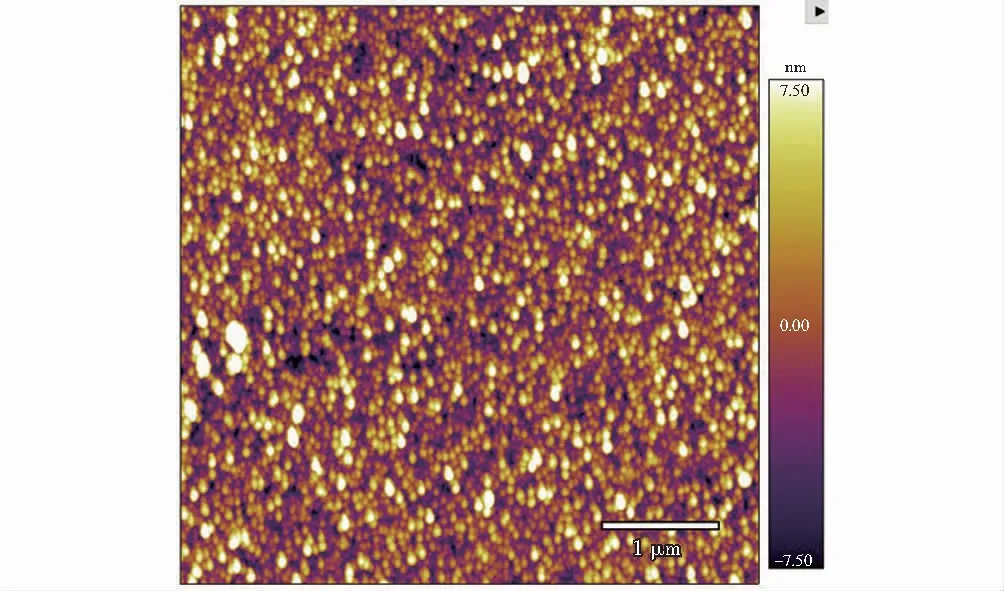
(d) 未退火 (d) As deposited
3 结论
本文通过射频磁控溅射在Si衬底上制备了ZnO薄膜晶体管,研究了不同退火气氛对ZnO薄膜晶体管电学性能的影响,并对沟道层薄膜进行了XRD与PL分析,发现退火可消除ZnO薄膜中由残余拉压力导致的晶格畸变,O2下退火有助于降低氧空位,同时使载流子浓度降低.通过SEM与AFM观察,未发现退火气氛对薄膜表面形貌造成影响.经计算与实测,发现N2下300 ℃退火15 min的器件电学性能最佳,电流开关比为5.88×107,阈值电压偏移ΔVTH为0.2 V,界面态密度DIT为3.34×1012cm-2eV-1.N2下退火能有效提高TFT的滞回稳定性,并且不会降低TFT的电学性能.
