PECVD氮化硅薄膜性质及工艺研究
2019-02-21李攀张倩夏金松卢宏
李攀 张倩 夏金松 卢宏
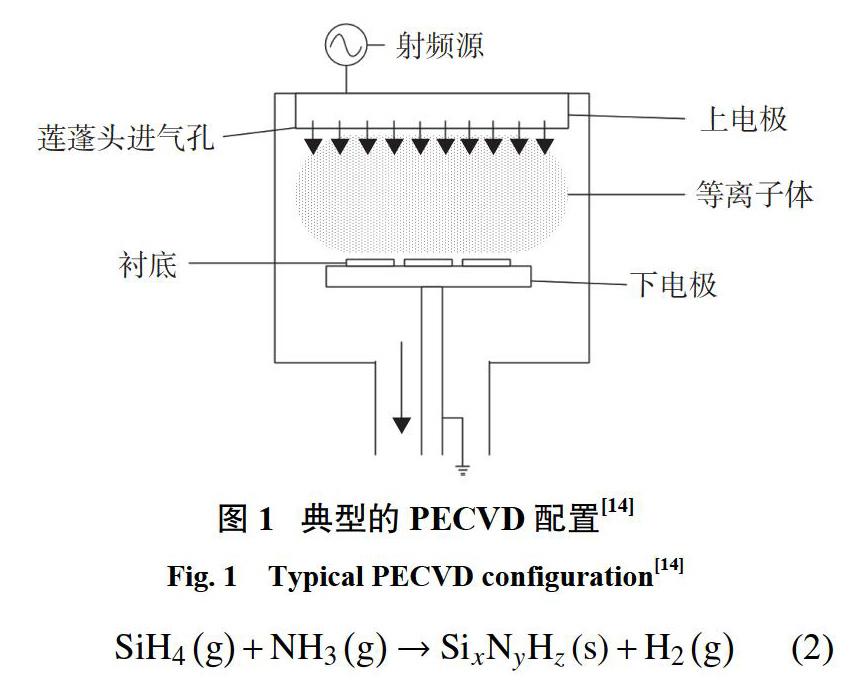


摘要:为了制备高质量氮化硅薄膜,采用等离子体增强化学气相沉积(PECVD)进行氮化硅的气相沉积,讨论了工艺参数对薄膜性能的影响,验证设备工艺均匀性和批次间一致性。通过高低频交替生长低应力氮化硅薄膜,并检测薄膜应力,对工艺进行了优化,探索最佳的高低频切换时间。研究了PECVD氮化硅薄膜折射率、致密性、表面形貌等性质,制备出了致密的氮化硅薄膜。研究结果表明,PECVD氮化硅具有厚度偏差小、折射率稳定等特点,为其在光学等领域的应用打下了基础。
关键词:半导体材料;氮化硅薄膜;等离子增强化学气相沉积(PECVD)
中图分类号:TN304.6 文献标志码:A
引言
等离子体增强化学气相沉积(PECVD)是一种通过射频使一定组成的气态物质部分发生电离形成等离子体,促进化学反应,沉积成薄膜材料的一种技术。由于该技术是通过高频电磁感应与气体分子的共价键产生耦合共振,使其电离,显著降低反应所需温度,增加反应速率,提高成膜质量。该方法具有设备简单,衬底与薄膜结合性好,成膜的均匀性和重复性好等特点。同时,较低的沉积温度有利于实现更小的畸变、更佳的共形沉积和更快的沉积速率。PECVD制备的氮化硅薄膜具有强度高、硬度高、介电常数大、折射率可调、透射率高、光衰减系数小和化学稳定性好等特点,广泛应用于光学、光电子、微电子、MEMS等领域。
氮化硅的残余应力可以直接影响薄膜与衬底的附着情况,过高的张应力或者压应力会导致薄膜开裂或者翘曲。13.56 MHz的高频可以生长张应力的氮化硅,而100 kHz的低频则由于等离子体的动能较高,离子轰击去除薄膜生长中的一些结合较弱的含氢的原子团,同时,轰击本身使薄膜致密化,表现出压应力。Pearee等在研究氮化硅时发现,氢和氮在低频下,主要以N-H2的形式结合,在高频下以N-H键结合。姜利军等利用高、低频交替沉积氮化硅薄膜将低频下产生的压应力和高频下产生的张应力相互抵消,制备了压应力为109Pa的氮化硅薄膜。本文在其基础上进一步优化工艺,制备出了张应力约为3×107Pa的氮化硅薄膜,应力的绝对值降低了两个数量级,并对其折射率、致密性、表面形貌等性质进行了表征。
1实验与测量
薄膜应力可以通过测量由膜的应力引起的膜与基底的弯曲程度,进而计算出膜的应力。使用台阶仪测量基底生长薄膜前后的曲率,使用椭偏仪测量薄膜厚度T,然后根据Stoney公式就可以近似算出氮化硅薄膜的应力So Stoney公式为
式中:E为试验用si衬底的杨氏模量;V为泊
松比;D为衬底厚度;R为衬底的曲率半径。
椭圆偏振法可以测量薄膜的厚度,其原理是利用偏振光束在界面或薄膜上反射或透射时发生的偏振变换。椭偏法测量的优点为误差小、灵敏度高和无损伤等。椭偏仪光源发出的光经滤光片后成为单色光,单色光通过起偏器后变成线偏振光,然后通过1/4波片变成椭圆偏振光,经过样品表面的反射后成为线偏振光。从偏振光经过样品表面前后的偏振态变化,结合一些数学的分析,便可以获知样片的相关光学特性,如折射率、薄膜厚度等。
1.1样品准备
实验采用4 inch(1 inch=2.54 cm)100晶向P型掺杂硅晶圆作为基底,将3片晶圆均匀排列在下电极上,为了测试均匀性和一致性,每片晶圆均测试5个点,每个实验条件重复3次,每次3片样品,每个参数共计45个样本。然后计算极差、平均值、标准偏差和变异系数(相对标准偏差)进行统计分析。
1.2实验设备及原理
本文采用英国牛津仪器公司PlasmaproSystem 800 PECVD设备进行沉积实验,图1为典型的等离子增强化学气相沉积设备示意图。反应过程主要控制的参数有气体流量、反应气体比例、射频功率、腔室压强、沉积温度等。使用美国产的KLA TENCORPl6+台阶仪测量薄膜生长前后的曲率,法国SOPRALAB公司生产的GES-5E光谱式椭偏仪测量薄膜厚度,VeecoNanoScope MultiMode原子力显微镜对样品表面进行扫描,分析氮化硅的表面形貌和粗糙度。
PECVD制备的氮化硅一般用于芯片最上面的钝化层,用来保护芯片,在STI和自对准工艺中也可以用作掩膜,由于其特殊折射率和光学性能,也可以用于光学薄膜。主要反应式为键容易遭到离子轰击的破坏,从而产生压应力。不同频率下,氢和氮结合形式不同,利用高、低频交替沉积氮化硅薄膜就显得十分必要。
2实验结果与分析
2.1氮化硅沉积工艺
采用高低频交替生长氮化硅,20 s为一个周期,温度为300°C,硅烷采用5%siH4与氮气的混合气,具体工艺参数见表1,其中编号1,2,3批次对应的高频时间分别为11 s,13 s,14 s。
通过测试每一片晶圆生长前后曲率,计算出不同高低频时长比下的应力值。可以看出,当高频为13 s,低频7 s交替生长时,应力为张应力,大小为29.8 MPa,且最接近于零。
2.2工艺可靠性检验
工艺可靠性通过片内均匀性、片间均匀性和批次间重复性来表示,均匀性和重复性的计算采用在相对极差的一半前面加上“±”来表征。
2.2.1沉积速率均匀性和重复性
氮化硅沉积5 min,样本数为45,通过椭偏仪测量厚度,测量点如图2所示,用T、C、B、L、R分别代表“上中下左右”5个点。沉积厚度呈正态分布,平均值为926mm,标准偏差为5.09mm,变异系数为0.55%。计算出沉积速率平均值为1 8.5 nm·min-1,重复性均小于±1%。氮化硅薄膜厚度、沉积速率及重复性测量结果见表2。
2.2.2折射率均匀性和重复性
通過椭偏仪对折射率进行测量,在入射光波长为632.8nm,样本数为45时,计算出折射率的平均值为1.97,标准偏差为0.004,变异系数为0.22%,测试结果详见表3。氮化硅的色散曲线如图3所示。
2.2.3氮化硅致密性
纯氮化硅薄膜很难被HF腐蚀,腐蚀速率一般不超过1 nm·min-1,而PECVD沉积的氮化硅中含有氢元素,造成氮化硅可以被氢氟酸较快地腐蚀。主要反应式为
Si3N4+18HF→H2SiF6+2(HN4)2SiF6(3)
采用HF与去离子水体积比1:10的氢氟酸水溶液(DHF),在室温25℃,对PECVD生长的氮化硅进行腐蚀,通过腐蚀速率来检验所生长的氮化硅的致密性。—般腐蚀速率只要不超过100nm-min-1,就可以认为满足致密性要求。氮化硅在DHF腐蚀时间与腐蚀速率的关系见图4。由图可以看出,随着腐蚀时间的增加,腐蚀速率逐渐下降。这主要是因为随着反应的进行,反应物浓度逐渐降低,生成物浓度逐渐升高,影响了反应的速率。
2.2.4氮化硅表面形貌
赵崇友等研究了温度对PECVD氮化硅表面形貌的影响,发现300°C得到的氮化硅有少量的颗粒,400°C有团聚现象。本文采用原子力显微镜(AFM),对高低频交替生长的氮化硅薄膜进行形貌分析,见图5。表面粗糙度RIMS仅为0.365nm,验证了300°C氮化硅无明显团聚的结论。
3结论
在硅晶圆上,采用300°C的PECVD工艺沉积SiNx速率为18.5 nm·min-1,在632.8 nm波长处的折射率为1.97。折射率和沉积速率的片内、片间、重复性、均匀性均在1%以下。氮化硅在DHF(1:10的HF水溶液,25℃)中的平均刻蚀速率为52.9 nm·min-1,验证所生长的氮化硅的致密性满足要求。通过调整高频和低频的交替时间分别为13 s、7 s,得到了张应力为29.8 MPa的低应力氮化硅薄膜。
