玉米蛋白质基底上射频磁控溅射法制备ZnO薄膜
2018-10-26初学峰闫兴振高晓红迟耀丹杨小天
杨 帆, 王 超, 周 路, 初学峰, 闫兴振, 王 欢, 郭 亮, 高晓红, 迟耀丹, 杨小天*
(1. 吉林建筑大学 吉林省建筑电气综合节能重点实验室, 吉林 长春 130118;2. 吉林建筑大学 电气与计算机学院, 吉林 长春 130118)
1 引 言
近年来,生物基底上氧化物半导体材料及器件的制备已经成为了研究热点[1-3],相比于传统的硬质衬底上的半导体材料与器件,基于生物基底的器件具有柔性、可降解、生物相容性好等优点,这使其在生物医学传感器、植入式电子系统、电子皮肤以及生物芯片等领域有着广阔的应用前景。
ZnO是一种Ⅱ-Ⅵ族化合物半导体材料,具有优良的光学和电学特性,且生物相容性好,易于刻蚀加工。Zn元素地球储量丰富,价格低廉。由于具有优异的物理化学性质,ZnO材料目前已被广泛应用于传感器件、光电子器件、表面声波器件和压电陶瓷器件中[4-9]。玉米蛋白(Zein)是一种提取自玉米的蛋白质,其外观呈淡黄色,不溶于水,但可溶解于乙醇溶液。玉米蛋白按照组成的不同分为α-Zein和β-Zein,本实验中采用了α-Zein作为基底材料。玉米蛋白薄膜现已广泛应用于食品、医药和纺织工业中,它具有质地坚韧、表面平滑、可弯曲、可生物降解、耐油以及抗菌等特点。由于机械性能和热稳定性优良,玉米蛋白薄膜十分适合作为半导体材料沉积所需的基底材料。
目前国内外相关研究工作主要基于丝素蛋白膜与玉米蛋白薄膜[10-11],2012年,Science杂志发表了基于蛋白质基底的多种瞬态电子器件,这些器件具有良好的生物相容性和可降解性,可完全溶解于水中,充分显示出了其在生物医学和绿色电子器件等领域的应用潜力[12]。与此同时,科研人员也成功地在蛋白质薄膜上制备了电极阵列、细菌探测传感器、心电图传感器、湿度传感器以及薄膜晶体管等器件[10-11,13-15]。
本文以玉米蛋白薄膜作为基底,采用磁控溅射方法在较低的温度(90 ℃)下制备了ZnO薄膜,利用XRD、PL和SEM来表征薄膜的性质,研究了靶基距、氩氧比(Ar/(Ar+O2))和溅射功率条件对玉米蛋白薄膜上的ZnO薄膜性质的影响,相关研究为玉米蛋白质基底上氧化物器件的制备提供了实验基础。
2 实 验
实验采用Kurt J. Lesker公司的PVD75型高真空磁控溅射设备在玉米蛋白质膜上制备ZnO薄膜,进行溅射前,先将真空室本底真空度抽至1.33×10-4Pa,然后向真空室通入氩气,将ZnO靶材预溅射10 min以清除表面上的杂质,预溅射功率为50 W,溅射压强为2.67 Pa。溅射ZnO薄膜时,压强保持在1.07 Pa,玉米蛋白质薄膜的温度控制在90 ℃。详细的实验参数如表1所示,在第一系列实验中,溅射功率保持在50 W不变,而氩气与氧气的比例Ar/(Ar+O2)为0.9,靶基距为7~20 cm;在第二系列实验中,溅射功率保持在50 W不变,靶基距为10 cm,而氩气与氧气的比例Ar/(Ar+O2)为0.5~1.0;在第三系列实验中,氩气与氧气的比例Ar/(Ar+O2)保持在0.7,靶基距为10 cm,而溅射功率为50~300 W。

表1 3个系列实验的溅射条件
采用日本JEOL公司的JSM-7610F型扫描电子显微镜(SEM)来观察ZnO薄膜的表面形貌;利用日本理学公司的Ultima IV型高X射线衍射仪(XRD)对ZnO薄膜的结晶特性进行测试;采用日本HORIBA公司的光致发光/拉曼(PL/Raman)光谱仪对ZnO薄膜的光学特性进行表征,其中,PL光谱使用波长为325 nm的He-Cd激光器激发。
3 结果与讨论
3.1 靶基距条件对ZnO薄膜性质的影响
图1(a)为玉米蛋白质薄膜的XRD图谱,图1(b)~(d)为不同靶基距条件下制备的ZnO薄膜的XRD图谱,其中,位于20°附近的较宽的衍射峰是与玉米蛋白质基底相关的衍射峰,而位于34.4°附近的衍射峰为纤锌矿结构的ZnO(0002)面的衍射峰[16-18]。可以看出,当靶基距为20 cm时,ZnO(0002)面的衍射峰强度很低,说明ZnO的结晶质量较差,随着靶基距的降低,ZnO的衍射峰强度增大,结晶质量有所提高。我们认为这是由于靶基距的减小会使到达蛋白质基底表面的粒子能量增大,这有利于粒子在生长表面的横向迁移,使生长粒子移动至能量稳定的晶格位置,从而提高了结晶质量。然而靶基距并不是越小越好,过低的靶基距使粒子能量更高,对基底的碰撞增加,进而使薄膜产生缺陷。本实验中靶基距为10 cm时所获得的ZnO薄膜综合性能最优。

图1 (a)玉米蛋白质薄膜的XRD 2θ-ω 扫描图谱;(b)~(d)不同靶基距条件下溅射的ZnO薄膜的XRD 2θ-ω 扫描图谱。
图2为不同靶基距条件下制备的ZnO薄膜的PL谱,其中短波长的较尖锐的发光峰为ZnO的近带边发光峰,而波长位于450~700 nm的较宽的发光峰是与ZnO的缺陷相关的深能级发光。可以看出,当靶基距为20 cm时,ZnO近带边发光峰较弱而深能级发光很强,说明薄膜中缺陷较多,可能由于生长粒子具有的能量较低,难以并入晶格位置,因而产生缺陷。随着靶基距的减小,ZnO近带边发光峰增强而深能级发光减弱,薄膜的光学质量有所提高,当靶基距为10 cm时,ZnO薄膜的深能级发光最弱。

图2 不同靶基距条件下溅射的ZnO薄膜的PL谱
3.2 氩氧比条件对ZnO薄膜性质的影响
图3为不同氩氧比条件下制备的ZnO薄膜的XRD图谱,可以看出,不同氩氧比条件下制备的ZnO薄膜都有较尖锐的ZnO(0002)面衍射峰,说明ZnO薄膜都呈良好的c轴择优取向生长[19]。图4为ZnO薄膜的生长速率、XRD衍射峰积分强度和半高宽随氩氧比条件的变化规律,随着氩气分压的增加,ZnO(0002)面的衍射峰强度逐渐增大,半高宽逐渐降低,ZnO薄膜沉积速率逐渐增加。这可能是由于溅射过程中,当保持压强不变时,氧气分压的减少使氩气分压增加,也使氩离子增加,这加剧了对靶材的轰击,产生更多的粒子参与薄膜生长,因此薄膜的沉积速率随氩气分压的增加而增大,在相同的沉积时间内,ZnO薄膜的厚度随氩气分压的增加而增加,这也使XRD衍射峰强度逐渐增大。此外,氧气分压的减小使得未电离的中性氧原子减少,在沉积过程中,溅射的粒子从靶材飞向基底途中与氧原子的碰撞几率相应减小,这降低了溅射粒子的能量损失,提高了薄膜的生长速率[20]。

图3 不同氩氧比条件下溅射的ZnO薄膜的XRD 2θ-ω 扫描图谱

图4 ZnO薄膜的沉积速率、XRD衍射峰强、半高宽与氩氧比条件的关系。
图5为ZnO(0002)面衍射峰位与氩氧比条件的关系曲线,由衍射峰位可以方便地计算出ZnO薄膜内部受到的双轴应力。ZnO的c轴长度可由布拉格(Bragg)定律计算得出:
2dsinθ=nλ,
(1)
式中d为晶面间距,n为衍射级数,θ为布拉格角,λ为X射线的波长,λ=0.154 056 nm。由晶面间距d便可知ZnO的c轴长度。薄膜中沿c轴方向的应变εzz可由下式给出[21-22]:
(2)
其中,c为通过ZnO薄膜(0002)面衍射峰位计算得到的c轴长度,c0为纤锌矿ZnO的晶格常数理论值,c0=0.520 65 nm。
对于六方对称的纤锌矿ZnO来说,薄膜内的应力σ与应变εzz的关系为[21-22]:
(3)
其中,Cij为弹性刚度系数,C11=208.8 GPa,C12=119.7 GPa,C33=213.8 GPa,C13=104.2 GPa,代入公式(3)得到:
σ=-233ε(GPa),
(4)
由此可得不同氩氧比条件下制备的ZnO薄膜所受应力情况,其结果如图5所示。可以看出,不同氩氧比条件下所沉积的ZnO薄膜都存在张应力,且随着氧分压的减小,张应力出现了先降低后升高的变化趋势,当Ar/(Ar+O2)为0.7时,ZnO薄膜所受双轴张应力最小。我们认为当氧分压减小时,氩离子增加,加剧了对靶材的轰击,使溅射粒子的能量增加,同时,溅射粒子与中性氧原子的碰撞几率减小,降低了粒子的能量损失,这使得溅射粒子有足够的能量迁移至正常的晶格位置。然而溅射粒子能量过高也会增加对正常点阵位置原子的碰撞,导致晶格畸变,进而产生应力。

图5 ZnO薄膜的衍射峰位、应力与氩氧比条件的关系。
图6为不同氩氧比条件下制备的ZnO薄膜的PL谱,其中短波长的较尖锐的发光峰为ZnO的近带边发光峰,波长位于450~700 nm的较宽的发光峰是与ZnO的缺陷相关的深能级发光。在不同氩氧比条件下制备的ZnO薄膜都有较显著的近带边发光峰。在众多基于硬质衬底和柔性衬底的报道中,ZnO的近带边发光峰位于380 nm附近[23-25],而我们的实验中发现,ZnO的发光峰都有不同程度的红移,图7为ZnO薄膜的发光峰位与氩氧比条件的关系,随着氧气分压的减小,ZnO薄膜的近带边发光峰位逐渐向长波长方向移动。以往的报道中,导致ZnO禁带宽度改变的因素主要包括晶界势垒、氧空位Vo、非晶相、应力以及掺杂等[26-30]。Srikant等报道,当薄膜的晶粒尺寸在30~80 nm时,晶界处的势垒会导致有效带隙宽度降低0.05~0.12 eV[26]。SEM测试表明,不同氩氧比条件下制备的ZnO薄膜的表面均较为平整,形貌无显著差异,其平均晶粒尺寸约为40 nm(如图10(a)),因此我们认为晶界势垒是导致ZnO近带边发光峰红移的一个原因。此外,Liu等报道氧空位Vo也可以导致ZnO的近带边发光峰红移,且红移量随氧空位Vo的增加而增大[27]。在ZnO的PL谱中,氧空位Vo导致的发光峰位于540 nm附近[31],从图6中可以看出,随着氧气分压的减小,540 nm附近的较宽发光峰逐渐增强,说明ZnO薄膜中的氧空位Vo逐渐增多,这与ZnO近带边发光峰位移动规律相吻合(图7所示),因此我们认为氧空位Vo是导致ZnO近带边发光峰红移的另一个原因。非晶相和双轴张应力使ZnO禁带宽度增加。尽管我们所获得的ZnO薄膜都存在张应力,并且不排除存在非晶相,但张应力和非晶相引起的带隙变化很小,都在0.01 eV以下,不足以对ZnO的发光波长产生显著影响。因此我们认为晶界势垒和氧空位Vo是导致ZnO近带边发光峰红移的主要原因。

>图6 不同氩氧比条件下溅射的ZnO薄膜的PL谱
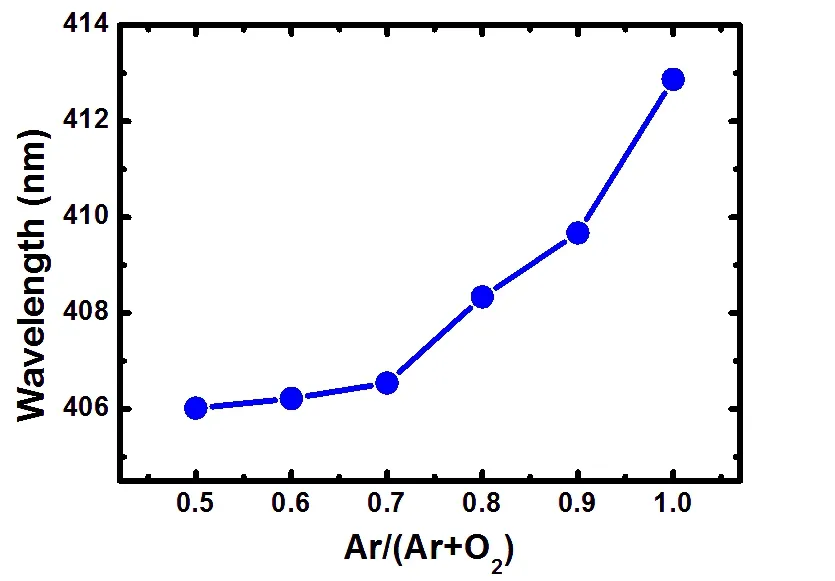
图7 ZnO薄膜的近带边发光峰位与氩氧比条件的关系
3.3 溅射功率对ZnO薄膜性质的影响
图8为不同溅射功率条件下制备的ZnO薄膜的XRD图谱,可以看出,随着溅射功率的增加,ZnO(0002)面的衍射峰强度逐渐增大,这是由于溅射功率增加,相同时间内有更多的靶材原子被轰击出来,这增加了ZnO薄膜的沉积速率,在沉积时间一定时,所沉积的薄膜厚度随溅射功率的增加而增加,因此,衍射峰的强度随薄膜厚度的增加而增大。
图9为不同溅射功率条件下制备的ZnO薄膜的PL谱,可以看出,随着溅射功率从50 W增加到300 W,ZnO薄膜的近带边发光峰位逐渐从408 nm移动至390 nm。我们认为,随着溅射功率的增加,ZnO薄膜厚度增加,晶粒尺寸逐渐增大(如图10所示),晶界势垒对有效禁带宽度的影响逐渐减弱,因此ZnO近带边发光峰位蓝移,逐渐趋向于理论值。然而,过快的沉积速率也使得薄膜中缺陷增多,深能级发光大幅增强(图9)。

图8 不同功率条件下溅射的ZnO薄膜的XRD 2θ-ω 扫描图谱

图9 不同功率条件下溅射的ZnO薄膜的PL谱
图10为不同溅射功率条件下制备的ZnO薄膜的SEM照片,可以看出,不同溅射功率下所制备的ZnO薄膜晶粒尺寸也较为均匀,且随着溅射功率的增加,晶粒尺寸逐渐增大,这可能是由于功率增加使被溅射出的粒子能量升高,生长粒子在基底表面的横向迁移距离增加,形成的晶核可以吸收更大范围内的表面吸附原子,使晶粒的尺寸更大[32]。

图10 不同功率条件下溅射的ZnO薄膜的SEM照片
4 结 论
采用Kurt J. Lesker公司的PVD75型射频磁控溅射仪在蛋白质基底上成功地制备了ZnO薄膜,利用XRD、PL和SEM表征薄膜的性质,研究了不同靶基距、氩氧比和溅射功率条件对ZnO薄膜性质的影响。结果表明,较小的靶基距有助于ZnO薄膜的c轴择优取向生长,提高光学质量,我们的实验中靶基距为10 cm时所制备的ZnO薄膜质量最优。在变氩氧比系列实验中,XRD测试发现,沉积于蛋白质基底的ZnO薄膜存在不同程度的张应力,当Ar/(Ar+O2)为0.7时,ZnO薄膜内的张应力最小。PL测试发现ZnO近带边发光峰有不同程度的红移,且红移量随着氧气分压的减少而增大,我们认为,这是由于晶界势垒和氧空位Vo造成的。随着溅射功率的增大,薄膜生长速率显著加快,晶粒尺寸增大,ZnO的近带边发光峰位逐渐蓝移,但薄膜内的缺陷增多,使深能级发光增强。
