10A/300V JBS整流管设计
2018-07-23闫丽红王永顺刘缤璐
闫丽红,王永顺,刘缤璐
(兰州交通大学 电子与信息工程学院,甘肃 兰州 730070)
结势垒肖特基整流管[1-3]是在功率肖特基二极管的基础上,在漂移区集成了多个梳状的p-n结栅,且结栅间的导电沟道保证在零偏时不被夹断,正向电流通过栅间导电沟道时从阳极流向阴极。当反偏电压超过几伏时,结栅p-n结空间电荷区展宽并相互交迭,引起耗尽层穿通,导电沟道被夹断。结势垒肖特基整流管(Junction Barrier Schottky Rectifier,JBS)具有大电流、高电压、低功耗等优点[4],在电子、通信、计算机、自动化、仪器仪表等领域具有广泛的应用。为此,本文设计并制造了10 A/300 V JBS整流管。
1 有源区参数设计
有源区是JBS整流管的核心部分,它的材料和结构在很大程度上决定着JBS整流管的正向导通特性及反向击穿特性。本次设计的目标是正向电流为10 A、泄漏电流小于20 μA、击穿电压为300 V的JBS整流管。要实现300 V的击穿电压,需要对器件进行终端造型设计,拟在器件中设置两道场限环。对于半导体平面器件,单个场限环能使平面p-n结的实际击穿电压达到理想值的60%以上[5-6]。
1.1 材料参数的确定
有源区采用金属铝作为器件阳极,确定主结和场限环p+区的掺杂浓度为NA= 1 × 1019cm-3,铝n-型漂移区的势垒高度φB=0.81 eV。外延层(即n-型漂移区)的厚度由器件的击穿电压决定,加场限环之后,器件的击穿电压大约是理想值的60%以上。因此,要实现实际300 V的击穿电压,设计的反向击穿电压要取到VB= 300 V/0.6 = 500 V。漂移区的掺杂浓度[7]为
(1)
将VB=500 V代入上式,得到ND=5×1014cm-3。
1.2 结构参数的确定
根据式(2)可以得到临界击穿漂移区[8-15]的厚度tepi为
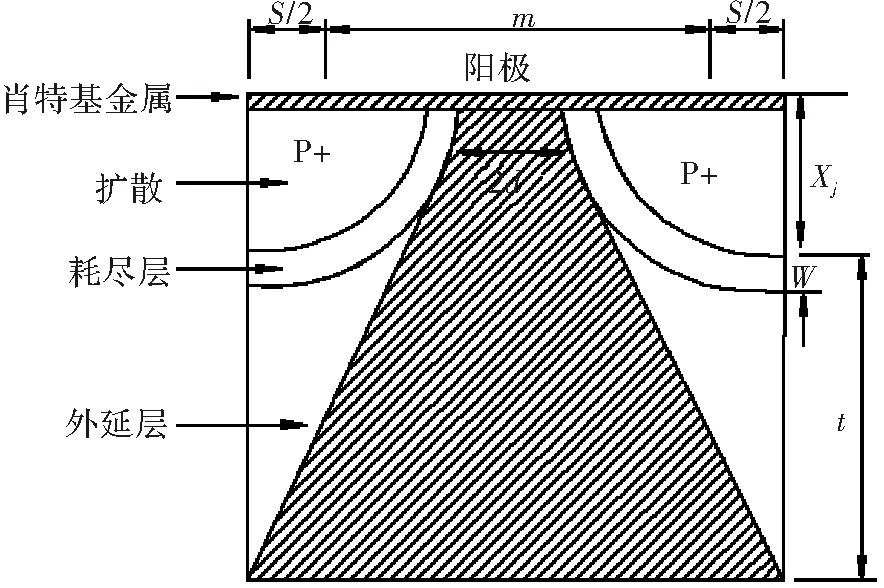
图1 JBS单胞结构图
(2)
当tepi=89 μm时,耗尽层已达到n+区边缘,但考虑到柱面结情况,击穿最先发生在曲率半径最大处,p-n结栅的耗尽层实际并未达到最大耗尽层宽度89 μm,所以选取tepi=89 μm是可行的。
JBS整流管的正向压降
(3)
式中,k为玻尔兹曼常数;T为温度;q为元电荷电量;m为扩散掩膜尺寸;s是扩散结栅时的窗口宽度;xj为p+n结结深;tepi为漂移区厚度;A*为有效理查逊常数;JF为流过每一单胞的电流密度;2d表示导电沟道宽度,如图1所示。ρ表示电阻率
(4)
式中,μn表示电子迁移率。
设横向扩散结深是纵向结深的85%,则导电沟道宽度
2d=m-2W0-2xj×85%,0≤d≤dmax
(5)
式中,W0为p+n结零偏时的耗尽层宽度,dmax为d的最大值。由式(3)可知,JBS的正向压降VF不仅与势垒高度φB、温度T有关,还与结构参数m、s、tepi及ND有关。在正向压降的表达式中p+n结内建电势
(6)
零偏时p+n结耗尽层宽度
(7)
反偏时p+n结耗尽层宽度
(8)
式中,VR为反偏电压,εs为半导体介电常数。d的最大值
dmax=WR(VR=VR0)-W0
(9)
式中,VR0表示导电沟道预夹断时的反偏电压。
JBS整流管的反向电流密度
(10)
式中,JLS表示金属-半导体结反向电流密度;JLD表示p+n结反向电流密度;D表示载流子扩散系数;τ表示少子寿命;k表示肖特基势垒区的电场强度[8]
(11)
在结构参数中,首先确定m和s的取值。取φB=0.81 eV,JF=20 A/cm2,ND=5×1014cm-3,NA=1×1019cm-3,tepi= 89 μm,T=300 K,A*=252 A/cm2·K2,ni=1.5×1010cm-3,xj分别取2 μm、3 μm和4 μm。本次设计要求JBS整流管在反偏电压VR0=15 V时必须夹断,根据式(5)~式(9)可计算得到器件结构参数m的取值范围,如表1所示。取s=4 μm,随着m的增大,VF减小,JL增大。这是由于随着m的增大肖特基势垒所占的比例增加。另外,随着m的增大沟道宽度2d亦增大,导致沟道串联电阻减小,所以m的取值需综合考虑其对VF和JL的影响[8]。

表1 不同xj值时m的取值范围 /μm
2 JBS终端造型设计
对于功率半导体器件,曲面弯曲效应严重影响着器件的击穿电压。为了减小p+n结的曲面弯曲效应,在器件中设计了两道场限环,如图2所示。分析时可将第一道场限环和主掺杂结当作一个整体,环二的浮空电场方向与环一相反,对主结的电场具有削弱作用,由此可以提高器件的击穿电压。用场限环技术可使器件的实际击穿电压达到理想值的60%,此时器件承受的实际电压等于主结电压和各个场限环电压之和[9-12]。影响击穿电压的最主要因素是场限环的间距。若取值合适,主结与环结电场将同时达到雪崩击穿的临界点,从而可获得最大的反向击穿电压。

图2 场限环示意图
在理想情况下,可以假设每个p+n结为单边突变结,结边界可使用圆柱形对称解作近似,忽略半导体到空气的电场损耗,环间距(l1和l2)略小于结深(rj),两道场限环在雪崩击穿临界点时均发生穿通,忽略环间的内边界势垒。图2中n-漂移区的泊松方程为
(12)
各场限环耗尽层分担的电压[8]

(13)

(14)
(15)
(16)
主结右侧的电场强度
(17)
环一右侧的电场强度
(18)
环二右侧的电场强度
(19)
环间距的最优条件[8]为
ED=EF1=EF2=ECC
(20)
式中,ECC=[6/Arj]1/7;A=1.8×10-35cm-1;rj=xj。当VB=500 V且xj=2,3,4 μm时,主结和各环结上的电压和最佳环间距如表2所示[13]。

表2 不同结深下场限环的设计参数 /μm
3 JBS工艺流片及测试结果分析
3.1 JBS工艺流片设计
根据前面设计的材料参数、结构参数,经过外延片材料准备、初始氧化等40多道工艺制造,对JBS整流管从圆片制作成管芯并封装成成品[13]进行一系列的工艺流程,如图3所示。在具体生产过程中,厂房温度24±3 ℃,相对湿度25%~50%;光刻间温度22±2 ℃,相对湿度35%~50%。图4是封装后的JBS整流管正面外形图。

图3 JBS整流器工艺流程图

图4 封装后的10 A/300 V JBS整流管
3.2 JBS产品测试结果分析
为保证产品流片后VBR可满足大于300 V的要求,对生产过程进行测试。
(1)引线孔腐蚀去胶后测试。根据实验设计基本原则,确定外延片参数不变,对硼退火的流片温度进行实验,实验数据结果如表3所示。

表3 不同硼退火工艺温度VBR数据值
根据实验结果可确认退火工艺温度对VBR数据的影响很大,最终确定选择硼退火工艺温度 1 180 ℃进行生产流片。探针测试主结区域VBR值在340~450 V范围内,测试电参数VBR曲线如图5所示,已满足设计要求300 V[14]。

图5 JBS 10A/300V产品引线孔腐蚀去胶后反向VR曲线:400 V
(2)背面金属化后测试。背面金属蒸发后,产品已定型,测试的数据是准确的。VR为320~380 V,IR<20 μA,VF@10 A:0.8~0.84 V,均满足设计标准要求,具体电参数曲线如图6和图7所示。

图6 JBS产品背面金属化后主结反向曲线VR=380 V,IR=20 μA

图7 JBS产品背面金属化后主结正向曲线VF=0.81 V@10 A
(3)JBS产品可靠性试验。JBS产品封装完成后的可靠性试验,主要进行了产品电参数测量、抗静电试验(ESD)、直流老化,经试验,该产品ESD水平高,可达15 kV水平,经高温直流老化后,产品电参数测试合格,可靠性水平满足预期要求[15]。
4 结束语
本文设计并制造了具有场限环结构的10 A/300 VJBS整流管。经测试结果表明,电参数水平正向电压VF=0.85~0.856 V,反向电流IR=4~50.5 μA,反向电压VR=307.5~465.2 V,产品由于硼退火温度的提升,增加了结深,ESD水平从低温退火的6~12 kV提高到15 kV,经高温直流老化后,可靠性电参数水平满足预期的设计要求,符合行业标准。
