C波段400 W GaN内匹配功率管研制
2018-06-25徐永刚顾黎明汤茗凯唐世军陈晓青
徐永刚,顾黎明,汤茗凯,唐世军,陈晓青,刘 柱,陈 韬
(南京电子器件研究所,南京 210016)
1 引言
氮化镓(GaN)是第三代宽禁带半导体的典型代表,具有击穿电压高、功率密度大、热导率高、抗辐射等突出优点。与第一代半导体Si和第二代半导体GaAs相比,GaN材料的电子饱和漂移速度和峰值漂移速度更大,是制备高压、大功率、高温、抗辐射的新一代微波功率器件和电路的理想材料。同时,由于GaN材料具有高热导率的特点,其在高温环境下工作时具有良好的散热特性以及更高的可靠性[1]。
GaN微波功率器件及MMIC相关产品在雷达、通信卫星和基站等通信设备中有着广泛的应用前景。随着无线通信以及卫星通信系统的发展,大功率、高效率GaN内匹配功率管的研发需求越来越迫切。近年来,国内外科研机构及相关企业纷纷推出不同频段、不同功率级别的GaN内匹配功率管产品,而在C波段,已经报道的内匹配功率管的功率从几十瓦到上百瓦不等,日本Takao Ishida等学者报道过一款应用于雷达的C波段100 W内匹配功率管产品[2];西电的卢阳等人也报道了一款C波段102 W的高效率内匹配GaN功率管[3]。本文基于南京电子器件研究所自主研制的GaN HEMT管芯,采用四胞合成的方式,在50 V条件下实现5.3~5.9 GHz频带内输出功率400 W,功率增益12 dB,带内附加效率48%以上。
2 GaN管芯
本文中选用的GaN HEMT由南京电子器件研究所研制,其AlGaN/GaN晶体管外延材料结构截面图如图1所示,SiC衬底之上分别为成核层、掺Fe GaN缓冲层、GaN沟道层、AlGaN势垒层和GaN帽层[4],在GaN沟道层和AlGaN势垒层之间有厚度约为1 nm的AlN插入层。管芯采用了对缓冲层掺杂适量Fe元素的方式提升了击穿电压。管芯采用“V”型栅结构,直流测试得到器件两端和三端击穿电压分别达到了180 V和160 V。
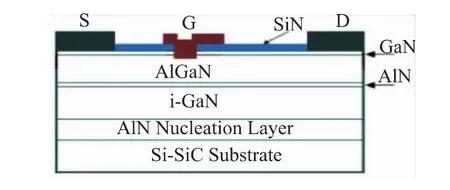
图1 AlGaN/GaN晶体管截面示意图
根据负载牵引测试结果,可以推算在6 GHz、50 V条件下,400 μm元件偏效率点的功率密度可以达到7.5 W/mm,根据此并结合匹配损耗及合成效率推算,为了实现400W以上的输出功率,需要采用4个16mm的管芯进行功率合成,16 mm管芯版图如图2所示。

图2 16 mm栅宽GaN HEMT管芯版图
3 内匹配电路的设计与实现
3.1 GaN HEMT器件输出阻抗模型
由于GaNHEMT管芯的功率密度可达7.5W/mm,远高于GaAs微波功率管(约10倍),且GaN器件的模型对热效应非常敏感,因此包含了热效应影响的负载牵引(Load-Pull)测试数据精度更高,可以直接用于指导设计。所以目前针对大栅宽、高功率的GaN器件,其输出阻抗模型主要还是依据负载牵引测试结果。
本文中对PCM单胞0.4 mm栅宽的GaN管芯进行Load-pull测量,得到其大信号负载阻抗,其测试结果如表1所示,然后按比例推算出16 mm栅宽GaN管芯的输出阻抗,作为进行管芯输出端匹配网络设计的依据。
表1为6.0 GHz频点下负载牵引测试得到的最佳功率、效率阻抗点及其所对应的功率、附加效率,测试条件为漏压50 V。图3为简化的GaN HEMT输出阻抗电路模型,电阻和电容的值由负载牵引测得的阻抗值换算得到,考虑到最佳功率阻抗和最佳效率阻抗的折中,最终优化出1 mm GaN功率管芯等效输出电阻和等效输出电容分别为96 Ω和0.34 pF。大栅宽管芯的输出阻抗可以通过并联来获得。

表1 6.0 GHz的负载牵引测试数据

图3 简化的GaN HEMT输出阻抗电路模型
采用管芯的小信号模型参数设计输入匹配电路,小信号模型可以通过在片测试小栅宽管芯的S参数进行提取。
3.2 内匹配电路的设计
内匹配技术是实现大功率器件的核心技术之一,GaN管芯栅宽越大,实阻抗部分越小,要把四胞管芯阻抗匹配到50 Ω,需要引入输入、输出内匹配电路。匹配电路可以提升管芯输入端与输出端阻抗的实部,抵消虚部,使管芯及管芯各部分间在信号幅度与相位上获得平衡,对参与匹配的管芯进行功率分配与合成,并且最终将四胞管芯输入输出阻抗变换到50 Ω。
匹配电路采用传统的匹配方式,主要包括两个部分,一部分是带阻抗变换的功率分配/合成器,功率分配/合成器的端口阻抗设置为15 Ω。在单个管芯的输入端通过一级L-C-L将阻抗进行提升,再通过两段微带线将阻抗变换到100 Ω,从而合成后实现50 Ω。输出端阻抗首先经一级L-C将单个管芯阻抗值进行提升,并抵消掉阻抗虚部,再经过两段微带线后匹配到100 Ω,从而合成后实现50 Ω。最终对整个电路进行了MOMENTUM仿真,图4为四胞GaN内匹配电路拓扑结构图。
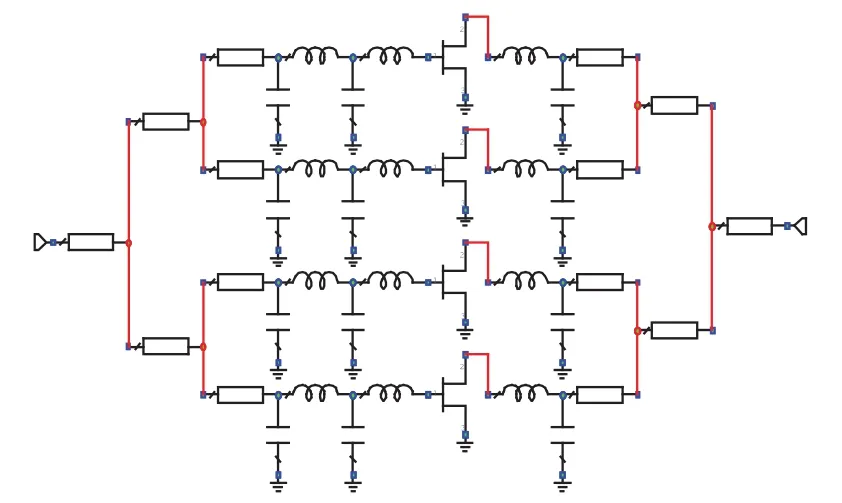
图4 内匹配功率管总体拓扑示意图
3.3 内匹配电路的实现
采用薄膜电路工艺制作内匹配电路,功率分配/合成器均制作在A12O3陶瓷基片(介电常数为9.9,厚度为380 μm)上,端口之间制作平衡电阻,增加各路之间的隔离。
在L-C型网络设计中,电感使用键合金丝等效,电感为[5]:

式中:D为金丝直径,n为金丝的根数,l为金丝长度,s为金丝间距,键合金丝直径为25 μm。
电容采用Al2O3陶瓷基片制作,双面镀金的电容值 C 为[5]:

式中:εr为材料的相对介电常数,ε0为真空介电常数,a为长,b为宽,t为厚度,K为修正因子,通常取值为1.2~1.8。文中所用陶瓷基片介电常数为85,厚度为180 μm。
根据设计仿真,电路片、管芯、电容等合理排布并用290℃金锡焊料烧结在高热导率管壳中以降低热阻,并用金丝键合。图5为最终实现的内匹配功率管正面照片。完成装配后,首先对器件进行初步测试,根据测试结果调整管芯栅和漏端的键合金丝长度和弧度以及匹配电容值的大小,使整个器件的匹配达到最佳状态,实现50 Ω匹配及功率最大,效率最佳。

图5 内匹配功率管照片
4 测试结果与分析
对功率管进行了测试,条件为:栅电压-2.9 V,漏电压50 V,周期1 ms,占空比10%,输入功率恒定44 dBm时,其输出功率与附加效率测试结果如图6所示。在5.3~5.9 GHz频率范围内,输出功率大于400 W,带内最高点处达到最大值431 W。各频点功率附加效率均在48.2%以上,最高点达到52.06%。从图中可以看出功率增益大于12 dB,最高点达到12.35 dB。

图6 微波测试结果
上述测试结果表明,在5.3~5.9 GHz,匹配合成后的器件在脉冲条件下GaN HEMT管芯的功率密度可达到6.25~6.73 W/mm,采用总栅宽为4×16 mm的管芯,最终实现了输出功率400 W以上的器件。
5 总结
本文采用自主研发的GaN HEMT管芯进行了四胞功率匹配合成,实现了大栅宽管芯的功率阻抗匹配,研制出在5.3~5.9 GHz频带内输出功率400 W、功率附加效率超过48.2%、功率增益大于12 dB的GaN内匹配功率管。采用该设计方法设计的内匹配功率管可以实现更高的输出功率,在固态微波放大器中有很好的应用前景。
[1]MILLIGAN J W,SHEPPARD S,PRIBLE W,et al.SiC and GaN wide bandgap device technologyoverview[C].Proceedings of IEEE Radar Conference.Boston MA,USA,2007:960-964.
[2]Takao Ishida.GaN HEMT Technologies for Space and Radio Applications[C].IEICE technical Report,2011,54(8):56.
[3]Yang Lu,Mengyi Cao,et al.71%PAE C-band GaN power amplifier using harmonic tuning technology[J].Electronic Letter,2014,50(17):1207-1209.
[4]Ren Chunjiang,Li Zhonghui,Yu Xuming,et al.Field plated 0.15 μm GaN HEMTs for millimeter-wave application[J].Chinese Journal of Semiconductor,2013,34(6):064002-1-064002-5.
[5]李效白.砷化镓微波功率场效应管及其集成电路[M].北京:科学出版社,1982:279.
