氢化非晶硅薄膜晶体管的低频噪声特性∗
2017-12-25刘远何红宇陈荣盛李斌恩云飞陈义强
刘远 何红宇 陈荣盛 李斌 恩云飞 陈义强
1)(工业和信息化部电子第五研究所,电子元器件可靠性物理及其应用技术国家重点实验室,广州 510610)
2)(华南理工大学微电子学院,广州 510640)
3)(北京大学深圳研究生院信息工程学院,深圳 518005)
4)(南华大学电气工程学院,衡阳 421001)
氢化非晶硅薄膜晶体管的低频噪声特性∗
刘远1)2)何红宇3)4)陈荣盛2)†李斌2)恩云飞1)陈义强1)
1)(工业和信息化部电子第五研究所,电子元器件可靠性物理及其应用技术国家重点实验室,广州 510610)
2)(华南理工大学微电子学院,广州 510640)
3)(北京大学深圳研究生院信息工程学院,深圳 518005)
4)(南华大学电气工程学院,衡阳 421001)
非晶硅,薄膜晶体管,低频噪声,局域态密度
1 引 言
氢化非晶硅薄膜晶体管(hydrogenated amorphous silicon thin film transistor,a-Si:H TFT)具有成本低廉、均匀性好、开关电流比大等优点,作为寻址开关元件、驱动电路等在大屏显示领域取得广泛应用[1],其制备、电学性能与稳定性已成为国内外研究热点[2,3].
a-Si:H TFT沟道内局域态分布将严重影响器件电学性能及稳定性[4,5].业界希望通过改良制程工艺来改善器件沟道内局域态分布并优化其界面性能.作为一种新型无损电学表征方法,低频噪声已被引入a-Si:H TFT器件质量及稳定性评价中[6−9].
在低频噪声研究与应用过程中,业界常借用金属氧化物半导体场效应晶体管(MOSFET)的经典理论与模型来描述a-Si:H TFT的噪声特性,通常不考虑沟道内局域态分布的影响.此外,由于a-Si:H TFT源漏接触电阻较大[10,11],这不但严重影响了器件的电流-电压(I-V)特性(例如电流拥挤效应),还将对器件低频噪声特性产生显著影响[6,12].因而有必要在考虑局域态分布与接触电阻影响的情况下,进一步对a-Si:H TFT低频噪声特性及其影响机理展开研究.
在器件建模与电路仿真过程中,a-Si:H TFT局域态随能级的分布是一项重要参数.业界采用数值仿真、I-V与变频C-V等手段对局域态分布进行参数提取与拟合[13−15].上述方法能较好地提取深能态缺陷的分布,但不能精确提取得到导带底附近带尾态缺陷的分布,因而可引入低频噪声方法进行数据补充与完善.
本文拟针对a-Si:H TFT的低频噪声特性展开实验与理论研究.在测量器件低频噪声功率谱密度后,分析器件低频噪声的影响机理,探讨接触电阻对器件低频噪声的影响;通过I-V特性提取器件表面能带弯曲量,并基于低频噪声构建器件局域态分布的提取方法;最后,对器件平均Hooge因子进行提取与分析.
2 器件直流特性与表面能带弯曲量
2.1 器件直流特性
所用样品为背沟刻蚀、底栅结构的非晶硅薄膜晶体管.首先,在玻璃衬底沉积Al/Mo作为栅电极,并通过湿法刻蚀制作相关图形.随后,分别沉积栅绝缘层(a-SiNx:H)、有源层(a-Si:H)以及源漏电极(Mo/Al/Mo).制作器件的结构如图1所示,其中栅绝缘层厚度为400 nm,有源层厚度为50 nm,器件宽长比(W/L)为3750µm/3.5µm.
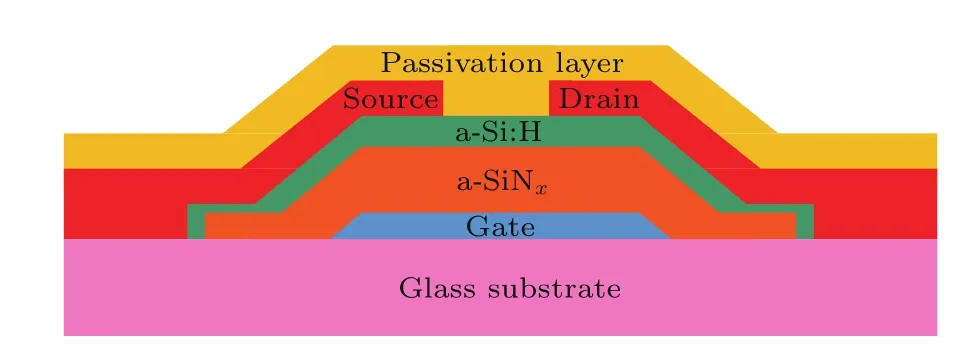
图1 a-Si:H TFT结构示意图Fig.1.Cross section view of a-Si:H TFTs.

图2 (网刊彩色)a-Si:H TFT的转移特性曲线Fig.2.(color online)Transfer characteristics of the a-Si:H TFTs.
为准确测量与分析器件的电学性能,基于半导体器件参数测试仪(Agilent B1500)的SMU单元对a-Si:H TFT进行I-V测试,器件转移特性、输出特性曲线如图2和图3所示.提取器件阈值电压Vth约为3.21 V,栅绝缘层电容Cox为5.04 nF/cm2,载流子有效迁移率µeff约为0.14 cm2·V−1·s−1,亚阈斜率SS约为1.03 V/dec,电流开关比约为106.
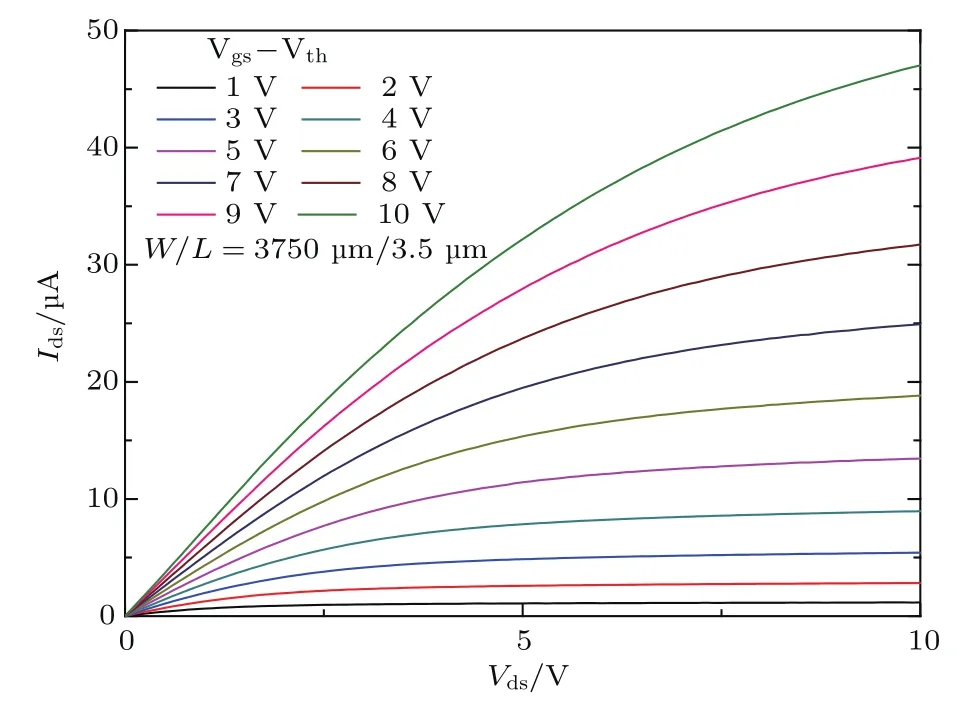
图3 (网刊彩色)a-Si:H TFT的输出特性曲线Fig.3.(color online)Output characteristics of the a-Si:H TFTs.
2.2 表面能带弯曲量
当器件工作在亚阈区时,栅压作用下引入沟道内的电荷大部分被陷阱态(包含深能态与带尾态)所俘获,亚阈电流Ids将随栅源电压Vgs呈指数变化:

式中VT为热电势,Ids0为Vgs=Vth时的源漏电流,η为亚阈因子.
由文献[16,17]可知,亚阈区内器件表面能带弯曲量φs与栅压间关系为

式中VFB为平带电压,φox为栅绝缘层上的电压降,Qs为引入沟道的总电荷量.

结合(1)式与(2)式可得表面能带弯曲量与亚阈电流之间的关系为基于(3)式,采用两个相近栅压(Vgs1与Vgs2)时测得源漏电流Ids1与Ids2,对实验曲线进行非线性拟合[16,18],即可获得器件表面能带弯曲量为

基于a-Si:H TFT的转移特性曲线,提取得到器件表面能带弯曲量随栅源电压的变化趋势如图4所示.当器件工作在亚阈区时,引入沟道的电荷大部分被深能态所俘获,此时表面能带弯曲量随栅压的增加而迅速变化.当器件工作在开启区时,引入沟道的电荷大部分为被带尾态俘获的电荷以及自由载流子;由于费米能级已接近导带底,因而表面能带弯曲量随栅压的变化较缓慢并呈饱和.
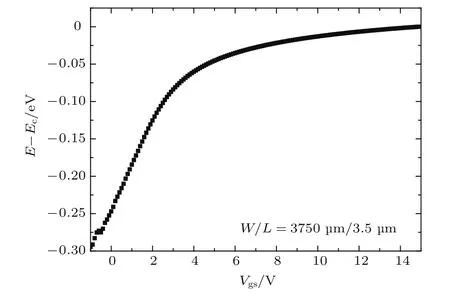
图4 a-Si:H TFT表面能带弯曲量随栅源电压的变化Fig.4.Band bending versus gate-source voltage in the a-Si:H TFT.
3 器件低频噪声特性与分析
噪声来源于物理量的随机起伏.半导体器件中闪烁噪声与产生-复合噪声的功率谱密度与频率有关,其在低频情况下较为显著,故又统称为低频噪声.本节将针对a-Si:H TFT低频噪声特性的影响机理、接触电阻对低频噪声的影响、低频噪声与局域态之间的相关性展开测试、参数提取与理论分析研究.
3.1 器件低频噪声的影响机理
基于半导体器件参数测试仪(Agilent B1500)与低频噪声测试仪(Keysight E4727A)构建a-Si:H TFT的低频噪声测试系统;使用B1500的SMU单元监控器件电学参数的变化,采用E4727A构建滤波、低频噪声放大及数据采集单元.为使被测器件与低频噪声放大单元相匹配,还需在器件栅极与漏极串联相应电阻,其阻值由软件系统(Keysight Waferpro)根据器件的输入、输出阻抗进行自动匹配.
基于上述软、硬件测试系统,可在过驱动电压Vgs−Vth=3 V与不同Vds条件下,测得器件低频噪声功率谱密度(SID)随频率的变化,如图5所示.

图5 (网刊彩色)不同Vds条件下a-Si:H TFT的低频噪声功率谱密度SIDFig.5.(color online)Noise spectral densities in the a-Si:H TFTs with varied drain-source voltages.
由图5可知,受Si/SiNx界面附近缺陷俘获与释放载流子效应的影响,a-Si:H TFT沟道电流噪声功率谱密度SID随频率f的变化遵循1/fγ的变化规律,其中γ约为0.92.由文献[18,19]可知,γ因子反映了Si/SiNx界面附近缺陷态的纵向分布;如果γ<1,则沟道内缺陷态密度大于栅绝缘层内陷阱密度;如果γ>1,则沟道内缺陷态密度小于栅绝缘层内陷阱密度.基于γ因子测量,可知a-Si:H TFT沟道内体缺陷密度与栅绝缘层内中立陷阱密度相近,但沟道内局域态密度更大.
由MOSFET低频噪声的物理模型可知:1/f噪声主要由载流子数随机涨落(ΔN)及迁移率随机涨落(Δµ)机理所主导,前者主要基于McWhorter模型[20],后者则基于Hooge经验模型[21].当器件工作在线性区时(沟道内自由电子呈强积累状态并形成沟道),若器件低频噪声特性主要由迁移率随机涨落机理所主导,则器件归一化之后的沟道电流噪声功率谱密度

式中f为频率;αH为Hooge因子,用于表征器件沟道材料质量与界面处理工艺的优劣.若器件低频噪声特性主要由载流子数随机涨落机理所主导,则器件为[20]

为明确a-Si:H TFT低频噪声的来源,可在Vds=0.1 V,Vgs变化条件下对器件低频噪声功率谱密度进行测量,并提取随过驱动电压的变化,如图6所示.
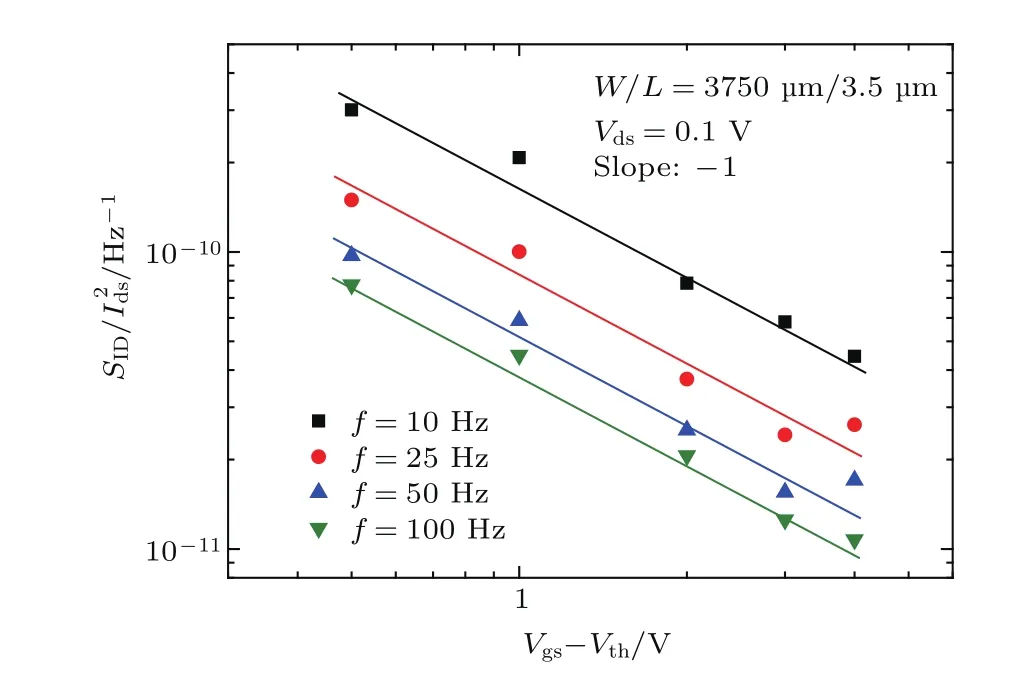
图6 (网刊彩色)器件低频噪声随过驱动电压的变化Fig.6.(color online)Low frequency noise versus overdrive voltage in the a-Si:H TFT.
由文献[22,23]可知,若噪声由载流子数随机涨落所主导,则随Vgs−Vth的变化斜率趋向于−2;若噪声由迁移率随机涨落所主导,则随Vgs−Vth的变化斜率趋向于−1.由图6可知,随Vgs−Vth的变化斜率约为−1,这表明器件低频噪声在线性区内主要受迁移率随机涨落效应的影响.
与传统的金属氧化物半导体(MOS)器件不同,a-Si:H TFT有源层/绝缘层界面附近存在大量体缺陷(局域态),包括深能态与带尾态.当器件工作在开启区时,引入沟道的载流子将部分被带尾态所俘获,另一部分则成为自由载流子.考虑局域态的影响,被陷阱所俘获的载流子亦将出现俘获-释放等现象,这不但会导致Si/SiNx界面附近载流子数量的涨落,还将进一步引起Si/SiNx界面附近载流子有效迁移率的涨落,这与MOS器件中与迁移率涨落相关的载流子数随机涨落模型(ΔN-Δµ模型)较为相似.
由文献[7,24,25]可知,当半导体器件中载流子数的随机涨落造成有效迁移率的显著变化时,其低频噪声特性可基于ΔN-Δµ模型进行描述.此时,沟道电流的噪声功率谱密度可表征为[24,25]

式中gm为器件跨导;αs为一常数,表征有效迁移率与界面附近电荷库仑散射等效应间的相关性;SVfb为平带电压噪声功率谱密度,通常可表示为[24,25]

式中Nt为界面附近缺陷态密度;λ为载流子在栅绝缘层中的隧穿距离,约为0.1 nm;K为玻尔兹曼常数;T为环境温度.
护理教师在传授护理知识、护理技能的同时也应进行护理研究。作为一名护理教师,只有在完成教学任务的基础上潜心研究,才能达到“以教带研,以研促教”的目的。护理教师可以把在护理教学、临床工作中发现的问题、难点、热点作为科研课题和方向,通过科学、严谨的科研方法去分析解决这些问题,不仅促进了护理专业的发展,也促进了教师本人的成长。所以,护理教师不仅要精于教学,也要勤于科研,从而获得教学和科研双丰收。
αs与SVfb可根据栅电压功率谱密度SVg提取得到.当器件工作在开启区时,栅电压功率谱密度通常可表征为[7,24,25]

图7为测得的a-Si:H TFT的栅电压功率谱密度.由图7可知,当器件工作在阈值电压附近时,测得的SVg值较相近,因而可提取得到SVfb约为4×10−10V2/Hz,界面附近缺陷态密度Nt约为7.69×1010cm−2·eV−1. 此外,依据SVg的平方根随过驱动电压的变化,可提取得到αs的值约为8.38×107V·s·C−1.

图7 a-Si:H TFT的栅电压功率谱密度Fig.7.Gate voltage noise spectral density in the a-Si:H TFTs.
基于提取得到的SVfb与αs的相关数据,采用(7)式可对归一化沟道电流噪声功率谱密度进行仿真,仿真数据与实测数据如图8所示.由图8可知,(7)式的仿真数据与实测数据相符合,但在沟道电流较大时却存在差异,这主要是受器件漏源接触电阻的影响[12],下节将对此进行讨论与优化.当沟道电流较小时,器件沟道表面电流与体电流较相近;此时,除界面附近缺陷外,器件体内局域态亦将对载流子随机涨落产生影响,并引起额外的低频噪声;该现象使得实测数据与仿真数据间产生误差,在(7)式中引入额外的噪声项展开可进行进一步精确表征[26].

图8 (网刊彩色)a-Si:H TFT低频噪声随沟道电流的变化Fig.8.(color online)Low-frequency noise versus drain current in the a-Si:H TFT.
3.2 接触电阻对低频噪声的影响
与传统MOS器件不同,a-Si:H TFT通常采用叠栅结构,其源、漏区并不掺杂,因而接触电阻较大,这对器件电性能、低频噪声特性等产生较大影响.当器件工作在深线性区时,可采用外推法[6,7]提取器件接触电阻,如图9所示.
与沟道电阻相似,接触电阻也会对器件低频噪声特性产生较大影响.电阻值的涨落将引起电流的涨落,可表征为[27]

图9 器件总电阻Rtot随过驱动电压的变化Fig.9. Extracted total resistance versus overdrive voltage in the a-Si:H TFT.

当器件工作在开启区时,沟道内载流子数可近似表征为Nch=LCox(Vgs−Vth)/q.沟道电阻Rch随着Nch的增加而减小,因而Rch∝(Vgs−Vth)−1.结合(10)式,沟道电阻和接触电阻对低频噪声的贡献可近似表征为[28,29]

基于(11)式和(12)式,a-Si:H TFT中低频噪声随过驱动电压的变化可能呈现四种情况[28−30]:
1)若器件总电阻值和低频噪声均由沟道电阻决定,则

2)若器件总电阻值由沟道电阻决定,而低频噪声由接触电阻决定,则

3)若器件总电阻值由接触电阻决定,而低频噪声由沟道电阻决定,则

4)若器件总电阻值和低频噪声均由接触电阻决定,则

由图10可知,当过驱动电压较小时,器件低频噪声随过驱动电压的变化率为−1,因而器件总电阻值和低频噪声此时均由沟道电阻决定;当过驱动电压较大时,器件低频噪声随过驱动电压的变化率为2,这表明此时沟道电阻可决定器件总电阻值,但器件低频噪声主要由接触电阻提供.
考虑漏源接触电阻的影响,器件低频噪声可表征为[30]

式中SRC为接触电阻噪声功率谱密度.采用(17)式即可很好地拟合器件低频噪声实测数据,如图8所示.

图10 器件归一化电流噪声功率谱密度随过驱动电压的变化Fig.10.Low frequency noise versus overdrive voltage in the whole region by considering contact resistance.
3.3 沟道内局域态分布的提取
由上文可知,被测a-Si:H TFT的低频噪声特性主要受界面附近局域态俘获和释放载流子的影响.基于所测沟道电流噪声功率谱密度,可提取得到不同过驱动电压作用下Si/SiNx界面附近的局域态密度为[31,32]

结合上文给出的栅压与表面能带弯曲量之间的关系,即可获得局域态随能级的变化,如图11所示.

图11 a-Si:H TFT局域态密度随能级的变化Fig.11.Distribution of localized states in the band gap of a-Si:H TFT.
由图11可知,a-Si:H TFT中局域态分布满足指数变化规律[4,5]:

式中NT1和NT2为导带底局域态密度,TT1和TT2为局域态特征温度(采用该参数可描述局域态随能级的分布).经过拟合可知,NT1约为6.31×1018cm−3·eV−1,TT1约为192 K;NT2约为1.26×1018cm−3·eV−1,TT2约为290 K.
上述提取的局域态密度及其分布参数与文献[4,5]报道的带尾态密度及其特征温度相近,这表明低频噪声适用于提取a-Si:H TFT等器件有源层内的带尾态等陷阱分布.然而,由于a-Si:H TFT有效迁移率与源漏电流较小,很难测得更小电流下器件的低频噪声,因而较难提取得到更靠近禁带中央处深能态陷阱的密度及其分布.以上参数需采用变频C-V法亦或其他电学、材料表征方法进行补充与完善.
在靠近导带底部处,受接触电阻影响,测得归一化低频噪声功率谱密度上升,使得提取的NT下降,这并不能真实反映缺陷态在导带底的密度和分布情况,因而实测数据与拟合数据间存在差异.
3.4 平均Hooge因子
当器件工作在开启区时,基于迁移率随机涨落模型,可评估器件及所用沟道材料性能的优劣.由(5)式可知,器件Hooge因子可近似表征为[22,23]

基于(20)式可估算得到器件平均Hooge因子αH约为0.011,如图12所示.
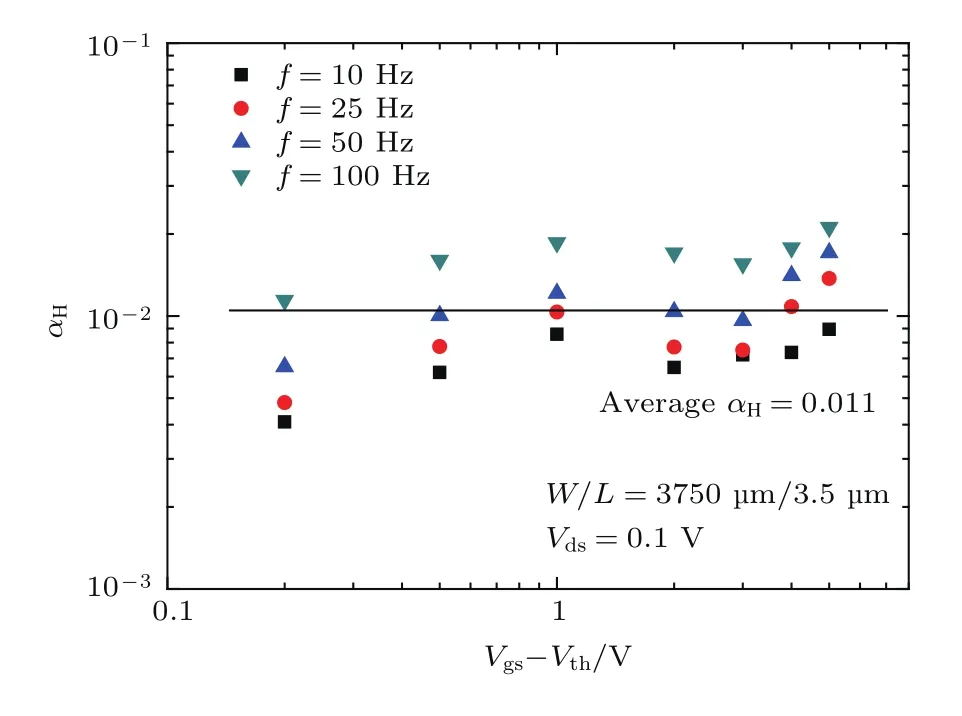
图12 a-Si:H TFT的平均Hooge因子Fig.12.Extracted average Hooge’s parameters in the a-Si:H TFTs.
由文献可知:在MOSFET中,αH介于10−6—10−4之间[33];在多晶硅薄膜晶体管中,αH约为10−3—10−2[34];在铟锌氧化物(IZO)薄膜晶体管中,αH约为10−3—10−1[22,23];在有机薄膜晶体管中,αH约为5—20[35].由此可知,本文所用非晶硅薄膜晶体管的材料性能较有机薄膜晶体管更优,与多晶硅、IZO薄膜晶体管等器件特性相当,适用于驱动电路、传感器和开关矩阵.
4 结 论
本文针对氢化非晶硅薄膜晶体管的低频噪声特性展开实验与理论研究.基于测得的低频噪声功率谱密度随过驱动电压的变化趋势,明确器件低频噪声的主导机理为迁移率随机涨落机理.在考虑接触电阻影响的情况下,分析低频噪声随沟道电流的变化趋势,并基于ΔN-Δµ模型进行参数拟合.基于亚阈区I-V特性,提取得到器件表面能带弯曲量随栅源电压的变化,并由此从低频噪声特性中提取得到沟道内局域态随能级的分布情况.最后对器件的平均Hooge因子进行参数提取与分析.
[1]Nathan A,Kumar A,Sakariya K,Servati P,Sambandan S,Striakhilev D 2004IEEE J.Solid-State Circ.39 1477
[2]Hu Z J,Wang L L,Liao C W,Zeng L M,Lee C Y,Lien A,Zhang S D 2015IEEE Trans.Electron Dev.62 4037
[3]Deane S,Wehrspohn R B,Powell M J 1998Phys.Rev.B58 12625
[4]He H Y,He J,Deng W L,Wang H,Liu Y,Zheng X R 2014IEEE Trans.Electron Dev.61 3744
[5]Liu Y,Yao R H,Li B,Deng W L 2008J.Disp.Technol.4 180
[6]Rhayem J,Valenza M,Rigaud D,Szydlo N,Lebrun H 1998J.Appl.Phys.83 3660
[7]Rigaud D,Valenza M,Rhayem J 2002IET Proc.Circuits Devices Syst.149 75
[8]Hatzopoulos A T,Arpatzanis N,Tassis H,Dimitriadis C A,Templier F,Oudwan M,Kamarinos G 2007Solid-State Electron.51 726
[9]Tai Y H,Chang C Y,Hsieh C L,Yang Y H,Chao W K,Chen H E 2014IEEE Electron Dev.Lett.35 229
[10]Jung K D,Kim Y C,Park B G,Shin H,Lee J D 2009IEEE Trans.Electron Dev.56 431
[11]Chen C Y,Kanicki J 1998Solid-State Electron.42 705
[12]Xu Y,Minari T,Tsukagoshi K,Gwoziecki R,Coppard R,Balestra F,Chroboczek J A,Ghibaudo G 2010Appl.Phys.Lett.97 033503
[13]Kimura M,Nakanishi T,Nomura K,Kamiya T,Hosono H 2008Appl.Phys.Lett.92 133512
[14]Xu P R,Qiang L,Yao R H 2015Acta Phys.Sin.64 137101(in Chinese)[徐飘荣,强蕾,姚若河2015物理学报64 137101]
[15]Bae H,Choi H,Oh S,Kim D H,Bae J,Kim J,Kim Y H,Kim D M 2013IEEE Electron Dev.Lett.34 57
[16]Lee J,Jun S,Jang J,Bae H,Kim H,Chung J W,Choi S J,Kim D H,Lee J,Kim D M 2013IEEE Electron Dev.Lett.34 1521
[17]Servati P,Nathan A 2002IEEE Trans.Electron Dev.49 812
[18]Wang J,Liu Y,Liu Y R,Wu W J,Luo X Y,Liu K,Li B,En Y F 2016Acta Phys.Sin.65 128501(in Chinese)[王静,刘远,刘玉荣,吴为敬,罗心月,刘凯,李斌,恩云飞2016物理学报65 128501]
[19]Jayaraman R,Sodini C G 1989IEEE Trans.Electron Dev.36 1773
[20]Dimitriadis C A,Brini J,Lee J I,Farmakis F V,Kamarinos G 1999J.Appl.Phys.85 3934
[21]Hooge F N 1994IEEE Trans.Electron Dev.41 1926
[22]Liu Y,Wu W J,Li B,En Y F,Wang L,Liu Y R 2014Acta Phys.Sin.63 098503(in Chinese)[刘远,吴为敬,李斌,恩云飞,王磊,刘玉荣2014物理学报63 098503]
[23]Fung T C,Baek G,Kanicki J 2010J.Appl.Phys.108 074518
[24]Ghibaudo G,Roux Q,Dguyen-Dug C H,Balestra F,Brini J 1991Phys.Stat.Sol.124 571
[25]Choi H S,Jeon S,Kim H,Shin J,Kim C,Chung U I 2011IEEE Trans.Electron Dev.32 1083
[26]Dimitriadis C A,Farmakis F A,Kamarinos G,Brini J 2002J.Appl.Phys.91 9919
[27]Ghibaudo G,Boutchacha T 2002Microelectron.Relia.42 573
[28]Vandamme L K J 1994IEEE Trans.Electron Dev.41 2176
[29]Delker C J,Zi Y L,Yang C,Jane D B 2013IEEE Trans.Electron Dev.60 2900
[30]He H Y,Zheng X R,Zhang S D 2015IEEE Electron.Dev.Lett.36 1056
[31]Pichon L,Cretu B,Boukhenoufa A 2009Thin Solid Films517 6367
[32]Liu Y,Wu W J,Qiang L,Wang L,En Y F,Li B 2015Chin.Phys.Lett.32 088506
[33]Vandamme L K J,Hooge F N 2008IEEE Trans.Electron Dev.55 3070
[34]Mercha A,Pichon L,Carin R,Mourgues K,Bonnaud O 2001Thin Solid Films383 303
[35]Vandamme L K J,Feyaerts R,Trefan G,Detcheverry C 2002J.Appl.Phys.91 719
Low-frequency noise in hydrogenated amorphous silicon thin film transistor∗
Liu Yuan1)2)He Hong-Yu3)4)Chen Rong-Sheng2)†Li Bin2)En Yun-Fei1)Chen Yi-Qiang1)
1)(Science and Technology on Reliability Physics and Application of Electronic Component Laboratory,CEPREI,Guangzhou 510610,China)
2)(School of Microelectronics,South China University of Technology,Guangzhou 510640,China)
3)(School of Electronic and Computer Engineering,Peking University Shenzhen Graduate School,Shenzhen 518005,China)
4)(School of Electrical Engineering,University of South China,Hengyang 421001,China)
17 April 2017;revised manuscript
25 August 2017)
Low-frequency noise in the hydrogenated amorphous silicon thin film transistor is investigated in this paper.The drain current noise spectral density shows a 1/fγ(γ ≈0.92,frepresents frequency)behavior which ascribes to fluctuations of the interfacial trapped charges due to the dynamic trapping and de-trapping of free carriers into slow oxide traps and localized traps.The normalized noise has the power law dependence on overdrive voltage,and the power law coefficient is about−1 which illustrates that the flicker noise is dominated by mobility fluctuation mechanism.By considering the contact resistance,and emission and trapping processes of carriers between localized states in the Si/SiNxinterface,the variation of low frequency noise with drain current is analyzed and fitted by use of the theory of carrier number fluctuation with correlated mobility fluctuation(ΔN-Δµmodel).Furthermore,the relationship between surface band-bending and gate voltage is extracted based on subthreshold current-voltage characteristics,and thus the density of localized states is then extracted through the measurement of drain current noise power spectral density.The experimental results show an exponential localized state distribution in the band-gap while densities of two defect modes at the bottom of conduction bandNT1andNT2are about 6.31×1018and 1.26×1018cm−3·eV−1,and corresponding characteristic temperaturesTT1andTT2are about 192 and 290 K,which is similar to the reported distribution of tail states in the amorphous silicon layer.Finally,the average Hooge’s parameter is extracted to estimate the quality of devices and materials.
amorphous silicon,thin film transistor,low-frequency noise,density of localized state
PACS:71.23.Cq,85.30.Tv,73.40.Qv,73.50.DnDOI:10.7498/aps.66.237101
*Project supported by the National Natural Science Foundation of China(Grant No.61574048),the Science and Technology Research Project of Guangdong,China(Grant No.2015B090912002),and the Pearl River S&T Nova Program of Guangzhou,China(Grant No.201710010172).
†Corresponding author.E-mail:Chenrs@scut.edu.cn
(2017年4月17日收到;2017年8月25日收到修改稿)
针对氢化非晶硅薄膜晶体管(hydrogenated amorphous silicon thin film transistor,a-Si:H TFT)的低频噪声特性展开实验研究.由测量结果可知,a-Si:H TFT的低频噪声特性遵循1/fγ(f为频率,γ≈0.92)的变化规律,主要受迁移率随机涨落效应的影响.基于与迁移率涨落相关的载流子数随机涨落模型(ΔN-Δµ模型),在考虑源漏接触电阻、局域态俘获及释放载流子效应等情况时,对器件低频噪声特性随沟道电流的变化进行分析与拟合.基于a-Si:H TFT的亚阈区电流-电压特性提取器件表面能带弯曲量与栅源电压之间的关系,通过沟道电流噪声功率谱密度提取a-Si:H TFT有源层内局域态密度及其分布.实验结果表明:局域态在禁带内随能量呈e指数变化,两种缺陷态在导带底密度分别约为6.31×1018和1.26×1018cm−3·eV−1,特征温度分别约为192和290 K,这符合非晶硅层内带尾态密度及其分布特征.最后提取器件的平均Hooge因子,为评价非晶硅材料及其稳定性提供参考.
10.7498/aps.66.237101
∗国家自然科学基金(批准号:61574048)、广东省科技重大专项(批准号:2015B090912002)和广州市珠江科技新星专项(批准号:201710010172)资助的课题.
†通信作者.E-mail:Chenrs@scut.edu.cn
