基于红外测温的GaN HEMT器件结构函数法热阻测量
2017-11-03翟玉卫梁法国吴爱华郑世棋乔玉娥刘霞美
翟玉卫,梁法国,吴爱华,郑世棋,乔玉娥,刘霞美
(中国电子科技集团公司第十三研究所,石家庄 050051)
基于红外测温的GaNHEMT器件结构函数法热阻测量
翟玉卫,梁法国*,吴爱华,郑世棋,乔玉娥,刘霞美
(中国电子科技集团公司第十三研究所,石家庄 050051)
为了准确的测量GaN HEMT的热阻参数,在两种不同的管壳接触热阻条件下,利用经过改进的显微红外热像仪测量了GaN HEMT的降温曲线。采用结构函数算法对两种降温曲线进行分析,得到了反映器件各层材料热阻的积分结构函数曲线。当管壳接触层由空气变化为导热硅脂时,积分结构函数曲线发生了变化。通过结构函数曲线能够明确区分被测件不同层的热阻。可以将被测件的分成7层结构,与器件真实结构基本一致。
热阻测量;结构函数;红外测温;热阻;GaN HEMT;降温曲线
基于GaN材料的高电子迁移率场效应管(HEMT)具有较高的禁带宽度、较高的电子迁移率,使其在高频、高电压和高功率密度方面的应用有着比较突出的优势,已经被广泛用于大功率脉冲雷达和空中交通管制系统等[1-2]。然而,由于GaN HEMT较高的功率密度,可能导致严重的自热效应,准确的测量和评估其温度和热阻等热特性参数对GaN HEMT的性能和可靠性评定非常重要。
传统的稳态热阻测试多关注于结壳热阻或结到环境的热阻[3]。近年来,能够检测器件结构热阻特性的结构函数方法在功率器件、LED等产品的热设计、可靠性分析等方面得到了广泛的应用[4-7]。结构热阻检测基于降(升)温曲线测量和结构函数分析,该方法不仅可以确定结壳热阻或结到环境的热阻,还可以给出器件纵向不同层材料,如:芯片层、粘接层、管壳层、接触层等各层的热阻特性[8-11],简称结构热阻。结构热阻对器件的热设计、失效分析非常重要,当器件某层材料结构或其热阻特性发生变化时,结构热阻曲线能够直观的将这个变化反映出来。
目前结构函数法热阻的测量基本都采用电学敏感参数(TSP)法,测量被测功率器件降温曲线。但是,对于GaN HEMT而言,电学敏感参数法(一般采用正向肖特基结的电压)的应用受到了一些限制,这主要是由于GaN器件的肖特基结的特性会在测量过程中发生非线性的变化[12],另一个可能的原因是电学法测试需要在测量电路和加热电路之间进行切换,容易导致器件自激甚至烧毁。
在GaN HEMT热特性测量领域应用最广的技术手段是显微红外热像仪。其特有的发射率修正功能,使得其可以测量器件表面各种材料的真实温度,而不需要采用黑体涂料等手段去提高发射率[13]。但是,传统的显微红外热像仪只能测周期性重复的瞬态温度信号,不具备降(升)温曲线的测量能力[14-16]。
为了解决上述问题,对显微红外热像仪进行了改进,成功测得了降温曲线,进行结构函数分析后,完成了对GaN HEMT结构热阻的检测。
1 实验详情
1.1 结构函数的基本理论
热阻对GaN功率器件是一个非常重要的参数,此类器件由多层材料构成,如图1所示。各层材料都对应着各自的热阻。如芯片层热阻、粘接层热阻、管壳热阻、导热硅脂热阻(管壳与热沉的接触热阻)、热沉热阻等。
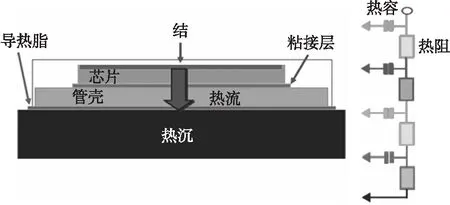
图1 半导体器件热阻
常规的热阻测试标准或方法(如Mil std 833、JESD51及GJB548等)多关注于测量结到壳的热阻,但是,结壳热阻只是器件总体热阻的一部分,对于器件的热设计,知道各层材料的热阻也是非常重要的。
基于结构函数法的电学热阻测量技术理论上能够测量包括接触热阻在内的各层材料的热阻,如图2所示。其基本原理是,不同层材料的热阻热容特性不同,图2所示的曲线的斜率也会不同,因此可以通过曲线斜率的层级对应器件的层级得到各层的热阻(图2中变化部分为粘接层的热阻)。
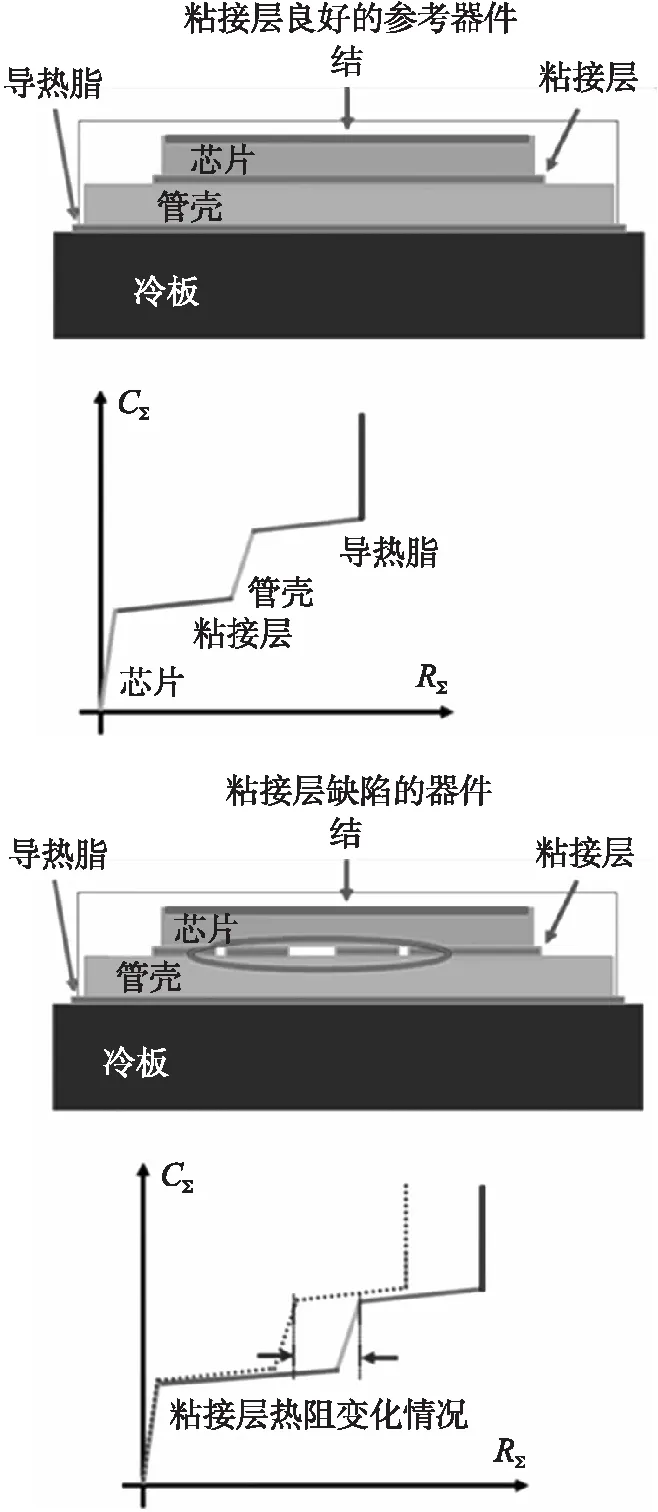
图2 理想情况下积分结构函数与热阻之间的关系
但是,上述方法的一个重要前提是器件的热传导是一维的,即只是从结向下传播,实际的器件的热传导都是三维的,导致各层的曲线斜率变化不会像图2中那样明确,一般都是如图3所示,结构函数曲线不同斜率都是连续变化的。

图3 实际情况下积分结构函数与热阻之间的关系
1.2 实验过程
1.2.1 测试仪器
结构热阻的测量首先需要采用高速测温的技术手段或仪器测量被测件的降(升)温曲线(多数采用降温曲线),然后利用结构函数算法对降温曲线进行反卷积运算,得到一条积分或微分曲线,从曲线的斜率或者峰值就基本可以判断各层材料的热阻。为了实现对降温曲线的测量,对显微红外热像仪进行了改进,测试系统结构如图4所示。相对于传统的显微红外热像仪,该测试系统的改进是开发了一套高速数据采集装置,该装置能够实现对非周期性温度信号的测量,这个功能是原有热像仪所不具备的[17]。为了实现上述功能,该系统采用具有14位分辨率的NI5122型高性能数据采集卡对红外探测器输出信号进行高速采样,系统采样率选择10 Msample/s。
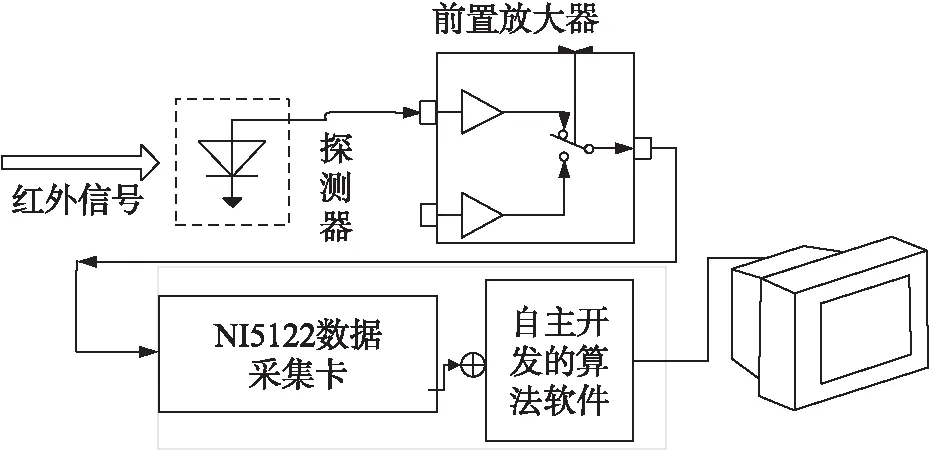
图4 改进的瞬态红外设备的结构框图
1.2.2 被测件准备
被测件为典型的GaN/AlGaN HEMT器件,其源漏电压28 V,源漏电流1.428 A,选取被测件上温度最高的区域进行降温曲线的测量。采用一套匹配测试夹具降低电子干扰和自激效应。被测件通过螺钉固定在夹具内,夹具稳定安放在水冷控温台上,夹具底面与控温台之间涂抹一层导热脂,保证二者具有良好的热接触。水冷控温台温度设定为70 ℃,其最大散热功率为200 W,温度准确度为1 ℃。
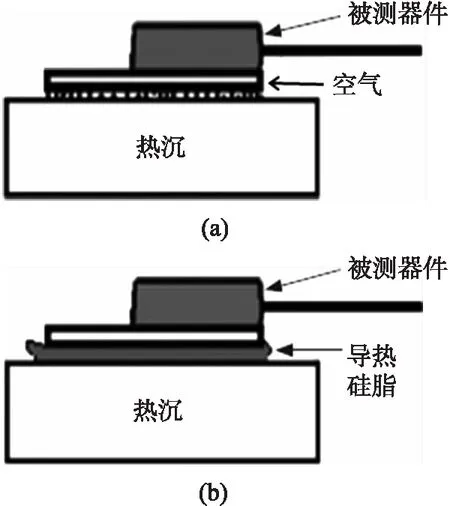
图5 两种热接触状态
在两种管壳接触热阻状态下测量降温曲线,如图5所示。首先,在器件管壳与夹具接触面之间涂抹导热脂,测量一次降温曲线;第2步,擦去器件管壳与夹具接触面之间的导热脂,使其介质为空气,测量一次降温曲线。将测得的降温曲线输入结构函数算法软件中得到反映结构热阻特性的积分结构函数曲线。
具体测试过程如下:首先,保持器件处于恒定的耗散功率下;器件温度稳定后,启动数据采集装置开始测量;给器件断电;数据采集装置工作120 s后停止采集。最终得到降温曲线,如图6所示。
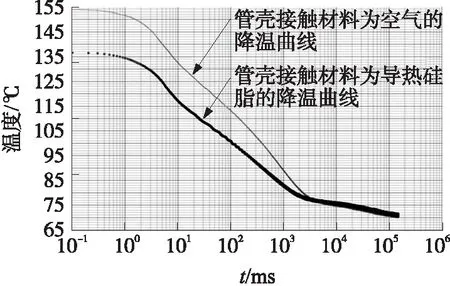
图6 两种降温曲线
相较于正向肖特基电压等电学敏感参数法(TSP),红外测量系统与被测件没有电接触,不会影响器件的工作状态;也不需要在加热电路和测量电路之间进行切换,降低了器件的自激;同时可以直接测量器件降温曲线的初始温度,不需要像电学法一样采用曲线拟合的方式得到初始温度,一定程度上保证了准确度。
2 结果和讨论
采用了测试夹具消除器件的自激和实现良好的电学匹配,实际的热传导途径上材料组成如图7所示,自上而下可分为芯片层、金锡焊料层、管壳层、管壳接触层、夹具层(铜)、夹具接触层(导热脂)和热沉(水冷散热片)。

图7 器件结构
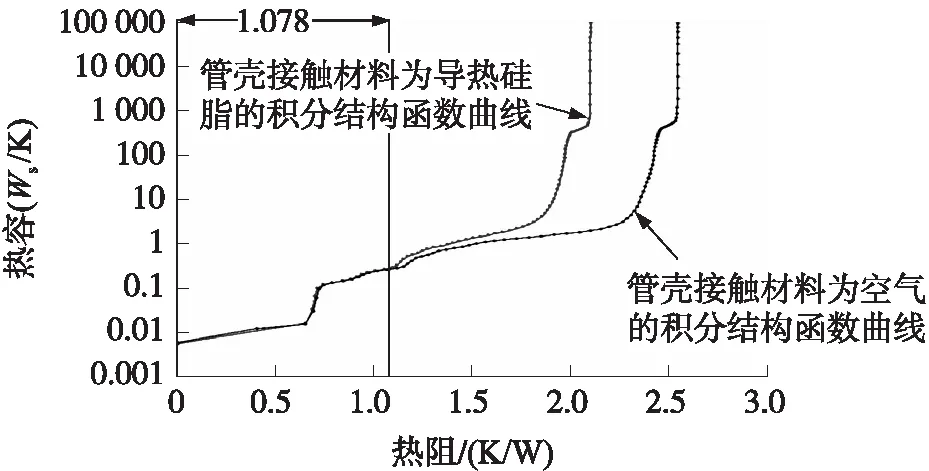
图8 两种积分结构函数曲线
两条降温曲线对应着不同的管壳接触层,可以预见,结构函数曲线在管壳接触层部分必然会发生变化。利用结构函数算法对两种管壳接触热阻条件下的降温曲线进行分析,得到的积分结构函数如图8所示。
可以看到,在0~1.078 K/W之间两条曲线基本重合,这代表两次测量过程中在这个热阻范围内热流经过的路径是相同的。根据图7的结构可见,两次降温曲线测量过程中只有管壳接触层发生了变化,芯片层到管壳层的材料结构是不变的,所以其热阻和热容也应该是完全一致的,证明图8的结果是正确的。这是JESD 51-14成立的基本理论依据,因此,该器件的结壳热阻是1.078 K/W。
当热阻大于结壳热阻时,两条曲线发生了分离,这是因为管壳接触材料发生了变化,导热硅脂热导率高于空气,热阻小于空气,所以两条结构函数曲线的接触热阻层发生了变化,且接触材料为导热硅脂的总热阻小于接触材料为空气的总热阻。
另外,两次测量中只有管壳接触层材料发生了变化,夹具层、夹具接触层和热沉都没有发生变化,所以两条结构函数曲线的代表上述热阻的部分及曲线的尾部应该是重合的,对图8的曲线进行横向平移,得到如图9所示的结果。两条曲线的尾部是重合在一起的,重合的部分代表管壳接触层下未发生改变的部分的热阻,与理论预期是一致的。
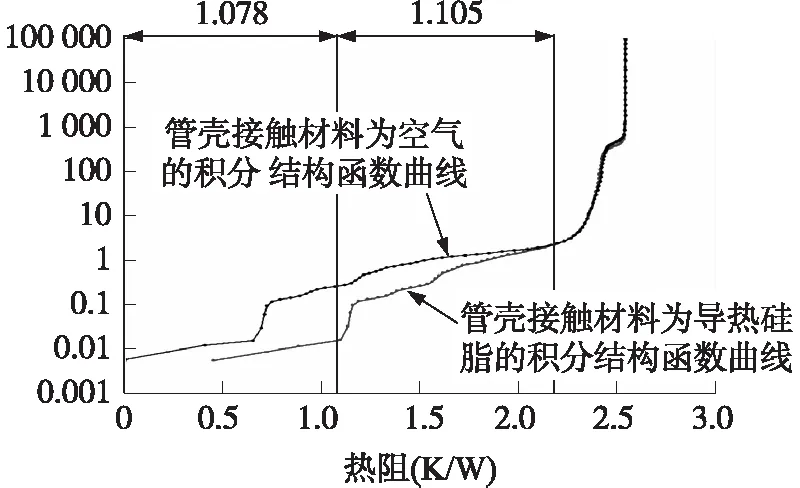
图9 平移后的两种积分结构函数曲线
由上述分析结果可知,当被测件纵向热传导路径上某层材料发生变化时,通过红外测温得到的降温曲线及其结构函数曲线会发生明显的变化,尤其是积分结构函数曲线能够将发生变化的材料所处的位置也体现出来。当器件某层结构发生缺陷时,就可以通过积分结构函数曲线对缺陷层进行定位。这说明,采用红外设备测量GaN HEMT降温曲线的方法可以得到各层材料的结构热阻。
在此基础上,根据结构热阻测量的基本原理,积分结构函数曲线的斜率改变就意味着材料发生了变化,可以将管壳接触热阻为导热脂的积分结构函数曲线分为如图10所示的7个部分。
与被测件实际的热传导路径结构相比,二者基本一致。但是,图10没有将芯片层各层材料热阻区分开,只是得到了芯片层整体热阻。分析其原因,被测件芯片层热阻较小,需要降温曲线的时间分辨率非常高才有可能区分芯片和焊料,这里采用的改进过的红外热像仪的最高时间分辨率为0.1 ms,相对于电学法最高1μs的采样间隔,可能不足以将芯片层热阻反映出来。
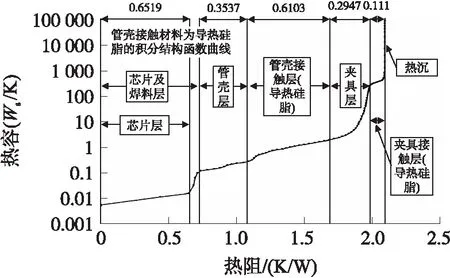
图10 确定器件分层
3 结论
用改进的显微红外热像仪测量了典型GaN HEMT降温曲线,并通过结构函数法分析得到了器件的结构热阻。通过测量不同的管壳接触热阻条件下的结构热阻确认了采用本方法可以检测GaN HEMT的各层材料的热阻及其变化。该方法避免了基于电学法容易诱发GaN器件自激的缺点,能够测量任何工作条件下GaN HEMT器件的结构热阻,这是其最大的优点。
由于噪声的干扰,测量系统的时间分辨率为0.1 ms,因此,本方法不能准确区分芯片层和焊料层,目前也无法区分热阻较小的材料。因此,后续将继续在降低红外测温噪声,提高降温曲线时间分辨率方面进行进一步的研究,以实现对芯片热阻的检测。
[1] Zhang Yamin,Feng Shiwei,Zhu Hui,et al. Assessment of Pulse Conditions Effects on Reliability in GaN-Based High Electron Mobility Transistors by Transient Temperature Measurements[J]. J Appl Phys,2013(114):094516-1-094516-5.
[2] Joh J,del Alamo J A,Chowdhury U,et al. Measurement of Channel Temperature in GaN High-Electron Mobility Transistors[J]. IEEE Trans Electron Devices,2009,56(12):2895-2901.
[3] Electronic Industries Association. JESD 51-1. Integrated Circuit Thermal Measurement Method-Electrical Test Method[S]. Arlington,Electron Industries Alliance,1995.
[4] Shweta Natarajan,Minseok Ha,Samuel Graham. Measuring the Thermal Resistance in Light Emitting Diodes Using a Transient Thermal Analysis Technique[J]. IEEE Transactions on Electron Devices,2013,60(8):2548-2555.
[5] Zhang Yamin,Feng Shiwei,Zhu Hui,et al. Effect of Self-Heating on the Drain Current Transient Response in AlGaN/GaN HEMTs[J]. IEEE Electron Device Letters,2014,35(3):345-347.
[6] Gabor Farkas. Thermal Transient Characterization of Semiconductor Devices with Programmed Powering[C]//29th IEEE SEMI-THERM Symposium. San Jose:IEEE Semiconductor Thermal Measurement and Management Symposium. 2013:248-255.
[7] 肖超,王立新. 基于结构函数的功率MOSFET器件热阻研究[J]. 电子器件,2012,35(5):489-492.
[8] Jedec Solid State Technology Association. JESD51-14. Transient Dual Interface Test Method for the Measurement of the Thermal Resistance Junction-to-Case of Semiconductor Devices with Heat Flow Through a Single Path[S]. Arlington,Electron Industries Alliance,2010.
[9] Gabor Farkas,Dirk Schweitzer,Heinz Pape,et al. Transient Measurement of the Junction-to-Case Thermal Resistance Using Structure Functions:Chances and Limits[C]//24th IEEE SEMI-THERM Symposium,2008. San Jose:IEEE Semiconductor Thermal Measurement and Management Symposium. 2008:191-197.
[10] Heinz Pape,Dirk Schweitzer,Liu Chen,et al. Development of a Standard for Transient Measurement of Junction-to-Case Thermal Resistance[J]. Microelectron Rel,2012,52:1272-1278.
[11] Dirk Schweitzer,Heinz Pape,Liu Chen,et al. Transient Dual Interface Measurement—A New JEDEC Standard for the Measurement of the Junction-to-Case Thermal Resistance[C]//2011 27th IEEE SEMI-THERM Symposium. San Jose:IEEE Semiconductor Thermal Measurement and Management Symposium. 2011:222-229.
[12] Killat N,Kuball M. Temperature Assessment of AlGaN/GaN HEMTs:A Comparative Study by Raman,Electrical and IR Thermography[C]//2010 IEEE International Reliability Physics Symposium(IRPS). Anaheim:IRPS. 2010. 528-531.
[13] Albright G C,Stump J A,McDonald J D,et al. True Temperature Measurements on Microscopic Semiconductor Targets[C]//Dennis H,LeMieux,John R,eds. Proc SPIE Thermosense XXI,SPIE 3700. 1999:245-250.
[14] Grant Albright,James Stump,Chun-pang Li. Emissivity-Corrected Infrared Thermal Pulse Measurement on Microscopic Semiconductor Targets[C]//Anders E. Rozlosnik,Ralph B. Dinwiddie,eds. Proc SPIE Thermosense ⅩⅩⅢ,SPIE proceeding 4360. 2001:103-111.
[15] Mahalingam M,Mares E,Brakensiek W,et al. High Power Microwave Device Temperature Measurement-Methodology and Applications for Pulsed Devices[C]//2007 IEEE MTT-S International,Honolulu:MIT-S. 2007:1189-1192.
[16] Tomas K P,Webb P W. Transient Thermal Impedance Measurement in Power Semiconductor Devices[C]//1999 IEEE Colloquium on New Developments in Power Semiconductor Devices. London. 1996. 3/1-3/6,Jul. 1996.
[17] 刘岩,翟玉卫,范雅洁,等. 基于红外测温技术的微波功率器件降温曲线测量系统[J]. 光学仪器,2016,38(2):100-105.
ThermalResistanceMeasurementforGaNHEMTUtilizingStructureFunctionMethodBasedonIRTemperatureTest
ZHAIYuwei,LIANGFaguo*,WUAihua,ZHENGShiqi,QIAOYu’e,LIUXiamei
(The 13th Research Institute,CETC,Shijiazhuang 050051,China)
In order to measure the thermal resistance of GaN HEMT accurately,under two different thermal contact conditions between case and fixture,cooling curves were measured using an improved IR microscope,respectively. Structure function method was used to deal with the cooling curves,the cumulative structure function curves which show the thermal resistances of layers in GaN HEMT were obtained. When the material between case and fixture was changed from air to thermal grease,the cumulative structure function curves changed obviously. Thermal resistance of different layers of DUT can be distinguished from structure function curves,the DUT was divided into a 7 layers structure,that was approximately consistent with the real device structure.
thermal resistance measurement;structure function;infrared temperature test;thermal resistance;GaN HEMT;cooling curve
10.3969/j.issn.1005-9490.2017.05.002
2016-09-01修改日期2016-10-17
TN325.3
A
1005-9490(2017)05-1060-05

翟玉卫(1983-),男,河北石家庄人,工学硕士,工程师,主要从事半导体器件热可靠性检测与分析方面的研究工作,kaoyan071@126.com。

梁法国(1983-),男,山东聊城人,硕士,研究员级高工,主要从事微电子计量测试方面的研究工作,liangdao@163.com。
