GaN基p-i-n和肖特基紫外探测器的响应光谱及暗电流特性
2017-10-10易淋凯黄佳琳李春燕赵德刚
易淋凯, 黄佳琳, 周 梅*, 李春燕*, 赵德刚
(1. 中国农业大学理学院 应用物理系, 北京 100083; 2. 中国科学院半导体研究所 集成光电子国家重点实验室, 北京 100083)
GaN基p-i-n和肖特基紫外探测器的响应光谱及暗电流特性
易淋凯1, 黄佳琳1, 周 梅1*, 李春燕1*, 赵德刚2
(1. 中国农业大学理学院 应用物理系, 北京 100083; 2. 中国科学院半导体研究所 集成光电子国家重点实验室, 北京 100083)
研究了p-i-n型和肖特基型GaN基紫外探测器的响应光谱和暗电流特性。实验发现,随着p-GaN层厚度的增加,p-i-n型紫外探测器的响应度下降,并且在短波处下降更加明显。肖特基探测器的响应度明显比p-i-n结构高,主要是由于p-GaN层吸收了大量的入射光所致。肖特基型紫外探测器的暗电流远远大于 p-i-n型紫外探测器的暗电流,和模拟结果基本一致,主要是肖特基型探测器是多子器件,而p-i-n型探测器是少子器件。要制备响应度大、暗电流小的高性能GaN紫外探测器,最好采用p-GaN层较薄的p-i-n结构。
GaN; 紫外探测器; 响应度; 暗电流
Abstract: The spectral response and dark current of p-i-n type and Schottky barrier GaN-based ultraviolet detectors are investigated. It is found that the responsivity of p-i-n detectors decreases with increasing thickness of p-GaN layer in p-i-n structure detectors , and the downward trend of responsivity is more pronounced at shorter wavelength of incident light . The responsivity of the Schottky barrier detector is obviously higher than that of the p-i-n structure, mainly because a lot of incident photons are absorpted in the p-GaN layer. The dark current of Schottky barrier ultraviolet detectors is far larger than the p-i-n ultraviolet detectors, and the results are basically consistent with the simulations, mainly because the Schottky detectors are majority carrier devices, and p-i-n detectors are minority carrier devices. To fabricate high performance GaN ultraviolet detectors, it is better to employ p-i-n structure with very thin p-GaN layer.
Keywords: GaN; ultraviolet detectors; responsivity; dark current
1 引 言
氮化镓(GaN)基材料被称为第三代半导体,其光谱范围覆盖了近红外到紫外多个波段,在半导体光电子学领域有重要的应用价值[1-2]。GaN基紫外探测器具有可见光盲、耐高温、耐腐蚀、抗辐射等特性,可应用于火灾告警、大气探测等领域,得到了国内外的重视。经过多年发展,已先后研制出pn结型、p-i-n型、肖特基型(Schottky)、金属-半导体-金属(MSM)型等多种结构GaN基紫外探测器[3-12],目前研究比较广泛的是p-i-n型和肖特基型。
本文利用蓝宝石衬底上生长的GaN材料制作了两种类型的紫外探测器,针对其响应光谱和暗电流特性进行了测量和分析。研究结果表明:随着p-GaN层厚度的增加,p-i-n探测器的响应度下降,并且在短波处变化更明显。肖特基探测器的响应度更大,但是肖特基型紫外探测器的暗电流比 p-i-n型紫外探测器的暗电流大得多。要制备高性能的探测器,应该选择p-GaN层较薄的p-i-n结构。
2 器件结构与制备过程
研制了GaN基 p-i-n型探测器和肖特基型探测器。制备探测器所用的材料是用英国Thomas Swan公司生产的金属-有机物化学气相沉积(MOCVD)反应器在c面蓝宝石衬底上生长而成。p-i-n探测器的材料生长过程如下:在蓝宝石衬底上530 ℃生长一薄层低温GaN缓冲层,然后在1 050 ℃高温下生长1.5 μm的n+-GaN层,再生长一层0.3 μm非故意掺杂的i-GaN层,最后生长p-GaN层。肖特基探测器的材料只是没有生长p-GaN层,其余和p-i-n探测器生长过程相同(此时肖特基结构相当于p-GaN厚度为0时的p-i-n结构)。材料生长结束以后,经过光刻、刻蚀、镀膜等工艺,制备出p-i-n和肖特基紫外探测器。其中n型电极为Ti/Al,p型电极为Ni/Au,肖特基电极为Ni/Au。实验中制备了两个p-i-n探测器A和B,其中器件A的p-GaN层厚度为0.1 μm,器件B的p-GaN层厚度为0.25 μm。肖特基探测器样品标号为C。图1所示为两种结构紫外探测器的分层结构图。
为了评价材料的质量,采用日本理学公司生产的高分辨率X射线衍射仪进行测量。3个器件的材料双晶衍射ω扫描摇摆曲线的半高宽相差很小,(002)面约为210 arcsec、(102)面约为230 arcsec,意味着3个器件的位错密度相差不大并且质量较好[13]。
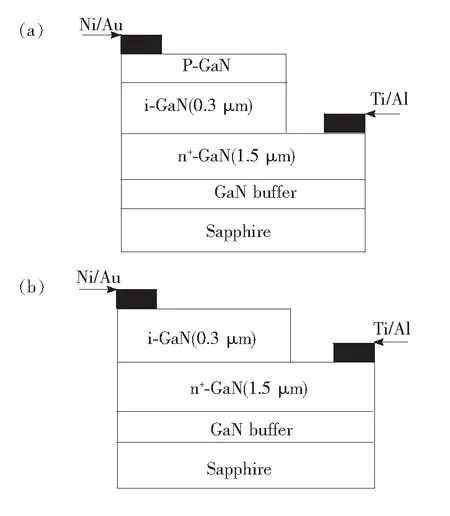
图1 p-i-n型(a)和肖特基型(b)GaN基紫外探测器结构示意图
Fig.1 Schematic diagram of p-i-n(a)and Schottky(b) GaN-based ultraviolet detectors
3 结果与讨论
我们首先研究了p-GaN层厚度对p-i-n探测器的响应度的影响,并且比较了p-i-n结构和肖特基结构的区别,分析了原因,然后进一步研究了器件的暗电流特性,又进行了模拟,与实验结果符合较好,这将对器件的设计和制备起到重要的参考作用。实验中,器件的光谱响应测试系统采用氙灯做光源,通过单色仪后照到待测器件,器件产生的信号经过放大器放大后由计算机采集,用校正的Si探测器进行定标。采用Keithley 2400源表测量器件的I-V特性曲线。
图2为p-i-n结构探测器A和B与肖特基探测器C的响应光谱曲线,可以看出:在0偏压下, 器件A的峰值响应度为0.13 A/W,器件B的峰值响应度为0.08 A/W,器件C的峰值响应度是0.20 A/W。显然,肖特基探测器比p-i-n探测器的响应度更高,而且对于p-i-n探测器,随着p-GaN层厚度的增加,器件的响应度下降。
根据基本的探测器物理,组成p-i-n探测器的光电流主要是3部分[14]:p层扩散区,i层耗尽区,n层扩散区。对于p和n层的扩散区来说,只有在距离耗尽区扩散长度内的光生载流子才可以扩散到耗尽区,通过内建电场的形式扫出,形成光电流。所以p-i-n探测器的光电流主要来源是i层耗尽区光生电子空穴对的分离。p-i-n型探测器的有源区为i-GaN层。当光照射到器件表面上时,p层有较强的吸收。当p层厚度增大时,光子被吸收的多,实际上透入到i-GaN层中的光子就少,产生的光电流也就较小。肖特基型探测器可以看做没有p层或者可等效为p层厚度为0的p-i-n结构,其有源区为i-GaN层中的耗尽部分,此时光子直接通过透明电极入射到有源区,不存在其他层的吸收损失问题,所以肖特基探测器响应度比较大,并且随着p层厚度增大,p-i-n探测器的响应度下降。实际制备中,应尽量选择p层较薄的器件结构。
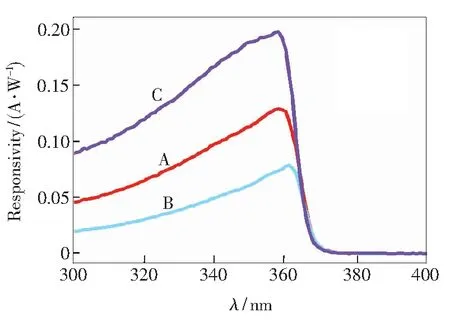
图2 探测器的光谱响应曲线
Fig.2 Spectral response of the GaN-based ultraviolet detectors
对3个器件按照峰值响应度进行归一化处理,结果如图3所示。随着入射光波长的减小,3个器件的响应度都逐渐减小,其中器件C的变化幅度最小,器件B的变化幅度最大。这主要是因为在短波处,光子的吸收系数大、透入小。光照射到器件表面时,必然会存在吸收,p层吸收的越多,则i-GaN层的光电流越小。所以p-GaN较厚的器件在短波处响应度变化比较明显,而肖特基探测器的响应光谱相对变化较小。我们还利用美国宾州大学提供的AMPS(Analysis of Microelectronic and Photonic Structures)软件对器件A、B、C的光谱响应进行了理论模拟。该软件通过数值求解泊松方程和连续性方程,得到器件的物理性质,是一个对半导体器件进行性质分析的有力工具[15-16]。模拟结果如图4所示。随着p-GaN层厚度的增加,p-i-n探测器的响应度降低,p-GaN层厚度为0时的肖特基探测器响应度最高。实验和理论都发现肖特基探测器的响应度比p-i-n探测器响应度大,并且随着p-GaN层厚度的增加,p-i-n探测器的响应度下降得更快。
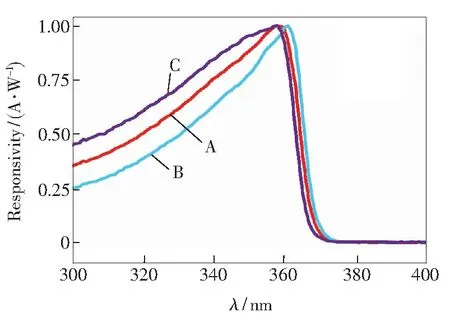
图3 3个器件按照峰值响应度归一化后的光谱响应曲线
Fig.3 Normalized spectral response curves of the three detectors
我们还研究了器件的暗电流特性,图5为探测器A(p-i-n型)和C(肖特基型)的电流-电压特性曲线。在-10 V偏压下,器件A的暗电流为1×10-7A,器件C的暗电流为1×10-3A。显然,肖特基型探测器的暗电流比p-i-n型探测器暗电流大得多。这主要是p-i-n型探测器属于少子器件,反向暗电流是由器件中的少子形成的;而肖特基型探测器属于多子器件,在反向偏压下,由金属内的自由电子渡越到半导体内形成反向暗电流。一般来说,多子器件的反向暗电流要远大于少子器件。另外,肖特基型探测器内的肖特基结容易受到表面态的影响,载流子通过表面态更容易隧穿越过势垒,从而在器件中形成更大的反向暗电流。暗电流越大,器件的暗电流噪声也越大。针对上述现象,我们用AMPS软件做了理论模拟,结果如图6所示。其中,肖特基型紫外探测器和器件C的结构一样,p-i-n型探测器和器件A的结构一样。显然,肖特基型紫外探测器的暗电流比p-i-n型探测器的暗电流大很多。
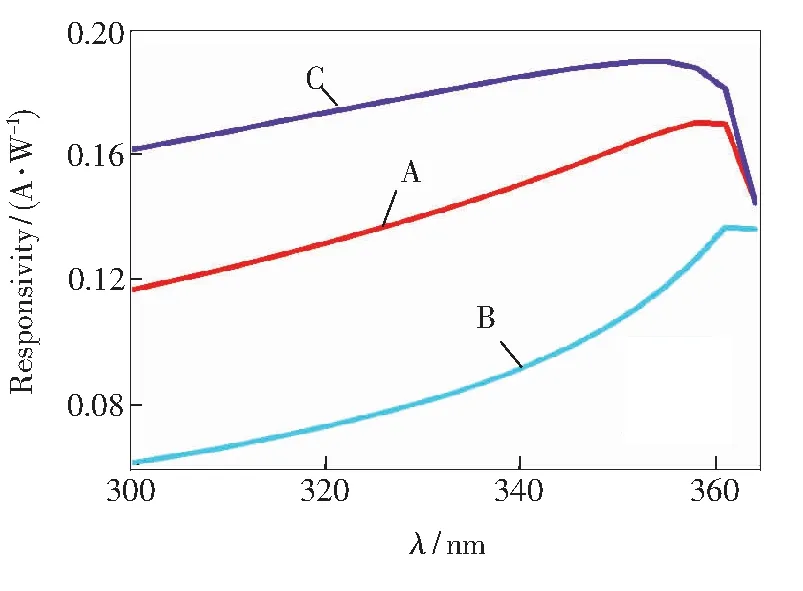
图4 探测器的光谱响应度模拟曲线
Fig. 4 Simulated spectral response curves of the GaN-based ultraviolet detectors

图5 探测器A(p-i-n型)和C(肖特基型)的电流-电压特性曲线
Fig.5 Current-voltage characteristics of A (p-i-n structure) and C (Schottky barrier structure ) detectors
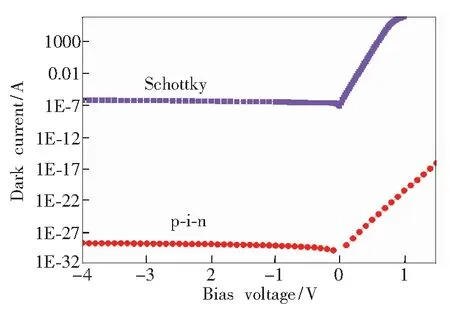
图6 p-i-n型(A)和肖特基型(C)探测器的电流-电压模拟曲线
Fig.6 Current-voltage simulation curves of A (p-i-n) and C (Schottky) detectors
4 结 论
制备了p-i-n型和肖特基型GaN基紫外探测器,并对其响应度和暗电流特性进行了研究。实验结果表明:肖特基探测器响应度比p-i-n探测器响应度更高,并且随着p层厚度增加,p-i-n探测器的响应度下降,和理论模拟结果基本一致。进一步比较了p-i-n型和肖特基型GaN基紫外探测器的暗电流特性,实验和模拟结果都表明,肖特基型GaN基紫外探测器的暗电流噪声比p-i-n型GaN基紫外探测器的暗电流噪声大很多。综合来看,要制作出响应度高、暗电流小的GaN紫外探测器,应该选用p-GaN厚度较薄的p-i-n结构。
[1] JIANG L R, LIU J P, TIAN A Q,etal.. GaN-based green laser diodes [J].J.Semicond., 2016, 37(11):111001-1-10.
[2] SUN Q, YAN W, FENG M X,etal.. GaN-on-Si blue/white LEDs: epitaxy, chip, and package [J].J.Semicond., 2016, 37(4):044006-1-8.
[3] CARRANO J C, LI T, BROWN D L,etal.. Very high-speed metal-semiconductor-metal ultraviolet photodetectors fabricated on GaN [J].Appl.Phys.Lett., 1998, 73(17):2405-2407.
[4] KATZ O, GARBER V, MEYLER B,etal.. Anisotropy in detectivity of GaN Schottky ultraviolet detectors: comparing lateral and vertical geometry [J].Appl.Phys.Lett., 2002, 80(3):347-349.
[5] MCCLINTOCK R, MAYES K, YASAN A,etal.. 320×256 solar-blind focal plane arrays based on AlxGa1-xN [J].Appl.Phys.Lett., 2005, 86(1):011117-1-3.
[6] BUTUN B, TUT T, ULKER E,etal.. High-performance visible-blind GaN-based p-i-n photodetectors [J].Appl.Phys.Lett., 2008, 92(3):033507-1-3.
[7] JIANG H, AND EGAWA T. Low-dark-current high-performance AlGaN solar-blind p-i-n photodiodes [J].Jpn.J.Appl.Phys., 2008, 47(3):1541-1543.
[8] CICEK E, VASHAEI Z, MCCLINTOCK R,etal.. Geiger-mode operation of ultraviolet avalanche photodiodes grown on sapphire and free-standing GaN substrates [J].Appl.Phys.Lett., 2010, 96(26):261107-1-3.
[9] ZHAO D G, ZHANG S, JIANG D S,etal.. A study on the spectral response of back-illuminated p-i-n AlGaN heterojunction ultraviolet photodetector [J].J.Appl.Phys., 2011, 110(5):053701-1-4.
[10] CICEK E, MCCLINTOCK R, HADDADI A,etal.. High performance solar-blind ultraviolet 320×256 focal plane arrays based on AlxGa1-xN [J].IEEEJ.Quant.Elect., 2014, 50(8):591-595.
[11] ALAIE Z, NEJAD S M, YOUSEFI M H. Recent advances in ultraviolet photodetectors [J].Mat.Sci.Semicond.Proc., 2015, 29:16-55.
[12] LI X J, ZHAO D G, JIANG D S,etal.. Influence of residual carbon impurities in i-GaN layer on the performance of GaN-based p-i-n photodetectors [J].J.Vac.Sci.Technol. B, 2016, 34(1):011204-1-4.
[13] HEINKE H, KIRCHNER V, EINFELDT S,etal.. X-ray diffraction analysis of the defect structure in epitaxial GaN [J].Appl.Phys.Lett., 2000, 77(14):2145-2147.
[14] SZE S M.PhysicsofSemiconductorDevices[M]. New York: Wiley, 1981.
[15] 周梅, 赵德刚. 结构参数对GaN肖特基紫外探测器性能的影响及器件设计 [J]. 发光学报, 2009, 30(6):824-831. ZHOU M, ZHAO D G. Effects of structure parameters on the performances of GaN Schottky barrier ultraviolet photodetectors and device design [J].Chin.J.Lumin., 2009, 30(6):824-831. (in Chinese)
[16] 周梅, 李春燕, 赵德刚. 背照射和正照射p-i-n结构GaN紫外探测器的i-GaN和p-GaN厚度设计 [J]. 发光学报, 2015, 36(9):1034-1040. ZHOU M, LI C Y, ZHAO D G. Effects and design of i-GaN and p-GaN layer thickness on the back-illuminated and front-illuminated GaN p-i-n ultraviolet photodetectors [J].Chin.J.Lumin. , 2015, 36(9):1034-1040. (in Chinese)

易淋凯(1991-),女,河南驻马店人,硕士研究生,2015年于河南工业大学获得学士学位,主要从事GaN基紫外探测器的研究。

E-mail: 1009721110@qq.com李春燕(1980-),女,安徽蚌埠人,博士,副教授,2008年于中国科学技术大学获得博士学位,主要从事激光光谱及检测的研究。

E-mail: chunyanl@cau.edu.cn周梅(1973-),女,山东淄博人,博士,副教授,2005年于中国科学院上海技术物理研究所获得博士学位,主要从事半导体光电子器件的研究。
E-mail: mmmzhou@126.com
SpectralResponseandDarkCurrentofp-i-nTypeandSchottkyBarrierGaN-basedUltravioletDetectors
YI Lin-kai1, HUANG Jia-lin1, ZHOU Mei1*, LI Chun-yan1*, ZHAO De-gang2
(1.DepartmentofPhysics,ChinaAgricultureUniversity,Beijing100083,China; 2.StateKeyLaboratoryonIntegratedOptoelectronics,InstituteofSemiconductors,ChineseAcademyofSciences,Beijing100083,China)
*CorrespondingAuthors,E-mail:mmmzhou@126.com;chunyanl@cau.edu.cn
TN304.2
A
10.3788/fgxb20173810.1327
1000-7032(2017)10-1327-05
2017-03-14;
2017-04-17
国家自然科学基金(61474142,21403297,11474355)资助项目 Supported by National Natural Science Foundation of China(61474142,21403297,11474355)
