辉光放电质谱法检测AZO靶材中痕量元素及深度分布
2017-07-18潘丹梅郑清洪
黄 瑾,潘丹梅,郑清洪
(1.中国科学院福建物质结构研究所测试中心,福建 福州 350002;2.福建农林大学材料工程学院,福建 福州 350002)
辉光放电质谱法检测AZO靶材中痕量元素及深度分布
黄 瑾1,潘丹梅1,郑清洪2
(1.中国科学院福建物质结构研究所测试中心,福建 福州 350002;2.福建农林大学材料工程学院,福建 福州 350002)
利用辉光放电质谱仪(GDMS)对铝掺杂的氧化锌(AZO)靶材中的常微量元素及其深度分布进行分析。首先考察AZO样品中的元素和Ar、H、O、N等气体元素形成的多原子离子干扰。其次利用GDMS和台阶仪对已经进行磁控溅射过的AZO靶材表面进行深度剖析,考察靶材上的主要污染元素随深度的纵向分布,最后利用GDMS对预溅射完后的AZO靶材内部杂质元素进行质谱分析。利用XPS进行验证,两种方法测试得到的Zn和Al的含量相近。分析结果表明GDMS是分析AZO等半导体靶材的有效方法,该方法可以对靶材造成的污染进行预判,避免溅射过程中造成的污染。
辉光放电质谱法;AZO靶材;磁控溅射;深度分析
0 引 言
透明导电薄膜因其兼具电阻率低和透光性好的特点,在各种光电器件例如太阳能电池、平板显示、LED上具有广阔的应用前景[1]。铝掺杂的氧化锌薄膜ZnO∶Al(AZO)作为一种典型的n型半导体薄膜,其禁带宽度接近3.3eV,在可见光范围具有较高的透射率和低电阻率[2],是一种价格低廉、原料丰富且无毒的透明导电氧化物,非常有希望替代传统的氧化铟锡[3-4]。因此近年来,AZO材料成为研究透明导电薄膜的热点。AZO薄膜的主要制备方法有磁控溅射法、化学气相沉积法(CVD)、溶胶凝胶法(sol-gel)、脉冲激光沉积法(PLD)、电子束蒸发法(MBE)等[5-7],其中磁控溅射法是薄膜制备的主要方法之一[8]。对于磁控溅射制备的AZO薄膜来说,靶材的纯度越高,溅射的AZO薄膜的均匀性、光学和电学性能就越好。靶材的化学组分和杂质含量对磁控溅射制备的薄膜的导电性和透光率有一定的影响[9-10]。靶材在制备过程中所产生的杂质是沉积薄膜的主要污染源,靶材的质量好坏直接影响其制备的薄膜的杂质浓度。靶材污染会在生长的AZO薄膜中引入非刻意掺杂的杂质,该杂质可能在AZO薄膜中充当施主,也可能充当受主,因此会使薄膜的电学性能偏离实验的预期。同时,非刻意掺杂杂质可能会使AZO薄膜的晶格发生畸变,引入缺陷能级。这些缺陷能级通常是深能级,充当可见光的吸收中心,从而降低AZO薄膜的光学性能。因此对于AZO靶材的研发和制备技术而言,如何准确地检测靶材中元素种类和含量显得尤为重要。目前对制备得到的AZO靶材一般采用扫描电镜能谱法(SEM-EDS)获得Al元素和Zn元素的含量[11]。SEM-EDS通常适用于掺杂均匀,表面平整,且目标元素含量1%以上的样品。相比之下辉光放电质谱(GDMS)采取固体直接进样方式,免除了样品溶解过程中产生的污染和待测元素损失的问题[12],检测限低至10-9g/g,可测量的线性动态范围宽,可以同时测量常量元素、痕量元素和超痕量元素[13]。AZO靶材具有较高的致密度且导电性良好,完全符合GDMS检测的要求。
另外AZO靶材在溅射过程中在腔体内不可避免会受到交叉污染,如何对在溅射过程中产生的污染进行监测也非常重要。在各种元素含量的分析方法中,SEM-EDS需要制备剖面样品;X射线光电子能谱(XPS)刻蚀速度很慢,一般在 0.2~0.4nm/s,且刻蚀深度一般在1~10 nm;二次离子质谱(SIMS)只适合100 nm以下薄层的分析和微米级别的微区分析[14]。因此SEM-EDS、XPS、SIMS等方法不适合靶材深度的测量。
而GDMS法可以直接采样分析,分析时候在样品表面可获得50 mm2的取样坑,取样范围较大,具有代表性,分析速度快,通过控制溅射时间可以控制不同深度,能够分析几微米到几百微米的深度。所以GDMS适用于快速准确的监控AZO靶材中的污染物杂质含量分布随深度的变化。目前国内外还没有利用GDMS对AZO靶材进行全元素分析的报道。本实验利用GDMS对溅射过的AZO表面进行深度分析,在一次分析过程中获得AZO靶材的元素含量。
1 试验部分
1.1 仪器与试剂
ELEMENT-GD双聚焦辉光放电质谱仪(美国赛默飞世尔科技公司);Dektak XT台阶仪(德国Bruker公司);ESCALAB 250Xi型X-射线光电子能谱(美国赛默飞世尔科技公司);直径50mm,厚度3mm的圆柱状、表面平整的AZO靶材。
1.2 工作参数选择
调谐仪器的放电电压、放电电流和放电气体流量,可以获取主体元素Zn信号的最佳峰型,在中分辨率下(4332R10%)GDMS的主要工作参数如表1所示,此时仪器达到分析AZO靶材的最佳状态。
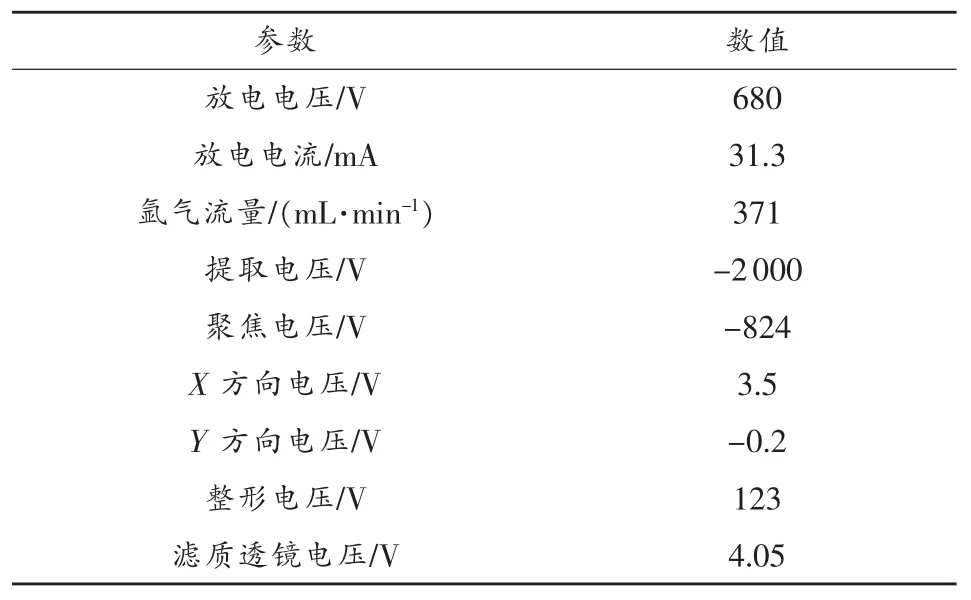
表1 仪器的工作参数
1.3 同位素的选择和待测元素的质谱干扰
AZO是铝掺杂氧化锌,空气中含有氧元素,所以AZO中的O不作考察,选取Zn作为主体元素。辉光放电气体氩气和残留的空气中的N、H、O、C会与溅射出的样品原子相互作用形成干扰,大部分元素的分析需要高分辨来分离干扰和目标元素。因此重点需要考察 Zn、Al与 Ar、H、N、O、C 等形成的多原子离子干扰。
Zn、Al与Ar形成的大部分多原子离子干扰在中分辨率下就可以分开。其中丰度最高的80Se(49.7%)存在68Zn12C干扰,78Se(23.6%)存在66Zn12C干扰,76Se(9.0%)存在64Zn12C干扰,因此选择77Se(7.6%)在中分辨率下考察。108Pd(26.46%)存在68Zn40Ar干扰,106Pd(27.33%)存在66Zn40Ar干扰,选择105Pd(22.33%),在中分辨率下可以分离干扰峰。103Rh(100%)存在67Zn36Ar干扰,需要在高分辨率下才能分离干扰峰。
对于同位素的选择,尽可能选择丰度较大且干扰较小的同位素进行考察。丰度最高的69Ga(60.1%)存在68Zn1H干扰,所以选择丰度较低的71Ga(39.9%)。
2 结果与讨论
由于辉光放电具有分布电离的特点,样品的原子化和离子化在两个不同区域发生,基体效应大为降低,不同元素的相对灵敏度因子差异较小[15-16]。即使在缺乏标准样品的情况下,辉光放电质谱法也可以一次性半定量地测出元素周期表中的大部分元素[17]。
进行AZO靶材溅射的同时,同一个溅射腔内还进行了银靶和镍靶的磁控溅射。为了考察腔体内的交叉溅射对靶材表面的污染,利用GDMS对AZO靶材正面进行深度剖析。图1为Al、Ag和Ni 3种元素的含量随时间的变化曲线,可以看到掺杂的Al元素的含量较为稳定,含量在9 000~13 000 μg/g之间变化,溅射 60min 后,含量稳定在 11 000 μg/g。 Ag、Ni的含量一开始升高然后随着溅射时间缓慢下降,溅射65 min后开始稳定,含量稳定在50 μg/g,不随溅射时间的增加而波动。磁控溅射过程是用加速的离子轰击靶材,使靶材表面的原子在衬底表面沉积。在溅射金属靶材的时候,靶材原子不仅会在衬底表面沉积,还会在腔体内壁上沉积。当再进行AZO靶材溅射的时候,沉积在腔体内的金属原子又被加速离子轰击而再沉积在AZO靶材表面,造成交叉沾污。
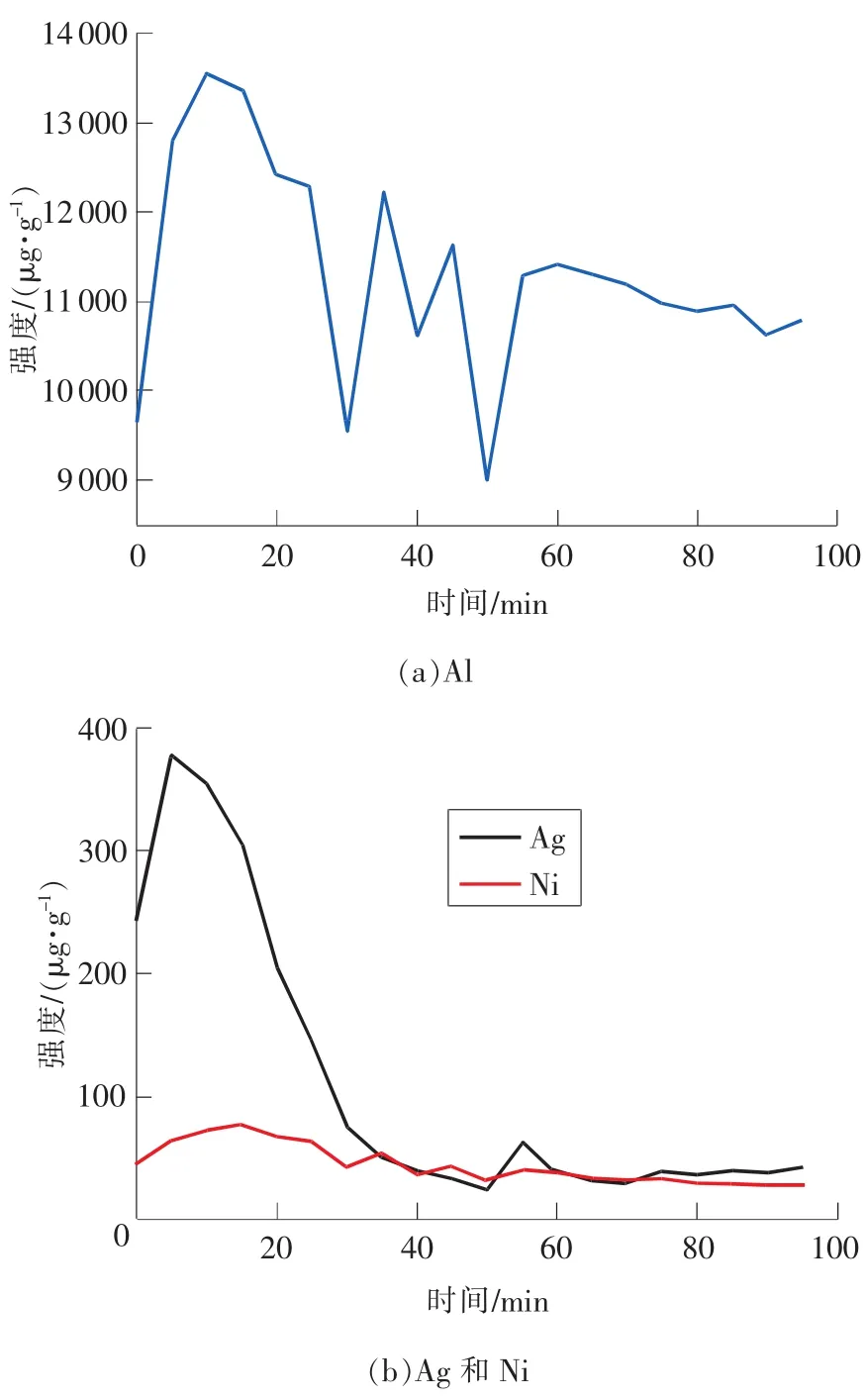
图1 AZO靶材中的元素含量随溅射时间的变化曲线

图2 溅射坑轮廓图
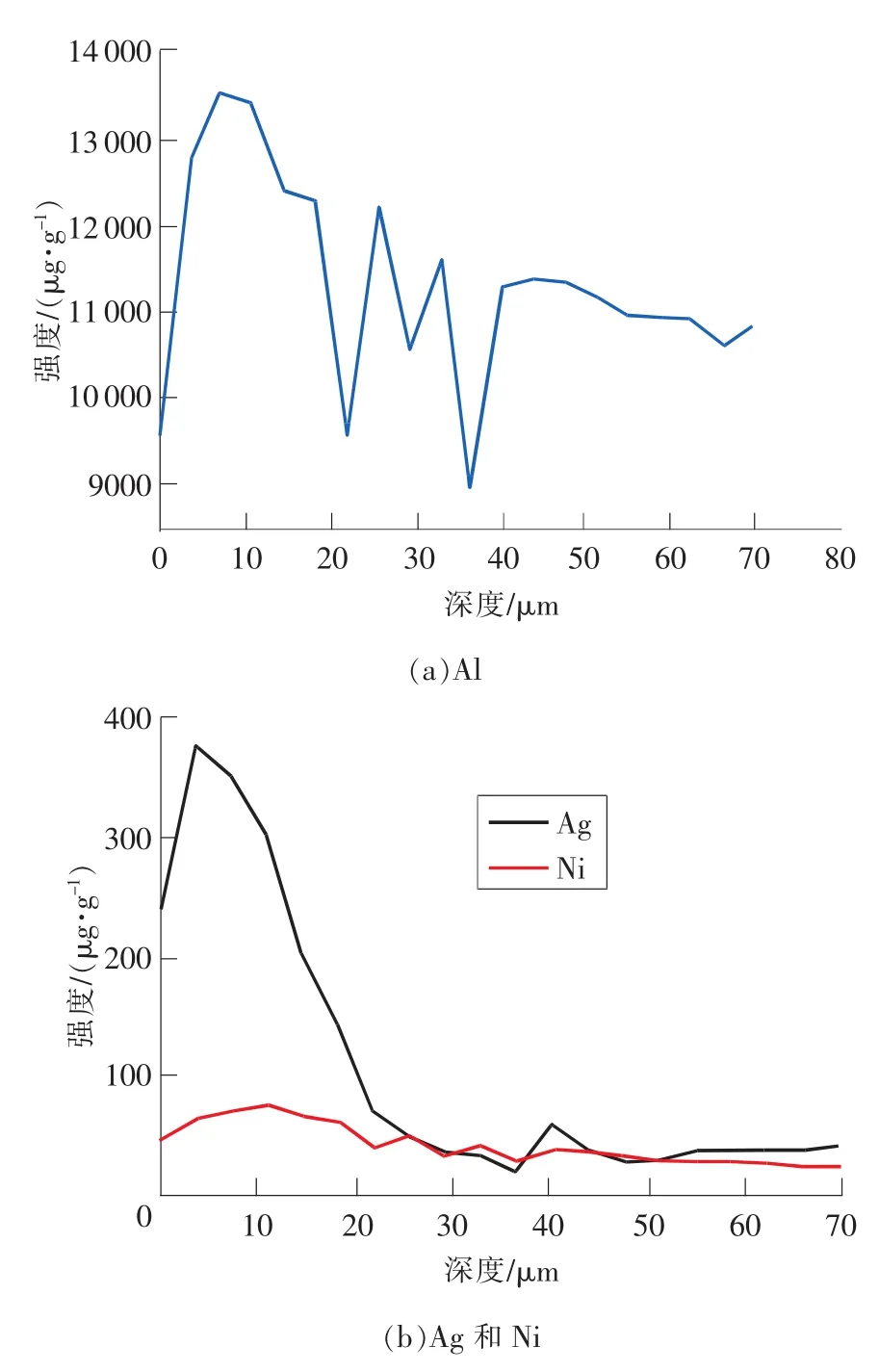
图3 AZO靶材中的元素含量随溅射深度的变化曲线
利用Dektak XT台阶仪对溅射后的溅射坑进行深度测试,结果如图2所示。溅射坑的深度大概为73μm。溅射的时间为100min,可以估算AZO溅射速率为0.73μm/min。
为了考察Al、Ag和Ni 3种由表面到体内随深度变化的情况,根据获得的AZO的溅射速率,将溅射时间转换为溅射深度,得到深度剖析的结果,如图3所示。可以看出,Ag、Ni的含量在溅射65min后降至稳定水平,由此可以推算由Ag、Ni造成的杂质污染需要通过从表层溅射48μm后消除。
AZO是掺Al的ZnO,而空气中含有氧元素,所以进行GDMS测试的时候AZO中的O不作考察。选取64Zn作为主体元素,即Zn含量为106μg/g。AZO没有标准样品,通常采用仪器提供的典型相对灵敏度因子(Std RSF)对离子束强度的比值进行校正[18]。采用Std RSF进行校正的大多数元素的相对标准偏差均在30%以内[19]。主体元素定义为Zn,计算各杂质在AZO中的含量还要将杂质元素换算成相对于ZnO的比值。表2为AZO中杂质元素的分析结果以及相对标准偏差(RSD)。当元素含量在μg/g水平时,除Se以外,测量的相对标准偏差均小于10%。可见在半定量分析中,GDMS对AZO中杂质元素的测定具有良好的精密度。
利用X-射线光电子能谱(X-ray Photoelectron Spectroscopy,XPS)分析靶材中的基体元素Zn和主体元素Al的成分,图4为Zn和Al的XPS图谱。XPS分析可得Zn的原子比为78.3%,Al的原子比为2.99%,计算出Al和Zn的质量比为1.58%,GDMS测试结果为1.45%,可以看出两种方法的测定结果相近。

图4 AZO靶材中Zn和Al的XPS谱图

表2 AZO样品中杂质元素的分析结果以及精密度
3 结束语
利用辉光放电质谱仪对AZO靶材中常微量元素的含量进行了检测。通过对仪器调谐,优化了工作参数,并对测试过程中产生的多原子离子干扰进行考察,获得较为理想的结果。同时对同一磁控溅射腔体内溅射过银靶和镍靶的AZO表面进行深度剖析,监测Ag和Ni元素含量随深度变化的情况,为靶材表层需要预溅射多少时间和深度才能将污染溅射去除提供一个依据。辉光放电质谱法采取固体进样,在一次分析过程中能直接测定基体元素 (~100%)、主体元素(%)、微量元素(μg/g)、痕量元素(ng/g),分析速度快,是半导体导电靶材直接测定的有效方法。本论文提出的AZO靶材中的杂质及杂质的深度分布的测试方法可以推广应用于其他的金属靶材和导电陶瓷靶材的杂质分析,实现靶材的杂质浓度的高精度、快速分析。
[1]KIM S, LEE J, DAO V A, et al.Investigation of electrical and optical properties of highly transparent TCO/Ag/TCO multi-layer[J].J Nanosci Nanotechno,2015(15):2247-2252.
[2]BECERRIL M,SILVA-LOPEZ H,GUILLEN-CERVANTES A,et al.Aluminum-doped ZnO polycrystalline films prepared by co-sputtering of a ZnO-Al target[J].Rev Mex Fis,2014(60):27-31.
[3]SENGUPTA J, SAHOO R K, MUKHERJEE C D.Effect of annealing on the structural,topographical and optical properties of sol-gel derived ZnO and AZO thin films[J].Matterials Letters,2012(83):84-87.
[4]MEREU R A, MARCHIONNA S, LE DONNE A, et al.Optical and electrical studies of transparent conductive AZO and ITO sputtered thin filmsforCIGS photovoltaics[J].Phys Status Solidi,2014(11):1464-1467.
[5]KIM W H, MAENG W J, KIM M K.Low pressure chemical vapor deposition of aluminum-doped zinc oxide for transparent conducting electrodes[J].J Electrochem Soc,2011,158(8):495-499.
[6]LAMIA Z, TAHAR T, DOMINIQUE V, et al.AZO thin films by sol-gel process for integrated optics[J].Coatings,2013(3):126-139.
[7]XU S S, LIANG Z C, SHEN H.The preparation of AZO/a-Si/c-Si heterojunction structure on p-type silicon substrate for solar cell application[J].Matterials Letters,2014(137):428-431.
[8]CHO H J, LEE S U, HONG B, et al.The effect of annealing on Al-doped ZnO films deposited by RF magnetron sputtering method for transparent electrodes[J].Thin Solid Films,2010(518):2941-2944.
[9]FANG G, LI D, YAO B L.Fabrication and vacuum annealing of transparent conductive AZO thin films prepared by DC magnetron sputtering[J].Vacuum,2003(68):363-372.
[10]MINAMI T, ODA J I, NOMOTO J I, et al.Effect of targetpropertieson transparentconductingimpuritydoped ZnO thin films deposited by DC magnetron sputtering[J].Thin Solid Films,2010(519):385-390.
[11]白雪,王星明,储茂友,等.AZO靶材热压致密化及Al元素扩散研究[J].粉末冶金技术,2012,30(6):420-427.
[12]PISONERO J, FERNANDEZ B, GUNTHER D.Critical revision of GD-MS,LA-ICP-MS and SIMS as inorganic mass spectrometric techniques for direct solid analysis[J].J Anal at Spectrom,2009,24(9):1145-1160.
[13]张见营,周涛,李金英.高纯硅中杂质元素的质谱与非质谱分析方法综述[J].质谱学报,2016,37(1):88-96.
[14]田春生.二次离子质谱仪(SIMS)的原理及应用[J].表面分析,2005(8):74-78.
[15]陈刚,葛爱景,卓尚军,等.辉光放电质谱法在无机非金属材料分析中的应用[J].分析化学,2004,32(1):107-112.
[16]钱荣,斯琴毕力格,卓尚军,等.辉光放电质谱新方法分析颗粒状金属铪[J].分析化学,2011,39(5):700-704.
[17]荣百炼,唐利斌,杨彦,等.辉光放电质谱法分析银铜合金样品时未知锂元素的鉴别 [J].红外技术,2010,32(3):169-172.
[18]SABATINO M D.Detection limits for glow discharge mass spectrometry (GDMS) analyses of impurities in solar cell silicon[J].Measurement,2014,50(1):135-140.
[19]GRASSERBAUER M.Ultra trace analysis of refractory metals by solid state mass spectrometry-A comparision of GD-MS, SSMS and SIMS[J].Microchinica Acta,1987(1):291-295.
(编辑:莫婕)
Impurities concentration detection and depth profile in AZO target by glow discharge mass spectrometry
HUANG Jin1,PAN Danmei1,ZHENG Qinghong2
(1.Test Center,Fujian Institute of Research on the Structure of Matter,Chinese Academy of Sciences,Fuzhou 350002,China;2.College of Materials Engineering,Fujian Agriculture and Forestry University,Fuzhou 350002,China)
In this paper,glow discharge mass spectrometry (GDMS) is used for the analysis of major and trace elements in alumina-doped zinc oxide (AZO)target and its depth profiling.First of all,the polyatomic ion interference of elements in AZO sample and Ar,H,O,N and other gas elements are thoroughly examined.Then,making an in-depth profile analysis of AZO target surface aftermagnetron sputtering by GDMS and step profiler,on which the longitudinal distribution of major pollution elements is also examined.Lastly,making mass spectrographic analysis of AZO target impurities after pre-sputtering by GDMS.Results of verification test by X-ray photoelectron spectroscopy(XPS) indicates that Zn and Al contents in the two methods are similar,and that GDMS is an effective method to analyze AZO and other semiconductor targets.Hence,pollution caused by AZO target in the process of sputtering can be effectively predicted and avoided.
glow discharge mass spectrometry; AZO target; magnetron sputtering; depth profile analysis
A
1674-5124(2017)04-0033-05
10.11857/j.issn.1674-5124.2017.04.008
2016-08-10;
2016-10-12
2014年国家自然科学基金青年项目(61306065);2015年福建省自然科学基金项目(2015J05133)
黄 瑾(1983-),女,福建福州市人,工程师,主要从事质谱分析检测工作。
